不同溅射气体对a-IGZO TFT特性的影响
张 耿,王 娟,向桂华,蔡君蕊,孙庆华,赵伟明1,,*
(1.东莞宏威数码机械有限公司,广东东莞523080;2.东莞彩显有机发光科技有限公司,广东东莞523080;3.东莞有机发光显示产业技术研究院,广东东莞523080;4.中山大学理工学院,广州510275)
在传统的有源驱动显示,如LCDs中,一般采用非晶硅或多晶硅薄膜晶体管。而硅基TFT对可见光不透明,且存在非晶硅TFT低迁移率、多晶硅的高成本、不均匀等缺点,限制了其在新兴的电流驱动型的 OLED显示技术领域的应用。近年来,以In-Ga-Zn-O(IGZO)为代表的透明氧化物半导体TFT技术,已取得很多突破性的进展。这项技术具有高迁移率、低亚阈值摆幅、低温制程、稳定且透明等优点,很有希望取代硅基TFT技术,成为下一代平板显示的主流技术[1-2]。
目前,该技术仍存在稳定性、均匀性等问题,阻碍其产业化进程[3]。研究者们尝试通过改变镀膜方式[4-5](DC or RF)、镀膜参数[6-8](溅射气压、氧分压、功率等)、退火条件[9-11](温度、气氛、时间等)、沟道钝化[12-13](制作方式、材料类型)等方法,来改进氧化物TFT的稳定性。文献中IGZO常采用Ar+O2或Ar+N2等混合气体制作,对于不同单组份溅射气体成膜效果及对TFT特性影响的系统研究,目前尚未见诸报道。
本文采用脉冲直流电源方式溅射制作IGZO-TFT器件,这是一种低成本、与传统生产兼容性高的工艺路线。文中分别采用Ar、O2、N23种单组份气体溅射制作IGZO膜,得到底栅结构的TFT,相应地研究了缺氧(Ar),富氧(O2),氧替代(N2)等3种类型的IGZOTFT特性。通过俄歇电子能谱(AES)、X射线衍射(XRD)、原子力显微镜(AFM)等方法,研究不同气体溅射的IGZO膜和相应的靶材表面成分、粗糙度、结构等特征和变化情况,分析采用不同溅射气体制备的IGZO膜和TFT器件特性存在差异的原因。
1 实验
实验中采用脉冲直流(Pulsed DC,ENI RPG-50)方式溅射制作IGZO膜,IGZO靶直径为150 mm,功率为30 W,气压为0.5 Pa,溅射气体为3种单组份的Ar、N2、O2(纯度均≥99.999%)。IGZO-TFT 为底栅顶接触结构,沟道尺寸W/L=1.0 mm/0.2 mm。沟道材料为不同气体制作的IGZO(30 nm);栅电极采用ITO(150 nm);SD电极采用蒸镀的Al膜(100 nm),并利用Shadow Mask图形化;栅绝缘层采用脉冲直流反应溅射制作的Si3N4/SiO2(300 nm/20 nm),功率为160 W,工艺气体分别为:Ar+N2、Ar+O2,总气压为0.46 Pa。TFT结构制作完成后,在氧气氛中于300℃下退火1 h。
分别采用俄歇电子能谱(AES,PHI680)、原子力显微镜(AFM,Veeco Dimension 3100)、四探针测试仪(Four Dimension Inc.1100-D)、X-Ray衍射法(XRD,D-MAX 2200 VPC)等方法分析IGZO膜的表面成分、表面粗糙度、表面方阻以及膜层结构。采用Keithley 2635和Keithley 2420组成的测试系统进行TFT特性测试。
此外,实验中截取新鲜的IGZO靶材截面,分别采用Ar、N2、O2等单组份气体进行溅射处理0.5 h,其它工艺条件与制作IGZO薄膜时的相同,然后采用AES对靶材轰击面进行成分测试,并与相同条件下制作的IGZO膜进行对比分析。
2 分析和讨论
采用不同的单组份气体制作的IGZO-TFT,沟道表现出不同的转移特性(如图1)。在退火前,Ar-IGZO TFT和N2-IGZO TFT(分别表示Ar和N2溅射制作的IGZO膜,下同)的沟道电流ID与栅极电压VG间呈线性关系,且ID较大,分别为10-2A和10-3A,这意味着沟道中自由载流子的浓度较高,ID不受VG控制;经退火后,这两种沟道均表现出受VG控制的半导体特性,参数如表1所示。其中Ar-IGZO TFT的特性表现更优异,其中S值为1 V/(°),Vth为1.4 V,μ值为8.3 cm2/Vs,Ion/Ioff≥105;N2-IGZO TFT 的相应参数分别为 5 V/dec、-0.9 V、2.0 cm2/Vs、103。而O2-IGZO TFT在退火前后均基本没有输出电流,图上波动的曲线为测试系统的本底噪声信号。

图1 不同溅射气体制作的IGZO-TFT的转移特性曲线
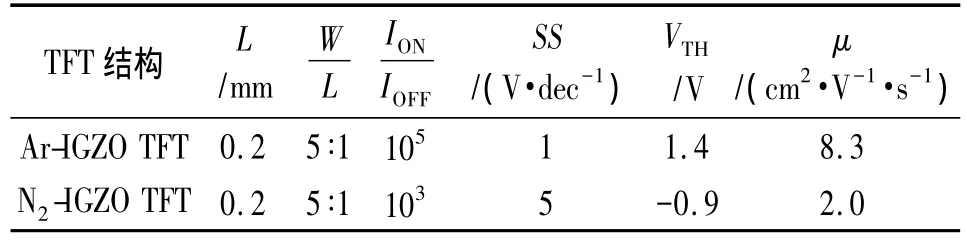
表1 退火后Ar-IGZO TFT和N2-IGZO TFT的TFT特性参数统计表
将3种单组份气体制备的IGZO膜(100 nm)分别制作在白玻璃上进行分析。图2是其经退火前后的XRD图,图中重叠的曲线表明,采用不同气体溅射制备的IGZO膜在退火前后均为非晶形态,退火处理对其结构基本无影响,因此具有良好的结构稳定性。

图2 XRD表征不同溅射气体制作的IGZO膜的结构特征
采用四探针法测量上述3种IGZO膜的方阻,结果如图3所示。从图中可看到,Ar-IGZO膜具有最小的方阻102Ω/□,而N2-IGZO膜和O2-IGZO膜的方阻分别为104-5Ω/□和≥109Ω/□。经退火后,除Ar-IGZO膜的方阻由102Ω/□上升至107-8Ω/□外,其它两种膜的方阻基本不变。根据Hosono等人[14]的观点,TFT的电学特性与IGZO膜中的氧空位密切相关,氧空位较多时IGZO膜的载流子浓度较高,此时相应的导电特性较好。由于采用Ar离子溅镀的IGZO膜会形成较多的氧空位,此时氧空位充当载流子施主,提供较多的自由电子;经过退火后,气氛中的氧填补了部份空位,降低了载流子的浓度,表现出方阻明显增加的现象。O2-IGZO膜在制作过程中,由于有足够的氧补充进IGZO膜层结构中,因此氧空位最少,表现为退火前后方阻值均较高。而N2-IGZO制作过程中虽然没有O2参与,但部分氧空位可被N原子填补,方阻介于Ar-IGZO和O2-IGZO之间。
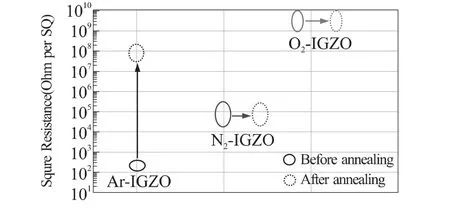
图3 不同溅射气体制作的IGZO膜的表面方阻情况
对于不同气体溅射制作的IGZO膜,除了形成不同的氧空位密度外,相应的靶材和膜层中的金属含量比也存在差异。从图4中对靶材的AES成分分析结果,原始靶材中In/Zn/Ga的原子比确认为2∶1∶1;分别采用Ar/N2/O23种等离子轰击0.5 h时,靶表面成分发生较大的变化。相应于Ar/N2/O2的处理次序,In含量逐渐增加,Ga含量逐渐减少,Zn的含量在Ar轰击后剩下的最多,N2轰击后的最少。这意味着溅射气体对靶材中不同元素的溅射速率影响很大:In在采用Ar轰击时的溅射产率最高,Ga是采用O2溅射时最高,Zn是采用N2时最高。

图4 AES分析采用不同溅镀气体轰击前后的IGZO靶材的表面成分情况
图5是IGZO膜表面的AES成分分析结果。整体而言,In在Ar-IGZO膜中的比重最高,Ga在O2-IGZO膜中的含量最高;退火前Zn在O2-IGZO膜中的含量最高,而退火后则是在Ar-IGZO中最高。根据Hosono等人[16]的研究报道,认为In原子是IGZO膜中载流子的主要贡献者,Ga起抑制载流子迁移的作用,Zn则有利于非晶结构膜层的形成。与前面方阻测量结果相对应,Ar-IGZO的方阻低是因为其膜层中In含量较高所致,O2-IGZO的方阻高是Ga原子含量较高的原因。

图5 AES分析采用不同溅镀气体制作的IGZO膜的表面成分情况
退火前后膜层成分,以N2-IGZO的成分比例最为稳定,这与N可提高IGZO结构的稳定性报道一致[15]。而Ar-IGZO和O2-IGZO中的成分比例则稍有变化,尤其是Zn和Ga的相对比重变化,说明这两种膜层结构较不稳定,退火会引起膜层内的原子迁移;尤其是O2-IGZO中In含量较高,这可能是受AES的测量局限性所致,采用AES测量时要求膜层具有一定的导电能力,而O2-IGZO膜的导电性较差,需采用等离子去中和膜层表面的积累电荷,此过程对薄膜有等离子轰击效果,相应的膜层成分与实际情况会有偏离。
采用AFM分析不同溅射气体制作的IGZO膜,如图6所示,表面粗糙度在退火前后呈现出不同的规律。Ar-IGZO和N2-IGZO膜表面较平整,平均粗糙度Ra<0.25 nm,退火前后基本无变化。但是O2-IGZO呈现出很大的不同,表面均较粗糙(Ra>2 nm),且退火处理导致粗糙度增加(2.1 nm→2.7 nm)。根据材料学的缺陷观点,薄膜表面的粗糙度高会引起更多的界面缺陷态,这对载流子起到陷阱捕获的作用。由此也说明了表面粗糙度较大的O2-IGZO膜具有较高的方阻,而且退火后粗糙度继续增加,这些对沟道载流子传输都是不利的。
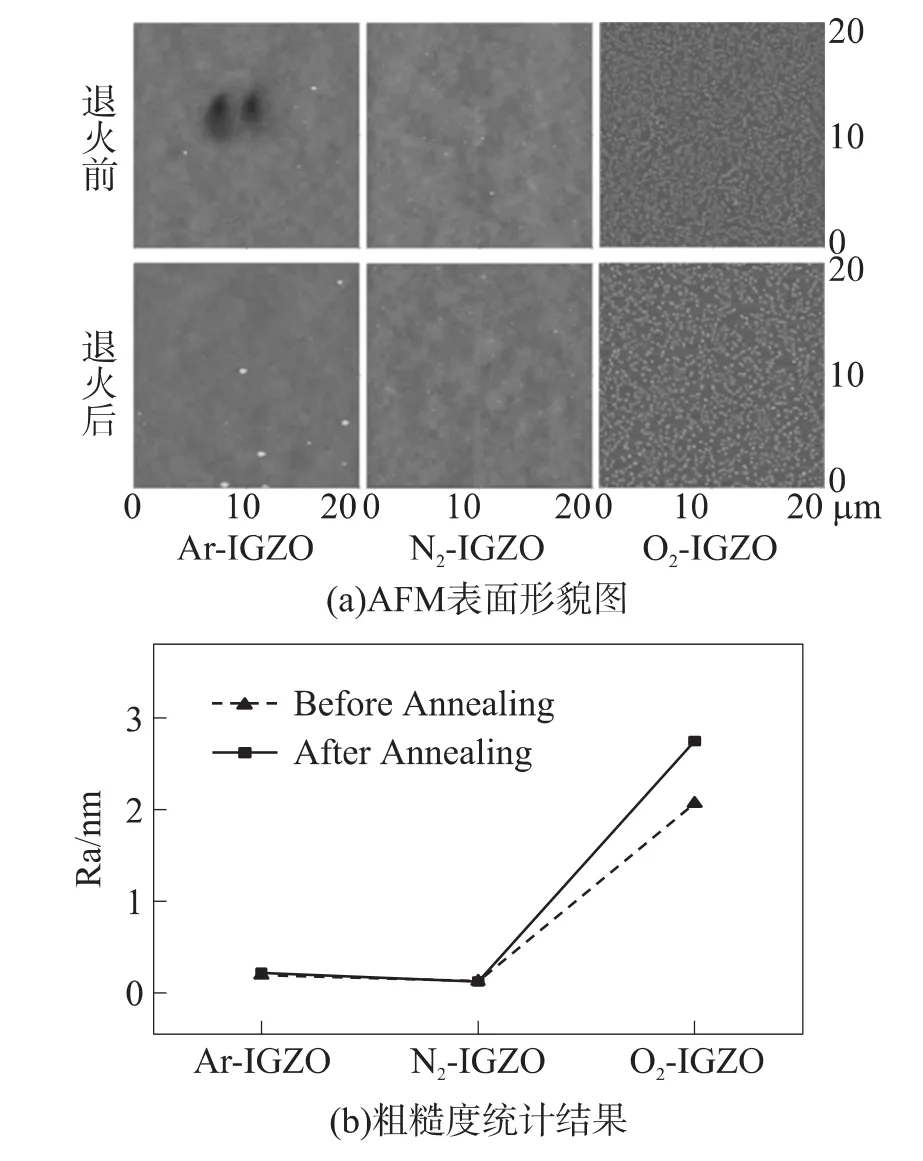
图6 不同溅镀气体制作的IGZO膜
3 结论
本文采用脉冲直流溅射方式制备了缺氧(Ar)、富氧(O2)、氧替代(N2)3种类型的IGZO-TFT,并考察其在退火前后的特性变化情况。退火前Ar-IGZO具有较低的方阻102Ω/□,沟道特性呈线性,退火后TFT具有良好的特性,S值为1 V/dec,迁移率可达8.27 cm2/Vs,开关比≥105。退火前后N2-IGZO的方阻为104-5Ω/□,结构和成分最稳定,退火处理后TFT有受控特性,但比Ar-IGZO TFT的差。退火前后O2-IGZO的方阻均≥109Ω/□,TFT无开关特性。
通过XPS、AES、AFM 等方法,发现 Ar-IGZO的方阻低与膜层中In含量较高有关,O2-IGZO的方阻高与Ga原子含量较高有关,而N2-IGZO膜的结构稳定性则与含N原子有关。此外,AFM表面粗糙度测量结果表明,退火前后Ar-IGZO和N2-IGZO膜表面较平整且较稳定(Ra<0.25 nm);而O2-IGZO膜表面粗糙度较大,且在退火后粗糙度变大,这对O2-IGZO TFT的沟道载流子传输是不利的。
[1]Toshio Kamiya,Kenji Nomura,Hideo Hosono.Present Status of A-morphous In-Ga-Zn-O Thin-Film Transistors,J,Science Technology of Advanced Materials,2010,11,044305.
[2]Park Seok Joon,Maeng Wan-Joo,Kim Hyun-Suk,et al.Review of Recent Developments in Amorphous Oxide Semiconductor Thin-Film Transistor Devices,J,Thin Solid Films,2011,In press.
[3]John F Conley.Instabilities in Amorphous Oxide Semiconductor Thin-Film Transistors[J].IEEE Transactions on Device and Materials Reliability,2010,10:460-476.
[4]Takafumi Aoi,Nobuto Oka,Yasushi Sato,et al.DC Sputter Deposition of Amorphous Indium-Gallium-Zinc-Oxide(a-IGZO)Films with H2O Introduction[J].Thin Solid Films,2010,518(11):3004-3007.
[5]Seo Kyu Dong,Shin Sangwoo,Cho Hyung Hee,et al.Drastic Improvement of Oxide Thermoelectric Performance Using Thermal and Plasma TreatmentsoftheInGaZnO Thin FilmsGrown by Sputtering[J].Acta Materialia,2011,59:6743-6750.
[6]Jung C H,Kim D J,Kang Y K,et al.Transparent Amorphous In-Ga-Zn-O Thin Film as Function of Various Gas Flows for TFT Applications[J].Thin Solid Films,2009,517(14):4078-4081.
[7]Chiu C J,Pei Z W,Chang S T,et al.Effect of Oxygen Partial Pressure on Electrical Characteristics of Amorphous Indium Gallium Zinc Oxide Thin-Film Transistors Fabricated by Thermal Annealing[J].Vacuum,2011,86(3):246-249.
[8]Hai Q Chiang,Brian R McFarlane,David hong,et al.Processing Effects on the Stability of Amorphous Indium Gallium Zinc Oxide Thin-Film Transistors[J].Journal of Non-Crystalline Solids,2008,354:2826-2830.
[9]Park Soyeon,Bang Seokhwan,Lee Seungjun,et al.The Effect of Annealing Ambient on the Characteristics of an Indium-Gallium-Zinc Oxide Thin Film Transistor[J].Journal of Nanoscience and Nanotechnology,2011,11:6029-6033.
[10]Seo Seok-Jun,Hwang Young Hwan,Bae Byeong-Soo.Postannealing Process for Low Temperature Processed Sol-Gel Zinc Tin Oxide Thin Film Transistors[J].Electrochemical and Solid-State Letters,2010,13(10):H357-H359.
[11]Fuh Chur-Shyang,Sze Simon Min,Liu Po-Tsun,et al.Role of Environmental and Annealing Conditions on the Passivation-Free in-Ga-Zn-O TFT[J].Thin Solid Films,2011,In press.
[12]Liu Shou-En,Yu Ming-Jiue,Lin Chang-Yu,et al.Influence of Passivation Layers on Characteristics of a-InGaZnO Thin-Film Transistors[J].IEEE Electron Device Letters,2011,32:161-163.
[13]Antonis Olziersky,Pedro Barquinha.Insight on the SU-8 Resist as Passivation Layer for Transparent Ga2O3-In2O3-ZnO Thin-Film Transistors[J].Journal of Applied Physics,2010,108,064505.
[14]Akihiro Takagi,kenji nomura,Hiromichi ohta,et al.Carrier Transport and Electronic Structure in Amorphous Oxide Semiconductor,a-In-GaZnO4[J].Thin Solid Films,2005,486:38-41.
[15]Liu Po-Tsun,Chou Yi-The,Teng Li-Feng,et al.Nitrogenated A-morphous InGaZnO Thin Film Transistor[J].Applied Physics Letters,2011,98,052102.
[16]Toshio Kamiya,Kenji Nomura,Hideo Hosono.Origins of High Mobility and Low Operation Voltage of Amorphous Oxide TFTs:Electronic Structure[J].Journal of Display Technology,2009,5:468-483.

