过渡金属氧化物薄膜阻变存储材料研究
高兴森, 张 飞, 林远彬, 芦增星
(华南师范大学华南先进光电子研究院,广东广州 510006)
过渡金属氧化物薄膜阻变存储材料研究
高兴森*, 张 飞, 林远彬, 芦增星
(华南师范大学华南先进光电子研究院,广东广州 510006)
随着半导体技术和集成电路的进步,器件的集成度不断提高,器件的特征尺寸不断减小,基于电荷存储的传统非易失性随机存储器面临着物理和技术上极限的挑战. 阻变式存储器(RRAM)作为新一代存储器件,因其具有结构简单、制备简便、存储密度高、擦写速度快、写入电流小等优势受到广泛研究. 针对过渡金属氧化物薄膜RRAM的研究概况,从RRAM的基本原理、材料体系、存储机理和器件应用所面临的困难等方面对RRAM进行了综述.
阻变存储器; 非易失性存储; 过渡性金属氧化物; 薄膜
随着计算机科技和信息科技的飞速发展,对存储器的要求也越来越高,如高密度、高速度、低功耗、小尺寸等. 当器件的特征尺寸不断减小,器件的集成度不断提高时,基于电荷存储的传统非挥发性存储器(如DRAM和FLASH)面临着物理和技术上的极限,阻碍了其进一步发展. 因此,开发一种全新的非挥发性存储器来取代现有的存储器,已成为当前研究热点. 目前广泛研究的新一代非挥发性存储器有:相变存储器(PRAM) 、磁存储器(MRAM)、铁电存储器(FRAM)和阻变存储器(RRAM).
PRAM利用材料在晶态和非晶态之间的相互转换来实现二进制存储, 但实现相变需要的电流较大. MRAM利用材料具有2个不同磁化方向来实现非挥发性存储. FRAM利用材料的极化特性来实现非挥发性存储. 但MRAM和FRAM都需要特殊材料, 且难与CMOS(互补金属氧化物半导体,Complementary Metal Oxide Semiconductor)工艺兼容, 制作成本高, 读出信号微弱. 这3类非挥发性存储器由于各自存在的缺点影响了进一步实际应用. 各种存储器优缺点[1]如表1所示,RRAM的特征尺寸是目前所有存储器中最小的,操作速度也是最快的,而器件的耐久性处于中等,有待提高. 但综合来看,RRAM是目前发展潜力最大的存储器之一.

表1 各种新兴非挥发性存储器的性能比较Table 1 A comparison for the properties of different immerging nonvolatile random access memorizers
与PRAM、MRAM和FRAM等非挥发性存储器相比,RRAM具有如下优势:RRAM的常见结构单元是金属-绝缘层-金属(MIM)[2](图1A),其结构简单,也有使用多层异质作为阻变层的,但工艺均采用与CMOS技术兼容的薄膜制备工艺,因此制备简便. RRAM的阻变效应是一种局域效应,电阻只在约几纳米的范围内发生变化,因此RRAM存储单元的物理尺寸可以达到很小.在RRAM器件中又存在多级存储现象,进而提高其存储密度[3-6]. RRAM的擦写速度由触发脉冲宽度决定(图1A),一般小于100 ns. LEE等[7]基于TiN/TiOx/HfOx/TiN制作的RRAM擦写速度快达5 ns,RRAM的写入电流较小. 另外,RRAM与半导体工艺的兼容性很好,易实现大批量、低成本的生产制造. RRAM因其具有上述优势而被广泛研究,有望成为下一代非挥发性存储器的主流.
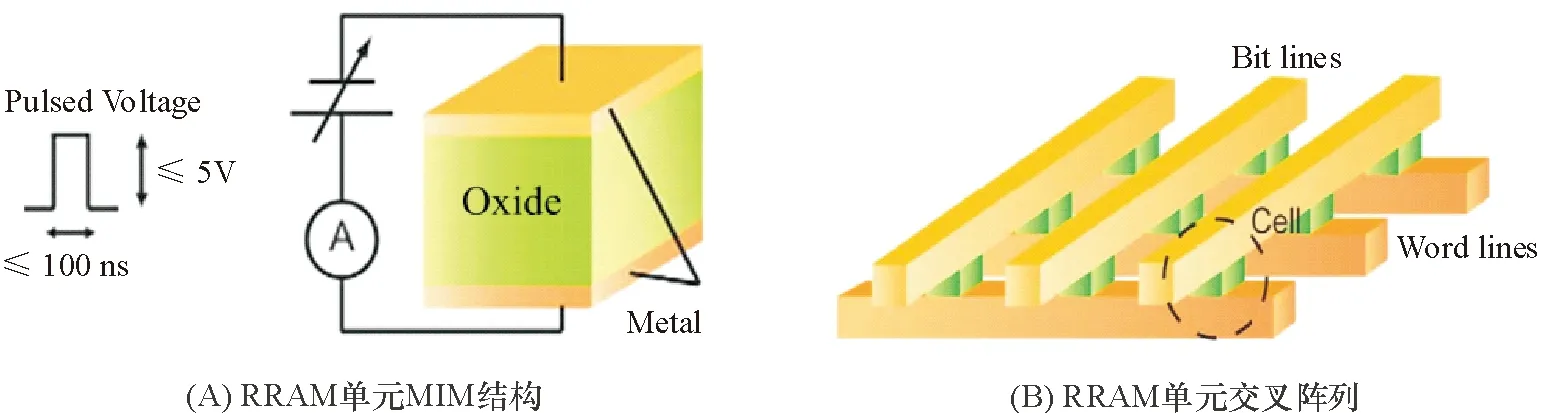
图1 RRAM器件的结构示意图[2]
1 RRAM的基本工作原理及性能指标
1.1 基本工作原理
RRAM通过电阻在高阻态(HRS)和低阻态(LRS)之间发生可逆稳定转换,实现“0”、“1”逻辑存储. 外部施加Set电压将器件从HRS转向LRS;反之,施加Reset电压使器件从LRS转向HRS.
阻变存储器的结构为2层电极中间夹1层绝缘介质的三明治结构(MIM)(图1A),一般采用交叉阵列(crossbar)的集成方式选择所操作的存储单元[8](图1B),通过这种集成方式可以将器件的单元面积做到4F2(F是特征线宽).
RRAM根据其阻变效应与电压极性的关系分为:单极性(Unipolar)和双极性(Bipolar)(图2). 单极性RRAM的Set电压和Reset电压的极性相同,且Set电压高于Reset电压;双极性RRAM的Set电压和Reset电压具有不同的极性(图2B). 这4种情况可能出现在单极性RRAM,而双极性RRAM只可能是图2B和C对应的情况[1].

图2 单极型和双极型阻变行为示意图
1.2 器件性能指标
RRAM的器件性能指标是判断其性能好坏的主要依据. 主要包括:
(1)操作电压Vwr、Vrd,读写时间twr、trd,读出电流Ird,wr代表写入,rd代表读出. 对存储器来说, 过大的操作电压意味着器件本身可靠性的降低,也会带来更大的功耗. 由于器件原理的限制,Vrd不能低于Vwr的1/10,且小于1 V.twr要达到100 ns数量级甚至更小,trd要与twr同等数量级甚至更小. 另外,为使读取信号能被外围电路的小信号放大器准确快速地识别,Ird不能低于1 μA.
(2)电阻比率,指高低电阻状态下电阻的比值RHRS/RLRS. 电阻比率的大小直接影响判读数据的准确性, 如果电阻比率太小, 外围电路将无法准确地判读数据. 对RRAM一般要求RHRS/RLRS>10,有利于实现多值存储,同时减小外围放大器的负担,简化放大电路.
(3)耐受性,指器件能够发生高低阻态转变并维持正常工作的周期数. 一般要求RRAM器件的工作寿命达到1012周期以上.
(4)保持时间tret指存储在存储单元中的数据能够被保存的时间. 一般商业化的存储器产品要求其保持时间达到10 年以上.
此外多级存储、器件良率等特性参数也会影响存储器的性能. 在上述主要性能参数中,各参数之间看似相互独立,但实际上相互制约,如Vrd与Vwr的比值事实上受tret和trd限制. 因此寻求高密度、低功耗的理想RRAM器件,需综合考虑各性能参数,寻求最佳的平衡点.
2 材料体系
2.1 阻变层材料
2.1.1 二元过渡金属氧化物 目前研究较多的有:NiO[9-10],ZnO[10-11],TiO2[12],Cu2O[13],ZrO2[14-15]等. KYUNG等[9]用阴极细丝熔断理论来解释基于NiO的RRAM; KINOSHITA等[16]在NiO体系中,通过减少寄生电容来降低Reset电流. YANG等[11]在Mn掺杂ZnO的RRAM中实现了5 ns的操作速度;XU等[10]用TiN电极中的氧空位调节效应探索了ZnO的阻变机制. CAO等[12]从限流角度分析了TiO2体系的阻变特性影响规律. YANG等[13]在基于Cu2O的RRAM中讨论了不同电极对阻变效应的影响. LI等[14-15]研究了Cu掺杂ZrO2体系RRAM的非极性阻变特性.
2.1.2 多元金属氧化物 目前具有阻变效应的多元金属氧化物以三元金属氧化物(SrRuO3、SrZrO3、SrTiO3等)[17-21]和四元金属氧化物(LaxSr1-xMnO3、LaxCa1-xMnO3、PrxCa1-xMnO3等)[19,22]为主. LIU等[23]报道了Pr0.7Ca0.3MnO3(PCMO) 薄膜的阻变效应.
2.2 电极材料
在选择RRAM的电极材料时,需考虑电极材料的功函数、电导率、稳定性、电极与功能层的接触界面等. 目前,常用的电极材料包括:Pt、Ag、Ti、Al、Pd、W、Cu等金属; IZO、ITO、YBCO、SrRuO3、LaAlO3等金属氧化物[24]. 如在NiO的RRAM中,当上电极为(Pt、Au)时,与NiO功能层形成欧姆接触;而当上电极为Ti时,在Ti/NiO界面形成肖特基接触[25].
3 RRAM存储机理
引起阻变现象的原因有多种, WASER等[6]将不同阻变机制分为9大类. 而在过渡金属氧化物的RRAM中,本文将阻变机制分为3类:局域化的导电细丝机制、表面和界面机制、铁电反转机制.
3.1 局域化导电细丝机制
局域化的缺陷形成导电通道是最常见的阻变类型,导电细丝理论模型[2]如图3所示.
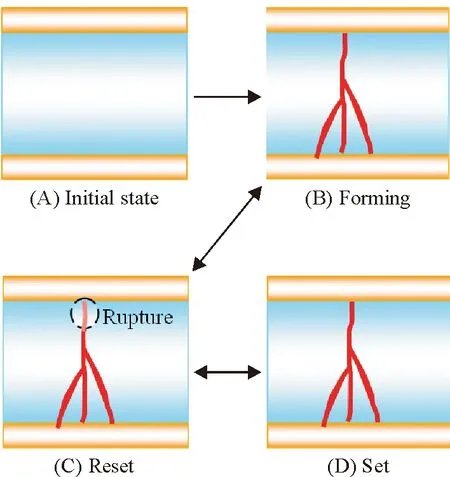
图3 导电细丝的形成和断裂模型示意图[2]
首先是Forming过程,通过较大的电流,产生导电细丝, 当导电细丝形成时,电阻处于低阻态(LRS);在Reset过程中,导电细丝断裂,电阻处于高阻态(HRS). 而在Set过程中,导电细丝恢复,形成低阻态. 然而,不同材料形成导电丝的机制并不相同,主要有以下几种:
3.1.1 变价型记忆效应(CVM) WASER提出, 在变价型导电细丝形成过程中,会产生氧化还原反应,而氧空位起着至关重要的作用[4]. 以SrTiO3(STO)为例,经过高真空退火的STO单晶氧含量较大,在较大的Forming电场作用下,氧空位迁移,形成浓度氧空位细丝,导致STO的进一步还原,形成电导较高的细丝. 在反向Reset电场作用下,部分细丝被氧化成不导电的STO,细丝断裂. 而在Set 电场作用下,已断裂的细丝可被还原成导电态(图4A). 因此,变价形成的导电细丝的阻变通常具有双极性. 导电细丝的分布可被导电-扫描探针检测,由多个细丝形成,而单个细丝直径可以小到2 nm(图4B).掺Cr的STO单晶通过X-射线荧光成像(XRF)观测到,在经过水平Forming电场后,氧在阳极(anode)附近的浓度增大(图4C),表明氧空位在电场作用下产生了迁移.

(A)电阻随Reset和Set后的变化 (B)导电原子力显微镜成像 (C)氧空位富集的XRF成像
3.1.2 热化学记忆效应 热化学记忆效应主要由温度变化引起的阻变,但与相变阻变不同. 其Forming和Set过程与变价型的类似, 但Reset过程不同,导电细丝断裂不是因为氧化,而是通过足够高的温度引起低阻态导电丝的熔断. SON等[26]在研究Hg/NiO/Rt结构的阻变特性时,用导电原子力显微镜(C-AFM)观察到了NiO薄膜导电细丝的形成和断裂现象. 当外加Set电压时,电极中的金属离子扩散到NiO功能层形成导电细丝,给电子的移动提供通道,电流急增,此时电阻处于低阻态(LRS);当施加Reset电压时,流过NiO功能层的电流较大,焦耳热过大,导电细丝熔断,电阻从低阻态变成高阻态(HRS). XU等[27]在TiN/ZnO/Pt器件结构中发现,ZnO的氧空位形成了非金属导电细丝,并导致了器件的阻变现象.
导电细丝理论中I-V曲线近似为直线,即I-V特性符合欧姆特性. 一般情况下,在导电细丝理论中,器件在低电阻态的电流与器件面积无关[27-30],因为导电通路只在特定区域内产生,且一旦导通后,其他区域不再导通. 因此,高低电阻的变化并不随面积的改变而变化,而器件的微型化很大程度决定于导电细丝的大小. 然而在一些特殊材料(如外延的STO超薄膜)中,可出现多个分布相对均匀的导电细丝,导致低阻态电阻变化受面积的影响较大,并可构建更小尺度的存储单元.
3.2 界面型阻变机制
与局域性导电细丝不同,界面型阻变常通过界面和缺陷实现,其导电分布较均匀.优点是读写速度快,但缺点是耐久性较差. 主要有以下几种机制:
3.2.1 肖特基发射效应 肖特基发射效应跟界面态有关,是一种界面势垒调制效应. SIM等[31]认为在SrTiO3与电极界面处氧空位的充放电会影响肖特基势垒变化(图5). 加负电压时,电子进入界面处氧化物一侧,与其中的氧空位结合使界面处的势垒升高,隧穿电流减小,电阻为高阻态;当加正电压时,界面处氧化物一侧的氧空位堆积使肖特基势垒降低,隧穿电流增大,电阻为低阻态.
肖特基发射属于热电子发射,其J-V关系如下:
(1)


图5 肖特基发射效应示意图[31]
3.2.2 空间电荷限制电流效应(SCLC) SCLC效应是空间电荷限制电流效应的简称,受缺陷控制. 在低电压下,薄膜中的陷阱将注入的电子捕获,电流较小,电阻(HRS)较大;增大电压,陷阱被充满,不再对注入的电子产生影响,电流大幅度上升,电阻(LRS)变小. SCLC效应的J和V的关系[30]如下:
(2)


(3)


(4)
比较式(3)和式(4)发现,在陷阱态为空态和满态情况下,SCLC效应的电流密度相差θ倍. LI等[15]在实验中将Zr+注入到ZrO2薄膜,得出I-V曲线(图6). 薄膜在高低电阻态下的I-V曲线变化趋势与SCLC效应的一致.
3.2.3 S-V理论 S-V理论最早于1967年由SIMMONS和VERDERBER提出,用于解释Au/SiO/Al结构中的阻变现象. 该模型认为材料的缺陷会引入缺陷能级. 当这些缺陷能级未被电荷填充时,电子

图6 注入Zr+的ZrO2薄膜器件I-V曲线[16]
则通过这些缺陷在器件中导通,电阻为低阻态(LRS). 当增加器件两端的电压时,缺陷能级被电荷充满,形成的自建电场阻止了电子的运行,器件不再导通,电阻变为高阻态. 当施加反向电压时,电荷离开缺陷能级,器件恢复到低阻态. 在S-V模型中存在负微分电阻效应,即随电压的升高,器件电流减小,电阻减小[32-33]. S-V模型常被用于解释金属氧化物中出现的阻变现象[34-36]. LEE等[35]用S-V模型解释了非化学计量比ZrO2中的阻变现象. GUAN等[36]报道了Au掺杂ZrO2器件的阻变特性.
3.3 电极化诱导阻变机制
电极化诱导阻变机制类似于界面肖特基发射,也因界面的肖特基势的变化引起,区别在于导致势垒变化的原因是电极化的反转. 这是一类新型阻变机制,可通过铁电极化反转写信息,而通过电阻的变化读信息,从而集铁电存储与阻变存储的两大优点于一体,有望获得稳定、高速、海量地存储.
3.3.1 铁电隧穿机制 铁电隧穿效应发生在铁电体作为阻变层的MIM结构中,它依赖于铁电体内部正负电荷在外加电场作用下的定向翻转. 当在铁电阻变层的上下电极间施加不同方向和大小的偏压时,铁电体内部的正负电荷会发生不同方向和程度的翻转,从而改变了体内的电荷势垒,影响了体内电子的隧穿几率,进而改变了体内的电阻,即产生了阻变效应. 铁电隧穿效应的原理[37]如图7所示,外加电场在铁电体内产生3种效应:①静电效应(图7B),使边界电荷层附近的电荷和电势产生一定的分布,从而改变整个铁电隧穿层的接触电势;②界面效应(图7C),使不同极性方向铁电层的隧穿几率不同;③应力效应(图7D),通过静电力使铁电体内产生电荷,从而改变铁电层势垒的高度. 以上3种效应均影响铁电体内的隧穿势垒,从而影响电子的隧穿几率,改变体内电阻,发生阻变效应[38].

图7 铁电隧穿效应的原理[38]
GARCIA等[39]观察到,BaTiO3在厚度为1~3 nm时,仍能保持其铁电性. 此时铁电性通过极化作用改变隧穿电阻的大小,且在不同极化状态下,隧穿电阻随BaTiO3薄膜厚度的增加而成指数增加. 通过原子力显微镜的导电探针,可使超薄膜的微曲极化反转,从而写入不同的铁电极化畴(图8). 这些畴结就可通过导电扫描探针的电流成像读出,正反极化的电流大小不同表明了用铁电隧穿阻变的可行性.

图8 BaTiO3超薄膜在导电原子力显微镜下的不同铁电极化状态下的高低电阻状态像[39]
3.3.2 可反转的铁电二极管效应 近年来,在较厚的铁电薄膜中,阻变效应也引起了关注. WANG等[40]发现BiFeO3材料具有类似二极管的整流效应(图9). 铁电二极管的整流方向可通过铁电极化反转而改变,导致高低电阻之比接近100倍.铁电二极管阻变效应可归结为极化反转的静电作用,产生的静电效应导致肖特基势垒的改变(图10). HUANG等[41]通过制备BFO/Nb-STO 并采用STM直接观测到这种肖特基势垒的改变,做出了不同位置的势垒高度图(图11),与铁电极化反转相吻合,进一步说明了铁电极化导致铁电效应的作用.
4 RRAM器件的应用
目前多数研究集中于RRAM阻变单元在传统CMOS结构中的应用,并制成有源的RRAM. 如将NiO的RRAM单元植入到180 nm的CMOS工艺中[42],其存储单元的工作寿命可达到106周期,器件在300 ℃下能稳定工作. 将TaOx的RRAM单元集成到180 nm的CMOS工艺中,其工作寿命长达109周期,且在85 ℃下能将数据保存10年以上[43].

图9 BiFeO3在不同电压范围的I-V曲线(A)和P-V曲线(B)[40]

图10 BiFeO3薄膜在原始态(A)、向上极化态(B)和向下极化态(C)的能带示意图[40]

图11 BiFeO3薄膜横截面的STM能带结构像[41]
与基于CMOS工艺的有源RRAM相比,无源RRAM阵列具有更可观的应用前景,无源RRAM存储阵列占用面积更小,存储密度更高. 无源RRAM单元阵列通常制成交叉条状(crossbar)结构,并通过可编程门阵列(FPGA)分别调用,此结构可代替传统CMOS电路. 另外,在许多基于氧化物薄膜的RRAM系统中观测到了多级存储现象,从而使存储器尺寸的进一步缩小成为可能.
尽管目前基于氧化物薄膜的RRAM器件已被广泛而深入地研究,但其商业化应用存在的主要问题如下:
(1)微观物理机制问题 多种关于氧化物薄膜阻变效应的微观物理机制,均根据研究者们各自的实验结果,目前仍存在争议,这将成为氧化物RRAM薄膜器件商业化应用的一大障碍.
(2)疲劳问题 RRAM器件的应用寿命要求在10年以上,疲劳特性达到109以上.但目前研究出的氧化物RRAM器件在经过多次连续电阻转变后易产生疲劳现象,表现为HRS与LRS之比的数量级大幅度下降,甚至完全丧失阻变效应.
(3)热效应、功耗问题 目前,RRAM器件的Reset电流较高,导致了器件的写入电流较大,热效应大,引起较高的功耗.
(4)器件稳定性问题 RRAM器件将HRS和LRS的电阻值作为存储信号,但HRS的电阻值、Set电压/电流和Reset电压/电流等工作参数经多次重复转换后存在严重的离散问题,导致RRAM器件不稳定.
5 结语
介绍了RRAM的基本工作原理、器件性能参数、过渡氧化物RRAM薄膜材料体系与存储机理. 针对氧化物RRAM的研究概况,分析了RRAM器件应用所面临的困难. 在未来非挥发性存储领域中,追求高密度存储仍是一个终极目标,但是由于物理极限的存在,通过缩小器件的尺寸来继续提高存储密度困难较大,因此研究具有多级存储能力的RRAM器件是必然趋势. 尽管目前对RRAM器件的研究已取得了很大成效,但其综合性能尚不足、物理机制尚未清楚、存在器件的稳定性和可靠性尚待提高等问题. 寻找环境友好、与COMS工艺兼容、具优异存储性能的RRAM材料体系,并研究RRAM的存储机理将是未来RRAM发展的一个重点方向. 总之,RRAM有希望成为下一代非挥发性存储器的主流.
[1] JEONG D S,THOMAS R,KATIYAR,et al. Emerging memories: resistive switching mechanisms and current status[J]. Rep Prog Phys,2012,75(7):076502.
[2] SAWA A. Resistive switching in transition metal oxides[J]. Mater Today,2008,11(6):28-36.
[3] 吴曙翔. 过渡金属氧化物的分子束外延生长及其相应器件的非易失存储研究[D]. 广州:中山大学,2009.
[4] WASER R,AONO M. Nanoionics-based resistive switching memories[J]. Nat Mater,2007,6:833-840.
[5] YANG J J,PICKETT M D,LI X,et al. Memrisitive switching mechanism for metal/oxide/metal nandevices[J]. Nat Nanotechn,2008,3:429-433.
[6] WASER R, DITTMANN R, STAIKOV G, et al. Redox-based resistive switching memories-nanoionic mechanisms, prospects, and challenges[J]. Adv Mater, 2009, 21, 2632-2663.
[7] LEE H Y,CHEN P S,WU T Y,et al. Low power and high speed bipolar switching with a thin reactive Ti buffer layer in robust HfO2based RRAM[C]∥IEDM Tech Dig. San Francisco, Canada, 2008:297-300.
[8] BAEK I G,KIM D C,LEE M J,et al. Multi-layer cross-point binary oxide resistive memory (OxRRAM) for post-NAND storage application[C]∥Int Elec Dev Meet.Washington, USA,2005:750-753.
[9] KYUNG M K,BYUNG J C,SEUL J S, et al. Filamentary resistive switching localized at cathode interface in NiO thin films[J]. J Electrochem Soc,2009,156(12):G213-G216.
[10] XU N,LIU L F,SUN X, et al. Characteristics and mechanism of conduction/set process in TiN/ZnO/Pt resistance switching random-access memories[J]. Appl Phys Lett,2008,92(23):232112.
[11] YANG Y C,PAN F,LIU Q,et al. Fully room-temperature-fabricated nonvolatile resistive memory for ultrafast and high-density memory application[J]. Nano Lett,2009,9(4):1636-1643.
[12] CAO X,LI X M,GAO X D, et al. Effects of the compliance current on the resistive switching behavior of TiO2thin films[J]. Appl Phys A,2009,97(4):883-887.
[13] YANG W Y, RHEE S W. Effect of electrode material on the resistance switching of Cu2O film[J]. Appl Phys Lett,2007,91(23):232907.
[14] LI Y T,LONG S B,ZHANG M H,et al. Resistive switching properties of Au/ZrO2/Agstructure for low-voltage nonvolatile memory applications[J]. Elec Dev Lett,2010,31(2):117-119.
[15] LI Q,GUAN W H,LONG S B, et al. Resistive switching memory effect of ZrO2films with Zr+implanted[J]. Appl Phys Lett,2008,92(1):012117.
[16] KINOSHITA,TSUNODA K,SATO Y, et al. Reduction in the reset current in a resistive random access memory consisting of NiOxbrought about by reducing a parasitic capacitance[J]. Appl Phys Lett,2008,93(3):033506.
[17] LIN C C,TU B C,LIN C C,et al. Resistive switching mechanisms of V-doped SrZrO3memory films[J]. IEEE Electr Device Lett,2006,27(9):725-727.
[18] CHOI B J,JEONG D S,KIM S K,et al. Resistive switching mechanism of TiO2thin films grown by atomic-layer deposition[J]. J Appl Phys,2005,98(3):033715.
[19] 曲炳郡,黄丽娜,刘理天. Ag/La0.67Sr0.33MnO3/Pt异质结构的电阻开关特性[J]. 纳米技术与精密工程,2009,7(2):178-181.
[20] CHOI D,LEE D,SIM H,et al. Reversible resistive switching of SrTiOxthin films for nonvolatile memory applications[J]. Appl Phys Lett,2006,88(8):082904.
[21] YANG M K,KIM D Y,PARK J W,et at. Resistive switching behavior of Cr-doped SrZrO3perovskite thin films for random access memory applications[J]. J Korean Phys So,2005,47:S313.
[22] 王乐毅. 忆阻器研究进展及应用前景[J]. 电子元件与材料,2010,29(12):71-74.
[23] LIU S Q,WU N J,IGNATIEV A. Electric-pulse-induced reversible resistance change effect in magnetoresistive films[J]. Appl Phys Lett,2000,76(19):2749-2751.
[24] 左青云,刘明,龙世兵,等. 阻变存储器及其集成技术研究进展[J]. 微电子学,2009,39(4):546-551.
[25] SEO S,LEE M J,KIM D C,et al. Electrode dependence of resistance switching in polycrystalline NiO films[J]. Appl Phys Lett,2005,87(26):263507.
[26] SON J Y,SHIN Y H. Direct observation of conducting filaments on resistive switching of NiO thin films[J]. Appl Phys Lett,2008, 92(22):222106.
[27] XU N,LIU L F,SUN X,et al. Bipolar switching behavior in TiN/ZnO/Pt resistive nonvolatile memory with fast switching and long retention[J]. Semicond Sci Tech,2008,23(7):075019
[28] KIM K M,CHOI B J,HWANG C S. Localized switching mechanism inresistive switching of atomic-layer-deposited TiO2thin films[J]. Appl Phys Lett,2007,90(24):242906.
[29] KINOSHITA K,TAMURA T,AOKI M,et al. Bias polarity dependent data retention of resistive random access memory consisting of binary transit ion metal oxide[J]. Appl Phys Lett,2006,89(10):103509
[30] LAMPERT M A,MARK P. Current injection in solids[M]. New York:Academic Press Inc,1970.
[31] SIM H,SEONG D J,CHANG M,et al. Excellent resistance switching characteristics of Pt/single-crystal Nb-doped SrTiO3schottky junction[C]//21stIEEE NVSMW. USA, 2006:88-89.
[32] SIMMONS J G,VERDERBER R R. New conduction and reversible memory phenomena in thin insulating films[J]. Proc Roy Soc A, 1967, 301(1464):77-102.
[33] SHIMA H,ZHONG N,AKINAGA H,et al. Switchable rectifier built with Pt/TiOx/Pt trilayer[J]. Appl Phys Lett,2009,94(8):082905.
[34] REDDY V S,KARAK S,DHAR A. Multilevel conductance switching in organic memory devices based on AlQ3and Al/Al2O3core-shell nanoparticles[J]. Appl Phys Lett,2009,94(17):173304.
[35] LEE D,CHOI H,SIM H,et al. Resistance switching of the nonstoichiometric zirconium oxide for nonvolatile memory applications[J]. IEEE Electr Device Lett,2005, 26(10): 719-721.
[36] GUAN W H,LONG S B,JIA R,et al. Nonvolatile resistive switching memory utilizing gold nanocrystals embedded in zirconium oxide[J]. Appl Phys Lett,2007,91(6):062111.
[37] TSYMBAL E Y,KOHLSTEDT H. Tunneling across a ferroelectric[J]. Science,2006,313(5784):181-183.
[38] KOHLSTEDT H,PERTSEV N A,CONTRERAS J R,et al.Theoretical current-voltage characteristics of ferroelectric tunnel junctions[J]. Phys Rev B,2005,72(12):125341.
[39] GARCIA V,FUSIL S,BOUZEHOUANE K,et al. Giant tunnel electroresistance for non-destructive readout of ferroelectric states[J]. Nature,2009(460):81-84.
[40] WANG C,JIN K J,XU Z T,et al. Switchable diode effect and ferroelectric resistive switching in epitaxial BiFeO3thin films[J]. Appl Phys Lett,2011,98(19):192901.
[41] HUANG B C,CHEN Y T,CHIU Y P,et al.Direct observation of ferroelectric polarization-modulated band bending at oxide interfaces[J]. Appl Phys Lett,2012,100(12):122903.
[42] KIM D C,LEE M J,AHN S E,et al. Improvement of resistive memory switching in NiO using IrO[J]. Appl Phys Lett,2006,88(23):232106.
[43] WEI Z,KANZAWA Y,ARITA,et al. Highly reliable TaOxRRAM and direct evidence of redox reaction mechanism[C]∥Int Electron Device Meet.San Francisco, USA,2008:1-4.
Keywords: resistive switching random access memory (RRAM); nonvolatile memory; transition metal oxide
TransitionMetalOxideThinFilmBasedNonvolatileResistiveRandomAccessMemory
GAO Xingsen*, ZHANG Fei, Lin Yuanbin, Lu Zengxing
(South China Academy of Advanced Optoelectronics, South China Normal University, Guangzhou 510006, China)
With the rapid developing of semiconductor industry and the increasing inegration level of electronic devices, the characteristicl dimention of the microelectronic devices become smaller and samller, the tranditional nonvolatile memories based on strorages will reach their physical and teachnological limit. As a kind of new immerging memories, resistive random access memory (RRAM) attracts intensive interests owing to its advantages such as simple structure, compatible with conventional CMOS process, high writing and reading speeds, low writing current etc. This paper gives a brief overview on transition metal oxides thin film based RRAM, including the basic working principles, performance criterions, material issues, resistive switching mechanism, as well as challenges on the way to real applications.
2013-03-12
国家自然科学基金项目(51072061, 51031004, 51272078);教育部长江学者创新团队项目(IRT1243)
*通讯作者:高兴森,教授,Email: xingsengao@scnu.edu.cn.
1000-5463(2013)06-0075-10
O472+.4;TN386.1
A
10.6054/j.jscnun.2013.09.011
【中文责编:谭春林 英文责编:李海航】

