瑞红RZJ-304光刻胶光刻工艺研究
庞梦瑶,程新利*,秦长发,沈娇艳,唐运海,王冰
(1.苏州科技学院数理学院,江苏苏州215009;2.昆山双桥传感器测控技术有限公司,江苏昆山215321)
瑞红RZJ-304光刻胶光刻工艺研究
庞梦瑶1,程新利1*,秦长发1,沈娇艳1,唐运海1,王冰2
(1.苏州科技学院数理学院,江苏苏州215009;2.昆山双桥传感器测控技术有限公司,江苏昆山215321)
利用光刻技术对瑞红RZJ-304正性光刻胶进行光刻工艺研究,用透射式光栅作为掩模版,通过改变光刻步骤中的前烘时间、曝光时间、显影时间等来研究光刻效果。实验结果表明,掩模版图形被成功地转移到了硅片基底上,显影后光刻胶厚度均匀,光刻胶线条呈周期性排列,得到了与掩模版尺寸一致的图形。这说明得到了适合RZJ-304光刻胶的光刻工艺。
RZJ-304光刻胶;光刻技术;光栅掩模版
半导体产业的飞速发展促使集成电路的性能不断提高,这与光刻技术的发展是分不开的。光刻是指在集成电路制造中利用光化学反应原理和化学、物理刻蚀方法,将电路图形传递到单晶表面或介质层上,形成有效图形窗口或功能图形的工艺技术。在微电子行业中器件等比例缩小定律和摩尔定律都与光刻技术密切相关,光刻技术已经成为集成电路制造的关键技术[1-4]。光刻技术的不断发展为集成电路技术的进步提供了三方面的保证[5]:其一是大面积均匀曝光,在同一块硅片上能同时做出大量器件和芯片,保证了批量化的生产水平;其二是图形线宽不断缩小,使集成度不断提高,生产成本持续下降;其三,由于线宽的缩小,器件的运行速度越来越快,从而使集成电路的性能不断提高。光刻技术在现代传感器技术中也得到了广泛的应用,利用光刻技术制作的薄膜传感器可以克服传统应变式传感器的缺点,如传统的金属应变片式传感器无法应用于运载火箭燃料室的压力测量、发动机燃烧室压力监测、供油压力、导弹飞行平衡控制以及石油工业的井下压力测量等[6-8]。而采用溅射薄膜技术和光刻技术相结合的金属薄膜电阻应变压力传感器恰恰可以满足这些条件。利用光刻工艺可以把溅射技术制备的薄膜制作成所需的电阻条,薄膜与衬底直接相连,消除了应变片式传感器中粘合剂的影响,改善了传感器的性能。
在光刻工艺中,光刻胶是影响光刻效果的重要因素。光刻胶分为两大类:(1)正性光刻胶,受光照部分发生降解反应而能为显影液所溶解,留下的非曝光部分图形与掩模版一致。正性光刻胶具有分辨率高、对驻波效应不敏感、曝光容限大、针孔密度低和无毒性等优点,适合于高集成度器件的生产;(2)负性光刻胶,受光照部分产生交链反应而成为不溶物,非曝光部分被显影液溶解,获得的图形与掩模版图形互补。负性光刻胶的附着力强、灵敏度高、显影条件要求不严,适于低集成度的器件的生产。不同厂家生产的光刻胶也有性能的差异,笔者对苏州瑞红电子化学品有限公司生产的RZJ-304光刻胶进行光刻工艺研究,为传感器薄膜图形化探索合适的光刻工艺参数。光刻技术一般包括基片清洗烘干、旋转涂胶、前烘、对准并曝光、显影、后烘坚膜、腐蚀和去胶等8个步骤[9-10]。笔者选择前烘、曝光、显影三个重要步骤进行研究,以获取适合光刻胶的最佳工艺参数。
1 实验
使用中国科学院光电技术研究所的URE-2000/25型紫外光刻机曝光,曝光波长为365 nm紫外线;利用中国科学院微电子研究所KW-4A型台式匀胶机匀胶;烘烤使用上海新高医疗器械制造有限公司制造的DHG-9143BS-Ⅲ干燥箱;使用的光刻胶为苏州瑞红电子化学品有限公司生产的RZJ-304正性光刻胶,粘度为10 MPa·s,显影液为该公司生产的RZX-3038正胶显影液;光刻后图形利用CMM-40E型金相显微镜进行观察,利用Dektak XT型台阶仪测量光刻胶和掩模版厚度。所用样品基片为2英寸单面抛光的P型单晶硅片。在实验过程中,根据光刻胶的性质,按照光刻工艺步骤进行整个流程,初步获得合适的工艺参数,然后进行参数优化实验,以获得最佳工艺参数。
2 实验结果与讨论
2.1 前烘时间对光刻质量的影响
前烘的目的是除去光刻胶中的有机溶剂,增强黏附性,释放光刻胶膜内的应力,防止光刻胶玷污设备等。如果前烘过度将会减小光刻胶中感光成分的活性,前烘不足会导致光刻胶中的溶剂不能完全蒸发掉,这将阻碍光对光刻胶的作用并且影响到其在显影液中的溶解度。只有干燥的光刻胶才能充分进行光化学反应并保持相应完整性,在显影时不易脱落。
前烘时间不同,显影漂洗后光刻胶的表面完整度就可能不同,因此,通过观察不同前烘时间的基片在显影后的完整情况来判断前烘时间是否合适,通过实验数据分析得到合适的前烘时间。实验中所用掩模版光栅如图1所示,光栅常数为50 μm,透光部分宽度为30 μm,遮光部分宽度为20 μm。
硅片清洗干燥后,用滴管滴入适量的光刻胶后进行匀胶。匀胶时首先低速旋转,转速为450 r·min-1,时间为9 s,然后高速旋转,转速为4 000 r·min-1,时间为30 s,烘烤温度100℃,滴胶量约为0.6 mL,曝光时间为3.2 s,显影时间为60 s。在100℃时前烘时间为3-5 min。用4组样品A、B、C、D做了相关实验,前烘时间分别为3、3.5、4和4.5 min,经过后期显影后得到的结果如图2所示。

图1 掩模版照片
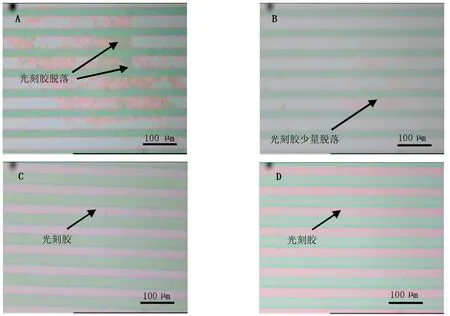
图2 不同前烘时间对光刻胶图形的影响
从图2中可以看出,在经过光刻流程后,都得到了与原来光栅类似的图形,图片中用箭头标记出的部分为没有经过曝光的光刻胶,经过显影后保留下来的,对应于光栅中不透光部分。从图2中还可以看出在不同前烘时间中,得到的图形是有明显差异的,图2(A)显示光刻胶在显影后部分被溶解掉,造成光刻胶线条不连续,说明光刻胶与基底结合不牢固,这是由于前烘不足造成的,有机溶剂没有完全挥发掉,光刻胶粘连程度不够;图2(B)显示随着烘烤时间增加,光刻胶图形完整度有所提高,但是仍有少量光刻胶在显影漂洗后缺失;图2(C)和2(D)显示样品中光刻胶图形保持完整,并且线条均匀,说明经过充分前烘过程后,光刻胶已经满足实验过程的需要。由此可见,光刻胶前烘时间从4 min至4.5 min都能得到较好的实验结果。
2.2 显影时间对光刻质量的影响
在显影过程中,要准确控制显影时间,防止显影液可能会与基片上要刻蚀的薄膜进行反应。实验目标是保证光刻胶完全显影,不要在样品表面曝光处残留光刻胶,同时又不能显影过度,防止要保留的光刻胶被腐蚀。实验中只改变显影时间一个变量,样品A、B、C、D、E、F的显影时间分别为40、45、50、55、60、70 s,其他工艺参数如下:匀胶时低速转速为450 r·min-1,时间为9 s,高速转速为4 000 r·min-1,时间为30 s,前烘温度100℃,时间4.5 min,曝光时间3.1 s。不同时间显影后的实验结果如图3所示。

图3 显影时间对光刻质量的影响
从图3可以看出,经过不同时间显影后,得到的光刻胶图形有明显的差异。图3(A)没能显示出图形,这是由于显影不够,即曝光的光刻胶没有充分反应,仍然大面积残留在硅片表面,导致不能显示出掩模版的图形;图3(B)虽能看到图形,但仍不很清晰,这也是由于显影时间不足造成的,仍有未去除的多余光刻胶;图3(C)和图3(D)显示得到的图形条纹较为清晰,在本组实验中显影效果较好,说明这两样品的显影时间是合适的,仔细分析可以发现光刻胶图形尺寸与掩模版对应尺寸稍有差别,这是由于光刻过程中多个步骤还不是完全匹配造成的,可以通过改进其他工艺参数改善图形质量;图3(E)也显示了光栅图样,清晰度有所下降,说明显影时间稍长而造成了显影过度,靠近表面的光刻胶被显影液过度溶解,造成图形不清晰;图3(F)显示照片不清晰,这也是由于显影过度造成的,导致胶被溶掉过多。由以上分析可知光刻的最佳显影时间为50-55 s。
2.3 曝光时间对光刻质量的影响
曝光过度与曝光不足都会使得到的图形无法与预期目标图形相同,因此,选择合适的曝光时间在光刻过程中尤为重要。选择A、B、C、D、E、F 6个样品用不同曝光时间进行实验,时间分别为2.5、3.0、3.1、3.2、3.3、3.8 s。其他实验参数如下:匀胶时低速转速为450 r·min-1,时间为9 s,高速转速为4 000 r·min-1,时间为30 s,前烘温度100℃,时间4.5 min,显影时间为50 s,显影后的表面如图4所示。

图4 曝光时间对光刻胶图形的影响
从图4可见,经过不同的曝光时间后,得到的光刻胶图形具有明显差异。图4(A)显示,经过2.5 s曝光再显影后,得到光刻胶图像不是很清楚,说明曝光时间不够,透光部分没能充分发生光化学反应,在显影的时候,被溶掉的光刻胶较少,不能显示出清楚的图形。图4(B)显示经过曝光3.0 s后样品,光刻胶图形与样品A类似,图形也不是很明显。图4(C)是曝光3.1 s后的样品照片,可以看出,随着曝光时间增加,所得的曝光部分与未曝光部分的颜色相差变大,得到较为明显的光刻胶图案,条纹变得清晰,说明曝光时间较佳,光刻胶较为充分的进行了光化学反应,因此,光刻质量变好。图4(D)和4(E)分别是曝光3.2 s和3.3 s后的样品照片,从图中可以看出光刻胶条纹非常清晰,说明经过3.2 s和3.3 s时间曝光后,光刻胶能够充分发生反应,在显影后保留了完整的图形。对比图4(D)和4(E),可以看出图E中保留的光刻胶宽度与原来掩模版遮光部分尺寸更为接近,说明样品E的光刻效果更好。图4(F)是曝光时间3.8 s后的样品照片,此图说明样品曝光过度,使被掩模版遮住的部分也曝光了,这是由于掩模版和光刻胶接触位置有微小的空隙,进行曝光的紫外线经过较长时间的衍射,使遮光部分的光刻胶也部分发生了光化学反应,因此,在显影过程中也被溶解了。从以上6个样品的分析可以看出,如果曝光时间不足,光刻胶中感光活性成分未能进行或充分进行光化学反应,则刻出的图形会不清晰或不存在图形。但是如果曝光过度,会使不该曝光的光刻胶也发生了曝光,也得不到好的实验结果。实验中较好结果是在3.1 s、3.2 s、和3.3 s得到的,三个时间参数相差很小,但是曝光效果明显不同,说明对光刻胶发生反应的时间点应该很好的控制。实验结果认为光刻的最佳曝光时间为3.3 s。
2.4 光刻后光刻胶图形纵深比分析
利用台阶仪对光刻后样品表面光刻胶图形进行测量分析,实验中同时测量了掩模版图像透光和遮光部分,结果如图5所示。
图5清楚显示了掩模版和光刻工艺后光刻胶在样品表面分布情况。从图5(A)可以看出掩模版中透光部分和遮光部分宽度分别为30 μm和20 μm,呈现周期性排列,遮光部分厚度约为220 nm,边缘陡峭。图5(B)是光刻工艺后光刻胶的分布曲线,可以看出掩模版上透光部分和遮光部分图形已经转移到硅片基底上了,光刻胶对应图形呈现周期性排列,光刻胶宽度与掩模版上对应部分尺寸接近,光刻胶厚度约为130 nm,光刻胶边缘不如掩模版的陡峭,这是由于化学湿法显影造成的。总之,通过上述实验得到了较好的光刻效果,成功的把掩模版图形转移到硅片衬底上了,说明选择的光刻工艺参数是合适的。

图5 掩模版和光刻胶表面图形测量曲线
3 结语
选择了瑞红RZJ-304正性光刻胶进行光刻工艺实验,得到了较好光刻效果的工艺参数:匀胶时低速旋转速度为450 r·min-1,时间为9 s,高速旋转速度为4 000 r·min-1,时间为30 s;前烘温度为100℃,烘烤时间为4-4.5 min;曝光时间为3.1-3.3 s;显影时间为50-55 s。在此工艺参数下得到的光刻胶图案呈现周期性排列,尺寸与掩模版对应部分相同,成功地实现了掩模版光栅图形的转移,为后续薄膜刻蚀奠定了基础。
[1]陈大鹏,叶甜春.现代光刻技术[J].核技术,2004,27(2):81-86.
[2]孙磊,戴庆元,乔高帅,等.从特征尺寸的缩小看光刻技术的发展[J].微纳电子技术,2009,46(3):186-190.
[3]刘加峰,胡存刚,宗仁鹤.光刻技术在微电子设备的应用及发展[J].光电子技术与信息,2004,17(1):24-27.
[4]Bruning J H.Optical lithography below 100 nm[J].Solid State Technology,1998,41(11):59-67.
[5]沈柏明.集成电路制造技术展望[J].微电子学,2002,32(3):202-205.
[6]田莉.NiCr合金薄膜的制备与特性研究[D].长沙:中南大学,2006.
[7]张虎.电阻应变式传感器及其在多个力传感器测试技术中的运用[J].实用测试技术,2001(5):23-24.
[8]晏建武,周继承,鲁世强,等.合金薄膜电阻应变式压力传感器的研究进展[J].材料导报,2005,19(12):31-34.
[9]豆丁网.光刻胶及光刻工艺流程[EB/OL].[2011-05-26].http://www.docin.com/p-209814157.html.
[10]豆丁网.光刻工艺(半导体制造技术)[EB/OL].[2012-07-23].http://www.docin.com/p-448001281.html.
A study on lithography process for the Ruihong RZJ-304 photoresist
PANG Mengyao1,CHENG Xinli1,QIN Changfa1,SHEN Jiaoyan1,TANG Yunhai1,WANG Bing2
(1.School of Mathematics and Physics,SUST,Suzhou 215009,China;2.Kunshan Shuangqiao Sensor Measurement Controlling Co.,Ltd,Kunshan 215321,China)
Lithography is a very important step in fabrication of semiconductor devices.In this paper,lithography process was studied to obtain the suitable parameters by using Ruihong RZJ-304 positive photoresist.This project was done by controlling exposure time,developing time,soft-baking time and so on.The optical grating was used as a mask.The result shows that mask shape was transferred to surface of silicon successfully.The photoresist lines were periodic array and almost the same as the optical grating mask.The thickness of the photoresist lines was uniform.The proper lithography process for RZJ-304 photoresist was achieved successfully.
RZJ-304 photoresist;lithography;optical grating mask
TN305.7;O484.8
A
1672-0687(2015)03-0020-05
责任编辑:李文杰
2013-12-16
江苏省产学研前瞻性联合研究项目(BY2011133;BY2014061);住房和城乡建设部科学技术项目(2014-K8-051);苏州市科技发展计划(纳米专项)项目(ZXG2013041);江苏省高等学校大学生实践创新训练计划项目
庞梦瑶(1990-),女,山西阳泉人。
*通信联系人:程新利(1976-),男,副教授,博士,E-mail:xlcheng@mail.usts.edu.cn。

