TFT栅极绝缘层和非晶硅膜层的ITO污染对电学特性影响的研究
王守坤,袁剑峰,郭会斌,郭总杰,李升玄,邵喜斌
(北京京东方显示技术有限公司,北京100176)
TFT栅极绝缘层和非晶硅膜层的ITO污染对电学特性影响的研究
王守坤∗,袁剑峰,郭会斌,郭总杰,李升玄,邵喜斌
(北京京东方显示技术有限公司,北京100176)
本文对TFT在栅极绝缘层和非晶硅膜层沉积过程中,透明电极ITO成分对膜层的污染和TFT电学性质的影响进行分析研究.通过二次离子质谱分析和电学测试设备对样品进行分析.ITO成分会对PECVD设备、栅极绝缘层和非晶硅膜层产生污染,并会影响TFT的电学特性.建议采用独立的PECVD设备完成ITO膜层上面的栅极绝缘层和非晶硅膜层的沉积,并且对设备进行周期性清洗,可降低ITO成分的污染和提高产品的电学性能.
薄膜晶体管;化学气相沉积;栅极绝缘层;有源层;非晶硅膜;氧化铟锡;电学特性
1 引 言
目前,液晶显示(LCD)已被广泛地应用于各种显示领域[1].由于TFT非晶硅有源层a-Si薄膜和栅极绝缘层SiNx是TFT器件的关键膜层,如果达不到最优化,则严重影响产品的电学特性产品良率,因而引起众多研究工作者的关注[2-3].
边缘场开关薄膜晶体管[4-5](FFS-TFT)通常采用以下工艺来完成:第一次光刻工艺,形成公共电极(1stITO),通过第二次光刻工艺形成栅极金属线(gate),第三次工艺,形成栅极绝缘层、半导体有源层和源/漏极金属层(g-SiNx,a-Si&SD layer),第四次光刻形成沟道绝缘层(PVX)和过孔(via hole);最后一次光刻形成像素电极(2ndITO).而第三次工艺是通过化学气相沉积形成栅极绝缘层(g-SiNx)和非晶硅有源层(a-Si layer).在此沉积过程中,产品的ITO膜层已经形成并且会进入高温等离子体环境的PECVD沉积设备,ITO就有可能会分解而污染设备,从而导致沉积的膜层掺入ITO的成分.
本文主要对TFT栅极绝缘层和有源层的成分进行分析,讨论ITO膜层对PECVD设备和沉积膜层的污染性及TFT的电学性能的影响,并给出建议,提高产品性能.
2 实 验
2.1样品制备
实验设备采用射频频率为13.56 M Hz的 PECVD系统,温度为290~360℃.设备的等离子功率为3~22 k W,反应腔的气压为159~320 Pa,电极间的距离为17~25 mm.栅极绝缘层膜层(SiNx)的反应气体为NH3、Si H4和N2,非晶硅有源层的反应气体为Si H4和H2,在完成第二次光刻形成透明ITO电极和栅极金属线的玻璃基板上沉积SiNx薄膜和非晶硅膜层.玻璃基板为2 500 mm×2 200 mm的超薄玻璃基板,沉积的同时在基板上粘贴硅片(Si-wafer),进行样品成分测试分析,拆除硅片后,玻璃基板会继续进行TFT的后续制作,以便测试样品的电学性质.图1为FFS-TFT结构截面示意图.
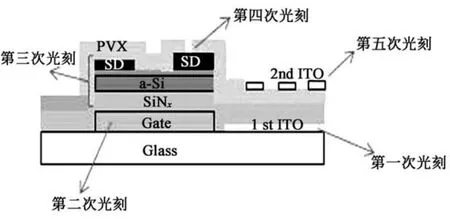
图1 TFT结构截面图Fig.1 Cross-sectional view of TFT
表1为样品的测试条件.其中×表示样品不进行此工序.设备L和M表示等离子体化学气相沉积栅极绝缘层或者非晶硅膜层的PECVD设备.其中,设备L表示长时间未进行清洗的PECVD设备;而设备M则是测试前已进行过清洗处理的PECVD设备.
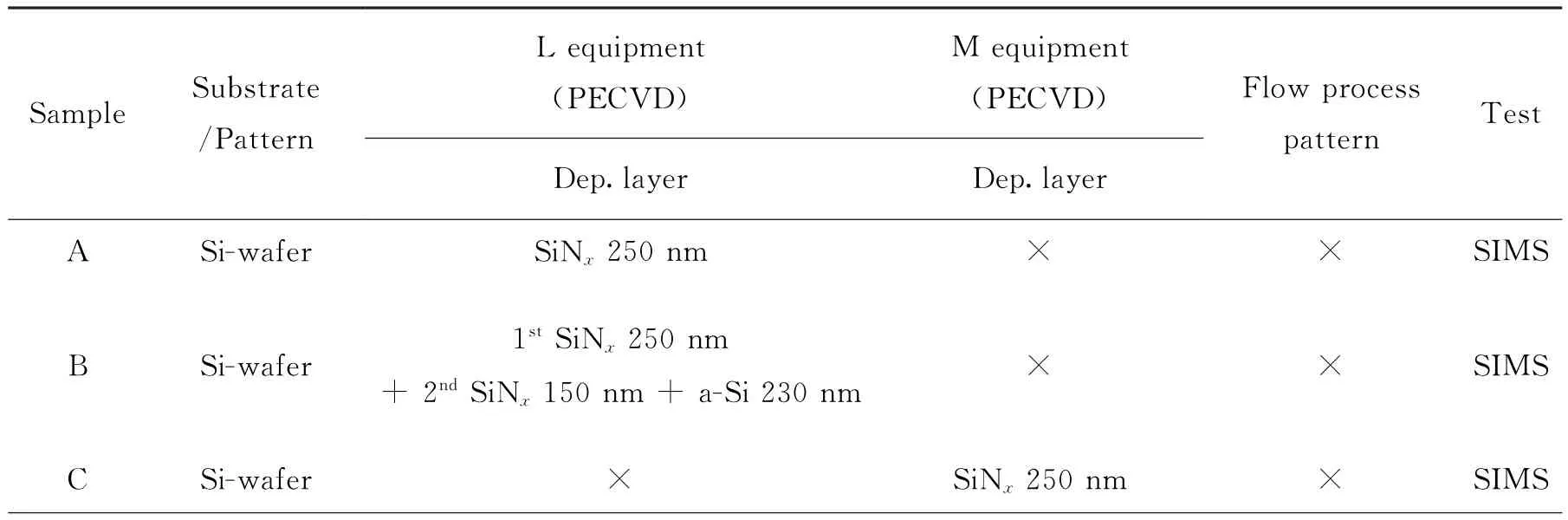
表1 样品测试条件Tab.1 Test condition of samples

续表
2.2分析测试方式
SIMS(Secondary Ion Mass Spectroscopy):二次离子质谱仪.高能一次离子轰击样品表面,并注入被分析样品,把动能传递给固体原子,通过层叠碰撞,引起中性粒子和带正负电荷的二次离子发生溅射,然后利用质量分析器接收,并对被轰击样品的表面和内部元素分布特征进行分析,就得到二次离子质谱,通过此分析可以得到不同深度的微量元素含量.
EPM(electronic parameter measurement): EPM相当于一个大型的精确万用表,可以测量包括电压、电流、电阻、电容和阈值电压在内的多种电学参数,对有代表性的TFT器件的电学特性进行整体评估.
3 实验测试结果
3.1TFT栅极绝缘层和非晶硅有源膜层成分测试结果
为分析ITO膜层分解的成分对PECVD设备及栅极绝缘层和非晶硅有源膜层的污染性,本文通过二次质谱仪SIMS对样品进行元素含量成分分析.SIMS样品是通过粘在玻璃基板的硅片(Si-wafer)在PECVD设备进行膜层沉积制作,条件如表1.图2和图3分别是硅片样品A,C和B,D的膜层结构示意图.

图2 SIMS分析样品A&C的膜层示意图Fig.2 A&C films of SIMS samples

图3 SIMS分析样品B&D的膜层示意图Fig.3 B&D films of SIMS samples
通过样品SIMS测试分析,可得到样品A,B,C和D在不同膜层深度中In和Sn元素成分含量分析图谱.其中,图4是A&C的SIMS测试分析结果.从图4的分析结果可知,在PECVD的L和M设备制作的栅极绝缘层SiNx样品,未发现明显的Sn元素的峰位出现,即Sn元素成分可以忽略;但是在L设备制作的样品A则会有明显的In元素的成分出现,而且In元素的峰位位置是在SiNx膜层240 nm的深度,也就是在PECVD设备沉积刚开始的时刻点.

图4 样品A&C的SIMS测试结果Fig.4 SIMS result of sample A&C

图5 样品B&D的SIMS测试结果Fig.5 SIMS result of sample B&D
图5为样品B&D的SIMS测试分析结果.通过图5的SIMS测试分析可知,在PECVD的L和M设备制作的栅极绝缘层SiNx和非晶硅膜层a-Si的样品,也未发现明显的Sn元素的峰位出现,即Sn元素成分也都可以忽略.而在L设备制作的样品B在600 nm,360 nm和210 nm的深度会有明显的In元素的峰位成分出现,分析可知此深度恰恰对应样品的各膜层在设备刚开始沉积的时刻点,这与样品A的结果一致.
可见,ITO膜层成分已经污染PECVD设备,并会对未清洗的L设备所沉积的栅极绝缘层和非晶硅膜层掺杂In元素;而清洗过的M设备则没有发现对栅极绝缘层和非晶硅膜层产生污染的ITO成分的出现.
3.2TFT电学特性测试结果
为确定ITO成分掺杂进入栅极绝缘层和非晶硅有源层对产品电学性质的影响,本文进行了TFT电学测试.图6,图7,图8和图9分别是样品TFT光照开启电流,关闭漏电流,开关电流比和迁移率的分析图表.分析可知,样品E和F的TFT开启电流和迁移率明显小于样品G,并且样品E的光照漏电流明显高于样品F和G;样品E的开关电流比也是三个样品里面最差的.
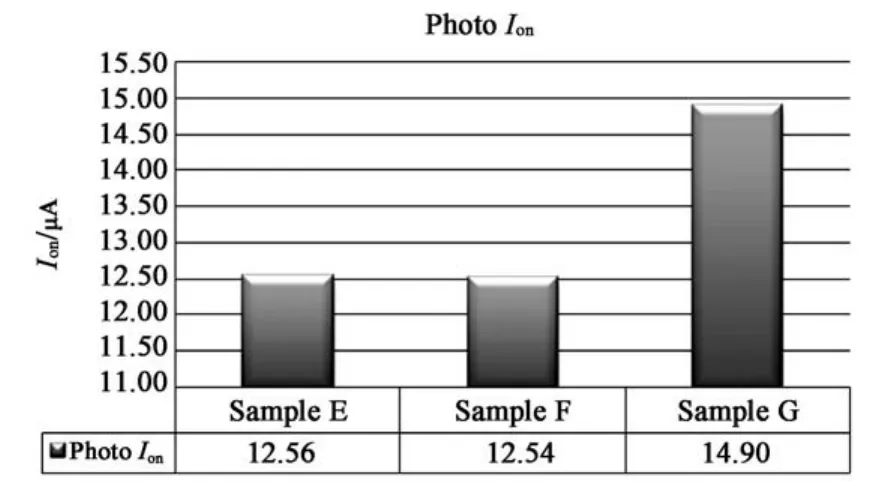
图6 样品的光照开启电流Fig.6 Photo Ionof samples

图7 样品的光照漏电流Fig.7 Photo Ioffof samples
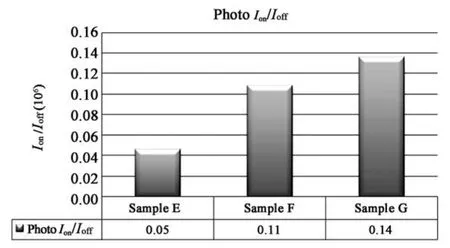
图8 样品的光照开关电流比Fig.8 Photo Ion/Ioffof samples
可见,在设备L进行过栅极绝缘层沉积的样品E和F,TFT工作开启电流Ion和迁移率都比较差.栅极绝缘层的ITO污染会导致TFT开启电流和迁移率降低.而样品E的非晶硅膜层是在ITO污染的L设备进行沉积的,样品F和G的非晶硅膜层是在未有ITO污染的M设备沉积的,所以,样品E的光照漏电流变大与非晶硅膜层的ITO污染有关.
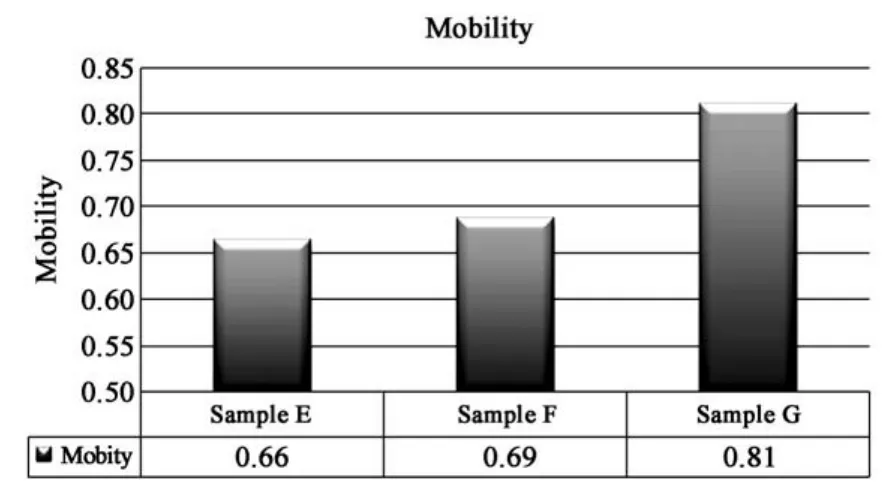
图9 样品的迁移率Fig.9 Mobility of samples
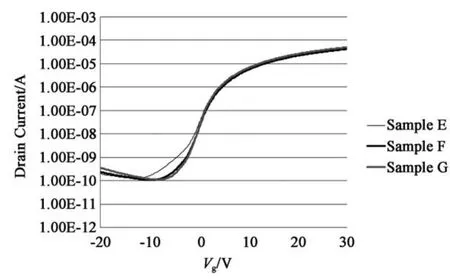
图10 样品的转移特性曲线Fig.10 TFT transfer curves of samples
图10为样品的TFT转移特性曲线.分析可知,样品F和G的亚阈特性值比样品E的数值明显陡峭,即样品F和G的亚阈值摆幅(S)基本相同,并且都比样品E的小.式(1)为亚阈值摆幅的表达式:

从a-Si TFT转移特性曲线的亚阈特征参数S可以估计界面态密度的大小,S越小,表示样品的界面态密度越小[6].所以,样品E的膜层界面态密度应该受到ITO成分的污染影响.
为进一步确定样品的电学稳定性,选择界面态密度较小的样品F和G进行长时间光照条件的栅压偏应力电学测试,测试条件为负栅压-30 V,温度50℃,光照强度为5 000 cd/m2,时间为12 h.图11~图12,分别为样品的负栅压偏应力TFT转移特性曲线.

图11 样品F的负栅压偏应力TFT转移曲线Fig.11 TFT transfer curves under gate negative bias stress of sample F
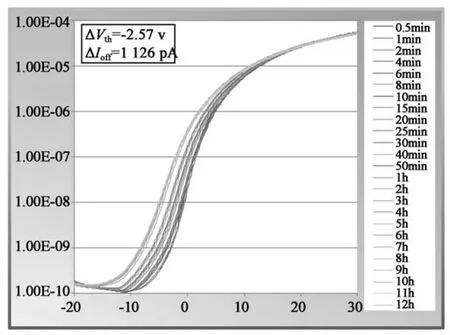
图12 样品G的负栅压偏应力TFT转移曲线Fig.12 TFT transfer curves under gate negative bias stress of sample G
测试可知,在负栅压偏应力作用下,样品F和G随着测试时间的加长,TFT转移特性曲线都向负方向移动.12 h测试后,样品F和G的阈值电压的变化量(ΔVth)分别为-4.92 V和-2.57 V,光照漏电流的变化量(ΔIoff)分别为3 880 p A和1 126 p A.可见,样品G的稳定性比较好.分析可知,ITO对栅极绝缘层的污染应该也影响着TFT阈值电压的稳定性.
4 讨论和分析
通过本文测试发现,在产品的ITO膜层上,如果通过PECVD设备沉积栅极绝缘层和非晶硅有源层,则此PECVD设备会有ITO成分的污染.若此设备使用时间较长并且不进行清洁,就会导致已经遭受ITO污染的设备中的In元素进入栅极绝缘层和非晶硅有源层,而且测试发现In元素对膜层的掺杂发生在栅极绝缘层和非晶硅有源层沉积的开始点.
分析可知,ITO的主要成分为SnO2和In2O3,其比例是1∶9.在高温等离子环境的PECVD设备,ITO膜层的成分就会被等离子轰击并溅射到PECVD腔室的上电极板.由于上电极板也是反应气体的出口位置,这样就会导致上电极板粘附的ITO成分随着反应气体一起沉积到下基板,掺杂在栅极绝缘层和非晶硅有源层.而ITO中In元素的含量比高于Sn元素,并且In元素的熔点低于Sn元素,这样就会导致栅极绝缘层和非晶硅有源层中污染的主要成分是In元素.同时,反应气体是由上电极板向下通入,在气体通入的开始时刻,反应气流变化较大.所以测试会发现栅极绝缘层和非晶硅有源层中In元素的污染峰值,对应于各层膜沉积的开始时刻.
对样品的电学性质测试分析可知,In元素对栅极绝缘层的污染会导致TFT开启电流和迁移率降低,TFT器件的稳定性也会变差.而In元素对非晶硅有源层的污染会导致TFT光照漏电流变大.这与膜层的界面态密度密切相关.In元素对栅极绝缘层和非晶硅有源层的污染,会使产品的栅极绝缘层和非晶硅膜层的界面性能变差,导致产品的电学性能降低.因而,对PECVD设备进行清洗,或者将栅极绝缘层和有源层分开在不同的PECVD设备进行沉积,可以降低ITO的成分污染,并且可以明显改善TFT的电学性能.
5 结 论
通过本文可以发现,PECVD设备如果遭受ITO膜层的污染,分解出的In元素就会再次沉积并掺杂在栅极绝缘层和非晶硅有源层,从而导致TFT开启电流和迁移率降低,TFT光照漏电流变大,TFT器件的稳定性也会变差.通过对设备进行定时清洗,或者考虑生产节拍而将栅极绝缘层和有源层分开在不同的PECVD设备进行沉积,可以改善ITO膜层成分对栅极绝缘层和非晶硅有源层的污染,提高产品的电学特性性能和提升产品的显示品质.
[1] 童林夙.2012年后的平板显示世界[J].现代显示,2007(7):6-16.
Tong L S.Flat panel displays after 2012[J].Advanced Display,2007(7):6-16.(in Chinese)
[2] 谢振宇,龙春平,邓朝勇,等.非晶硅TFT栅界面层氮化硅薄膜性能的研究[J].真空科学与技术学报,2007,27(4):341-345.
Xie Z Y,Long C P,Deng C Y,et al.Interfacial structures and properties of SiN layer in a-Si thin film transistors[J].Chinese Journal of Vacuum Science and Technology,2007,27(4):341-345.(in Chinese)
[3] 张金中,张文余,谢振宇,等.栅极绝缘层工艺优化对氢化非晶硅TFT特性的改善[J].真空科学与技术学报,2012,32(11):991-995.
Zhang J Z,Zhang W Y,Xie Z Y,et al.Growth and optimization of hydrogenated amorphous Si films for thin film transistor fabrication[J].Journal of Vacuum Science and Technology,2012,32(11):991-995.(in Chinese)
[4] Lee S H,Lee S M,Kim H Y,et al.18.1″ultra-FFS TFT-LCD with super image quality and fast response time[C].SID Symposium Digest,2001:484-487.
[5] Lee S H,Lee S L,Kim H Y,et al.Electro-optic characteristics and switching principle of a nematic liquid crystal cell controlled by fringe-field switching[J].Appl.Phys.Lett.,1998,73(20):2881-2883.
[6] 宋跃,邹雪城.a-Si TFT亚阈特征参数与有源层的厚度效应[J].固体电子学研究与进展,2004,24(1):20-25.
Song Y,Zou X C.The subthreshold characterization parameter and active layer thickness effect over a-Si TFT[J]. Research&Progress of SSE,2004,24(1):20-25.(in Chinese)
Influence of ITO contamination of TFT gate insulation& a-Si layers on electrical characteristics
WANG Shou-kun∗,YUAN Jian-feng,GUO Hui-bin,GUO Zong-jie,LI Sheng-xuan,SHAO Xi-bin
(Process Development Department,BOE Display Technology Co.Ltd.,Beijing 100176,China)
Indium-tin-oxide(ITO)films as transparent conductive are applied on TFT.This paper studied the influence of ITO contamination of gate insulation&a-Si layers and TFT on electrical characteristics.The obtained samples were characterized by secondary ion mass spectroscopy(SIMS)and electronic parameter measurement(EPM).The result shown on the gate insulation&a-Si layers had been contaminated by ITO in the PECVD equipment,and the contamination can make TFT electrical characteristics become worse.ITO concentration in process equipments plays an important role in the TFT electrical characteristics.Therefore,we suggest the gate insulation&a-Si layers should be deposited in independent equipment and the PECVD equipment should be cleaned periodically.Thus,the ITO contamination can be reduced and TFT electrical characteristics can also be improved.
TFT;PECVD;gate insulation layers;active layers;a-Si films;ITO;electrical characteristics
TN321.5
A doi:10.3788/YJYXS20153006.0930
1007-2780(2015)06-0930-07
王守坤(1982-),男,山东人,硕士研究生,高级研究员,主要从事TFT-LCD工艺的研究.E-mail:wangshoukun@boe.com.cn
2015-03-06;
2015-04-13.
∗通信联系人,E-mail:wangshoukun@boe.com.cn

