平行缝焊焊缝质量的评判
肖汉武
(无锡中微高科电子有限公司,江苏 无锡 214035)
1 引言
在微电子集成电路的高可靠气密封装中,盖板密封技术主要包括低温合金焊料熔封、平行缝焊、低温玻璃熔封、储能焊及激光焊等几种形式。其中,平行缝焊过程主要是在盖板局部产生温升,被广泛用于混合电路、微电子单片集成电路以及对温度较敏感器件的气密封装。
众所周知,平行缝焊本质上属于电阻焊,它是通过流经一组平行的铜合金滚轮电极的焊接电流在电极与盖板、盖板与焊环之间这两个高阻处产生焦耳热,当温度超过表面镀层熔点时,镀层熔化并形成合金后将盖板与焊环密封。此过程中,除了焊环、盖板表面镀层的熔化外,或多或少还存在部分盖板基体材料的熔化。由于整个封帽过程中仅在焊环处发生焊接行为,外壳整体温度并没有像其他两种盖板熔封工艺一样同步升高。通过适当的工艺参数优化,缝焊过程中外壳的温度可以很容易控制在100℃以下。因此平行缝焊通常被认为是一种局部高温、整体低温的封帽技术。
尽管如此,平行缝焊过程中,焊缝位置附近的实际温度通常都超过1 000℃,甚至高达1 600~1 700℃。因此,实际形成缝焊的过程中,在焊环与陶瓷结合部位通常会出现一个较大的温度梯度并产生一定程度的热应力,倘若工艺控制不当的话,引入的热应力会导致焊环与陶瓷之间的开裂。此外,焊接参数设置不当也会直接带来漏气问题。因此,获得一个质量良好的焊缝是平行缝焊工艺的关键。
2 平行缝焊焊缝质量评判
对于气密性封装而言,封盖质量是影响最终封装的可靠性及合格率的关键所在。与合金焊料熔封、低温玻璃熔封两种封帽工艺不同,平行缝焊所形成的焊缝宽度通常只有0.2~0.4 mm,比前两种封帽方式形成的焊缝窄很多。大量的数据显示,平行缝焊的总合格率通常低于前两种封帽工艺,其中一个很重要的原因正是因为焊缝较窄小,缝焊过程一个很小的异常将可能导致气密性不良或其他不良现象发生。因此,如何有效地对平行缝焊焊缝质量进行评判显得尤为重要。本文从气密性、焊缝外观、封盖强度、盐雾试验及盖板形变等几个方面进行讨论。
2.1 气密性
气密性是任何气密封装技术的第一要素。气密性检测又称密封试验,通常采用的是氦质谱细检漏、氟碳化合物粗检漏相结合的方法对平行缝焊气密性进行检测。
氦质谱细检漏技术通常需要将待检漏器件放置在一个具有一定压力的氦气压力罐中进行氦轰击(俗称“加压”),经过指定时间轰击后,从压力罐中取出放入氦质谱检漏仪中进行检测,整个检测过程必须在规定时间内完成。这也是高可靠混合电路、微电子单片集成电路普遍采用的气密性检测方式。氦质谱检漏有两种试验条件:试验条件A1(固定方法)及试验条件A2(灵活方法),当封装器件种类较多时,通常采用试验条件A1的固定方法,也就是根据表1中列举的固定条件进行氦加压、检测判断。
但是,在平行缝焊工艺应用最广泛的普通消费类电子器件,如声表面波器件、晶振等应用中,通常还采用了一种预封氦气的方式进行氦质谱检漏,即在平行缝焊手套箱内,通入按一定比例预先混合的氮气/氦气混合气体作为封帽气氛,在缝焊过程中,一定比例的氦气(一般是氦气体积比为10%)同时被封接在器件壳体内。倘若该器件存在气密性不良,封接在壳体内的氦气将会从漏孔处逸出进入氦质谱检漏仪而被探测。
这种方法的最大优点是可以省略氦气压力罐中的轰击时间,从而大大缩短生产效率。缺点则是必须在完成缝焊后的规定时间内完成所有器件的氦气检漏过程。若无法完成所有器件的检漏,必须重新采用常规的氦气压力罐对未及时完成检漏的器件进行氦气轰击,然后进行氦检漏,否则有可能造成个别气密性不良器件的漏检。

表1 氦质谱检漏试验条件A1的固定条件
氟碳化合物粗检漏技术是将先行经过氦质谱检漏后的器件置于真空/压力罐中,对压力罐抽真空至压力小于或等于0.7 kPa,保持至少30 min后,在不破坏真空的前提下注入Ⅰ型检测用液体(低温氟碳化合物)覆盖待检测器件。然后按照表2的条件对压力罐进行加压。加压结束去除压力,将器件从液体中取出,在空气中干燥2±1 min,然后浸入125±5 ℃的Ⅱ型指示液体中,经放大镜观察器件中是否有气泡冒出。若观察到从同一位置出来一串明显气泡或两个以上大气泡则视该器件气密性失效。

表2 氟碳化合物粗检漏加压条件
氦质谱检漏是一种定量的气密性检测方法,利用它可以准确地测试某个器件的漏率水平,当测量到某个器件漏率大于5.0×10-3Pa·cm3·s-1时,通常还无法定位漏气部位所在。
虽然氟碳化合物粗检漏可以确定漏气部位,但也只能筛选漏率大于或等于1 Pa·cm3·s-1的较大漏孔,对于10-3Pa·cm3·s-1数量级的漏孔无能为力。平行缝焊器件的气密性不良中,因焊缝密封不良占的比例相对较大,针对这种漏气器件,通常可藉助焊缝外观检查、开盖等方法来判断漏气部位。而对于一些焊缝外观正常、漏率较为临界的器件,可通过特别的吸氦法来定位漏孔。
对于平行缝焊器件而言,除了在完成缝焊后直接进行气密性检测外,更重要的是需要进行缝焊器件在环境试验、机械试验等系列试验后的气密性检测。这也是由平行缝焊工艺本身特点所决定的。平行缝焊过程对于器件、外壳本身不会带来较大的温升,但封接过程中盖板表面温度通常都超过1 000 ℃,在焊环与陶瓷结合部位会存在一个较大的温度梯度并产生一定程度的热应力,倘若工艺控制不当的话,缝焊过程中的残余应力在后续的温度循环、热冲击、机械冲击、恒定加速度试验中有可能叠加,当叠加后应力接近或超过焊环、陶瓷间的结合强度甚至陶瓷本身的断裂强度时,会导致焊环与陶瓷之间结合处的开裂甚至瓷体炸裂现象。这一点与低温合金焊料熔封及低温玻璃熔封两种盖板封帽技术不甚相同,后两种封帽技术都是整体同步加热,封帽过程中的残余热应力低很多,相对于平行缝焊封帽,其在可靠性试验后的气密性检测中的失效比例也低很多,这也是平行缝焊工艺中需要特别关注的问题。
此外,平行缝焊器件在环境试验、机械试验后的气密性检测还可以剔除因盖板材料或制造过程中的缺陷而形成的微小孔隙(砂眼)导致的漏气现象。这种缺陷在完成封帽的早期通常不会出现问题,但在后续的电路测试、筛选及机械试验过程中,由于热应力及机械应力的作用,微小孔隙或裂纹有可能因扩散而变大,最终演变成漏孔。
另外,在环境试验中的盐雾试验之后进行的气密性检测,可以评估平行缝焊器件经盐雾气氛的加速腐蚀后的密封完好性,即便是盐雾试验后合格的器件也有可能因为局部腐蚀严重而出现漏气。
2.2 焊缝外观
平行缝焊的焊缝是由几十甚至上百个连续的焊点组合而成,为保证焊缝的密封性,焊点必须相互重叠,重叠部分控制在30%~50%通常可以保证焊缝的连续,如图1所示。当重叠过少,焊缝中出现断点而导致漏气;重叠过多,焊缝本身没有问题,但总的焊点数会增多,而每一个焊点的形成都是一个高温过程,倘若焊接时间不变,高温过程越多,引入的热应力越大,对外壳的热冲击也越大,出现焊环、瓷体间结合处开裂甚至瓷体炸裂的可能性自然也会增大。重叠过多还会增加基体金属的暴露机会,过多的基体材料的暴露会加深盐雾试验中的腐蚀,严重者甚至还会出现焊缝锈蚀穿孔,并直接导致后续密封试验中的失效。因此,在工艺设计阶段,必须仔细考量焊点的重叠量。
平行缝焊中几个关键的工艺参数主要包括焊接功率(焊接电流)、脉冲宽度、脉冲占空比、电极滚动速度及电极压力,这5个因素是平行缝焊的主要焊接参数,其中前4个参数最为关键。当然,由于平行缝焊机设备间的差异,4个参数的名称都有所不同。目前,国内各单位使用的基本上是美国SSEC和日本AVIO两家公司的两类平行缝焊机,本文暂以SSEC 的2400型号为例进行讨论。
SSEC 2400平行缝焊机的4个关键焊接参数分别是:P(功率)、PW(脉宽)、PRT(脉冲重复时间)及S(焊接速度),相邻两个焊点之间的距离L1可以通过以下公式计算:


图1 理想的焊缝重叠
单个焊点的长度或宽度与焊接能量(参数组合)、盖板、外壳、电极甚至工装夹具相关,对其进行准确计算很困难,但是可以通过仿真计算获得一个近似的数据。一个简便的方式是在焊接参数中设定焊接距离等于L1,即只形成一个焊点,然后通过测量显微镜即可确定单个焊点的长度或宽度值。
假定两个相邻焊点的重叠量为X,单个焊点长度为W,相邻焊点间距离L1,可以计算出重叠量X与L1、W之间的关系,即:X=1-L1/W。
不同类型的外壳,允许的焊点重叠量可以不同。对于尺寸较大的金属外壳,较大的焊点重叠量并不会引入更大的热应力,因为整体金属结构有利于热量的传递。而对于陶瓷外壳,焊环是通过银铜焊料钎焊在陶瓷基体上,通常陶瓷外壳材料为氧化铝,焊环材料为柯伐合金,室温下二者的热导率、热膨胀系数相差并不大,前者分别为18 W(m·k)-1和5.69×10-6K-1,后者分别为19 W(m·k)-1和6.2×10-6K-1,但随着温度的升高,二者的差距逐渐加大,图2、图3分别为不同材料热导率、热膨胀系数随温度的变化关系。从图3可以看出,氧化铝陶瓷的热导率表现为负温度系数,也就是说,当温度升高时,陶瓷本身的导热性能变差。因此,当焊点重叠量加大时,所产生的过多热量并不能够快速扩散,因此焊环处的温度会变得更高,加上柯伐焊环的热膨胀系数随温度升高变得更大,结果过多的焊点重叠量导致更大的热应力残留。其最严重的结果是封接器件在后续应用、经历环境试验及机械试验后的各个阶段出现焊环与瓷体结合处开裂而导致的漏气,甚至出现瓷体炸裂现象。

图2 几种常用金属与陶瓷的热膨胀系数

图3 不同材料的热导率与温度的关系
焊点的重叠程度通过在器件Z方向也就是盖板表面方向的目检可以非常直观、明了地观测及测量,但是获得良好的焊点重叠并不一定意味着焊缝是可靠的。
一个可靠的焊缝还必须在盖板与焊环的连接部位形成一个连续的粘接层,也就是说,在盖板的侧壁与焊环连接部位有明显的熔融层存在,这正是平行缝焊焊缝质量的关键所在。因为此区域是平行缝焊外壳的密封区外侧,该区域的密封状况直接决定了密封性能的好坏,此位置若能形成一个完全连续的熔融层,表明焊缝处镀层熔化较好,如图4所示。
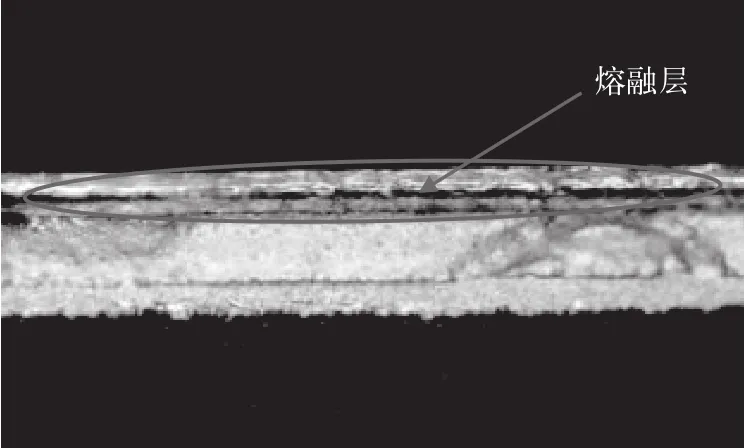
图4 侧壁可见连续的熔融层
该熔融层是由盖板及焊环表面镀层的熔化形成的,熔融层越厚说明熔融越充分,理论上,封接强度也越高。但是,过厚的熔融层意味着焊点表面更高的焊接温度,图5揭示了焊点形成时沿着外壳纵深方向的温度分布趋势。显然,电极与盖板接触处温度越高,镀层熔化越充分,沿着外壳纵深方向的热影响也越大,焊环与陶瓷结合处的残余应力也就越大。过大的应力对于器件的可靠性显然是不利的。并且过高的温度还会带来更多基体材料的暴露,对焊缝的抗蚀也是不利的。
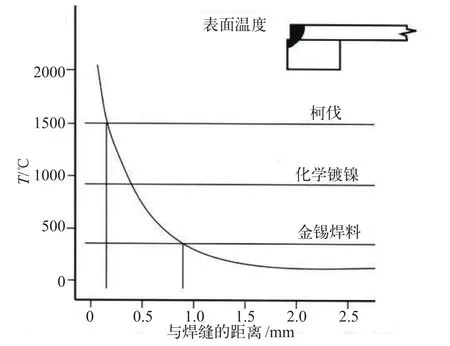
图5 焊缝附近的温度分布趋势
当采用化学镀Ni盖板时,由于镀Ni层中含有8%~12% 的P,P的掺入提高了盖板的抗蚀性能,但Ni层的脆性会变大。当焊接温度过高时,会促进热裂纹的产生,反而对气密性不利。
因此当观测到侧壁熔融层过厚,甚至出现熔融层鼓起、气泡等现象时,说明焊接参数过盈,需要进行适当调整。导致熔融层鼓起、气泡的原因主要是盖板基材及镀层中的气体释放,同时还与焊环或盖板的表面洁净度有关,尤其是焊接区附着的一些有机颗粒物,会在焊接高温下发生炭化、气化而导致熔融层的异物、鼓起、气泡等现象。根据生产经验,熔融层厚度控制在盖板厚度的1/3~2/3时较为合适,如图6所示。
当然,如果仅仅是对外壳进行评价,采用过盈的焊接参数可以对外壳的整体质量尤其是焊环的钎焊质量进行摸底,以评估在最苛刻条件下焊环与陶瓷间的结合强度。

图6 侧壁熔融层厚度控制要求
此外,通过焊点的形状亦可对焊缝性能进行基本的判断。图7、图8代表两种不同形貌的焊点,其中图7中的焊点呈近似圆形,而图8中的焊点则呈沿着焊缝方向的扁长椭圆形。显然,由沿着焊缝方向的扁长椭圆形的焊点组成的焊缝其宽度相对圆形焊点要窄,在相同焊缝长度和焊点重叠量下,总的焊点数也相对较少。因此其总的焊接能量降低,对外壳的热冲击也随之减少。
焊点的形状可以近似用单个焊点长度W来表征,W值越大,焊点形状越扁长。如前所述,W值的大小与焊接速度、电极锥度及电极压力等相关,在相同的焊接功率、脉宽、脉冲重复时间条件下,焊接速度越快越容易形成沿着焊缝方向的扁长椭圆形焊点,而当电极锥度过小、电极压力变大以及焊接速度较小时,焊点形状更圆甚至变为沿着垂直于焊缝方向的扁长椭圆形。
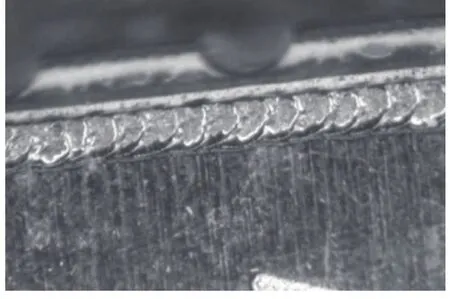
图7 近似圆形焊点
只要工艺参数控制得当,两种形状的焊点均可获得能满足使用要求的密封质量。在保证气密性及封盖强度的前提下,若能形成沿着焊缝方向的扁长椭圆形焊点对封装的可靠性更有利。

图8 椭圆形焊点
封接过程中的电极打火是平行缝焊封帽工艺中一个常见的问题。最常见的打火多发生在盖板拐角处,在焊点表面形成烧蚀浅坑,严重时甚至烧穿盖板。也有一些打火是发生在焊接中间部位,其原因包括焊环及盖板平整度较差、盖板制作过程中的切割多元物(包括毛刺)、电极上的飞溅物等。轻微打火除了影响焊缝外观外,对焊缝质量影响较小,而严重打火通常会引起盖板基体材料的熔化和暴露,将会降低焊缝的抗蚀能力。因此在实际生产过程中,严重打火器件通常予以剔除。
拐角处打火的主要原因是滚轮电极从焊环、盖板表面上升或下降时不同步,存在后上或先下现象。可以通过优化工夹具设计、设置合理的焊接长度及延时距离等途径来加以改善。此外,优化平行缝焊机的焊接电源也可大大降低打火的发生。平行缝焊的焊接电源一般为1 kHz的直流方波脉冲电流,当电极在焊环、盖板表面上升或下降时,焊接功率(焊接电流)通常是保持恒定的,而某些焊接电源如AVIO公司的新型焊接电源则可实现多段电流下降功能,即在上升或下降阶段的焊接电流均可进行控制,尤其是在下降阶段还可以分四段下降。实践证明,当上升及下降阶段焊接电流降至正常焊接电流的60%左右时,打火现象可以得到有效的抑制,同时还可以改善正常封接中角部位置因重叠过密所带来的焊点颜色加深的现象。
正常的焊缝表面光亮,呈银白色,当观察到焊点颜色黯灰甚至变色等情形时,说明焊接总能量过大或者平行缝焊机手套箱内氮气气氛中的H2O、O2含量偏高;而焊点表面的黄色亮点则是由于铜合金电极中的少量铜粘连在焊缝表面的缘故。通过适当降低焊接功率、减少焊点重叠量、控制手套箱内气氛以及加强滚轮电极管理等途径,可以改善焊缝变色问题。
2.3 封盖强度
平行缝焊通常是两种相同材料(焊环、盖板均为柯伐材料)或同类材料(柯伐焊环、铁镍盖板)之间的熔焊,通过两个结合面表面镀层的熔化及Au与Ni镀层的合金化来实现两种材料的焊接。焊缝形成时的局部温度超过1 000 ℃,很难避免部分基底金属的熔化,由于存在这种母材之间的结合,平行缝焊封盖的理论结合强度是很高的,因此人们对平行缝焊后的盖板封接强度一般不做特别测试。
然而,当外壳及盖板镀层制造工艺出现异常波动时,缝焊强度会出现明显下降甚至出现盖板自然脱落的零强度现象。
从工艺控制的角度而言,平行缝焊工序的所有关键参数及其有效性均应处于受控状态。虽然平行缝焊器件的气密性检测为平行缝焊工序的必须筛选检查项目,但平行缝焊工艺的另一个重要的有效性指标即封盖强度通常并没有得到有效的监控,即便在GJB548B-2005标准中也没有相应的评价方法。我们认为,有必要在实际工艺过程中对封盖强度进行周期性监测,尤其是在外壳、盖板的入厂检验阶段,这将有利于及时发现外壳、盖板制造工艺中的异常,并促使外壳或盖板制造商进行改进。否则,有可能导致封装生产过程中的批次性异常。
正常情况下的平行缝焊盖板封接强度很高,由于盖板厚度太薄,常规的剪切强度测试方法无法适用,拉力强度测试方法同样也不适用。一个行之有效的方法是通过专用工具在盖板中间位置穿孔,然后将穿孔扩大,再用小型钳具将盖板沿着焊缝方向进行撕扯,盖板扯离后在焊环外侧边缘留下熔焊痕迹,如图9、图10、图11及图12,观察熔焊痕迹可以推测实际的焊接强度。

图9 焊缝熔焊痕迹1

图10 焊缝熔焊痕迹2

图11 焊缝熔焊痕迹3

图12 焊缝熔焊痕迹4
图10~图12 代表了3种不同的焊缝熔化痕迹,其中图10中的熔化痕迹均匀连续,熔化区域集中在焊缝最外侧,向内部延伸较少;而图11中的熔化痕迹尽管也是连续的,但熔化区域较宽,且中间出现空隙;图12中则几乎看不到熔化痕迹。很显然,图12中的样品焊缝强度是3者之中最低的,虽然在完成封帽后的气密性检测中是合格的,但在后续可靠性试验中存在较大的漏气风险。
通过开盖后的焊缝熔化痕迹的观察,我们可以判断封接工艺是否正常、外壳或盖板镀层是否存在异常,并据此进行调整和改进。
2.4 盐雾试验
盐雾试验是为模拟潮湿、多盐分的海洋环境对器件的影响所设计的一种加速腐蚀试验,其试验目的是评估封装器件镀涂层的质量。对于采用平行缝焊和合金焊料熔封两种气密封帽技术的封装器件而言,由于使用的均为具有表面保护镀层的铁基合金盖板,在沿海地区或船舶、舰艇等使用环境下,大气中的盐雾成分较高,倘若盖板表面保护镀层异常,盐雾容易形成对铁基合金盖板的侵蚀和电解腐蚀,导致盖板表面甚至基体生锈,严重者还会造成焊缝处盖板基材的锈蚀穿孔以致漏气,因此,盐雾试验是除气密性之外的另一个关键考核项目。
平行缝焊所使用的盖板材料通常有柯伐4J29和4J42合金两种,这两种盖板均为铁基合金材料。常见的平行缝焊盖板主要有镀Ni盖板和镀Au盖板两种镀层结构。对于前者,由于电镀Ni的熔点在1 450℃,熔点过高,通常不会使用;而含P量在8%~12%的化学镀Ni的熔点在880℃左右,为尽量降低平行缝焊的焊接温度,镀Ni盖板主要采用化学镀Ni工艺。而对于后者,一般采用电镀工艺的单层Ni/Au结构。由于平行缝焊过程中很难避免盖板基体材料的暴露,在完成焊接后,焊缝表面或多或少存在Fe元素。这也是平行缝焊器件在盐雾试验中焊缝处容易出现腐蚀的根源。
虽然使用镀Au盖板可以增强盖板的整体抗蚀能力,但在平行缝焊焊缝处的抗盐雾能力却并没有得到改善,反而多数情况下变得更差。这是因为Au与Fe元素的电位差比Ni与Fe元素的电位差更大,由于盐雾反应本质上是一种电池反应,电位差越大,反应程度越大。出现这种情况的原因可能是目前所广泛使用的镀Au盖板多为单层Ni/Au结构,而采用电镀方法获得的镀层结构致密性逊于化学镀层,单层Ni/Au结构很难避免焊接过程中基体材料中Fe元素的暴露。据报道,采用Ni/Au/Ni/Au复合镀层结构的平行缝焊盖板可顺利通过盐雾试验的考核。
根据GJB548B-2005标准的要求,在盐雾试验中须进行测量的封装腐蚀缺陷包括凹坑、气泡、起皮和腐蚀生成物,对于已封装器件,其腐蚀缺陷总面积应小于或等于除引线外的任何封装零件(例如盖板、管帽或外壳)镀涂或底金属面积的5%;而对于封装前的盖板及外壳原材料的来料检查过程中的盐雾试验,要求盖板腐蚀缺陷总面积应小于或等于盖板镀涂面积或底金属面积的1%,要求外壳腐蚀缺陷总面积应或小于或等于除引线以外其他任何部位镀涂面积或底金属面积的2.5%。
实际操作中,腐蚀缺陷总面积通常是采用估算的方法进行判断,通过与一个标准的计算腐蚀面积的卡片进行比较,得出一个估算值,再将该估算值与标准值比较,最终评判是否符合标准要求。
事实上,平行缝焊器件在盐雾试验中的失效情况较为普遍,这也是国内同行中普遍存在的一个长期未能得到很好解决的难题。
2.5 盖板形变
平行缝焊器件在完成焊接后,常常可观察到盖板表面中间凸起现象,这与合金焊料盖板封帽后盖板中间凹陷现象正好相反,后者主要是熔封后的器件腔体内部存在负压的缘故。
由于平行缝焊盖板的厚度(焊接边缘厚度)通常为0.08~0.12 mm,如此薄的金属盖板很容易发生形变。焊接过程中,随着电极的滚焊,盖板两个平行边被固定在焊环表面,焊接时产生的高温使得盖板快速加热而发生膨胀,加上两个电极的侧向挤压作用,于是膨胀的盖板在中间位置向外凸起。盖板凸起现象在扁平结构盖板中尤为明显,且盖板尺寸越大凸起越明显。在器件进行恒定加速度、机械冲击等机械试验中,当盖板朝向与试验过程中所施加的加速度方向相反且加速度足够大时,受向心力的作用盖板中间则有可能出现凹陷现象。
平行缝焊盖板的两种形变主要影响封装外观,即便出现盖板凹陷,如果封装设计中在盖板与键合引线之间预留了足够的距离,不会造成盖板与引线的短路问题,对封帽质量无不良影响。
3 结束语
关于平行缝焊焊缝质量的评判,目前尚无一个统一的规范,本文结合实际生产中的经验,从气密性检测、焊缝外观、封盖强度、盐雾试验及盖板形变等几个方面对其进行了初步的探讨。由于作者水平有限,文章中难免有疏漏之处,希望更多专家同行能就相关问题进行更深入的研究和交流。
[1] SSEC M2400e Operating Manual.
[2] 中华人民共和国国家军用标准. GJB548B-2005微电子器件试验方法和程序[S].
[3] 邹茉莲. 焊接理论及工艺基础[M]. 北京:北京航空航天大学出版社, 1994.
[4] 《电子工业生产技术手册》编委会. 电子工业生产技术手册7:半导体与集成电路卷[M]. 北京:国防工业出版社, 1991.
[5] 《电子封装技术丛书》编委会. 集成电路封装试验手册[M]. 北京:电子工业出版社, 1998.
[6] 李茂松,等. 平行缝焊工艺抗盐雾腐蚀技术研究[J]. 微电子学,2011,6:465-469.

