质子辐射环境下PNP输入双极运算放大器辐照效应与退火特性
质子辐射环境下PNP输入双极运算放大器辐照效应与退火特性
姜柯1,2,3,陆妩1,2,*,马武英1,2,3,郭旗1,2,
何承发1,2,王信1,2,3,曾俊哲1,2,3,刘默涵1,2
(1.中国科学院 特殊环境功能材料与器件重点实验室,新疆 乌鲁木齐830011;
2.中国科学院 新疆理化技术研究所 新疆电子信息材料与器件重点实验室,新疆 乌鲁木齐830011;
3.中国科学院大学,北京100049)
摘要:对不同偏置下的PNP输入双极运算放大器在3、10 MeV两种质子能量下的辐照效应进行了研究,并将质子辐射损伤效应与0.5 Gy(Si)/s剂量率60Co γ射线辐射损伤效应进行了比较,以探究质子和γ射线产生的辐射损伤之间的对应关系。结果表明,运放LM837对γ射线的敏感程度较10 MeV质子和3 MeV质子的小,然而其室温退火后的后损伤效应却更严重;相同等效总剂量条件下,10 MeV质子造成的损伤较3 MeV质子的高;质子辐射中器件的偏置条件对损伤影响不大。
关键词:PNP输入双极运算放大器;质子辐射;60Co γ射线辐射;辐射效应
中图分类号:TN321.8;TN431 文献标志码:A
收稿日期:2014-07-15;修回日期:2014-11-20
作者简介:姜柯(1988—),男,黑龙江牡丹江人,硕士研究生,微电子学与固体电子学专业
doi:10.7538/yzk.2015.49.11.2087
*通信作者:陆妩,E-mail: luwu@ms.xjb.ac.cn
Irradiation Effect and Annealing Character of PNP Input Bipolar
Operational Amplifier in Proton Radiation Environment
JIANG Ke1,2,3, LU Wu1,2,*, MA Wu-ying1,2,3, GUO Qi1,2, HE Cheng-fa1,2,
WANG Xin1,2,3, ZENG Jun-zhe1,2,3, LIU Mo-han1,2
(1.KeyLaboratoryofFunctionalMaterialsandDevicesforSpecialEnvironments,
ChineseAcademyofSciences,Urumqi830011,China;
2.XinjiangKeyLaboratoryofElectronicInformationMaterialsandDevices,
XinjiangTechnicalInstituteofPhysics&Chemistry,ChineseAcademyofSciences,
Urumqi830011,China; 3.UniversityofChineseAcademyofSciences,Beijing100049,China)
Abstract:The PNP input bipolar operational amplifiers were irradiated with 60Co γ rays, 3 MeV protons and 10 MeV protons respectively at different biases to determine the correlation of the radiation damage induced by γ rays and protons. The comparison of protons with 60Co γ rays shows that the proton radiation can induce both displacement and ionization damage, and 10 MeV protons can induce more damage than 3 MeV protons under the same absorbed dose. The biases have little effect on the proton radiation damage.
Key words:PNP input bipolar operational amplifier; proton radiation;60Co γ rays radiation; radiation effect
卫星和其他飞行在近地轨道(低于3.8倍地球半径的轨道)的航天器对被地球磁场俘获的高通量质子流极其敏感,双极型集成电路则更易因此而产生辐照损伤。在双极型集成电路中,这些粒子产生的损伤会同时引起体复合(主要由位移损伤引起)与表面复合(主要由电离损伤引起),这将导致电流增益的退化。辐射效应的大小与入射粒子的能量、种类和强度均有密切关系。因此,深入了解运算放大器(简称运放)这种基本线性电路在各辐射条件下性能的变化规律和损伤特性,对系统评价运放电路的抗辐照水平,特别是研究各粒子对运放的辐射损伤等效性及其微观机制,具有非常重要的意义。
近年来,国内外对双极运放进行了较多研究[1-3],但其使用的实验室模拟辐射源大多为电离辐射源(如X射线和60Co γ射线),较少采用质子辐射源。由于空间环境中造成辐射损伤的粒子主要为质子和电子,质子产生的辐射损伤与γ射线产生的损伤有何不同以及如何建立二者之间的等效关系等有待研究。为此,本文选用PNP输入双极运算放大器,在正偏置和零偏置两种状态下,分别进行3、10 MeV质子辐射实验和美军标剂量率范围内60Co γ射线辐射实验,以研究运算放大器在不同射线下的辐照损伤效应。
1实验样品和实验方法
实验采用相同厂家、批次的PNP输入级运算放大器LM837作为实验对象,LM837是专为低噪声应用而设计的四运放放大器,具有速度高、带宽宽等特点,其原理图如图1所示。

图1 LM837运放原理图 Fig.1 Schematic diagram of LM837 operational amplifier
质子辐射实验在北京大学重离子物理研究所的2×6 MeV EN串列静电加速器上进行,质子能量分别为3 MeV和10 MeV,注量率为5×107cm-2·s-1,射线垂直入射样品,质子辐射实验样品均将顶盖去除,以消除封装造成的能量损失,每组实验样品中包含1个未开盖的器件,以对比分析封装对质子辐射的阻挡能力。

(1)
式中:φ为质子的注量率;dE/dx为不同能量的质子在Si中的电子阻止本领,MeV·cm-2·g-1。
60Co γ射线辐射实验在中国科学院新疆理化技术研究所的60Co γ射线源上进行,辐射剂量率为0.5 Gy(Si)/s,累积总剂量为2 kGy(Si)。实验中,钴源用国家计量标准的剂量计进行标定。
正偏置状态下运放的电源电压为±10 V,负端输入连接输出形成反馈状态,零偏置的所有管脚接地。运放的参数采用高精度Tektronix577曲线示踪仪进行测试。测量参数包括失调电压Vio、正负输入偏置电流±Ib、共模抑制比CMRR、开环增益AVO、电源电压抑制比±PSRR以及正负电源电流±Iss。辐射实验及其参数的测量均在室温下进行,每次参数的测试均在辐射实验后20 min内完成。辐射结束后,保持与辐射时相同的偏置状态,对不同辐射源辐射的运放电路进行长时间的室温退火和125 ℃的高温退火实验。
2实验结果
测试过程中发现,未开盖的实验器件均无任何变化,说明10 MeV以下的质子无法穿透芯片封装。开盖器件的大部分参数会在辐照过程中发生不同程度的变化,而运放的正负输入偏置电流±Ib则是所有参数中最敏感的。图2为零偏置状态下的LM837在质子和γ射线辐射环境中输入偏置电流变化ΔIb随累积总剂量、室温退火时间和125 ℃环境下退火时间的变化。由图2可看出,零偏置时,10 MeV质子产生的损伤较3 MeV质子的大,而在等效累积总剂量下,60Co γ射线导致的ΔIb的增加小于3 MeV和10 MeV质子的。在随后的室温退火过程中,ΔIb不但未减小,还表现出后损伤现象,即ΔIb随退火时间的增加而增加,60Co γ射线辐射后的室温退火产生的后损伤现象更严重。退火一定时间后,ΔIb出现恢复的趋势。在125 ℃高温退火时,ΔIb在最初一段时间出现很快的退火现象,随后其退火程度趋于缓慢,60Co γ射线照射的器件高温退火程度最大,其次为10 MeV质子照射的器件,3 MeV质子照射的器件高温退火最缓慢。
图3为正偏置状态下的LM837在质子和γ射线环境中ΔIb随累积总剂量、室温退火时间和125 ℃高温退火时间的变化,正偏置状态下表现出了与零偏置状态下相同的响应规律,即等效累积总剂量下60Co γ射线导致的ΔIb的增加小于3 MeV和10 MeV质子的,3 MeV质子产生的损伤较10 MeV的小;室温退火时器件均出现了后损伤现象,60Co γ射线照射的器件后损伤现象最严重。且在125 ℃高温退火时,ΔIb变化规律与零偏置辐照时基本一致。
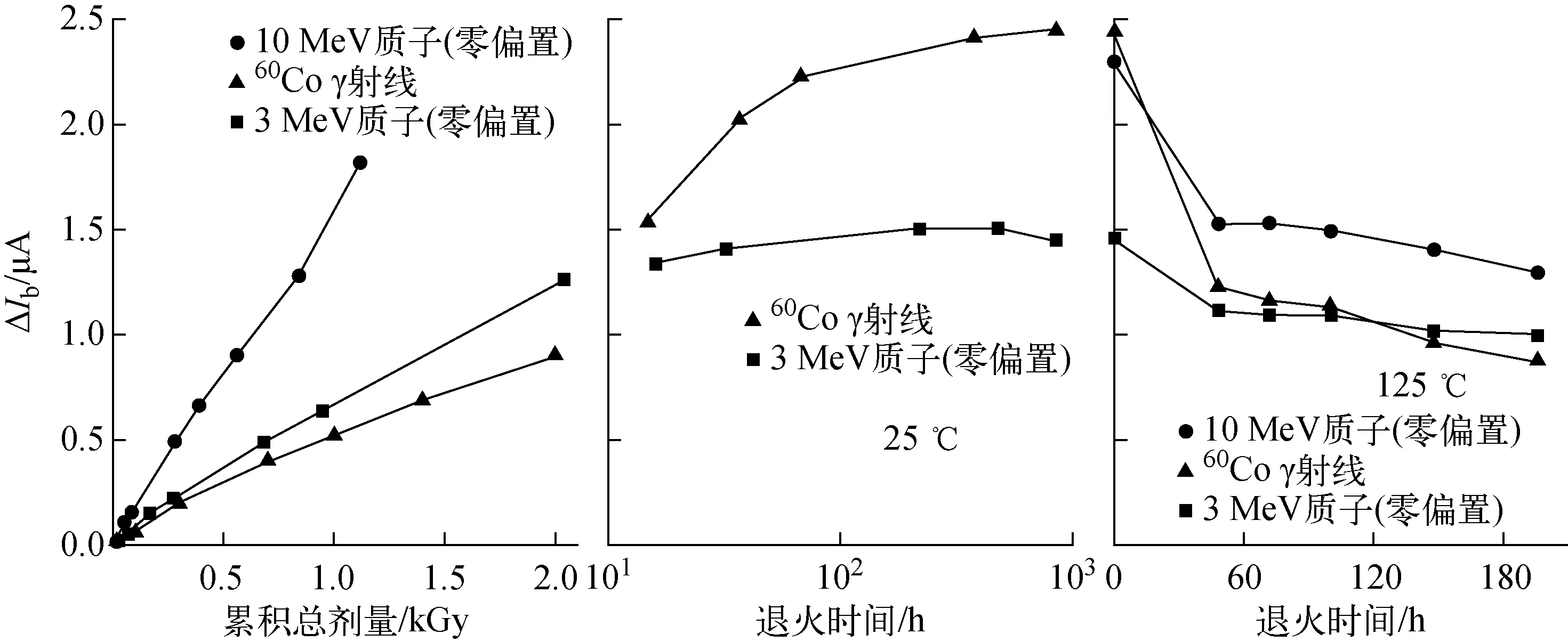
图2 零偏置状态下LM837运放的质子和 60Co γ射线辐照效应及退火效应 Fig.2 Irradiation and annealing effects of protons and 60Co γ rays for zero-biased LM837 operational amplifier

图3 正偏置状态下LM837运放的质子和 60Co γ射线辐照效应及退火效应 Fig.3 Irradiation and annealing effects of protons and 60Co γ rays for forward-biased LM837 operational amplifier
3讨论与分析
从以上的实验结果可看出,60Co γ射线及10 MeV和3 MeV质子辐射均会使LM837运算放大器电路的ΔIb发生明显变化,而质子辐射样品损伤的敏感度则大于60Co γ射线辐射。这种差异是由两种辐射源产生的辐射损伤效应不同产生的。
3.160Co γ射线对PNP输入级运算放大器的影响
在60Co γ源辐射下,γ射线对双极运算放大器造成的电离损伤表现为双极晶体管增益的下降,电路性能的退化。对于LM837运算放大器电路,辐射引起其偏置电流的增大,主要是由于电离辐射导致其输入级PNP晶体管钝化基区表面复合电流Ibsr的增加使基极电流增大所致。
Schmidt等[4]通过研究发现,PNP晶体管Ib的增长与电离辐射总剂量之间并不呈线性关系,而是呈亚线性关系,辐射产生的氧化物电荷则是导致这一现象的原因。因为对PNP三极管而言,在Si-SiO2界面感生的界面态会导致表面复合速度的增加,而基区表面复合电流与复合速率S0呈正比关系。但辐射感生的正氧化物电荷积累n型基区,改变了表面的载流子密度,抑制了表面复合,导致复合电流的减小。根据间接复合统计学理论(SRH),正向偏置的PNP型晶体管中,表面复合电流Ibsr、复合速率S0和氧化物电荷密度之间的关系大致可表示为:
(2)
其中:q为电子电量;AB为基极表面积;ns与ps分别为基极表面的电子与空穴浓度,为氧化物陷阱电荷密度NOX的函数。等式假设所有的界面陷阱的能级均在禁带中央。
3.2质子辐射对PNP输入级运算放大器的影响
双极晶体管对质子辐射很敏感,在质子辐射下,其发射极直流增益Ic/Ib(即hfe)随入射质子通量的衰减满足如下关系式[5]:
(3)
式中:hfe0、hfe分别为辐射前、后器件的电流增益;K为复合位移损伤因子,其值依赖于特定的粒子能量;Φ为入射粒子通量。由式(3)可知,器件的电流增益随质子通量的增大而减小。
研究[6]发现,质子辐射可使三极管中产生界面陷阱电荷、氧化物陷阱电荷和体缺陷,从而增加双极器件中载流子复合的几率,这些复合主要发生在基射结耗尽层和中性基区。掺杂浓度较低的发射极也会增加载流子复合的概率,导致输入偏置电流Ib增加。界面陷阱电荷会增加表面复合的速率,促进载流子复合,氧化物电荷的作用则与器件类型有关,对NPN型晶体管而言,氧化物陷阱电荷会促进载流子的表面复合,在PNP型晶体管中氧化物陷阱电荷则会对载流子表面复合起抑制作用,位移损伤引入的体缺陷则会增加载流子的体复合。
对只产生位移损伤的射线而言,体复合导致的Ib的减小主要发生在基区内部,基区内部复合电流Ib,bulk和少子寿命τ之间的函数关系[6]可大致表示为:
(4)
其中:VB为基区的体积;nb和pb分别为基区内电子和空穴密度。
然而在质子辐射实验中,输入偏置电流并不能用式(2)与(4)的加和表示,因为这两个公式并未考虑氧化物电荷对基区体复合的影响。质子辐射产生的氧化物陷阱电荷不仅影响表面复合的速率,也影响体复合的速率。考虑氧化物陷阱电荷对体复合的影响后,式(4)可改为:
(5)
与表面复合的模型相似,氧化物陷阱电荷会使界面附近的多子(电子)的密度增大,从而抑制体复合电流的增加。因此式(2)与(5)之和可更精确地估计质子辐射导致的PNP晶体管基极复合电流的退化[6]。
从实验结果可看出,LM837双极输入运算放大器在质子辐射与60Co γ射线辐射下的损伤结果有明显差别。60Co γ射线导致双极器件退化的原因是其与硅材料相互作用产生界面态和氧化物陷阱电荷,从而增加了表面复合速率S0,导致电路性能的退化。双极运放对质子辐射敏感,是因为质子辐射会同时产生界面陷阱、氧化物陷阱和体缺陷,从而影响运放性能[6-7]。实验结果中,运放LM837对γ射线的敏感程度小于10 MeV质子和3 MeV质子,是因为位移损伤和电离损伤共同作用产生的效果大于γ射线。研究表明,对于能量低于12 MeV的质子,等效累积总剂量下,质子的能量越高,其产生的电离损伤越大[8-9],因此,10 MeV质子产生的电离损伤较3 MeV质子的大。虽然相同注量下3 MeV质子产生的位移损伤较10 MeV质子的大,但由于3 MeV质子的电子阻止本领(84.86 MeV·cm-2·g-1)大于10 MeV质子的(34.79 MeV·cm-2·g-1),在换算为相同等效剂量后两种质子产生的位移损伤相差很小,这使器件在叠加位移损伤后,10 MeV质子产生的总体损伤也较3 MeV质子的大。
3.3PNP输入级运算放大器辐照后的退火特性分析
在图2、3所示的室温退火特性曲线中,辐照后的样品电参数不但未恢复,反而表现出一定程度的后损伤效应。室温下退火之所以会产生后损伤效应,是由于电离辐射会在双极晶体管基-射结上的隔离氧化物中产生氧化物陷阱电荷,这些正电荷会在氧化物中形成空间电场,阻碍后续产生的空穴输运到界面,并与界面处的Si—H钝化键发生反应形成缺陷,但在退火阶段,由于辐射产生的电子-空穴对不再增加,且辐射感生的氧化物电荷在室温下较易退火,由其形成的空间电场逐渐减弱,使辐射感生的空穴和H+具有足够的概率输运到Si-SiO2界面参与形成界面态。所以,在退火阶段器件表现出了明显的后损伤效应[10]。实验结果中,运放LM837对γ射线的敏感程度小于10 MeV质子和3 MeV质子,然而其退火后的后损伤效应却更严重。有研究表明,能量低于12 MeV的质子产生的电离损伤小于同等剂量的γ射线产生的损伤,而能量高于12 MeV的质子产生的电离损伤与60Co γ射线的相当[8-9]。因此可认为,在实验的质子辐射能量范围内,室温退火时质子辐射产生的后损伤小于60Co γ射线,是因为其产生的电离损伤较γ射线的小,因而辐射产生的界面陷阱电荷和氧化物陷阱电荷较γ射线产生的少,其结果是后损伤效应小于等剂量的60Co γ射线。
在高温退火阶段可看出,在125 ℃时,器件出现明显的退火,根据以往对氧化物电荷和界面态退火特性的研究结果,氧化物电荷在室温下退火较迅速,而界面态在室温下一般不退火,仅在温度高于100 ℃时才出现退火现象,而位移损伤造成的体缺陷仅在温度高于200 ℃时才会退火,因此根据以上结果,可认为质子辐射可对运算放大器LM837同时产生界面陷阱、氧化物陷阱和体缺陷。器件退火速度的差别源于60Co γ射线和两种不同能量的质子射线造成的电离损伤的不同,其中60Co γ射线造成的电离损伤最严重,其次为10 MeV质子,3 MeV质子造成的电离损伤最低。3 MeV与10 MeV质子辐射器件高温退火恢复程度的差别,源于质子辐射造成的电离损伤与位移损伤所占比例的不同。3 MeV质子高温退火恢复程度低于10 MeV质子,源于3 MeV质子辐射损伤造成的位移损伤所占比例高于10 MeV质子。使用MULASSIS软件计算1011cm-2注量的质子产生的电离能量沉积和位移能量沉积,结果为3 MeV质子的电离能量沉积为1.36×103Gy,位移能量沉积为0.359 Gy;10 MeV质子的电离能量沉积为5.96×102Gy,位移能量沉积为0.126 Gy。可发现,3 MeV质子产生的位移能量沉积和电离能量沉积之比较10 MeV质子的大,这解释了3 MeV质子辐射器件高温退火速度较慢的原因。
4结论
在γ射线辐射和质子辐射下,通过对PNP输入级运算放大器不同程度损伤的研究,可得出以下结论。
1) LM837运算放大器在3、10 MeV质子和60Co γ射线辐射下电参数均会产生变化,其中偏置电流的变化最敏感。
2) 运算放大器的损伤程度与入射质子的能量有关,相同等效总剂量的条件下,10 MeV质子辐射造成的损伤大于3 MeV质子。
3) 等效总剂量条件下,3、10 MeV质子辐射产生的损伤高于美军标剂量率范围内60Co γ射线辐射造成的损伤,其主要原因是质子辐射可同时产生电离损伤和位移损伤,两种损伤的叠加使器件性能产生更严重的退化。
4) 3 MeV和10 MeV质子辐射后,运算放大器LM837在室温退火时会产生后损伤效应,在125 ℃高温退火时,损伤明显恢复,其主要原因是质子辐射产生了界面陷阱与氧化物陷阱。
5) 125 ℃高温退火时,60Co γ射线辐射器件的恢复程度大于3 MeV和10 MeV质子照射器件,其原因是60Co γ射线造成的电离损伤大于3 MeV和10 MeV质子辐射;3 MeV质子高温退火恢复程度低于10 MeV质子源于3 MeV质子辐射损伤中位移损伤所占比例高于10 MeV质子。
参考文献:
[1]胡天乐,陆妩,席善斌,等. PNP输入双极运算放大器在不同辐射环境下的辐射效应和退火特性[J]. 物理学报,2013,62(7):325-330.
HU Tianle, LU Wu, XI Shanbin, et al. Effects of irradiation on PNP input bipolar operational amplifiers in different radiation environments and under various post-annealing treatments[J]. Acta Phys Sin, 2013, 62(7): 325-330(in Chinese).
[2]陆妩,任迪远,郭旗,等. 双极运算放大器的辐射效应和退火特性[J]. 半导体学报,1998,19(5):55-61.
LU Wu, REN Diyuan, GUO Qi, et al. Radiation effects and annealing characteristics of bipolar operational amplifiers[J]. Journal of Simiconductors, 1998, 19(5): 55-61(in Chinese).
[3]王义元,陆妩,任迪远,等. 不同偏置下电流反馈运算放大器的电离辐射效应[J]. 原子能科学技术,2001,45(4):461-466.
WANG Yiyuan, LU Wu, REN Diyuan, et al. Ionizing radiation effect of current-feedback am-plifier under different biases[J]. Atomic Energy Science and Technology, 2001, 45(4): 461-466(in Chinese).
[4]SCHMIDT D, WU A, SCHRIMP R. Modeling ionizing radiation induced gain degradation of the lateral PNP bipolar junction transistor[J]. IEEE Transactions on Nuclear Science, 1996, 43(6): 3 032-3 039.
[5]SUMMERS G P, BURKE E A, DALE C J, et al. Correlation of particle-induced displacement damage in silicon[J]. IEEE Transactions on Nuclear Science, 1987, 34(6): 1 133-1 139.
[6]BARNABY H J, SMITH S K, SCHRIMPF R D, et al. Analytical model for proton radiation effects in bipolar devices[J]. IEEE Transactions on Nuclear Science, 2002, 49(6): 2 643-2 649.
[7]BARNABY H J, STERNBERG A L, PEASE R L. Proton radiation response mechanisms in bipolar analog circuits[J]. IEEE Transactions on Nuclear Science, 2001, 48(6): 2 074-2 080.
[8]TALLON R W, ACKERMANN M R, KEMP W T, et al. A comparison of ionizing radiation damage in MOSFETS from cobalt-60 gamma rays, 0.5 to 22 MeV protons and 1 to 7 MeV electrons[J]. IEEE Transactions on Nuclear Science, 1985, 32(6): 4 393-4 398.
[9]OLDHAM T R, McGARRITY J M. Ionization of SiO2by heavy charged particles[J]. IEEE Transactions on Nuclear Science, 1981, 28(6): 3 975-3 980.
[10]NICHOLS D K, PRICE W E, GAUTHIER M K. A comparison of radiation damage in transistors from cobalt-60 gamma rays and 2.2 MeV electrons[J]. IEEE Transactions on Nuclear Science, 1982, 29(6): 1 970-1 974.

