磁控溅射偏压对Cr薄膜密度以及表面形貌的影响
孙钢杰, 伊福廷, 王焕华, 贾全杰, 张天冲
(中国科学院 高能物理研究所 多学科中心,北京 100049)
磁控溅射偏压对Cr薄膜密度以及表面形貌的影响
孙钢杰,伊福廷,王焕华,贾全杰,张天冲
(中国科学院 高能物理研究所 多学科中心,北京100049)
摘要:利用磁控溅射技术,在不同偏压条件下在Si(001)基底上沉积了金属Cr薄膜样品。用同步辐射装置对样品进行了X-射线反射率测试,采用X-射线反射率分析法研究了不同偏压下Cr薄膜密度的变化。发现当偏压小于300V时,偏压对所沉积的薄膜起到紧致的效果,偏压为300V时薄膜密度最大;当偏压大于300V时,薄膜密度减小。另外,为了探究偏压对薄膜表面形貌的影响,用扫描电子显微镜对各样品进行了表面分析,发现在偏压较小时薄膜表面较为平整;随着偏压增大,表面呈现界面分明的岛状分布。
关键词:X-射线反射率分析; 铬薄膜; 密度; 表面形貌; 磁控溅射; 偏压
引 言
铬薄膜具有良好的硬度、耐磨性、耐腐蚀性和表面装饰性等特点,在不锈钢、汽车零件及光学领域都有大量应用[1-3]。磁控溅射具有沉积速率快、镀膜面积大及附着力强等优点,是制备铬薄膜最常用的方法之一[4-6]。在制备过程中,给衬底施加的偏压大小对薄膜的表面结构、粗糙度、密度等性质都有很大的影响,这方面的研究对于实际的薄膜制备过程可以起到指导作用。X-射线反射率(XRR)分析是表征薄膜性能的重要方法,由于薄膜表面的X-射线反射率大小主要与薄膜的厚度、表面粗糙度和密度等性质有关[7-8],对反射率曲线进行模拟分析可以得到薄膜密度的精确信息[9-10]。
本工作利用磁控溅射技术,施加不同偏压条件下在硅片上沉积Cr薄膜,用parratt软件对薄膜进行了XRR分析,研究了偏压对薄膜密度的影响,以及用扫描电子显微镜(SEM)观察了薄膜表面形貌的差异。
1 材料的制备与表征原理
1.1Cr薄膜样品的制备
基底材料为直径5cm(001)硅片,在沉积前先用离子束刻蚀机对硅片表面进行2min的刻蚀,以去除表面氧化层,再用无水酒精和丙酮进行清洗,用氮气枪吹干。用磁控溅射进行沉积,磁控溅射条件:本底真空3mPa,氩气流量为20mL/min,腔体气压为0.5Pa,溅射偏压分别为0、100、200、300和400V。
1.2X-射线反射率分析法基本理论
X-射线反射率(XRR)分析法是将X-射线掠入射到样品表面,变换入射光角度,通过分析得出全反射临界角曲线,从而得到样品信息的方法。
1.2.1材料的X-射线折射率
材料的折射率在X-射线段可表示为[11-12]
n=1-δ-iβ
(1)
其中δ是和材料散射性质相关的系数;β是和材料吸收性质相关的系数。
(2)
式中Zj为原子序数;NA为阿伏加德罗常量;λ为X-射线波长;fj'为扩散修正系数与材料对X-射线的散射有关;Mj为摩尔质量;ρj为材料密度;r0为经典电子半径。
1.2.2全反射临界角、折射率及材料密度的关系
X-射线由空气入射到薄膜表面时满足折射率关系
(3)
由于在X-射线段,一般材料的折射率n都小于1,对于空气来说是光疏介质,所以在X射线入射过程中会有一个全反射临界角θc。对于掠入射来说,θ1和θ2都较小,由公式(1)、(2)和(3)可以得到
(4)
通常扩散修正系数很小,可以忽略。所以对于同一种材料而言
(5)
式中ε0是真空介电常数;M是材料相对原子质量;me是经典电子质量。
2 实验结论分析
2.1X-射线反射率分析测量薄膜密度
利用北京同步辐射光源,对0、100、200、300及400V偏压下沉积的Cr薄膜进行X-射线反射率扫描,将得到的数据用parratt软件进行模拟绘出样品的全反射临界角曲线,如图1所示。

图1 对应于偏压从0~400V变化的全反射临界角
得到临界角的变化如图2所示。由图2可以看出,不同偏压条件下薄膜样品对应的全反射临界角分别为0.22°、0.25°、0.28°、0.35°和0.31°。

图2 不同偏压条件下薄膜样品对应的全反射临界角
通过公式(5)计算得到所对应的薄膜密度如表1所示。由表1可知,薄膜密度分别为2.38、3.08、3.86、6.03及4.73g/cm3。
表1Cr薄膜密度
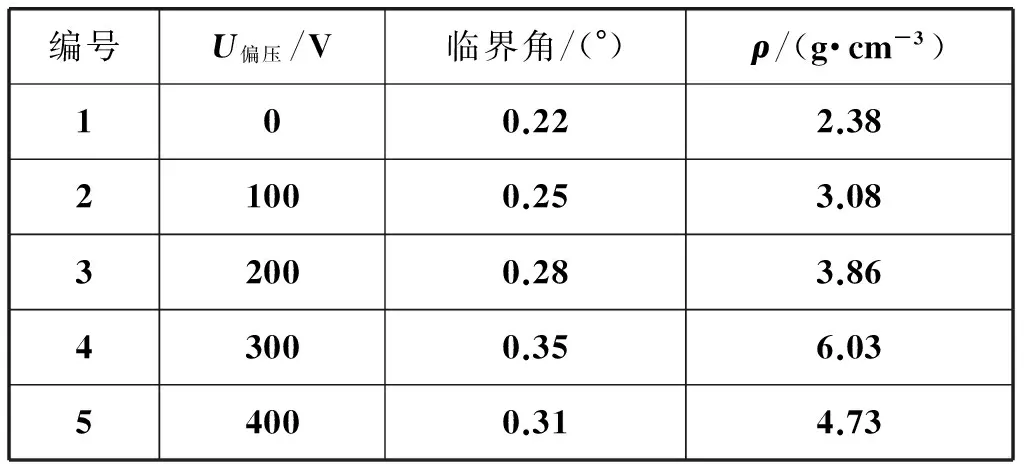
编号U偏压/V临界角/(°)ρ/(g·cm-3)100.222.3821000.253.0832000.283.8643000.356.0354000.314.73
结果表明,偏压达到300V之前,磁控溅射沉积的Cr薄膜密度随着偏压的增大而增大;当偏压达到300V时,再增大偏压,薄膜的密度会减小。因为随着偏压的增大,靶材溅射的高能量粒子增多,能够增强粒子与膜层间的粘附力与致密度;当偏压增大到一定值时,高能溅射粒子会造成对表面的轰击过大,造成二次溅射,使得Cr薄膜致密度下降。
2.2表面形貌分析
为了探究偏压对磁控溅射Cr薄膜表面形貌的影响,利用扫描电子显微镜(SEM)对各样品进行了扫描,如图3所示。

图3 对应于偏压为0~400V Cr薄膜表面SEM照片
图3(a)、图3(b)和图3(c)表明,当偏压较低薄膜密度较小时,Cr薄膜表面较为平整,随着偏压增大,表面纹路越来越清晰,渐渐出现沟壑;图3(d)显示当偏压为300V时,表面呈明显的星形岛状分布,界面清晰;图3(e)与图3(d)相比,当偏压增大到400V时,薄膜表面呈连续的岛状分布,相互间界面比较模糊,且表面岛的形状也不同。
3 结 论
通过磁控溅射方法,在偏压为0~400V条件下在Si片上沉积得到Cr薄膜样品。经过XRR测试和SEM扫描,得出以下结论:
1)偏压从0V增加到300V的过程中,Cr薄膜密度逐渐增大;当偏压超过300V时薄膜密度减小。
2)偏压对Cr薄膜表面形貌有很大影响。当偏压较小时,薄膜表面形状比较平整,随着偏压的升高表面出现沟壑,界面清晰,呈岛状生长。
3)SEM扫描表明,偏压对Cr薄膜密度的影响不仅可能和薄膜表面形貌存在内在联系,也应该和薄膜的生长方式密切相关。
参考文献
[1]刘宗贺,方雪冰,刘波,等.直流磁控溅射铬膜附着性的影响因素研究[J].实验科学与技术,2006,2(1):31-32.
[2]陈志一.方便廉价的高稳定微带电路铬薄膜电阻[J].现代雷达,1992,14(3):72-75.
[3]闫卫平,朱剑波,马灵芝,等.Cr金属薄膜温度传感器的研究[J].仪器仪表学报,2004,25(4):310-311.
[4]宋文龙,邓建新,赵金龙.磁控溅射薄膜附着性能的影响因素[J].工具技术,2007,41(10):20-22.
[5]Lin Jianping,Lin Limei,Guan Guiqing,et al.Structural, Optical and Electrical Properties of Chromium Thin Films Prepared by Magnetron Sputtering[J].Acta Photonica Sinica,2012,41(8):922-926.
[6]谷文翠,李寿德,王怀勇,等.基片偏压对磁控溅射制备TiB2涂层结构及性能的影响[J].航空材料学报,2014,34(5):37-42.
[7]Parratt L G.Surface Studies of Solids by Total Reflection of X-Rays[J].Physical Review,1954,95(2),359-369.
[8]Sinha S K,Sirota E B,Garoff S.X-ray and neutron scattering from rough surfaces[J].Physical Review B,1988,38(4),2297-2311.
[9]于吉顺,陆琦,肖平,等.X射线反射(XRR)对薄膜样品厚度的研究[J].功能材料,2008,39(2),199-201.
[10]Misture S.Characterization of Glass Surfaces and Coatings Using X-ray Reflectivity[J].American Ceramic Society Bulletin,2004,83(1),27-29.
[11]Jark W,Eichert D,Luehl L,et al.Optimisation of a compact optical system for the beamtransport at the X-ray Fluorescence beamline at Elettra for experiments with small spots[J].Proc.of Spie,2014,9207,1-12.
[12]Yoshikazu Fujii.Comparison of Surface Roughness Estimations by X-ray Reflectivity Measurements and TEM observations[J].Materials Science and Engineering,2011,24,1-9.
doi:10.3969/j.issn.1001-3849.2016.07.001
收稿日期:2016-01-27修回日期: 2016-03-01
中图分类号:O434.19; TB31
文献标识码:A
Influences of Bias Voltage on Density and Surface Morphology of Chromium Thin Films in Magnetron Sputtering
SUN Gangjie,YI Futing,WANG Huanhua,JIA Quanjie,ZHANG Tianchong
(Center for Multi-disciplinary,Research Institute of High Energy Physics,Chinese Academy of Sciences,Beijing 100049,China)
Abstract:Magnetron sputtering technology was used to deposit a series of Cr thin films under different bias voltages on Si (001).The X-ray reflectivity of the sample was tested by the synchrotron radiation device,and the density change of Cr thin films was studied under different bias voltages by X-ray reflection analysis.The results showed that when the bias was less than 300V,the deposited thin films were more compact.And the film density was the largest when the bias was 300V.When the bias voltage exceeded 300V,the correspondent density declined.Scanning electron microscope (SEM) was used to investigate the influence of bias voltage on films' surface morphology.The surfaces of films are relatively smooth at low bias voltages,while the surface structure became harsh and island distribution at high bias voltages.
Keyword:X-ray reflection analysis;chromium thin film;density;surface morphology;magnetron sputtering;bias voltage

