软性粒子抛光石英玻璃的材料去除机理
刘德福,陈 涛,陈广林,胡 庆
(1.中南大学 机电工程学院,湖南 长沙 410083;2.中南大学 高性能复杂制造国家重点试验室,湖南 长沙 410083)
软性粒子抛光石英玻璃的材料去除机理
刘德福1,2*,陈涛1,2,陈广林1,2,胡庆1
(1.中南大学 机电工程学院,湖南 长沙 410083;2.中南大学 高性能复杂制造国家重点试验室,湖南 长沙 410083)
基于阿伦尼乌斯原理和分子振动理论,分析了软性抛光粒子、石英玻璃和抛光垫之间的弹性与超弹性接触,研究了用软性粒子抛光石英玻璃的材料去除机理。基于理论研究进行了大量的抛光试验,建立了软性粒子抛光石英玻璃的材料去除率模型。理论计算与试验结果表明:在石英玻璃化学机械抛光中,材料的去除主要由抛光粒子与石英玻璃的界面摩擦化学腐蚀作用来实现;单个抛光粒子压入石英玻璃的深度约为0.05 nm,且材料去除为分子量级;石英玻璃表层的分子更易获得足够振动能量而发生化学反应实现材料的去除;抛光压力、抛光液中化学试剂种类和浓度以及石英玻璃试件与抛光盘的相对运动速度决定了软性粒子抛光石英玻璃的材料去除率大小。
石英玻璃;化学机械抛光;软性抛光粒子;材料去除机理;去除速率模型
1 引 言
随着光学技术的发展,光学材料的应用日益广泛,对光学元件表面加工质量的要求也越来越高[1]。作为光学元件不可或缺的原材料,石英玻璃的加工去除机理研究具有重要意义。目前,作为石英加工的常用方法,化学机械抛光(Chemico-Mechanical Polishing, CMP)是唯一可以实现硬脆材料全局平坦化的加工工艺,其材料去除机理及去除速率的研究大都建立在二体磨粒磨损机理基础上[2]。然而,Lee[3]提出了包括粒子大小、浓度和分布、抛光液流速、抛光垫表面形貌、材料特性等的化学机械抛光模型,发现石英玻璃CMP后的表面并不满足二体磨粒磨损特征。Zhao等[4]建立了反映抛光试件的材料性能、抛光液中化学试剂的性能以及抛光工艺参数等对抛光试件表面材料去除影响的数学模型,认为CMP工艺中的材料去除是试件表面材料的原子/分子不断发生化学反应和磨损的动态平衡过程。Hocheng等[5]采用能量平衡理论建立了抛光速率和抛光压力等工艺参数对材料去除率影响的模型,提出了基于能量平衡的微观材料去除理论,用以研究CMP工艺中的抛光压力以及抛光试件与抛光垫之间的相对运动速度对最终抛光效果的影响。不过,Hocheng模型并未考虑抛光垫和抛光试件的特性以及抛光粒子浓度、抛光液中化学试剂浓度等参数对试件表面材料去除率的影响,也没有给出准确的材料去除率计算方程。总之,这些模型都是采用硬质粒子抛光试件,在建立模型时都没有考虑磨粒的变形,这样的工艺条件下石英玻璃试件表面易产生划痕等损伤。因此,有学者分别从机械作用对化学反应活化能的影响[6]和单分子化学吸附[7]的角度出发,研究了石英玻璃CMP分子级的材料去除机理,建立了石英玻璃CMP分子级的材料去除率模型。并有研究[8-9]证明氧化铈等软性抛光粒子有利于提高石英玻璃表面的抛光质量,采用含有氧化铈等软性抛光粒子抛光液抛光后的石英玻璃表面光滑没有划痕,而经典塑性接触理论与切削理论都无法解释软性粒子抛光硬质材料的去除机理。
本文基于弹性与超弹性接触力学理论,从软性抛光粒子压入石英玻璃的深度出发,结合分子振动理论和阿伦尼乌斯原理,研究了软性抛光粒子与石英玻璃界面摩擦化学对石英玻璃表面分子活化能的影响,从而查明软性粒子抛光石英玻璃的分子量级材料去除机理,并建立了一种关于软性粒子抛光石英玻璃的材料去除率模型。
2 石英玻璃CMP的材料去除机理
2.1石英玻璃与抛光垫的接触应力
本文采用的抛光垫材料是多孔聚氨酯。图1所示为扫描电镜(SEM)测得的抛光垫形貌,其表面由半球凸起和凹坑组成。研究表明,采用此类抛光垫抛光石英玻璃时,载荷主要由抛光垫粗糙峰承担[10]。为描述载荷对实际接触面积和微观接触的影响,采用如图 2所示的半球等效抛光垫轮廓模型描述石英玻璃与抛光垫的接触。

图1 SEM测得的抛光垫的真实形貌

图2 石英玻璃与抛光垫的接触模型
如图2所示,抛光垫等效轮廓的半球凸起与凹坑的半径均满足正态分布:R1~N(m1,σ12)和R2~N(m2,σ12),且有:

(1)
若石英玻璃抛光面被压到距离参考平面d的位置,由弹性接触力学可知[11],石英玻璃承受的载荷为:

(2)
式中:W为石英玻璃承受的载荷;Esp为石英玻璃与抛光垫的等效弹性模量;R1为微凸峰半径;φ(R1)为微凸峰半径R1分布的概率密度函数;δ1为微凸峰的变形量;P为石英玻璃承受的平均抛光压力;Ae为石英玻璃的名义接触面积。
抛光垫单个半球的粗糙峰与石英玻璃试件的接触应力为[11]:

(3)
式中:Py为单个粗糙峰上的接触应力;wy为单个粗糙峰上的载荷;Sy为单个粗糙峰上的实际接触面积;R1y为单个粗糙峰的半径。
2.2软性抛光粒子与抛光垫、石英玻璃的微观接触
2.2.1软性抛光粒子与抛光垫的微观接触
抛光垫与氧化铈粒子的弹性模量差异较大,在抛光过程中,有效氧化铈粒子几乎全部嵌入到抛光垫粗糙峰中[12]。石英玻璃、抛光粒子、抛光垫三者在接触区域的变形如图3所示。

图3 抛光粒子与抛光垫、石英玻璃的接触示意图
Fig.3Contact scheme of polishing particle with polishing pad and fused glass
根据超弹性接触理论[12],抛光粒子嵌入抛光垫的深度为:

(4)

(5)
式中:δ0为软性抛光粒子嵌入抛光垫的深度;δ(x)为抛光垫接触轮廓的高度函数,δ′(x)为δ(x)的一阶导数;a为软性抛光粒子与抛光垫半球微凸体的最大接触半径;r为软性抛光粒子与抛光垫半球微凸体的接触区域半径,r∈(0,a)。
抛光粒子与抛光垫的接触轮廓高度函数为[13]:

(6)
抛光垫与抛光粒子的接触力Fmp[13]为:

(7)
式中:Fmp为抛光垫与抛光粒子的接触载荷;Emp为抛光垫与氧化铈抛光粒子的等效弹性模量;Em,vm分别为氧化铈抛光粒子的弹性模量和泊松比;Ep,vp分别为抛光垫的弹性模量和泊松比。
2.2.2软性抛光粒子与抛光垫的微观接触
抛光粒子与石英玻璃的等效变形量分别为δp,δs,可分别表示为[11]:

(8)

(9)
式中:Es,vs分别为石英玻璃的弹性模量和泊松比,Q为弹性变形系数。
由式(8)和式(9)可知:

(10)
因此,软性氧化铈抛光粒子与石英玻璃接触的等效变形量δ可表示为:
δ=δp+δs.
(11)
单个抛光粒子施加在石英玻璃的载荷Fw[11]为:

(12)
式中Ew为氧化铈抛光粒子与石英玻璃的等效弹性模量。
如图3所示,抛光粒子与抛光垫的接触载荷为:
Fc=Fmp+πa2Py.
(13)
由力的平衡条件可得:
Fw=Fc.
(14)
由于氧化铈粒子的弹性模量比抛光垫的大很多,根据超弹性接触理论,抛光粒子、抛光垫变形量与抛光粒子半径的关系可以近似为:

(15)
式中R为氧化铈抛光粒子的半径。
将式(3)、式(6)、式(7)、式(11)、式(12)、式(13)和式(15)代入式(14)可以得到单个粒子压入石英玻璃深度与抛光参数的关系方程:

(16)
本文采用的抛光垫、软性氧化铈抛光粒子和石英玻璃的材料性能参数如表1所示。
表1抛光垫、石英玻璃、软性氧化铈抛光粒子的性能参数
Tab.1Mechanical parameters of polishing pad, fused glass and soft ceria particle

弹性模量/GPa泊松比氧化铈抛光粒子[16]Em=165nm=0.5石英玻璃[16]Es=73ns=0.17抛光垫[15]Ep=0.01np=0.5
在抛光垫半球凸起的平均半径为100 μm,半径分布的标准差为100 μm的条件下,由式(16)计算得到抛光压力以及抛光粒子半径对粒子压入石英玻璃深度的影响如图 4所示。如图4(a)所示,粒子压入石英玻璃的深度与粒子粒径呈线性关系。如图4(b)所示,粒子压入石英玻璃的深度随抛光压力的增加而增加,但增长速度减小。石英玻璃抛光工艺中常用的抛光压力一般为50 kPa 左右[14],计算结果表明:抛光压力为50 kPa 条件下,平均粒径为260 nm的氧化铈粒子压入石英玻璃的深度约为0.5 nm,这与二氧化硅分子大小在同一尺度[13],由此表明氧化铈粒子抛光石英玻璃的材料去除尺度为分子量级。

(a)软性抛光粒子粒径的关系
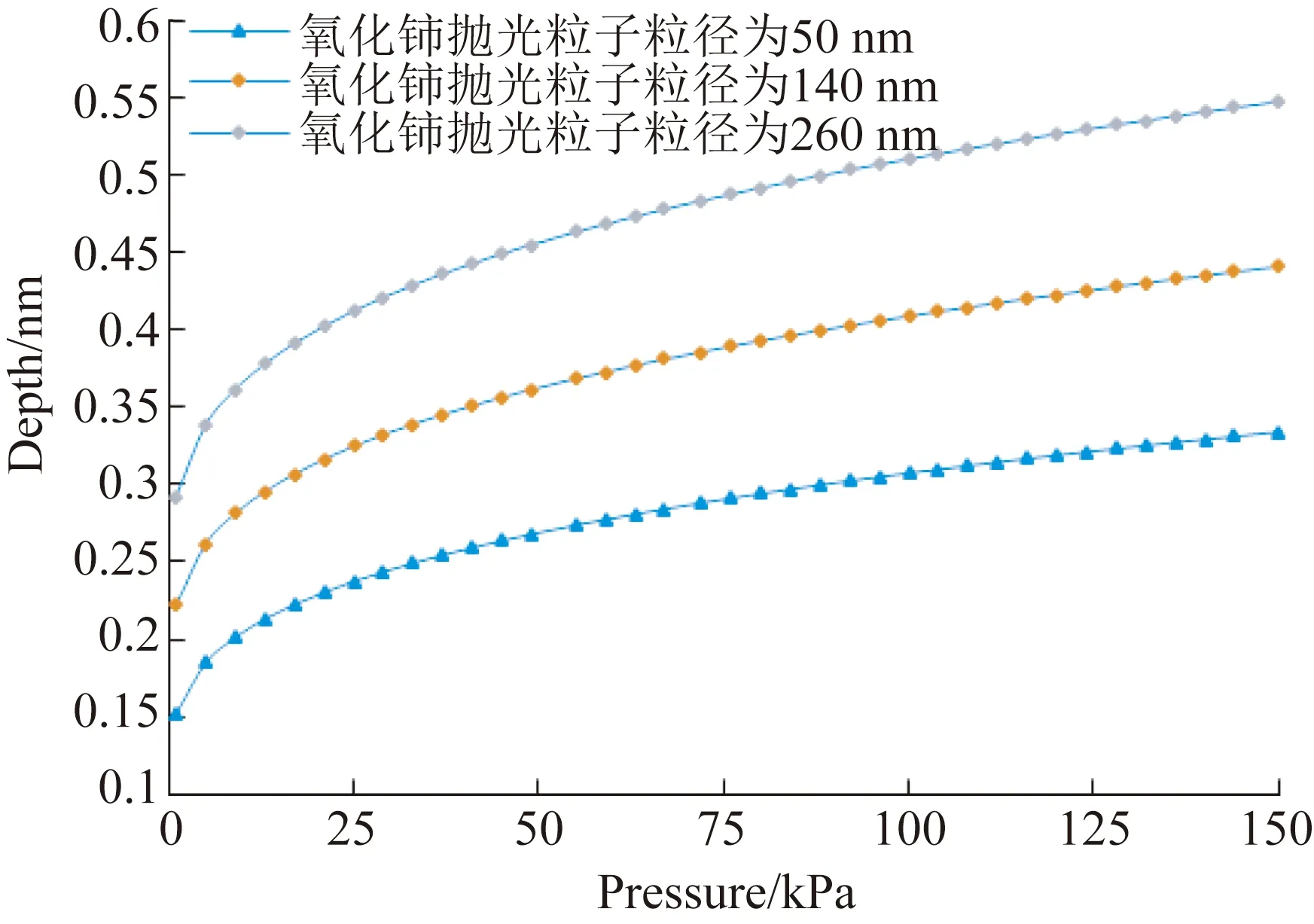
(b)平均抛光压力的关系
图4氧化铈粒子压入石英玻璃的深度与软性抛光粒子半径和平均抛光压力的关系
Fig.4Relationships of depth of ceria particle embedding into fused glass with soft particle size and polishing pressure respectively
2.2.3软性氧化铈粒子抛光石英玻璃的材料去除机理分析
在如表2所示的工艺参数下抛光石英玻璃片,抛光后石英玻璃的表面形貌如图5(a)所示。分别采用浓度为0.5 mol/L的HF和NaOH溶液浸润石英玻璃2 h,浸润前后石英玻璃的形貌分别如图5(c)、5(d)所示。抛光后石英玻璃表面没有划痕,但存在不规则的小突起,这与图5(c)所示的经NaOH溶液浸润2 h后和图5(d)所示的经HF溶液浸润2 h后石英玻璃的表面形貌一致。因此采用软性粒子抛光石英玻璃的材料去除机理如图6所示:二氧化硅分子在界面摩擦激发下与抛光液中的化学试剂反应而脱离石英玻璃表面。根据界面摩擦化学理论,由于二氧化硅的结晶率低[15],抛光液与石英玻璃表面分子化学反应的产物与基底结合力小而溶解在抛光液中。单个粒子压入石英玻璃的深度对石英玻璃表面分子振动链可视为一个位移脉冲激励。随着粒子与石英玻璃的相对运动,石英玻璃表面各个微观区域不断接受位移脉冲激励,表面分子不断获得机械能[16]。当二氧化硅分子动能达到与抛光液中化学试剂反应所需的活化能时,二氧化硅分子发生反应且生成物溶解在抛光液中。由于实际参与材料去除的粒子较少[13],在同一区域承受两次位移脉冲激励间隔内,化学试剂与二氧化硅分子能充分完成反应[7]。

表2 验证石英玻璃材料去除机理的抛光试验参数

(a)抛光后(a)After polishing

(b)浸润前(b)Before infiltration

(c) NaOH溶液浸润2 h后(c)After soaked in NaOH for 2 hour

(d)HF浸润2 h后(d)After soaked in HF for 2 hour
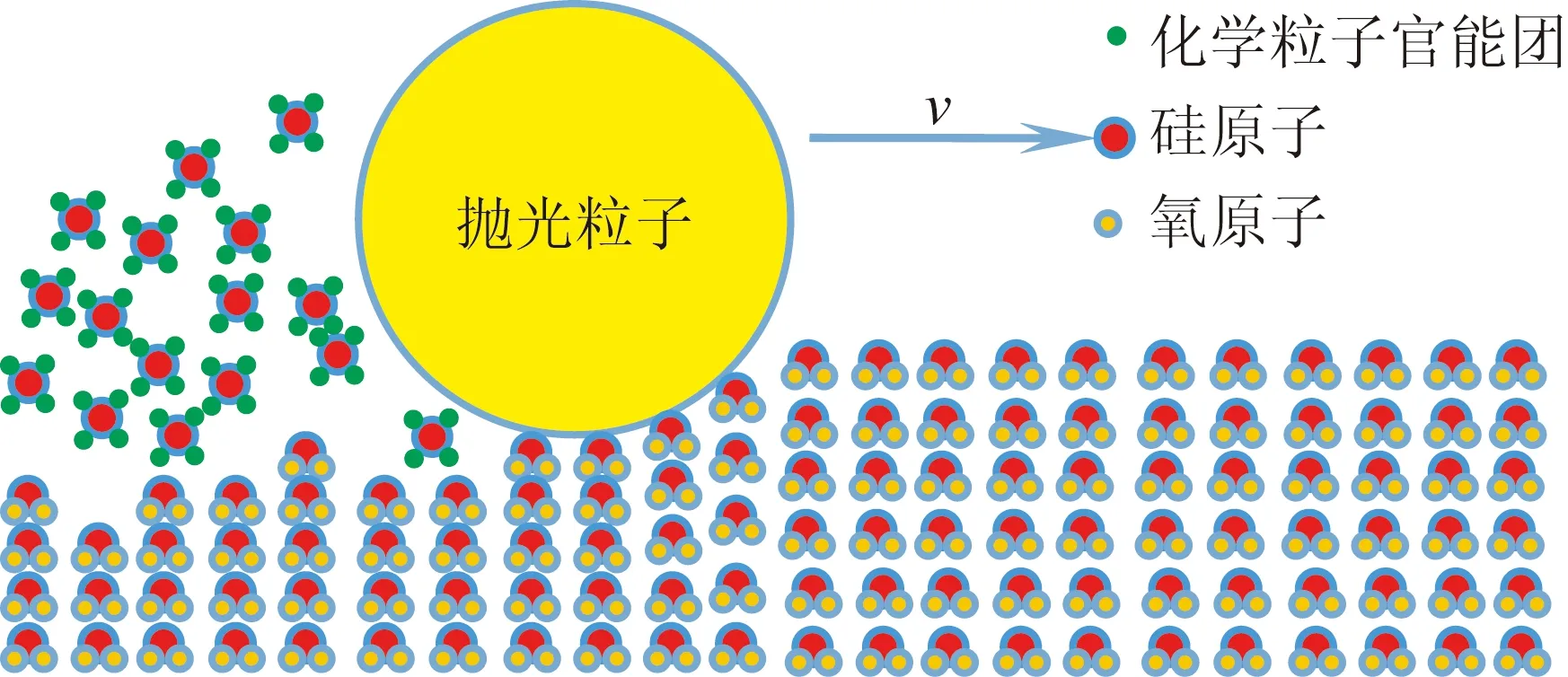
图6软性抛光粒子抛光石英玻璃材料去除机理示意图
Fig.6Material removal mechanism of fused glass polished by soft particles
3 石英玻璃CMP的材料去除率模型
低结晶率使石英玻璃整体不满足晶体性质,但表面微观区域仍满足晶体结构[15]。将石英玻璃表层的分子排布简化为谐振模型。只有处在分子振动链首端的分子会参与化学反应而溶在抛光液中,而且由于振动链尺寸比分子尺寸大得多,因此,振动链刚度矩阵与质量矩阵近似保持不变。分子振动链谐振的质量矩阵和刚度矩阵分别为[17]:

(17)

(18)
式中:k为Si—O键的等效弹性系数;m为二氧化硅分子的等效质量。
分子振动链振型可表示为:
MX″+KX=0,
(19)
式中X为分子振动链的位移向量。
由振动模型可以知道:
M=mE,
(20)
式中E为n阶单位矩阵。
K=kΓ,
(21)
式中Γ为K的系数矩阵。
将式(20)、式(21)代入式(19)可以得到:

(22)
假设分子振动链各分子的振动响应xi为:

(23)
式中:uij为振动模态矩阵U的元素;A为振动正弦分量的系数矩阵;B为振动余弦分量的系数矩阵。
振动链各分子位移和速度的初始条件为:

(24)
式中:x0为单个分子振动链的位移向量,δ1为单个分子振动链的初始位移。

(25)

由初始条件可知:
A=0,
(26)

(27)
根据式(27)计算得到振动分子链首端分子与第二个分子的振动位移变化如图7所示。当抛光粒子与石英玻璃发生界面摩擦时,石英玻璃表面分子极易获得反应所需的振动能量,振动链的第一个分子的最大振动能量约为第二个分子的3倍。
由于抛光压力和抛光液中的化学试剂直接影响石英玻璃的材料去除,考虑化学与机械联合作用对石英玻璃材料去除率的影响,假设抛光粒子均匀嵌入抛光垫且化学官能团离子在抛光液内均匀分布。

图7振动分子链首端分子与第二个分子的振动位移变化
Fig.7Vibration displacement of the first molecule and the second molecule in vibration molecular chain
由式(12)可得到单抛光粒子所承受的载荷Fw,抛光粒子与石英玻璃的最大接触应力Pj[11]为:

(28)
石英玻璃与抛光粒子的接触压力P分布为:

(29)
式中b为抛光粒子与石英玻璃的接触半径。

(30)
石英玻璃接触区域的变形量分布为:

(31)
式中:δs1为石英玻璃与抛光粒子接触区域各分子振动链的初始位移分布函数。


(32)

石英玻璃表面单层吸附膜的化学官能团粒子的面浓度为:

(33)
式中c为抛光液中化学官能团粒子的物质量浓度。
那么单个粒子去除石英玻璃表面的分子数为:

(34)
式中:s为石英玻璃试件相对抛光垫运动的路程;a1为二氧化硅晶胞边长;φ(E)为E的概率分布函数。
石英玻璃表面活化分子面浓度为:

(35)
石英玻璃试件被去除的总分子数可表示为:

(36)
式中:nm为实际参与材料去除的抛光粒子数[13];I为化学反应速率常数。

(37)
式中:χ为抛光液中抛光粒子的体积浓度;D为抛光粒子的平均粒径;Ar为石英玻璃与抛光垫的实际接触面积。
根据晶胞理论[2],石英玻璃的材料去除率为:

(38)
式中:Ae为石英试件的名义接触面积,t为抛光时间。
将式(32)~式(36)代入式(38)中,石英玻璃总的材料去除率为:

(39)
式中:φ(E)为E的概率分布函数;φ(R)为氧化铈粒子半径的分布函数;i为氧化铈粒子压入石英玻璃深度δs∈(δi,δi+1)时,单个分子振动链发生化学反应的分子数;v为石英玻璃相对于抛光垫运动的速度。
4 试验与讨论
试验采用高精密抛光试验机,采用精密天平测量抛光前后石英玻璃的质量差以计算材料去除率。试验工艺参数如表3所示,试验结果如图8所示。
表3抛光压力对石英玻璃材料去除率影响试验的工艺参数
Tab.3Polishing parameters of experiment on effect of polishing pressure on material removal rate of fused glass

试验条件值抛光时间/min30抛光试件石英玻璃抛光粒子氧化铈粒子粒径/nm263抛光液中化学添加剂HFNaOH化学试剂浓度/(mol·L-1)0,0.05,0.1,0.35,10,0.05,0.1,0.3,0.5,0.8抛光盘转速/(r·min-1)30陶瓷圈转速/(r·min-1)25抛光压力/kPa36,45,50,66.2,102,130,140
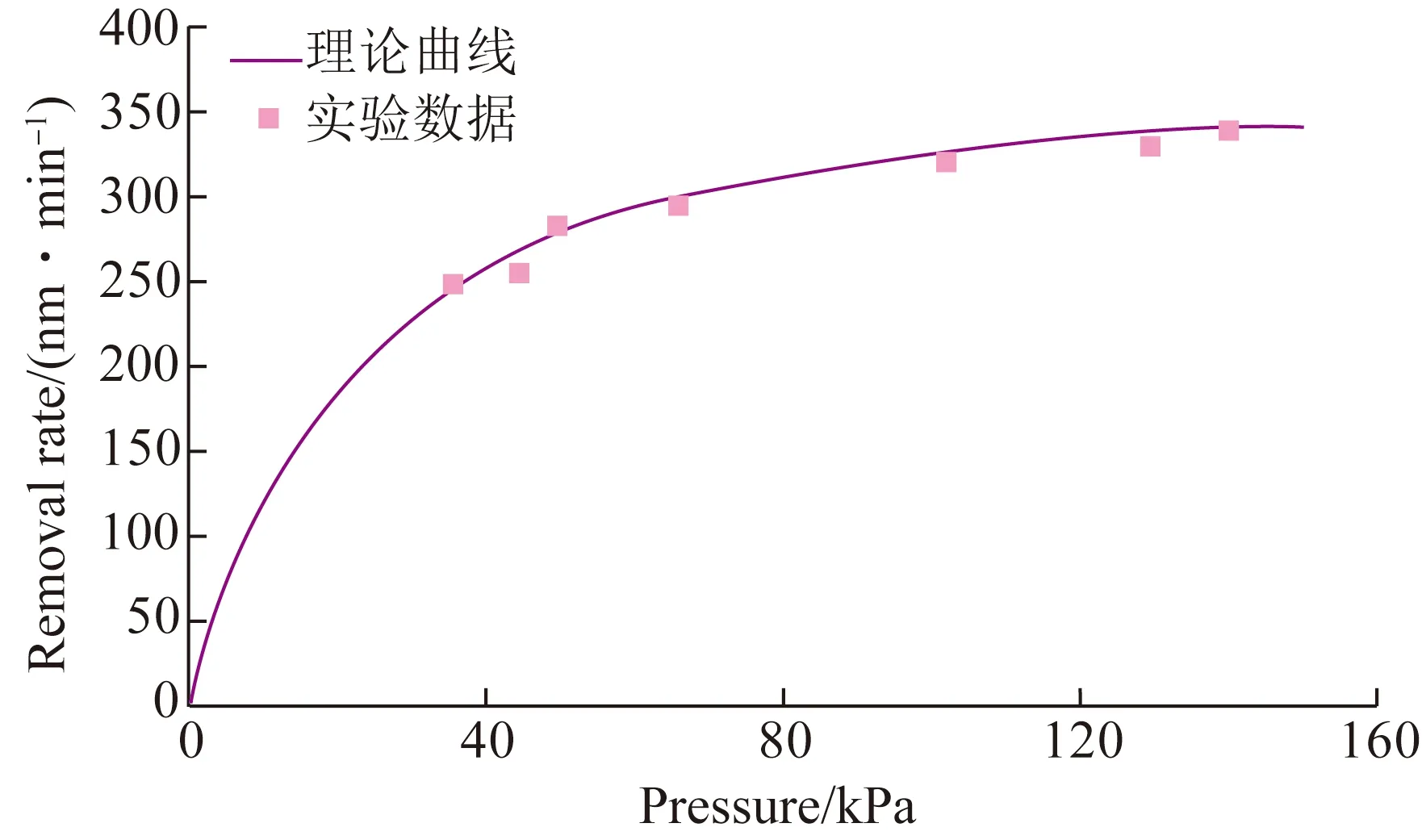
(a)抛光压力与材料去除率的关系

(b)化学试剂浓度与材料去除率的关系
Fig.8Relationships of material removal rate with polishing pressure and chemical reagent concentration respectively
理论计算和试验结果表明:氧化铈粒子抛光石英玻璃时,如图8(a)所示,石英玻璃的材料去除率随抛光压力的增加呈非线性增加,这表明氧化铈粒子抛光石英玻璃的材料去除率并不满足Preston材料去除率经验公式(MRR=KPV[21]),随着抛光压力的增大,石英玻璃的去除速率增幅逐步降低。图8(b)表明化学活化能的不同使化学试剂对石英玻璃材料去除率的影响程度也不同,同等浓度条件下,含HF的抛光液比含NaOH的抛光液更易实现材料去除。由此表明,模型的理论预测结果与试验数据较为吻合,文中建立的软性氧化铈粒子抛光石英玻璃的分子级材料去除机理和材料去除率模型与实际情况相符。这说明在软性氧化铈抛光石英玻璃时,石英玻璃材料去除主要由抛光粒子与石英玻璃表面的界面摩擦促进作用下的化学腐蚀实现的。
5 结 论
本文通过分析抛光粒子、抛光垫、石英玻璃试件三者之间的接触,研究了软性粒子抛光石英玻璃的材料去除机理,分析了机械激励与化学腐蚀在软性粒子抛光石英玻璃中对材料去除的影响,建立了一种新的关于软性粒子抛光石英玻璃的材料去除率模型。理论分析与实验结果表明:软性抛光粒子压入石英玻璃的深度约为0.5 nm,这个深度与二氧化硅分子大小在同一尺度。石英玻璃表层的分子振动链的首端分子较振动链其他分子更易获得机械能量而发生化学反应。在抛光粒子与石英玻璃间的界面摩擦、试剂与石英玻璃间化学腐蚀的联合作用下,软性粒子抛光石英玻璃实现了分子级的材料去除。
[1]郭晓光, 瞿昌恒, 张亮,等. 光学石英玻璃纳米级加工性能[J]. 光学 精密工程,2014,22(11): 2959-2966. GUO X G, QU CH H, ZHANG L,etal.. Nano-processing performance of optical glass[J].Opt.PrecisionEng., 2014,22(11): 2959-2966.(in Chinese)
[2]武昌壕, 郭冰, 姚光,等. 硬脆材料的化学机械抛光机理研究[J].机械设计与制造,2014,2(2): 37-39.
WU CH H, GUO B, YAO G,etal.. The chemical mechanical polishing technology research of the hard and brittle materials [J].MachineryDesign&Manufacture, 2014, 2(2): 37-39.(in Chinese)
[3]LEE H S, JEONG H D, DORNFELD. Semi-empirical material removal rate distribution model for SiO2chemical mechanical polishing(CMP) processes [J].PrecisionEngineering, 2013,37:483-490.
[4]ZHAO Y W, CHANG L, KIM S H. A mathematical model for chemical-mechanical polishing based on formation and removal of weakly bonded molecular species [J].Wear, 2003,254(3):332-339.
[5]HOCHENG H, TSAI H Y, SUB Y T. Modeling and experimental analysis of material removal rate in the chemical mechanical planarization of dielectric films and brare silicon wafers [J].Electt.Dchem.Soc.,2001,148(10):581-586.
[6]GUO D M, LIU R H, KANG R K. Sudy on adhesion removal model in CMP SiO2ILD [J].KeyEngineeringMaterials, 2008,759(389):475-480.
[7]WANG Y G, ZHAO Y W. Research on the molecular scale removal mechanism in chemical mechanical polishing [J].ChineseScienceBulletin, 2008,53(13):2084-2089.
[8]ZHANG P ZH, LEI H, ZHANG J P,etal.. Preparation of nano-sized CeO2and its polishing performances [J].OpticalTechnique, 2006,32(5):1-4.
[9]CHEN Y, LU J X, CHEN Z G. Preparation, characterization and oxide CMP performance of composite polystyrene-core ceria-shell abrasives [J].MicroelectronicEngineering, 2011,88(2):200-205.
[10]LUO J F, DORNFELD D A. Material removal mechanism in chemical mechanical polishing: theory and modeling [J].IEEETrans.Semicond.Manuf., 2001,14:112-133.
[11]VALENTIN L, POPOV.ContactMechanicsandFrictionPhysicalPrinciplesandApplications[M]. Beijing:Tsinghua University Press,2011.
[12]WANG Y G, ZHAO Y W, GU J. A new nonlinear-micro-contact model for single particle in the chemical-mechanical polishing with soft pad [J].JournalofMaterialsProcessingTechnology, 2007(183):374-379.
[13]王永光. 基于分子量级的化学机械抛光材料去除机理的理论和试验研究[D]. 无锡: 江南大学,2008.WANG Y G.ExperimentalandTheoreticalStudyontheMaterialRemovalMechanismintheChemicalMechanicalPolishingatMolecularScale[D].Wuxi: Jiangnan University, 2008.(in Chinese)
[14]顾欣, 张晨辉, 雒建斌,等. 石英光纤端面的化学机械抛光试验研究[J]. 摩擦学学报,2008,28(1): 11-17.
GU X, ZHANG CH H, LUO J B,etal.. Research on polishing end face of silica optical fiber [J].ChineseJournalofTribology, 2008, 28(1): 11-17.(in Chinese)
[15]周永恒. 石英玻璃及原料中的羟基的研究[D]. 北京: 中国建筑材料科学研究院,2002.
ZHOU Y H.StudyontheHydroxyofFusedGlassandRawMaterials[D]. Beijing: China Building Materials Academy, 2002.(in Chinese)
[16]苏建修.IC制造中硅片化学机械抛光材料去除机理研究[D]. 大连: 大连理工大学,2006.
SU J X.StudyonMaterialRemovalMechanismofWaferChemicalMechanicalPolishinginICManufacturing[D]. Dalian: Dalian University of Technology,2006.(in Chinese)
[17]李有堂. 机械振动理论与应用[M]. 北京:科学出版社,2012.
LI Y T.TheTheoryandApplicationofMechanicalVibration[M]. Beijing: Science Press, 2012.(in Chinese)
[18]仇中军, 周立波, 房丰洲,等. 石英玻璃的化学机械磨削加工[J]. 光学 精密工程,2010,18(7): 1554-1560.
CHOU ZH J, ZHOU L B, FANG F ZH,etal.. Chemical mechanical grinding for fused glass [J].Opt.PrecisionEng., 2010,18(7): 1554-1560.(in Chinese)
[19]徐越. 化学反应动力学[M]. 北京: 化学工业出版社,2005.
XU Y.ChemicalReactionDynamics[M]. Beijing: Chemical Industry Press, 2005.(in Chinese)
[20]钟开莱. 概率论[M]. 北京: 机械工业出版社,2001.
ZHONG K L.ACourseinProbabilityTheory[M]. Beijing: China Machine Press, 2001.(in Chinese)
[21]计时鸣, 李琛, 谭大鹏, 等. 基于Preston方程的软性抛光粒子流加工特性[J]. 机械工程学报,2011,47(17): 156-163.JI SH M, LI CH, TAN D P,etal.. Study on machinability of softness abrasive flow based on Preston equation [J].ChineseJournalofMechanicalEngineering, 2011, 47(17): 156-163.(in Chinese)

刘德福(1971-),男,湖南茶陵人,博士,教授,博士生导师,2008年于中南大学获得博士学位,主要从事精密制造方面的研究。E-mail: liudefu@csu.edu.cn

陈涛(1986-),男,甘肃山丹人,博士研究生,2014 年于兰州理工大学获得硕士学位,主要从事精密制造方面的研究。E-mail:ctxy999@126.com
(版权所有未经许可不得转载)
Material removal mechanism for fused glass by using soft particles
LIU De-fu1,2*, CHEN Tao1,2, CHEN Guang-lin1,2, HU Qing1
(1.CollegeofMechanicandElectricalEngineering,CentralSouthUniversity,Changsha410083,China;2.StateKeyLaboratoryofHighPerformanceComplexManufacturing,CentralSouthUniversity,Changsha410083,China)
*Correspondingauthor,E-mail:liudefu@cus.edu.cn
On the basis of Arrhenius theory and molecular vibration theory, the elastic and hyper elastic contact among the soft polishing particles, fused glass and the polishing pad was analyzed, then the material removal mechanism of fused glass using soft particles in polishing process was explored. According to the theoretical research mentioned above, a lots of polishing experiments were carried out and a material removal rate model was established. Theoretical calculation and experimental results show that the material is mainly removed by the interfacial tribo-chemical effect between polishing particles and fused glass in chemical mechanical polishing. The depth of a single particle embedding into the fused glass is 0.05 nm and the material removed by a single particle is a molecular scale. The superficial molecules of fused glass are easier to gain enough energy to implement chemical reactions, so that the materials could be removed easily. Moreover, the polishing pressure, the chemical reagents in polishing liquid, and the relative movement speed between the fused glass and the pad determine the material removal rate of fused glass.
fused glass; chemico-mechanical polishing; soft polishing particle; material removal mechanism; model of material removal rate
2016-01-13;
2016-03-12.
国家自然科学基金面上资助项目(No.51275534);湖南省自然科学基金资助项目(No.2015JJ2153)
1004-924X(2016)07-1623-09
TQ171.731; TQ171.684
Adoi:10.3788/OPE.20162407.1623

