附加O离子注入对单晶Si中H注入损伤的影响研究
王 卓,田 光,石少波
(天津职业技术师范大学理学院,天津 300222)
附加O离子注入对单晶Si中H注入损伤的影响研究
王 卓,田 光,石少波
(天津职业技术师范大学理学院,天津 300222)
室温下将40 keV 的H离子以不同剂量注入到单晶Si样品中,部分H预注入的样品又进行了190 keV O离子注入。采用光学显微镜和透射电子显微镜分析比较了注入及退火后单晶Si样品的表面损伤以及注入层微观缺陷的形貌。光学显微镜结果表明,只有高剂量H离子注入的单晶Si经过450 ℃退火后出现了表面发泡和剥离,而总剂量相同的H、O离子顺次注入单晶Si的样品没有出现任何表面损伤。透射电子显微镜结果表明,低剂量H离子注入单晶Si经过高温退火可以在样品内部形成一个由空腔构成的损伤带。附加O离子注入对损伤形貌产生了重要影响,空腔消失,损伤带由大量板状缺陷构成。
H离子注入; 空腔; 单晶Si
1 引 言
一定剂量的H离子注入单晶Si在随后的热处理过程中能够在注入层产生板状缺陷、空腔、微裂缝等[1,2]。当注入的H离子剂量足够高时,还能够导致单晶Si表面出现局域剥离甚至层离等表面损伤[2-4]。Bruel以H离子注入单晶Si导致的表面剥离原理为基础,提出了一种制备SOI(Silicon-on-insulator)材料的新技术,即智能剥离(Smart-cut)技术[5]。智能剥离技术在制备SOI材料方面的优势非常明显,传统的注氧隔离技术所需的O离子注入剂量较高(约1017~1018cm-2),而智能剥离技术所需的H离子注入剂量约为1016cm-2,因此采用智能剥离技术能够有效降低制备SOI材料的生产成本。
智能剥离技术的应用范围很广,不仅可以用来制备SOI材料,还可以用来制备其它具有特殊功能和应用前景的多层复合材料,例如在玻璃上构建单晶SiC薄膜[6],在Si基体上InP薄膜[7]和GaAs薄膜[8]等。采用智能剥离技术制备制备多层复合功能材料成为了本方向的一个研究热点。为了降低表面剥离所需的注入离子总剂量从而减少生产成本,降低表面剥离所需的热处理温度从而避免不同材料热错配的影响,促进该技术更好地应用于复合材料制备领域,还需要对注入离子与缺陷之间相互作用的机理进行深入研究。近年来,采用H离子和其它离子共同注入单晶Si研究损伤形成及其热演变性能受到人们的极大关注。研究表明,由于He离子注入单晶Si能够引入气体原子He以及大量的空位型缺陷[9],将H和He离子联合注入单晶Si能够促进气泡的形成和热生长,降低Si表面剥离所需要的热处理温度和注入离子的总剂量[10-12]。Tong等的研究表明[13],一定剂量的B离子先注入单晶Si然后再进行H离子注入也能够降低表面层离所需要的热处理温度。作为气体离子,O注入在引入空位型缺陷[14]的同时也有助于增大缺陷中的压强,于是本研究采用H、O离子联合注入单晶Si,采用光学显微镜与同等注入总剂量下H离子单独注入Si的表面损伤情况进行了比较。但是与Tong等的研究[13]不同的是,本研究先注入H离子然后进行O离子注入,借助透射电子显微镜详细地比较研究了附加O离子注入对H注入损伤微观形貌的影响。
2 实 验
实验中,采用p型(100)单晶Si片。在室温下对单晶Si片首先进行40 keV H离子注入,H的注入剂量分别为4.5×1016cm-2和3.5×1016cm-2。随后对部分低剂量H离子注入的单晶Si样品又进行了O离子注入,为使O离子注入深度与H离子基本相同,通过TRIM程序[15]的模拟计算,固定O离子的注入能量为190 keV。O离子的注入剂量为1×1016cm-2,因此单晶Si中H、O离子的注入总剂量与高H样品中H离子的注入剂量相同。注入后将样品切割成小块进行高温退火处理,退火在真空中进行,退火时间均为1 h。
采用光学显微镜(OM)对注入及退火后单晶Si样品的表面损伤进行了观测。此外,对经过800 ℃退火的低H以及H、O顺次注入的样品又进行了截面透射电子显微镜(XTEM)观测。XTEM样品的制备是按照传统方法通过机械减薄和离子束减薄来完成的。电镜分析使用了Tecnai G2 F20 S-Twin型电子显微镜,加速电压为200 kV。借助于XTEM观测,可以直观的看出注入层缺陷的微观形貌以及深度分布等特征。
3 结果与讨论
注入及退火后单晶Si表面损伤的光学显微镜结果

图1 注入及退火后单晶Si表面损伤的光学显微镜照片 (a)H、O顺次注入样品,800 ℃退火;(b)高H样品,450 ℃ 退火Fig.1 OM images of the surface damage on implanted and annealed crystalline Si(a) H and O sequentially implanted sample,800 ℃ annealing; (b) high dose H implanted sample, 450 ℃ annealing
如图1所示。需要指出的是,低H以及H、O离子顺次注入的单晶Si样品即使退火温度达到800 ℃也没有观测到发泡、剥落等表面损伤。作为例子,图1a给出了H、O离子顺次注入单晶Si经800 ℃退火后样品的表面形貌。从图中可以看出,样品表面平整,没有任何损伤出现。而对于高H样品,当退火温度为400 ℃时,样品表面没有观测到损伤产生。进一步升高退火温度到450 ℃,样品表面出现了剧烈的损伤。
如图1b所示,样品表面出现了大量的发泡(黑色箭头所示)和剥离(白色箭头所示)。表面发泡基本为圆形,而表面剥离的形状不规则。我们对表面剥离的尺寸进行了统计,发现表面剥离的尺寸分布在3.2~12.1 μm之间,平均尺寸约为6.6 μm。其中尺寸为5~8 μm的表面剥离数量较多,约占总数的71.1%。从光学显微镜的结果可以看出,H离子以剂量4.5×1016cm-2注入单晶Si并经过450 ℃退火,能够引起表面出现大量的发泡和剥离,但是总剂量相同的H和O离子顺次注入的单晶Si样品,即使经过高温800 ℃退火,表面依然没有出现损伤。这表明,后注入的1×1016cm-2的O离子,并没有发挥同等剂量H离子的物理和化学作用,后注入的O离子不利于表面损伤的形成。
表面损伤的形成来源于注入层缺陷的热演变。为了揭示注入层缺陷的微观形貌,研究附加注入的O离子对缺陷形成及热演变的影响,我们又进行了XTEM观测。需要说明的是,高H样品表面出现了严重的发泡和剥离现象,不利于透射电镜观测,因此电镜分析只测试了低H以及H、O顺次注入的单晶Si样品。图2给出了低H样品经800 ℃退火1 h后的XTEM照片。从图2a中可以看出,样品内部产生了一个比较狭窄的损伤带,深度位于表面下480 nm左右。图2b给出了损伤带的放大照片,可见损伤带主要由空腔和大尺寸的位错构成。大空腔一般位于缺陷带中央,周围环绕着一些尺寸约为几个纳米的小空腔。仔细观察空腔的形貌,发现尺寸较大的空腔(60~100 nm左右)近似呈现出椭圆形,并且沿着损伤带的方向伸长。而尺寸较小的空腔并不是规则的圆形,如白色箭头所示,该空腔的尺寸约为33.0 nm,空腔带有明显的刻面。图2c给出了一个尺寸约为44.7 nm空腔的放大照片,空腔近似为圆形,但仍可以清楚的看出其中的刻面。空腔周围晶格完好,没有出现非晶区域。
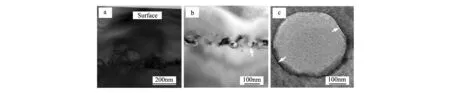
图2 低H样品经800 ℃退火1 h后损伤形貌的电镜照片 (a)整体形貌;(b)损伤带形貌;(c)空腔Fig.2 XTEM micrographs showing defects created in Si implanted with low dose H ions and followed by 800 ℃ annealing for 1 h (a) the overall defect morphology; (b) the morphology of defect band; (c) the cavity

图3 H、O顺次注入单晶Si经800 ℃退火1 h后损伤形貌的电镜照片 (a)整体形貌;(b)损伤带放大照;(c)板状缺陷Fig.3 XTEM micrographs showing defects created in Si sequentially implanted with H and O ions and followed by 800 ℃ annealing for 1 h(a) the overall defect morphology; (b) the close view of defect band; (c) the platelet
如图3所示,H、O顺次注入的单晶Si样品经800 ℃退火1 h后缺陷的微观形貌发生了剧烈的变化。从图3a中可以看出,样品内部出现了一个宽度约为270 nm的损伤带,损伤带的中心深度约为530 nm。通过损伤带的放大照片图3b可以看出,损伤带主要由大量的板状缺陷构成,并没有发现空腔存在。板状缺陷位于(100)面,与样品的表面平行,尺寸多为十几纳米。作为例子,图3c给出了一个板状缺陷的放大照,该板状缺陷的尺寸约为14.2 nm。板状缺陷周围的晶格也非常完整,没有观测到非晶区域存在。
通过XTEM结果可以看出,附加的O离子注入会对H注入单晶Si的损伤形貌产生重要的影响。剂量为3.5×1016cm-2的H离子注入单晶Si经800 ℃退火后,样品内部的损伤带主要由空腔构成。而附加注入1×1016cm-2的O离子后,空腔消失,损伤带由大量板状缺陷构成。因此,O离子后注入会抑制甚至阻碍H空腔的形成与热生长。
H的化学性质非常活泼,在H注入单晶Si的过程中,一些Si-Si断键与H相互作用结合成Si-H-H-Si键。由于H键较弱,在随后的退火过程中H键会发生断裂促使板状缺陷形成。此外,H注入单晶Si能够产生大量的空位型缺陷,H原子和空位型缺陷相结合能够形成H与空位的复合体。当退火温度达到400 ℃左右,一部分小尺寸的单H缺陷不稳定,会分解释放出H原子,H原子彼此结合形成H2分子。在进一步的退火过程中,板状缺陷能够通过吸收H2而成长为微裂缝,H空位的复合体也会不断的吸收空位和H2分子,最终形成了电镜下能观测到的空腔。由于损伤带的位置较深,空腔在内部H2压强的作用下沿纵向增大相对较难而沿横向增大比较容易,因此如图2b所示,大尺寸的空腔通常沿缺陷带的方向伸长。然而在低剂量H离子注入单晶Si的情况下,空腔的最大尺寸约100 nm,空腔之间没有相互连通,所以观测不到任何表面损伤。然而,可以看到大空腔周围有大尺寸的位错存在,表明大空腔周围有一个很大的应力场,大空腔有沿着损伤带方向进一步扩张的趋势。空腔的生长与注入产生的H原子以及引入的大量空位型缺陷有关,增大H离子的注入剂量,会同时增大H2分子以及空位型缺陷的数量。在不断增长的H2压强的作用下,空腔沿着横向和纵向两个方向发展,与其它的空腔或者微裂缝之间相连通,最终导致了表面发泡和剥离现象的产生,如图1b所示。
对于H、O离子顺次注入的单晶Si样品,H离子注入首先引入了H原子和大量H的复合体。但是O原子比H原子重,在随后O注入的过程中,O原子会和H的复合体发生碰撞损坏这些缺陷的结构,产生了大量的悬挂键。Moutanabbir等的研究结果也表明,较高能量的He离子后续注入能够破坏较低能量H预先注入产生的缺陷结构[16]。在退火过程中,活泼的H原子将和悬挂键相结合,促进了板状缺陷的形成。因此,如图3b所示,H、O离子顺次注入单晶Si经800 ℃退火后出现的大量板状缺陷是由于较重的O离子后续注入对H复合体结构的损伤造成的。与空腔相比,板状缺陷的尺寸较小,虽然密度很大但是彼此之间没有连通,因此采用光学显微镜观测不到任何表面损伤。值得注意的是,由板状缺陷构成的损伤带分布范围很宽。根据Nguyen的研究,较高剂量H、He离子联合注入单晶Si形成的部分非晶区域能够导致板状缺陷和微裂缝出现在Si内较深的位置[17]。虽然我们的XTEM照片中没有显示出非晶区域,但是较大的应力场以及重损伤区的存在也会导致板状缺陷出现在样品深处,从而导致损伤带变宽。
4 结 论
综上所述,采用光学显微镜和截面透射电子显微镜研究了H离子单独注入以及H、O离子顺次注入单晶Si的表面损伤以及注入层缺陷的微观形貌。与同等剂量下H注入及退火后产生的表面发泡和剥离相比,H、O联合注入并不能引起表面损伤。研究结果表明,附加的O离子注入会抑制H空腔的形成,不利于表面损伤的产生。这是因为后续注入的O离子较重,能够破坏H预先注入引入的缺陷的结构,导致注入层形成了大量的板状缺陷。因此,采用H和其它离子共同注入单晶Si时,为了促进表面剥离,应考虑采用重离子先注入H离子后注入的顺序。
[1] Capello L,Rieutord F,Tauzin A,et al.Quantitative Study of hydrogen-implantation-induced cavities in silicon by grazing incidence small angle X-ray scattering[J].J.Appl.Phys., 2007,102(2):026106.
[2] Fecioru A M,Senz S,Scholz R,et al.Silicon layer transfer by hydrogen implantation combined with wafer bonding in ultrahigh vacuum[J].Appl.Phys.Lett.,2006,89(19):192109.
[3] Henttinen K,Suni I,Lau S S.Mechanically induced Si layer transfer in hydrogen-implanted Si wafers[J].Appl.Phys.Lett.,2000,76(17):2370-2372.
[4] Höchbauer T,Misra A,Nastasi M,et al.Physical mechanisms behind the ion-cut in hydrogen implanted silicon[J].J.Appl.Phys.,2002,92(5):2335-2342.[5] Bruel M.Silicon on insulator material technology[J].ElectronicsLetters,1995,31(14):1201-1202.
[6] Tong Q Y,Lee T H,Werner P,et al.Fabrication of single crystalline SiC layer on high temperature glass[J].J.Electrochem.Soc.,1997,144(5):L111-L113.
[7] Aspar B,Jalaguier E,Mas A,et al.Smart-cut(R) process using metallic bonding:application to transfer of Si,GaAs,InP thin films[J].ElectronicsLetters,1999,35:1024-1025.
[8] Radu I,Szafraniak I,Scholz R,et al.GaAs on Si heterostructures obtained by He and/or H implantation and direct wafer bonding[J].J.Appl.Phys.,2003,94(12):7820-7825.
[9] 刘昌龙,尹立军,吕依颖,等.不同能量He离子注入单晶Si引起的损伤研究[J].人工晶体学报,2005,34(4) :714-719.
[10] Nguyen P,Bourdelle K K,Maurice T,et al.The effect of order and dose of H and He sequential implantation on defect formation and evolution in silicon[J].J.Appl.Phys.,2007,101:033506.
[11] Agarwal A,Haynes T E,Venezia V C,et al.Efficient production of silicon-on-insulator films by Co-implantation of He+with H+[J].Appl.Phys.Lett.,1998,72(9):1086-1088.
[12] 王 卓,刘昌龙.H、He离子联合注入单晶Si引起的表面损伤研究进展[J].硅酸盐通报,2014,33(8):1996-2000.
[13] Tong Q Y,Scholz R,Gösele U,et al.A ''smarter-cut'' approach to low temperature silicon layer transfer[J].Appl.Phys.Lett.,1998,72(1):49-51.
[14] Stein H J,Vook F L,Borders J A.Direct evidence of divacancy formation in silicon by ion implantation[J].Appl.Phys.Lett.,1969,14(10):328-330.
[15] Ziegler J F,Biersack J P.SRIM (Stopping and range of ions in matter) computer code (http://www.srim.org).
[16] Moutanabbir O,Terreault B.Effects in synergistic blistering of silicon by coimplantation of H,D,and He ions[J].Appl.Phys.Lett.,2005,86:051906.
[17] Nguyen P,Cayrefourcq I,Bourdelle K K,et al.Mechanism of the smart cut TM layer transfer in silicon by hydrogen and helium coimplantation in the medium dose range[J].J.Appl.Phys.,2005,97:083527.
Effect of O Postimplantation on the Damage of H Implanted Crystalline Si
WANGZhuo,TIANGuang,SHIShao-bo
(School of Science,Tianjin University of Technology and Education,Tianjin 300222,China)
Crystalline Si samples are first implanted at room temperature with 40 keV H ions of different doses.Subsequently,some of H preimplanted samples are implanted with 190 keV O ions.Optical microscopy (OM) and cross-sectional transmission electron microscopy (XTEM) are used to study the surface damage as well as defect microstructures of annealed Si samples.OM results show that surface blisters and exfoliations only occurs on samples implanted with high dose H ions and after 450 ℃ annealing.However,no surface damage is observed on Si sequentially implanted with H and O ions at the equivalent total doses.XTEM observations exhibit a cavity band in Si samples implanted with low dose H ions and after high temperature annealing.But O postimplantation has a great influence on the morphology of defect microstructures.No cavities are observed and a density of platelets appears in the damage band.
H ion implantation;cavity;crystalline Si
天津市应用基础与前沿技术研究计划项目(15JCYBJC16700);天津职业技术师范大学人才启动基金项目(KYQD11001);天津职业技术师范大学科研发展基金资助项目(KJ2009010)
王 卓(1983-),女,博士,讲师.从事离子与固体相互作用的研究.
O483
A
1001-1625(2016)08-2600-04

