芳纶纤维性能分析及其在电子产品中的应用
吴永明,周文英
(西安科技大学化工学院,西安,710054)
芳纶纤维性能分析及其在电子产品中的应用
吴永明,周文英
(西安科技大学化工学院,西安,710054)
探讨了芳纶纤维族的性能与特点。报道了松下电工ALIVH产品工艺设计与特点,并详细探讨了ALIVH工艺流程。并指出对开发高性能印刷电路板(特种印刷电路板)的借鉴作用。
芳纶(Kevlar); ALIVH;芳纶无纺布环氧树脂印刷线路基板
芳纶由于其优异的性能被称为全能纤维,是综合性能最好的有机纤维之一,对位芳纶纤维具有优异的力学性能、电绝缘性能、透波性能以及尺寸稳定性能。在高精尖端领域尤其是电子领域具有巨大的发展潜力。对位芳纶的开发已成为促进我国国防军工及相关产业快速发展的迫切需要。
1 综合性能
1.1芳纶纤维的结构
芳纶具有很高的结晶度。Kevlar29纤维的晶粒尺寸小于5.2nm,而Kevlar49大于5.8nm。径向的褶叠状结构经过交替的面以相等但相反的角度堆积而成。薄片间分子的引力属于范德华力。这就解释了为什么Kevlar纤维有较低的纵向剪切模量和横向性能。对Kevlar纤维来说,PPTA晶粒与纤维之间的角度在15o~20o之间,而对Kevlar49纤维则为10o或更小。
Kevlar纤维的一个显著特点是其结晶结构中大量微纤结构。通过等离子体腐蚀Kevlar纤维揭示了其具有定向纤维结构。沿着纤维轴向排列的弯曲的微纤宽度约为600nm,长度可达几个厘米。每一个微纤呈现出间距30~40nm的一系列的带状物,这被认为是缺陷层 分隔和晶面的堆积所致。从横截面来看,Kevlar纤维的结构是不均一的,表现出一种表层-内部的不同行为,表层有着更高程度的微纤取向,比内部密度更大。

图1 Kevlar纤维的微观褶叠状结构


1.2芳纶纤维的性能
由于芳纶(芳香族聚酰胺)纤维具有优异的化学稳定性、热稳定性及高强、高模等特性,因此作为高性能特种纤维,已广泛应用于众多领域,得到了世界各国的广泛关注。芳纶纤维用途广泛,用量在三大高性能纤维中(芳纶、碳纤维和高强高模聚乙烯纤维)居首位。芳纶纤维从20世纪50年代开始发展,早期的芳纶,如杜邦公司生产的Nomax,即间苯二甲酰间苯二胺,有良好的热稳定性,但是拉伸强度不高。新一代的高强度、高模量的芳纶是70年代在Kevlar和同事的工作的基础上发展起来的。作为一类高性能材料,芳纶料的优异性能在不同的领域被被开发应用,其市场需求也将迅速增大,特别是在高性能芳纶纤维的需求上将表现得更为突出。现在主要有两种芳纶:1972年由杜邦公司生产的Kevlar纤维和1985年由日本Teijin公司生产的Technora纤维。
芳纶纤维拉伸强度高。单丝强度可达3773MPa;254mm长度纤维束的拉伸强度为2774MPa,大约为铝的5倍。芳纶纤维的冲击性能好,大约为石墨纤维的6倍,为硼纤维的3倍,为玻璃纤维的0.8倍。芳纶与其他纤维的性能比较见表1、2、3。
芳纶纤维具有良好的热稳定性,耐火而不熔,当温度达487oC时尚不熔化,但开始炭化。所以在高温作用下,它直至分解不发生变形,能长期在180oC下使用,在150oC下作用一周后强度、模量不会下降,即使在200oC下,一周以后强度降低15%,模量降低4%,另外在低温(-60oC)不发生脆化,也不降解。
芳纶纤维的线膨胀系数和碳纤维一样具有各向异性的特点。纵向线膨胀系数在0~100oC时为-2×10-6/oC;在100~200oC时为-4×10-6/oC。横向线膨胀系数为59×10-6/oC。
1.3芳纶纤维样品

图2 凯夫拉Kevlar纤维部分产品样品展示

图3 微电子印制电路板产品样品

2 芳纶电子产品开发及应用
2.1芳纶纤维在电子电器相关领域的应用
松下电器产业和松下电子部件公司(简称松下电工)用芳纶无纺布浸渍高耐热的环氧树脂使其成为电子封装材料,固化后在表面贴上铜箔,制成印刷线路基板。(Copper Clad Laminate,全称覆铜板层压板,英文简称CCL)-----又名基材。将补强材料浸以树脂,一面或两面覆以铜箔,经热压而成的一种板状材料,称为覆铜箔层压板。它是做PCB的基本材料,常叫基材,应用于印制线路板行业。当它用于多层板生产时,也叫芯板(CORE)。据称其今后可望用于手提电话和PHS搭载的印刷线路的基板。松下电器产业株式会社台湾的新工厂完工,以及各种层数的IVH(ALIVH)多功能多层树脂板生成开始,这些产品主要用在智能电话终端方面。ALIVH系列的PCB采用的基材是非织造芳纶,其是耐热和强大的合成纤维,并可通过与铜粘贴的激光填充孔使任意层之间互连。全球手机市场正从标准电话向智能手机(高功能终端)迅速转变,在长远看来其增长预期明显。为了满足日益增长的对这些高功能终端使用的PCB的需求,松下正在努力提高其原有的ALIVH多层树脂的海外生产能力,以提供高密度多层板应用的优势。松下ALIVH作为其最优的业务领域之一,主要是因为随着智能手机的进一步发展,专用的多层树脂板技术是高功能终端中一个必不可少的关键组成部分。该公司将继续积极发展其ALIVH业务,以满足世界各地的智能手机和其他移动终端制造商的需求。
芳纶纤维是一种新型的有机增强材料,相比覆铜板常用的无机玻璃纤维布来说,它具有质轻比强度高低介电易加工等优点,适合制作一些高档次的印刷线路板,如封装材料轻薄短小通电子产品航天航空军事等的应用领域.芳纶纤维同时也可以广泛地应用于复合材料电气绝缘结构件等领域。芳纶材料在通信电子领域的应用始于上世纪90年代初期,随着电子信息业的飞速发展,作为电子信息产品基材的PCB面临许多新的挑战,其中轻、薄、小和高密度化成为发展趋势,激光钻孔技术同时兴起。由于对位芳纶纤维的诸多优点,满足了当时的技术趋势而备受关注。芳纶纤维相对于最常用的覆铜板增强材料玻璃纤维布具有如下突出优点:有机增强材料,更适合激光钻孔加工比重轻30%左右,有利于电子产品的轻量化;较低的介电常数,有利于提高板材的高频特性,适应电子产品不断提高的工作频率;平面热收缩特性,降低板材的平面热膨胀率,有利于电子产品的高密度化,可用作各类IC封装基板。当前,芳纶纤维成为PCB制造商开发应用的一个重要方向。芳纶纤维目前最成功的应用就是松下的ALIVH(Any Layer Inner Via Hole Strueture Multilayered Printed WiringBoard的简称)工艺,利用该技术,松下电工开发了当时世界上最轻薄短小化的手机PD系列。
2.2松下电工—各种高、中端印制板用基板材料。
松下电工产品主要有HIPER系列和MEGTRON系列。具体如:FR-1、FR-4、CEM-3、FPC系列。松下电工覆铜板 CEM-3 FR-1 FR-4 PCB,见表4。)
松下部分覆铜板样例
(Ⅰ) 品牌:松下电工-覆铜板
型号:CEM-3R1786
规格(尺寸):1020mm*1025mm;1220mm*1025mm;
规格(厚度/铜箔):1.0TH/H1/1;1.6T H/H 1/1;
特长:1.优良的耐漏电痕迹性(CTI 600)
2. 出色的耐CAF特性
3.卓越的板厚精度
4.独特的制造工法、本公司制造过程中减少1/4的CO2排放量(与本公司一般FR-4相比)
用途:打印机、显示器等办公自动化设备、空调机、游戏机、调谐器、厨房电器、电源基版等。
(Ⅱ) 高·熱傳導性無紡玻纖覆銅板—高·熱傳導性CEM-3 R1787
特性/Features
①根據高·熱傳導性、使部品及導體(線路)的溫度上升得到抑制
②具有出色的耐漏電性(CTI 600)
③優異的板厚精度,為±0.05mm,與通常复合覆銅層壓板相比,是其精度的3倍
④通過独特的制造工藝,使制造過程中CO2的排出量減少75%(於敝司一般FR-4相比較)
特性/Applications
具有規格
—基材厚度0.8mm、0.9mm 、1.6mm
—銅箔厚度18/18μm、35/35μm
—尺寸規格1225*1025mm、1020*1025mm

表4 松下电工产品系列及其应用范围
2.3松下电气产业和松下电子部ALIVH工艺开发及芳纶纤维在印刷线路基板中的应用
2.3.1ALIVH工艺为目前芳纶纤维在电子领域最成功的应用。
具体来讲,该公司设计者和开发者就是利用下面所述的材料及生产加工技术进行开发研究。
1.用二氧化碳激光高速地加工微细的过孔
2.基板材料采用ァラミド无纺布Ф1与环氧树脂组成的复合材料
3.开发新的利用导电胶填充的层间连接技术
该生产加工技术不需要钻孔和镀铜,在各层进行积层的同时形成IVH,采用全层IVH构造,可以实现基板的小型化,由于在IVH上面也能安装器件,所以能够有效地提高安装的密度.而且,因为采用了ァラミド无纺布,因而具有低介电常数、重量轻的特点。另外利用其低热膨胀系数和平滑性,有望制作安装倒装片的MCM基板。

表5 ALIVH基本尺寸
内层的信号层为18μm厚的铜箔,最外层布线可以是18μm或者35μm厚的铜箔。因为多层板的各层层压材料的厚度大约只有0.1mm,所以它可以做得相当薄,4层板的厚度只有0.35mm,6层板的厚度只有0.55mm。另外,由于不需要镀铜过程,铜布线的厚度与铜箔的厚度完全一样.因此和以往的方法相比,也有利于形成精细的模型.在工业生产上,线宽和间距分别可以达到6μm和90μm。而且,因为焊盘直径可以做得很小,所以直接在片状器件和半导体芯片的焊盘下面就能够形成IVH,非常适合于高密度安装。

表 6 ALIVH 基板性能
表6所示的是“ALIVH”的基板性能。采用新材料ァラミド无纺布,可以实现低热膨胀系数、低电常数和轻量化。特别是由于ァラミド无纺布具有负的热膨胀系数,可以通过它调整与环氧树脂的组成比例来控制基板的热膨胀系数,使其达到与陶瓷基板相同的程度.
“AIIVH”的材料、生产工艺和结构使得它具有以下一些特点。
1)实现基板尺寸的小型化并进行高密度的安装。跟本公司以前的基板相比,面积可以减小30一50%;
2)用高强度的ァラミド无纺布制作基板,既薄又轻。
3)采用全层IVH的构造,可使布线最短,而且由于它的低介电常数,因此可以进行高速信号处理。
4)容易使用计算机进行自动设计, 能够缩短设计周期。
2.3.2ALIVH采用了于ァラミド(芳香族聚酰胺类纤维)无纺布的基板材料
现在,一般使用的基板材料都是通过让作为增强材料的玻璃纤维布浸渍含有热硬化
树脂即环氧树脂制作而成。在本次开发中, 用能够进行激光加工的ァラミド无纺布(全芳香族聚酞胺的总称)作为增强材料,而其浸含的环氧树脂与以往的相同。ァラミド无纺布是将纺丝得到的ァラミヤ纤维切割成短纤维而成,因此它具有了ァラミド纤维的高强度、高耐热等特性,是优秀的基板用增强材料。在本次开发中,使用的层压材料就是用这种ァラミド不织布浸含高耐热环氧树脂(相当于FR一5)制作而成的。
“ALIVH”最新采用脉冲发振型二氧化碳激光加工机进行高速、微细地打孔加工。加工的方法是,让激光通过电流镜子[注Φ2](galvanomirror)和fθ镜头[注Φ3]进行扫描,并在层压材料上聚焦打孔,与传统的机械方法—钻孔加工相比,加工速度大约提高10倍(约100孔/秒);利用
fθ镜头聚焦的区域范围可以达到50mmx50mm,一个区域加工完了以后,X一Y载物台带着加工件移到下一个区域继续加工。加工的孔径最小大约可以达到150料m左右。另外,为了有效地利用激光的能量,可以将激光分成若干束,通过多个电流镜子与印镜头在多个方向上进行加工。这样可以同时对多块层压材料进行打孔加工。
使用导电胶实现新的层间连接方法
a)制作过程
IVH的连接不采用以前的镀铜的方式,而是使用新开发的由铜粉、环氧树脂和硬化剂组成的无溶剂型导电胶来进行连接。
图6表示的是采用导电胶的“ALIVH”的制作过程的概况。首先,用脉冲发振型二氧化碳激光在层压材料(浸含有环氧树脂的ァラミド无纺布)上进行打孔加工。1个脉冲可以加工直径约150μm的小孔。

图5 ALIVH基本构造
接着,在这个孔穴中填充上面所述的导电胶。再在层压材料的两面加七两层粗化铜箔(1/2OZ),在180~2000C的温度下进行真空加热、加压。这样就使得层压材料中的树脂以及导电胶中的树脂硬化与铜箔粘合在一起,同时也完成了电气上的连接。然后,使用以往的蚀刻法在基板两面的铜箔上制作布线图案,这样就得到了内部具有IVH的画面基板。
将经过上述步骤制作出的两面基板作为芯子进行多层化处理。具体的过程是,在这个芯子的两面把填充有前面所述的导电胶的层压材料根据铜箔的位置叠加在一起,再一次进行热压,实现多层化处理。最后,对最外层的铜箔进行蚀刻处理,这样4层基板就制作出来了。
在需要进一步多层化时,将这个4层基板作为芯子,再次重复上面的过程,就能很容易地制造出6层、8层基板。
对于使用导电胶的层间连接法,因为层压材料和导电胶是在热压时同时硬化的,每个过孔的电阻都在1mΩ以下,达到以前镀铜通孔的极低的连接电阻的同等程度。如上所述,本加工工艺不需要镀铜过程,在地球环境的保护方面也是令人满意的。
b)使用导电胶的层间连接的可靠性
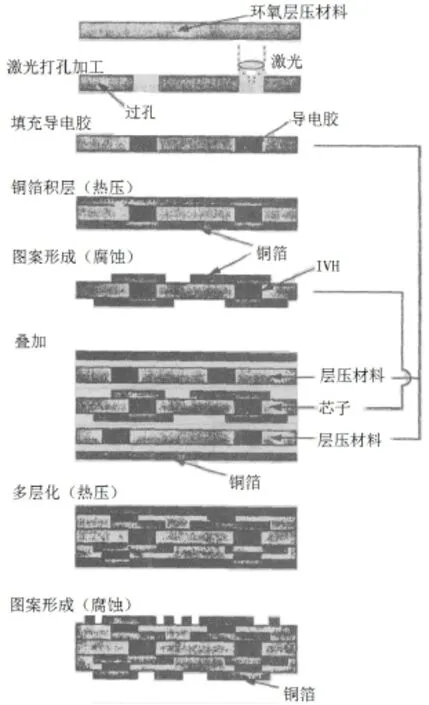
图6 ALIVH制作过程
本全层IVH多层基板构造的实现要点就是使用导电胶进行层间连接。表7说明了这种连接方法的可靠性。在低温和高温的放置试验中、另外在高温高湿的放置试验中、在PCT的高湿空气中的放置试验中显示出了极高的可靠性。导电胶采用铜粉作为填充物,在其两边还覆盖着铜箔,因此即使氧化了也不会发生接触不良。另外,在温度循环、热油试验、回流焊接等的热冲击试验中,电阻变化率也在10%以内,非常稳定.还有热油试验、回流焊接试验等等的试验结果。不管采用哪个试验条件,在2000C以上的温度下都没有发生断线的情况;显示了极高的耐热冲击的特性。
在本ALIVH工艺中使用了高性能纤维ァラミド(芳香族聚酰胺类)纤维,正是由于芳纶的优异性能使其在PCB中得到了运用,目标是特种印制电路板的开发,开发高性能芳纶树脂基印制电路板在尖端技术领域具有巨大的潜力。其有别于传统板材的树脂纤维体系配方设计。

表 7 使用导电胶的层间连接的可靠性
3 今后的展望
日本松下电工作为老牌的覆铜板制造和研究公司,研发水平名列前茅,处于世界第三位,不断推出新产品以满足下游需要。从技术的角度看,对提高自身产业水平很具有借鉴作用,对覆铜板技术革新有促进作用。
现在,正计划将具有全层IVH构造的树脂多层基板“ALIVH”应用到便携式情报终端、计算机、计算机外围设备等小型.高密度机器中去。与原来采用玻璃环氧基板相比,用同样的器件设计电路,只需一半的基板面积就行了。
今后,将利用“ALIVH”的小型、高密度、低热膨胀等特点,制作CSP(ChipSizePa-ckage)用的母板和倒装片安装用的MCM一L基板,关于这一点也正在讨论之中。
注意并掌握芳纶在电子领域的开发应用这一前沿,展开对柔性印刷电路板、特种印刷电路板的关注与研究有助于提升国家科技实力。
[1] 胡保全,牛晋川.先进复合材料[M].北京:国防工业出版社,2012.
[2]伊洪峰,魏剑.复合材料[M].北京:冶金工业出版社,2010.
[3] M. Alagar, A. Ashok Kumar, K.P.O. Mahesh etc. Studies on thermal and morphological characteristics of E-glass/ Kevlar 49 reinforced siliconized expoxycomposites[J]. European Polymer Journal Volume 36, Issue 11,November 2000, Pages 2449-2454.
[4] 树脂多层板“ALIVH”开发—在所有层之间形成IVH,实现高密度的安装—松下电器产业 中谷 诚一·家本 胜秀·石田彻松下电子部品和田·彰
[5] 张家亮. 世界覆铜板新品种新技术赏析(2)——松下电工兼容无铅焊接的高耐热低介
质损耗的 PCB 基板材料 R-2125. Printed Circuit Information印制电路信息 2009 No.1.
[注Ф1]:ァラミド无纺布:作为基板材料的增强材料。ァラミド(芳香族聚酰胺类)纤维是用来做防弹背心汽车轮胎等的高强度纤维,将这种纤维切短采用造纸技术便能制得ァラミヤ无纺布。
[注Φ2]:电流镜子:把反射激光的镜子装在有四个旋转方向的抽上,使得激光能够高速地进行扫描.
[注Φ3]:fθ镜头:为使经过电流镜子反射而进行扫描的激光在平面上聚焦而设计钓果焦镜头,通常由3~4枚镜头组合而成。
Aramid fiber properties and its application in electronic products
Wu Yongming,Zhou Wenying(Xi`an University of Science and Technology of School of Chemical Engineering,China,710054)
It is discussion on the family of aramid fiber of performance and features.and reporte the product and process design characteristics of Matsushita Electric ALIVH,and discussed in detail ALIVH process.It pointed reference to the development of high performance printed circuit board (special printed circuit board).
aramid (Kevlar);ALIVH;non-woven aramid epoxy printed circuit board

