碳化硅MOSFET电热耦合模型及分析
吕秀婷,谭平安
(湘潭大学信息工程学院,湘潭411105)
碳化硅MOSFET电热耦合模型及分析
吕秀婷,谭平安
(湘潭大学信息工程学院,湘潭411105)
为在Matlab/Simulink环境下准确预测碳化硅SiC(silicon carbide)功率器件在实际工况下的结温变化,针对SiC MOSFET器件提出了一种基于时变温度反馈的电热耦合模型建模方法。该方法能更好地反映SiC MOSFET在导通和开关过程中的性能特点,模型从器件物理分析和工作机理出发,将功率损耗和热网络模块引入建模,实时反馈器件结温和更新温度相关参数。采用CREE C2M0160120D SiC MOSFET器件进行测试,根据制造商数据手册和测试实验中提取,仿真结果证实了该建模方法的正确性,为器件的寿命预测和可靠性评估提供了研究基础。
碳化硅;MOSFET;电热耦合;Matlab/Simulink
引言
近年来,随着变流器的功率、频率的不断提升,传统硅Si(silicon)材料本身物理性能的缺陷逐渐显现。为满足高效率和高功率密度的社会需求,SiC MOSFET器件受到越来越多的关注[1-2]。然而,对于SiC MOSFET来说,大容量高压高频的应用场合对其可靠性提出了更高的要求。现有研究结果表明,功率器件结温的变化是影响其可靠性及使用寿命的重要因素,结温升高导致电子迁移率增大,氧化层中电荷的分布改变,引起内部参数的退化,比如电阻偏离标准值、阈值电压漂移、跨导降低、最大允许功耗下降等,大大降低了器件的可靠性和工作寿命[3]。因此,建立能够反映实际工况下结温动态变化的SiC MOSFET电热耦合模型,对器件寿命预测和可靠性评估以及系统级建模和工程分析有着至关重要的作用。
目前,建模方法主要有两类:物理级建模[4-5]和电路级建模[6-7]。文献[4]以半导体物理理论为基础,用数学方法表达器件内部作用机理并从根本上构造器件物理模型,此种建模方法精确度高,但工作量大、仿真时间长、收敛性差,且不适用于工程分析;文献[6]使用PSpice建立SiC MOSFET电路级仿真模型,建模重点从器件内部机理转为外部特性,在软件自有MOSFET内核的基础上进行器件参数调整和模型改造,此种建模方法仿真时间短,收敛性较好,但在仿真精度上具有一定的局限性且没有考虑温度对参数的影响;文献[8]提出了一种变温度的Matlab/Simulink模型,模型采用温控电压源和电流源补偿SiC MOSFET的静态特性,分析了在不同温度下器件的工作特性,但没有考虑实时功率损耗对器件瞬时温度的影响。
基于时变温度反馈的建模方法,在 Matlab/ Simulink环境下构建了SiC MOSFET电热耦合模型,SiC MOSFET电热耦合模型由3个子模块组成:SiC MOSFET模型、功率损耗模块和热网络模型。综合考虑了外部环境和内部损耗对器件结温的影响,通过功率损耗[9-10]和RC热网络[11-12]模块来反映结温的动态变化,将时变的结温信号作为影响模型精度和准确性的重要参数反馈到SiC MOSFET模型中,借此分析实际工况下SiC MOSFET的结温情况及工作特性。
1 SiC MOSFET模型
SiC MOSFET电热耦合模型结构如图1所示,SiC MOSFET模型的等效电路模型[15]如图2,模型包含3个电路端口栅极G、漏极D和源极S,分别连接1个内电阻和2个极间电容。内电阻受器件结温的影响,栅漏电容CGD和漏源电容CDS则随外电压改变呈非线性变化。为提高模型的准确性和有效性,SiC MOSFET建模过程中需要综合考虑其静态特性和动态特性。

图1 SiC MOSFET电热耦合模型结构Fig.1 Electro-thermal coupling model structure of SiC MOSFET
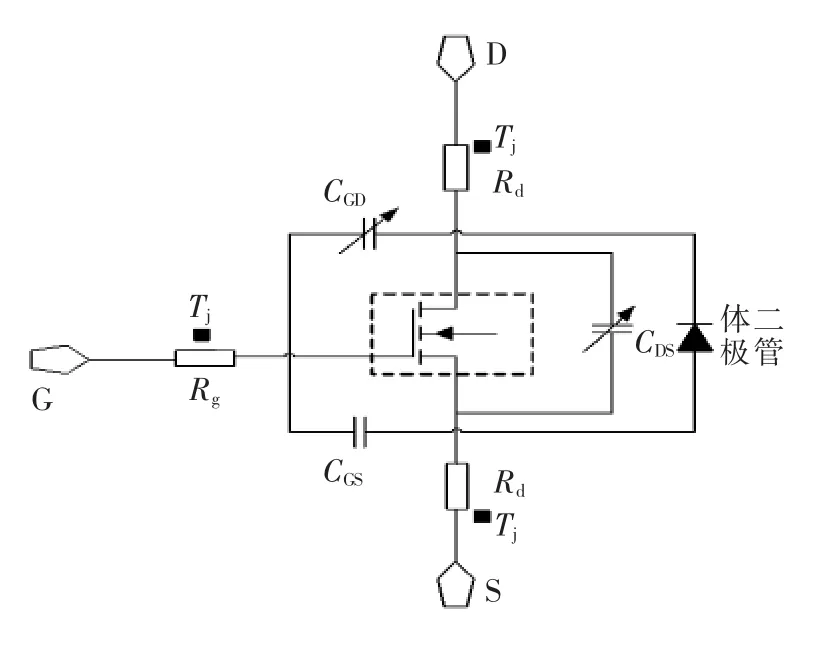
图2 SiC MOSFET等效电路模型Fig.2 Simple circuit model of SiC MOSFET
1.1 静态特性
SiC MOSFET静态特性主要描述器件导通状态下的U-I特性,漏极电流Id与漏源电压Vds、栅源电压Vgs之间的数学关系式可描述为

式中:Vth为开启电压;k为增益系数。
随着MOSFET的导通和关断,其表面温度、PN结温度都会发生变化,其中结温Tj的变化较为显著,且对内部参数值影响较大[13-14]。Tj对SiC MOSFET静态特性的影响主要表现在对开启电压Vth、增益系数k以及导通电阻Ron的影响,其关系可表述为

式中,a~e为系数,用曲线拟合方法获取。
1.2 动态特性
SiC MOSFET动态特性通过3个极间电容:栅源电容CGS、栅漏电容CGD、漏源电容CDS得以体现。现研究发现,当外部条件发生变化时,CGS的变化较小可以忽略不计,可认定为常数,而CGD、CDS则是与外部电压相关的函数[16],即

式中:m1和m2为指数,需通过曲线拟合得到。此外,由于温度对极间电容的影响较小,所以此处并不考虑极间电容与温度的相关性。
2 功率损耗模块
当SiC MOSFET工作时,在其导通电阻和寄生参数的影响下产生一定的功率损耗,导致器件温度的动态变化,甚至影响器件的可靠性。因此,功率损耗的计算与分析显得尤为重要。SiC MOSFET总的功率损耗主要包括两部分:导通损耗和开关损耗。
2.1 导通损耗
导通损耗是指器件导通时的损耗,与频率无关,与占空比有关。导通损耗Pcond的计算公式为

式中:IRMS为开关电流的有效值;I0为负载电流;D为占空比。
2.2 开关损耗
SiC MOSFET在状态切换的瞬间,漏电流Id和漏源电压Vds并没有立即发生变化,在Id和Vds交叠变化较短的时间内,器件产生开关损耗。开关损耗Psw为

式中:Eon和Eoff分别表示导通开关能量和关断开关能量[8];f为开关频率;t1~t4分别为电流上升时间、电压下降时间、电流下降时间和电压上升时间。则有

则SiC MOSFET总的功率损耗P可以表示为

3 热网络模块
热网络模块是将SiC MOSFET功率损耗转换为器件结温的关键。功率损耗与结温增量的关系为

式中:Zth为热阻抗;ΔTj(t)为结温增量。热网络在模型中表示为热阻抗Zth组成的RC网络,SiC MOSFET的热阻抗曲线可以由生产厂商提供的数据手册得到,通过曲线拟合方法即可得到热电阻Rth和热电容Cth的大小。
图3为SiC MOSFET一维等效热网络模型。图中,SiC MOSFET由PN结到外部环境进行热传导过程,功率损耗经过基片到外部环境的热网络得到基片温度Tc,再经过PN结到基片的热网络得到结温Tj。

图3 一维等效热网络模型Fig.3 Equivalent heat network of SiC MOSFET
图中,Zth(jc)、Rth(jc)、Cth(jc)分别为 PN结到基片的热阻抗、热电阻和热电容;Zth(ca)、Rth(ca)、Cth(ca)分别为基片到环境的热阻抗、热电阻和热电容;Tc、Ta分别为基片和外部环境温度,与结温Tj的关系分别为

根据上述分析建立PN结到基片的3阶热网络模型,根据瞬态热阻抗特性曲线进行曲线拟合,得到的热网络参数如表1所示。
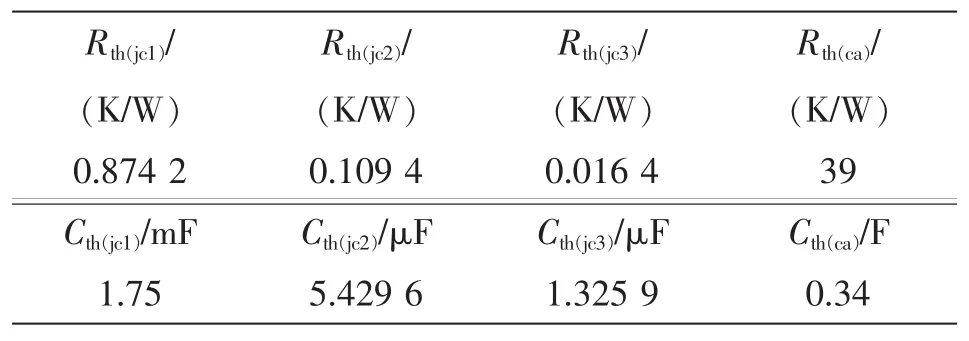
表1 热网络模型参数Tab.1 Parameters of heat network
将所求RC网络表示为传递函数形式,时间常数τ=RC,在Simulink环境中建立SiC MOSFET热网络模块,如图4所示。

图4 SiC MOSFET热网络模块Fig.4 Thermal module of SiC MOSFET in Simulink
综合上述SiC MOSFET模型、功率损耗模块和热网络模块3个模块的分析,建立SiC MOSFET电热耦合模型如图5所示。模型包含6个端口,其中3个为信号端口:分别为漏源电压Vds、栅源电压Vgs和一个模式(导通过关断)判断端口M;另外3个为SiC MOSFET电路端口。

图5 SiC MOSFET电热耦合模型Fig.5 Electro-Thermal coupling model of SiC MOSFET
4 仿真分析
为了验证SiC MOSFET电热耦合模型的正确性以及分析其结温变化情况,搭建SiC MOSFET仿真测试电路如图6所示,器件参数如表2所示。对电路中SiC MOSFET栅极施加脉冲信号,信号开关频率为100 kHz,幅值为20 V,占空比为0.5。

图6 SiC MOSFET仿真测试电路Fig.6 Simulation test circuit of SiC MOSFET

表2 CREE C2M0160120D模型参数Tab.2 Parameters of CREE C2M0160120D
4.1 模型试验
通过上述仿真测试电路验证所建SiC MOSFET电热耦合模型的正确性。图7为SiC MOSFET模型Tj=25℃和Tj=150℃时输出特性曲线。将仿真数据与datasheet进行对比,吻合情况很好,说明了所建SiC MOSFET电热耦合模型的正确性。
图8为SiC MOSFET开关能量的仿真结果,通过模拟得到不同温度下SiC MOSFET的开关能量情况,从而求取器件功率损耗。将仿真结果与datasheet进行对比发现,在温度较低(约小于100℃)时,仿真数据与datasheet吻合情况较好,当温度较高(大于100℃)时误差增大,模型的高温特性有待改善。仿真结果同时说明,结温对开关损耗的影响并不大,尤其是关断开关损耗基本不随结温的变化而发生变化。

图7 SiC MOSFET输出特性曲线Fig.7 Output characteristic curve of SiC MOSFET

图8 SiC MOSFET开关能量Fig.8 Simulation results of the SiC MOSFET switching power

图9 温度相关参数Fig.9 Temperature-dependent parameter
图9为SiC MOSFET温度相关参数变化情况。仿真结果说明,随着结温增高导通电阻偏离标准变大,开启电压则变小,产生漂移,与实际状况相符。
4.2 结温分析
通过图6的仿真测试电路模拟SiC MOSFET实际工况下的结温变化情况,对模型施加周期性脉冲信号,设置环境温度分别为25℃、50℃、75℃,得到SiC MOSFET结温变化情况如图10所示。由图可以看出,在外部环境和内部损耗的共同作用下,SiC MOSFET结温约分别升至90℃、115℃、140℃,并呈现周期性震荡变化;此外,研究发现当对模型施加非周期脉冲驱动信号时,结温呈现非周期变化,与实际状况相符。

图10 SiC MOSFET结温变化Fig.10 Simulation results of the junction temperature of SiC MOSFET
5 结语
功率损耗和热网络模块的引入使得SiC MOSFET模型更加真实、准确,更能适用于工程实际,仿真结果表明,SiC MOSFET在外部环境和内部损耗的综合作用下,器件内部参数值更新,从而引起了器件外部特性的变化,与实际工况下模型状态变化相吻合,证明了SiC MOSFET电热耦合模型的正确性和有效性,为后续功率器件的寿命预测和可靠性评估提供了研究基础。
然而,现阶段该模型高温性能仍存在缺陷,还有待改善。此外,SiC MOSFET体二极管采用了理想二极管,导致仿真结果存在偏差,后续研究将会补充体二极管的子模块,从而完善SiC MOSFET电热耦合模型。
[1]Orlov L K,Steinman E A,Smyslova T N,et al.Features and mechanisms of growth of cubic silicon carbide films on silicon[J].Physics of the Solid State,2012,54(4):708-715.
[2]张斌锋,许津铭,钱强,等.SiC MOSFET特性及其应用的关键技术分析[J].电源学报,2016,14(4):39-51.Zhang Binfeng,Xu Jinming,Qian Qiang,et al.Analysis on Characteristics of SiC MOSFET and Key Techniques of Its Applications[J].Journal of Power Supply,2016,14(4):39-51(in Chinese).
[3]Chen Tianbing,Najafizadeh L,Zhu Chendong,et al.CMOS device reliability for emerging cryogenic space electronics applications[C].Semicon ductor Device Research Symposium,2005 International,2005:328-329.
[4]Gachovska T K,Du B,Hudgins J L,et al.Modeling and smulation of a SiC BJT[C].IEEE Energy Conversion Congress& Exposition.IEEE,2009:979-985.
[5]Igic P M,Mawby P A,Towers M S.Physics-based dynamic electro-thermal models of power bipolar devices(PiN diode and IGBT)[J].Power Semiconductor Devices&Ics.Ispsd.Proceedings of International Symposium on,2001:381-384.
[6]徐艳明.SiC MOSFET PSpice建模及应用[D].北京:北京交通大学,2016.Xu Yanming.SiC MOSFET PSpice modeling and its application[D].Beijing:Beijing Jiaotong University,2016(in Chinese).
[7]赵波,周哲,徐艳明,等.适用于电动汽车的SiC MOSFET PSpice仿真模型研究[J].电源学报,2016,14(4):21-27.Zhao Bo,Zhou Zhe,Xu Yanming,et al.Study on PSpice model of SiC MOSFETs applied in electric vehicle[J].Journal of Power Supply,2016,14(4):21-27(in Chinese).
[8]Giammatteo P,Buccella C,Cecati C.Matlab/simulink Modeling of SiC Power MOSFETS[J].International Review of Electrical Engineering,2014,9(4):671-680.
[9]罗四海,娄本超,唐君.MOSFET的损耗分析与工程近似计算[J].电子设计工程,2011,19(21):136-138.Luo Sihai,Lou Benchao,Tang Jun.The power losses of MOSFET and approximate calculation[J].Electronic Design Engineering,2011,19(21):136-138(in Chinese).
[10]Ma K,Bahman A S,Beczkowski S.Complete loss and thermal model of power semiconductors including device rating information[J].IEEE Transactions on Power Electronics,2014,30(5):2862-2869.
[11]徐铭伟,周雒维,杜雄.NPT型IGBT电热仿真模型参数提取方法综述[J].电力自动化设备,2013,33(1):134-141.Xu Mingwei,Zhou Luowei,Du Xiong.Review of parameter extraction methodology for electro-thermal simulation model of NPT IGBT[J].Electric Power Automation Equipment,2013,33(1):134-141(in Chinese).
[12]Mijlad N,Elwarraki E,Elbacha A.SIMSCAPE electrothermal modelling of the PIN diode for power circuits simulation[J].Iet Power Electronics,2016,9(7):1521-1526.
[13]孙凯,陆珏晶,吴红飞,等.碳化硅MOSFET的变温度参数建模[J].中国电机工程学报,2013,33(3):37-43.Sun Kai,Lu Juejing,Wu Hongfei,et al.Modeling of SiC MOSFET with temperature dependent parameters[J].Proceedings of the CSEE,2013,33(3):37-43(in Chinese).
[14]Dia H,Sauveplane J B,Tounsi P.A temperature-dependent power MOSFET model for switching application[C].International Workshop on Thermal Investigations of ICS and Systems,2009:87-90.
[15]Cao Yang,Yuan Liqiang,Chen Kainan.Modeling of SiC MOSFET in matlab/simulink[C].IEEE Transportation Electrification Asia-Pacific,2014:1-5.
[16]Kampitsis G,Antivachis M,Kokosis S.An accurate matlab/simulink based SiC MOSFET model for power converter applications[C].IEEE Applied Power Electronics Conference and Exposition,2015:1058-1064.
Modeling and Analysis of Electro-thermal Coupling Model for SiC MOSFET
LYU Xiuting,TAN Ping’an
(College of Information Engineering,Xiangtan University,Xiangtan 411105,China)
In order to predict the junction temperature of the silicon carbide(SiC)power device accurately under Matlab/Simulink environment,this paper presents a modeling method based on time-varying temperature feedback for SiC MOSFET.From the physics analysis of device,the power loss and thermal network module is introduced into SiC MOSFET to feedback junction temperature and update real-time parameters,and which reflect the process of conduction and switching characteristics of SiC MOSFET more reasonable.The device of SiC MOSFET adopts CREE C2M0160120D, extractes the modeling parameters from the manufacturer datasheet and the test experiment.The simulation results prove the rationality of the modeling method,and provide the basis for life prediction and reliability assessment of the device.
silicon carbide;MOSFET;electric-thermal coupling;Matlab/Simulink

吕秀婷
吕秀婷(1991-),女,硕士研究生,研究方向:电力电子与电力传动,E-mail:1334805548@qq.com。
谭平安(1979-),男,通信作者,博士,副教授,研究方向:电力电子系统可靠性、无线电能传输,E-mail:tanpingan@ xtu.edu.cn。
10.13234/j.issn.2095-2805.2016.6.29
TM 461.5
A
2016-07-31
国家自然科学基金资助项目(51207134)
Project Supported by the National Natural Science Foundation of China(51207134)

