抗辐射0.18 μm NMOS器件热载流子效应研究
谢儒彬,张庆东,纪旭明,吴建伟,洪根深
(中国电子科技集团公司第58研究所,江苏无锡 214072)
抗辐射0.18 μm NMOS器件热载流子效应研究
谢儒彬,张庆东,纪旭明,吴建伟,洪根深
(中国电子科技集团公司第58研究所,江苏无锡 214072)
基于0.18 μm CMOS工艺开发了抗总剂量辐射加固技术,制备的1.8 V NMOS器件常态性能良好,器件在500 krad(Si)剂量点时,阈值电压与关态漏电流无明显变化。研究器件的热载流子效应,采用体电流Isub/漏电流Id模型评估器件的HCI寿命,寿命达到5.75年,满足在1.1 Vdd电压下工作寿命大于0.2年的规范要求。探索总剂量辐射效应与热载流子效应的耦合作用,对比辐照与非辐照器件的热载流子损伤,器件经辐照并退火后,受到的热载流子影响变弱。评估加固工艺对器件HCI可靠性的影响,结果表明场区总剂量加固工艺并不会造成热载流子损伤加剧的问题。
辐射加固;总剂量效应;热载流子效应;0.18 μm
1 引言
随着半导体技术的发展,微电子元器件在航空航天领域中的应用日益广泛,器件在空间辐射环境中将面临抗辐射可靠性与自身可靠性的双重考验[1],使得器件的可靠性成为微电子技术中尤为重要的一个方面。因此,需要开展空间应用中元器件的可靠性研究,以保证航空航天电子系统的安全性与稳定性。
微电子制造技术已经向着纳米尺寸迅速发展,在MOS器件的沟道长度、结深和栅氧厚度等尺寸等比例缩小的同时,电源电压却未能随之等比减小,这样会导致沟道区的横向和纵向电场的显著增加。在强电场的作用下,器件中的载流子平均动能超过了热平衡载流子的平均动能,载流子从电场获得的能量不能及时通过散射等途径传递到周围晶格,导致一部分载流子的能量大于晶格系统的能量,比费米能级大几个kT以上,一般称这种状态的载流子为热载流子。当载流子的能量达到或超过Si-SiO2界面势垒时,便会注入到氧化层中,产生界面态、氧化层陷阱或被陷阱所俘获[2]。热载流子效应可以导致阈值电压漂移,漏电流和跨导降低,还将产生衬底电流、栅极电流等非工作电流,使器件性能退化,以致最终失效,引起所谓的“热载流子可靠性问题”。因而热载流子效应将阻碍超大规模集成电路的进一步发展。
另一方面,MOS器件在总剂量电离辐射的影响下,会导致氧化层中产生电子-空穴对,由于电子有着相对较高的迁移率,所以能很快地移出氧化层,而空穴移动较慢,当其移动到Si-SiO2界面时,会被陷阱俘获成为正氧化物电荷,同时在界面处,弱键在电离辐射作用下断裂成悬挂键从而感生出界面态,正氧化物电荷和界面态共同影响阈值电压的漂移方向及其大小。
由此可以发现,在空间环境应用下,N型MOS器件将同时受到总剂量辐射效应和热载流子效应的双重影响,两种效应都存在累积性,都会造成器件电学参数的退化。由此可以认定器件的总剂量辐射损伤与热载流子损伤之间具有一定的相关性,且两者同时造成的损伤并不是一个简单的线性叠加,因此对这两种效应进行深入的研究可以有效提高在空间环境应用下器件的可靠性。
目前对MOS器件中的热载流子退化寿命及可靠性的预测已开始进入了实用阶段。国际上对热载流子效应的研究主要集中在以下几个方面:(1)热载流子及其产生的陷阱的确认和建模,如HU提出的幸运电子模型[3];(2)研究优化器件热载流子效应的新型结构和设计方法[4];(3)研究超深亚微米CMOS器件中各种失效机理的耦合作用[5];(4)研究不同温度条件下的热载流子失效机理[6]。其中,为了更好地满足复杂环境下应用的需求,不同损伤机制之间的耦合效应也越来越受到人们的关注。
根据我们之前的研究,0.18 μm CMOS工艺总剂量辐射导致的损伤主要源于STI场区部分正电荷的积累,造成STI/衬底界面处的P型硅反型,导致STI侧壁的寄生管开启,形成新的漏电通道。针对该机理,我们基于0.18 μm CMOS工艺开发了抗总剂量辐射加固技术[7],如图1所示,对STI场区进行抗总剂量辐射加固,STI/衬底界面处的P型硅不容易发生反型。针对所得的0.18 μm NMOS器件进行了常态特性以及辐照特性的评估,通过对比实验的结果证明了加固工艺的有效性。

图1 NMOS晶体管STI场区加固示意图
抗总剂量辐射加固工艺在MOS器件的场区引入了陷阱电荷,这将对场区电场分布造成影响,同时经过研究得出,电离辐射造成的正电荷积累与界面态都会对源漏端电荷分布造成影响,从而改变源漏端的结深、电场强度等特性,这些都会导致漏端沟道电场的分布发生变化,进而影响器件的寿命,因此需要对加固工艺器件的可靠性进行评估。
2 器件特性
基于0.18 μm CMOS工艺完成了1.8 V NMOS器件的制备,器件结构剖面见图2,器件常态参数见表1。对器件进行总剂量辐照实验,实验采用中科院上海原子核研究所辐射技术中试研究基地的60Coγ射线,选取的剂量点为50 krad(Si),100 krad(Si),150 krad(Si),500 krad(Si),辐照偏置为最劣偏置 (ON偏置),即Vg=2 V(1.1 Vdd),Vd=Vs=Vb=0 V。辐照完成后,对样品进行I-V特性测试。不同剂量下的I-V特性曲线如图3所示。

图2 1.8 V NMOS器件结构剖面图
从图3中明显看出加固的1.8 V NMOS在500 krad(Si)剂量点时关态漏电流未发生明显变化,器件I-V特性曲线与辐照前基本一致,器件不同剂量下的跨导也几乎没有变,说明器件的迁移率没有发生变化,因此可以得知,加固的NMOS器件抗总剂量辐射能力达到了500 krad(Si)水平。

表1 器件常态参数表
针对加固的1.8 V NMOS器件,测试其总剂量辐照前与辐照后的热载流子特性,对加固工艺器件的HCI可靠性进行初步的评估。

图3 不同剂量下的I-V特性曲线
3 实验与分析
3.1 实验过程
实验样品基于标准商用0.18 μm工艺,并增加了总剂量加固工艺,器件常态参数见表1。选取两组器件,A组作为对比样品,B组进行辐照实验,实验采用西北核技术研究所的60Coγ射线,剂量率是50 rad(Si)/s,剂量点分别为100 krad(Si),300 krad(Si),500 krad(Si),辐照偏置为最劣偏置(ON偏置),即Vg=2 V(1.1 Vdd),其余端口接地。100 krad(Si)、300 krad(Si)两个剂量点辐照完成后,各取1颗样品进行I-V特性测试,并且不再继续后续的辐照,样品编号及接受的总剂量见表2。辐照实验后对B组样品进行一周常温(25℃)退火处理。退火完成后,对两组样品分别进行热载流子试验。

表2 热载流子效应试验条件
热载流子试验选取漏端电压应力Vd=3 V,栅端电压应力Vg选取最大衬底电流(IsubMAX)点的栅电压,热载流子试验条件见表2。选取10 s、100 s、1000 s、10000 s对器件进行I-V特性曲线测试,测试设备为KEITHLEY 4200S半导体参数测试仪。
3.2 实验结果
热载流子试验过程中,每个应力时间结束后,测试转移输出特性曲线。转移特性曲线的测试方法如下:漏端电压Vd=0.1 V,栅电压Vg从-0.5 V扫描到1.8 V,源端和体端接地,得到转移特性曲线Id-Vg,采用最大跨导法提取器件的阈值电压;输出特性曲线的测试方法如下:漏端电压Vd=1.8 V,栅电压Vg从-0.5 V扫描到1.8 V,源端和体端接地,得到转移特性曲线Id-Vg,提取漏端的饱和电流Idsat=Id@Vg=1.8 V。
B-3#MOS器件在Vd=3 V应力下进行热载流子试验,各时间点的转移特性曲线如图4所示,采用最大跨导法提取器件的阈值电压,阈值电压随着应力时间的变化量见图4中小图。从图中可以看出,MOS器件的亚阈值区域在前1000 s退化较少,从1000 s到10000 s亚阈值区域退化明显,阈值电压发生显著变化,从A组样品与B组样品的数据对比来看,A组样品的退化更强。

图4 热载流子应力前后转移特性曲线
B-3#MOS器件在Vd=3 V应力下进行热载流子试验,各时间点的输出特性曲线如图5所示,提取器件的饱和电流Idsat=Id@Vg=1.8 V,饱和电流随着应力时间的变化量见图5中小图。从图中依然可以看出,MOS器件辐照后饱和电流的退化较辐照前变弱了,说明MOS器件在进行总剂量辐照并退火后,受到热载流子损伤的程度减弱了,这与文献[8]的研究结果是相悖的。

图5 热载流子应力前后输出特性曲线
3.3 理论分析
在热载流子效应的表征中,倍增因子M=Isub/Id是一个非常有用的器件退化标识量,衬底电流是在漏端附近的高场区中产生的,电子在沟道电场加速作用下在漏端碰撞电离,产生的空穴扩散到电势较低的中性体区形成衬底电流,它正比于Id,并与沟道横向电场强度呈指数关系,即:

因此Isub/Id可以描述漏端附近的横向电场。热载流子效应引入的陷落电荷分布在漏端附近的氧化层和界面态电荷陷阱中,它们改变了局部有效栅压,从而影响沟道横向电场。所以,通过测量整个栅压范围内的倍增因子的退化,就可以得到器件的损伤情况。
在热载流子效应试验过程中,器件进行了衬底电流测试,衬底电流随辐照剂量的变化曲线如图6所示。器件的衬底电流随着总剂量的增加而减小,但变化量并不明显。衬底电流的减小,表明热载流子注入的减少,因此衬底电流的表征解释了辐照退火后器件热载流子效应损伤减弱的现象。
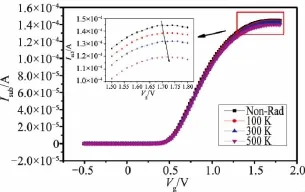
图6 MOS器件衬底电流随辐照总剂量的变化
总剂量电离辐射与热载流子效应的损伤原理存在相似之处,他们都会在氧化层中引入陷阱电荷同时在界面处形成界面态,然而它们的损伤形式并不完全相同。总剂量辐射效应主要会造成器件的关态漏电流的增加以及阈值电压的降低,而热载流子效应主要会造成器件的阈值增大、驱动下降。造成区别的原因在于引入的陷阱电荷与界面态的位置。
由于期间经历了常温下的退火效应,因此大部分的氧化物陷阱电荷将会被退掉,而界面态在禁带中处于深能级,常温下很难退火。故退火后的器件特性主要受界面态的影响。热载流子效应界面态产生的主要原因是高能电子和空穴在注入时打破了Si-Si和Si-O键,形成Si-、O-悬挂键,成为受主界面态。
图6显示衬底电流最大值对应的栅压正漂,由此证明栅氧化层与STI区域中的陷阱电荷的数量小于界面态,说明MOS器件辐照后在界面处还是形成了较多的界面态,退火后造成界面态多于陷阱电荷。因此沟道中形成的是负电场,使得漏端的电场强度下降,随着总剂量的增加,STI场区与栅氧化层中产生的界面态相对增加,由此造成MOS器件的衬底电流变小,但增加量并不明显。
从图7的对比情况来看,标准工艺器件由于热载流子损伤造成的退化确实要强于加固工艺器件,因此怀疑加固工艺在STI侧壁中引入了电子陷阱中心,其影响将会造成部分受主界面态的复合,造成界面态数量的减少,使得加固工艺器件的热载流子损伤要弱于非加固工艺器件。但具体的原因还需要后续补充实验分析做进一步的确认。

图7 加固工艺与标准工艺器件退化情况对比
对我们加固工艺制备的1.8 V NMOS器件进行HCI可靠性评估试验,计算其HCI可靠性寿命。根据JEDEC/FSA Joint Publication No.001的要求,MOS器件寿命推导模型如下:





表3 加速应力寿命
由图8的曲线可知1.1 Vdd工作条件下,器件的寿命为5.75年,满足大于0.2年的要求。由此说明,加固工艺器件HCI的可靠性满足规范要求,说明我们采取的加固措施并不会影响到器件的热载流子注入(HCI)可靠性。
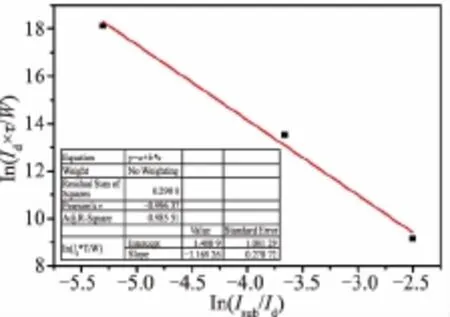
图8 MOS器件寿命拟合曲线
4 结论
基于标准商用0.18 μm CMOS工艺,并通过抗总剂量辐射加固工艺,制备了1.8 V NMOS器件,对器件的抗辐射特性以及HCI可靠性进行测试与分析,可以得出以下结论:
(1)采用场区加固工艺制备的MOS器件,辐照并退火后受到的热载流子损伤要弱于未辐照的器件,其原因在于辐照后界面处的界面态增加,减弱了漏端的电场强度;
(2)采用场区加固工艺的NMOS管,其受到的热载流子损伤比标准工艺的稍弱,其原因可能是加固工艺引入的电子陷阱中心复合了部分界面态,具体原因还需要后续补充实验分析;
(3)我们采取的场区加固工艺并不会影响到器件的热载流子注入(HCI)可靠性,器件的HCI可靠性满足大于0.2年@1.1 Vdd的规范要求。
[1]Cui Jiangwei,XueYaoguo,Yu Xuefeng,RenDiyuan,Lu Jian,and Zhang Xingyao.Total dose irradiation and hot-carrier effects of sub-micro NMOSFETs[J].Journal of Semiconductors,2012,33(1):014006.
[2]S P Zhao,S Taylor,W Eccleston,K J Barlow.Oxide degradation study during substrate hot electron injection[J]. Microelectronic Engineering,1993,22:269-272.
[3]C Hu.Simulating Hot-Carrier Effects on Circuit Performance[J].Semicon Tech,1992,7:555-558.
[4]FOND(Fully Overlapped Nitride-etch defined Device):a new device architecturefor high-reliability and high-performance deep submicron CMOS technology [C].IEEE Electron Devices Meeting.Dec,1994,Technical Digest.83-86.
[5]刘红侠,郝跃.深亚微米PMOS器件的HCI和NBTI耦合效应与物理机制[J].半导体学报,2005,26(9):1813-1817.
[6]S Y Chen,J C Lin,H W Chen,et al.An investigation on Substrate Current and hotcarrier degradation at elevated temperatures for NMOSFETs of 0.13 μm technology[J]. IEEE IIRW,2005:120-122.
[7]Xie Rubin,Wu Jianwei,Chen Haibo,Li Yanyan,Hong Genshen.Total ionizing dose effect on NMOS transistors with radiation-hard in STI[J].JournalofTerahertz Science and Electronic Information Technology,2016,14(5):805-810.
[8]Silvestri M,Gerardin S,Paccagnella A,FaccioF,Gonella L, Pantano D,Re V,Manghisoni M,Ratti L.Ranieri A IEEE Trans[C].Nucl.Sci.200855:1960.
Studies of Hot-Carrier Injection Effect in 0.18 μm Radiation-hardened NMOS Transistors
XIE Rubin,ZHANG Qingdong,JI Xuming,WU Jianwei,HONG Genshen
(China Electronics Technology Group Corporation No.58Research Institute,Wuxi214072,China)
Total ionizing dose radiation-hard technology is developed based on 0.18 μm CMOS process.The normal performance of the 1.8 V NMOS transistors manufactured in this process is stable.And there is no shift of threshold voltage and off-state current at 500 krad(Si)irradiating.The HCI lifetime is estimated to study the hot carrier injection effect of NMOS transistors.The HCI lifetime is 5.75 year,longer than 0.2 year under 1.1 Vdd.The performance affected by both total dose irradiation and the hot-carrier injection effects is explored by compared the irradiated NMOS transistors with the one without irradiation.The transistors pro-irradiated and annealed are less influenced by hot-carrier injection effect.The radiation-hardening process does not exacerbate hot-carrier injection effect.
radiation-hard;total ionizing dose effect;hot carrier injection effect;0.18 μm

TN306
A
1681-1070(2017)04-0030-04
谢儒彬(1988—),男,江苏无锡人,硕士研究生,工程师,2013年毕业于南京大学物理学院,目前主要从事抗辐射集成电路工艺集成技术研究。
2016-12-12

