150 keV电子辐照下直拉硅的缺陷演化及其电学性能
董 磊
(哈尔滨师范大学)
0 引言
空间带电粒子会对航天器上的材料、电子元器件造成严重的辐射损伤[1].辐射环境下硅材料的可靠性高低直接关系到半导体器件和电子系统的正常工作.系统研究空间带电粒子辐照下硅材料的电学性能变化及其缺陷演化规律,进一步提高其抗辐照性能、对半导体器件的抗辐加固具有十分重要的工程实际意义.
国内外已有研究表明,Watkins[2]等学者分析中子辐照在硅晶体中产生的损伤缺陷,发现辐照会使晶格原子向间隙位置移动,在硅中引入大量的空位、间隙原子、空位团等复合体,抑制硅片表面氧化层错的形成.刘昌龙[3]等学者研究离子辐照下单晶硅的辐照效应发现,在单晶硅中产生双空位、中性四空位以及大的空位团或间隙子团;Varichenko[4-5]等学者进一步发现离子辐照产生的缺陷可以分布到远大于离子射程的区域,并且这些缺陷的数量随辐照剂量增大而增加,双空位的产生在一定照射剂量下会趋向饱和.李养贤[6]等学者发现快中子辐照对单晶硅电学性能产生较大影响,所引入的电活性缺陷使硅的电阻率发生巨大变化,并使硅中氧沉淀的速度明显加快.
综上所述,国内外关于中子、离子、快中子辐照在单晶硅中引起的缺陷种类、辐射损伤机理等研究都有很大的突破,而关于电子辐照下硅材料的缺陷演化及辐射损伤机理方面研究较少,没有明确的结论.为此,该文研究直拉硅在电子辐照条件下的缺陷演化规律及其对电学性能的影响,旨在为进一步提高器件的抗辐射性能、寻求合理有效的器件抗辐射加固途径提供实验依据和理论指导.
1 试验器件与试验方法
该文所用样品为沿<100>晶向生长的直拉单晶硅片(CZ-Si),样品尺寸为1 cm×1 cm,其中N型硅片厚度为450 μm,掺杂浓度为1×1017cm-3,P型硅片厚度为375 μm,掺杂浓度为1×1019cm-3.两种类型硅片电阻值均小于0.05 Ω.
该文选取150 keV电子进行辐照试验,辐照注量分别为5×1014cm-2、1×1015cm-2和5×1015cm-2.进行实验前,在直拉硅材料表面镀电极,采用Magna IR560型傅里叶变换红外光谱仪进行红外光谱分析.使用KEITHLEY 4200-SCS型半导体参数仪探究电子辐照对直拉硅电学性能的影响.
2 实验结果与分析
2.1 FTIR测试分析
傅立叶变换红外光谱(FTIR)技术是快速、无损检测半导体材料的理想手段.在能量为150 keV、不同注量的电子辐照下,P型直拉硅中各缺陷红外吸收峰强度的变化曲线如图1所示.由图1可见,与未辐照样片相比,辐照后样片的红外光谱图上出现吸收峰.此外,随着电子辐照注量的增加,相应的缺陷吸收峰强度也不断增强,说明电子辐照注量增加促使辐照缺陷浓度不断升高.Londos C A[7]等学者研究发现,在700~1000nm的波长范围内出现的吸收峰是由于A中心引起的局域模振动,对应着VnOm复合体.研究表明,电子辐照在硅中引入的辐照缺陷,会在禁带中形成新的能级,呈施主态、受主态或中性态,可作为主要的电子陷阱和有效的复合中心,对直拉硅单晶的电阻率及载流子浓度等电学性能产生影响[8].
不同注量的150 keV电子辐照下N型直拉硅中微观缺陷红外吸收峰强度的变化曲线如图2所示,所得结论与P型直拉硅结果类似.同样在波长700~1000 nm范围内出现吸收峰,对应VnOm复合体,辐照注量越大,在直拉硅内产生的缺陷浓度越高.
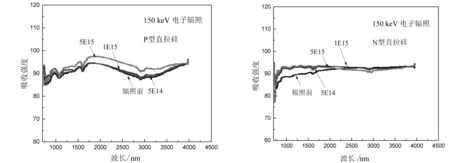
图1 150 keV电子辐照下P型直拉硅的红外吸收谱 图2 150 keV电子辐照下N型直拉硅的红外吸收谱
2.2 电学参数测试分析
为深入分析低能电子辐照对直拉硅电学性能的影响,该文分别测试了P型和N型直拉硅的薄膜方块电阻和电阻率.图3(a) 和(b)分别为150 keV电子辐照下P型直拉硅的薄膜方块电阻与薄膜电阻率随辐照注量变化的关系曲线.如图3所示,随着电子辐照注量的增加P型直拉硅的薄膜方块电阻与薄膜电阻率都先逐渐升高后趋于饱和.已有研究表明,辐照缺陷对直拉硅电学性能的影响与其引入辐照缺陷密度有关,进而影响直拉硅中载流子浓度的变化[9].图3中曲线变化主要是由于P型直拉硅中多子为空穴,电子辐照过程中在P型直拉硅样品打入电子,直拉硅中空穴和电子相互抵消,从而使直拉硅中的多子浓度降低,导致薄膜方块电阻和薄膜电阻率升高.而随着辐照注量增加,在直拉硅中引入的受主态VnOm复合体缺陷浓度升高,导致多子浓度升高,从而薄膜方块电阻和薄膜电阻率降低.因此,薄膜方块电阻和薄膜电阻率逐渐趋于饱和.

(a) 薄膜方块电阻 (b) 薄膜电阻率随电子注量变化的关系曲线图3 150 keV电子辐照下P型直拉硅
图4 (a) 和(b)分别为150 keV电子辐照下,N型直拉硅的薄膜方块电阻与薄膜电阻率随电子辐照注量的变化曲线.如图4所示,150 keV电子辐照下,随着辐照注量的增加,N型直拉硅的薄膜方块电阻与薄膜电阻率均先降低后趋于饱和.这主要是由于N型直拉硅中多子为电子,而在电子辐照过程中在N型直拉硅样品打入电子,使直拉硅中的多子浓度增高,导致薄膜方块电阻和薄膜电阻率降低.而随着辐照注量增加,在直拉硅中引入的受主态VnOm复合体缺陷浓度升高,作为电子陷阱在N型Si中起到杂质补偿作用,导致多子浓度降低,从而薄膜方块电阻和薄膜电阻率升高.因此,薄膜方块电阻和薄膜电阻率逐渐趋于饱和.

(a)薄膜方块电阻 (b)薄膜电阻率随电子辐照注量变化的关系曲线图4 在150 keV电子辐照下N型低阻直拉硅
3 结论
该文研究150 keV电子辐照下直拉硅中辐照损伤缺陷及其电学性能的演化规律.红外光谱分析发现,电子辐照在直拉硅中引入VnOm复合体,且随辐照注量的增加,辐照缺陷浓度逐渐升高.电学性能测试结果表明,随电子辐照注量的增大,P型直拉硅薄膜方块电阻和薄膜电阻率逐渐升高并趋于饱和,而N型直拉硅薄膜方块电阻和薄膜电阻率逐渐降低并趋于饱和,这主要是由电子辐照的载流子注入效应和辐照损伤微观缺陷的受主补偿效应共同作用的结果.
参 考 文 献
[1] Zhang L, Zhang Y M, Zhang Y M, et al.High energy electron radiation effect on Ni/4H-SiC SBD and Ohmic contact[J], Chin Phys B, 2009, 18(3): 893-899.
[2] Watkins G D, Corbett J W. Defects in irradiated silicon: electron paramagnetic resonance of the divacancy[J]. Phys Rev, 1965, 138(2): 543-555.
[3] 刘昌龙,朱智勇,侯明东,等.离子辐照单晶Si损伤效应的研究[J].原子核物理评论,2000,17(3):140-145.
[4] Varichenko V, Zaitsev A, Melnikov A, et al. Defect production in silicon implanted with 13.6 MeV boron ions [J]. Nucl Instr & Meth B, 1994, 94(3): 259-265.
[5] Varichenko V, Zaitsev A, Kazutchits N, et al. Defect production in silicon irradiated with 5.68 GeV Xe Ions [J]. Nucl Instr & Meth B, 1996, 107(1): 268-272.
[6] 李养贤,杨帅,陈贵峰,等.快中子辐照直拉硅中受主和施主的研究[J].物理学报,2005,54(4):1783-1787.
[7] Londos C, Andrianakis A, Aliprantis D, et al. IR studies of oxygen-vacancy defects in electron-irradiated Ge-doped Si [J]. Physica B Condensed Matter, 2007, s401-402(4):487-490.
[8] Makarenko L, Korshunov F, Lastovski S, et al. Elimination and formation of electrically active defects in hydrogenated silicon particle detectors irradiated with electrons [J]. Nuclear Instruments and Methods in Physics Research A, 2005, 552(1): 77-81.
[9] 刘文平.硅半导体器件辐射效应及加固技术[M].北京:科学出版社,2013.10-12.

