基于双表面等离子激元吸收的纳米光刻∗
刘仿李云翔 黄翊东
(清华大学电子工程系,信息科学与技术国家实验室,北京 100084)
基于双表面等离子激元吸收的纳米光刻∗
刘仿†李云翔 黄翊东‡
(清华大学电子工程系,信息科学与技术国家实验室,北京 100084)
(2017年6月19日收到;2017年7月5日收到修改稿)
光刻技术(lithography)是微纳结构制备的关键技术之一.受限于光的衍射极限,传统光刻方法进一步缩小特征尺寸变得越来越难.表面等离子激元(surface plasmon polariton,SPP)作为光与金属表面自由电子密度振荡相互耦合形成的一种特殊电磁形式,具有波长短、场密度大、异常色散等特点,在突破传统光学衍射极限的研究和应用中具有重要的学术和实用价值.本文针对SPP在光刻胶中的非线性吸收及其在大视场纳米光刻中的应用进行了理论和实验探索.在回顾SPP概念的基础上,阐述了双SPP吸收的概念及其应用于纳米光刻的优势,明确了该效应具有与传统双光子吸收不同的内涵和特性.在800和400 nm飞秒激光的作用下,实现了基于双SPP吸收效应的周期干涉条纹,同时验证了双SPP吸收的阈值效应,通过控制曝光计量实现了图形线宽的调控,最小线宽小于真空光波长的1/10.利用SPP波长短、场增强的特点,并结合非线性吸收的阈值效应,单次曝光区域比纳米图形尺度大4—5个数量级,曝光区域的直径可达1.6 mm.同时制备出较为复杂的同心圆环结构.基于双SPP吸收独有的特性以及SPP丰富的模式,有望进一步在大光刻视场、超小尺度图形光刻技术上获得突破.
表面等离子激元,纳米光刻,光学非线性,衍射极限
1 引 言
光刻技术(lithography)是实现大规模制造微/纳尺度微电子和光电子器件的关键技术之一[1].受光的衍射效应限制,进一步缩小特征尺寸变得越来越困难,常规的光刻技术也变得越来越复杂和昂贵[1,2].在过去的几十年间,人们在不断探索新原理、新方法、新技术,期望突破光的衍射极限,实现亚波长的纳米光刻技术,例如基于双光子吸收(two-photon-absorption,TPA)的光刻[3]、基于表面等离子激元(surface plasmon polariton,SPP)的光刻[4]、纳米压印光刻[5]和激光消融光刻[6]等.
SPP是光与金属表面自由电子密度振荡相互耦合形成的一种特殊电磁形式[7,8].具有波长短、场密度大、异常色散等特点,在突破传统光学衍射极限的研究和应用中具有巨大的潜力.例如:利用金属膜上的周期性小孔激励起SPP,实现了90和60 nm的周期点阵[4,9];利用银膜上的周期光栅激励SPP干涉条纹,获得了50 nm线宽的光刻胶图形[10];利用同心圆环构成的SPP透镜实现了直写式的光刻,获得了线宽小于90 nm的光刻光斑[11];将SPP透镜集成在扫描飞行头上,实现了22 nm的高产出率SPP光刻图形[12,13];基于SPP制作完美透镜和超透镜,实现了亚波长的光刻图形[14].
尽管光刻图形的线宽对于纳米光刻至关重要,但是光刻视场(一次曝光所能覆盖的光刻面积)和对复杂图形的刻写能力也是决定该项技术能否推广应用的关键.基于SPP纳米光刻的诸多方案分别利用了SPP不同的特点,均表现出实现超光学衍射极限光刻的能力.考虑到飞秒激光汇聚光斑与光刻胶发生的双光子吸收非线性光学作用[15-17],本文提出并研究飞秒激光作用下光刻胶中的双SPP吸收效应,探索该效应在纳米光刻中的应用;既利用SPP这种特殊电磁模式的特点,又利用SPP和光刻胶的非线性光学作用,以期实现大光刻视场下的超小线宽SPP光刻.
本文首先回顾SPP的基本概念,在厘清SPP和光子、表面等离子体等相互关系的基础上,阐述双SPP吸收效应及其应用于纳米光刻的特性,然后介绍双SPP吸收效应的仿真和实验方面的工作.
2 双SPP吸收的基本概念和特点
2.1 SPP的概念[18]
为了更清晰地认识SPP,理解本文提出的双SPP吸收的概念,下面结合图1,厘清与SPP相关的若干概念及其相互关系.
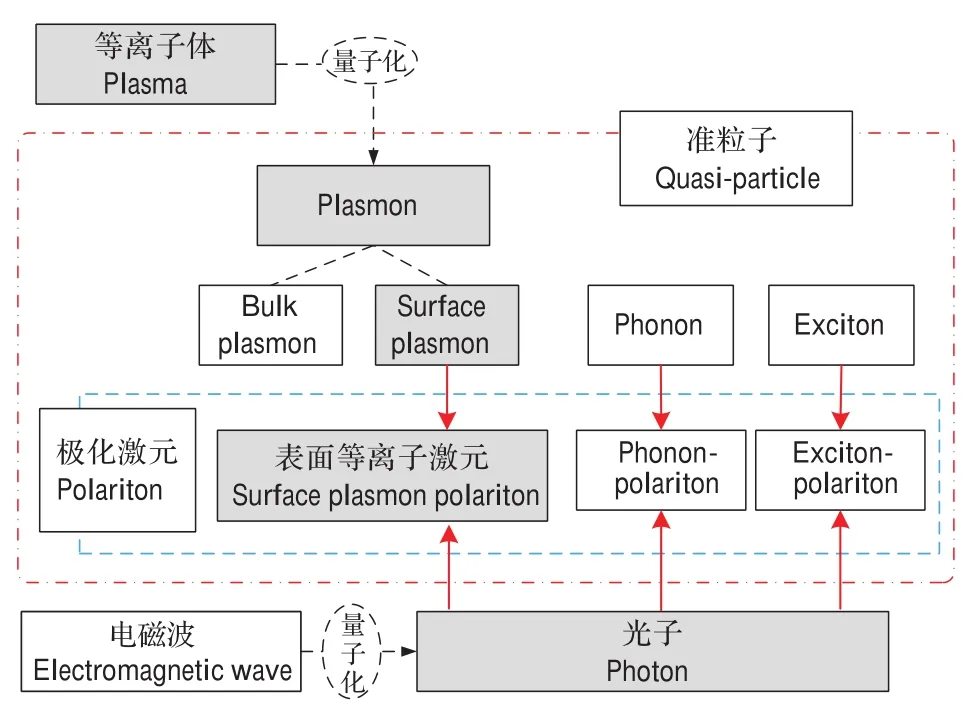
图1 SPP与其他(准)粒子的关系示意图Fig.1.The relation of SPP and other(quasi-)particles.
2.1.1 等离子体(plasma and plasmon)
等离子体(plasma)是由电子和正离子构成的混合物,由于等离子体中的正负粒子存在电磁相互作用力,等离子体中电子的运动可以描述为围绕着正电荷粒子的集体来回振荡,其振荡频率其中n为电子浓度,m0为电子质量.常见的等离子体形式包括火焰、电弧等.金属及半导体中的电子和正电粒子具有等离子体的特性,故也可以看作是“固体等离子体”. Plasmon是plasma的量子化描述[19-22].
2.1.2 表面等离子体(surface plasma and surface plasmon)
表面等离子体存在于等离子体边界处的振荡[20-22],其振荡频率不仅与金属材料的本征振荡频率ωp有关,同时还与金属表面的介质材料介电常数ε有关,即ωsp=ωp/(1+ε)1/2[23].Surface plasmon是surface plasma的量子化描述[19,21-24].
2.1.3 极化激元(polariton)
极化激元指的是一个混合态的准粒子,由光子(photon)与其他基本粒子或激发(excitation)(如电子、声子、磁子等)耦合构成[21,25].Hopield[26]引入polariton的概念以描述光子与物质的相互作用与耦合.常见的极化激元有surface-plasmonpolariton,phonon-polariton,exciton-polariton等.
2.1.4 表面等离子激元(surface plasmon polariton)
表面等离子激元指的是photon和surface plasmon相互作用形成的混合态准粒子[7,8],刻画的是光与金属表面自由电子振荡相互耦合形成的一种特殊电磁形式.SPP这个名称本身就是一个量子化的概念,体现了其作为一种准粒子的内涵.而表面等离子体波(SPW)的提法是从波动的角度来看待这种现象的.
2.2 双SPP吸收的概念和特点[18,27]
双SPP吸收(two SPP absorption)是指介质分子内部电子吸收两个SPP的能量后从基态跃迁到激发态的三阶非线性过程.从能量的角度来看,双SPP吸收与双光子吸收的过程类似.两者均是通过吸收两个“能量子”实现介质分子内部电子的跃迁.不同的是,双光子吸收中的能量单元是光子,而双SPP吸收中的能量单元是photon与surface plasmon共同耦合作用形成的polariton.
双SPP吸收与双光子吸收同为双能量子参与的非线性吸收过程,具有以下共同的特点[15]:
1)非线性吸收的过程具有显著的阈值效应;
2)非线性吸收概率与电磁场的强度平方I2(电场的四次方)呈正比.
由于SPP是一种photon和surface plasmon相互耦合形成的准粒子,金属自由电子的参与使得SPP具有异于光子的特殊性质.不同于双光子吸收,双SPP吸收效应具备的新特性为:
1)尽管同频率下的光子和SPP具有相同的能量,但是等离子体的参与使得SPP具有更大的动量(波矢)、更短的波长,如图2中光波与SPP的色散曲线所示;SPP模式在媒质(光刻胶)中实现亚波长的电磁场分布,在突破光学衍射极限的尺度范围内实现非线性吸收;
2)由于photon与surface plasmon的相互耦合作用,模场体积被压缩,金属界面附近场强得到增强,金属表面材料非线性吸收概率得到了提高;双SPP吸收中的场增强效应可以降低非线性吸收对入射光源功率的要求,或者对于相同输出功率的激光源可以增大单次曝光的面积.
可见,SPP参与的非线性过程与传统的光子参与的非线性吸收过程既有联系,又有显著的不同.双SPP吸收带来的新特性有助于大光刻视场、超小尺度图形光刻的技术取得突破.

图2 双SPP吸收过程示意图 (a)SPP与光波的色散曲线;(b)双SPP吸收和双光子吸收Fig.2.Schematic of two SPP absorption:(a)Dispersion curve of light and SPP;(b)two photon absorption and two SPP absorption.
3 基于双SPP吸收的光刻
3.1 800 nm飞秒激光作用下的双SPP吸收光刻[18,27]
图3所示为双SPP吸收光刻的示意图.在透明的玻璃衬底上方为厚度为100 nm的金膜,金膜上方的媒质为光刻胶.金和光刻胶的介电常数分别为εAu=-25+1.8i[28]和εresist=2.465.金膜上有两组周期性的光栅,光栅的周期与金-光刻胶界面所支持的SPP波长一致.中心波长为800 nm,脉冲宽度为150 fs,x偏振态的飞秒激光从玻璃衬底照射至金属膜.通过光栅补偿激励SPP所需的波矢,在金-光刻胶界面上产生相向传播的SPP,在两组光栅之间的区域形成谐振腔,SPP相互叠加形成干涉条纹.图3(c)为模拟仿真结果,可见在800 nm飞秒脉冲激光作用下可以获得稳定且对比度高的干涉条纹.飞秒激光的谱宽对干涉条纹的影响可以忽略.图3(d)为金膜上方x-z平面内SPP干涉条纹电场强度平方I2(归一化)分布,仿真结果表明干涉条纹具有很高的对比度,同时条纹中心的强度最大,远离条纹中心强度不断衰减.因此,通过控制入射光的功率,可以使得干涉条纹分布中只有强度位于双SPP吸收阈值之上的部分能够有效地发生非线性反应,从而调控光刻线宽.
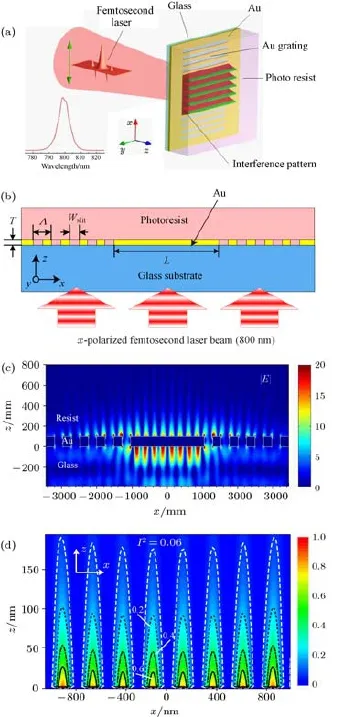
图3 基于双SPP吸收干涉光刻示意图和模拟结果(a)和(b)为干涉光刻的3维和2维示意图;(c)800 nm波长下SPP干涉条纹的仿真结果;(d)金膜上方x-z平面SPP干涉条纹的电场强度平方的分布Fig.3.Schematic fi gure of two SPP absorption lithography and simulation results:(a)Three-dimensional and(b)two-dimensional schematic fi gure;(c)interference pattern of SPP under illumination of 800 nm femtosecond laser;(d)the square of SPP intensity on the metal fi lm.

图4 双SPP吸收(800 nm飞秒激光作用下)干涉光刻结果 (a)光刻胶图形的SEM显微照片和AFM扫描结果(激光平均功率630 mW);(b)图(a)中蓝色虚线处的光刻胶表面形貌;(c)降低曝光功率后光刻胶的表面形貌(激光平均功率230 mW)Fig.4. Experiment results of two-SPP-absorption lithography under illumination of 800 nm femtosecond laser:(a)SEM and AFM photos of resist patterns with illumination power of 630 mW;(b)the pro fi le of resist along the blue dashed-line in fi gure(a);(c)the resist patterns with lower illumination power of 230 mW.
利用溅射、聚焦离子束刻蚀制备金属SPP光刻模板,并旋涂具有非线性作用的光刻胶(在800 nm波长输入光作用下,光刻胶不会发生单光子吸收;在400 nm输入光作用下,光刻胶发生单光子吸收的变性过程).再将平均功率为630 mW的飞秒激光经透镜汇聚后照射到样品表面.将经过10 s飞秒激光照射的样品依次在SU-8显影液、异丙醇和去离子水中浸泡35,10和30 s.利用扫描电子显微镜(SEM)和原子力显微镜(AFM)可以观察到金属光栅间明显的周期性光刻胶条纹,如图4(a)所示.图4(b)为图4(a)中蓝色虚线处光刻胶的表面形貌,光刻胶的周期约为240 nm、线宽约为120 nm、平均高度约为60 nm.利用双SPP吸收的阈值效应,通过调控曝光剂量可以对光刻线宽进行控制.将飞秒激光的平均功率从630 mW降低为230 mW,曝光时间从10 s变为15 s,图4(c)显示条纹线宽从约120 nm减小到约70 nm(条纹周期仍约为240 nm),条纹线宽仅为曝光波长800 nm的1/11,极大地突破了衍射极限的限制.
实验中条纹线宽不均匀、条纹不完整呈现断续状,主要原因是激励SPP的金属周期光栅不均匀且有形变,同时金膜的粗糙表面以及光刻条件对最终光刻条纹的质量造成了影响.
3.2 400 nm飞秒激光作用下的双SPP吸收光刻[18,29]
通过改变曝光波长可以进一步减小干涉条纹的周期与线宽.为进一步挖掘双SPP吸收纳米光刻的潜力,将曝光波长缩短为400 nm.图5(a)所示为400 nm飞秒激光作用下基于双SPP吸收效应的光刻示意图.此时,采用铝膜作为金属材料(厚度T=100 nm),铝膜上方的媒质为光刻胶.纳米狭缝代替光栅激励SPP模式.图5(b)的仿真结果表明在400 nm飞秒激光作用下,图5(a)所示结构可获得周期约240 nm的干涉条纹.

图5 波长400 nm飞秒激光作用下的双SPP吸收干涉光刻示意图和模拟结果 (a)结构示意图;(b)纳米狭缝激励的SPP干涉条纹强度平方分布Fig. 5. Schematic fi gure of two-SPP-absorption lithography and simulation results for 400 nm femtosecond laser:(a)Two-dimensional schematic fi gure; (b)interference pattern of SPP on the metal fi lm.
不同于800 nm飞秒激光作用下的光刻,此处光刻胶采用深紫外光刻胶(在400 nm波长输入光作用下,光刻胶不会发生单光子吸收;在200 nm输入光作用下,光刻胶发生单光子吸收的变性过程).利用平均功率为50 mW的飞秒激光曝光样品8 s,并依次在显影液和去离子水中浸泡8和360 s.光刻图形SEM和AFM照片如图6(a)和图6(b)所示,可以观察到明显的周期性光刻胶条纹.图6(c)对应图6(b)中黄色虚线的光刻胶条纹表面形貌,光刻胶的空间周期约为138 nm,条纹的平均线宽约为70 nm.图中绿色虚线所指示的光刻胶是由透过金属狭缝的激光直接作用形成的.
与800 nm飞秒激光下的双SPP吸收光刻类似,这里通过改变曝光的计量(激光功率或曝光时间),同样也可以实现条纹线宽的调控.平均曝光功率为50 mW时光刻胶平均线宽随曝光时间的变化如图6(d)所示.结果表明,当曝光时间从20 s减小至5 s时,光刻胶平均线宽从约85 nm减小到约50 nm.实验中入射至样品表面的光斑直径约为1.6 mm,表明基于双SPP吸收效应的纳米光刻可应用于大视场的纳米光刻.
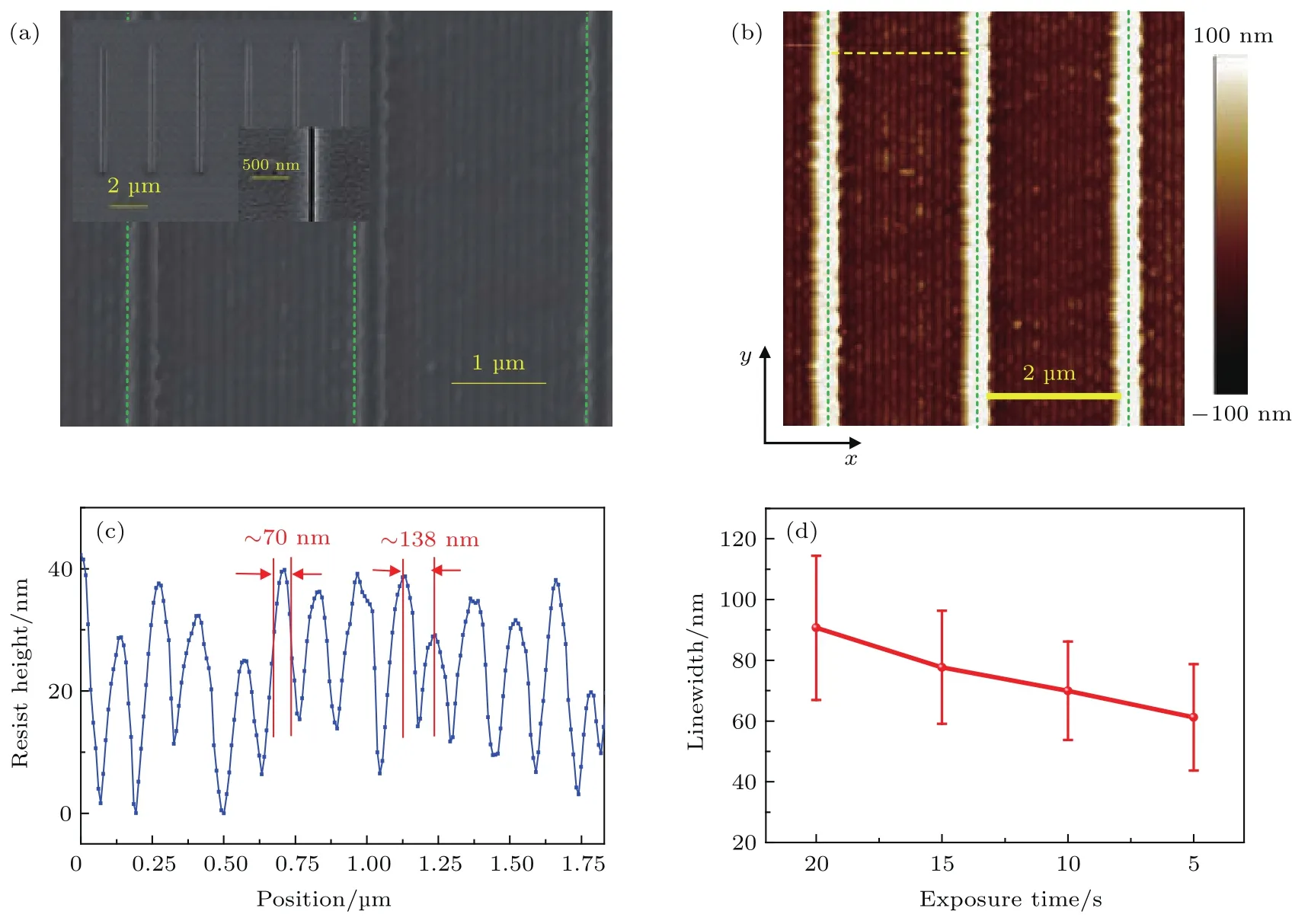
图6 双SPP吸收(400 nm飞秒激光作用下)干涉光刻结果 (a)光刻胶图形的SEM照片(插图为激励SPP的纳米狭缝照片);(b)光刻图形的AFM照片;(c)对应图(b)中黄色虚线的光刻胶条纹表面形貌;(d)光刻胶条纹线宽随曝光时间的变化Fig.6.Experiment results of two-SPP-absorption lithography under illumination of 400 nm femtosecond laser:(a)SEM and(b)AFM photos of resist patterns;(c)the pro fi le of resist along the yellow dashed-line in fi gure(b); (d)the linewidth as a function of exposure time.
3.3 同心圆环纳米光刻[18,30]
利用双SPP吸收光刻还可以实现较为复杂的图形.图7(a)所示为利用双SPP吸收光刻实现同心圆环图形的示意图.铝膜上的圆型狭缝结构在不同偏振光照射下可以实现复杂的同心圆环干涉图形.仿真结果如图7(b)和图7(c)所示,在垂直线偏振光作用下,可获得扇形的周期环状干涉条纹;在圆偏振光作用下,可激励完整的周期同心圆环干涉条纹.
图8(a)为在铝膜上制备的圆形狭缝结构.当入射飞秒激光为线偏振时,半径为2.5µm的圆形狭缝形成的光刻图形如图8(b)和图8(c)所示,可以看到明显的扇形周期环状光刻胶条纹,环纹线宽约为70 nm.图8(c)相对图8(b)的曝光时间较短,根据前面提到的双SPP吸收光刻的阈值效应,可以看到光刻胶图形主要存在于光强较强的圆环中心区,图形线宽约为60 nm.若入射飞秒激光的偏振态为圆偏振,获得的光刻图形为完整的同心圆环,如图8(d)所示,与模拟结果完全符合.

图7 基于双SPP吸收同心圆环纳米光刻示意图和模拟结果 示意图(a);线偏振(b)和圆偏振(c)飞秒激光作用下SPP图形模拟结果Fig.7.Two-SPP-absorption lithography for concentric circles:Schematic fi gure(a);SPP interference pattern of concentric circles with linear(b)and(c)circular polarization.
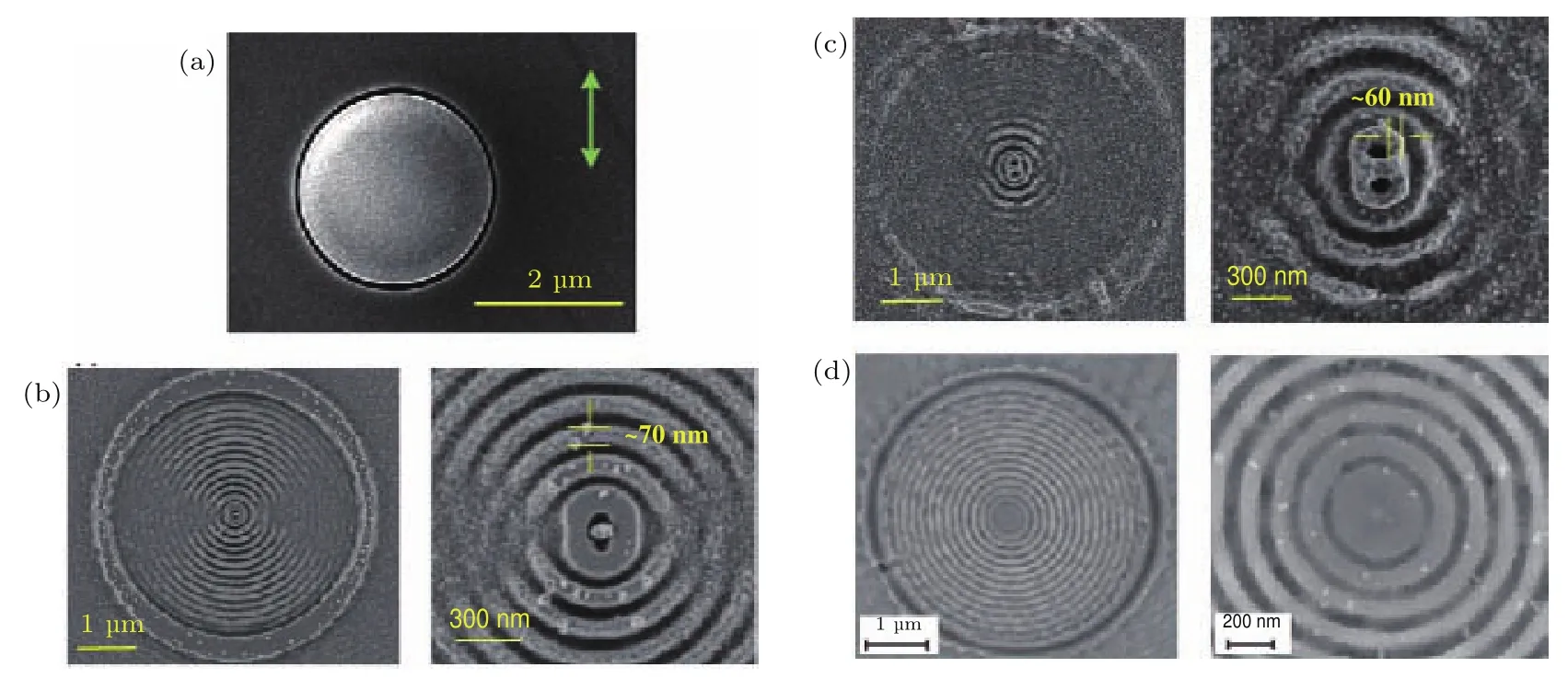
图8 基于双SPP吸收(400 nm飞秒激光)同心圆环纳米光刻实验结果 (a)铝膜上用于激励SPP的圆形纳米狭缝;(b)线偏振光作用下的部分同心圆环光刻图形;(c)线偏振光短时间曝光后的光刻图形;(d)圆偏振光作用下的同心圆环结构Fig.8.Experiment results of concentric circles based on two-SPP-absorption lithography:(a)The ring nano-slits on the Al fi lm for SPP pattern;(b)resist pattern under illumination of linear polarized femtosecond laser;(c)resist pattern with lower illumination dose compared with that in fi gure(b);(d)resist pattern under illumination of circular polarized femtosecond laser.
进一步,可以将制备的同心圆环光刻图形转移至芯片衬底,有望实现电磁波的聚焦、滤波等功能,并有望在亚波长光学器件[31,32]、生化传感等[33,34]方面得到应用.上述光刻结果表明,利用基于双SPP吸收效应的光刻,在不同结构和不同曝光条件下可以实现不同形状的复杂纳米图形.同时该光刻方法精确地记录下SPP干涉的场分布信息,提供了一种有效的记录SPP场的手段.
4 总 结
本文针对双SPP吸收(SPP在光刻胶中的非线性作用)突破光学衍射极限及其应用于大视场纳米图形制备中的关键问题展开了理论和实验研究.阐明了双SPP吸收既有与双光子吸收相同的特点,即显著的阈值效应和吸收概率与场强度平方成正比,又有其独有的特点,如更易实现亚波长电磁分布和更高的场强.通过设计和制备金属SPP模板,模拟仿真了飞秒激光作用下的SPP干涉图形,利用800 nm飞秒激光实现了周期约为240 nm、线宽约为120 nm的光刻胶条纹,并通过降低曝光功率,将条纹线宽降低约为70 nm,仅为曝光波长的1/11;将曝光波长减小为400 nm,实现了周期约为138 nm、线宽约为70 nm的光刻胶条纹,并通过改变曝光时间,实现了条纹线宽从约85 nm到约50 nm的有效调控.此外,利用简单的圆形纳米狭缝SPP模板,实现了复杂的同心圆环结构.实验中飞秒激光的单次曝光区域的直径达到1.6 mm,较纳米图形尺度大4—5个数量级,验证了双SPP吸收效应应用于大视场纳米光刻的可行性.本文只对基于双SPP吸收的纳米光刻做了初步探索,考虑到纳米金属/介质结构中丰富的SPP模式和不同的特性,结合双SPP吸收效应的特点,有望在更大的光刻视场下获得更多高质量的纳米光刻图形.
[1]Mack C 2008 Fundamental Principles of Optical Lithography:the Science of Microfabrication(Hoboken:John Wiley&Sons)
[2]Bakshi V 2009 EUV Lithography(Vol.178)(Bellingham:Spie Press)
[3]Cumpston B H,Ananthavel S P,Barlow S,Dyer D L, Ehrlich J E,Erskine L L,Heikal A A,Kuebler S M,Lee I Y S,McCord-Maughon D,Qin J 1999 Nature 398 51
[4]Srituravanich W,Fang N,Sun C,Luo Q,Zhang X 2004 Nano Lett.4 1085
[5]Chou S Y,Krauss P R,Renstrom P J 1996 J.Vacuum Sci.Technol.B:Microelectr.Nanometer Struct.Process.Measur.Phenom.14 4129
[6]Zhai T,Zhang X,Pang Z,Dou F 2011 Adv.Mater.23 1860
[7]Zayats A V,Smolyaninov I I,Maradudin A A 2005 Phys. Reports 408 131
[8]Brongersma M L,Kik P G 2007 Surface Plasmon Nanophotonics.(Berlin:Springer)
[9]Srituravanich W,Durant S,Lee H Sun C,Zhang X 2005 J.Vacuum Sci.Technol.B:Microelectr.Nanometer Struct.Process.Measur.Phenom.23 2636
[10]Luo X,Ishihara T 2004 Appl.Phys.Lett.84 4780
[11]Seo S,Kim,H C,Ko H,Cheng M 2007 J.Vacuum Sci.Technol.B:Microelectr.Nanometer Struct.Process.Measur.Phenom.25 2271
[12]Srituravanich W,Pan L,Wang Y,Sun C,Bogy D B, Zhang X 2008 Nature Nanotechnol.3 733
[13]Pan L,Park Y,Xiong Y,Ulin-Avila E,Wang Y,Zeng L, Xiong S,Rho J,Sun C,Bogy D B,Zhang X 2011 Sci. Reports 1 175
[14]Melville D O,Blaikie R J 2005 Opt.Express 13 2127
[15]Sun H B,Kawata S 2004 In NMR·3D Analysis·Photopolymerization(Berlin:Springer Berlin Heidelberg) pp169–273
[16]Lee K S,Yang D Y,Park S H,Kim R H 2006 Polym. Adv.Technol.17 72
[17]Park S H,Yang D Y,Lee K S 2009 Laser Photon.Rev. 3 1
[18]Li Y X 2014 Ph.D.Dissertation(Beijing:Tsinghua University)(in Chinese)[李云翔 2014博士学位论文 (北京:清华大学)]
[19]Bellan P M 2008 Fundamentals of Plasma Physics (Cambridge:Cambridge University Press)
[20]Ritchie R H 1957 Phys.Rev.106 874
[21]Ponath H E,Stegeman G I 2012 Nonlinear Surface Electromagnetic Phenomena(Vol.29)(Amsterdam:Elsevier)
[22]Raether H 2013 Surface Plasmons on Smooth and Rough Surfaces and on Gratings (Berlin:Springer-Verlag Berlin)
[23]Pines D 1956 Rev.Modern Phys.28 184
[24]Raether H 2006 Excitation of Plasmons and Interband Transitions by Electrons(Vol.88)(Berlin:Springer)
[25]Chen D Z A 2007 Ph.D.Dissertation(Massachusetts:Massachusetts Institute of Technology)
[26]Hop field J J 1958 Phys.Rev.112 1555
[27]Li Y,Liu F,Xiao L,Cui K,Feng X,Zhang W,Huang Y 2013 Appl.Phys.Lett.102 063113
[28]Palik E D 1998 Handbook of Optical Constants of Solids (Vol.3)(Cambridge:Academic Press)
[29]Li Y,Liu F,Ye Y,Meng W,Cui K,Feng X,Zhang W, Huang Y 2014 Appl.Phys.Lett.104 081115
[30]Meng W S 2015 M.S.Dissertation(Beijing:Tsinghua University)(in Chinese)[孟维思2015硕士学位论文(北京:清华大学)]
[31]Fu Y,Zhou X 2010 Plasmonics 5 287
[32]Carretero-Palacios S,Mahboub O,Garcia-Vidal F J, Martin-Moreno L,Rodrigo S G,Genet C,Ebbesen T W 2011 Opt.Express 19 10429
[33]Gao Y,Gan Q,Bartoli F J 2014 IEEE Photon.J.6 1
[34]Gao Y,Xin Z,Zeng B,Gan Q,Cheng X,Bartoli F J 2013 Lab on a Chip 13 4755
PACS:81.16.Nd,42.50.St,42.65.—k DOI:10.7498/aps.66.148101
Nanolithography based on two-surface-plasmon-polariton-absorption∗
Liu Fang†Li Yun-Xiang Huang Yi-Dong‡
(Tsinghua National Laboratory for Information Science and Technology,Department of Electronic Engineering,Tsinghua
University,Beijing 100084,China)
19 June 2017;revised manuscript
5 July 2017)
Lithography is one of most important technologies for fabricating micro-and nano-structures.Limited by the light di ff raction limit,it becomes more and more difficult to reduce the feature size of lithography.Surface plasmon polariton (SPP)is due to the interaction between electromagnetic wave and oscillation of free-electron on metal surface.For the shorter wavelength,higher field intensity and abnormal dispersion relation,the SPP would play an important role in breaking through the di ff raction limit and realizing nanolithography.In this paper,we theoretically and experimentally study the optical nonlinear e ff ect of SPP(two-SPP-absorption)in the photoresist and its application of nanolithography with large field.First,the concept and features of two-SPP-absorption are introduced.Like two-photo-absorption,the two-SPP-absorption based lithography is able to realize nanopatterns beyond the di ff raction limit:1)the absorption rate quadratically depends on the light intensity,which can further squeeze the exposure spot;2)the pronounced power threshold provides a possibility for precisely controlling the linewidth by manipulating the illumination power. Nevertheless,unlike the two-photo-absorption lithography which focuses light onto a single spot and scans point by point, the two-SPP-absorption method could obtain the subwavelength field pattern by simply illuminating the plasmonic mask. The subwavelength field pattern due to the short wavelength of SPP would further result in the overcoming-di ff ractionlimit resist pattern.Besides,the highly concentrated SPP field leads to the strong electromagnetic field enhancement at the metal-dielectric interface,which could reduce the input power density of exposure source or enlarge the exposure area.Then the two-SPP absorption is realized under the illuminations of femtosecond lasers with vacuum wavelengths of 800 nm and 400 nm.Meanwhile,the interference periodic patternis realized and it is observed that the linewidth could be adjusted by controlling the exposure dose.The minimum linewidth of resist pattern is only one tenth of the vacuum wavelength.By utilizing the features of two-SPP-absorption,namely shorter wavelength,enhanced field and threshold e ff ect,the lithography field could be of millimeter size,which is about four to fi ve orders of magnitude larger than the characteristic size of nanostructure.Therefore,this two-SPP-absorption scheme could be used for large-area plasmonic lithography beyond the di ff raction limit with the help of various plasmonic structures and modes.
surface plasmon polariton,nano-lithography,nonlinear optics,di ff raction limit
:81.16.Nd,42.50.St,42.65.—k
10.7498/aps.66.148101
∗国家重点基础研究发展计划(批准号:2013CBA01704)和国家自然科学基金(批准号:61575104,61621064)资助的课题.
†通信作者.E-mail:liu_fang@tsinghua.edu.cn
‡通信作者.E-mail:yidonghuang@tsinghua.edu.cn
©2017中国物理学会Chinese Physical Society
http://wulixb.iphy.ac.cn
*Project supported by the National Basic Research Programs of China(Grant No.2013CBA01704)and the National Natural Science Foundation of China(Grant Nos.61575104,61621064).
†Corresponding author.E-mail:liu_fang@tsinghua.edu.cn
‡Corresponding author.E-mail:yidonghuang@tsinghua.edu.cn

