金属衬底上高质量大面积石墨烯的插层及其机制∗
郭辉 路红亮 黄立 王雪艳 林晓 王业亮 杜世萱 高鸿钧
(中国科学院物理研究所,中国科学院大学,北京 100190)
金属衬底上高质量大面积石墨烯的插层及其机制∗
郭辉 路红亮 黄立 王雪艳 林晓 王业亮 杜世萱†高鸿钧‡
(中国科学院物理研究所,中国科学院大学,北京 100190)
(2017年7月14日收到;2017年8月31日收到修改稿)
石墨烯,硅,插层技术,扫描隧道显微镜
1 引 言
石墨烯(graphene,Gr)是一种由sp2杂化的碳原子构成的六角蜂窝状二维原子晶体[1].这种独特的晶格结构导致石墨烯中出现很多新奇的物理现象,如室温下量子霍尔效应[2]、Berry相位[3]、Klein隧穿[4]等,以及优异的性质,如超高的载流子迁移率[5,6]、高机械强度、高热导率、高柔性等.它不仅为凝聚态物理中基本问题的研究提供了全新的平台,而且在大规模集成电路、柔性电子学等领域具有广阔的应用前景.因此,石墨烯也被看作是在后硅时代最具潜力的新型材料之一.
为满足石墨烯在科学和工业领域的需求,人们一方面需要制备高质量、大面积的石墨烯样品,另一方面还需要将这些高质量石墨烯无损地置于半导体、绝缘衬底之上以实现功能器件.已报道的将石墨烯置于半导体或绝缘衬底之上的方法有如下几种:通过机械剥离[5]、化学腐蚀[7,8]或化学气泡[9]等方法将石墨烯转移至半导体或绝缘衬底上,或通过化学气相沉积在SiO2[10,11]或其他绝缘衬底[12−15]上直接生长石墨烯.然而这些方法都存在一些不足:一是人们难以获得大面积的单畴石墨烯,二是在转移的过程中会污染石墨烯[16],不可避免地在石墨烯中产生缺陷,从而降低其载流子迁移率等[17].另一方面,通过超高真空分子束外延(ultrahigh vacuum-molecular beam epitaxy,UHVMBE)的方法,可在一些过渡族金属单晶衬底(如Ru(0001)[18−20],Ir(111)[21,22],Ni(111)[23,24])表面外延生长出高质量、大面积的单晶石墨烯.然而这些外延生长的石墨烯和大多数金属基底有较强的相互作用,电子轨道间的相互耦合导致石墨烯失去其本征特性[25,26].因此,如何将外延生长的高质量单晶石墨烯无损地置于半导体或绝缘衬底之上一直是研究的热点.同时如何将高质量的单晶石墨烯与当前的硅基技术相兼容是一个很大的挑战.
近年来,研究人员发展了一种与当前硅基工艺融合的插层技术,可以将高质量、大面积的单晶石墨烯原位且无损地置于半导体之上[27−29].在UHV-MBE系统中,结合金属单晶表面外延生长高质量石墨烯的工艺,原位引入异质原子硅(Si)、铪(Hf),或其他金属原子,通过退火将异质原子插层到石墨烯和金属基底的界面处并形成连续薄膜.该技术不仅可以有效屏蔽石墨烯和基底的相互作用,使石墨烯恢复本征性质,而且构造了多种石墨烯/插层异质结构,为调控石墨烯的性质提供了新的途径.同时,基于Si或Hf的成功插层,有望进一步通过引入氧元素将插层元素氧化以获得SiO2或HfO2等高介电层,实现原位地将石墨烯置于绝缘衬底之上,为高质量石墨烯功能器件的制备提供新的方法.本文对金属单晶衬底表面外延石墨烯的Si插层结构及其对石墨烯电子结构的影响、多层Si插层、金属单晶薄膜衬底上的Si插层、金属原子插层、异质原子的插层机制、C原子插层(双层石墨烯)等方面的最新进展进行综述,并对该领域的未来发展趋势进行展望.
2 外延石墨烯硅插层的结构分析
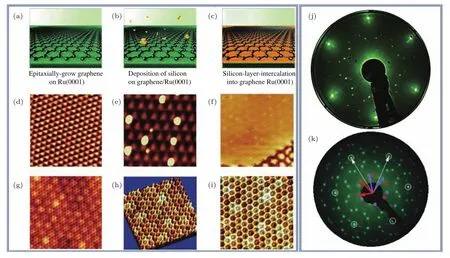
图1 单晶Ru(0001)表面外延石墨烯的硅插层 (a)—(c)硅插层过程示意图;(d)Ru(0001)表面石墨烯的STM图像(40 nm×40 nm);(e)石墨烯表面沉积硅原子后的STM图像(2 nm×2 nm);(f)经过退火完成硅插层后的STM图像(25 nm×25 nm);(g)插硅后小范围STM图像(6 nm×6 nm);(h),(i)插硅后石墨烯的三维STM图像(3 nm×3 nm)[29];(j)插硅后Gr/Ru的LEED图像;(k)Ru(0001)表面硅烯的LEED图像[30]Fig.1.Silicon intercalation of epitaxial graphene on Ru(0001):(a)–(c)Schematics of the silicon intercalation process;STM images of(d)graphene on Ru(0001)(40 nm×40 nm),(e)silicon deposition on the graphene(20 nm×20 nm)and(f)Si intercalation between graphene and Ru(0001)after annealing(25 nm×25 nm);(g)zoom-in STM image of Gr/Si/Ru(6 nm×6 nm);(h)and(i)three-dimensional STM images of the Gr/Si/Ru surface(3 nm×3 nm)[29];(j)LEED pattern of Gr/Si/Ru;(k)LEED pattern of silicene/Ru[30].
外延生长石墨烯的硅插层过程如图1(a)—图1(c)所示.在UHV-MBE系统中,首先在干净的原子级平整的金属单晶表面外延生长出高质量大面积单畴石墨烯,然后沉积硅原子到石墨烯表面,最后通过退火将硅原子插入到石墨烯和金属基底之间,并在界面处扩散形成连续薄膜[29].图1(d)展示了Gr/Ru表面的扫描隧道显微镜(scanning tunneling microscopy,STM)图像,可以看到样品表面出现周期约为3 nm的莫尔超结构,来源于石墨烯与Ru(0001)表面的晶格失配.沉积到石墨烯表面的硅原子会首先形成硅团簇(图1(e)).经过退火过程,硅团簇消失且样品表面恢复了原子级平整,如图1(f).这说明硅原子成功插入到石墨烯与金属基底之间的界面处且未破坏石墨烯的高质量特性.通过对比插硅前后石墨烯格子的平整度,发现插硅之后Ru表面石墨烯的起伏消失且莫尔条纹明显减弱,见图1(g)—(i).图1(j)所示的低能电子衍射(low energy electron di ff raction,LEED)图像表明,Gr/Ru界面处的单层Si插层形成了相对于Ru基底的超结构.有趣的是,在后期的研究中发现Ru(0001)表面的超结构对应着单层硅烯[30],如图1(k)所示.这意味着通过插层技术获得了石墨烯/硅烯异质结,而石墨烯和硅烯的堆垛结构将会带来更多新奇的物理现象[31].此外,硅烯在大气环境下不能稳定存在[32].通过上述插层技术,实现了在硅烯表面覆盖一层石墨烯,从而为进一步非原位研究硅烯的优异性质提供了新的途径.
与Gr/Ru体系类似,在Gr/Ir体系中同样实现了硅插层[28].在插硅之前,LEED图像(图2(a))表明Ir表面形成了一层相对于基底无转角的石墨烯,也就是石墨烯的 [110]方向和 Ir(111)表面的 [10]方向平行.而插硅之后的LEED图像(图2(b))显示莫尔条纹明显减弱,而且在Ir的衍射点内部出现了新的衍射斑点.STM(见图2(c)和图2(d))的结果与LEED结果一致,而且更清楚地显示新出现的衍射斑点是由硅插层引起的一种相对于Ir基底的莫尔超结构,其周期约为1.2 nm.该莫尔超结构有两个镜像对称的取向,其夹角约为13.2°,如图2(d)中的A和B区域所示.图2(e)给出了高清的Gr/Ir区域(右下)和Gr/Si/Ir区域(左上)的畴界(由黑色虚线标示).可以看到插硅区域的几个特征:石墨烯的蜂窝状格子、R23.41°超结构以及石墨烯下面的硅层的结构.相应的快速傅里叶变换(fast Fourier transform,FFT)图像(图2(f))包含了四组衍射点,每组包含六个点且呈六重对称性.其中周期为0.44 nm的衍射点代表石墨烯下面的硅结构,通过对FFT图像做高通处理,发现石墨烯蜂窝状格子完美地出现在最上层,而且石墨烯下面的硅层也呈现出蜂窝状格子特征.
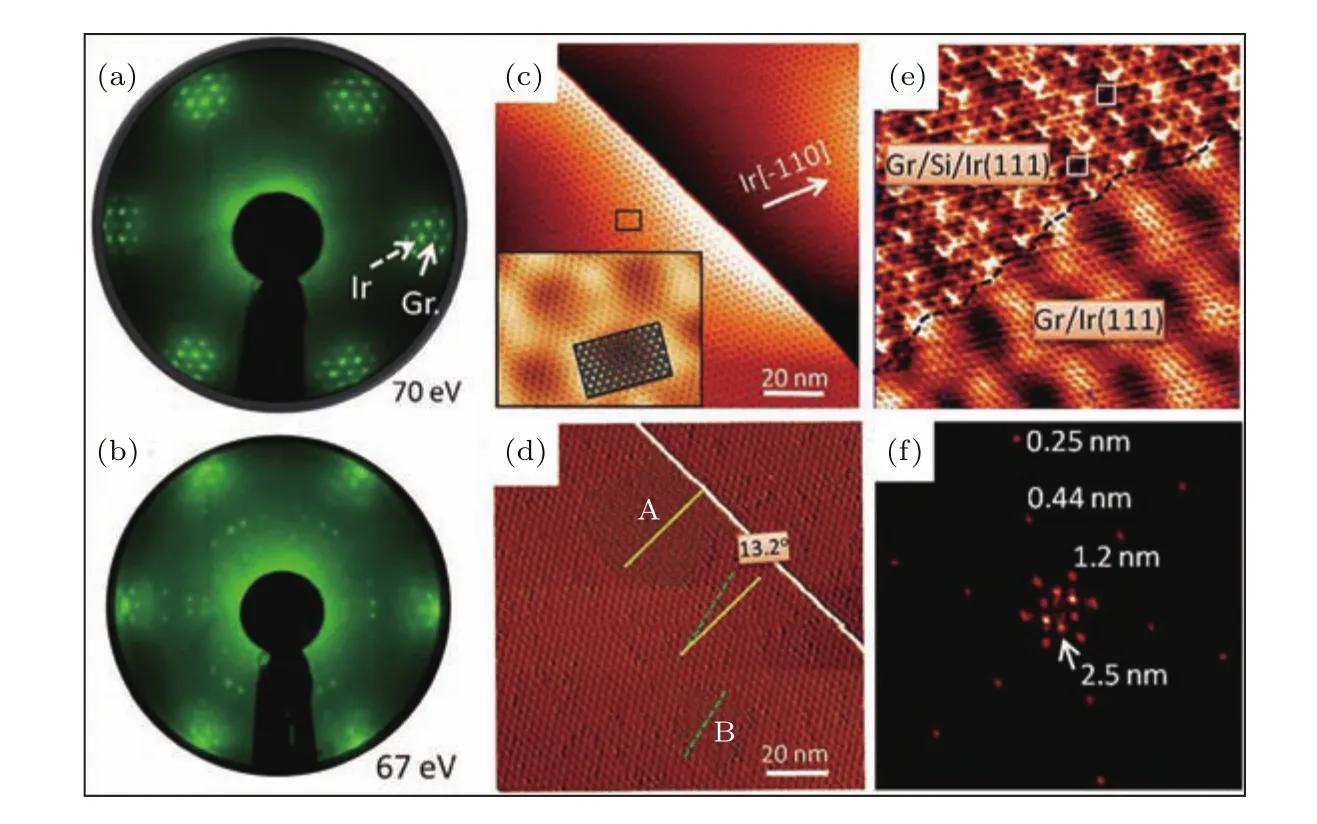
图2 单晶Ir(111)表面外延石墨烯的硅插层 (a)插硅之前的LEED图像,虚线和实线箭头分别指出了Ir(111)和石墨烯的衍射点;(b)插硅之后的LEED图像;(c)插硅之前的STM图像,插图是石墨烯的原子分辨图;(d)插硅之后的STM图像,在石墨烯和基底之间出现了两个取向的硅岛;(e)—(f)插硅和未插硅区域畴界处的原子分辨图像及相应的FFT图像[28]Fig.2.Silicon intercalation of epitaxial graphene on Ir(111):(a)LEED pattern of Gr/Ir,spots from Ir(111)and graphene adlayer are indicated by the dashed-line and solid-line arrows,respectively;(b)LEED pattern of Gr/Si/Ir,a group of new spots appear within the circle of Ir(111)di ff raction spots;(c)STM image of Gr/Ir,inset is a zoomed-in image with atomic resolution;(d)STM image of Gr/Si/Ir,showing two distinct ordered domains(marked as A and B);(e)and(f)close-up STM images and corresponding FFT patterns at the domain boundary of areas with and without silicon intercalation[28].
3 硅插层对石墨烯电子结构的影响
金属表面外延生长的石墨烯与基底之间的相互作用会导致石墨烯失去本征特性.例如,Ru(0001)表面外延石墨烯的电子轨道与Ru的4d电子轨道有较强的杂化作用,致使石墨烯失去本征能带结构[33];在Gr/Ir体系中,零转角的石墨烯在费米面附近的π带遭受一定程度的扭曲,而且未呈现出Dirac点的性质[26].为了进一步探究硅插层对石墨烯电子结构的影响,研究人员对插硅后的石墨烯样品进行了角分辨光电子能谱(angle resolved photoemission spectroscopy,ARPES)、扫描隧道显微谱(scanning tunneling spectroscopy,STS)和拉曼光谱(Raman)的研究,结果给出了插硅后石墨烯与基底之间相互作用的变化情况.
从图3(a)可以看出,在Gr/Ru体系中,插硅后的石墨烯的导带(π*)和价带(π)相交于Dirac点(ED),并恢复了本征的线性色散关系,说明硅插层有效地屏蔽了基底对石墨烯电子结构的影响.所测得的费米速度(Dirac锥在Γ—K方向的斜率)为0.95×106m/s,这和SiO2衬底上的石墨烯的费米速度处于同一量级.而且,Dirac点位于费米面下方0.26 eV处,说明硅插层后的石墨烯具有电子掺杂的特性,计算得到掺杂浓度为5.1×1012cm−2.此外,分别对Gr/Ir和Gr/Si/Ir样品做了相应的dI/dV谱(图3(b)).插硅之前,从dI/dV谱中看到在低于费米能级约0.3 eV处有一个局域极大值,这与文献[34]中报道的Ir(111)的表面态相关(0.4 eV).但是在插硅之后,这一局域态消失,此结果直接证明了硅插层可以有效地屏蔽石墨烯与基底的相互作用.而且,和插硅前相比,插硅后的dI/dV谱线变得更加对称,这一对称性表现了石墨烯的本征特征.插硅前后样品的拉曼光谱(图3(c))显示,Gr/Si/Ir样品中石墨烯恢复了其特征峰,G峰和2D峰,同样证明了硅插层屏蔽了基底对石墨烯的耦合作用.G峰和2D峰的蓝移可能源于石墨烯受到的应力和硅插层的电荷转移[35−38].另外,Gr/Si/Ir样品的拉曼光谱并没有出现缺陷峰D峰,这意味着插硅后的石墨烯仍然保持其高质量特点.总之,ARPES,STS和Raman光谱的实验结果表明,硅插层使金属单晶表面外延生长的石墨烯恢复了本征的电子结构,更接近自由状态.

图3 插硅后石墨烯的ARPES,STS和Raman表征 (a)沿着Γ—K方向,Gr/Si/Ru表面石墨烯的电子结构[29];(b)Gr/Ir和Gr/Si/Ir样品的dI/dV谱[28];(c)Gr/Ir和Gr/Si/Ir样品的Raman光谱[28]Fig.3.ARPES,STS and Raman characterizations of silicon intercalated graphene:(a)Electronic structure of Gr/Si/Ru along the Γ –K direction[29];(b)dI/dV spectroscopy measured for both Gr/Ir and Gr/Si/Ir[28];(c)Raman spectra of Gr/Ir and Gr/Si/Ir[28].
4 多层硅插层及金属单晶薄膜上外延石墨烯的硅插层
利用上述插层技术不仅可以获得单层的硅插层,而且当增加插层次数,沉积更多的硅时,可以获得双层甚至更厚的硅层[29].图4(a)所示的STM图像给出了双层(左边)和单层(右边)硅插层区域的边界,两区域的高度之差大约是3 Å,接近于单层硅的高度.从双层硅插层区域的石墨烯高分辨STM图像(图4(b)和图4(c))中可以看出,石墨烯变得更加平坦,它和基底间的相互作用变得更弱.此外,还可以用金属单晶薄膜代替块材单晶[27].利用在YSZ(yttria-stabilized zirconia)衬底上生长的Ir(111)单晶薄膜,通过上述插层技术成功获得了高质量的石墨烯/硅异质结构,扫描透射电子显微镜和电子能量损失谱表明了硅原子位于石墨烯和Ir单晶薄膜之间(如图4(d)).石墨烯和金属界面的双层Si的插入和在金属薄膜上外延石墨烯的Si插层的成功制备,为石墨烯器件和硅基器件的集成,以及进一步降低成本以实现工业上的大规模应用提供了有价值的参考.
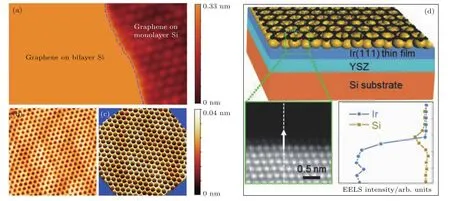
图4 多层硅插层及Ir(111)单晶薄膜衬底上的硅插层 (a)单层硅和双层硅插层区域的边界(12 nm×7 nm);(b)和(c)是在双层硅插层区域扫描的石墨烯高分辨STM图像(4.5 nm×4.5 nm)[29];(d)Ir(111)单晶薄膜衬底上外延石墨烯的硅插层[27]Fig.4.(a)STM images of thick silicon intercalated graphene,in ML silicon intercalated region,the moiré pattern can be observed(12 nm×7 nm);(b),(c)high resolution STM images at the bilayer silicon intercalated region,showing clearly each carbon atom of the graphene lattice(4.5 nm×4.5 nm)[29];(d)silicon intercalation of epitaxial graphene grown on single-crystalline Ir(111)thin films[27].
5 外延石墨烯的金属原子插层
受硅插层的启发,研究人员还实现了Ir(111)表面外延生长石墨烯的铪(Hf)插层[39].HfO2在微电子器件领域具有广泛的应用,其介电常数要远高于SiO2[40].因此,若能实现Hf插层,就有可能通过进一步的氧插层使Hf氧化进而获得Gr/HfO2/Ir异质结构,为实现石墨烯的功能器件提供新的渠道.首先通过STM和LEED确认了在单晶Ir(111)表面外延生长出了高质量大面积的单晶石墨烯,如图5(a)和图5(b).然后沉积适量的Hf原子到石墨烯表面,通过退火过程使吸附在石墨烯表面的Hf原子插层到石墨烯下面,并形成一个新的超结构(图5(c)和图5(d)).此外,石墨烯的起伏减弱且莫尔条纹变得模糊不清,可以推断Hf插层的存在削弱了石墨烯和基底Ir的相互作用,使石墨烯更加趋近于自由态(与Raman结果一致).从更细致的STM图像可以得出,石墨烯位于铪层的上面,且铪层所对应的超结构的周期为0.54 nm(同LEED结果一致),是基底Ir(111)晶格常数的两倍,即铪插层形成了相对于基底2×2的超结构(图5(e)—5(h)).值得注意的是,在后来的报道中该超结构被证明是铪烯[41],这种由d电子金属元素构成的二维蜂窝状结构具有更强的自旋轨道耦合,通过插层技术获得的石墨烯/铪烯垂直异质结构为研究二维体系中新的量子现象提供了全新的材料体系.

图5 单晶Ir(111)表面外延生长石墨烯的Hf插层 (a),(b)Hf原子插层前的STM和LEED图像;(c),(d)Hf原子插层后的STM和LEED图像;(e)—(h)Hf插层表面的石墨烯的原子分辨图像[39]Fig.5.Hafnium intercalation of epitaxial graphene on Ir(111):(a),(b)STM image and LEED pattern of graphene before Hf intercalation;(c),(d)STM image and LEED pattern of graphene after Hf intercalation;(e)–(h)atomic resolution STM image of graphene on intercalated Hf layer[39].
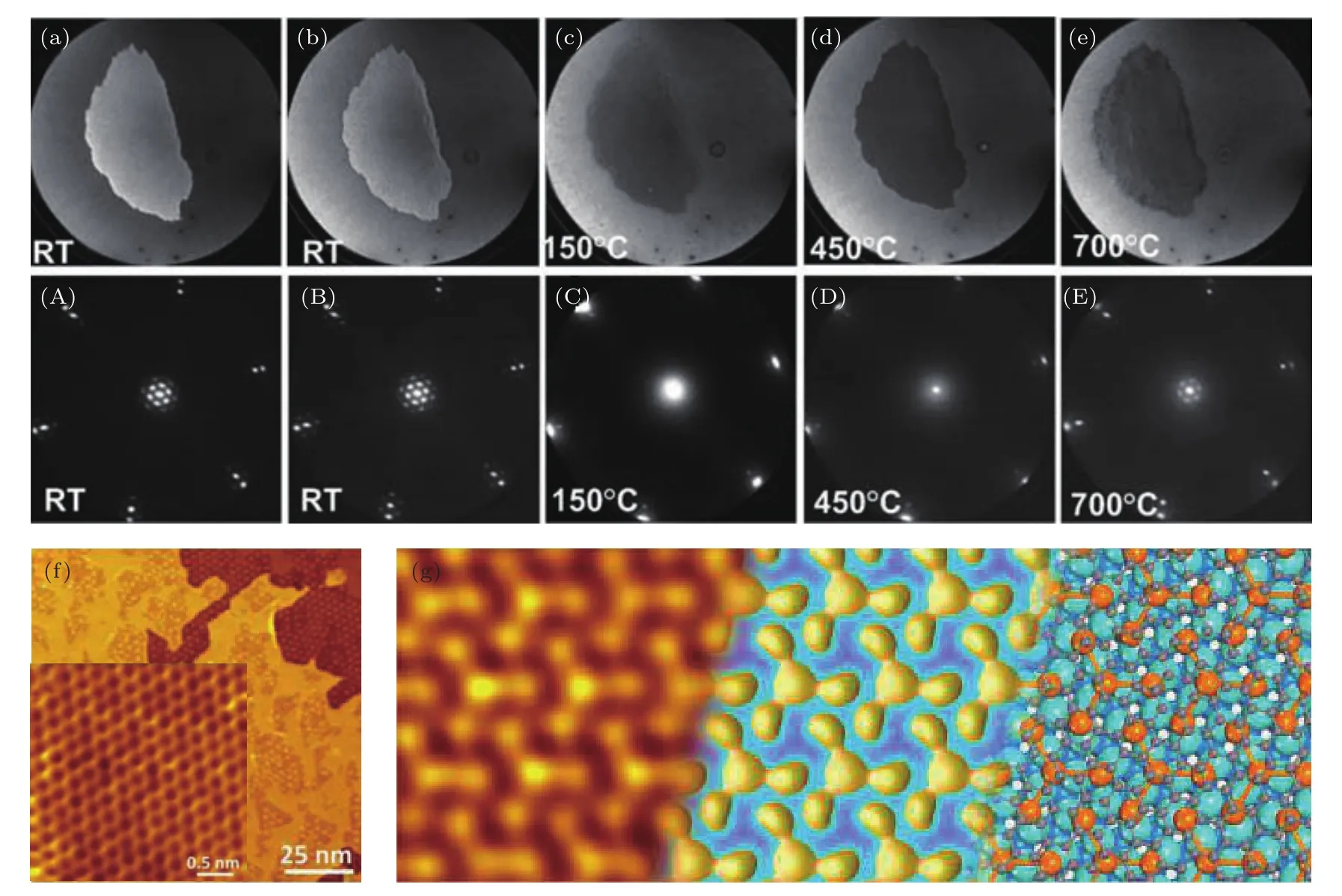
图6 单晶Ru(0001)表面外延石墨烯的Pb插层 (a)Gr/Ru,(b)沉积Pb之后未退火,(c)—(e)在标定温度下退火后的LEEM图像;(A)—(E)是(a)—(e)相应的LEED图像[44];(f)插Pb后的STM图像;(g)界面处Pb插层的结构及理论模型[45]Fig.6.Pb intercalation of epitaxial graphene on Ru(0001):(a)LEEM image of Gr/Ru;(b)LEEM image after Pb deposition before anneal;(c)–(e)LEEM images of sample annealed at the marked temperatures;(A)–(E)are the corresponding LEED patterns of(a)–(e)[44];(f)STM image of graphene after Pb intercalation;(g)structure and corresponding theoretical model of intercalated Pb layer at the interface[45].
石墨烯本身不具有超导特性[42],但石墨烯和超导材料接触后,超导库伯对和相对论Dirac费米子的相互作用会引起很多新的量子现象,比如双极性超导电流及镜面安德烈(Andreev)反射[4,43].通过插层过程可以将超导元素插入到石墨烯和衬底之间,从而形成石墨烯超导异质结.Jin等[44]首先在低能电子显微镜(lowenergyelectronmicroscopy,LEEM)下观察了整个Pb插层过程的演化(图6(a)—(e)). 从相应的LEED图像(图6(A)—(E))看出石墨烯和基底之间的莫尔条纹逐渐消失,表明Pb插层抵消了基底对石墨烯的耦合作用.此外,研究人员利用低温STM研究了插Pb之后石墨烯表面的形貌和结构(图6(f))[45].和插Pb之前相比,样品表面变得非常平整,更容易获得高清的石墨烯原子分辨图像,如图6(f)插图所示.密度泛函理论(density functional theory,DFT)计算结果表明在界面处的单层Pb层形成了相对于Ru(0001)基底的的超结构(见图6(g)).实验还表明插Pb后的石墨烯和Ru表面直接外延的石墨烯相比,具有更低的氧刻蚀活性.通过插层方法构建石墨烯和超导材料的异质结构将为研发全新的石墨烯功能器件提供新的思路[42].
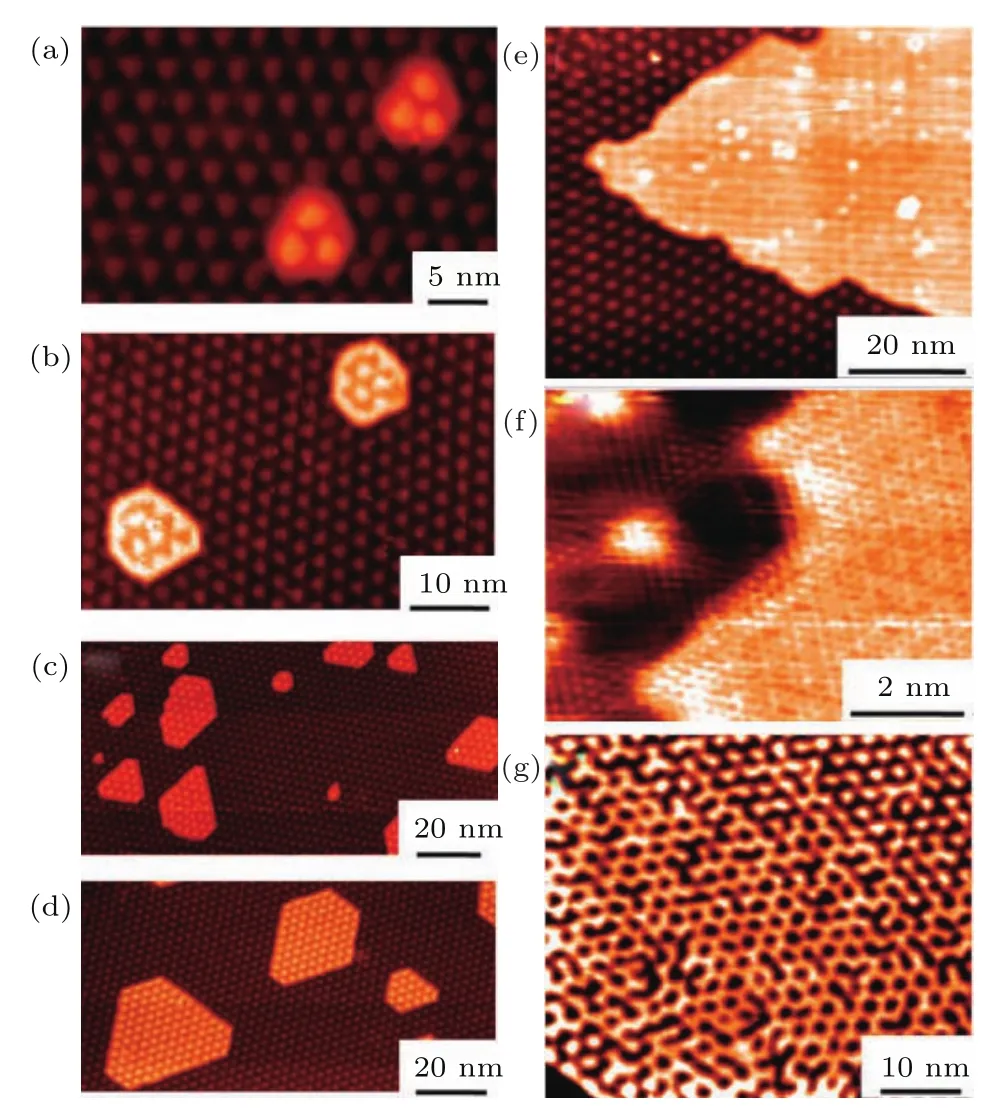
图7 单晶Ru(0001)表面外延生长石墨烯的各种金属原子插层 (a)—(g)分别对应Pt,Pd,Co,Ni,Au,In和Ce的插层[47]Fig.7.STM topographic images:Pt(a),Pd(b),Co(c),Ni(d),Au(e),In(f),and Ce(g)intercalation structures at the interface of Gr/Ru[47].
性质各异的金属原子在插层之后会形成不同的结构,进而可以达到调控石墨烯性质的目的.Schumacher等[46]研究了稀土磁性原子Eu的插层,发现在不同覆盖度下,Eu原子在界面处会形成相对石墨烯的2×2和两种结构,而且这两种结构分别表现出顺磁和铁磁耦合两种截然不同的性质.文献[47]还报道了Pt,Pd,Co,Ni,Au,In和Ce等金属原子的插层,如图7(a)—(g)所示.这些插层原子包含贵金属、磁性金属、IIIA主族金属和稀土金属,它们在原子半径、外壳层电子结构、电负性、熔点等性质上差别很大.这显示了外延生长石墨烯的金属原子插层是一种普适性行为.不同原子构建的插层结构,形成不同的石墨烯/插层元素异质结,为调控石墨烯的性质提供了更加丰富的实验手段.
6 异质原子的插层机制
异质原子可以插层到石墨烯和金属基底的界面处,有效削弱了石墨烯和基底之间的耦合,使外延石墨烯更接近自由状态,同时在一定程度上对石墨烯的能带结构进行了调控.而关于异质原子插层机制的问题,一直以来也是人们研究的热点.已报道的插层机制有:通过石墨烯边缘进行插层[44,48,49]、通过石墨烯本身存在缺陷进行插层[50]以及异质原子与碳原子交换的机制[51]等.但是这些机制并不能解释这里的插层过程,因为Ru或Ir表面外延生长的石墨烯质量很高,缺陷非常少,这就意味着异质原子可以直接穿过单层石墨烯而并不经过边界等缺陷.
研究人员以Si在Gr/Ru界面的插层为模型体系,通过系统的STM研究并结合DFT计算,提出了一种全新的、普适性的插层机理[52].图8(a)给出了硅原子在Gr/Ru体系中插层机理的示意图.当Si原子沉积到Gr/Ru表面后,由于Si原子与Ru基底的协同作用,在一定温度下石墨烯表面可以产生随机的空位缺陷.这些缺陷的产生极大地降低了Si原子的插层势垒,会促进Si原子向界面扩散.Si原子向界面扩散的过程也是缺陷与基底协同作用的结果,而Si原子位于Gr/Ru界面相对位于石墨烯表面而言是一个更加稳定的结构.在界面的Si原子可以在插层温度下扩散形成不同的插层结构,与此同时Ru体内的碳原子在这一温度下可以偏析到晶体表面修复产生的空位缺陷.这样不断地产生缺陷、Si原子插层、Si原子在界面扩散以及缺陷修复的过程构成了完整的Si原子插层过程.需要着重强调的是缺陷的产生、Si原子的插层以及缺陷修复的过程在插层过程中是同时发生的,即缺陷在不断地产生与修复,与此同时Si原子也在不断地通过缺陷到达Gr/Ru界面完成插层.
为验证这一机制,首先在Gr/Ru表面沉积了0.05个单原子层(ML)的Si原子.Si原子会形成团簇并优先吸附在fcc位置.在400°C退火10 min之后,样品表面的STM图像(图8(b))显示了约几个纳米大小的、由Si原子团簇引起的白色突起.此外,样品表面还出现了很多尺寸约0.2 nm的小的白色突起,如蓝色箭头所指.高分辨STM图像(图8(c))表明这些小的白色亮点是由石墨烯的空位缺陷造成的;但是当提高退火温度或延长退火时间,硅原子会迁移聚集并与石墨烯缺陷结合起来形成不同高度的凸起(见图8(d)).通过对比实验,在同样条件下加热未沉积硅原子的Gr/Ru样品,发现并没有石墨烯的缺陷产生.因此可以推断石墨烯表面碳原子空位缺陷的形成与硅原子的引入密切相关.
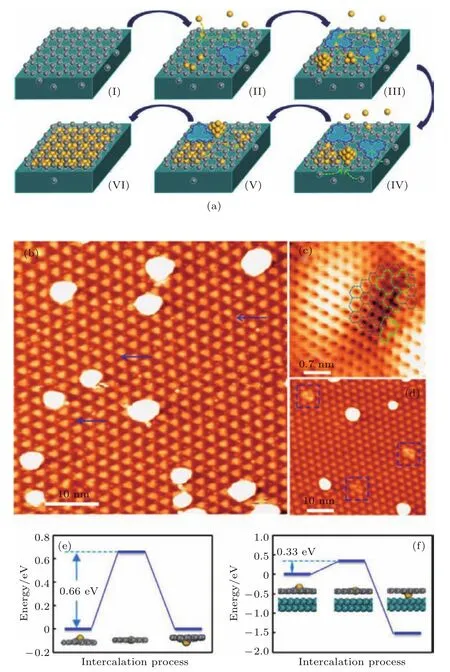
图8 (a)硅在Gr/Ru体系插层机制的示意图;(b)基底在室温时沉积0.05 ML硅到Gr/Ru表面,并经400°C退火10 min后的STM图像;(c)石墨烯碳空位缺陷处的原子分辨图像;(d)450°C退火30 min后的STM图像;(e)无Ru基底时,硅插层的势垒;(f)有Ru基底协同作用时,硅插层的势垒[52]Fig.8.(a)Schematic diagram of silicon intercalation mechanism;(b)STM image of Gr/Ru with deposition of 0.05 ML Si at room temperature,followed by thermal annealing at 400°C for 10 min;(c)atomic resolution image revealing a carbon vacancy;(d)STM image of the sample in(b)after another thermal annealing at 450°C for 30 min;(e)and(f)calculated energy barrier of Si intercalation without and with Ru substrate,respectively[52].
依据DFT计算,自由状态石墨烯产生一个空位缺陷的势垒为8.09 eV,然而在一个Si原子存在的情况下缺陷形成能降为0.26 eV,综合考虑基底和Si原子时缺陷形成能为0.23 eV.可见Ru基底与Si原子的存在均能够降低石墨烯空位缺陷的形成能,使缺陷形成的过程在较低的温度下就可以实现.在此基础上,研究人员又计算了缺陷存在时的插层势垒,从图8(e)和图8(f)得出,空位和Ru基底的存在均能极大地降低插层的势垒.只考虑空位时,插层势垒为0.66 eV;而同时考虑了空位和Ru基底的存在之后,插层势垒仅为0.33 eV,说明这样的插层过程在上述实验条件下是完全可以实现的.
这一研究发现异质原子和金属基底协同诱导石墨烯产生缺陷,从而实现插层.然而,当异质原子插层后,石墨烯依然保持着较高的质量,说明插层后的石墨烯实现了自我修复.为了验证这一过程,研究人员利用低能氩离子轰击几个Gr/Ru样品表面,产生同样初始浓度的缺陷,然后将这些样品在不同的温度下退火30 min(图9(a)—9(c)).从一系列实验结果中可以看到,随着温度的升高,更多的缺陷会被修复(图9(d)).实验中还发现在700°C进行30 min的退火即可修复几乎所有的缺陷,从而使石墨烯晶格重新恢复完整.可能的原因是Ru晶体内部本身存在的碳原子以及在制备石墨烯过程中溶解到Ru体内的碳原子可以作为碳源,在退火的过程中偏析到Ru单晶表面,实现空位缺陷的修复[53].
插层到界面处的异质原子的扩散行为是整个插层过程的一个重要环节,对于研究插层原子在界面的结构以及未来构建基于插层的二维异质结有重要的意义.Schumacher等[54]研究了Eu在Gr/Ir界面的行为,插层后的Eu原子在室温下就可以在界面扩散,导致插层结构的变化.然而,对于不同的插层体系而言,插层原子在界面的扩散势垒、石墨烯与基底的距离以及石墨烯的起伏大小等因素都会影响插层原子的扩散行为.例如对于Gr/Ru和Gr/Ir两个体系,根据表面石墨烯的莫尔周期起伏,可划分为atop,fcc和hcp区域.不同区域的石墨烯与基底的距离不同、“空间”大小不同,因此可以想象在不同区域插层原子将具有不同的扩散行为.实验研究发现,插层到界面的Si原子优先扩散和聚集到atop位置下方.当atop位置全部被占据之后,更多的扩散到界面的Si原子会依次填充fcc位和hcp位,分别形成“Y”型和三角形的插层结构;当atop位、fcc位和hcp位下方均被Si原子填充后,界面处则形成了一层Si原子插层(图9(e)—(h)).

图9 石墨烯缺陷的自我修复和硅原子在界面处的扩散行为 (a)—(c)同一缺陷浓度的样品分别在25°C,300°C,450°C退火30 min后的STM图像;(d)石墨烯的缺陷浓度和退火温度的依赖关系;(e)—(g)随着沉积量的增加,硅原子会依次选择atop,fcc和hcp位置进行插层,右上角是插层结构示意图;(h)在界面处形成了完整的单层硅[52]Fig.9.Removal of vacancies on Gr/Ru and the evolution of the intercalated Si layer at the interface:STM images of the Gr/Ru samples annealed at(a)25 °C,(b)300 °C,and(c)450 °C for 30 min;(d)relation between defect density on the Gr/Ru surface and annealing temperature;The intercalated Si atoms can sequentially occupy the areas below atop sites(e),fcc sites(f),and hcp sites(g);the inset shows the corresponding structural configuration of the intercalated Si atoms;(h)a full ML Si is formed at the interface[52].
理论计算对多个插层体系中石墨烯的空位缺陷形成能的研究发现,在以下几种体系中:Pt,Pd,Ni,Si在Gr/Ru上,Pt,Si在Gr/Ir上,以及Si在Gr/SiC上,均发现有异质原子和衬底存在时石墨烯的缺陷形成能会明显降低[52].同时在实验上也探究了Ni,Pd和Pt原子在Gr/Ru体系中的插层过程,确实观察到缺陷的产生[52].这一系列理论计算和实验结果表明异质原子诱导产生缺陷的插层机制具有普适性.
7 Ru(0001 )表面外延生长大面积双层石墨烯
金属表面外延生长的石墨烯可以通过硅等异质原子的插层使其恢复本征特性.假如以碳原子作为“异质原子”,那获得的便是双层石墨烯.双层石墨烯是由两层石墨烯按照一定的方式堆垛而成,不仅继承了石墨烯的优异性质,同时还具有其独有的物理化学性质.与单层石墨烯不同的是,其电子结构受两层石墨烯间耦合作用的调制,因此可以通过调控双层石墨烯层间的堆垛结构来调制双层石墨烯的电子结构及其性质[55].此外可以通过在两层石墨烯之间插入其他原子形成最薄的插层石墨结构[56].可以说双层石墨烯具有更为丰富的调控自由度,因此一直受到广泛关注和研究.下文介绍在Ru(0001)表面外延生长大面积、高质量双层石墨烯,并展示表层的石墨烯接近自由状态[57].
与Ru(0001)上单层石墨烯类似,双层石墨烯也具有非常有序的周期约为3 nm的莫尔结构(图10(a)),这是由于底层的石墨烯与Ru衬底的晶格不匹配.这也说明表层的石墨烯像地毯式地铺在底层石墨烯之上.有趣的是,在莫尔结构的亮斑(atop区域)的表观高度中,还有一个周期调制,周期约为21.5 nm,如图10(b)所示.这两种莫尔结构也可以从FFT图像中清晰分辨.如图10(a)中插图所示,外围的六个点对应的是周期为3 nm的莫尔结构的倒格子,而靠近中心的六个点则对应周期为21.5 nm的莫尔结构的倒格子.这两种结构的晶格方向没有相对转角.
通过分析双层石墨烯的原子分辨STM图像(图11(a)),可以清晰地看到表层石墨烯的蜂窝状晶格结构(图11(b)).测量得到表层石墨烯的晶格常数为(2.46±0.02)Å,与自由状态单层石墨烯的晶格常数相同[58].这表明双层石墨烯层间具有很弱的范德瓦耳斯作用,且在表层石墨烯中不存在应变.然而在图11(c)显示的区域中,只能分辨出三角形的晶格结构,说明在这一区域的双层石墨烯是AB堆垛,与石墨的情形相似.根据Ru(0001)表面单层石墨烯的堆垛模型[59,60],底层石墨烯与Ru(0001)的[100]方向是平行的且其晶格被拉伸约1%[59].而在表层石墨烯上则是没有应变的,所以,可以推断周期约为21.5 nm的莫尔结构是由上下两层石墨烯的晶格失配引起的.据此,图11(d)给出的是约为1/4个超结构单胞(周期约为21.5 nm)的结构模型.两层石墨烯的[100]方向是平行的,其中底层石墨烯相对于表层石墨烯有1.2%的拉伸应变.从这模型中,可以清晰地看到石墨烯层间堆垛方式从AA堆垛连续转变为AB堆垛.这种连续变化的堆垛方式与原子分辨的STM图像是严格对应的.此结果与Peng和Ahuja[61]理论计算的结果一致.
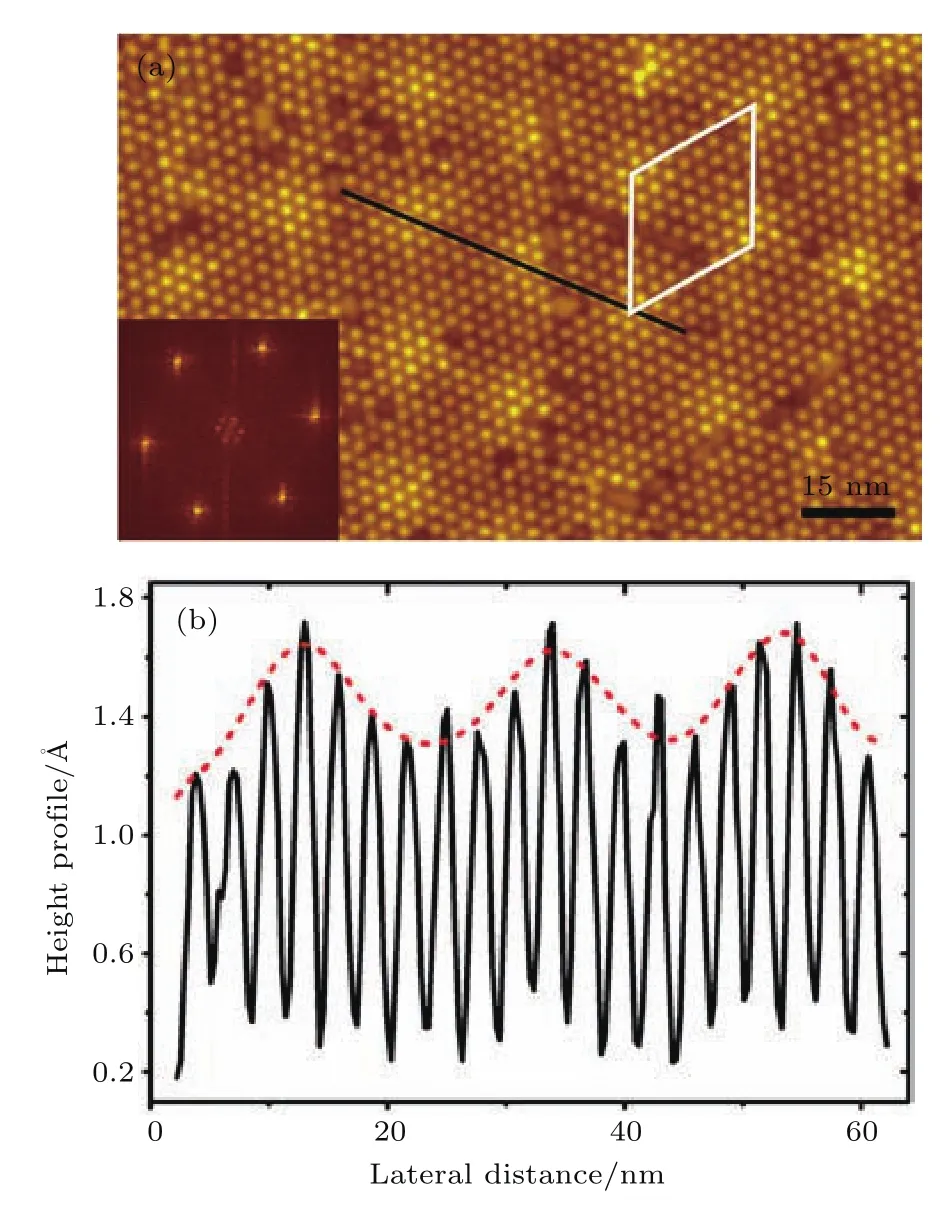
图10 Ru(0001)表面外延双层石墨烯的超结构 (a)双层石墨烯的STM形貌图展示的两种莫尔结构,周期分别约为3 nm和21.5 nm,其中大周期的莫尔结构的原胞由图中白色菱形所示,插图是形貌图的FFT图像;(b)沿着(a)中黑色直线的STM高度轮廓线,红色虚线标识的是周期为3 nm的莫尔结构中atop区域亮斑的周期调制[57]Fig.10.Superstructures of epitaxial bilayer graphene on Ru(0001):(a)STM image showing a moiré pattern with a periodicity of 3 nm and an additional moiré pattern with a periodicity of 21.5 nm,the white rhombus indicates the unit cell of this additional moiré pattern,inset shows the FFT pattern;(b)line pro fi le along the black line shown in(a),the red dashed line illustrates the modulations of the apparent heights of atop regions[57].
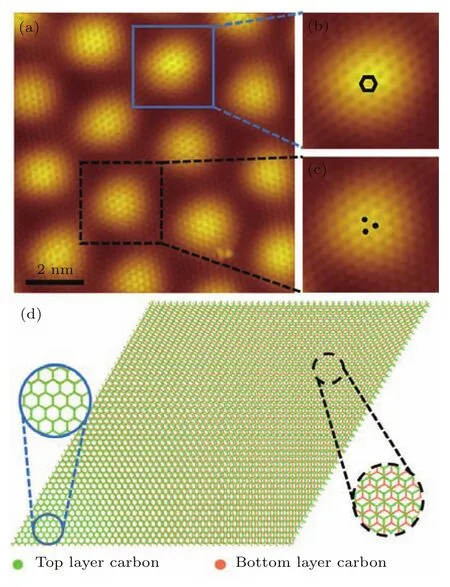
图11 (a)Ru(0001)表面双层石墨烯的高分辨STM图像;(b)和(c)分别是(a)中蓝色和黑色标记位置放大的STM形貌图;(d)Ru(0001)外延双层石墨烯的模型示意图;绿色为表层的石墨烯,晶格常数取自由石墨烯的值2.46 Å;橙色为底层石墨烯,相对于自由石墨烯有1.2%的拉伸应变,两层石墨烯之间没有相对转角[57]Fig.11.(a)High-resolution STM image of bilayer graphene on Ru(0001);(b),(c)Close-ups showing the honeycomb and triangular lattices of the regions marked with blue solid and black dashed squares in(a),respectively;(d)structural model of bilayer graphene grown on Ru(0001).The top layer graphene is free-standing,whereas the lattice of the bottom layer is stretched by 1.2%with respect to that of the top layer.The two layers are AA-and AB-stacked in the regions marked with blue solid and black dashed circles,respectively[57].
8 总结与展望
本文回顾了一系列异质元素在石墨烯/金属衬底界面插层的工作.其中将硅原子插层到外延生长的石墨烯和金属基底之间的界面处,不仅使外延石墨烯恢复了本征性质,同时还保持了其大面积高质量的特点.利用该插层技术,可以原位且无损地将Ru(0001),Ir(111)等金属单晶表面外延生长的石墨烯无转移地置于半导体之上.当增加硅原子插层量,硅在界面处会形成双层甚至可能形成更厚的硅膜.此外,不同种类金属原子Hf,Pb,Pt,Pd,Co,Ni,Au,In和Ce的成功插层,表明该插层技术具有普适性.插层机制包含四个主要过程:诱导产生缺陷、异质原子迁移、石墨烯自我修复和异质原子扩散成膜.考虑到插层元素的多样性,包含了半导体、贵金属、磁性金属和稀土金属等,以及不同元素在界面处形成各异的结构,该插层方法为未来调控石墨烯的性质提供了丰富的实验手段.这些研究进展也为未来构建石墨烯半导体金属异质结器件,尤其是构建石墨烯与其他二维原子晶体的范德瓦耳斯异质结,如石墨烯/硅烯、石墨烯/铪烯等,开辟了一条新的途径.此外,有报道显示氧气等气体分子可以实现插层[49,62,63],这预示着将来有望在Si或Hf插层的基础上进一步使其氧化,形成SiO2或HfO2高介电层,原位地实现石墨烯和金属基底的绝缘.这对制备高质量石墨烯-绝缘体-金属器件及石墨烯在电子学中的广泛应用具有重要意义.
[1]Novoselov K S,Geim A K,Morozov S V,Jiang D,Katsnelson M I,Grigorieva I V,Dubonos S V,Firsov A A 2005Nature438 197
[2]Novoselov K S,Jiang Z,Zhang Y,Morozov S V,Stormer H L,Zeitler U,Maan J C,Boebinger G S,Kim P,Geim A K 2007Science315 1379
[3]Zhang Y B,Tan Y W,Stormer H L,Kim P 2005Nature438 201
[4]Beenakker C W J 2006Phys.Rev.Lett.97 067007
[5]Novoselov K S,Geim A K,Morozov S V,Jiang D,Zhang Y,Dubonos S V,Grigorieva I V,Firsov A A 2004Science306 666
[6]Castro Neto A H,Guinea F,Peres N M R,Novoselov K S,Geim A K 2009Rev.Mod.Phys.81 109
[7]Li X S,Cai W W,An J H,Kim S,Nah J,Yang D X,Piner R,Velamakanni A,Jung I,Tutuc E,Banerjee S K,Colombo L,Ruo ffR S 2009Science324 1312
[8]Bae S,Kim H,Lee Y,Xu X F,Park J S,Zheng Y,Balakrishnan J,Lei T,Kim H R,Song Y I,Kim Y J,Kim K S,Ozyilmaz B,Ahn J H,Hong B H,Iijima S 2010Nat.Nanotechnol.5 574
[9]Gao L B,Ren W C,Xu H L,Jin L,Wang Z X,Ma T,Ma L P,Zhang Z Y,Fu Q,Peng L M,Bao X H,Cheng H M 2012Nat.Commun.3 699
[10]Yan Z,Peng Z W,Sun Z Z,Yao J,Zhu Y,Liu Z,Ajayan P M,Tour J M 2011Acs Nano5 8187
[11]Xu S C,Man B Y,Jiang S Z,Chen C S,Yang C,Liu M,Gao X G,Sun Z C,Zhang C 2013Cryst.Eng.Comm.15 1840
[12]Chen J Y,Guo Y L,Wen Y G,Huang L P,Xue Y Z,Geng D C,Wu B,Luo B R,Yu G,Liu Y Q 2013Adv.Mater.25 992
[13]Lee J H,Lee E K,Joo W J,Jang Y,Kim B S,Lim J Y,Choi S H,Ahn S J,Ahn J R,Park M H,Yang C W,Choi B L,Hwang S W,Whang D 2014Science344 286
[14]Chen Y B,Sun J Y,Gao J F,Du F,Han Q,Nie Y F,Chen Z,Bachmatiuk A,Priydarshi M K,Ma D L,Song X J,Wu X S,Xiong C Y,Rummeli M H,Ding F,Zhang Y F,Liu Z F 2015Adv.Mater.27 7839
[15]Tang S J,Wang H M,Wang H S,Sun Q J,Zhang X Y,Cong C X,Xie H,Liu X Y,Zhou X H,Huang F Q,Chen X S,Yu T,Ding F,Xie X M,Jiang M H 2015Nat.Commun.6 6499
[16]Suk J W,Lee W H,Lee J,Chou H,Piner R D,Hao Y F,Akinwande D,Ruo ffR S 2013Nano Lett.13 1462
[17]Pirkle A,Chan J,Venugopal A,Hinojos D,Magnuson C W,McDonnell S,Colombo L,Vogel E M,Ruo ffR S,Wallace R M 2011Appl.Phys.Lett.99 122108
[18]Pan Y,Shi D X,Gao H J 2007Chin.Phys.16 3151
[19]Pan Y,Zhang H G,Shi D X,Sun J T,Du S X,Liu F,Gao H J 2009Adv.Mater.21 2777
[20]Sutter P W,Flege J I,Sutter E A 2008Nat.Mater.7 406
[21]Meng L,Wu R T,Zhang L Z,Li L F,Du S X,Wang Y L,Gao H J 2012J.Phys.:Condens.Matter24 314214
[22]N’Diaye A T,Coraux J,Plasa T N,Busse C,Michely T 2008New J.Phys.10 043033
[23]Usachov D,Dobrotvorskii A M,Varykhalov A,Rader O,Gudat W,Shikin A M,Adamchuk V K 2008Phys.Rev.B78 085403
[24]Odahara G,Otani S,Oshima C,Suzuki M,Yasue T,Koshikawa T 2011Surf.Sci.605 1095
[25]Preobrajenski A B,Ng M L,Vinogradov A S,Martensson N 2008Phys.Rev.B78 073401
[26]Starodub E,Bostwick A,Moreschini L,Nie S,El Gabaly F,McCarty K F,Rotenberg E 2011Phys.Rev.B83 125428
[27]Que Y D,Zhang Y,Wang Y L,Huang L,Xu W Y,Tao J,Wu L J,Zhu Y M,Kim K,Weinl M,Schreck M,Shen C M,Du S X,Liu Y Q,Gao H J 2015Adv.Mater.Interfaces2 1400543
[28]Meng L,Wu R T,Zhou H T,Li G,Zhang Y,Li L F,Wang Y L,Gao H J 2012Appl.Phys.Lett.100 083101
[29]Mao J H,Huang L,Pan Y,Gao M,He J F,Zhou H T,Guo H M,Tian Y,Zou Q,Zhang L Z,Zhang H G,Wang Y L,Du S X,Zhou X J,Neto A H C,Gao H J 2012Appl.Phys.Lett.100 093101
[30]Huang L,Zhang Y F,Zhang Y Y,Xu W Y,Que Y D,Li E,Pan J B,Wang Y L,Liu Y Q,Du S X,Pantelides S T,Gao H J 2017Nano Lett.17 1161
[31]Cai Y,Chuu C P,Wei C M,Chou M Y 2013Phys.Rev.B88 245408
[32]Cinquanta E,Scalise E,Chiappe D,Grazianetti C,van den Broek B,Houssa M,Fanciulli M,Molle A 2013J.Phys.Chem.C117 16719
[33]Sutter P,Hybertsen M S,Sadowski J T,Sutter E 2009Nano Lett.9 2654
[34]Vanderveen J F,Himpsel F J,Eastman D E 1980Phys.Rev.B22 4226
[35]Casiraghi C,Pisana S,Novoselov K S,Geim A K,Ferrari A C 2007Appl.Phys.Lett.91 233108
[36]Ferralis N,Maboudian R,Carraro C 2008Phys.Rev.Lett.101 156801
[37]Das A,Pisana S,Chakraborty B,Piscanec S,Saha S K,Waghmare U V,Novoselov K S,Krishnamurthy H R,Geim A K,Ferrari A C,Sood A K 2008Nat.Nanotechnol.3 210
[38]Mohiuddin T M G,Lombardo A,Nair R R,Bonetti A,Savini G,Jalil R,Bonini N,Basko D M,Galiotis C,Marzari N,Novoselov K S,Geim A K,Ferrari A C 2009Phys.Rev.B79 205433
[39]Li L,Wang Y,Meng L,Wu R,Gao H J 2013Appl.Phys.Lett.102 093106
[40]Robertson J 2006Rep.Prog.Phys.69 327
[41]Li L F,Wang Y L,Xie S Y,Li X B,Wang Y Q,Wu R T,Sun H B,Zhang S B,Gao H J 2013Nano Lett.13 4671
[42]Beenakker C W J 2008Rev.Mod.Phys.80 1337
[43]Heersche H B,Jarillo-Herrero P,Oostinga J B,Vandersypen L M K,Morpurgo A F 2007Nature446 56
[44]Jin L,Fu Q,Mu R T,Tan D L,Bao X H 2011Phys.Chem.Chem.Phys.13 16655
[45]Fei X M,Zhang L Z,Xiao W D,Chen H,Que Y D,Liu L W,Yang K,Du S X,Gao H J 2015J.Phys.Chem.C119 9839
[46]Schumacher S,Huttmann F,Petrović M,Witt C,Förster D F,Vo-van C,Coraux J,Martínez-Galera A J,Sessi V,Vergara I,Rückamp R,Grüninger M,Schleheck N,Meyer zu Heringdorf F,Ohresser P,Kralj M,Wehling T O,Michely T 2014Phys.Rev.B90 235437
[47]Huang L,Pan Y,Pan L D,Gao M,Xu W Y,Que Y D,Zhou H T,Wang Y L,Du S X,Gao H J 2011Appl.Phys.Lett.99 163107
[48]Girit C O,Meyer J C,Erni R,Rossell M D,Kisielowski C,Yang L,Park C H,Crommie M F,Cohen M L,Louie S G,Zettl A 2009Science323 1705
[49]Sutter P,Sadowski J T,Sutter E A 2010J.Am.Chem.Soc.132 8175
[50]Xia C,Watcharinyanon S,Zakharov A A,Yakimova R,Hultman L,Johansson L I,Virojanadara C 2012Phys.Rev.B85 045418
[51]Cui Y,Gao J F,Jin L,Zhao J J,Tan D L,Fu Q,Bao X H 2012Nano Res.5 352
[52]Li G,Zhou H T,Pan L D,Zhang Y,Huang L,Xu W Y,Du S X,Ouyang M,Ferrari A C,Gao H J 2015J.Am.Chem.Soc.137 7099
[53]Cui Y,Fu Q,Bao X H 2010Phys.Chem.Chem.Phys.12 5053
[54]Schumacher S,Forster D F,Rosner M,Wehling T O,Michely T 2013Phys.Rev.Lett.110 086111
[55]dos Santos J M B L,Peres N M R,Castro A H 2007Phys.Rev.Lett.99 256802
[56]Kim N,Kim K S,Jung N,Brus L,Kim P 2011Nano Lett.11 860
[57]Que Y D,Xiao W D,Fei X M,Chen H,Huang L,Du S X,Gao H J 2014Appl.Phys.Lett.104 093110
[58]Meyer J C,Kisielowski C,Erni R,Rossell M D,Crommie M F,Zettl A 2008Nano Lett.8 3582
[59]Wang B,Bocquet M L,Marchini S,Gunther S,Wintterlin J 2008Phys.Chem.Chem.Phys.10 3530
[60]Martoccia D,Willmott P R,Brugger T,Bjorck M,Gunther S,Schleputz C M,Cervellino A,Pauli S A,Patterson B D,Marchini S,Wintterlin J,Moritz W,Greber T 2008Phys.Rev.Lett.101 126102
[61]Peng X Y,Ahuja R 2010Phys.Rev.B82 045425
[62]Zhang H,Fu Q,Cui Y,Tan D L,Bao X H 2009J.Phys.Chem.C113 8296
[63]Du Y,Zhuang J,Wang J,Li Z,Liu H,Zhao J,Xu X,Feng H,Chen L,Wu K,Wang X,Dou S X 2016Sci.Adv.2 e1600067
PACS:68.65.Pq,85.30.–z,68.37.Ef DOI:10.7498/aps.66.216803
*Project supported by the National Key Research and Development Projects of China(Grant No.2016YFA0202300),the National Basic Research Program of China(Grant No.2013CBA01600),the National Natural Science Foundation of China(Grant Nos.61390501,61471337,51325204,61622116,61504149,11604373),the Chinese Academy of Sciences,and the President Funds of University of Chinese Academy of Sciences.
†Corresponding author.E-mail:sxdu@iphy.ac.cn
‡Corresponding author.E-mail:hjgao@iphy.ac.cn
Intercalation and its mechanism of high quality large area graphene on metal substrate∗
Guo HuiLu Hong-Liang Huang LiWang Xue-Yan Lin Xiao Wang Ye-Liang Du Shi-Xuan†Gao Hong-Jun‡
(Institute of Physics and University of Chinese Academy of Sciences,Chinese Academy of Sciences,Beijing 100190,China)
d 14 July 2017;revised manuscript
31 August 2017)
Graphene,a two-dimensional material with honeycomb lattice,has attracted great attention from the communities of fundamental research and industry,due to novel phenomena such as quantum Hall effect at room temperature,Berry phase,and Klein tunneling,and excellent properties including extremely high carrier mobility,high Young’s modulus,high thermal conductivity and high flexibility.Some key issues hinder graphene from being used in electronics,including how to integrate it with Si,since Si based technology is widely used in modern microelectronics,and how to place high-quality large area graphene on semiconducting or insulating substrates.A well-known method of generating largearea and high-quality graphene is to epitaxially grow it on a single crystal metal substrate.However,due to the strong interaction between graphene and metal substrate,the intrinsic electronic structure is greatly changed and the conducting substrate also prevents it from being directly used in electronics.Recently,we have developed a technique,which intercalates silicon between epitaxial graphene and metal substrate such as Ru(0001)and Ir(111).Experimental results from Raman,angle-resolved photoemission spectroscopy,and scanning tunneling spectroscopy con fi rm that the intercalation layer decouples the interaction between graphene and metal substrate,which results in the recovery of its intrinsic band structure.Furthermore,we can use this technique to intercalate thick Si beyond one layer and intercalate Si between graphene and metal film,which indicates the possibility of integrating both graphene and Si device and vast potential applications in industry by reducing its cost.Besides Si,many other metal elements including Hf,Pb,Pt,Pd,Ni,Co,Au,In,and Ce can also be intercalated between graphene and metal substrate,implying the universality of this technique.Considering the versatility of these elements,we can expect this intercalation technique to have wide applications in tuning graphene properties.We also investigate the intercalation mechanism in detail experimentally and theoretically,and find that the intercalation process is composed of four steps:creation of defects,migration of heteroatoms,self-repairing of graphene,and growth of intercalation layers.The intercalation of versatile elements with different structures by this technique provides a new route to the construction of graphene heterostructures,espectially van der Waals heterostructure such as graphene/silicene and graphene/hafnene,and also opens the way for placing graphene on insulating substrate for electronic applications if the intercalation layer can be oxidized by further oxygen intercalation.
graphene,silicon,intercalation technique,scanning tunneling microscopy
石墨烯作为一种新型二维材料,因其优异的性质,在科学和应用领域具有非常重要的意义.而其超高的载流子迁移率、室温量子霍尔效应等,使其在信息器件领域备受关注.如何获得高质量并且与当代硅基工艺兼容的石墨烯功能器件,是未来将石墨烯应用于电子学领域的关键.近年来,研究人员发展了一种在外延石墨烯和金属衬底之间实现硅插层的技术,将金属表面外延石墨烯高质量、大面积的特点与当代硅基工艺结合起来,实现了无需转移且无损地将高质量石墨烯置于半导体之上.通过系统的实验研究并结合理论计算,揭示了插层过程包含四个主要阶段:诱导产生缺陷、异质原子插层、石墨烯自我修复和异质原子扩散成膜,并证实了这一插层机制的普适性.拉曼和角分辨光电子能谱实验结果表明,插层后的石墨烯恢复了本征特性,接近自由状态.此外,还实现了多种单质元素的插层.不同种类的原子形成不同的插层结构,从而构成了多种石墨烯/插层异质结.这为调控石墨烯的性质提供了实验基础,也展现了该插层技术的普适性.
10.7498/aps.66.216803
∗国家重点研发计划(批准号:2016YFA0202300)、国家重点基础研究发展计划(批准号:2013CBA01600)、国家自然科学基金(批准号:61390501,61471337,51325204,61622116,61504149,11604373)、中国科学院和中国科学院大学青年教师启动基金资助的课题.
†通信作者.E-mail:sxdu@iphy.ac.cn
‡通信作者.E-mail:hjgao@iphy.ac.cn
©2017中国物理学会Chinese Physical Society

