不同尺寸SiGe HBT Gummel图的参数提取
李 垚
(中国科学技术大学电子科学与技术系,合肥230027)
1 引 言
SiGe HBT 研究已日渐成熟[1]。对于SiGe HBT 的实验结果分析,即器件建模参数提取技术,越发显得重要[2-4],文献[2]和[4]分别采用标准的双极器件模型VBIC 和MEXTRAM 对SiGe HBT 进行了参数提取。与此方法不同,本研究针对自己制备的SiGe HBT的器件和材料质量问题,从简洁的物理公式出发,用Origin 软件变换公式进行简单提参,可对器件质量进行随时监控,并比较了不同尺寸SiGe HBT 提参技术的不同。
2 器件制备
器件结构如图1 所示,采用台面HBT 结构,SiGe基区由分子束外延(Molecular beam epitaxy, MBE)方法实现。1 为N 型Si 衬底;2 为N+型Si 子集电区,由离子注入形成;3 为集电区,N 型Si,厚度250nm,掺杂浓度1×1017cm-3;4,6 为本征层;5 为基区,P+型Si0.75Ge0.25,厚度30nm,硼掺杂浓度5×1019cm-3;7 为轻掺杂发射区,N 型Si,分为两层,一层厚度为60nm,掺杂浓度1×1018cm-3,一层厚度20 nm,掺杂浓度1×1017cm-3;8 为重掺杂发射区,N+型Si,厚度200nm,掺杂浓度2×1020cm-3。覆盖SiO2厚度350nm,金属Al 厚度1μm。

图1 台面SiGe HBT结构
3 实际测量
出于基区SiGe 材料生长质量好坏判断的目的,选择同一硅片上四种不同尺寸的HBT 进行测量(直流和交流测量),为两种正常尺寸(TA3,TA4)和两种大尺寸(TE1a 和TE1),具体如表1 所示。

表1 进行测量的四种SiGe HBT
对表1 中的各器件进行实际测量。测量结果分别由下面图2、图3、图4 和图5 所示。
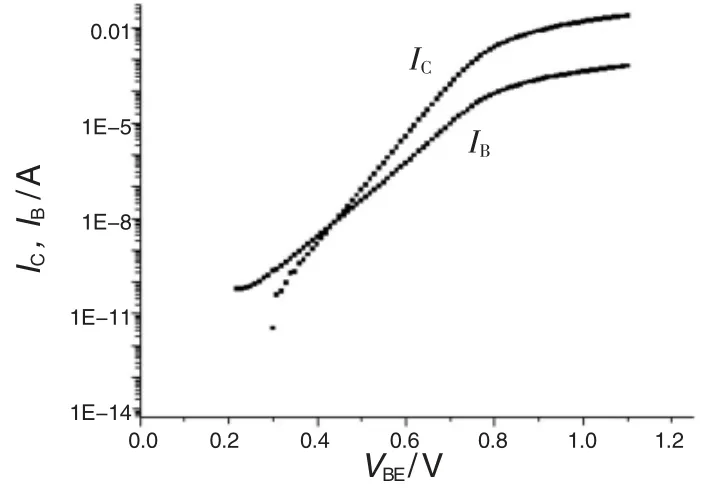
图2 TA3晶体管直流Gummel曲线
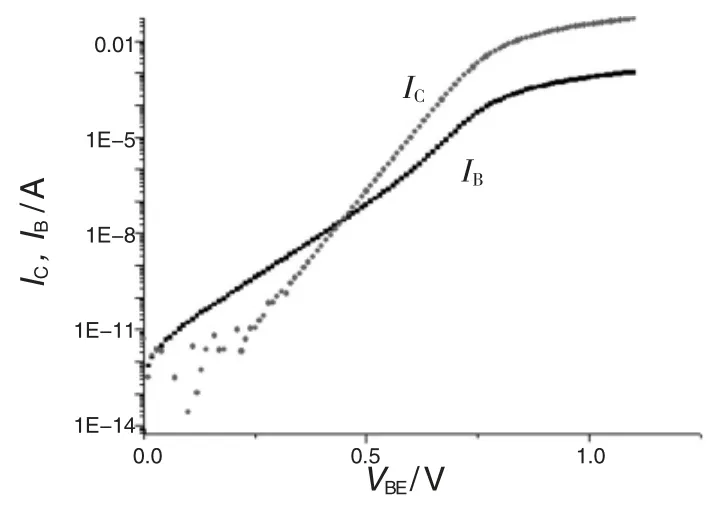
图3 TA4晶体管直流Gummel曲线
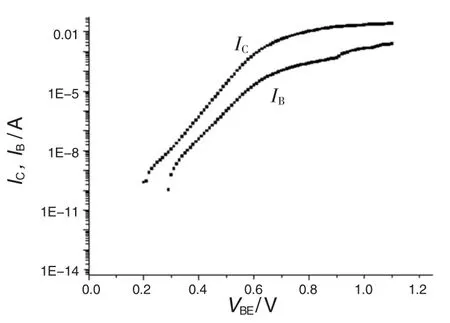
图4 TE1a晶体管直流Gummel曲线
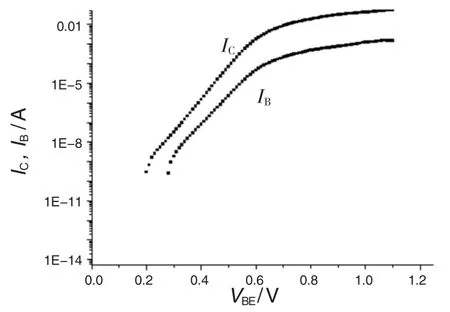
图5 TE1晶体管直流Gummel曲线
图2~图5 分别为晶体管TA3、TA4、TE1a 和TE1 的直流Gummel 曲线,即集电极电流IC和基极电流IB随发射结电压VBE的变化曲线。图6 则为TA4 晶体管的交流测量曲线,粗略估计其截止频率fT约为8GHz。

图6 TA4晶体管交流测量曲线
4 参数提取及Gummel图分析
4.1 非理想因子n的提取
晶体管中集电极电流和基极电流皆满足如下公式[5]:

其中I0为反向饱和电流,n 为非理想因子,VT为热电压,进而有:

因此,Gummel 曲线可变换得到n 随VBE变化的曲线,如图7、图8。

图7 TA4集电极电流变化曲线

图8 TE1a集电极电流变化曲线
从中可知,TA4(正常尺寸)和TE1a(大尺寸)晶体管集电极电流非理想因子的平台值分别为1.003和1.001,表明集电结质量没有问题。非理想因子的具体结果如表2 所示。

表2 集电极电流和基极电流非理想因子
4.2 串联电阻RS的提取
集电极(或基极)串联电阻RS可表示为:

由(1)式也可得出:

可因此将Gummel 曲线做出变换,结果如图9。
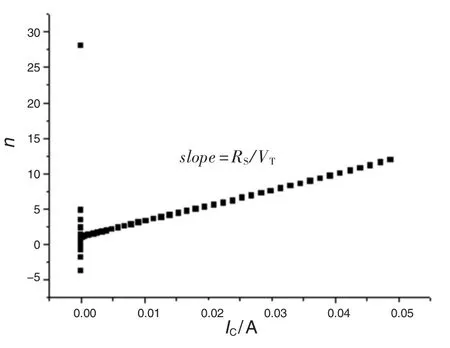
图9 TA4晶体管串联电阻RS的提取
从图中所示结果来看,n 随IC(或IB)的变化呈一条直线,从直线斜率(即RS/VT)可得串联电阻,其详细数值如表3。

表3 串联电阻RS的提取
4.3 反向饱和电流IO的提取
4.3.1 集电极反向饱和电流提取
欲得到集电极反向饱和电流,只须取Gummel曲线IC-VBE在纵轴上的截距即可。对于TA4,ICO=6.11×10-16A,因此电流密度JCO=2.229×10-10A/cm2。将它和资料上的理论结果进行比较。集电极电流密度在理论上可计算为[6]:

式中DnB,NB,WB分别为基区的扩散系数、掺杂浓度和宽度。niB为基区有效本征载流子浓度,有:

式中,ΔEg,SiGe为基区禁带变窄量,它是Ge 含量引起的禁带变窄和重掺杂引起的禁带变窄之和[7]。计算可得JCO=7.15×10-9A/cm2(T=293K,为测试当时实验室环境温度)。可见,当Ge 含量为0.11 时,理论值才与提参值基本一致,因此我们重新测定了Ge 含量,发现其确为0.11(不是0.25),从而证明了提参结果的正确。
4.3.2 基极反向饱和电流提取
基极电流IB可表示为:

其中IB1和IB2分别为基区的理想扩散电流和复合电流,非理想因子m 在2 左右。若令=VBE-IBRS,则:

图10 为Gummel 曲线IB-VBE中的VBE换成后的曲线(TA4),纵轴为对数坐标,所以呈一直线。直线在纵轴上的截距为IBO1。IBO1提取后代入(7)式得IB2=IB-IB1,其随VBE的变化曲线如图11 所示(TA4),取对数坐标时也呈直线关系,很容易提取出IBO2和非理想因子m,详细提取数值如表4。

图10 TA4晶体管IB随变化曲线
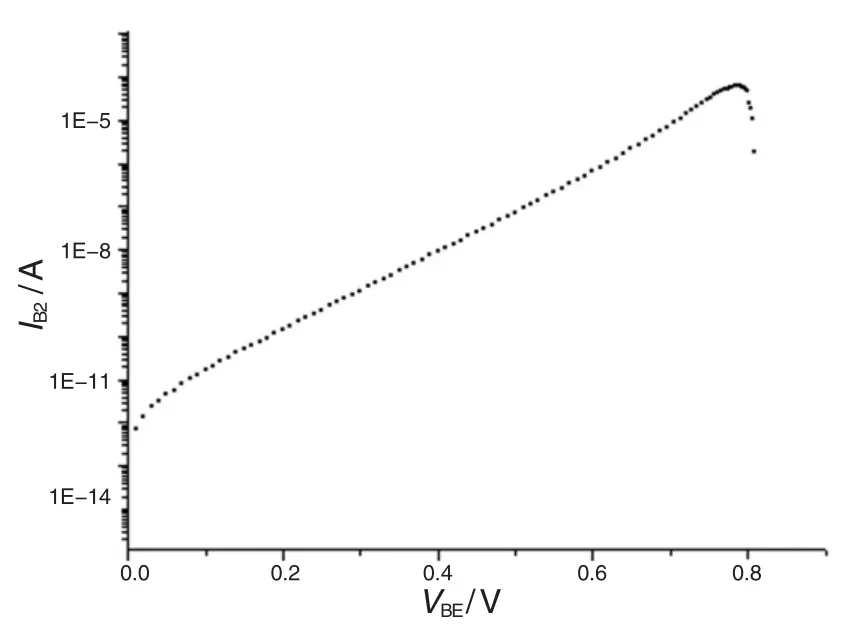
图11 TA4晶体管IB2随VBE变化曲线

表4 TA4晶体管IBO的提取
以同样的方法对大尺寸晶体管TE1a 做处理,提取结果及数值如图12、图13 以及表5 所示。

图12 TE1a晶体管IB随变化曲线
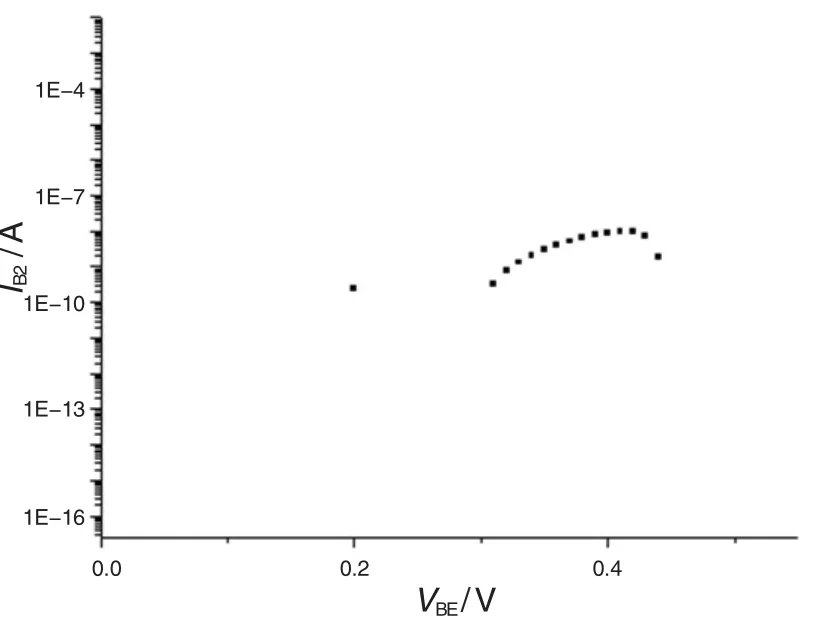
图13 TE1a晶体管IB2随VBE变化曲线

表5 TE1a晶体管IBO的提取
关于基极反向饱和电流的提取的进一步讨论,可归纳为以下三点:
I. 关于IBO1,非理想因子为1,表明发射结质量没有问题,且该扩散电流项与面积成正比;
II.关于IBO2,实际提取值与资料上的理论值进行比较,理论上[8]有:

式中σ 为俘获截面积,Vth为热运动速度,Nt为复合中心浓度,τ 为寿命,WD为耗尽区宽度。对于TE1a,理论值大约是提参值的2 倍左右,说明提参结果正确,且该复合电流项近似与周长成正比。

从而有:

其中IBO1=AMJBO1,=(A0-AM)JBO1。JBO1为电流密度,AM为金属接触区的面积,A0为台面面积,而对于大尺寸晶体管,台面面积A0会远大于AM,从而导致了的存在。上述过程的原理示意图如图14。

图14 的产生原理示意图
5 结束语
本研究采用了MBE 方法成功制备出截止频率为8GHz 的SiGe HBT,对晶体管尺寸较大的情况,此截止频率的数值较为合宜;运用物理意义明确的公式变换方法准确提取出不同尺寸下的Gummel 曲线;经验证对比,发射结、集电结的质量均无问题,表明所制备SiGe HBT 质量良好,也证明此提取方法的合理、可行。

