氢气浸泡辐照加速方法在3DG111 器件上的应用及辐射损伤机理分析*
赵金宇 杨剑群 董磊 李兴冀
(哈尔滨工业大学材料科学与工程学院,哈尔滨 150001)
(2018 年11 月8 日收到; 2019 年1 月9 日收到修改稿)
本文以60Co 为辐照源,针对3DG111 型晶体管,利用半导体参数分析仪和深能级缺陷瞬态谱仪,研究高/低剂量率和有/无氢气浸泡条件下,电性能和深能级缺陷的演化规律. 试验结果表明,与高剂量率辐照相比,低剂量率辐照条件下,3DG111 型晶体管的电流增益退化更加严重,这说明该器件出现了明显的低剂量率增强效应; 无论是高剂量率还是低剂量率辐照条件下,3DG111 晶体管的辐射损伤缺陷均是氧化物正电荷和界面态陷阱,并且低剂量率条件下,缺陷能级较深; 氢气浸泡后在高剂量率辐照条件下,与未进行氢气处理的器件相比,辐射损伤程度明显加剧,且与低剂量率辐照条件下器件的损伤程度相同,缺陷数量、种类及能级也相同. 因此,氢气浸泡处理可以作为低剂量率辐射损伤增强效应加速评估方法的有效手段.
1 引 言
空间环境中航天器电子元器件损伤主要是由各种带电粒子和射线造成[1]. 1991 年,Enlow 等[2]发现双极型器件在低剂量率下的辐照损伤要远远高于高剂量率下的辐照损伤,这一现象被称为低剂量率辐射损伤增强(enhanced low dose rate sensitivity,ELDRS)效应[3−5]. 这一效应的发现,立刻引起了国际航天领域的广泛关注. 双极型器件具有电流驱动能力好、线性度高、噪声低及匹配特性好等优点[6],广泛应用于空间电子系统. ELDRS 效应的存在[7],给空间用双极型器件抗辐射能力的评价带来很大困难. 若采用实际空间环境的典型剂量率(10–6—10–4Gy(Si)/s)对电子元器件进行抗辐射能力评价,成本高、耗时长. 因此,找到一种可靠、高效的双极型器件的ELDRS 效应加速评估方法显得尤为重要. 目前,针对双极型器件ELDRS效应提出了许多常用的加速评估试验方法: 1)恒高温恒剂量率(100 ℃,5 × 10–3—5 × 10–2Gy(Si)/s)辐照; 2)高剂量率辐照后加温退火; 3)变剂量率辐照等[8−10]. 然而,文献中已报道的各种加速评估方法均存在着不足. 恒高温恒剂量率辐照损伤明显小于低剂量率辐照; 变剂量率方法存在所需时间长、评估总剂量不高及所需器件数量多等缺点[9−14]; 而且,上述评估方法均存在普适性差的缺点. 迄今,国际上还没有一种加速评估方法能加速评估出所有器件的ELDRS 效应,也没有快速鉴别器件是否具有ELDRS 效应的有效方法. 近年来,有些文献报道了加氢辐照法[15−17],但这些文献只停留于宏观电性能评价,尚未给出器件加氢处理后高剂量率辐照与低剂量率条件下辐射损伤机制是否一致. 本文基于氢气浸泡处理,针对3DG111 晶体管,研究高、低剂量率辐照条件下电性能和深能级缺陷的演化规律,探究加氢处理后高剂量率辐照与低剂量率辐照对器件造成辐射损伤行为的关系,可为建立ELDRS 效应加速评估方法提供重要依据.
2 试验器件与试验方法
本文选用3DG111 型NPN 晶体管为研究对象,辐照试验所用晶体管均为同一批次生产. 氢气浸泡前,需要对晶体管进行开帽处理. 将浸泡容器抽至真空,并注入纯度为100%的氢气. 为确保器件中氢气浓度达到饱和,需要将器件在室温条件下浸泡氢气氛围中至少144 h,容器内氢气压强不低于0.06 MPa.
辐照试验利用中国科学院新疆理化技术研究所的60Co 辐照源. 高剂量率辐照试验剂量率为100 rad/s (1 rad =10–2Gy),低剂量率辐照试验剂量率为10 mrad/s,所有辐照试验均在室温条件下进行,辐照之前将氢气浸泡器件从容器中取出再进行辐照. 辐照试验表明,60Co 辐照源对开帽和未开帽处理的器件造成的损伤一致,如图1 所示. 因此对于未经氢气浸泡处理的器件样品无需进行开帽处理.
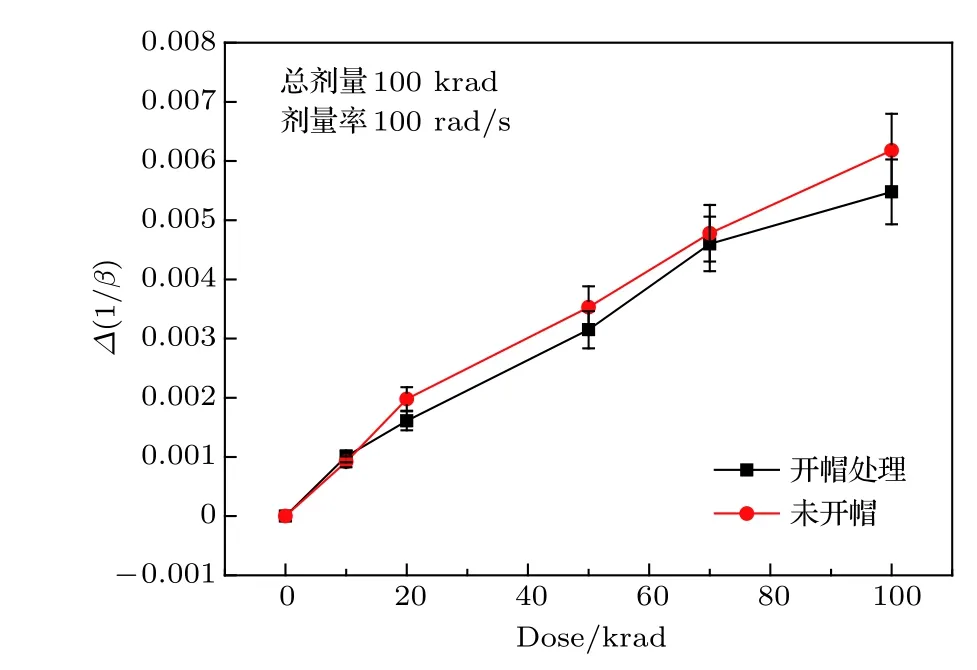
图1 开帽处理后经γ射线辐照晶体管电流增益倒数变化量与未处理直接辐照对比Fig. 1. Comparison of ∆ (1/β) ofγ-ray irradiated transistor after open cap treatment with untreated.
采用KEITHLEY 4200-SCS 半导体参数分析仪测试Gummel 特性曲线. 双极晶体管Gummel特性曲线测试的参数设置为: 发射极接扫描电压VBE,以0.01 V 的扫描步长,从0.2 V 扫描至1.2 V,即VBE=0.2—1.2 V; 基极和集电极均接地,测试基极电流IB和集电极IC随发射极电压的变化趋势. 本文选取的电流增益β值为VBE=0.65 V 时对应的IC与IB的比值. 通常利用电流增益倒数的变化量表征器件损伤程度.
深能级瞬态谱仪(deep level transient spectroscopy,DLTS)是检测双极型器件内部深能级缺陷的有效手段,可以定量表征微观缺陷种类、浓度及能级等信息. DLTS 测试过程中主要参数设定为: 脉冲宽度TP=0.01 s,脉冲电压VP=0 V,反向偏压VR=5 V,温度从350 K 扫描到40 K,测试周期TW=2.05 s.
3 试验结果
图2(a)和图2(b) 分别为剂量率为100 rad/s和10 mrad/s 的 γ 射线辐照条件下,3DG111 晶体管的基极电流IB和集电极电流IC随发射极电压VBE的变化曲线. 由图2 可见,无论高剂量率还是低剂量率辐照条件下,当发射极电压相同时,随着辐照剂量的增加,3DG111 型双极晶体管基极电流与集电极电流均发生变化. 其中基极电流明显升高,而集电极电流与基极电流相比变化不显著. 当辐照剂量相同时,与高剂量率条件下相比,低剂量率辐照条件下基极电流增加程度更加明显.
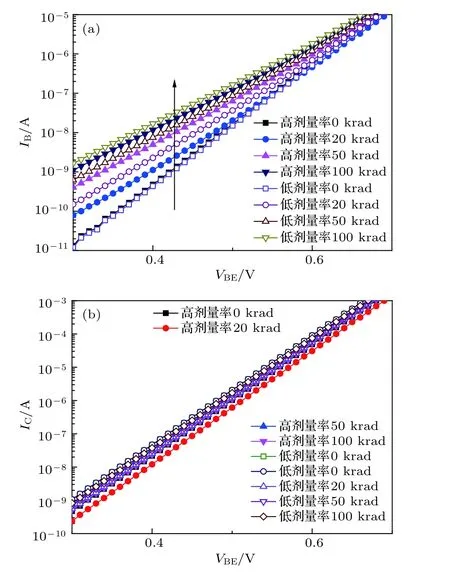
图2 高剂量率辐照条件下未经氢气浸泡的晶体管的Gummel 曲线 (a)基极电流; (b)集电极电流Fig. 2. Gummel curve of a transistor that has not been treated with hydrogen at high dose rates: (a) Base current;(b) collector current.
图3 为高、低剂量率和氢气浸泡后高剂量率辐照条件下,3DG111 型晶体管电流增益倒数变化量随着辐照剂量的变化关系. 由图3 可知,当辐照剂量相同时,与100 rad/s 高剂量率辐照相比,10 mrad/s低剂量率辐照条件下3DG111 晶体管损伤更加严重. 这说明3DG111 型晶体管具有明显的低剂量率增强效应. 另一方面,在辐照剂量相同的条件下,经氢气浸泡后3DG111 型晶体管电流增益倒数的变化量要远大于未经氢浸泡的情况. 并且,随着辐照剂量增加,未经氢气浸泡的晶体管增益退化开始出现饱和,而经氢气浸泡的晶体管损伤呈线性增加. 这说明氢加剧了3DG111 型双极晶体管的损伤程度. 值得注意的是,经氢气浸泡后高剂量率辐照条件下,晶体管损伤程度与低剂量率辐照条件下相同. 这表明,从宏观电性能方面分析,氢气浸泡后高剂量辐照方法可以获得ELDRS 效应加速评估的效果.

图3 氢气浸泡再经γ射线辐照后晶体管电流增益倒数变化量与未经处理辐照样品对比Fig. 3. Comparison of∆ (1/β) with/without hydrogen treated sample underγ-ray irradiated.
4 讨论与分析
通过分析双极型晶体管中过剩基极电流( ∆IB)与发射极-基极电压(VBE)的变化关系,可以揭示双极型晶体管辐射损伤机制. 辐照导致过剩基极电流定义为 ∆IB=IB–IB0,式中IB为辐照后晶体管的基极电流,IB0为辐照前的基极电流.
过剩基极电流的变化主要由以下两种原因导致: 1)辐射感生界面态引起的表面复合电流的增加; 2)辐射感生氧化物俘获正电荷引起的表面复合电流的增加[18]. 过剩基极电流可由(1)式表示:

式中Ki为常数,Di(T)为总的电离吸收剂量,q为电子电荷,k为玻尔兹曼常数,T为热力学标准温度,n是理想因子. 当辐照引起的过剩基极电流主要来自于发射结空间电荷区的复合电流时,n=2;而当过剩基极电流主要来自中性基区复合电流时,n=1.
图4 给出了高、低剂量率辐照条件下,3DG111晶体管过剩基极电流随发射极-基极电压的变化.由图4 可知,相同总剂量条件下,低剂量率辐照的晶体管过剩基极电流大于高剂量率辐照的晶体管.高、低剂量率辐照条件下,随着辐照剂量的增加,3DG111 晶体管过剩基极电流的n值均逐渐趋向于2,这说明晶体管在 γ 射线辐照过程中复合电流主要来自空间电荷区. 而且,与高剂量率相比,低剂量率辐照条件下,晶体管过剩基极电流的n值更接近2,这说明低剂量率辐照会导致空间电荷区的复合电流加剧. 对于NPN 双极晶体管而言,氧化物电荷和界面态均会导致空间电荷区的复合电流加剧[19].
图5 为经氢气浸泡处理后100 rad/s 高剂量率辐照和10 mrad/s 低剂量率辐照条件下,过剩基极电流的对比结果. 由图5 可以看出,两种辐照条件下,晶体管过剩基极电流随发射极-基极电压的变化趋势相同.
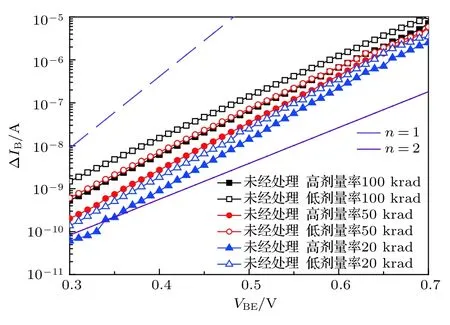
图4 高低剂量率辐照条件下3DG111 晶体管过剩基极电流对比Fig. 4. Comparison of excess base current of 3DG111 transistors at high and low dose rates.

图5 氢气浸泡预处理与未经处理晶体管辐照后过剩基极电流对比Fig. 5. Comparison of excess base current of a transistor after irradiation with/without hydrogen-immersion pretreat ment.

图6 氢气浸泡预处理与未经处理晶体管辐照后DLTS曲线对比Fig. 6. Comparison of DLTS curves of a transistor with/without hydrogen-immersion pretreatment.
图6 为有无氢气浸泡后高、低剂量率辐照条件下,3DG111 晶体管的DLTS 谱图. 从图6 可以发现,有无氢气浸泡后无论高低剂量率辐照条件下,晶体管的DLTS 谱均存在两个特征峰. 峰值位于300 K 左右为界面态,峰值在75 K 左右为氧化物电荷,峰的位置代表缺陷的能级[20]. 对于双极型晶体管,其能级越靠近中带,能级越深,对性能影响越大. 硅的中带位置通常在250 K 左右[21].
对于高剂量率辐照条件下,界面态数量多,但能级较浅. 而对于低剂量率辐照条件下,界面态数量减少,但能级较深. 能级越深,对晶体管的性能影响越大. 随着剂量率的减小,氧化物电荷不仅能级向中带移动,数量也明显增多. 综上所述,无论是高剂量率辐照还是低剂量率辐照,3DG111 晶体管主要产生界面态和氧化物电荷电离缺陷. 与高剂量率辐照相比,低剂量率辐照会产生能级较深的界面态和氧化物电荷,从而导致空间电荷区的复合电流变大,进而导致基极电流增大.
从表1 所列数据可以得出,经氢气浸泡处理后高剂量率辐照的晶体管和未经氢气处理直接进行低剂量率辐照的晶体管相比,辐照后产生的缺陷种类、缺陷能级、俘获截面和缺陷浓度等参数均非常接近. 因此,氢气浸泡处理加剧了晶体管的辐射损伤,且产生的缺陷与低剂量率辐照的缺陷特征相同. 这说明,对于3DG111 晶体管,氢气浸泡处理后高剂量率辐照和低剂量率辐照两种条件下,微观辐射损伤机制相同. 因此,氢气浸泡处理可以作为一种ELDRS 效应加速试验方法的有效手段.

表1 氢气浸泡预处理与未经处理晶体管辐照后缺陷参数对比Table 1. Comparison of defect parameters of a transistor with/without hydrogen-immersion pretreatment.
近年来,Rashkeev 等[22]和Chen 等[23]针对双极型器件ELDRS 效应的解释提出了基于氢的双分子模型,该模型认为器件内部各种形式的氢是导致器件出现低剂量率增强效应的根本原因. 其基本过程如图7 所示,双极型器件在受到辐照时,会在SiO2层内生成电子-空穴对,并发生电子-空穴复合和空穴与含氢缺陷反应两个过程[24],两个过程之间存在竞争关系. 在高剂量率辐照时,主要发生电子-空穴复合,此时生成的界面态数量较少; 当辐照剂量率较低时,电子-空穴对生成较少,此时电子-空穴复合减慢,空穴的移动变得更加容易,导致空穴和含氢缺陷反应加剧,生成更多的界面态. 而氢气浸泡后,由于氢分子与氧原子和硅原子产生结合[25]. 器件内部会引入大量的氢分子,氢分子会对电子和空穴复合产生干扰,同时被辐照后的氢分子可以裂解为氢离子,提高器件内部空穴的浓度. 此时会起到和低剂量率辐照同样的效果. 根据本文的试验结果,可以认为低剂量率辐照时影响的不只是界面态的数量,还可以影响界面态的能级. 当界面态能级处于更深位置时,同样可以加剧器件的辐照损伤.
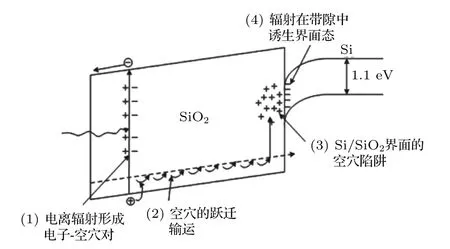
图7 辐照中的SiO2 中的空穴传输、俘获和质子释放的示意图[24]Fig. 7. Schematic illustration of hole transport,trapping and proton release in SiO2 irradiated[24].
长期以来,国内外对低剂量率效应的研究均着眼于界面态的变化情况而忽视了氧化物电荷的变化. 根据本文的DLTS 结果显示,双极型器件低剂量率辐照和氢气浸泡后辐照都会使氧化物电荷的数量显著增加. 根据目前研究显示,电子器件SiO2层中主要有两种氧空位结构[26]: 二聚体(dimer)结构 V oδ和褶皱结构 V oγ ,氧空位会和晶体管内部的氢结合成含氢空位,基于密度泛函理论计算可知,单氢缺陷结构 V oδH 和 V oγH 为空穴的深能级俘获心,双氢缺陷结构 V oδH2和 V oγH2为浅能级俘获心[27]. 辐照产生的电子和空穴会被这些缺陷所俘获,形成氧化物电荷[28]. 根据本文的试验结果,氧化物电荷也会影响器件的复合电流,是一种与ELDRS效应密切相关的缺陷.
综上可以得知,氢气浸泡和低剂量率辐照在氧化物电荷和界面态上生成上可以起到相似的作用.因此可以得出,氢气浸泡是一种合理的加速试验方法,且在微观缺陷和宏观电性能方面均有很好的吻合效果.
5 结 论
本文通过对比研究有/无氢气浸泡高剂量率辐照和未经氢气浸泡低剂量率辐照三种情况下晶体管的电性能和缺陷参数,提出氢气浸泡可以作为一种有效的ELDRS 效应加速试验的方法,并得到如下结论.
1) 3DG111 型晶体管存在明显的ELDRS 效应. 它表现为在低剂量率辐照时,电性能退化明显加剧. 造成退化加剧的主要原因是低剂量率辐照时氧化物电荷浓度增加,同时氧化物电荷和界面态能级均向中带移动,导致晶体管空间电荷区复合加剧,最终导致晶体管损伤程度增大.
2) 经过氢气浸泡后进行高剂量率辐照的晶体管,其电性能退化程度与低剂量率辐照时相似. 对比两者的微观缺陷情况可以得知,两者的缺陷能级和数量几乎完全相同. 因此认为氢气浸泡后再辐照是一种有效的ELDRS 效应加速试验方法,且损伤情况与低剂量率辐照吻合得很好.
根据本文的试验经验,目前我们提出一种氢气浸泡辐照加速试验的基本思路. 首先对样品进行开帽处理,使内部芯片完全暴露. 随后将样品浸泡于浓度为100%的氢气气氛中,压强可根据容器安全范围进行选取. 浸泡至少40 h 后,将样品从容器中取出,完成规定剂量的辐照试验.

