引入籽晶层的物理溅射生长Ga2O3外延薄膜特性研究*
洪梓凡 陈海峰 贾一凡 祁祺 刘英英 过立新 刘祥泰 陆芹 李立珺 王少青 关云鹤 胡启人
(西安邮电大学电子工程学院, 新型半导体器件与材料重点实验室, 西安 710121)
氧化镓(Ga2O3)薄膜在功率器件以及紫外探测等领域中具有重要的应用潜力, 而实现高质量薄膜制备则是其中的关键. 本文在蓝宝石衬底上物理溅射生长外延Ga2O3 层, 因采用引入籽晶层的方法提供了人为成核点而使得外延层结晶质量获得明显改善. 实验发现该外延层薄膜的生长中随着功率增加, 晶粒团聚到一定尺寸后出现裂解现象. 这一物理机制归因于大功率下溅射粒子在生长晶面上扩散携带的能量过大导致粒子碰撞次数增多. 文中生长的外延层为 () 晶面取向的β 型Ga2O3 薄膜, 厚度在202.4—292.3 nm 之间, 薄膜在450—800 nm 范围可见光波段的透射率约为90%, 吸收边随着功率的增加先蓝移后红移, 带隙约为4.81—4.96 eV. 光致发光光谱分析表明, 该外延层薄膜在460 nm 处产生蓝色发光. 本文发现溅射功率为160 W时引入籽晶层生长的β-Ga2O3 薄膜具有最佳的结晶质量, 这一方法将为高质量β-Ga2O3 薄膜的可控生长提供有益参考.
1 引 言
氧化镓(Ga2O3)禁带宽度约为4.4—5.3 eV[1],大于SiC 和GaN, 这一特征展示出了巨大的应用潜力[2], 因此被认为是未来电力电子学和光电领域应用中最有前景的超宽带隙半导体之一[3]. β-Ga2O3在众多相中最稳定[4-7], 拥有接近5 eV 的超大带隙, 并且具有8 MV/cm 的超高击穿电场[8,9]. 目前制备β-Ga2O3薄膜的主流方式为射频磁控溅射[10,11]、分子束外延(MBE)[12]、脉冲激光沉积(PLD)[13,14]、原子层沉积(ALD)[15]、化学气相沉积(CVD)[16,17].其中, 射频磁控溅射法作为常用方法, 具有附着性高、质量可控、成本低的优点, 通过改变溅射功率、沉积压强、生长温度、氧分压等条件在蓝宝石衬底上进行β-Ga2O3薄膜可控生长已被广泛报道[18-21].然而, 使用射频磁控溅射法沉积Ga2O3薄膜时通常选择在衬底上直接外延生长, 这导致制备出的Ga2O3薄膜表现出表面形貌差、晶粒尺寸小、位错缺陷过多等特点, 最终得到的薄膜质量不佳. 该问题的主要原因是蓝宝石衬底和β-Ga2O3薄膜之间的晶格失配[22]. 因此, 有必要对生长过程进行工艺改进以提高晶粒尺寸, 降低位错缺陷数量, 提高薄膜质量.
本文采用磁控溅射法, 在C面蓝宝石衬底上预生长籽晶层并进行退火处理, 在籽晶层基础上进行二次薄膜沉积. 为了分析外延层薄膜在籽晶层上的生长特性, 选取不同溅射功率范围在籽晶层上进行β-Ga2O3薄膜沉积. 使用X 射线衍射仪(XRD)、原子力显微镜(AFM)、场发射扫描电镜(SEM)、紫外分光光度计、光致发光(PL)谱表征技术, 对沉积的Ga2O3薄膜结构、形貌和光学性能进行研究, 并给出了相关的引入籽晶层的外延Ga2O3薄膜的物理生长机理.
2 实验过程
2.1 材料制备
图1 为蓝宝石衬底上Ga2O3籽晶层-外延层结构图. 首先使用丙酮、无水乙醇、去离子水对蓝宝石衬底分别进行10 min 的超声波清洗, 采用99.99%的Ga2O3靶材, 使用磁控溅射法在蓝宝石衬底上进行薄膜沉积. Ga2O3籽晶层使用射频磁控溅射生长, 沉积时间为20 min, 溅射功率为200 W,沉积结束后对籽晶层在800 ℃的N2中进行1 h退火处理. 然后在籽晶层上沉积外延层, 设置溅射功率为140 W, 舱室气压为7×10—4Pa, 以Ar 和O2为混合气体, 气体流量分别设置为36 和4 sccm(1 sccm = 1 ml/min), 并使工作气压保持1 Pa,在室温下沉积2 h, 并在800 ℃的N2中进行1 h退火处理. 此外, 为了更好地分析检验引入籽晶层的外延层生长质量, 本文还直接在蓝宝石衬底上生长单层Ga2O3薄膜作为对照样品, 其生长条件与籽晶层-外延层结构中的外延层生长退火条件一致.使用AFM 扫描样品并观察到引入籽晶层和直接外延的两个样品表面形貌之间存在明显差异, 证实Ga2O3籽晶层对薄膜生长将产生一定影响. 之后, 分别以160, 180 和200 W 的溅射功率在籽晶层上进行薄膜外延生长并退火处理, 溅射过程中使用衬底非加热模式, 以研究外延层溅射功率对薄膜生长特性及其光学性能的影响.
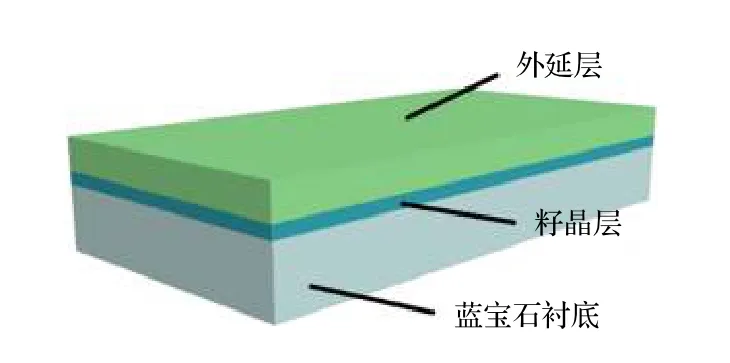
图1 蓝宝石衬底上Ga2O3 籽晶层-外延层薄膜系统结构示意图Fig. 1. Structure diagram of Ga2O3 seed layer-epitaxial layer.
2.2 性能测试
使用德国Bruker dimensionAFM 进行表面形貌表征与粗糙度测定, 使用日本理学Smaralab ragiku 9 型XRD 进行结构性能表征, 使用FEI Nova NanoSEM 450SEM 来估算薄膜厚度, 使用UV-2400 型紫外分光光度计分析薄膜样品的透过率,使用FLS-920 型荧光光谱仪分析薄膜PL 谱.
3 结果与讨论
使用AFM 对薄膜表面形貌进行表征, 图2(a)为无籽晶层结构在140 W 溅射功率下沉积的Ga2O3外延薄膜表面形貌图. 相比图2(b)在籽晶层上使用140 W 溅射功率下生长的Ga2O3外延薄膜, 无籽晶层时生长的表面颗粒无序性更明显, 尺寸更小, 并且小尺寸颗粒占更大比例, 说明籽晶层结构将有助于外延层生长, 并且表面形貌得到较大改善. 图2(c)—图2(e)分别为溅射功率160, 180 和200 W 的二维扫描图. 对所有样品进行颗粒尺寸估算, 图2(a)—图2(e)对应的外延薄膜的平均颗粒尺寸分别为34.26, 60.61, 80.32, 76.08 和56.25 nm.同时, 从图2(b)—图2(e)引入籽晶层的情形可以看出, 溅射功率为140 W 时, 60 nm 以下的小尺寸颗粒占较大比例; 溅射功率为160 W 时, 颗粒尺寸急剧增加; 溅射功率为180 W 时, 颗粒出现裂解现象, 大颗粒逐渐裂解为小颗粒, 这种裂解现象往往与粒子轰击效应或能量效应相关. 而大功率条件下, 溅射产物离化率也必然提高; 当溅射功率达到200 W 时, 大颗粒裂解为更多的小颗粒. 以上的实验现象揭示了Ga2O3外延薄膜在籽晶层上的生长特性, 相比之前有关蓝宝石衬底直接外延生长的报道(Li 等[18]发现表面形貌多由小晶粒组成, 随着溅射功率增加, 尺寸逐渐增大), 显示出了不同的生长过程. 可以推测其内在的物理机理为: 随着溅射功率升高, 活性原子数增多, 沉积时的扩散速度更快, 由于籽晶层提供了人为成核点, 解决了晶格不匹配导致难以成核生长的问题, 溅射粒子在籽晶层表面快速扩散并参与薄膜生长. 同时, 溅射粒子在沉积生长的过程中互相碰撞结合成大颗粒, 当溅射功率过大时, 溅射粒子在生长晶面上扩散, 携带的能量过大导致粒子碰撞次数增多, 使得溅射粒子难以结合成大颗粒形态. 根据AFM 对表面粗糙度的测定结果, 图2(f)显示图2(a)—图2(e)的均方根粗糙度(RMS)分别为0.82, 1.53, 1.24, 1.46, 1.30 nm,说明所有的Ga2O3薄膜具有非常小的粗糙度, 引入籽晶层生长的外延薄膜相比无籽晶层生长的薄膜粗糙度略微提高, 这是由于表面颗粒尺寸增大导致的. 籽晶层设计使得薄膜表面呈现相对平坦的形貌, 减弱了应力导致薄膜形貌差的影响, 在提高晶粒尺寸的同时使得粗糙度维持在较低的水平.

图2 不同条件下生长的Ga2O3 薄膜AFM 扫描图及尺寸估算与RMS 折线图 (a)无籽晶层140 W 溅射生长; (b)籽晶层上140 W 溅射生长; (c)籽晶层上160 W 溅射生长; (d)籽晶层上180 W 溅射生长; (e)籽晶层上200 W 溅射生长; (f) 尺寸估算与RMS 折线图Fig. 2. AFM scans of Ga2O3 thin films grown under different conditions, particle size and RMS lines chart: (a) 140 W sputter growth without seed layer; (b) 140 W sputter growth on seed layer; (c) 160 W sputter growth on the seed layer; (d) 180 W sputter growth on the seed layer; (e) 200 W sputter growth on the seed layer; (f) particle size and RMS lines chart.
图3 (a)为图2(a)—图2(e)中不同的溅射功率下沉积的Ga2O3外延薄膜XRD 曲线图, 结果显示在18.95°, 38.40°, 59.19°出现了很强的衍射峰, 分别对应于β-Ga2O3的(JCPDS File No.41-1103). 这三个晶向同属于晶面族, 说明在蓝宝石衬底上制备的Ga2O3外延薄膜具有很强的择优取向性, Nakagomi 和Kokubun[23]认为这是因为β-Ga2O3的氧原子排列与C面蓝宝石的(0001)面相同, 而其他峰则被证实为蓝宝石的衍射峰[24]. 从衍射峰强度来看, 在四个籽晶层上生长的Ga2O3薄膜样品中, 功率为160 W 的样品衍射峰强度相比其他三个样品更高, 说明其结晶度更高. 这是因为从140 W 增加到160 W, 溅射粒子的逸出功逐渐增加, 有利于沉积粒子在籽晶层上扩散迁移形成晶体. 当功率从160 W 增加到180 W时, 溅射粒子的能量过大, 破坏了籽晶层的表面结构, 不利于外延层的再生长, 从而使得衍射峰强度下降. 当功率为200 W 时, 衍射峰强变化不明显,结晶度与180 W 时相比没有明显变化. AFM 图所观察到的表面颗粒为晶粒团聚体, 可直接测量其尺寸, 而平均晶粒尺寸可根据XRD 中显示的半峰宽值(FWHM)进行计算. 针对图3(a)中五个样品的衍射峰进行研究并计算平均晶粒尺寸, 计算晶粒尺寸采用谢乐公式[25]:

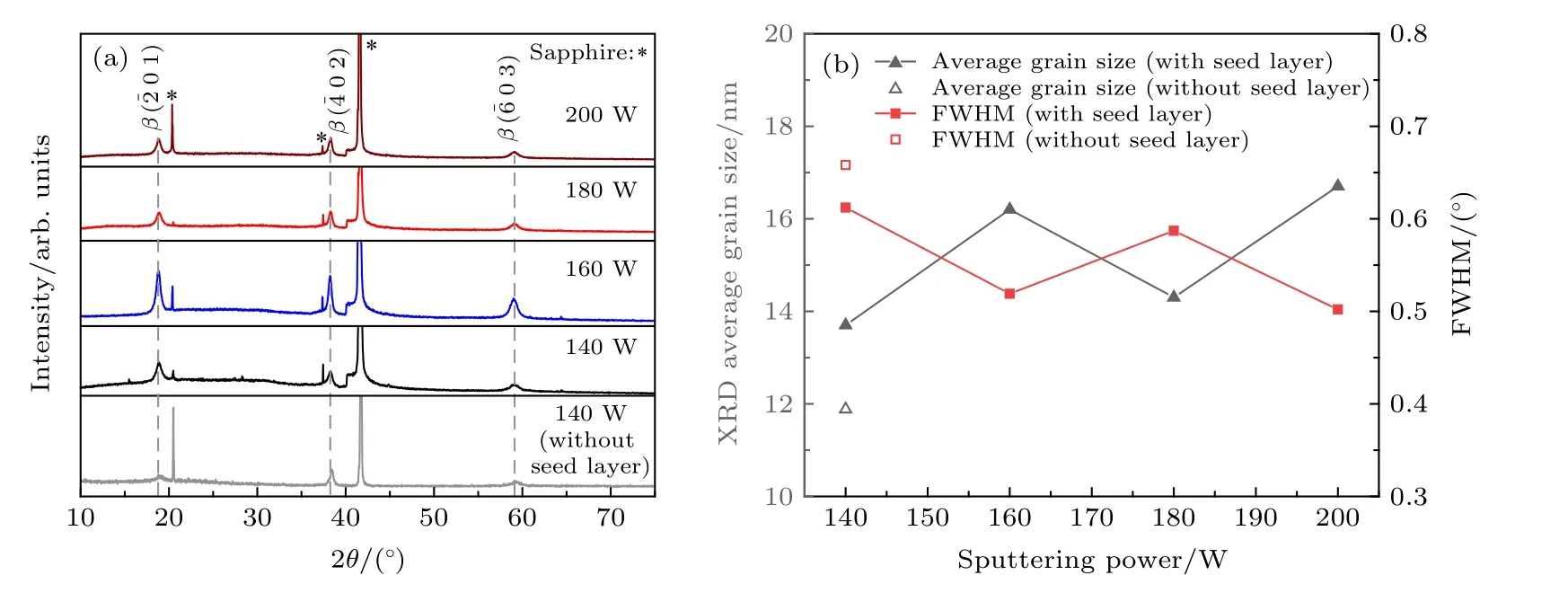
图3 (a) 以不同溅射功率沉积的β-Ga2O3 薄膜的XRD 图谱; (b) FWHM 以及平均晶粒尺寸分布图Fig. 3. (a) XRD pattern of β-Ga2 O3 thin films deposited at diffreent sputtering power; (b) FWHM and average grain size distribution.
其中λ为X 射线波 长(1.54056Å),β为FWHM值,θ为衍射角, 图3(b)显示了衍射峰的FWHM 值以及使用谢乐公式计算所得晶粒尺寸折线图. 无籽晶层条件下使用140 W 功率生长的Ga2O3薄膜以及在籽晶层条件下使用四种功率生长的Ga2O3薄膜FWHM 值分别为0.661, 0.612,0.519, 0.587 和0.502. 计算出的晶粒尺寸分别为11.9, 13.7, 16.2, 14.3 和16.7 nm. 在功率为140 W时, 无籽晶层的条件下生长的Ga2O3薄膜FWHM值大于籽晶层条件下生长的Ga2O3薄膜, 这说明籽晶层设计对晶体质量具有明显的改善效果. 通过与AFM 测试所估算的表面颗粒尺寸对比, 可以看到由谢乐公式计算出的晶粒尺寸和AFM 扫描结果估算的颗粒尺寸变化趋势并不完全一致, 这是因为表面颗粒虽然是晶粒凝聚的产物, 但在其凝聚成团的过程中可能受到更多因素的影响, 故晶粒尺寸的提高并不意味着表面颗粒尺寸一定会随之提高.XRD 显示的晶粒尺寸变化趋势可以理解为: 功率从140 W 增加到160 W, 晶粒尺寸提高; 从160 W增加到180 W, 溅射粒子逸出功过大, 使得籽晶层表面结构开始被破坏, 结晶度下降, 晶粒尺寸降低;而从180 W 增加到200 W 时, 由于功率过大, 反而使晶粒尺寸又一次提高.
图4(a)—图4(d)为在籽晶层上使用不同溅射功率生长的薄膜截面SEM 扫描图. 可以看到随着功率升高, 厚度分别为202.4, 247.3, 292.3 和260.8 nm. 由于籽晶层较薄故未能看见与外延层的明显分层现象, 可以看到从140 W 到180 W, 随着功率升高, 薄膜生长速率增加. 当功率达到200 W时, 出现小幅下降, 这是因为溅射粒子逸出功过大导致的.

图4 籽晶层上使用不同功率生长的β-Ga2O3 薄膜SEM截面扫描图 (a) 140 W; (b) 160 W; (c) 180 W; (d) 200 WFig. 4. SEM cross-section scan of β-Ga2 O3 thin film grown on seed layer with different power: (a) 140 W; (b) 160 W;(c) 180 W; (d) 200 W.
图5 (a)给出了不同功率生长的Ga2O3外延层薄膜的透射光谱. 所有样品在450—800 nm 范围的可见光波段透过率均在90%左右, 在350—400 nm区间开始急剧下降. 关于透射光谱吸收峰的研究,刘浩等[26]认为此波段范围内出现的吸收峰对应于氧空位能级, 曲线凹陷表明薄膜内部空位缺陷较多, 质量较差. 而功率为160 W 的样品在此区间的波形呈凸起形状, 意味着该样品中薄膜的氧空位浓度比另外三个样品要更低, 进一步说明了该样品的结晶质量要更好. 从功率为140, 160, 180 和200 W的样品透过率曲线可以看出, 随着功率增加, 吸收边先蓝移后红移. 这可能和改变溅射功率引起的粒径变化有关, 粒径减小, 内应力导致能带结构发生变化, 能级间距变窄, 导致电子由价带到导带迁跃引起的光吸收带和吸收边发生红移. 而粒径增大则导致吸收边蓝移, 这与AFM 观察到的粒径变化相对应. 氧空位数量减少, 薄膜边带附近的缺陷能级减少, 这些因素也将导致吸收边蓝移[27]. 使用Tauc 方法估算光学带隙(Eg), 如图5(b)所示, 绘制出(αhν)2vshν 曲线图, 吸收系数α由下式得到[18]:

其中t为薄膜厚度,T为透射率. 在140, 160, 180和200 W 的溅射功率下沉积的Ga2O3外延薄膜带隙值分别为4.81, 4.96, 4.89 和4.86 eV. 这一结果与Oanh 等[28]使用PLD 制备出的Ga2O3薄膜带隙值相似. 而各样品出现不同带隙值的原因归结于薄膜厚度以及粒径大小不同, 这些因素将导致晶格应变程度不同, 从而影响带隙大小. 缺陷数量也将影响带隙值, 缺陷越多, 带隙越小[25].

图5 (a) β-Ga2O3 薄膜的透射光谱; (b) (αhν)2~hν 曲线图Fig. 5. (a) Optical transmittance spectra for β-Ga2O3 films;(b) the plot of (αhν)2~hν.
图6 显示了不同溅射功率的Ga2O3薄膜的PL 谱. 蓝色发光来源于施主杂质上的电子和受主杂质上的空穴的复合, 这个机制被称为施主-受主对复合, 施主由氧空位和Ga 间隙形成, 受主由镓空位或者镓-氧空位对组成[29]. 所有的薄膜样品在460 nm 处均出现了强烈的蓝光激发, 这与之前有关Ga2O3薄膜PL 谱的报道并不完全相同(Cheng等[30]使用电子束蒸发生长Ga2O3薄膜并观察到其PL 谱存在蓝、绿、红三种激发光). 可以看到改变功率对发光波长并未产生明显偏移, 溅射功率为160 W 的样品相比其他样品具有更高的峰值.对于发光强度, 这可能还涉及到表面态和晶界散射导致的非辐射复合过程等影响因素[31]. 200 W 功率下生长的Ga2O3外延薄膜FWHM 值最小, 计算出的平均晶粒尺寸最大, 发光强度却不是最强,这可能是由于激光束斑(10 µm)照射区与XRD测试区(1 cm × 2 cm)面积存在较大差异, 且激光束斑更容易照射至不均匀区域, 致使发光强度与XRD 结果存在一定偏差. 此外, Li 等[18]在使用磁控溅射法生长Ga2O3薄膜并进行PL 谱研究时, 亦出现了类似的偏差结果, 他们认为发光强度的变化是一些复杂性因素所致, 包括结晶体中不同浓度的缺陷、表面态和晶界散射导致的非辐射复合.
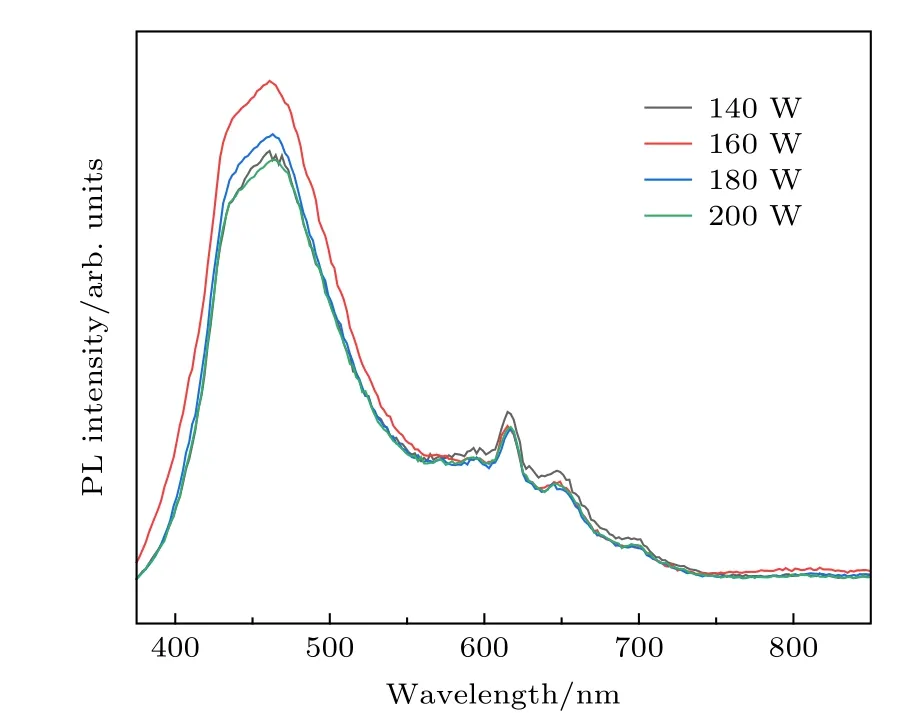
图6 在籽晶层上使用不同溅射功率沉积的β-Ga2O3 薄膜PL 谱Fig. 6. PL spectra for β-Ga2O3 films deposited at different sputtering power on seed layer.
4 结 论
本文采用射频磁控溅射制备了Ga2O3籽晶层并在其基础上进行Ga2O3薄膜沉积. 针对溅射功率研究了在籽晶层上生长Ga2O3外延层薄膜的生长特性和光学性能, 结合XRD, AFM, SEM, 紫外分光光度计, PL 谱等分析, 发现了薄膜的生长中出现晶粒团聚, 随着功率增加, 晶粒团聚到一定尺寸后出现裂解的现象. 本文生长的外延薄膜具有沿面择优取向, 并且具有较高的晶体质量和优良的光学性质, 在450—800 nm 范围的可见光波段达到了约90%的透过率, 并具有蓝光激发的PL 特性. 本文采用引入籽晶层生长氧化镓外延层薄膜方法, 将为高质量β-Ga2O3薄膜的可控生长提供有益参考.

