GaN HEMTs小信号等效电路建模与参数直接提取
郑良川,王 军
(西南科技大学 信息工程学院,四川 绵阳 621010)
随着应用市场对能效的重视,对高性能低成本电子产品的追求,基于GaN的电子器件种类越来越多,其中高电子迁移率晶体管器件(HEMT)是主要一类。GaN HEMT的主要优点有极低的门极电荷、极低的分布电容、超快的开关速度、超小的器件体积、优异的品质因数、超低的开关损耗和很低的器件发热[1]。由于其优异的特性,使得GaN HEMT可以应用于很多领域,比如无线充电、电源系统、同步整流功率变换系统、控制系统中的驱动电路和功放控制电路,其在功放控制及保护电路技术领域起着决定性的作用,是控制电路中的必要组成部分[2]。
精确的小信号等效电路模型不仅可以帮助提高器件和电路的可靠性,减少功耗,更能指导电路设计。另外,要完成设备的大信号模型,则需要准确的各偏置点的小信号模型。在高频时要考虑的主要问题是寄生效应[3]。这些高频信号会产生额外的寄生效应,需要用具有更多参数的分布式小信号模型来模拟[4]。此外,还应该添加额外的本征参数,以提高在大范围操作条件下的建模能力。
国外已有许多关于提取方法的报道并应用于砷化镓(GaAs)和氮化镓(GaN)器件[5]。这些方法可分为直接提取法、算法优化和直接提取结合的混合提取方法、基于算法优化的提取方法。直接提取法被认为是一种简单、可靠的方法,但它对测量的不确定性非常敏感。算法优化方法可用于一定程度的不确定测量,但提取结果可能不可靠[6],此外,该解决方案很可能陷入局部最小值,从而导致提取不准确,特别是在使用局部搜索优化技术时[7]。算法优化和直接提取结合的混合技术结合了两者的优点,但成本(时间和精力)高于直接提取[8]。根据查阅文献发现,直接提取法在速度和效率上都优于其他两种方法。因此,本文建立了拥有20个参数的GaN HEMT小信号等效电路模型,并在此基础上提出了一种用于提取这些参数的精确且简便的算法。同时将所建模型的仿真结果与实验结果进行了比较,验证了模型的准确性和算法的可靠性与精确性。
1 小信号等效电路模型
如图1所示是本文所提出的包含20个参数的GaN HEMT器件的小信号等效电路模型。图中的虚线框将器件的物理模型分为两个部分,虚线框内表示的是器件的10个本征参数,框外表示的是器件的10个寄生参数。其中,寄生参数包括衬底寄生电容Cpga和Cpda,极间电容Cpgi和Cpdi。Ld,Lg,Ls和Rd,Rg,Rs分别表示的是金属镀层电感和体电阻。本征参数包括栅极正向电导Ggsf和击穿电导Ggdf,输出电导Gds,源极和漏极间的极间电容Cds,以及Cgs,Cgd,Ri,Rgd表示充放电过程,Gm和τ分别表示通道跨导和电子传输时延。

图1 硅衬底GaN HEMT小信号等效电路模型Fig.1 Silicon substrate GaN HEMT small signal equivalent circuit model
1.1 寄生参数提取
当所测器件处于冷场条件下,即VGS≤VP和VDS=0 V时,器件中存在的主要是电容效应,此时器件的物理性质可以用图2的电路来表示。各外部寄生电容的值可以通过实测的Y参数矩阵表示,如式(1)-(3)[9]。对Y参数和频率进行线性拟合可以获得各外部寄生电容的具体值。

各电容值之间的关系可以通过式(4)-(5)表示:

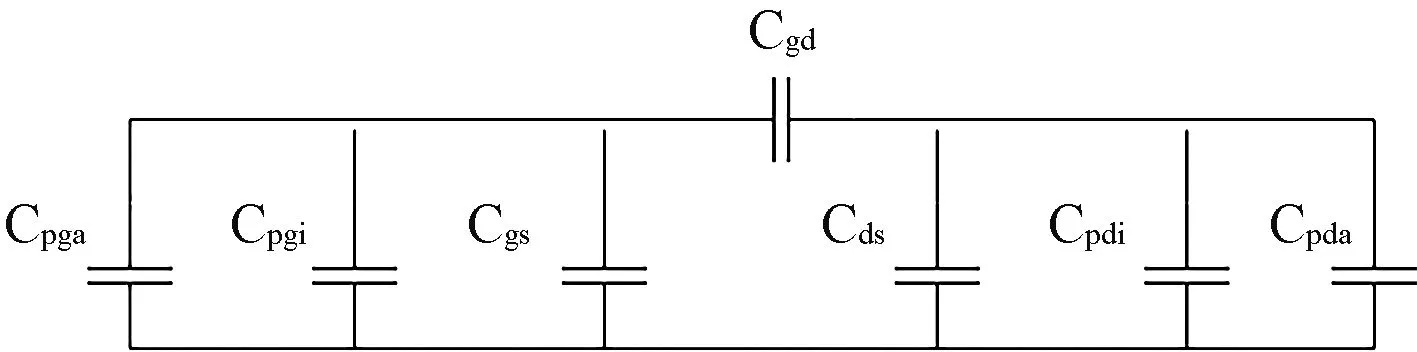
图2 低频条件(V GS≤V P,V DS=0 V)下GaN HEMT等效电路Fig.2 GaN HEMT equivalent circuit under low frequency conditions(V GS≤V P,V DS=0 V)
当器件的偏置电压为VGS=VDS=0 V时,器件的物理性质可由图3的等效电路来表示。此时测量器件的S参数,通过一系列矩阵变换,便可获得寄生电阻和寄生电感的值。在此等效电路图中利用一个RC网络来模拟肖特基势垒[10]。值得注意的是,在栅极处于高偏压的条件下进行S参数测量可能会损坏器件,所以利用无偏测量(VGS=VDS=0 V)获取寄生参数[11]。
图3中的栅极、源极和漏极的支路阻抗可以用式(6)-(8)表示。实测获得Z参数的虚部后,首先对寄生电容(Cpg,Cpd)去嵌处理,再将去嵌后的数据与频率进行曲线拟合,便可获得寄生电感的值。


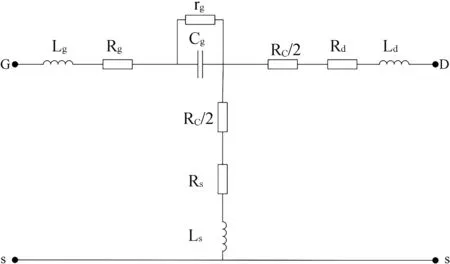
图3 零偏置条件下GaN HEMT等效电路图(V GS=V DS=0 V)Fig.3 Equivalent circuit diagram of GaN HEMT under zero bias condition(V GS=V DS=0 V)
用实测的Z参数的虚部(Im(Zs)、Im(Zd))与频率进行曲线拟合,即可获得寄生电感Ls和Ld的值。Lg的值由Im(Zg)与频率的平方进行曲线拟合得到。最后由Z22的实部确定(Rs+Rd),由式(6)-(8)同时求解寄生电阻Rs,Rc,Rd的值。至此,已完成所有的外部寄生参数值的提取,表1是所有外部参数的提取值。

表1 GaN HEMT(2μm×100μm)外部参数提取值Tab.1 GaN HEMT(2μm×100μm)external parameters extraction
1.2 本征参数提取
提取偏置相关的内部参数需要对外部寄生参数先进行去嵌处理。然后将模型的本征部分根据导纳Ygs、Ygd、Yds进一步细分为不同的导纳部分,如图4所示,用于简化提取过程。

图4 本征参数部分等效电路图Fig.4 Partial equivalent circuit diagram of intrinsic parameters
导纳Ygs可以用式(9)表示,由式(10)得到一个新的变量D。电容Cgs的值可以通过计算ω2与ωD的斜率而获得。
然后再将上述式(10)转化为式(11),由ω2与ωD的斜率可获得电阻Ri的值。

同样的,导纳Ygd可以用式(12)表示,由式(13)表示新变量D,通过计算ω2与ωD的斜率可获得电容Cgd的值。

随后,在式(14)中重新定义变量D用于计算电阻Rgd的阻抗。通过线性拟合ω2与ωD的实部可以获得其阻抗值。同时,利用Ygs和Ygd的实部可以计算出源极正向跨导Ggsf和栅极跨导Ggdf的值。

式(15)表示本征导纳分支Ygm,根据式(16)计算ω2与D的斜率可以获得跨导Gm的值。

器件的跨导由参数Gm模拟,它表示了漏极电流相对于栅极电压的变化率。在式(17)中再次用变量D来模拟2DEG通道的传输时延,时间延迟参数τ的值可以由D与ω的线性拟合得到。最后,本征分支导纳Yds由式(18)给出。

至此,本征部分的所有参数已提取完毕。以上参数提取过程所用到的算法均是在MATLAB软件中编程实现的,表2是GaN HEMT(2μm×100μm尺寸)的所有本征参数提取值。
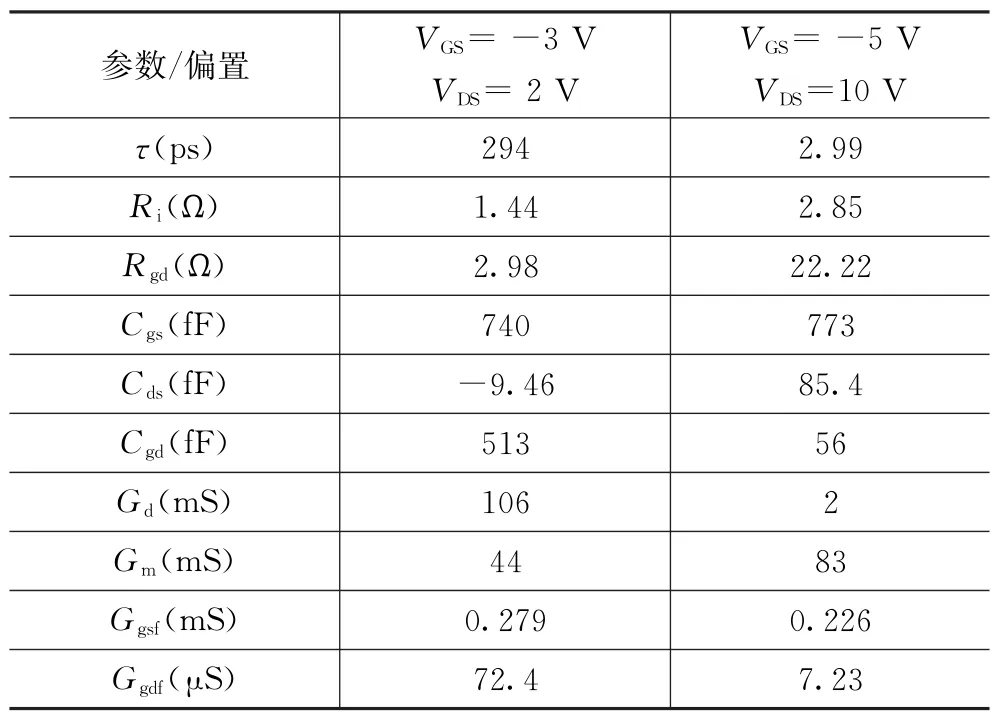
表2 GaN HEMT(2μm×100μm)本征参数提取值Tab.2 GaN HEMT(2μm×100μm)eigen value parameter extraction
2 模型验证及结果分析
为了验证此模型的有效性与可靠性,将所建立的小信号等效模型嵌入到安捷伦公司的ADS中进行S参数仿真,并将仿真结果与实测数据进行对比。仿真与实测的结果均建立在多个不同尺寸的GaN HEMT器件上,这些器件是在相同的衬底上制作的。图5是在ADS中搭建的包含20个模拟参数的GaN HEMT小信号等效电路模型。

图5 ADS中仿真电路图Fig.5 Simulation circuit diagram in ADS
如图6所示,对该模型的仿真S参数与实测S参数进行了对比。实测器件尺寸为2μm×100μm,仿真与实测频段为0.25~50 GHz,分别在两种偏置条件下测量。图6(a)表示的是偏置条件为VGS=-2 V,VDS=20 V;图6(b)表示的是偏置条件为VGS=-1 V,VDS=10 V。结果显示,在较宽的频率范围内,模拟模型S参数与实测数据之间有非常好的一致性。总体而言,本文所提出的方法在时间和精度上都提高了GaN HEMT器件小信号建模方法的水平。

图6 仿真与实测S参数对比Fig.6 Comparison of simulated and measured S parameters
3 结论
本文提出了一种精确、可靠、直接的小信号模型参数提取技术。该技术为外部寄生参数的提取提供了一种简单易行的方法,并为确定GaN HEMT器件的小信号模型的内部参数提供了一种方法。结果表明,测量和仿真模型之间有很好的一致性,从而验证了该方法的准确性。此外,所提取的内在参数的偏差和频率依赖性证明了所提模型及其提取过程的有效性。此工作有助于指导GaN HEMT器件的电路设计,以提高电路的可靠性。

