单晶硅表面钝化层在低能电子辐照前后的SIMS和XPS分析
杨玉青,雷轶松,向勇军,李 刚,熊晓玲,徐 建,董文丽
1.中国工程物理研究院 核物理与化学研究所,四川 绵阳 621900;2.中国电子科技集团第44研究所,重庆 400060
所有半导体器件的可靠性和稳定性均与它们的表面状态有着密不可分的关系[1],表面钝化一直是单晶硅器件研制中非常重要的内容。对单晶硅太阳能电池的表面钝化研究从20世纪60年代一直持续到现在[2-6],研究N型及P型掺杂单晶硅表面的各种表面钝化工艺、各种表面钝化层结构(SiO2、SiNx、SiO2/SiNx叠层、SiNx/SiNy叠层、Al2O3等)对太阳能电池效率、工艺稳定性及工艺成本的影响,国内比较成熟的单晶硅PN结器件的表面钝化层主要有二氧化硅层、氮化硅层、二氧化硅与氮化硅的叠层、硼硅玻璃与氮化硅的叠层、磷硅玻璃与氮化硅的叠层,由于氮化硅与硅的界面失配较明显,直接在硅器件表面进行氮化硅钝化的工艺很少使用。
辐射伏特效应同位素电池(简称辐伏同位素电池)是同位素电池中一个重要的分支[7]。它是利用半导体结型器件把同位素衰变射线能量转化为电能的装置,由于它全静态工作、直流稳定输出,非常适合对超低功耗IC芯片及超低功耗MEMS传感器进行长期免维护供能。辐伏同位素电池的基本要素是同位素和半导体结型器件,半导体换能器件在同位素源作用下的稳定性是实现辐伏同位素电池的长寿命及免维护的关键,雷轶松等[8]发现即使是发射低能β电子的同位素,亦会对不同表面钝化单晶硅器件的辐伏输出产生明显的影响。虽然从20世纪60年代开始就已经对半导体材料的辐射损伤开展了大量研究[9-10],如在太阳能电池、硅光电器件、MOS器件的辐射损伤方面,但主要集中在高能质子(几百keV~1 MeV)对太阳能电池板的辐射损伤及高能电子(1 MeV)、γ射线(60Co)与质子的辐射损伤等效研究方面[11-13];如在辐射探测器方面,前期的研究集中在α粒子、高能电子、高能中子、γ射线辐射探测器的辐射损伤研究方面[14-15],近年来随着新的辐照装置的建立,如欧洲X射线自由电子激光(XFEL),也开展了低能(12 keV)X射线对单晶硅探测器的辐射损伤研究[16-17]。而氚、63Ni辐伏电池中的单晶硅器件要同时承受连续能谱β电子和韧致辐射X射线的辐射作用,这一辐射领域中单晶硅表面钝化膜本身的变化很少见诸报道,2014年雷轶松等[18]研究了单晶硅器件表面SiO2/Si3N4在氚源辐照后的感生缺陷。
本工作主要针对加载低能β同位素的辐伏同位素电池中单晶硅能量转换器件表面钝化结构与工艺的优化设计,对国内单晶硅器件生产线常用的三种表面钝化工艺制备的钝化单晶硅材料,通过低能电子加速器辐照,对比辐照前后表面钝化层的二次离子质谱(SIMS)分析,并用Ar离子刻蚀X射线表面光电子能谱(XPS)作辅助分析,以研究低能电子辐照在三种表面钝化单晶硅器件的钝化界面中产生的化学微结构的变化,为该类电池中半导体器件的设计和制备工艺优化提供参考,也为其他在辐射环境下使用的半导体器件的工艺设计提供参考。
1 实验部分
1.1 材料与仪器
在P型〈100〉晶向、厚度675 μm、电阻率2 000~5 000 Ω·cm的单晶硅基底上,制备单一SiO2钝化膜(厚度(40±2) nm)、SiO2/Si3N4复合钝化膜(厚度(20±2) nm/(20±2) nm)、硼硅玻璃/Si3N4复合钝化膜(厚度(20±2) nm/(20±2) nm),样品编号分别为10、11、12。样品由中国电子科技集团第44研究所制备,其中SiO2膜采用栅氧化工艺制备、Si3N4膜采用低压化学蒸发沉积(LPCVD)工艺制备、硼硅玻璃膜采用硅玻璃沉积法制备。
TOF-SIMS飞行时间二次离子质谱仪,北京艾飞拓科技有限公司;AXIS SUPRA表面光电子能谱仪,KRATO公司。
1.2 实验方法
1.2.1低能电子辐照实验方法 采用加速器电子束模拟低能β同位素源,实验装置结构示意图示于图1。采用90 kV加速电压,2 mA束流,辐照样品置于电子腔外样品台上,在常压空气气氛中开展样品辐照实验,到达样品台的电子能谱及韧致辐射X射线能谱经Geant4模拟示于图2。由图2可知:到达样品台电子最大能量约为70 keV、平均能量约为37 keV。为避免束流升温对辐照效应的影响,样品台采用循环水冷却,在辐照期间保证不锈钢样品台的温度控制在37 ℃以内并维持稳定,样品在空气气氛下辐照6 h。
1.2.2测试方法 采用飞行时间二次离子质谱仪测试从钝化层表面到硅基底的Si-、NO-、B-纵深分布,所用一次离子为Bi+、能量为30 keV,纵向溅射速率约为0.1 nm/s,横向空间分辨率约为3 μm。采用Ar离子刻蚀光电子能谱仪测试从钝化层表面到硅基底的Si谱纵深分布,刻蚀Ar离子能量为4 keV,刻蚀深度间隔约为6.5 nm,共测试6个点。
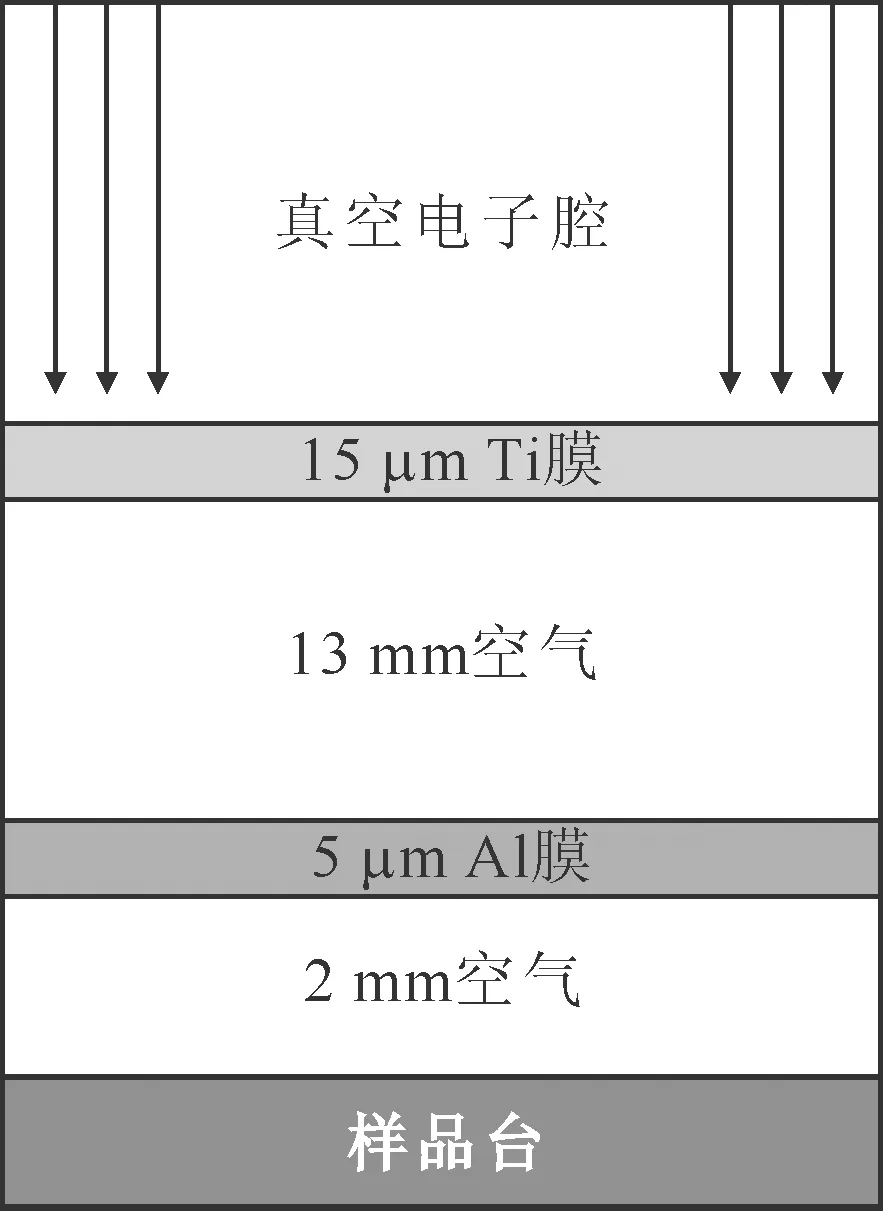
图1 辐照实验装置结构示意图Fig.1 Diagrammatic drawing of electron beam radiation experimental setup
2 结果与讨论
2.1 单一SiO2表面钝化的单晶硅样品在辐照前后的变化
单一SiO2钝化单晶硅样品辐照前后Si元素从表面到硅基底材料的SIMS负离子谱纵深变化示于图3。由图3可见:辐照前单一SiO2钝化膜最表面的Si-的强度(I)明显低于内部SiO2中的,随着深度的增加,Si-的强度迅速增加达到与内部SiO2中的一致;辐照后单一SiO2钝化膜最表面的Si-的强度明显高于内部SiO2中的,随着深度的增加,Si-的强度迅速下降到与内部SiO2中的一致;另外,Si-在SiO2/Si界面的分布变化明显,辐照后原界面靠SiO2一侧5 nm范围内的Si-的强度低于辐照前的。Si-的强度与其所处的化学结构环境相关,极性越大,化学键断裂倾向性越强,产额越高,因此SiO2中Si-的强度大于单质Si中Si-的强度。辐照在SiO2/Si界面产生了明显的影响,界面SiO2中Si的极性降低预示着完整化学计量比的化学结构的破坏,最大的可能是Si—O键的断裂。最表面Si-强度的变化应该与表面钝化工艺有关,栅氧化工艺制备SiO2的最后在氮气气氛中退火30 min,其作用和表面氧的作用相反,表面氧使SIMS的离子产额增大[19],表面氮气气氛处理使样品的SIMS离子产额降低,而样品在空气气氛中的电子辐照过程破坏了氮气退火影响的表面,因此使辐照后最表面SiO2或Si3N4的Si、N负离子谱的产额增大。单一SiO2钝化样品辐照前最表面Si(a)和微量N(b)的SIMS纵深变化示于图4。由图4可知:辐照前最表面存在很少量的NO-峰,而且Si-峰的峰强变化与NO-峰强变化趋势恰好相反,该层约厚1.5 nm。

图2 Geant4模拟到达辐照样品台的电子能谱(a)和X射线能谱(b)Fig.2 Geant4 simulation of electron energy spectrum(a) and bremsstrahlung photo energy spectrum(b) during radiation

——辐照前,●——辐照后图3 单一SiO2钝化膜辐照前后Si-的SIMS谱从表面到硅基底材料的纵深变化Fig.3 SIMS of Si- from surface to silicon substrate of mono-SiO2 passivation samples before and after low-energy electron radiation

图4 单一SiO2钝化样品辐照前最表面Si(a)和微量N(b)的SIMS纵深变化Fig.4 SIMS of Si-(a) and NO-(b) from outer surface to inner SiO2of mono-SiO2 passivation sample before radiation
对相同样品做Ar刻蚀X光电子能谱的测试分析,结果示于图5。由图5可知:XPS谱中SiO2的Si峰位在104 eV左右,单晶硅基底中Si单质的峰位在99~100 eV左右,测试显示辐照对SiO2结构的影响不仅仅在SiO2/Si界面的小区域内,而是向表面延伸了。辐照后样品Si-10-6h-4在距表面约19.5 nm的深度上已经有非理想SiO2结构的Si元素少量存在,这种Si也不是单质Si,很可能是部分Si—O键断裂之后的Si,即SiOx(x<2);距表面约26 nm时,未辐照样品Si-10-5中Si为大量的SiO2结构的Si元素和较大量的SiOx(x<2)时,辐照后样品已经绝大部分为类似单质Si中的Si元素和少量的SiO2结构的Si元素;距表面约32.5 nm时,未辐照样品Si-10-6中Si为绝大多数SiOx(x<2)的Si元素和少量的SiO2结构的Si元素,而辐照后样品已经几乎全部为类似单质Si中的Si元素。这和SIMS对该样品的分析基本一致。
2.2 SiO2/Si3N4复合钝化的单晶硅样品在辐照前后的变化
SiO2/Si3N4复合钝化单晶硅样品辐照前后Si-、NO-从表面到硅基底材料的SIMS负离子谱纵深变化示于图6。由图6可见:辐照前SiO2/Si3N4复合钝化膜最表面的Si3N4中的Si-和NO-的强度均明显低于内部Si3N4中的,随深度的增加,Si-和NO-的强度迅速增加达到与内部Si3N4中的一致,这一变化与单一SiO2钝化表面相似;辐照后钝化膜最表面的Si-和NO-的强度明显高于内部SiO2中的,随着深度的增加,Si-强度迅速下降到与内部SiO2中的一致,这一变化也与单一SiO2钝化表面相似;同时,辐照后Si-在SiO2/Si3N4界面的分布基本没有变化,而Si-在SiO2层及SiO2/Si界面的分布变化明显,辐照后整个SiO2层材料中的Si-峰强低于辐照前的,其原因与单一SiO2钝化表面一致,很可能是部分Si—O键在辐照后断裂;辐照后NO-在SiO2/Si3N4界面靠近Si3N4一侧强度明显低于辐照前,可能是部分Si—O键在辐照断裂后,游离的O元素向Si3N4层迁移,在辐照作用下可能形成了SiNO。
相同样品的Ar离子刻蚀X光电子能谱示于图7。由图7可知:在Si3N4/SiO2/Si中的Si元素,在第二点之前主要是Si3N4峰,可以看出辐照前后变化不明显,第三个点进入了SiO2层,辐照前后峰位变化也不明显,第四个点辐照前的峰位出现了单质Si的峰,可以认为此处靠近了SiO2和Si界面,辐照后的峰位中类似单质Si的峰强增加明显,说明辐照后理想结构的SiO2层的厚度变薄了,界面处SiO2中有较多的SiOx(x<2)存在。这和SIMS对该样品的分析也基本一致。
2.3 硼硅玻璃/Si3N4复合钝化的单晶硅样品在辐照前后的变化
硼硅玻璃(SiOB)/Si3N4复合钝化单晶硅样品辐照前后Si、N、B从表面到硅基底材料的SIMS负离子谱纵深变化示于图8。由图8可见,辐照前后复合钝化膜最表面的Si3N4中的Si-、NO-的强度变化与另外两种钝化结构的单晶硅材料中的相同,这应该与表面钝化工艺有关,不管是最表面的SiO2还是Si3N4,其制备后均在氮气气氛中退火30 min;同时,辐照后Si在SiOB/Si3N4界面的分布基本没有变化,Si-在SiOB内部及SiOB/Si界面的分布有轻微的变化,辐照后整个SiOB层中的Si-峰强稍低于辐照前;辐照后Si3N4层中NO-的SIMS峰强略微低于辐照前,N元素在SiOB/Si3N4界面基本没有变化。

Si-10-1—Si-10-6、Si-10-6h-1—Si-10-6h-6分别为辐照前、后样品依次从表面向硅基底的6个测试点图5 单一SiO2钝化单晶Si样品的表面XPS纵深Si元素谱Fig.5 XPS of Si element from surface to silicon substrate of mono-SiO2 passivation samples before and after low-energy electron radiation
相同样品的Ar离子刻蚀XPS的Si谱示于图9。由图9可知:辐照前后Si的钝化层及Si表面的变化微小,是三种表面钝化材料中最小的,说明其中Si元素所处的化学结构环境变化最小。

Si-11-1、Si-11-2、N-11-1、N-11-2为辐照前样品的两个平行测试点,Si-11R-1、Si-11R-2、 N-11R-1、N-11R-2为辐照后样品的两个平行测试点图6 SiO2/Si3N4复合钝化单晶Si样品辐照前后Si-(a)、NO-(b)的SIMS谱从表面到硅基底材料的纵深变化Fig.6 SIMS of Si-(a) and NO-(b) from surface to silicon substrate of SiO2/Si3N4 passivation samples before and after low-energy electron radiation

Si-11-1—Si-11-6、Si-11-6h-1—Si-11-6h-6分别为辐照前、后样品依次从表面向硅基底的6个测试点图7 SiO2/Si3N4复合钝化单晶硅样品的表面XPS纵深Si元素谱Fig.7 XPS of Si element from surface to silicon substrate of SiO2/Si3N4 passivation samples before and after low-energy electron radiation

Si-12-1—Si-12-6、Si-12-6h-1—Si-12-6h-6分别为辐照前、后样品依次从表面向硅基底的6个测试点图9 硼硅玻璃/Si3N4复合钝化单晶硅样品的表面XPS纵深Si元素谱Fig.9 XPS of Si element from surface to silicon substrate of boronsilicate glass/Si3N4 passivation samples before and after low-energy electron radiation
3 结 论
在空气气氛中,低能电子(包括其韧致辐射的X射线)辐照在轻掺杂P型单晶硅的三种表面钝化层界面引起的化学微结构变化有明显的差异。单晶硅表面钝化层的化学微结构损伤主要存在于SiO2/Si界面,该结构损伤并不能通过SiO2/Si3N4复合钝化得到明显改善;辐照对SiO2/Si3N4界面影响较小;而采用硼硅玻璃/Si3N4复合钝化有助于增强单晶硅表面及钝化层各界面材料结构的稳定性。

