半导体显示两种硅岛干法刻蚀方式对比
朱麟

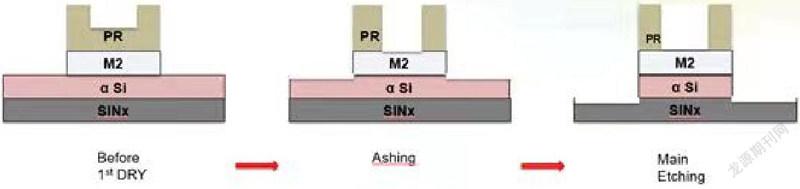
一:2W2D工艺
TFT-LCD面板中,TFT基板的制造工艺每道光罩基本工艺流程一般包括成膜,黄光,刻蚀及去光阻几个步骤。
其中蚀刻工艺主要分为湿法蚀刻与干法蚀刻两种,其中湿法刻蚀指的是药液与衬底膜层直接接触,通过化学反应的方式去除未被掩膜覆盖保护的区域;干法蚀刻一般指将气体等离子化,利用等离子体中活性自由基与离子的物理或化学反应,将对应刻蚀膜层去除的技术,干法刻蚀目前广泛应用于半导体生产工艺中半导体层、介质层及金属层刻蚀中
目前TFT-LCD面板制造工艺主流分为5Mask与4Mask两种,主要差别体现在4Mask PEP2/3光罩工艺合并为一道工艺,通过2次湿法刻蚀+2次干法刻蚀的方式完成Source/Drain电极与有源层沟道的形成,故4Mask工艺又叫2W(WET)2D(DRY)工艺
二:干法刻蚀
在上下两个平板电极施加一定的RF
Power,并在真空环境下通入一定量的气体,在电场的作用下气体解离生成活性自由基和离子,与沉积在基板上未被光刻胶覆盖的区域发生物理或化学反应,生成挥发性的物质被真空泵抽走,最终得到预想的图形,这就是干法刻蚀的基本原理
干法刻蚀的关键影响参数即RF Power,真空压力,气体,温度
根据干法刻蚀原理可分为物理蚀刻,化学蚀刻及反应离子蚀刻。其中物理蚀刻主要指的是用带电粒子轰击基板表面,使粒子和粒子发生物理碰撞,达到蚀刻的目的,因而在整个过程中起作用的都是物理碰撞,没有新的物质生成。因自偏压的存在,带点粒子物理蚀刻是各向异性的,蚀刻方向电场方向相关,在除正向之外的其他方向上基本没有蚀刻。因为物理过程不会针对特定的键或物质,故在选择比上物理蚀刻表现较差。
而化学蚀刻主要指的是用活性自由基或离子与基板表面待刻蚀膜层发生化学反应,生成挥发性的气态物质,被真空泵抽走的过程;对于化学蚀刻而言,只有在副产物是气体可以被及时抽走的情况下,才能维持一定的刻蚀速率,否则生成的物质覆盖在界面上将会阻止反应继续进行。因为化学蚀刻不受电场方向影响,故在蚀刻行为上表现是各项同性的,但是蚀刻的过程也会产生一些Polymer副产物,沉积在侧壁上组织刻蚀的进行,故亦可据此实现各向异性的效果。
反应离子蚀刻的原理是综合物理和化学蚀刻的过程,在实际干法刻蚀中,完全使用化学性刻蚀和完全使用物理性刻蚀的情况较少,一般是综合刻蚀结果需求,灵活地调整物理刻蚀和化学刻蚀所占比重,以达到最优的结果。
三:DRY硅岛刻蚀工艺介绍
2W2D工艺中,第一次DRY需完成的工艺要求为①未被光阻覆盖之大面积非晶硅刻蚀,形成TFT关键硅岛②有源层沟道半曝光区域的光阻去除,使沟道内的金属露出,在第二次WET刻蚀时去除,形成源漏电极。故第一次DRY刻蚀工艺流程也据此一般包含两部分:大面积非晶硅刻蚀(即主蚀刻,又叫Main Etching,ME)與沟道半曝光区域去光阻(即Half-ton Ashing,又叫Etch Back,EB)。
因刻蚀对象膜层不同,主蚀刻与烧光阻刻蚀工艺差异明显。
刻蚀非晶硅时,一般需要使用含CL,F气体,形成挥发性的SiFx和SiClx。因考虑到刻蚀均一性要求及物理刻蚀占比,使用压力一般在50mtorr~75mtorr左右,既不显著降低粒子平均自由程,可以维持一定量的反应粒子,使物理作用和化学作用的综合效果达到最佳。而光阻Ash的步骤中,主要以化学刻蚀为主。所以需要尽可能多地增加活性粒子浓度,一般使用压力为100~150mtorr,在主蚀刻O2中加入少量的NF3气体以达到增加刻蚀速率的效果。
四:两种DRY硅岛刻蚀工艺对比
一般我们把非晶硅刻蚀放在沟道内光阻Ash之前的模式叫做Etching First,把非晶硅刻蚀放在沟道内光阻Ash之后的模式叫做Ashing First,两种类型均为目前TFT制造中大规模使用的技术。
Etching First工艺中,由于光阻Ash时非晶硅已经刻蚀完成,一般使用F系气体+氧气的组合进行,其中O2用于PR有机成分的去除,F系气体用于提升Ashing速率;为减少对GI层的刻蚀F系气体需要尽可能小,这也导致了相对较慢的Ashing速率,影响工业生产的效率。
Ashing First工艺相对于Etching First工艺优点:①Ashing时无SiNx损失风险,可大幅提升F系气体与O2比例,一方面可增加Ashing速率,另一方面在Ashing过程中可同时对+非晶硅薄膜进行刻蚀,降低主蚀刻需要刻蚀的厚度,综合起来可大大提升工艺效率②Ashing 提前可预先将一部分被金属遮挡的非晶硅薄膜露出,接下来的主蚀刻中被蚀刻掉,这样可以大大降低非晶硅拖尾长度-对于高刷新率器件充电效率影响较大。但先进行Ashing也有其无法避免的缺点,首先,如使用Cl2,因刻蚀步骤在最后,残留的气体分子附着在基板表面,与空气中水汽结合生成酸性腐蚀剂,随着在空气中暴露的时间增加造成金属腐蚀或断线等异常。如使用含F气体,因Cl2与F系气体对于非晶硅-氮化硅刻蚀选择比的不同,主蚀刻步骤中氮化硅的损耗量会大大增加,一方面影响器件电学特性,一方面会增加栅极与源漏电极的异常放电概率。
五:总结
TFT显示技术2W2D工艺中的DRY硅岛刻蚀中,无论先主蚀刻或是先烧光阻,均有其优势与缺点,目前来说在应用中综合考虑电性,良率要求等生产实际情况,选择最适合当前的工艺即可。但是随着刷新率及生产效率的进一步提升需求,Ashing First工艺可能成为以后主流。

