填孔覆盖电镀的盖帽位漏镀失效分析
陈正清 丁 琪 曹大福 宋祥群
(生益电子股份有限公司,广东 东莞 523127)
0 引言
随着电子通信产品的飞速发展,产品设计需求传输信息量大、速度快和损耗小等特点,对于被称之为“电子产品字母”[1][2]的印制电路板(PCB)提出了更高的要求。除了使用的介质材料逐步向低介电常数、低介电损耗的发展外,特殊设计如N+N结构、背钻、POFV(填孔覆盖电镀:Plating over Filled Via)等应用也越来越广泛,其中POFV设计(如图1所示)有减小产品尺寸,降低层数结构的优点,为大多数通讯类产品所使用。常规的POFV设计在PCB加工过程中按工艺流程可分为一次钻孔和二次钻孔,主要差异在于不塞孔由一次钻出还是二次钻出,两种工艺流程各有优劣[1],POFV设计逐渐成熟的同时,其相对复杂的工艺制程对PCB塞孔、镀铜等加工过程提出了更高的要求。

图1 POFV结构
在实际生产过程中,当使用新型垂直连续电镀(VCP:Vertical Continuous Plate)进行POFV时,发现覆盖在塞孔上的树脂表面镀铜层有高比例见图2示的镀铜层缺失的问题,称之为“盖帽位漏镀”,而相同条件下其他电镀线此类缺陷比例极低。盖帽漏镀会影响产品整体的电气性能和元器件的贴装,对于下游客户端属于不可接收的缺陷。本文结合POFV工艺流程对漏镀失效影响因素进行分析,给出了盖帽位漏镀失效机理和改善方向。

图2 (a)盖帽正常与(b)漏镀图示 (随机取两个不同位置)
1 盖帽位漏镀失效分析
将漏镀区域通过小型切片机截取下来制作成切片,并沿通孔纵向研磨至对应位置,然后使用金相显微镜进行观察。通过观察可以发现,盖帽位镀层从孔边缘向中间位置渐薄,部分位置镀层不连续表现为缺镀(如图3所示)。此外,渐薄区镀层呈非包覆状内向延伸,说明在电镀过程中渐薄镀层区仍有一层微薄的化学铜起到导通作用。

图3 金相显微镜下的漏镀形态(随机取两个不同位置)
同时将漏镀区域切片置于3D显微镜下,横向观察盖帽位镀层表观,可以看出,漏镀位置周边镀层电镀铜结晶粗糙,存在微裂纹和点状缺镀(见图4所示)。与纵向切片一致的是,镀层由孔环边缘向漏镀中心区域渐薄,可以视为典型化学铜层导通不良导致的镀层不连续问题。基于上述分析,盖帽位漏镀的产生原因可以解释为塞孔树脂表面位置化学铜效果差或化学铜层被咬蚀,导致盖帽位沉积的化学铜层导通效果不足,在电镀过程中镀铜电流分布不稳定形成渐薄区镀层,在中间区域则表现为漏镀。
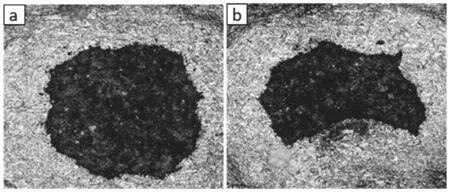
图4 3D显微镜下的漏镀表观(随机取两个不同位置)
2 失效影响因素分析
一次镀铜后经树脂塞孔流程形成塞孔树脂与铜面的平整基面,在此树脂基面上通过二次化学铜和电镀实现POFV盖帽镀层的制作,盖帽镀铜层与基面间为一层相对疏松的化学铜层,各镀层分布(见图5所示)。从漏镀的失效模式看,化学铜层导通不良是盖帽漏镀的根本原因,结合POFV工艺流程进行分析,化学铜层导通不良的原因主要与如下因素有关:

图5 POFV镀层分布
(1)塞孔树脂化学铜效果不佳,化学铜层过薄;(2)化学铜层与塞孔树脂结合力差,易受外力冲击脱落;(3)电镀前处理过程化学铜层氧化或被咬蚀。
2.1 塞孔树脂化学铜效果
PCB加工时,在孔内或表面非金属基材上(一般为环氧树脂)形成一层金属导体,一般先采用化学铜或非金属导电高分子方法实现导通,再进行电镀加厚铜[1][2]。常规化学铜制程一般需要经过清洁、微蚀、预浸、活化及化学铜,而化学铜的沉积是在贵金属催化条件下,通过铜离子的还原反应实现,其反应方程式如式(1)所示。

在化学铜过程中活化是最关键的一环,活化处理是在非金属表面吸附一层具有催化活性的粒子,诱发后续的化学铜反应。目前金属活化应用最广泛且最稳定的是钯活化液,而钯活化又分为离子钯活化、胶体钯活化以及敏化-活化一步法等。在钯活化体系中离子钯和胶体钯的主要差异在于钯团性质不同,其中胶体钯由钯核、Sn2+和过量的Cl-组成,整个胶体粒子带负电荷,因此在调整过程中需要将带负电的树脂孔壁调整为带正电,以便胶体钯团吸附。而离子钯是带正电的金属钯络合离子,在调整过程中只需维持负电性的孔壁或将带负电的孔壁调整为更加负电性。
2.2 化学铜层与塞孔树脂结合力
化学铜层与树脂的结合力主要取决于树脂表面的粗糙度。在化学铜之前对树脂表面进行粗化的过程为化学除胶,一般先采用有机溶胀剂打断树脂本身的聚集键结,将树脂加以膨胀及软化,然后利用高锰酸盐(高锰酸钠或高锰酸钾)的强氧化性,在高温及强碱性的条件下与树脂发生反应,其反应方程式如式(2)所示。

化学除胶对塞孔树脂的处理能力决定了表面粗糙度的大小,当粗糙度不足时,树脂表面上沉积的化学铜层在化学铜后、电镀铜前受药水或其他外力冲击下,可能会发生局部剥离与脱落,从而失去原有的导通作用。
2.3 化学铜层氧化或被咬蚀
化学铜后需要经过运输和等待,沉积的化学铜层发生一定程度的氧化在PCB制程中是无法完全避免的,镀铜前处理段的酸性环境也有去除氧化铜的效果。此外,为有效改善异常氧化问题一般会重点管控化学铜后的停留时间、产品烘干后放置环境的温湿度等。对过程数据统计发现,问题产品主要集中在新型VCP电镀线制作,与常规龙门电镀线相比其失效比例也相对较高,因此对此电镀线前处理段结构设计进行深入分析,确认可能对化学铜层进行破坏的因素。
新型VCP电镀线采用一体式钢带回型传动,不同槽体间通过双排挡水辘和进出口回流隔开,前处理段流程设计:入板→(入口回流)→除油→(出口回流)→热水洗→水洗*1(溢流)→水洗*2→酸洗→铜槽回流→镀铜入口。药水交换主要有两种方式,其中除油槽采用上槽浸泡+两侧回流+强烈对喷,除油后水洗和酸洗段则采用非浸泡式的顶喷+侧喷(见图6所示)。

图6 前处理流程
与常规龙门电镀线(浸泡式)对比主要存在如下差异,一方面除油槽为有效节省空间采用上下槽设计,其中上槽为反应主槽,下槽为暂存副槽。主槽通过入口、出口回流和侧边溢流至副槽,副槽通过循环泵浦将槽液通过喷淋管打回主槽。另一方面除油后水洗和酸洗设计为两侧喷淋方式,生产板处于滞空状态,药水从循环泵浦通过纵向排布的密集高压喷嘴直接作用于板面(如图7所示)。上下槽回流设计由于高落差冲击时产生的大量气泡,除油和酸洗段对板面的强烈对喷以及回流与非浸泡式设计导致的长滞空时间等都可能加剧板子化学铜层的咬蚀。此外,从化学反应的角度分析,前处理段对化学铜层有腐蚀作用的主要成分是空气中的氧、酸和铜离子。

图7 前处理设备结构
3 盖帽位漏镀机理分析
塞孔树脂的主要成分为常规环氧树脂,与基板材料一致,其化学沉铜过程中的相关特性此处不再讨论,本文主要从化学铜后铜层的轻微氧化开始,对新型VCP电镀线前处理过程各槽体对化学铜层的破坏进行分析,给出了盖帽位漏镀的失效机理。
3.1 化学铜层在空气中的氧化
正常电镀过程中化学铜后有一定的停留时间,其储存位置各不相同,但都多为潮湿的电镀车间,因此极易造成铜层的氧化。新鲜的化学铜层在钯活化的基础上沉积覆盖,相对于电镀铜层的致密沉积,化学铜过程大量的氢气生成致使化学铜层相对疏松。因此,化学铜层易被氧化,形成Cu2O、CuO层,时间越长氧化程度越严重,具体如图8(a)所示。
3.2 前处理段除油槽的去氧化
前处理段除油槽为酸性清洁体系,化学铜表面的氧化层会被清洗去除,露出新鲜的化学铜层,经过清洗后的化学铜层第一次变薄,具体见图8(b)所示。

图8 前处理段除油槽去氧化图
3.3 除油槽的持续氧化破坏化学铜层
除油槽的高位回流设计使槽液中存在大量气泡,且为保持足够的上槽液位也造成喷嘴对喷压力过高,对化学铜层形成剧烈冲击。槽液中气泡的氧气会与化学铜层持续反应生成氧化亚铜和氧化铜,而新形成的氧化层在除油槽持续被蚀去,铜层进一步变薄。此外,相对于常规的通孔设计,POFV盖帽位的化学铜层直接与除油喷嘴射流接触,更容易被氧化和破坏。
3.4 除油后水洗和酸洗的继续氧化
前处理段除油后水洗和酸洗设计为喷淋式,在清洁过程中存在持续与空气的接触氧化也会对化学铜层产生破坏。化学铜层经过多次的氧化逐渐变薄至漏基材,导致盖帽上部分位置化学铜层缺失,经电镀后表现为漏镀,具体如图9所示。

图9 除油后水洗和酸洗过程
化学铜层在VCP电镀前处理段持续被氧化破坏:除油槽上槽回流产生的大量气泡和强烈对喷冲击掉了大部分的化学铜层,除油后水洗和酸洗的喷淋过程与空气持续接触氧化造成了进一步的破坏,化学铜层厚度逐渐变薄至露出树脂,盖帽上部分位置的化学铜层缺失在电镀过程无法有效导通而出现盖帽位漏镀。
5 结论
在使用VCP电镀线对POFV盖帽部位树脂表面进行电镀的过程中,电镀前处理段药水槽高落差回流和高压对喷产生的强烈冲击,以及水洗段和酸洗段在喷淋过程与空气的持续接触,会对化学铜层产生很大的破坏,使得树脂上的化学铜层逐渐变薄甚至是缺失而露出树脂,没有化学铜层的位置由于无法导通在电镀后出现盖帽漏镀。同时,考虑到电镀前处理段对化学铜层的破坏是无法彻底消除的,降低电镀前处理过程喷淋强度同步提高化学铜层厚度可以改善盖帽部位漏镀问题。

