半导体硅器件接触时粘着产生起因的原子尺度分析
张琦,陈晶晶,宋萌萌,马艳花
(1.海南经贸职业技术学院 a.海南智能电网装备工程研究中心 b.机电与汽车工程学院,海口571127;2.宁德师范学院 信息与机电工程学院,福建 宁德 352100)
半导体硅器件因有着优异的高强度、耐腐蚀、耐高温、导电性、热导性等物理力学特性,在微型集成电路和微/纳机电系统器件中得以广泛使用,是微电子整流器、探测器、传感器、集成电路等国家重大需求领域广泛运用的重要核心半导体器件[1-2]。然而实践表明,微/纳机电系统器件大约七成失效归因接触间粘着产生,是诱发微型传感触发器、微马达动力装置出现耐久稳定性差及残次品比例高的主因[3]。另有报道指出,微传动装置经长时间高速运转后,在轴毂配合、齿轮啮合等紧密配合面,常观察到有大量磨痕和散落的粘着颗粒集聚产生,在界面粘附力和重载高速等复杂工况下,易诱使半导体器件脆性断裂而成磨粒,是导致微/纳机电系统产生故障和发出噪音的罪魁祸首[4]。倘若能了解其瞬态接触特性,及认识接触间粘着产生内因,将在半导体硅器件工况服役寿命提高中发挥显著作用,为设计出具有减摩耐磨的半导体硅器件奠定理论基础支撑。因此,研究半导体硅器件的接触变形行为与相变规律显得尤为必要,对理解半导体硅器件接触时的粘着起因这一基础问题仍值得探究。
目前,对微观接触研究主要采用微/纳压痕及划痕实验法、连续介质有限元法、离散统计学的分子动力学法(简称MD)等。最新报道指出[5],由于受纳尺度探针加工制造技术的局限,目前还未能制造出真实纳米尺度探针,用以表征纳尺度接触状态与描述纳米摩擦行为,连续介质力学理论也无法深入探究接触器件的内部相变特征,而经典分子动力学法可有效避免上述实验和有限元法的不足,成为捕捉微观接触变形与相变转化的有效研究工具,并能从纳观角度解释宏观粘着起因问题。Dai 等人[6]对磨粒磨削单晶硅材料去除机理展开研究,结果表明,结构宽度越小、结构深度越小或结构因子越高的磨料,对硅材料抛光效果越好,越具有韧性。文献[7]用MD 法对比了单晶硅抛光中有无石墨烯润滑下的抛光力、原子位移、配位数、温度、势能、摩擦系数和抛光表面形貌的差异,指出石墨烯的添加能有效提升被抛光表面形貌质量。陈晶晶等人[8-9]对单晶铜粘着接触失效展开原子尺度模拟,指出微观粘着产生是引诱接触失效的主要原因,然而,该研究未能解释清楚粘着到底是如何产生的这一重要基础问题。黄德明等人[10]基于MD 研究了针尖型探针切削单晶硅过程,分析了切削力、切屑、表面形貌与切削深度的关系。郭晓光等人[11-12]从原子尺度研究了单晶硅微量磨削材料的去除行为,分析了表面形貌重构和亚表面损伤机理。文献[13]从空间角度分析了单晶硅纳米级压痕过程的瞬间原子位置、作用力和势能等变化,但尚未对压痕中的变形与相变行为展开研究。朱宝义等人[14]运用MD 模拟了高速磨削下,金刚石磨粒切削单晶硅的过程,通过分析切屑、相变、位错运动,并结合工件表面积演变规律,研究了磨削速度对亚表层损伤和被磨削表面形貌的影响。
本文以典型半导体微器件单晶硅为具体研究对象,构建半导体硅器件与正三棱锥针尖探针的纳尺度物理模型。运用剪切变形公式,描述基底动态接触变形行为;用配位数刻化单晶硅器件相变特征,并揭示其接触间粘着产生起因,找出粘着接触失效及相变转化的微观规律。此研究对半导体硅器件芯片粘着产生的动态过程,有着重要学术借鉴意义。
1 分子动力学建模和计算
1.1 条件设置
为研究纳米尺度针尖型探针与基底间的接触特性,本文基于原子力显微镜AFM 操作原理,实时测量了纳尺度接触状态下的粘着起因,建立了图1 所示的针尖型探针与单晶硅的三维接触物理模型。该模型包含两部分:一部分是正三菱锥针尖型探针(图1b),选用此针尖型探针主要目的是,避免纳尺度针尖底部面积对接触粘着带来的额外影响;另一部分为半导体单晶硅器件基底。单晶硅X、Y、Z轴晶向分别为[100]、[010]、[001],硅基底X、Y、Z轴尺寸分别为27.155、27.155、19 nm。正三棱锥探针的边长和高度分别为9.5 nm 和8 nm。建模时,单晶硅晶格常数为0.5431 nm,金刚石晶格常数为0.3567 nm。本文模拟了接触加载和卸载两个过程。保持正三棱锥探针最底部距离单晶硅基底上表面为1.2 nm。单晶硅基底包含固定层、恒温层及牛顿层三种原子层,把恒温层和牛顿层统称为运动层,其中,固定层厚度为1.6 nm,恒温层厚度为2.2 nm,牛顿层厚度为15.2 nm,如图1a 所示。此外,模拟时,对模型Z轴采用非周期性边界条件,X、Y轴设为周期性边界条件。计算时,先进行能量最小化,对运动层原子用Langevin 控温为300 K,运动层原子的牛顿运动方程求解基于NVE 系综,时间步长为1 fs。在接触前,充分弛豫体系1.5 ns,达到温度及体系总能的稳定。随后,探针以匀速40 m/s沿着Z轴负方向加载单晶硅基底,下压到一定深度后,再以相同速度沿着Z轴正方向卸载。

图1 探针与单晶硅粘附接触的分子物理模型Fig.1 Molecular physical model of contact area between probe and mono-crystalline silicon
1.2 势函数描述
基于Verlet 算法[15]解牛顿运动方程,相关文献[10-13]也表明:Tersoff 势函数[16]适合描述单晶硅局部接触区变形,能很好地反映单晶硅内相变转化。Tersoff势函数表达式如式(1)、(2)所示。

式中,E为体系总能,Vij为原子i与原子j间的成键能量,rij为原子i与原子j间的距离,fA和fR分别为对势的吸引项和排斥项,fC为截断函数,bij为吸引势函数。
探针与单晶硅间相互作用基于Morse 势函数[17],表达式为式(3):

式中,D为结合能系数,α为势能曲线梯度系数,r0为原子间作用力为零时的间距,D=0.435 eV、α=46.87 nm−1、r0=0.194 75 nm 三个参数来源于文献[10]。
1.3 应变与应力描述
材料变形往往与受载的应力有关。本文用静水应力来表征材料局部接触区应力的集中度[18-19],其表达式如式(4)所示,且采用剪切应变公式(式(5))描述接触区域的动态接触变形行为[20]。


式中,σXX、σYY、σZZ分别表示X、Y、Z方向的应力张量分量;式(5)中的ηXX、ηYY、ηZZ、ηXZ、ηXY、ηYZ分别表示剪切应变分量。
2 结果与分析
2.1 单晶硅接触变形与相变描述
为了解接触时单晶硅基底的变形行为,运用剪切应变公式(式5)定性描述单晶硅接触时的动态变形过程(见图2)。另外,加载时探针下压位移用D表示,卸载时探针向上位移用D1 表示。在加载中,原子应变初始参考位置为探针沿着Z轴负方向开始下压的初始时刻;在卸载中,原子应变参考位置为探针沿着Z轴正方向开始卸载时的初始时刻。从图2a—c可知,加载中的单晶硅变形程度随加载位移增加而加剧,且正三棱锥探针和硅基底的紧密接触边缘应变程度最剧烈,主要原因是紧密接触区域的应力分布不均性加剧(见后文图4b),导致原子应变程度加深。另外,在探针底部的尖端周围区域有明显的应变呈波动传播的特性,即尖端探针周围应变涉及范围随加载位移增加而扩张(见图2a—c 中的红色圈),表明针尖探针底部积累了晶格受压产生的应变畸形能,该晶格应变畸能程度对应图2a—c 红色圈颜色深度。从图2d—f 可知,随着探针卸载位移增加,单晶硅基底变形也逐渐增加,尤其是紧密接触区域边缘应变最为剧烈(见图2 白色箭头指示)。其主要原因是,卸载时的探针与硅基底间出现了明显粘着特征,导致与硅基底紧密接触区域边缘的应变强烈处有部分原子腾空越出表面,形成桥接式构型(见图2d—e 黑色虚线)。由此表明,卸载时,基底与探针表面存有较强粘附力。

图2 300 K 下加载和卸载的单晶硅YZ 截平面变形图Fig.2 Deformation diagram on YZ section plane for mono-crystalline silicon under 300 K during loading and unloading
在探针卸载位移D1=4 nm 到D1=5.6 nm(见图2d—f)时,硅基底表现出明显塑性变形。为更好地观察硅基底加载和卸载时的变形特性,图3 展示了这两个过程的俯视变形图,图中黑色虚线表示探针与基底紧密接触外形轮廓。观察图3a—c 可知,随着探针加载位移增加,硅基底上表面变形加剧,而紧密接触变形行为表现出由内到外的衰减趋势,且以探针棱边为边缘分界的应变波传播衰减趋势均展现出一致性(见图3 黄色箭头)。此外,卸载时的基底变形行为与加载时的趋势有着一致性,即紧密接触区变形展示出由外到内的加剧(见图3d—f 红色箭头)。其原因是,图2a—c 红色圈线所表示的加载期积累的部分晶格应变能得以释放,导致图2d—f 卸载时出现明显粘附增强效应,此趋势与图3 变形图保持一一对应。观察图3 还可知,整个卸载过程,硅基底受载时产生的三角形凹坑区因积累应变畸形能释放的原因,以致凹坑随卸载位移增加而逐渐缩小(见图3d—f),完全卸载后,基底表面残留小三角形凹坑区(见图3f 虚线三角形区),该残留凹坑区域表示基底此时已经完全为塑性变形。
图4a 为加卸载过程中的载荷与位移曲线。从该图可知,在加载中,载荷与位移曲线呈现出类抛物线的阶梯式增加。而卸载时的力曲线波动幅度比加载时力曲线波动幅度更大,这归因于图3 中硅基底有部分积累的应变能在卸载时得以释放,且硅基底与探针间存有粘着效应,使得硅基底部分原子粘附于探针表面,进而引发力曲线波动。然而,完全卸载后,载荷仍然没有为0,再次说明硅基部分原子依附于探针外围轮廓(见图4d)。此外,完全卸载时,硅基底可明显看出有残余应力存在(见图4c 虚线框),即上述图3f 虚线三角形区域所展示的基底上表面凹坑周围有残余应力分布。

图3 300 K 下加载和卸载的单晶硅俯视变形图Fig.3 Deformation diagram on XY section plane for mono-crystalline silicon under 300K during loading and unloading

图4 硅基在加载和卸载时的载荷–位移曲线与应力图Fig.4 Load and displacement curves and stress maps of silicon during loading and unloading: a) load displacement curve; b)loading stress diagram; c) unloading stress diagram; d) adhesion diagram; e) schematic diagram of phase transformation
为更好地了解硅基底在动态接触时粘着产生起因,通过计算硅原子配位数,来描述硅晶格的相变转化行为,其结构原理如图4e 所示。文献[3-4]指出,当硅基底配位数CN≤3,表示硅晶胞原子受载产生变形缺陷,但尚未形成明显相变。每个硅原子周围有4个邻近硅原子为Si-I 相(CN=4),即完整的硅晶格结构;有5 个领近硅原子(CN=5)为Bct5-Si 相;有6个领近硅原子(CN=6)为Si-II 相。图5 定性表达了受载时的硅基底相变转化。加载时,硅基底内缺陷原子数(CN≤3)随压深增加而增多。另外,加载时的相变主要以Bct5-Si 为主,而Si-II 相变数呈现最少,查阅文献[3-4]发现Si-II 相变极不稳定。卸载时,由于硅基底弹塑性恢复,基底受载产生的相变也随之产生微变,即Bct5-Si 相原子数额随探针向上移动而逐渐减少,当卸载位移D1 为3 nm 时,Bct5-Si 相变数额逐渐开始趋于平稳(见图6b)。图6 定量统计了图5 中的相变转化数额。从图6 可知,在加载期,硅基底相变以Bct5-Si 相为主,并随探针位移增加,呈现抛物线式增长规律。而卸载时,在探针位移D1≤3时,Bct5-Si 相数额随探针向上位移增加,也呈抛物线式衰减趋势;当探针位移D1>3 nm 后,Bct5-Si 相维持稳定水平,此时硅基底发生完全塑性变形,与图3 卸载时的硅基底应变趋势一致。可见,在加载时,产生的Bct5-Si 相表示硅晶格接触区域原子键的断裂破坏,造成基底塑性变形为主的破坏;而卸载时,硅基底因加载受压的晶格畸变能部分释放,使得接触区Bct5-Si 相处于一定衰减趋势,直至基底完全塑性变形,且卸载时的粘着产生起因也正是由于加载区的Bct5-Si 相硅原子被破坏,从而粘附于探针外围轮廓上,形成明显粘附增强效应。

图5 300 K 下加载和卸载的单晶硅相变转化俯视图Fig.5 Phase transformation diagram on XY section plane for mono-crystalline silicon under 300 K during loading and unloading

图6 300 K 下加载和卸载时的单晶硅相变类型统计Fig.6 Phase transformation statistics for mono-crystalline silicon under 300 K during loading (a) and unloading (b)
2.2 温度响应的单晶硅粘附接触与相变行为
基于上述接触变形与相变转化的行为分析及深层次探讨粘附力产生的内在机制,分别比较了20、300、700、1000 K 的硅基底在温度响应下的接触变形与相变转化的差异性(见图7 和图8)。从图7 的加载过程可知,单晶硅变形的温度依赖性显著。在低温时,硅上表面变形光滑,而温度升高时,硅上表面变形起伏程度加剧,表面呈现随机粗糙波纹,表明温度越高,基底上表面变形紊乱越加明显。此外,在探针加载位移D=5.6 nm 时,随着温度升高,探针与硅基底紧密接触边缘的应变传播范围反而下降(见图7c、f、i 白色虚线)。分析图8 卸载过程可知,相同温度情形下,随着探针卸载位移增加,硅基底应变因粘附原因而逐渐增强。当温度低于700 K 时,完全卸载后(D1=5.6 nm),基底上表面残余的凹坑逐渐萎缩(见图8 白色箭头),当温度为1400 K 时,其粘附力效果越加突出,以致于完全卸载后的硅基底表面凹坑被变形强烈的原子淹没覆盖。为更好观察温度对粘附接触行为的影响,图9a、b 定性和定量给出了完全卸载后的粘附原子构型和统计数目。从图9a、b 可知,粘附探针表面的原子数随温度升高,呈类抛物线增长规律。图9c 表明,温度越高,接触过程中载荷与位移曲线波动幅度越加明显,说明温度极容易造成接触时的粘着增大,导致更多原子粘附于探针表面,这进一步解释了高温下微机电系统半导体器件硅接触失效的主要原因。图9d、e 量化了单晶硅基底加载和卸载时Bct5-Si 相变受温度的影响,结果表明:温度越高,Bct5-Si 相数量在整个加卸载中逐渐减小,且都以抛物线式趋势增加(加载时)或衰减(卸载时),到一定阶段后,维持稳定波动趋势。
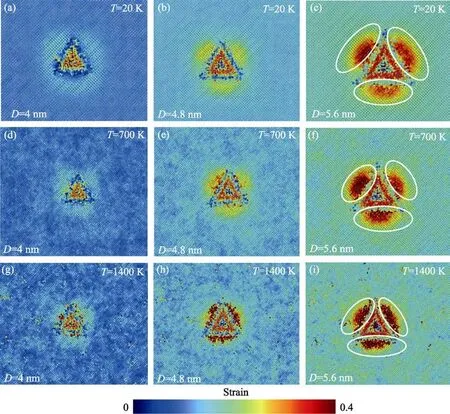
图7 加载时单晶硅俯视变形受温度依赖性影响Fig.7 Temperature-dependent effect on the deformation for mono-crystalline silicon during loading from top view

图8 卸载时单晶硅俯视变形受温度依赖性影响Fig.8 Temperature-dependent effect on the deformation of mono-crystalline silicon during unloading from top view

图9 单晶硅粘附接触与相变行为定量描述Fig.9 Quantitative description of adhesion contact behavior and phase transformation for mono-crystalline silicon
3 结论
本文采用分子动力学法对正三菱锥探针与半导体硅器件的接触过程变形与相变转化行为展开深入研究,揭示了纳米尺度半导体硅器件接触时的粘着产生起因,并讨论了温度响应下的硅基底粘附接触变形与相变转化差异,得出以下几点重要研究结论:
1)在理论计算MD 仿真中,加载和卸载时的硅基应变程度有着类似规律。在加载期,硅基应变程度由与探针紧密接触区从内到外逐渐衰减,卸载时的应变由外到内逐渐增强,且在卸载时接触边缘两侧的硅基原子形成桥接互连态势,表明卸载时有明显粘附特性存在。
2)加载时产生的Bct5-Si 相表示硅基接触区原子键的断裂破坏,造成硅基以塑性变形为主。卸载时,因加载期部分晶格畸变能释放,使得接触区Bct5-Si相规律呈现先衰减,随后因硅基完全塑性变形而维持稳定波动的趋势。卸载时,粘着起因的内秉机制是,受载区硅基相变的键能被破坏而粘附于探针外围轮廓上,形成明显粘附增强效应。
3)单晶硅粘附接触变形与相变转化行为的温度依赖性显著。温度越高,硅基表面随机粗糙波纹起伏程度越大,受载时的变形越严重,更易导致卸载时产生粘着接触失效。温度升高引起的材料软化变形是造成粘附增强的主要原因。整个加载和卸载中,硅基Bct5-Si 相展示的规律为,随温度升高,数量呈现出先下降、后稳定的趋势。

