聚焦离子束双束系统在微机电系统失效分析中的应用
袁锦科,黄彩清
(深圳赛意法微电子有限公司,广东 深圳 518038)
0 引言
聚焦离子束(Focus Ion Beam,FIB)是由离子源激发出来的离子束经过光阑过滤,静电磁场聚焦成直径为纳米级别的高能离子束并对样品表面进行轰击,从而达到对样品表面进行切割抛光、刻蚀等可选择性的微纳米精度加工的目的。配合气体注入系统,FIB 还可在样品表面进行沉积喷镀如Pt、W、SiO2等物质,对样品表面进行处理、保护或修饰[1]。FIB 系统是在普通的扫描电子显微镜的基础上加装了聚焦离子束和能谱分析组成的双束系统,该系统可对样品进行微纳米精度加工的同时,使用扫描电子显微镜(SEM)进行实时观察,并对可疑物质和结构进行能谱分析,是十分高效的加工、观察、分析系统,广泛应用在生命科学、材料科学、半导体制造等行业[2]。
MEMS 陀螺仪利用科里奥利力-旋转中的物体在有径向运动时所受的切向力,旋转中的陀螺仪可对各种直线运动产生各种反应[3]。惯性陀螺仪的原理见图1,MEMS 陀螺仪通常安装有2 个方向的可移动电容板,径向的电容板加振荡电压迫使物体做径向运动,横向的电容板测量由于科里奥利运动带来的电容变化。这样,MEMS 陀螺仪的悬浮块在驱动的作用下不停地来回做径向运动,从而模拟出科里奥利力不停地在横向来回的运动,并可在横向作与驱动力相差90°的微小振荡,这样科里奥利力好比角速度,由电容的变化量便可以计算出MEMS 陀螺仪的角速度[4]。

图1 MEMS 陀螺仪简化原理图Fig.1 Principle diagram of MEMS gyroscope
同理,MEMS 加速度计的微机械结构则由固定电极的定子和可移动电极的动子组成,可移动电极与悬浮质量块相连,悬浮质量块由弹簧悬挂着(图2)。当加速度计接收到外界的加速度时,由于惯性悬浮块和动子会产生相对运动,动子和定子之间的距离发生改变从而使电容的变化量发生变化,由此可计算出加速度大小[5]。
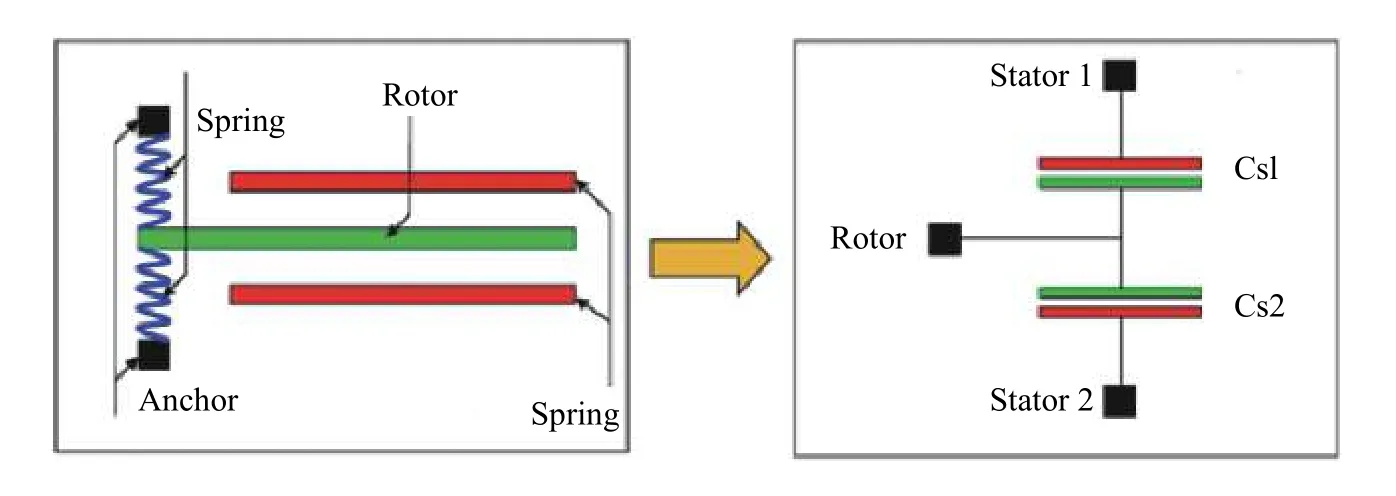
图2 MEMS 加速度计基本原理图Fig.2 Principle diagram of MEMS accelerometer
通过CMOS 微制造工艺MEMS 器件得以集机械、电磁,集成电路、传感器于一块微小的半导体硅材料上[6]。MEMS 芯片由尺寸为1~1000 μm的各种组件组成,封装尺寸介于微米到毫米级别之间。由于MEMS 惯性传感器结构的不同和工作原理的差异,传统的半导体分析方法已不能满足MEMS 惯性传感器失效分析的需求[7],本研究通过FIB 双束系统对MEMS 惯性传感器展开一系列失效分析,讨论FIB 双束系统在此失效分析过程中的重要性,对MEMS 传感器失效分析流程有一定的指导性。
1 实验过程与结果
在制造、运输、安装或应用过程中,MEMS 传感器主要失效模式有由外界冲击应力或振动应力引起的悬梁臂断裂、梳齿电极断裂、锚点破损、凸点破损、碎片阻塞悬浮块和碎片导致电极间短路等[8]。当对一个MEMS 传感器进行失效分析时,在红外显微镜无法找到失效模式的情况下,则需要使用更精密的设备对微机电系统某些特定部件进行微纳米精度的可选择性切割移除,从而进行更深层次的分析。FIB 双束系统正好满足MEMS器件失效分析的高精度和局部可选择性加工要求。使用FIB 双束系统,可以高效快速地对微机电系统进行高精度局部切割,从而达到移除相应的微部件的同时,保留其余微部件的完整性。本研究主要论述FIB 双束系统在MEMS 惯性传感器存在漏电流、灵敏度异常、零输入偏差异常等失效下的应用。
1.1 产品存在漏电流时对模封体的分析
对于电容式惯性传感器,由MEMS 内部动子和定子引出的2 根导线必须连接至ASIC 进行信号处理,2 根导线之间的信号正是对外界物理量感应到的交变弱小信号,因此其对漏电流更加敏感[9]。
本实验中由MEMS 电测机测得产品漏电流达毫安级别。将MEMS 芯片放进105 ℃的烤箱烘烤24 h,然后进行第二次电测,漏电流现象消失。再将芯片进行温湿度(85 ℃,85%RH)存储后进行第3 次电测,漏电流再次出现。由于该失效中漏电流受温湿度影响严重;因此,初步推断失效模式为封装模封体中存在空洞或者裂缝,当将芯片放置于高温高湿环境中时,水汽通过模封体进入并存储于空洞和裂缝中导致模封体阻抗变小从而出现漏电流[10]。确认失效现象后,使用FIB-SEMEDS 双束系统对模封体进行微纳米定位切割,切割位置为出现漏电流的2 根导线的焊盘和两者之间的区域。使用FIB 切割之前使用平行研磨机对模封体和晶粒进行减薄处理,晶粒剩余厚度约为30 μm。图3 为使用FIB-SEM 对晶粒焊盘和模封体进行微切割加工之后的横截面图片。对切割区域中的焊线和焊盘进行放大观察,可以观察到裂缝存在于模封体和焊盘之间的界面中并贯穿于2 根导线之间(图3b),对裂缝某一区域进行再次放大后可测得裂缝宽度约为800 nm(图3c)。

图3 FIB 切割后的焊线区域图片Fig.3 Image of welding area after FIB cutting
使用SEM 对2 个焊盘之间区域进行放大观察,可以发现模封体自身也已出现细小裂缝(图4),此裂缝是由于2 个焊盘之间长期存在漏电流而加剧形成的。最起初的裂缝只存在于焊盘和模封体两者之间的界面中,湿气存储于此裂缝中导致2 根导线之间存在微小漏电流,随着时间增长,电流经过的模封体也开始出现细小裂缝并加剧失效,电流进一步增大最终导致器件无法正常工作。

图4 模封体出现分层Fig.4 Delamination in die seal body
1.2 对MEMS 芯片进行开盖和表层结构分析
对于MEMS 器件,当外界运动物理量过大时,MEMS 晶粒中的悬浮块和固定电极、锚点极易发生机械碰撞从而导致结构损坏。另一方面,当微机电系统内部存在固体颗粒或者外物时也会阻碍悬浮块正常运动从而导致输出异常[11];因此,在电性能输出存在异常的MEMS 器件进行失效分析时,MEMS 晶粒将是分析的重点对象。使用FIB 双束系统对灵敏度和零输入偏差存在异常的MEMS 器件进行失效分析,通过FIB 对MEMS晶粒顶盖进行切割移除,再使用SEM 对内部微机电结构进行观察分析最后使用EDS 对可疑物质进行能谱分析,从根本上找出失效模式。
本实验使用浓硝酸对器件进行模封体化学腐蚀后得到MEMS 裸晶粒。MEMS 晶粒由集成有微机电系统的硅衬底和起到封装保护作用的硅顶盖黏合而成。在使用红外显微镜对其结构进行观察后无异常发现的前提下,则需要进一步使用FIB 对硅顶盖进行切割移除。本实验在其可疑失效部位正上方的硅顶盖上使用FIB 进行穿透性切割。聚焦离子束围绕可疑失效部位四周进行切割,使中间部分面积和晶粒分离,再使用工具将中间的硅顶盖进行移除(图5a),图5b为部分硅顶盖进行移除后,使用SEM 观察的内部结构。

图5 FIB 移除硅顶盖Fig.5 Remove the silicon cover by FIB
移除MEMS 硅顶盖后,将SEM 高倍放大进行观察,可发现微机电系统中的悬梁臂发生断裂现象(图6)。悬梁臂起到悬挂悬浮块的作用,当悬梁臂出现断裂的情况下,悬浮块便丧失运动功能,因此相应的灵敏度也将严重出现偏差。

图6 悬梁臂出现裂缝Fig.6 Cracking of suspension arm
微机电系统梳齿驱动电机之间存在可移动颗粒,此颗粒会使梳齿电极在运动过程中受到阻塞,从而导致器件的偏差量输出异常(图7)。使用FIB-SEM-EDS 双束系统,还可对颗粒进一步做能谱分析从而判断颗粒主要成分。由于此颗粒位于两梳齿电极之间,如果该颗粒为导电物质时,则还会造成电极之间出现短路或者漏电流。
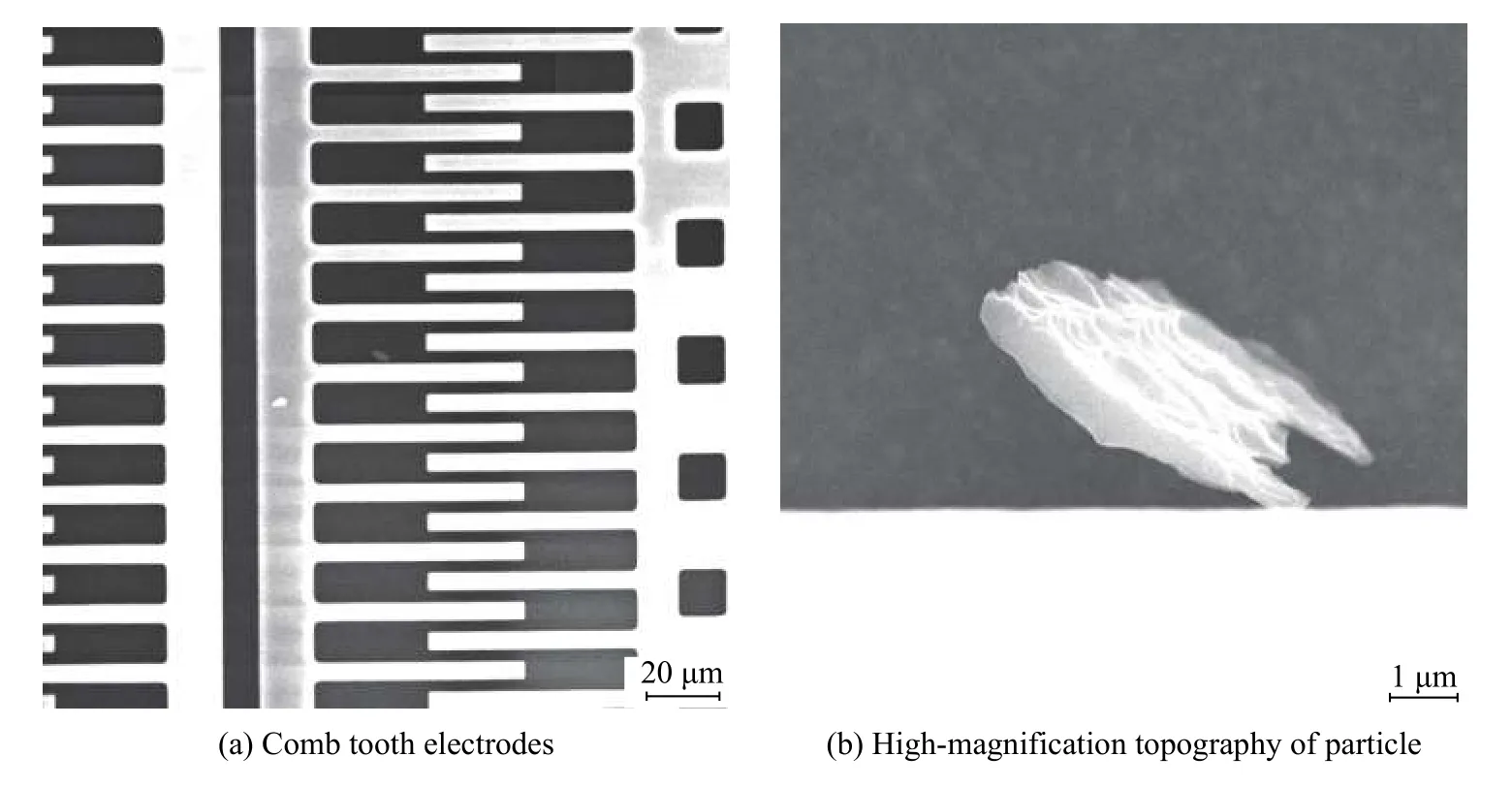
图7 梳齿电极间的颗粒Fig.7 Particle between comb tooth electrodes
1.3 对悬浮质量块进行移除分析和底层结构分析
对于上述中灵敏度和零输入偏差存在异常的MEMS 器件,机械损伤部位或者颗粒更多的是隐藏在微机械结构底层,因此在使用FIB 对硅顶盖进行移除之后,并无法直接通过SEM 在微机电系统表层找到失效点。此种情况下,则需要使用FIB 对微机械结构中的悬浮块进行切割,将悬浮块和硅衬底分离并将悬浮块移除,从而可以进一步对微机械系统底层结构进行分析。
图8 为使用FIB 将微机电结构中的悬梁臂进行切割加工后的效果图。悬梁臂起到连接悬浮块和硅衬底的作用[12],通过切断悬梁臂可以将悬浮块和硅衬底分离。本实验使用FIB 中的梯形切割功能,利用1 nA 小电流对悬梁臂进行成像、聚焦、精准切割,将所有悬梁臂切断从而达到分离悬浮块的目的。
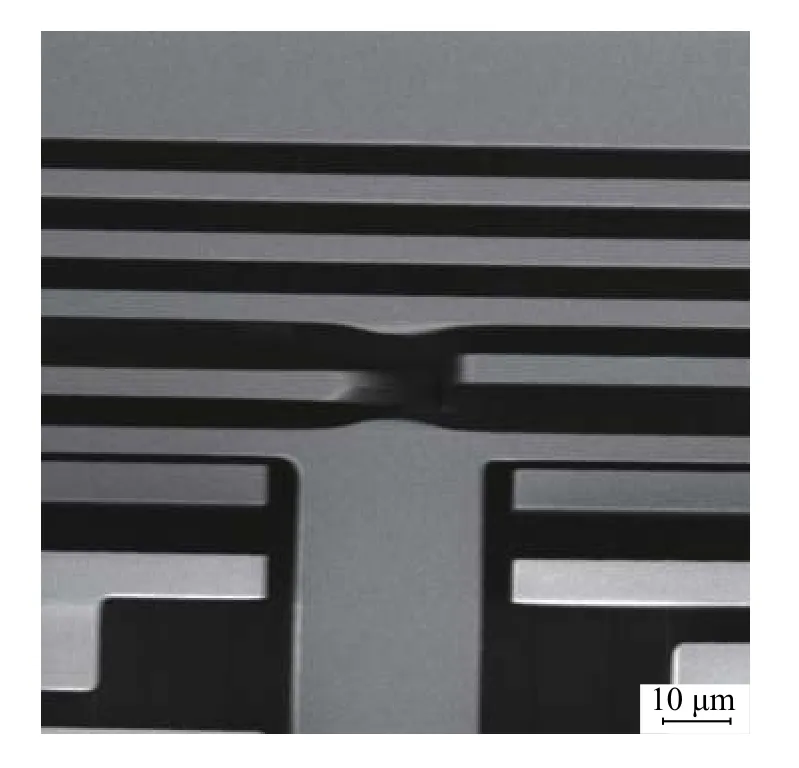
图8 FIB 切断的悬梁臂Fig.8 Suspension arm cut off by FIB
悬浮块移除后微机电系统的底层结构见图9a,可以看到底部的垂直方向的感应电极和沟槽,在SEM 低倍数下可看到沟槽某一位置存在异常,对此位置进行放大后观察,可以发现,电极的边缘位置已经发生严重的机械损伤且碰撞出了大量的碎屑颗粒(图9b)。对悬浮块底面进行观察,可以发现悬浮块底面相应位置的凸点也存在许多微小颗粒和凹坑(图9c)。在微机电系统中,此种现象为常见的机械碰撞所造成的。

图9 悬浮块移除Fig.9 Suspension block has been removed
2 分析与讨论
本研究使用FIB 双束系统对MEMS 器件3 种常见的电性能失效进行失效分析。
1)使用FIB 双束系统对模封体进行切割。对存在漏电流的MEMS 器件进行可靠性实验及失效验证,在确认产品漏电流存在的前提下,使用FIB 双束系统对相应的焊线区域进行纳米级别精准切割,当切割位置达到焊球中心位置时,发现2 个焊盘及其之间的模封体存在宽度约为800 nm 的分层。当器件存放于高湿高温环境中时,水汽极易聚集于该界面分层,导致2 根焊线之间的阻抗降低而产生漏电流。界面分层是半导体器件中最常见的导致器件无法稳定工作的典型失效模式。
2)使用FIB 双束系统对硅顶盖进行移除。对于MEMS 器件,产品对外界运动量感应的灵敏度是衡量产品性能的主要判定标准之一,其灵敏度与微机系统结构紧密相连,通常MEMS 晶粒中的微机电结构都由一层硅顶盖封装保护起来。该实验中使用FIB 双束系统对灵敏度存在异常的MEMS器件进行硅顶盖精准开窗移除,加工过程中既要保证硅顶盖彻底分离,又要保证不伤及内部的微机电结构。硅顶盖移除后对内部微机电系统进行观察,发现对应轴中的悬梁臂存在裂缝。通过分析发现是由于微机电结构损坏从而导致器件灵敏度异常。该失效模式通常是由于器件收到外界的过机械应力冲击而导致的。
3)使用FIB 双束系统对悬浮块进行移除。当实验中对微机电系统表层进行观察无异常发现时,一般需要使用FIB 对微机电结构中的悬浮块进一步加工移除。使用小束流对悬浮块中的悬梁臂进行切断,再利用工具对悬浮块进行异常,即可分析观察微机电结构底层形貌。该实验中发现悬浮块底层的凸点和平面电极之间存在轻微碰撞,碰撞过程中产生的细小颗粒可阻碍悬浮块正常运动,从而导致MEMS 器件灵敏度和零输入偏差异常。
3 结论
1)使用FIB 双束系统对MEMS 器件的模封体进行切割分析,可避免机械研磨时引入的外物以及材料延展等问题,从而使模封体及内部结构保持原始形貌,得到最真实的分析结果。
2)由于FIB 超高精度以及可选择性的局部切割功能,使得FIB 在对MEMS 芯片硅顶盖以及对微米级别的悬浮块进行精准移除的同时,可保证目标分析区域的安全性和结构的完整性,极大地提高分析的有效性。

