三维数值仿真研究锗硅异质结双极晶体管总剂量效应*
张晋新 王信 郭红霞3) 冯娟† 吕玲 李培 闫允一 吴宪祥 王辉
1) (西安电子科技大学空间科学与技术学院,西安 710126)
2) (中国科学院新疆理化技术研究所,乌鲁木齐 830011)
3) (西北核技术研究院,西安 710024)
4) (西安交通大学核科学与技术学院,西安 710049)
为探索锗硅异质结双极晶体管(SiGe HBT)总剂量效应的损伤机理,采用半导体器件三维模拟工具(TCAD),建立电离辐照总剂量效应损伤模型,分析比较电离辐射在SiGe HBT 不同氧化层结构的不同位置引入陷阱电荷缺陷后,器件正向Gummel 特性和反向Gummel 特性的退化特征,获得SiGe HBT 总剂量效应损伤规律,并与60Co γ 辐照实验进行对比.结果表明:总剂量辐照在SiGe HBT 器件中引入的氧化物陷阱正电荷主要在pn 结附近的Si/SiO2 界面处产生影响,引起pn 结耗尽区的变化,带来载流子复合增加,最终导致基极电流增大、增益下降;其中EB Spacer 氧化层中产生的陷阱电荷主要影响正向Gummel 特性,而LOCOS 隔离氧化层中的陷阱电荷则是造成反向Gummel 特性退化的主要因素.通过数值模拟分析获得的SiGe HBT 总剂量效应损伤规律与不同偏置下60Co γ 辐照实验的结论符合得较好.
1 引言
锗硅异质结双极晶体管(SiGe HBT)由于硅基能带工程材料和器件结构的优势,通过对基区Ge 组分梯度的控制,可实现大跨度的工作温度范围[1-3].如在月球—180 ℃—+120 ℃的典型极端宽温范围内,SiGe 器件使相关航天探测设备具备去掉庞大保温装置的可能,进而降低发射成本[4,5].因此,不同于传统设计中无源器件作为舱外设备的主流,SiGe HBT 具备了有源器件舱外应用的可能性,能够显著提高平台的有效载荷质量,实现信息获取、处理与传输能力的大幅提升.同时,SiGe HBT利用能带工程,在增益、频响特性、噪声和线性度等方面都表现出优异的电学性能;其还与Si CMOS工艺具有良好的兼容性,对于不同电路应用具有很强的适用性,成为空间极端环境应用中的有力竞争者之一[6,7].
然而,工作于空间辐射环境中的电子系统不可避免地要遭受电离辐射的影响.尤其当器件应用于卫星壳体外部时,短时间内遭受的粒子辐射急剧增加,电离辐射总剂量效应成为不可忽视的损伤因素.在SiGe HBT 实现商业量产之后,针对其总剂量效应的实验研究工作也随之展开,结果表明SiGe HBT 抗总剂量效应能力要强于传统Si BJT,但早期研究的实验环节设计较为简单,多采用浮空辐照的实验条件,对其辐照后的损伤机制仍采用传统BJT 正向电学特性的方法进行分析,不同氧化层中辐射诱发不同缺陷的影响也鲜有报道[8-12];另一方面,由于总剂量效应作用机理目前尚未形成统一的认识,其数值仿真并不像单粒子效应一样具有完善的模型,基于数值仿真的SiGe HBT 总剂量效应机理分析报道较少[13,14].我们团队在前期开展了针对SiGe HBT 在不同辐照偏置、不同辐照剂量率下的总剂量效应实验研究工作,发现电离辐射总剂量效应在SiGe HBT 器件内部引入的缺陷分布随着辐照条件发生变化,可能形成复杂的总剂量效应响应形式.
因此,为深入分析SiGe HBT 总剂量效应陷阱电荷驻留方式对器件损伤的影响,本文针对国产SiGe HBT 器件进行总剂量效应三维数值模拟.根据器件实际结构与工艺,构建合理的结构模型;通过在器件不同氧化层的Si/SiO2界面处添加陷阱,来模拟电离辐照后SiGe HBT 电学特性的退化情况;通过分析正向和反向Gummel 特性的变化,获得不同条件下总剂量效应诱发陷阱电荷分布差异对器件性能退化的影响,结合辐照实验结果,深入揭示SiGe HBT 总剂量效应关键影响因素损伤机理.
2 总剂量效应损伤机理与模拟方法分析
2.1 总剂量效应损伤机理
研究表明,电离辐射总剂量效应是由辐射在氧化层中引入缺陷造成的.高能粒子或光子入射器件氧化层,SiO2吸收射线能量而电离产生大量电子空穴对.大部分电子空穴对短时间内发生复合,逃离初始复合的电子空穴对会在氧化物中电场的作用下分离,电子约在1 ps 内被快速扫出氧化层,而空穴则以较低迁移率在氧化层中缓慢输运.一部分空穴输运至氧化物内本征缺陷处被氧空位所俘获,形成亚稳的氧化物陷阱正电荷(中心),这些中心大约在0.1 eV 的激活能下就发生退火;其余空穴输运到氧化物边界处,被界面附近(几nm 范围内)的氧空位缺陷俘获形成稳定的氧化物陷阱正电荷(中心),从而引起耗尽区电势变化.另一方面,空穴在输运过程中,打破弱的Si—H 钝化键,空穴和H+在电场作用下输运到界面,在那里参与反应生成界面陷阱即Pb中心,引起界面处载流子复合.电离辐射总剂量效应通过上述物理反应形成氧化物陷阱电荷(Not)与界面陷阱电荷(Nit)两种缺陷,对器件电学特性产生影响[13-16].
与SiNPN 双极晶体管相似,SiGe HBT 辐照后电学性能的退化主要是由基极电流增加(ΔIB)引起的,ΔIB越大,电流增益β衰退越严重.对于单一正向工作的pn 结而言,其电流密度可表示为

其中J0为饱和电流密度,n为理想电流因子,通常1 <n< 2,n越大,电流中非理想因素(复合电流)所占比例越大,电流曲线斜率越低.器件处于正常工作环境中时,基极电流主要取决于发射结空穴扩散电流IpE,由于SiGe HBT 基区掺Ge 后能带渐变引起的载流子快速迁移,基区复合电流可忽略不计.然而,当SiGe HBT 遭受电离辐射,在材料内部引入辐照损伤缺陷,导致晶体管中的发射结复合电流IrE和基区电子复合电流IrB显著增加,这两个电流分量成为影响基极电流变化的主要因素,造成SiGe HBT 电流增益的退化,这些非理想因素主要由耗尽区复合电流和表面复合电流组成,引起SiGe HBT ΔIB的增长.其中,基区外部覆盖的SiO2氧化层中的辐射感生净正电荷的积累在结区附近形成额外的空间电场,使得p 型基区表面耗尽,并与pn 结空间电荷层连接起来,增加了耗尽区的总体积,从而增加了耗尽区复合电流.Si/SiO2界面处辐射感生界面缺陷作为额外的复合中心,增加了表面复合速率,增大了表面复合电流.因此,对于SiGe HBT,辐照感生净正氧化物陷阱电荷和界面态越多,IB越大,增益衰减越显著.
2.2 总剂量效应模拟方法
进行SiGe HBT 总剂量效应的半导体器件数值模拟,首先需要建立器件模型,包括器件结构模型和物理参数模型.结构模型根据器件实际几何参数和工艺布局信息进行合理的设计与近似,既能有效反映器件的关键结构,又不会过于复杂而增加无效的计算量.物理参数模型则根据器件的半导体物理特性和所关注的电学参数进行选择[17,18].然后,开展总剂量效应的模拟计算.Sentaurus TCAD 包含了一些辐射模型,但是它们并不适用于所有的情况,因此,大量文献主要从以下两方面来解决总剂量效应的模拟问题:一是通过载流子连续性方程中的生成项在给定的区域或材料中引入固定电荷模型,这一模型与吸收剂量下的体电荷相关.但是,Sentaurus TCAD 无法在绝缘层(SiO2)中求解载流子连续性方程,因此,这一模型不适用器件中对辐射敏感的材料层,此外,该模型的默认值是对X 射线辐射有效,而对于其他射线(如伽马射线)需要进行修正.二是采用traps 模型模拟总剂量效应,其可在Si/SiO2界面处构建陷阱模型,与吸收剂量有关,目前有报道采用的方法是在氧化层以及Si/SiO2界面处添加陷阱模型,模拟γ辐照后器件性能的衰退情况[19].结合我们前期工作的实验数据,本文采用在Si/SiO2界面嵌入traps 模型来模拟γ辐照下SiGe HBT 总剂量效应,根据模拟计算的数据深入分析SiGe HBT 总剂量效应损伤机理.
3 器件仿真与总剂量效应三维数值模拟
3.1 SiGe HBT 器件建模
数值仿真基于SiGe HBT 实际结构建立器件模型,该样品采用垂直型双极晶体管工艺制造,其结构如图1 所示.在掺杂浓度约为5 × 1015cm—3的大面积p 型衬底和n 型集电区上方,外延硅层并掺入组分渐变的锗作为基区.引入的Ge 含量从发射极/基极结(E/B 结)和基极/集电极结(B/C 结)处的0%向基区中央缓慢变化至20%,形成缓变异质结,pn 结处的带隙差使基区实现厚度薄(约0.08 μm)、掺杂浓度高(掺入约1 × 1019cm—3的硼(B))的特性,提高器件响应频率的同时降低基区电阻.基区上生长氧化层,随后采用自对准工艺刻蚀淀积多晶硅制作发射区,掺入1.5 × 1020cm—3的砷(As)形成n 型发射极.其他重要结构包括:在重掺B 的p 型外延基区下方集电区内采用LOCOS工艺制造的隔离氧化层,这种氧化隔离工艺会在基区内形成较短的一部分薄氧化层,称为“鸟嘴效应”区;重掺As 形成n+层引出集电极电极;以及在接近器件边缘处,采用离子注入工艺注入硼离子并推进形成的环状重掺p 型隔离墙,作为衬底电极的引出接触.
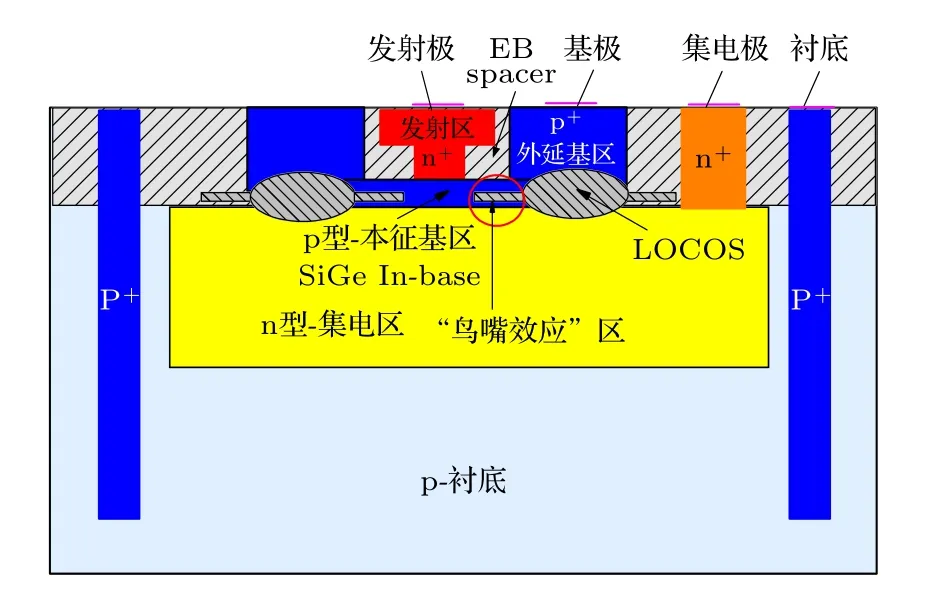
图1 SiGe HBT 结构示意图Fig.1.Schematic device cross section of SiGe HBT.
总剂量效应是由氧化层及Si/SiO2界面处辐射诱发的陷阱缺陷引起的,仿真应重点考虑pn结耗尽区与氧化层界面处的载流子输运情况.由图1 可以看出,对总剂量效应产生影响的陷阱缺陷可能分布于:本征基区(In-base)与基区覆盖的氧化层区(EB spacer)界面处、发射区与EB spacer界面处、本征基区与LOCOS 隔离氧化层界面处、以及集电区与LOCOS 隔离氧化层界面处.因此模拟计算中一方面应在本征基区、pn 结区、EB spacer与LOCOS 氧化层的Si/SiO2界面处设置较精细的网格提高计算精度,另一方面为了节约计算时间与成本,器件结构模型简化去掉了衬底结构,设计为发射区、基区和集电区的垂直结构.图2 给出sentaurus TCAD 构件的器件三维结构模型和器件内部结构二维仿真剖面图.
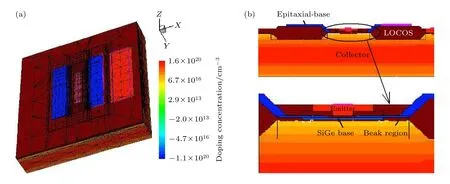
图2 器件结构仿真模型 (a) 器件三维结构;(b) 内部结构二维剖面图(上)及局部放大视图(下)Fig.2.Device model of simulation:(a) Three dimensional (3D) structure;(b) two dimensional (2D) cross section of SiGe HBT.
物理模型的合理选择对数值模拟的精确性有重要影响.首先,作为双极器件,少子迁移是SiGe HBT 工作原理的关键,philips 统一迁移率模型可实现多子和少子迁移率的同步模拟,是最重要的物理模型;其次,考虑器件重掺杂以及Si,Ge 为间接带隙半导体的特性,使用 Auger 复合模型和SRH复合模型;最后,考虑到发射区、基区与集电区引出处采用重掺杂,还选用了速率饱和模型与禁带变窄模型.根据划分的网格,在每一个X,Y,Z坐标确定的节点处求解泊松方程、载流子连续方程、以及玻尔兹曼输运方程.
3.2 总剂量效应数值模拟
在前期工作[20]中,我们通过60Coγ射线辐照实验分析认为,γ辐照在SiGe HBT 的发射极/基极(E/B)结和基极/集电极(B/C)结连接的两处氧化层,即EB spacer 氧化层和LOCOS 氧化层内都诱发陷阱电荷,数值计算采用在EB spacer 和LOCOS 隔离氧化层与有源区的界面处添加陷阱的方式来模拟总剂量效应.γ辐照电离产生的电子在1 ps 内被扫出氧化层,因此计算中只添加空穴陷阱.根据空间电荷理论,辐射诱发的空穴逃脱初始复合后,被俘获形成的亚稳极易发生退火,而输运至Si/SiO2界面的空穴被俘获形成的中心则较为稳定不易退火,其通常位于价带上1 eV 左右.因此数值模拟中嵌入htraps 模型,陷阱以单一能级分布,距离价带1.9 eV,浓度2 × 1015cm—3,空穴陷阱捕获截面为5 × 10—16cm2,电子陷阱捕获截面为5 × 10—17cm2.
同时,根据实验结果分析认为,不同偏置在EB 结耗尽区附近的EB spacer 氧化层、BC 结耗尽区附近的LOCOS 隔离氧化层中形成的电场方向不同,造成氧化物陷阱电荷与界面陷阱电荷的分布与积累有所差异,最终导致工作于不同偏置状态下的SiGe HBT 的电离辐射总剂量效应损伤程度并不相同,且正向Gummel 特性和反向Gummel特性对辐照偏置的响应情况也并不一致[20,21].因此,为探讨电离辐射在SiGe HBT 内部诱发陷阱电荷驻留差异对总剂量效应的影响机制,数值模拟中根据不同偏置电场下电离载流子在SiO2层中的输运方向,选取的traps 模型添加位置具体为:1#样品在本征基区In-base 与EB spacer 界面添加上述traps;2#样品在本征基区In-base 与EB spacer界面、本征基区In-base 与LOCOS 隔离氧化层下界面添加traps 模型;3#样品在本征基区In-base与LOCOS 隔离氧化层下界面添加traps 模型;4#样品在本征基区In-base 与LOCOS 隔离氧化层上界面添加traps 模型;5#样品在发射区和EB spacer 界面添加traps 模型;6#样品在本征基区In-base 与LOCOS 隔离氧化层下界面、在集电区与LOCOS 隔离氧化层下界面添加traps 模型;7#样品在本征基区In-base 与EB spacer 界面、本征基区In-base 与LOCOS 隔离氧化层上界面添加traps模型.图3 为不同Si/SiO2界面位置处添加traps模型的示意图.
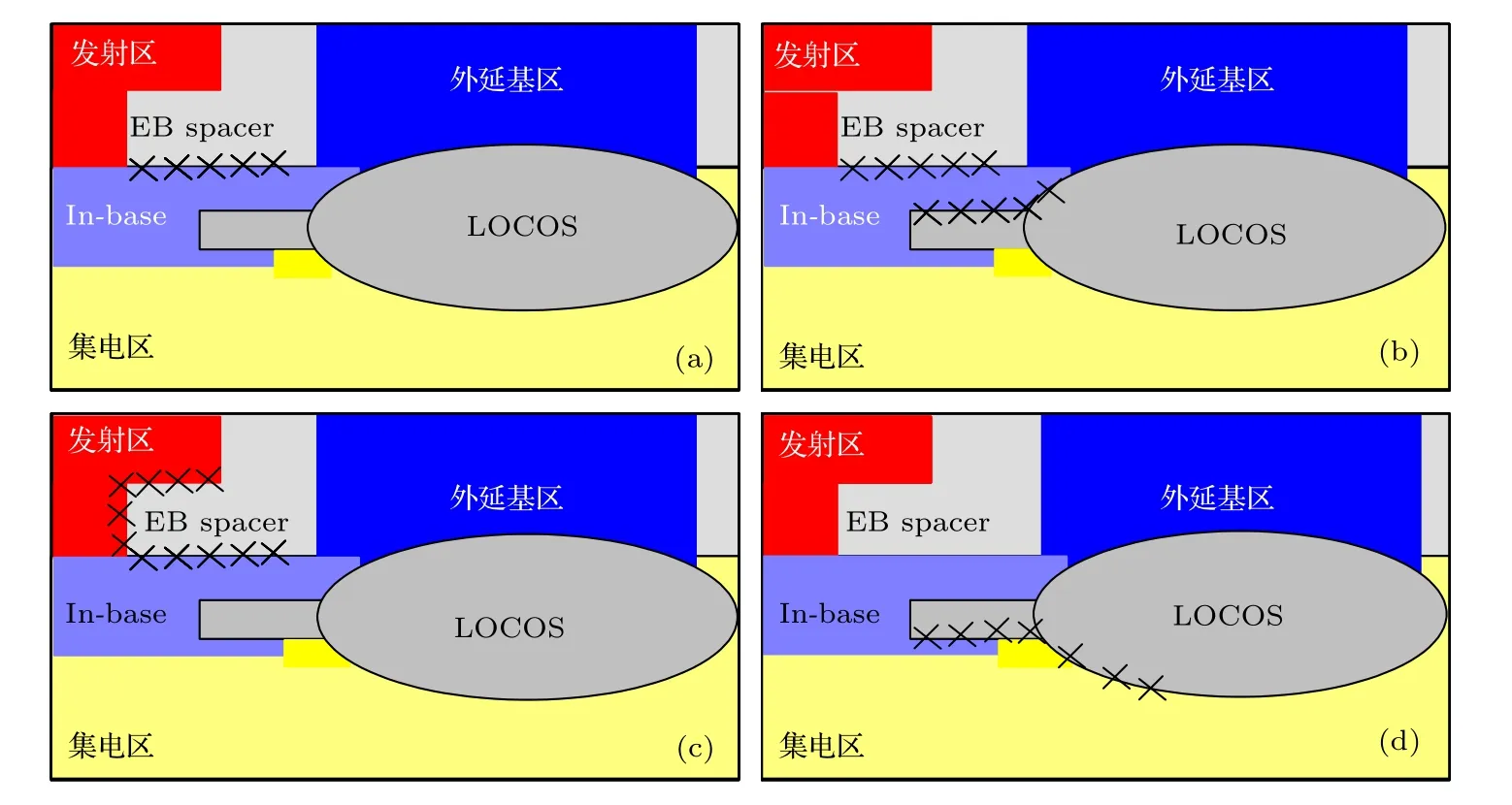
图3 不同Si/SiO2 界面位置处添加traps 模型的示意图 (a)本征基区In-base 与EB spacer 界面添加traps;(b)本征基区Inbase 与LOCOS 上界面添加trap;(c)发射区和EB spacer 界面添加traps;(d)本征基区In-base 与LOCOS 下界面、集电区与LOCOS 下界面添加trapsFig.3.Traps on different location of Si/SiO2 interface:(a) Traps on interface between In-base and EB spacer;(b) traps on interface between In-base and upside LOCOS;(c) traps on interface between emitter and EB spacer;(d) traps on interface between below side LOCOS and In-base,up side and collector.
4 模拟结果与讨论
4.1 SiGe HBT 总剂量效应损伤机制数值仿真研究
早期文献报道的针对SiGe HBT 总剂量效应的研究一般采用管脚全部接地或浮空的方式进行实验.文献[22]在辐照过程中选择了发射结不同偏置,但辐照后仍采用传统BJT 正向电学特性分析器件退化情况.因此,本文针对不同偏置影响SiGe HBT 总剂量效应的陷阱电荷驻留机制开展仿真研究.Gummel 特性是双极晶体管最重要的电学特征,它可以反映双极晶体管直流电流的放大能力.对于NPN 型晶体管而言,正向Gummel 特性表示了电子电流从发射极向集电极的放大功能,而反向Gummel 特性则代表了电子电流从集电极向发射极的放大特征,在不同电路应用中二者都具有重要作用.传统Si BJT 为实现正向电流放大能力,通常采用发射区重掺杂,基区掺杂浓度次之,集电区掺杂浓度最低的工艺方法,这不仅在一定程度上减弱了器件的频率特性,还使得反向放大功能下降.SiGe HBT 电流增益和响应频率的提高则依赖于基区掺Ge 引入的带隙变化,使得基区和集电区掺杂都可有所提高,从而减小了区域电阻.各区域之间浓度差的缩小和pn 结处带隙差的渐变使SiGe HBT 同样具备良好的反向放大功能.因此,仿真对正向Gummel 特性和反向Gummel 特性都进行了关注.图4 给出在SiGe HBT 结区与氧化层界面处添加traps 模型前后正向Gummel 与反向Gummel 特性的变化.

图4 添加traps 模型前后SiGe HBT Gummel 特性变化 (a)正向Gummel;(b)反向GummelFig.4.Gummel characteristics of SiGe HBT in the pre and post traps:(a) Forward Gummel characteristics;(b) reverse Gummel characteristics.
由图4 可知,电离辐射总剂量效应诱发陷阱电荷后,SiGe HBT 正向和反向Gummel 特性均没有出现明显失效.集电极电流IC和发射极电流IE在陷阱电荷的影响下变化很小,而基极电流IB随着辐照总剂量累积而增大,因此造成电流增益的下降,引起器件性能衰退.
γ辐照引起基区外部SiO2氧化层中氧化物陷阱正电荷的积累,在结区附近形成额外电场,改变了Si/SiO2的界面电势,造成p 型基区表面耗尽甚至反型,并与pn 结空间电荷层连接起来,增加了耗尽区的总体积,从而增加了基区的耗尽区复合电流.另一方面,Si/SiO2界面处辐射感生界面陷阱电荷作为额外的复合中心,增加了表面复合速率,增大了基区表面复合电流.因此,对于SiGe HBT,辐照感生氧化物陷阱电荷与界面陷阱电荷越多,IB越大,器件放大特性衰减越显著.
4.2 SiGe HBT 总剂量效应陷阱电荷驻留分布对电学特性的影响机制仿真研究
不同偏置在器件内部引入的电场不同,造成辐射电离产生的载流子的输运方向、输运速度、缺陷形成位置不同,基极电流的增加程度有所不同,并非所有位置引入的陷阱电荷都会造成基极电流的增加,而正向Gummel 与反向Gummel对陷阱电荷的分布位置的响应也有所差别.
4.2.1 不同陷阱电荷驻留分布对正向Gummel特性的影响
为分析电离辐射总剂量效应在SiGe HBT 内部诱发缺陷位置的不同,造成器件电学性能变化差异的损伤机制,首先对比了只在器件一处氧化层Si/SiO2界面添加traps模型时,SiGe HBT正向Gummel 特性的变化,即1#样品在本征基区与EB spacer 界面添加traps,3#样品在本征基区与LOCOS 隔离氧化层下界面添加traps,4#样品在本征基区与LOCOS 隔离氧化层上界面添加traps,5#样品在发射区和EB spacer 界面添加traps.同时为了深入研究不同偏置对SiGe HBT 总剂量效应的影响,引入参数归一化过剩基极电流,即辐照后基极电流的增量与辐照前基极电流的比值(ΔIB/IB0=(IBpost-IB0)/IB0).根据实验结果,测量正向Gummel 特性时,器件大约在VBE=0.6 V时正常开启,因此,正向电参数测试时,统一提取E/B 结电压为0.6 V 时的IB.图5(a)给出TCAD仿真获得的以上4 种样品添加traps 模型后与未辐照器件的正向Gummel 特性中基极电流的变化,图5(b)则对比了4 种样品TCAD 仿真获得正向Gummel 归一化过剩基极电流.
由图5(a)可以看出,TCAD 仿真获得的SiGe HBT 总剂量效应正向Gummel 特性变化与实验的变化规律相同:电离辐射诱发的缺陷导致基极电流增加,引起器件增益下降,其中基极电流在基-射结电压(VBE)较小时增量显著,当增大至0.8 V 以后电流趋于饱和,基极电流相对增量逐渐减小.对比发现,3#样品、4#样品与未添加traps 模型的器件相比,基极电流没有明显的增加,1#样品基极电流增量最大,5#样品次之.图5(b)的归一化过剩基极电流定量地表明1#样品和5#样品相比于未辐照器件,基极电流分别增加了4.05 倍与1.84 倍;4#样品只增加了0.04 倍,而3#样品在添加traps模型后没有发生基极电流增加的情况.
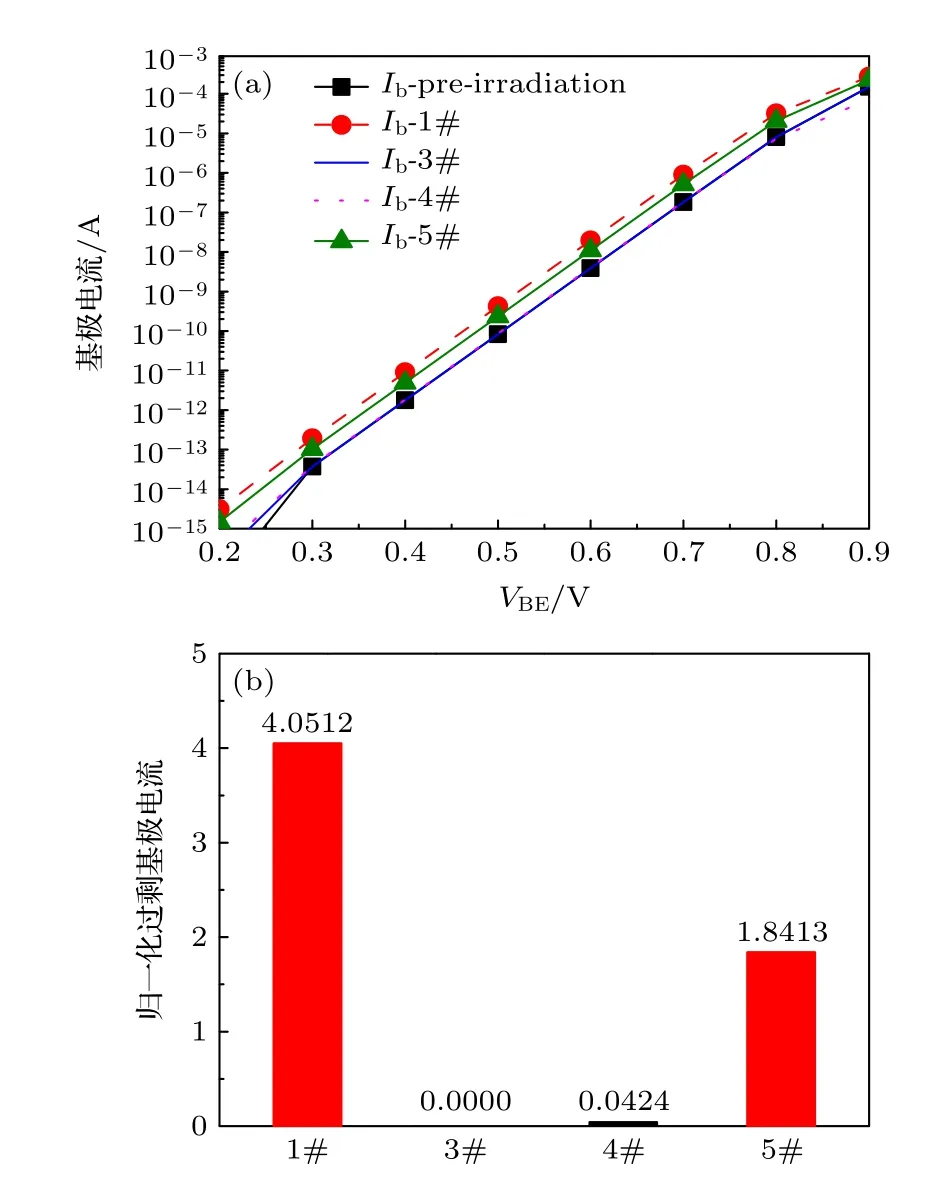
图5 对比只在器件一处Si/SiO2 界面添加traps 模型的正向Gummel 特性变化 (a)正向Gummel 基极电流变化;(b)正向Gummel 特性归一化过剩基极电流Fig.5.Forward Gummel characteristic with the traps model added toonly one Si/SiO2 interface:(a) Base current of forward Gummel;(b) normalized excess base current of forward Gummel.
通过对这4 种样品的对比分析认为,总剂量效应对SiGe HBT 正向Gummel 特性的影响,主要取决于发射区/基区(E/B)结处Si/SiO2界面附近电离辐射诱发的陷阱电荷.这是因为正向Gummel测试中,为实现电流正向放大流动,电子和空穴要越过 EB 结势垒,EB 结耗尽区内电流分量的变化成为影响ΔIB增长的主要因素.1#样品陷阱电荷分布于本征基区与EB spacer 的界面附近(图3(a)),这一区域靠近基区一侧,且氧化层与E/B 结耗尽区的接触面积较大,电离辐射产生的空穴输运至这一区域被俘获形成正陷阱电荷,引起耗尽区扩张,基区复合电流增加最为显著;5#样品的陷阱电荷位于发射区与EB spacer 界面(图3(c)),与E/B结耗尽区接触面积较小,但这些陷阱电荷形成的空间电场会对E/B 结耗尽区产生一定影响,造成基区复合电流有所增加.4#样品在本征基区与LOCOS上界面添加陷阱(图3(b)),这部分陷阱主要位于LOCOS 隔离的“鸟嘴效应”区与基区的Si/SiO2界面处,一方面氧化层体积较小,另一方面距离E/B 结耗尽区较远,陷阱电荷形成的空间电场对耗尽区的影响减弱,因此4#样品的归一化过剩基极电流仅为0.042.3#样品陷阱电荷分布在了“鸟嘴效应”区的靠近B/C 结一侧的基区中(图3(d)),对正向Gummel 特性没有产生影响.
为进一步分析两处氧化层中陷阱缺陷对SiGe HBT 总剂量效应的综合影响,图6 对比了1#样品本征基区与EB spacer 界面添加traps,2#样品本征基区与EB spacer 界面、本征基区与LOCOS 隔离氧化层下界面添加traps 模型,7#样品本征基区与EB spacer 界面、本征基区与LOCOS 隔离氧化层上界面添加traps 模型的电学特性变化情况.由于3 种样品都在本征基区与EB spacer 的界面分布有陷阱电荷,可以看出图6(a)中3 种样品基极电流都有相近的增量.图6(b)对比归一化过剩基极电流,7#样品由于在LOCOS 隔离氧化层上界面添加了陷阱缺陷,对基区中E/B 结耗尽区的复合电流产生了附加的影响,其损伤最为严重.1#样品与2#样品的归一化过剩基极电流只有0.00003的差异,可以认为B/C 结处Si/SiO2界面的陷阱电荷对正向Gummel 特性的退化几乎没有影响.综上所述,当偏置电压在EB spacer 与LOCOS 氧化层中形成的内建电场,促使辐射电离空穴向着EB结耗尽区的方向输运时,SiGe HBT 正向Gummel特性的退化较为严重.
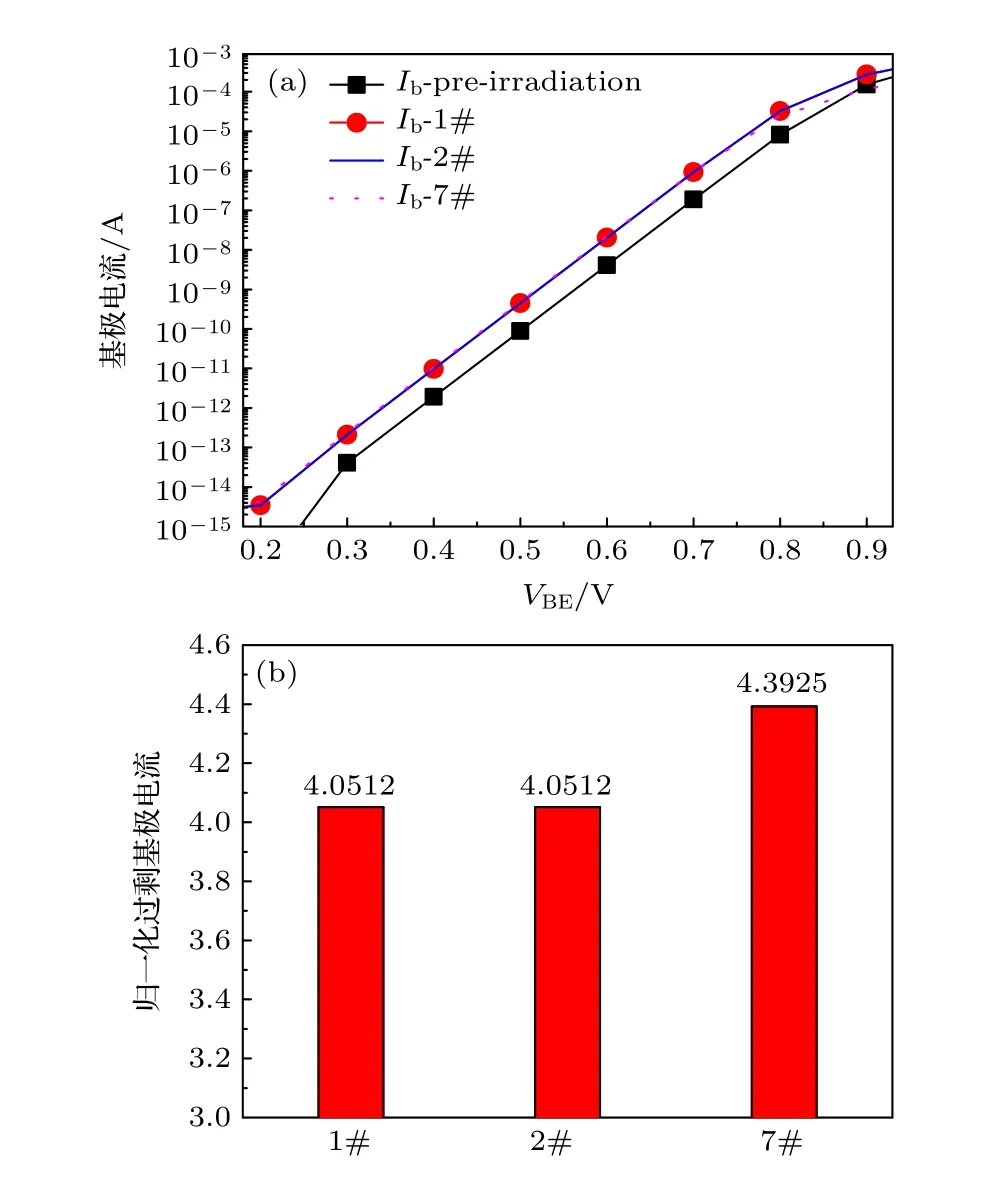
图6 对比本征基区与EB spacer 界面添加traps 模型的正向Gummel 特性变化 (a) 正向Gummel 基极电流变化;(b) 正向Gummel 特性归一化过剩基极电流Fig.6.Forward Gummel characteristic with the traps model added to theinterface of intrinsic base and EB spacer:(a) Base current of forward Gummel;(b) normalized excess base current.
由于本征基区与LOCOS 隔离氧化层下界面的接触面积很小(3#样品),可能不足以对器件电学性能造成显著影响,图7 对比了3#样品与6#样品在辐照前后的正向Gummel 特性基极电流变化情况.可以看出,这两种样品的基极电流只在小电压(VBE< 0.3 V)时略有增大,随后基极电流与未辐照器件相比没有变化.6#样品在本征基区与LOCOS 隔离氧化层下界面、集电区与LOCOS 隔离氧化层下界面都添加了traps 模型(图3(d)),B/C结耗尽区与隔离氧化层的界面面积增加,但正向Gummel 特性的基极电流并未增加,说明电离辐射在LOCOS 隔离氧化层下界面诱发的陷阱电荷对正向Gummel 特性的影响很小.

图7 对比LOCOS 隔离下界面添加traps 模型的正向Gummel 特性基极电流变化Fig.7.Base current of forward Gummel characteristic with the traps model added to theinterface on the below side of LOCOS.
4.2.2 不同陷阱电荷驻留分布对反向Gummel特性的影响
基区掺锗引起的带隙变化使SiGe HBT 同时具有了良好的反向放大能力,因此,进一步探讨了电离辐射诱发陷阱电荷驻留规律对反向Gummel特性的影响.与正向Gummel 特性一样,首先分析了只在器件一处氧化层Si/SiO2界面添加traps 模型时,SiGe HBT 反向Gummel 特性的变化.根据实验结果,测量反向Gummel 特性时,器件大约在VBE=0.4 V 时开启,提取此时的基极电流IB,分析反向Gummel 特性的归一化过剩基极电流.图8对比了1#,3#,4#,5#样品在添加陷阱缺陷后反向Gummel 特性的基极电流变化与归一化过剩基极电流.

图8 对比只在器件一处Si/SiO2 界面添加traps 模型的反向Gummel 特性变化 (a)反向Gummel 基极电流变化;(b)反向Gummel 特性归一化过剩基极电流Fig.8.Reverse Gummel characteristic with the traps model added only to one Si/SiO2 interface:(a) Base current of reverse Gummel;(b) normalized excess base current of reverse Gummel.
由图8(a)可以看出,电离辐射总剂量效应在SiGe HBT 中引入陷阱电荷后,反向Gummel 特性中的基极电流在小电压下就开始增大,在VBC大于0.6 V 后基极电流相对增量逐渐减小,在0.8 V后和未辐照器件的基极电流基本一致.其中4#样品基极电流增量很大,3#样品基极电流也有明显增大,1#与5#样品的基极电流变化很小.结合图8(b)给出的归一化过剩基极电流数据分析,4#样品的陷阱电荷分布在本征基区与LOCOS 隔离氧化层的上界面(图3(b)),这一区域与B/C 结耗尽区Si/SiO2界面的接触面积大,产生的空间电场易对耗尽区中基区复合电流产生影响;3#样品陷阱电荷分布在本征基区与LOCOS 隔离氧化层的下界面,这一区域处于B/C 结耗尽区内,引起基极电流增加了3.3 倍,但其与基区接触面积较小,基极电流增加没有4#样品显著;1#样品在本征基区与EB spacer界面添加了traps 模型(图3(a)),对B/C 结耗尽区内的复合电流没有影响,这一部分陷阱电荷作为复合中心,造成了基区内复合电流的微小增加,归一化过剩基极电流仅为0.12;5#样品由于是在发射区与EB spacer 界面形成陷阱电荷(图3(c)),对反向Gummel 完全没有影响.对比这4 种样品分析认为,反向Gummel 测试中,为实现电流反向放大,电子和空穴有效越过 B/C 结势垒在其耗尽区内的电流分量成为影响电流-电压特性的主要因素.因此,反向Gummel 主要取决于LOCOS 隔离鸟嘴效应区氧化层中的辐射感生缺陷.
图9 对比了本征基区与LOCOS 隔离上界面分布陷阱缺陷的两种样品归一化过剩基极电流的情况.4#样品只在本征基区与LOCOS 隔离氧化层上界面添加traps 模型,而7#样品同时还在本征基区与EB Spacer 界面添加了traps 模型,可以看出7#样品基极电流的增量大于4#样品.图10对比了本征基区与LOCOS 隔离下界面分布陷阱缺陷的3 种样品归一化过剩基极电流的情况.其中,3#样品只在本征基区与LOCOS 隔离下界面添加traps,其归一化过剩基极电流最小(3.29),6#样品还在集电区与LOCOS 隔离氧化层下界面添加traps 模型,这一区域包括了集电区内的小部分B/C 结耗尽区,归一化过剩基极电流比3#样品略有增加(3.37);2#样品则另外在本征基区与EB Spacer 界面添加traps 模型,其归一化过剩基极电流在这3 种样品中最大(3.42).根据图9 与图10的数据分析认为,SiGe HBT 中LOCOS 隔离氧化层在基区中由应力作用形成了一个较薄的“鸟嘴”效应区域,这一区域中电离辐射感生形成的陷阱电荷对SiGe HBT 的反向Gummel 特性起主要影响作用;由于其与基区接触面积有限,反向Gummel特性还明显受到了本征基区与EB spacer 界面处陷阱电荷的影响,这些缺陷作为复合中心,引起了基极电流的少量增加.

图9 对比本征基区与LOCOS 隔离上界面分布陷阱缺陷的归一化过剩基极电流Fig.9.Normalized excess base current of reverse Gummel with the traps model added to the interface of intrinsic base and upside LOCOS.

图10 对比本征基区与LOCOS 隔离下界面分布陷阱缺陷的归一化过剩基极电流Fig.10.Normalized excess base current of reverse Gummel with the traps model added to the interface of intrinsic base and below LOCOS.
4.360Coγ射线辐照实验结果对比分析
SiGe HBT 在不同工作模式下设置的偏置电压不同,在E/B 结与B/C 结处形成的电场方向不同,电离辐射诱发载流子的输运受到这些电场力的作用,造成最终陷阱电荷分布的差异.为探讨缺陷驻留方式对SiGe HBT 的影响,在60Coγ射线辐照过程中,分别为E/B 结与B/C 结设置正偏、零偏与反偏.具体为7 种偏置条件:1#样品VBE=+0.9 V,VBC=—2 V;2#样品VBE=+0.68 V,VBC=+0.65 V;3#样品VBE=+0.65 V,VBC=0 V;4#样品VBE=0 V,VBC=—1 V;5#样品VBE=0 V,VBC=+1 V;6#样品VBE=0 V,VBC=0 V;7#样品VBE=—2 V,VBC=—2 V.处于不同偏置条件的样品在接受累积剂量为1 Mrad(Si)的γ射线辐照后,分别进行正向Gummel 特性与反向Gummel 特性的测试.图11 给出了测试获得的正向和反向Gummel 特性分别在VBE=+0.6 V 与VBC=+0.4 V 时的归一化过剩基极电流.
由图11(a)可以看出,对于正向Gummel 特性,当B/C 结置于反偏时,E/B 结反偏辐照后的归一化过剩基极电流大于E/B 结零偏,E/B 结正偏的值最小,即7# > 4# > 1#;当B/C 结置于正偏时,也表现出E/B 结反偏辐照后的归一化过剩基极电流大于E/B 结零偏的特征,即5# > 2#;当B/C 结置于零偏时,变化规律相同(6# > 3#).当E/B 置于相同偏置时,辐照后的归一化过剩基极电流则表现出B/C 结零偏大于正偏大于反偏.E/B 结正偏,形成了从基区指向发射区的电场,伽马射线辐照在EB spacer 氧化层中电离产生的空穴向着远离基区的方向输运,形成的氧化物陷阱电荷对E/B 结耗尽区的影响较小,因此1#,2#,3#样品的基极电流退化最小;E/B 结反偏时则正好相反,空穴输运至基区与EB spacer 的Si/SiO2界面形成正陷阱电荷,其引起的空间电场使E/B结耗尽区扩大,基极电流退化增强,7#样品基极电流退化较为严重.说明SiGe HBT 总剂量效应影响下正向Gummel 特性的退化主要受到EB spacer氧化层与基区界面陷阱电荷的影响,数值模拟分析得出的结论与之符合.

图11 60Co γ 射线辐照后不同偏置条件样品的归一化过剩基极电流 (a)正向Gummel 测试;(b)反向Gummel 测试Fig.11.Normalized excess base currents of SiGe HBT after γ irriadition in different biases:(a) Forward Gummel;(b) reverse Gummel.
根据图11(b)对反向Gummel 特性进行了分析,B/C 结正偏时形成从基区指向集电区的电场,在B/C 结耗尽区附近的Si/SiO2界面形成氧化物陷阱电荷,引起基极电流中的复合电流增加,因此2#样品和5#样品辐照后的归一化过剩基极电流最大;B/C 结反偏时电场由集电区指向基区,氧化层中电离的空穴沿这一电场方向运动,被氧空位捕获形成的陷阱电荷概率更大地分布在“鸟嘴”效应区域附近,这一部分氧化层较薄,与基区接触面积也有限,感生缺陷形成的空间电场对耗尽区中基极复合电流影响较小,因此1#样品和4#样品的归一化过剩基极电流最小.说明电离辐射在LOCOS隔离氧化层与基区界面处诱发的陷阱电荷是造成SiGe HBT 反向Gummel 特性退化的主要原因,数值模拟的结果也符合这一结论.
5 结论
本文使用 TCAD 仿真工具进行γ辐照对国产SiGe HBT 总剂量效应影响的数值模拟研究.结果表明,基极电流增加是SiGe HBT 总剂量效应引起器件电学特性退化的原因,基极电流的变化趋势也同实验结果相似.不同偏置在器件内部引入的电场不同,造成辐射电离产生的载流子的输运方向不同,引起陷阱缺陷分布位置不同,从而影响基极电流退化,并非所有位置引入的陷阱电荷都会造成基极电流的增加,而正向Gummel 特性与反向Gummel 特性对陷阱电荷的分布位置的响应也有所差别.其中EB spacer 氧化层中产生的陷阱电荷主要影响正向Gummel 特性,而LOCOS 隔离氧化层中的氧化物陷阱正电荷则造成反向Gummel特性的退化.数值模拟获得的SiGe HBT 总剂量效应损伤机制与不同偏置下60Coγ辐照实验分析结论符合得较好.

