硅基光子调制器研究进展
胡祥建 冯 松 冯露露 王 迪 刘 勇陈梦林 丁斌斌 韩 超 韩小祥
(西安工程大学理学院 西安 710048)
1 引 言
光子调制器是光子集成的核心器件,特别是在通信领域,它具有将电数据写入光载波的功能。随着硅光子技术的快速发展,世界各大研究机构都开始研发各种高性能的器件[1-3],而调制器作为通信领域的核心器件之一,引起了全世界的关注。目前,对调制器的研发集中于亚微米绝缘体上硅(Silicon On Insulator,SOI)波导。然而,亚微米 SOI 波导存在高光纤耦合损耗、高偏振相关损耗、大波导双折射和相位噪声等问题[4-7]。现有亚微米器件的一些缺点,可能成为实现下一代片上光互连器件的主要障碍,用亚微米 SOI 波导集成的器件要克服这些障碍仍需做大量的研究工作。硅基高速光子调制器是一个关键构建模块,可以为未来的光互连和通信系统提供解决方案。
一般来说,硅基光子调制器的调制机制分为两种:强度调制和相位调制。强度调制主要通过改变电压、温度等偏置条件,来改变折射率的大小从而进行调制;相位调制主要是在调制器中加入移相器,通过改变电压大小,使吸收系数发生改变进而实现调制。与强度调制相比,相位调制由于采用干涉技术而具有很高的检测灵敏度和极大的动态测量范围,抗干扰能力强;且调制器形式灵活多样,可适用于多种物理量和不同的测量环境,因而被广泛使用。硅基光子调制器可以采用 SOI 材料、锗硅(SiGe)材料、锗(Ge)材料、铁电材料、有机光电材料、III-V 族材料和石墨烯材料等进行制作。化学气相沉积(Chemical Vapor Deposition,CVD)法是常用的外延材料制备技术,其中,减压化学气相沉积(Reduced Pressure Chemical Vapor Deposition,RPCVD)法具有成本低、效率高、薄膜质量好等优点,是适合工业量产的外延工艺之一。早在 2011 年,中国科学院卞剑涛的课题组已提出采用 RPCVD 法在 Si 衬底上生长出高质量的 Ge 薄膜[8]。同年,兰州大学陈达的课题组也采用 RPCVD 法在硅(Si)衬底上制备出了组分约为 20% 的高质量 SiGe 薄膜[9]。此外,制备 SiGe 薄膜的方法还有分子束外延(Molecular Beam Epitaxy,MBE)以及超真空化学气相沉积(Ultra High Vacuum Chemical Vapor Deposition,UHVCVD)。磁控溅射是物理气相沉积(Physical Vapor Deposition,PVD)的一种,一般的溅射法可用于制备金属、半导体、绝缘体等多种材料,且具有价格低廉、适应性强、制备技术成熟的特点。对于单晶薄膜,磁控溅射已经实现了钛酸盐系、铋系单晶薄膜的制备,以及低居里温度的铁电薄膜的制备,且具有设备简单、易于控制、镀膜面积大和附着力强等优点。通过磁控溅射已经实现的铁电薄膜有铌酸锂(LiNbO3)、钛酸钡(BaTiO3)等。分子束外延是一种在晶体基片上生长高质量晶体薄膜的新技术,具有能精确控制厚度、结构与成分,以及形成陡峭的异质结构等优点。2015 年,上海大学杨文献的课题组提出基于分子束外延方法制备高质量的 InGaAsP 薄膜[10]。自单层及多层石墨烯发现以来,石墨烯的制备便受到广泛关注。石墨烯的制备方法一般有3 种:机械剥离法;化学合成法,如 CVD 法和氧化还原法等;特殊的制备方法,如有机合成和碳纳米管轴向切割法等。
近年来,硅基光子调制器的性能有了显著提升。但采用传统硅材料制成的调制器,其调制速度并不理想,这是由于硅材料没有一阶电光效应,且高阶电光效应十分微弱。因此,采用传统硅材料制成的调制器一般都是基于等离子色散效应。等离子色散效应是指在外加电场的作用下,使有源区的自由载流子浓度发生改变,进而改变输出光波的幅值和相位,从而实现电光调制。但是,由于受到载流子本身寿命的限制,调制器的速度并不是很高,因此,采用其他材料或结构制成调制器的研究已迫在眉睫。随着硅基半导体工艺的发展,硅基光子调制器已经成为了主流器件。通过大量实验证明,将其他材料与 SOI 波导结合,实现调制的混合器件已经取得了长足的进展,包括 III-V 族材料[11]、聚合物[12]、Ge[13]和石墨烯[14]等材料。为进一步研究硅基光子调制器,本文对基于 SOI 材料、SiGe 材料、Ge 材料、铁电材料、有机光电材料、III-V 族材料以及石墨烯材料等硅基光子调制器的研究现状进行了讨论,并对相关调制器的调制速率、插入损耗、消光比等参数进行了对比和分析,为未来继续研发高速率、低损耗的光子调制器提供了思路。
2 基于 SOI 材料的调制器
SOI 是指在具有绝缘层的硅衬底上生成一层单晶硅薄膜,或是通过绝缘层(通常为 SiO2)将单晶硅薄膜与支撑的硅衬底分离的一种材料。基于硅材料和硅集成电路制造方面的成功经验,SOI 技术具有其独特的优势。采用 SOI 材料所制备的 CMOS 器件具备良好的无闩锁效应及低功耗、高运行速率等优点,其也是制备微纳米光子器件的理想衬底材料。近年来,随着商用光电子与微电子技术的快速发展,SOI 技术已成为商用光电子和微电子领域的主流技术,已被广泛应用于光波导器件、光通信器件、抗辐照硅集成电路和高速微电子集成器件等重要的商用信息技术领域,是国际公认的“21 世纪的半导体新技术”。
2012 年,英国萨里大学 Thomson 的课题组首次提出了调制速率为 50 Gb/s 的硅光调制器[15]。该调制器是在马赫-曾德尔(Mach-Zehnder,MZ)干涉仪中加入相位调制器得到的,通过实验仿真,结果显示该调制器在波长为 1 550 nm 处,其消光比为 3.1 dB,相应的插入损耗约为 3.7 dB。相位调制器截面图如图 1 所示,该器件设计的一个关键优点是制造过程相对简单,其被设计成内脊高为 220 nm、脊宽为 400 nm、平板高度为100 nm 的脊型波导结构。与平板高度为 50 nm 的器件相比,100 nm 的平板高度具有更低的接触电阻和侧壁粗糙度。该器件脊型区和一侧的平板区是 P 型掺杂,另一侧的平板区是 N 型掺杂,由于P 型区域的掺杂浓度低于 N 型区域,使得在反向偏压条件下,耗尽层主要延伸到脊型区,这种掺杂比例可以有效降低插入损耗。
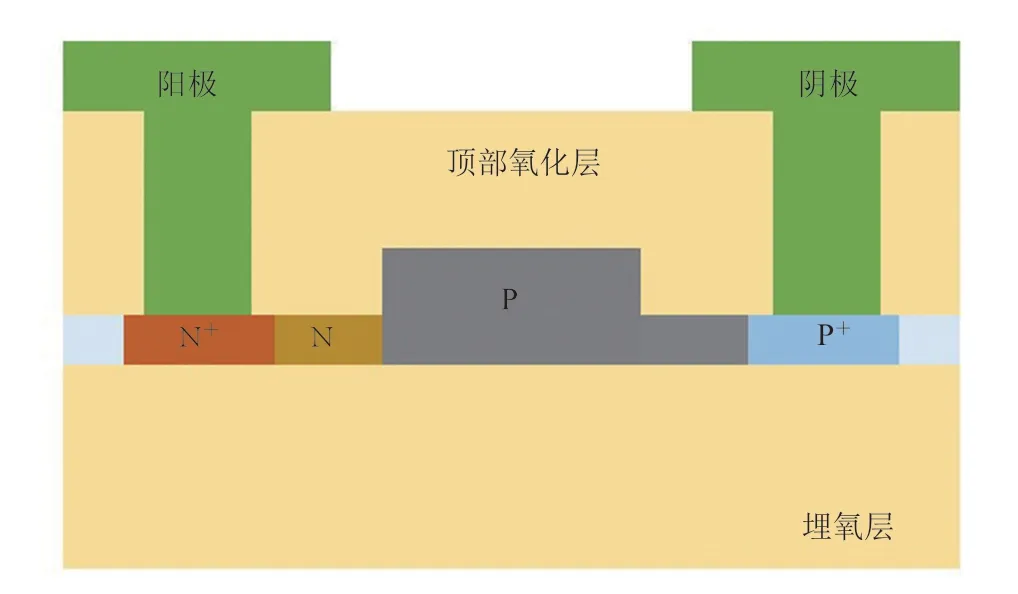
图1 相位调制器截面图Fig. 1 Cross section of phase modulator
2013 年,中国科学院半导体研究所 Xiao 的研究小组设计了一种在 1 550 nm 波长下工作,基于横向 PN 结结构的高速硅 MZ 调制器[16],调制速率高达 60 Gb/s,该速率是目前报道中通信波段单个调制器芯片的最高速率。该调制器是在200 mm 厚的 SOI 晶圆上制备的,顶层硅厚度为340 nm,埋氧层厚度为 2 μm,该调制器的截面图和俯视图如图 2 所示。

图2 MZ 调制器的截面示意图和俯视图Fig. 2 Section diagram and top view of MZ modulator
2018 年,英国南安普顿大学 Cao 的课题组设计了在 1 950 nm 波长下,基于 SOI 材料的高速调制器[17]。该调制器被设计成基于 PN 结结构的 MZ 干涉仪,其调制速率为 20 Gb/s,该速率是目前报道中红外调制器的最高速率。通过实验仿真,结果显示该调制器在 1 950 nm 波长处的插入损耗为 13 dB,明显高于 1 550 nm 波长处的插入损耗值(4 dB),这种差异是因为波导在直接穿过金属层下面区域时被金属吸收。该结构的波导层顶部和金属层底部之间的垂直距离只有 600 nm,在 1 950 nm 波长处的光学模场较大,因此与金属之间存在较大的重叠。由于带宽的限制,该实验无法获得在 2 μm 波长下,调制器速率大于20 Gb/s 的眼图数据,但由于 PN 结在 1 950 nm和 2 μm 波长处的带宽非常相似,因此,该实验预测所设计的调制器可以具有更高的调制速率。该调制器的截面图如图 3 所示,器件是在顶层硅厚度为 220 nm 的 SOI 波导上制作的,脊波导宽为 550 nm,平板区刻蚀深度为 90 nm。PN 结位于波导的中心,高掺杂区宽度分别为 1.125 μm(N型)和 1.025 μm(P 型),图中 N、P、N+、P+区域的掺杂浓度分别为 3e17 cm-3、8.5e17 cm-3、le20 cm-3和 le20 cm-3。
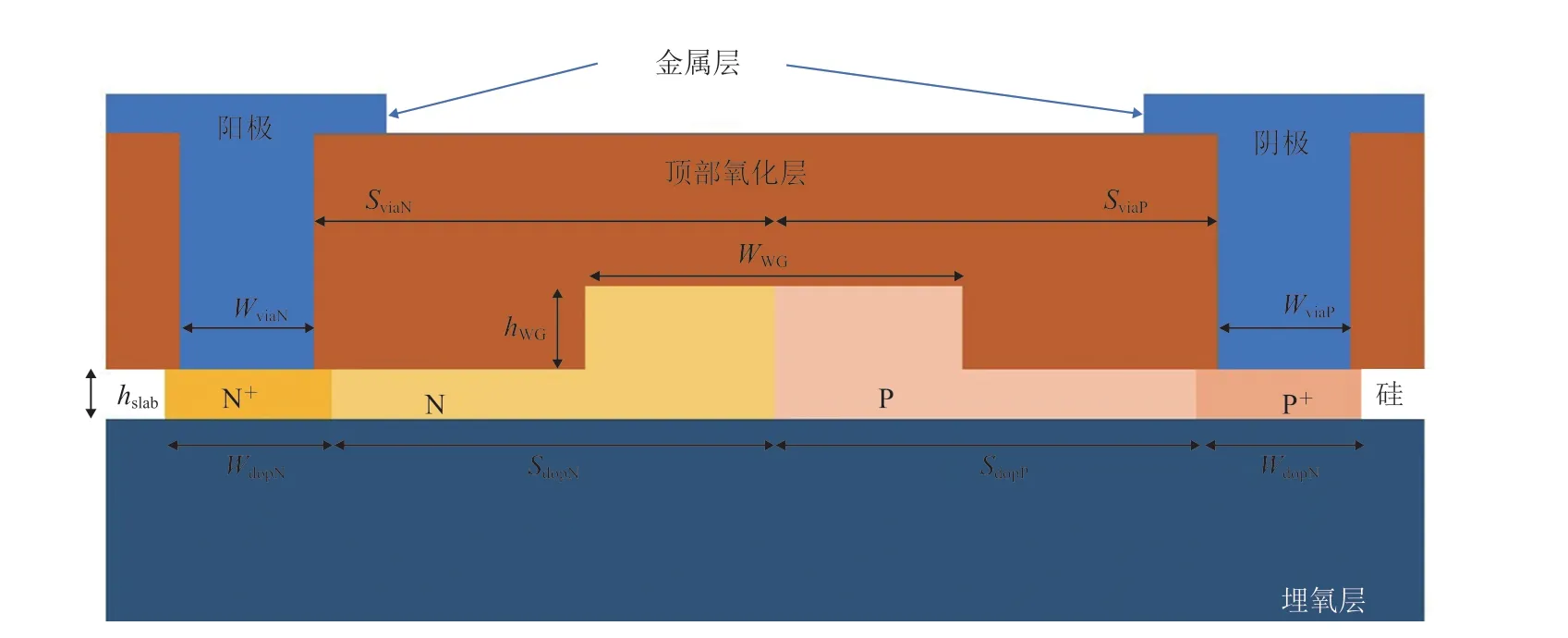
图3 MZ 调制器的横截面Fig. 3 Cross section of MZ modulator
2019 年,日本富士通实验室 Sobu 的研究小组提出了一种基于载流子注入等离子色散效应的 Si MZ 调制器[18]。该调制器是基于带无源电阻电容(Resistor-Capacitor,RC)均衡器的正向偏置 PIN 二极管的设计,通过对其改进制作了一种Si MZ 调制器,证明了在 50 Gbaud 以上高速运行的可行性。图 4 为 Si MZ 调制器截面图,基于掺杂脊波导的非对称 Si MZ 调制器结构是在 SOI 晶片上制作的,该晶片由一个 220 nm 厚的 Si 层和一个 3 µm 厚的埋氧层组成,正向偏置的 PIN 移相器在 480 nm×220 nm 波导的芯层内有一个未掺杂的本征区。通过在无源均衡器的电容器中引入金属-绝缘体-金属(Metal-Insulator-Metal,MIM)结构,实现了 37.5 GHz 的 3 dB 带宽,调制效率测量为 2 V·cm。在大信号实验中,当消光比大于1.38 dB 时,获得了高达 70 Gbaud 不归零编码信号的清晰眼图。这些结果都清楚地表明了全硅调制器用于高速和低功耗芯片的可行性。

图4 Si MZ 调制器的截面图Fig. 4 Cross section of Si MZ modulator
为了对 SOI 材料调制器进行更为清晰的对比,表 1 列出了近年来基于不同调制结构的 SOI 光子调制器的性能参数。由表 1 可知,在 1 550 nm的工作波长下,Xiao[16]和 Timurdogan[19]等人设计的光子调制器的插入损耗较低,均为 1.20 dB;此外,与其他工作在 1 550 nm 波长下的光子调制器相比,Xiao 等[16]设计的光子调制器还具有较高的调制速率以及较大的带宽(3 dB)。

表1 调制器性能参数Table 1 Modulator performance parameters
3 基于 SiGe 材料的调制器
目前,采用传统硅材料制成的调制器的调制速率已经达到 50 Gb/s,但进一步提高调制速率是十分困难的。与 Si 材料相比,SiGe 材料具有更高的载流子迁移率,其制备工艺与 CMOS 工艺相兼容,且材料本身具有很强的电吸收(EA)效应,利用弗朗兹-凯尔迪什(Franz-Keldysh,FK)效应或量子限制斯塔克效应,就可以使其工作在吸收边界波长处。SiGe 材料作为一种制作高速率器件的理想材料,具有调制带宽大、调制效率高、消光比高、插入损耗低等优点,尤其在中红外波段方面有着良好的应用前景。
2012 年,美国 Kotura 公司和 Sun 实验室联合演示了一种高速 SiGe 电吸收调制器[30]。该调制器利用 FK 效应,采用水平 P-I-N 结构,设计集成在一个 3 μm 厚的 SOI 波导上,其工作波长为 1 546~1 581 nm。当波长为 1 550 nm、摆幅电压为 2.8 V 时,器件的插入损耗为 5.0 dB,消光比为 6.0 dB。该器件在 1 550 nm 波长处的插入损耗较大,损耗主要来源于没有施加电压时 SiGe的吸收损耗,以及 Si 波导和 SiGe 波导之间的模式失配损耗。3 dB 带宽测量结果表明,该器件在2.8 V 反向偏压下,3 dB 带宽为 40.7 GHz。其结构示意图如图 5 所示,当光从脊 SOI 波导传播到调制区域时,在有源区(SiGe)被吸收,吸收的量取决于 P-I-N 结的施加电压大小。这种水平的P-I-N 结构使得 SiGe 区域非常狭窄,降低了实现高消光比所需的摆幅电压。通过实验测量发现,该调制器的漏电流很大,产生这种高漏电流的一个可能原因是 SiGe 和 Si 之间的界面处存在过高的缺陷密度;另一个可能原因是钛/铝金属在干法刻蚀后存在金属残留。通过优化 SiGe 材料的生长和后退火条件,或是对钛/铝金属进行过度刻蚀来除去金属残留,可以显著降低漏电流。这种器件的优点是体积小、速度快、功耗低。
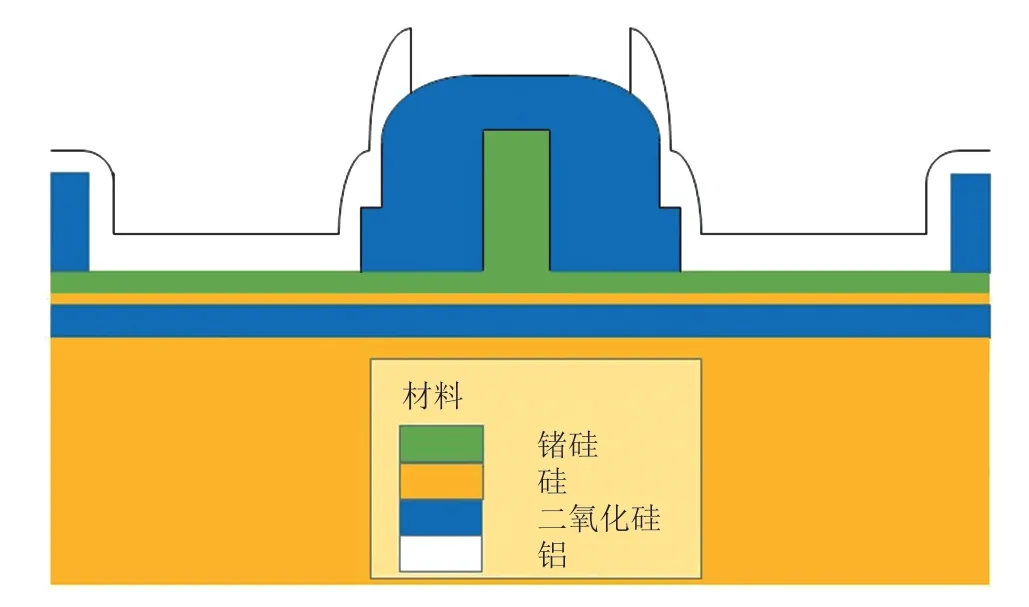
图5 SiGe FK 调制器截面图Fig. 5 Cross section of SiGe FK modulator
2016 年,比利时根特大学 Srinivasan 的课题组采用了与 Ge 波导电吸收调制器[31]类似的横向 P-I-N 二极管设计,演示了一种调制速率为50 Gb/s 的 SiGe 波导电吸收调制器[32]。其截面示意图如图 6 所示,该调制器宽度为 0.6 μm、长度为 40 μm,集成在 220 nm 厚的 SOI 波导上。通过实验仿真,结果表明,SiGe 电吸收调制器在室温下的最佳工作波长为 1 560 nm。其 3 dB带宽大于 50 GHz,在-1 V 偏置电压下结电容为 13.8 fF。当摆幅电压为 2 V 时,直流消光比为(4.2±0.3)dB,插入损耗为(4.4±0.6)dB,链路功率损耗为 8.5 dB。当调制速率为 50 Gb/s 时,该实验还在波长为 1 560 nm、摆幅电压为 2 V的条件下,测试出了该调制器的动态消光比为3.0 dB。

图6 SiGe 电吸收调制器截面图Fig. 6 Cross section of SiGe electro absorption modulator
2016 年,西安工程大学冯松的课题组提出了一种新型 Si/SiGe/Si 双异质结 P-I-N 电学调制结构[33],该结构波导宽度W为 450 nm,平板高h为 50 nm,内脊高H为 220 nm,其中,N+、P+以及 I 的掺杂浓度分别为 1e19 cm-3、1e19 cm-3、1e15 cm-3,Ge 含量为 0.2。其结构示意图如图 7所示,通过模拟仿真其载流子浓度与调制电压的关系,对比 SiGe-OI 以及 SOI 两种 P-I-N 电学调制结构发现,这种双异质结 P-I-N 电学调制结构可以在更小的调制电压下获得更高的载流子注入效率,且更便于调制,可有效减小调制电压并进一步降低调制功耗。
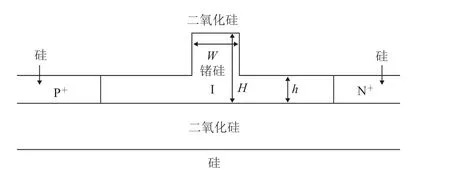
图7 Si/SiGe/Si 双异质结Fig. 7 Si/SiGe/Si double heterojunction
2018 年,英国南安普顿大学 Mastronardi 的课题组提出了一种在 1 566 nm 波长下工作的低功耗 Si/SiGe 异质结电吸收调制器[34]。该调制器基于 FK 效应,尺寸为 1.5 µm×40 µm。在调制速率为 56.2 Gb/s 下对该调制器进行测量,测量结果表明该调制器具有 5.2 dB 的动态消光比和44 fJ/bit 的调制功率。此外,56 GHz 的 3 dB 带宽证明了该设计方法在高速应用方面的领先能力。该调制器选用了一种环绕式 P-I-N Si/SiGe 异质结构,并在 800 nm 厚的 SOI 平台上实现。其结构示意图如图 8 所示,在一个宽 1.5 μm 的脊波导上集成了一个二极管,P 掺杂定义在一个 100 nm厚的硅层(绿色),本征区(总厚度 600 nm)包括底部的 Ge 层(黑色)和 SiGe 区域(金色),其中 N掺杂(厚度为 100 nm)沿着脊波导顶部的轮廓(橙色/红色区域)。显然,这种设计是有利的,因为电场分布与波导宽度无关,并且还可根据需要对波导宽度进行调整,以改善光学模式的偏振和光学约束的传播。这种异质结结构的设计也为高速紧凑型电吸收调制器提供了一种简单、可定制的制造工艺。
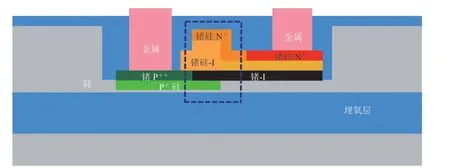
图8 调制器横截面示意图Fig. 8 Cross section diagram of modulator
表 2 为近年来基于同种材料的 SiGe 光子调制器的性能参数。由表 2 可知,对于相同材料、相同结构且都采用 FK 效应制作的调制器,其各方面性能有所不同,是因为 SiGe 在整个 Si 中含量的占比大小,会直接影响器件调制速率的大小。此外,SiGe 里 Ge 的含量虽相比于 Si 占比很小,但由于 Ge 的迁移率比 Si 的迁移率快得多,因此,Ge 含量越高,载流子迁移率越高,通过调节 Ge 的含量大小可以优化器件特性 。但并不是 Ge 的含量越高越好,因为 Ge 存在吸收损耗,会使调制器具有较大的损耗,所以一般调制器都是采用低 Ge 含量设计的。

表2 调制器性能参数Table 2 Modulator performance parameters
4 基于纯 Ge 材料的调制器
Ge 材料主要应用于半导体电子器件、光导纤维、红外元器件、太空用太阳能电池等领域。与 Si 材料相比,Ge 材料在大功率器件中具有明显优势。目前,基于 Ge 材料制备的红外器件已应用于军事遥感和空间科学技术,如红外通信、红外侦察及各种军事目标的侦测与搜索等。Ge 材料具有很强的电吸收效应,利用这种效应,很多于 Ge 材料的高速调制器进行了研究。


图9 Ge 电吸收调制器的截面示意图和俯视图Fig. 9 Cross section and top view of Ge electro absorption modulator
2015 年,比利时根特大学 Srinivasan 的课题组研发了一种带宽超过 50 GHz 的 Ge 波导电吸收调制器[31]。该调制器利用 FK 效应,在 1 610 nm 的工作波长下,调制速率高达 56 Gb/s。对其施加2 V 的驱动电压,可实现高达 3.3 dB 的动态消光比,该器件的结电容仅为 12.8 fF,静态功耗为1.2 mW。通过相关实验得出,该调制器在实现以 56 Gb/s 或更高速率进行短程光互连的高密度和低功率硅光子收发器方面具有巨大的潜力。如图 10 所示,该调制器集成在 220 nm 厚的 SOI 平台上,采用 RPCVD 法在 110 nm 深的凹硅区选择性地生长 Ge。晶圆经过退火以降低螺纹位错密度,Ge 层经过化学机械抛光,最终厚度为 350 nm。Ge 通过离子注入形成 N 型和 P 型区域。由于 Ge外延层与 Si 衬底之间热膨胀系数不匹配,Ge 电吸收调制器显示出 0.2% 的拉伸应变,将带隙从0.8 eV(1 550 nm)移动到 0.78 eV(1 580 nm),其在 Pantouvaki[40]和 Ishikawa[41]等人的研究中均有相关验证。
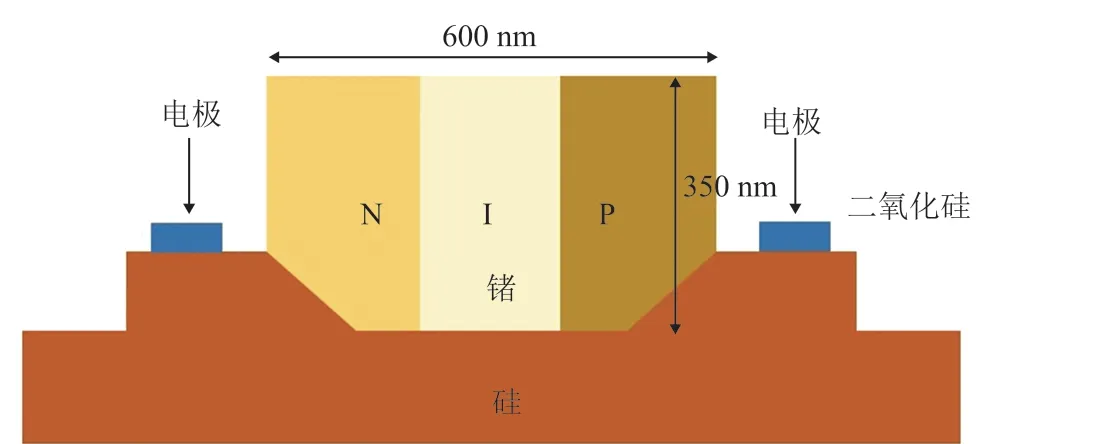
图10 集成在 220 nm 厚的 SOI 平台上的 Ge 电吸收调制器的截面示意图Fig. 10 Cross section diagram of Ge electro absorption modulator device integrated on 220 nm SOI platform
表 3 为近年来基于相同材料的 Ge 光子调制器的性能参数。从 Liu 等[42]的研究可知,电吸收调制器的 3 dB 带宽仅受器件 RC 时间常数的限制,减小器件电容是实现更高调制速度的有效途径。当增大反向偏置电压时,器件的本征区由于载流子耗尽而增大,因此 P-I-N 结的电容减小,这使得 RC 时间常数更小,调制速度更高。为了得到更高的调制速度,可以将其尺寸设计得更小,但这对其工艺的要求较高;或可通过合理设计器件电极,减小器件电容来实现更高的调制速度。

表3 调制器性能参数Table 3 Modulator performance parameters
5 基于铁电材料与有机光电材料的调制器
铁电材料具有优异的物理性能,其除具有铁电性外,还具有声光效应、光电效应和非线性光学效应等性能,可用于制备传感器、波导管等器件。铁电材料拥有广阔的应用前景,因而备受关注。
有机光电材料具有带宽大、响应速度快、驱动电压低、介电常数低、电光系数大和易于加工等优点。这些优势是无机/半导体材料所无法媲美的,因此,有机光电材料受到了广泛的关注,并被认为是制备高性能电光器件和实现超高带宽以及信息快速处理传输的关键。
5.1 LiNbO3 与硅光子集成
LiNbO3晶体是一种多功能铁电材料, 具有良好的声光、非线性光学、电光等特性,被称为光子学领域中的“硅”。基于 LiNbO3材料的集成光子学平台,由于其出色的光学特性,已被广泛应用在快速电光调制、非线性光学频率转换和频率梳生成等方面。LiNbO3作为一种被广泛应用的调制器材料,可以实现带宽大于 35 GHz 的高速调制器[44-45],且这类调制器已长期应用于光纤网络中[46]。
2019 年,中山大学 He 的课题组提出了一种混合 Si/LiNbO3MZ 调制器。该调制器使用了两层混合集成波导和垂直绝热耦合器[47]。垂直绝热耦合器可以在 Si 波导和 LiNbO3波导之间进行光信号传输,这种方法有效地利用了 LiNbO3膜。该器件具有电光带宽大、调制效率高、片上插入损耗低等优点,为未来高速、节能的光通信网络开辟了新途径。此高性能调制器通过基于 LiNbO3波导与低损耗硅电路的无缝集成来实现。通过仿真实验,成功得到了高达 100 Gb/s 的开关键控调制和高达 112 Gb/s 的四级脉冲振幅调制。LiNbO3波导截面示意图如图 11 所示,LiNbO3波导作为该器件中最关键的组成部分,必须进行优化,以实现高调制效率和低光损耗。所制作的波导的顶部宽度为w=1 µm,平板厚度为s=420 nm,脊高为h=180 nm,波导和电极之间的间隙被设为2.75 µm。这些参数旨在实现调制效率和光学损失(包括金属吸收和侧壁散射损失)之间的平衡,电极以接地-信号-接地(Ground-Signal-Ground,GSG)的形式配置,其中,两个 LiNbO3波导分别位于接地和信号金属之间的两个间隙中。为了实现较大的电光带宽,电极以行波的方式操作,并优化了阻抗匹配,以及微波和光信号的速度匹配,电极的厚度设为t=600 nm,信号和接地电极的宽度分别设为ws=19.5 µm 和wg=30 µm。
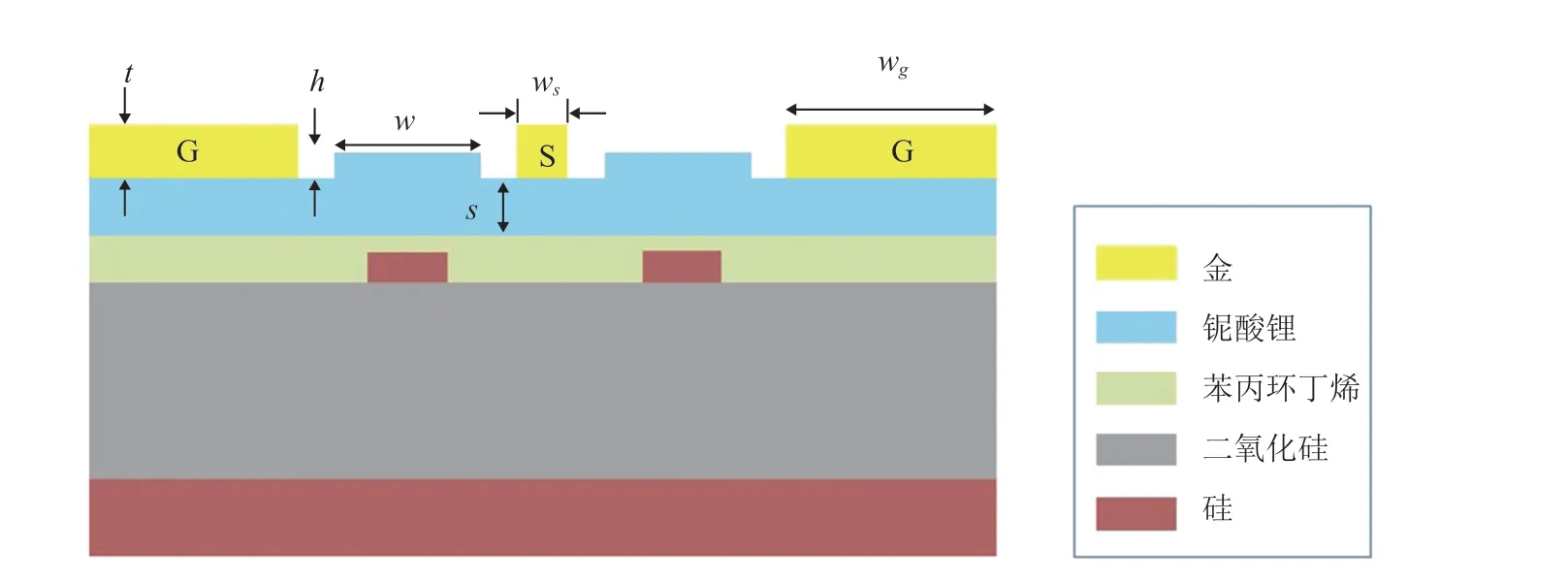
图11 LiNbO3 波导截面示意图Fig. 11 Schematic diagram of LiNbO3 waveguide section
5.2 BaTiO3 与硅光子集成
BaTiO3是一种很有希望与硅光子(Silicon Photonics,SiPh)平台集成的材料。BaTiO3具有较高的泡克尔斯(Pockels)系数(在大体积形式中,LiNbO3的 Pockels 系数仅为-30 pm/V,而 BaTiO3提供了高的 Pockels 系数(>1 000 pm/V))[48],具备与硅衬底集成的可行性,并有高速调制的能力[49]。BaTiO3材料还具有化学热稳定性[50]、可集成、低损耗[51]等优点。目前,Si/BaTiO3混合技术已取得了一些进展,包括低传输损耗的无源结构、有源光开关[49]以及在光子器件中[52-53]的高速调制等。
2018 年,瑞士 IBM 研究所 Eltes 的研究小组设计了一种基于硅衬底的 BaTiO3电光器件[53]。通过实验仿真,证实了在 Si/BaTiO3电光器件中存在 Pockels 效应,该小组还证实了相同的实验结果,可以采用 BaTiO3的 Pockels 系数(r42=923 pm/V)来复现,且所采用的 Pockels 系数是截至 2018 年所报道的 Si/BaTiO3电光器件中的最高值。Si/BaTiO3移相器的横截面如图 12 所示,其中,BaTiO3层厚度为 225 nm,二氧化硅层厚度为2 μm。首先,将 BaTiO3沉积在具有 100 nm 厚 Si层的 SOI 晶片上;其次,通过直接晶圆键合将BaTiO3和器件硅层转移到另一个具有厚热氧化物的硅片上;最后,在移除施主晶圆后,将硅层图案化为波导。其中,退火步骤确保了器件具有低的传输损耗。移相器是通过沿波导制作电极来施加平面内电场形成的。当 BaTiO3层以外延方式沉积时,器件的电光响应强烈依赖于外加电场、光场和晶体轴的相对方向。钛酸钡材料的这种各向异性是 Pockels 效应的一个关键特征,在以往的 Si/BaTiO3光子器件中还未被证实。为了探究这种各向异性,该实验设计了两种不同的波导几何形状,并最终得到超过 25 GHz 的强电光响应,展现出了其高速调制的巨大潜力。
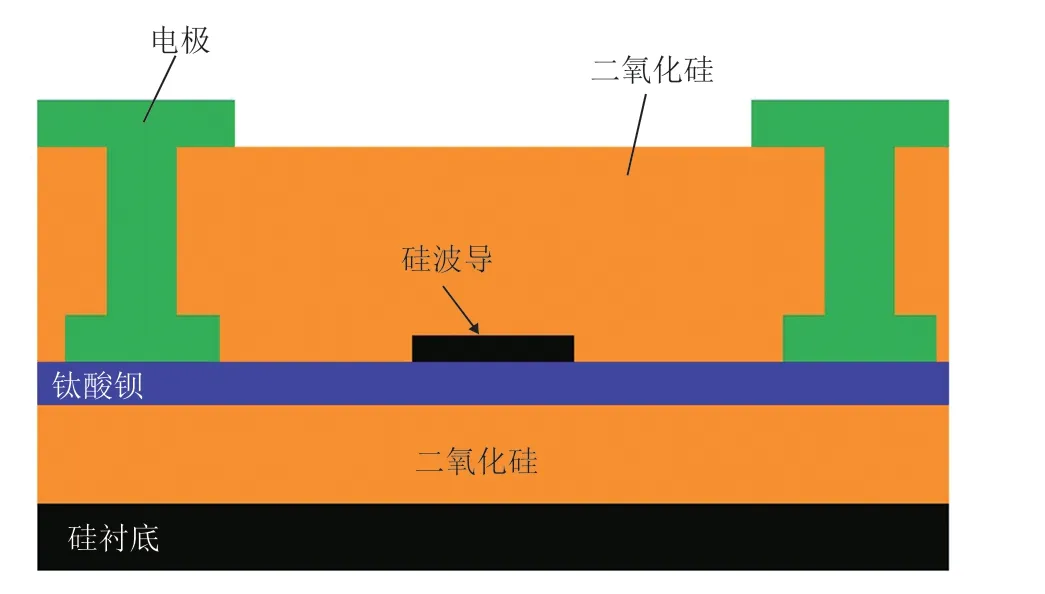
图12 Si/BaTiO3 移相器的横截面图Fig. 12 Cross section of Si/BaTiO3 phase shifter
5.3 有机光电材料与硅光子集成
2020 年,德国卡尔斯鲁厄理工学院 Kieninger的课题组演示了一种高效的硅有机混合体(Silicon-Organic Hybrid,SOH)MZ 调制器[54],该调制器是在新加坡 A*Star 微电子研究所(IME)200 mm 厚的 SOI 晶片上用紫外光刻制而成的。MZ 调制器的两臂各包含 280 µm 长的移相器,因此所制成的调制器面积小。移相器的插入损耗仅为 0.7 dB,这是迄今为止 SiPh 平台上高速 MZ 调制器所报告的最低移相器损耗。移相器截面示意图如图 13 所示,波导由两条宽度Wrail=240 nm、高度为 220 nm 的硅轨构成,再由一条宽度Wslot=130 nm 的狭缝从中隔开,两条硅轨通过高度为70 nm 的 N 掺杂硅板层与底部金属层的 GSG 传输线电连接,2 µm 厚的埋氧层将波导与硅基板分离。3 µm 厚的二氧化硅包层覆盖整个芯片,并在移相器上方选择性打开,用来沉积高效的有机光电(OEO)材料[55]。
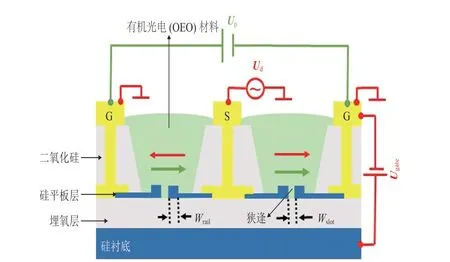
图13 移相器截面示意图Fig. 13 Section diagram of phase shifter
表 4 为近年来基于铁电材料与有机光电材料的调制器性能参数。对表 4 数据分析可得,与其他 Pockels 调制器相比,有机电光调制器具有较好的调制效率,Kieninger 等[56]所提出调制器的最低调制速率为 0.032 V·cm,且能耗明显低于混合 Si/LiNbO3电光调制器。混合 Si/BaTiO3电光调制器的调制效率要优于混合 Si/LiNbO3电光调制器,主要是因为 LiNbO3的 Pockels 系数要远小于 BaTiO3,而 Pockels 系数越大,器件的调制效率就越好。

表4 调制器性能参数Table 4 Modulator performance parameters
6 III-V 族材料
III-V 族材料与 SiPh 平台的集成是一个成熟的研究领域,因为它为激光源与硅光子的集成提供了一条可行的途径[58-60]。直接键合[58]、BCB辅助粘合剂键合[59]、III-V/Si 倒装芯片键合[60]是III-V/Si 集成的一些成熟的键合机制。III-V 与先进的 SiPh 平台集成已经被演示[61]。尽管 Si 和III-V 族材料之间存在很大的晶格失配,但也有III-V 在 Si 上的外延生长,III-V 族材料在 Si 上的集成也为实现高速调制器提供了一条途径[62],因为 III-V 族材料提供了较大的电子诱导折射率变化、高电子迁移率和低载流子等离子体吸收[63]。
2020 年,日本东京大学 Li 的课题组提出了一种具有反偏 III-V/Si 混合金属氧化物半导体(Metal Oxide Semiconductor,MOS)光学移相器的高效光学调制器[64]。该调制器是基于 FK 效应和载流子耗尽的 III-V/Si 混合 MOS 光调制器。通过将这两种效应结合起来,实现了与正偏 III-V/Si混合 MOS 光调制器相同的调制效率,以及较大的调制带宽和较小的能耗。图 14 为反偏 III-V/Si混合 MOS 光调制器示意图,该调制器是将 P 型Si 波导的顶部和一个薄的 N 型 InGaAsP 膜相连。其中,脊波导宽度为 1 μm,厚度为 220 nm,在Si 波导上的 InGaAsP 层厚度为 200 nm。通过实验仿真分析,反向偏置的 III-V/Si 混合 MOS 光调制器的调制效率为 0.12 V·cm,其电容为正向偏置情况下所需的一半,且所提出的 III-V/Si 混合MOS 光调制器有望达到超过 100 GHz 的带宽,能耗低于 100 fJ/bit。
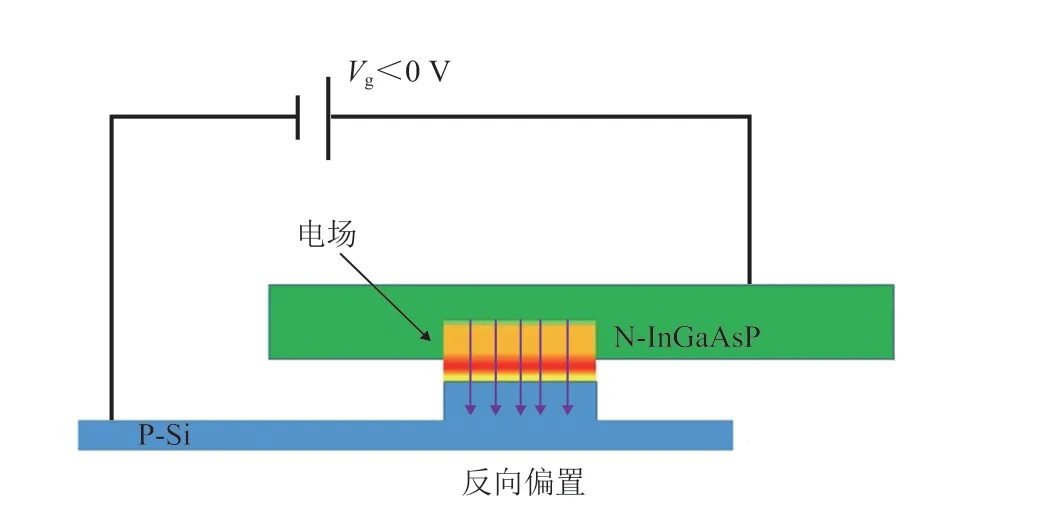
图14 反偏 III-V/Si 混合 MOS 光调制器示意图Fig. 14 Schematic diagram of reverse bias III-V/Si hybrid MOS optical modulator
7 基于石墨烯材料的调制器
石墨烯是二维碳的同素异形体,在其固有状态下可吸收光的带宽范围从紫外到远红外线。然而,在掺杂石墨烯中,通过状态填充和相应的泡利阻塞可以有效地减少吸收,特别是在红外频率下。石墨烯即使只有一个原子层,也能吸收2.3% 正常入射的紫外线和可见光[65]。这个普遍的吸收系数是由于狄拉克费米子独有的线性和无隙带色散[66]。尽管这种吸收很小,但利用石墨烯的各向异性的吸收特性以及由此产生热电子的新型无源光电子技术(包括锁模激光器、偏振器和光电探测器在内)已经得到了验证[67-70]。
7.1 单层石墨烯结构
2018 年,比利时根特大学 Alessandri 的课题组制作并仿真了速度为 20 Gb/s 的单层石墨烯-硅电吸收调制器[14]。调制器采用石墨烯-氧化物-硅(Graphene-Oxide-Silicon,GOS)结构,该结构位于嵌入在 SiO2中的平面化掺杂 Si 波导之上。该调制器在 1 520~1 590 nm 波长范围内和零偏压下,具有 4.4 dB 消光比和 16.0 GHz 的 3 dB 带宽。单层石墨烯电吸收调制器示意图与等效电路模型如图 15 所示,该设备运行速度为 20 Gb/s,当施加2.5 V 电压时,测得的动态消光比为 1.8 dB。
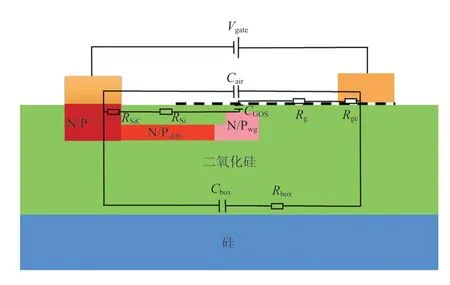
图15 单层石墨烯电吸收调制器的示意图与等效电路模型Fig. 15 Equivalent electrical model of the monolayer graphene electro absorption modulator
由于环境和聚合物污染,未钝化的石墨烯[71]通常具有高浓度的 P 掺杂。当石墨烯和 Si 接触,并在 GOS 电容上施加电场时,石墨烯中性点会向负偏压方向偏移,从而导致低正偏置下具有低电阻。从电光角度来看,石墨烯上的 P 掺杂也具有优势。在 P 掺杂的石墨烯中,光透射的最小值向负偏压方向偏移。因此,在大约 0 V 到较低的正偏置(2 V)范围内,会发生 on 和 off 状态之间的切换,而不是高的正向偏置或反向偏置。为了在低正向偏压下降低石墨烯电吸收调制器的电容,可以使用 P 掺杂 Si 波导。GOS 电容器在负直流偏置下进行累积工作,并在低正向直流偏置时切换到耗尽状态,从而使石墨烯电吸收调制器工作区域的电容更低。为了优化电阻和电容之间的平衡,并使 RC 常数最大化,通过优化 Si 波导和接触板的掺杂水平,可进一步改进该器件。
7.2 双层石墨烯结构


图16 双层石墨烯光调制器示意图Fig. 16 Schematic diagram of double layer graphene light modulator
表 5 为近年来基于不同结构的石墨烯光子调制器的性能参数。由表 5 可知,双层石墨烯调制器的 3 dB 带宽明显高于单层石墨烯调制器,且双层石墨烯调制器的消光比明显高于单层石墨烯调制器。由于高的宽带是石墨烯材料重要的优势之一,所以随着石墨烯层数的增加,其 3 dB 带宽也会随之变大。对于相同调制结构的单层石墨烯调制器,器件的结构设计不同,器件的性能也有所差别。

表5 调制器性能参数Table 5 Modulator performance parameters
8 结 论
基于 Si、Ge 的 FK 效应或量子限制斯塔克效应所制成的电吸收调制器,其器件尺寸可以达到微米级别,FK-电吸收调制器提供了 100 Gb/s的调制速率,但这些调制器的消光比和光学带宽十分有限。LiNbO3、BaTiO3、石墨烯和有机薄膜具有较高的 Pockels 系数,为线性和无啁啾高性能的 SiPh 调制器铺平了道路。早期研究结果表明,将 LiNbO3、BaTiO3材料集成在 Si 上可以获得良好的性能,有机光电材料在 Si 上的集成也达到了 100 Gb/s 的调制速率和较高调制效率。据报道,在解决器件寿命方面也取得了长足进展,但在有机电光材料的高速调制器商业化之前,需要进行更多的研究与发展。将 III-V 族材料与 Si结合,可以充分利用两者的优点来实现 MOS 型相位调制器和电吸收调制器。在 MOS 型光调制器中,调制带宽和能耗存在一种相互制衡的关系。而高调制带宽需要 MOS 结中具有较小的电容,但是这会限制调制效率,增大驱动电压,导致能耗过高。由于石墨烯独特的电子结构和二维特性,在该材料中尚未发现较强的 EA 效应,这意味着石墨烯有作为电吸收调制器活性介质的潜力。然而,单层石墨烯调制器所面临的挑战之一是单层的石墨烯对光的吸收有限。可通过将石墨烯与光波导集成来解决该问题,光波导通过倏逝波与石墨烯之间的耦合大大增加了相互作用的长度。据相关文献报道,多层石墨烯的调制器在一些重要性能参数上要明显优于单层石墨烯的调制器。
本文主要围绕硅基光子调制器,对近年来国内外一些调制器件的研究成果进行了陈述,对不同材料的光子调制器进行了研究与分析,对采用相同材料的调制器性能差异进行了对比。光子调制器作为光纤通信系统的核心器件,实现其高调制速率、低驱动电压以及低插入损耗,仍是目前需要解决的问题。近年来,国内外进行了大量的基于 SOI 材料、Ge 材料、SiGe 材料、铁电材料、有机光电材料、III-V 族材料以及新型二维材料石墨烯调制器的研究,可实现器件的高速调制以及获得更低的插入损耗,为未来继续发展高速率、低损耗的光子调制器提供了思路,也为其他光子器件的研发提供了技术参考。由于硅光子技术的发展,全球范围内涌现出了很多高性能的调制器,而采用传统硅材料的调制器已经不能满足日益快速发展的光通信技术以及光互连技术,基于其他材料及结构的调制器必将不断出现,同时,现有器件与制造工艺的兼容性也将不断提高。

