辐照对MOSFETs栅介质阈值电压漂移的影响研究
杨 燚,赵 凯,2,赵钰迪,董俊辰
(1.北京信息科技大学 智能芯片与网络研究院,北京 100192;2.北京大学 微米纳米加工技术国家级重点实验室,北京 100871)
0 引言
集成电路中晶体管小型化发展使得传统硅基器件逐渐接近物理极限和性能极限,硅的替代半导体材料成为研究的热点[1]。在空间辐照等特殊工况下,器件的性能及可靠性受到带电粒子、γ射线、X射线等的显著影响[2]。近年来随着集成电路工艺进入到纳米尺度,为了减小栅介质漏电,高k栅介质材料得到了广泛应用,然而器件的抗辐照设计也变得愈加复杂。二氧化铪材料由于其更高的介电常数和更大的带隙,在宇航应用中具有更好的抗辐照性能,被认为是目前二氧化硅材料的合理替代方案之一[3]。金属-氧化物半导体场效应晶体管(metal oxide semiconductor field effect transistors,MOSFETs)中的阈值电压漂移和载流子迁移率是两个容易受到辐照影响的重要指标[4],数值仿真表明电离辐照总剂量(total ionizing dose,TID)会导致器件阈值电压漂移以及载流子迁移率下降[5];此外利用实验研究电场、温度、辐照剂量率、器件掺杂浓度等因素对阈值电压和迁移率的影响是更为有效的方式[6],相关实验表明在高剂量率下空间电荷效应对界面态的形成存在抑制作用[7]。
目前大多针对TID效应的研究极少考虑微观下的缺陷行为,特别是器件栅介质中缺陷对载流子的俘获/发射、缺陷生长/复合和缺陷耦合等。本文利用非辐照多声子跃迁和辐照诱导陷阱电荷的物理形成过程,通过动力学蒙特卡洛(kinetic Monte Carlo,KMC)方法建立MOSFETs结构研究模型,模拟研究缺陷的多种行为及TID效应对MOSFETs器件阈值电压漂移的影响,可为集成电路的设计、仿真、可靠性分析和抗辐射加固等提供依据。
1 物理过程
高k栅介质良好的热力学稳定性与匹配性能够有效地抑制MOSFETs短沟道效应,但是MOSFETs栅介质中缺陷充放电行为会导致器件可靠性退化。如图1所示:栅介质中的缺陷能够从沟道或栅极俘获载流子(过程a),也能向沟道或栅电极发射载流子(过程b),并且载流子有一定几率在缺陷之间隧穿,发生缺陷耦合行为(过程c);高k栅介质中除本征初始缺陷外,在温度和电压应力下还会产生新的缺陷(过程d),其中一些氧空位可能与其相邻近的粒子发生复合行为(过程e);电离辐照会激发介质层中的电子—空穴对,从自体复合中逃逸出的电子在电场作用下被快速扫出介质层,而逃逸出的空穴有一定几率在临近的缺陷之间跳跃,向着沟道界面迁移并被俘获形成介质层陷阱电荷(过程f);一部分被俘获的空穴与缺陷发生反应会释放出质子,质子向沟道界面移动并与被氢钝化的悬挂键反应形成界面陷阱电荷(过程g)。

图1 MOSFETs栅介质中载流子俘获相关的微观物理过程
栅介质缺陷行为过程a—e可利用非辐照多声子跃迁模型[8]进行描述:
Pc=δncνnnexp[-εc/(kBT)]
(1)
Pe=δneνnNcexp[-εe/(kBT)]
(2)
Pij=Tijfcexp[-εij/(kBT)]
(3)
Pg=fgexp[-(Eg-γF)/(kBT)]
(4)
Pr=frexp[-Er/(kBT)]
(5)
式中:Pc和Pe分别为缺陷从沟道/栅电极俘获载流子行为的概率和缺陷向沟道/栅电极发射载流子行为的概率;Pij为载流子在缺陷之间跳跃行为的概率;Pg为缺陷生长行为发生的概率;Pr为缺陷发生复合行为的概率;δnc,e为缺陷俘获截面面积;νn为载流子在栅介质材料中的热速度;kB为玻尔兹曼常数;n为沟道或栅电极的载流子浓度;Nc为电子的有效能级密度;εc和εe分别为缺陷俘获和发射势垒;T为温度;F为电场强度;εij为俘获载流子在缺陷间隧穿需要跨过的热势垒;Tij为隧穿几率;fc为载流子在缺陷中的振动频率;Eg和Er分别为缺陷生长和复合的零点场激活能,与材料相关;fg和fr分别为缺陷生长和复合对应的晶格振动频率;γ为化学键极化系数。
辐照诱导介质层陷阱电荷和界面陷阱电荷的形成过程f—g可利用动力学模型进行描述[9]:
(6)
Pit=NSiH[1-exp(-0.5DitD′t)]
(7)
(8)
式中:Pot为辐照诱导形成的介质层陷阱电荷密度;Pit为辐照诱导形成的界面陷阱电荷密度;D′为辐照剂量率;fy为电子空穴对从本体复合中逃逸的概率;Nt和NSiH分别为缺陷密度和被氢钝化的悬挂键密度;σpt和σit分别为介质层内空穴俘获截面面积和界面质子俘获截面面积;tox为介质层厚度;g0为电离辐照诱导电子空穴对生成的转换因子。TID效应引起的阈值电压漂移由介质层陷阱电荷和界面陷阱电荷两部分组成,N型MOSFETs介质层陷阱电荷引起负向漂移(ΔVot),界面陷阱电荷引起正向漂移(ΔVit)。
2 模拟方法
基于随机数的动力学蒙特卡洛方法在MOSFETs可靠性分析中有广泛的应用,可以直观地描述器件中的各种随机过程。利用非辐照多声子跃迁和辐照诱导陷阱电荷的物理形成过程,通过KMC方法建立MOSFETs结构栅介质研究模型,模拟过程如图2所示。首先通过Synopsys公司的Sentaurus TCAD工具的SDE模块建立N型MOSFETs结构,利用SDevice模块模拟器件在栅压应力和温度应力下的物理行为,提取初始电势电场分布、载流子密度分布作为KMC方法模拟的输入数据。模拟中假设初始缺陷分布是随机均匀的,根据缺陷俘获/发射载流子、载流子隧穿跳跃及缺陷生长/复合行为发生的概率,在每个时间步长(Δt)内判断缺陷发生的行为,进而重新计算缺陷分布、电荷分布和缺陷电荷分布,新产生的缺陷将在下一个Δt内参与行为模拟,每个Δt结束时统计电荷分布及电子流的变化情况并计算阈值电压漂移(ΔVth),循环直至模拟设定时间结束。

图2 动力学蒙特卡洛方法模拟仿真流程
模拟仿真样品为铪基nMOSFET器件,栅长、宽均为20 nm,栅介质由3.7 nm二氧化铪和0.4 nm二氧化硅组成[8]。介质层初始缺陷密度分别为5.0×1018cm-3和3.0×1018cm-3,衬底掺杂浓度为1.0×1016cm-3,源漏端掺杂浓度为1.0×1020cm-3,栅极电压为1.7 V。模拟中假设辐照电离产生的电子空穴对在介质层内均匀产生,忽略界面附近的空间电荷效应;通过提取MOSFETs栅介质缺陷的电荷分布,得到阈值电压的退化特性。式(1)~(8)中部分参数数值如表1所示。
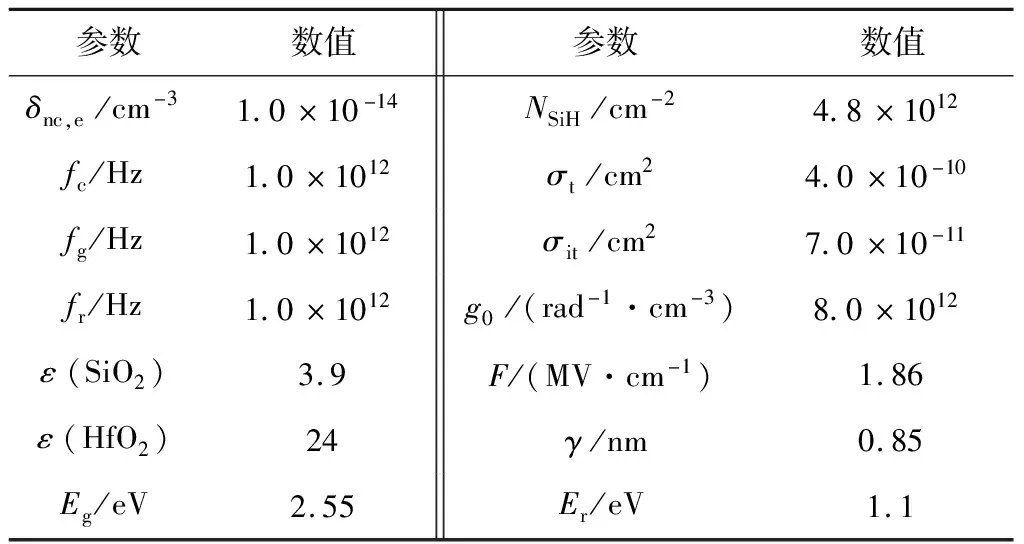
表1 式(1)~(8)参数数值
3 结果与分析
陷阱诱导退化和辐照诱导退化的作用强度不同。图3为无辐照时不同温度下阈值电压漂移的瞬态变化,为减小KMC方法随机性带来的误差,阈值电压漂移统计50次模拟的平均值。缺陷的多种行为与温度应力密切相关,不同温度下缺陷生长/复合的可能性不同,使得在后续的时间步长内参与俘获/发射载流子的缺陷数量发生变化,且不同温度下载流子在缺陷间跳跃的可能性不同,电荷所获得的能量不同。由模拟结果可知,高温下,随着时间的累积会产生更多的缺陷;这些新增加的缺陷在下一个时间步长中都会参与到载流子的俘获/发射行为中,更多的载流子俘获使得阈值电压发生变化,还会导致泄漏电流的变化。加入辐照后,阈值电压漂移与累积时间的关系如图4所示,阈值电压漂移由TID及缺陷行为共同作用。由模拟结果可知,当辐照剂量小于1 krad时,阈值电压有少许正向漂移;当辐照剂量继续累积时,阈值电压出现越来越严重的负向漂移。这是由于在辐照剂量较小时,介质中因TID效应累积的陷阱电荷很少,而温度应力使得缺陷生长,参与载流子俘获发射的缺陷数目增加,缺陷诱导漂移占据主导,阈值电压正向漂移;随着辐照累积剂量的增加,介质层陷阱电荷和界面陷阱电荷增加,TID效应导致的阈值漂移已经远远大于缺陷俘获发射行为导致的阈值漂移,阈值电压负向漂移并越发严重。

图3 温度对阈值电压漂移的影响
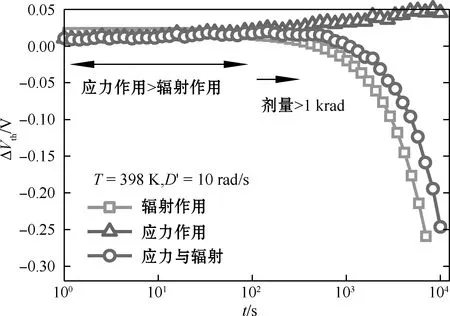
图4 TID效应对阈值电压漂移的影响
不同辐照剂量下,TID效应产生的电子空穴对数量不同,使得介质层陷阱电荷和界面陷阱电荷的累积量不同,进而导致阈值电压漂移不同,在辐照剂量累计大于1 krad之后,模拟结果如图5所示,介质层陷阱电荷导致负向的阈值电压漂移,界面陷阱电荷导致正向的阈值电压漂移。此时,TID诱导的陷阱电荷作用已经远远大于缺陷生长带来的影响。辐照剂量越大,累积的电子空穴越多。电子被电场扫出介质层,空穴被缺陷俘获形成陷阱电荷,陷阱电荷的累积与空穴密切相关;空穴越多,累积的陷阱电荷越多,导致阈值电压漂移越严重。

图5 不同剂量下介质层陷阱电荷引起的阈值电压漂移
当辐照剂量累积至极高的水平时,TID效应导致的阈值电压漂移出现反弹现象,如图6所示,辐照剂量被提高了一个数量级以加快模拟的速度。由结果可知,在中高剂量累积下,介质层陷阱电荷密度趋于饱和,而界面陷阱电荷仍在增加,在仿真的样品中当累积剂量大于1.4 Mrad时,界面陷阱电荷的增长率大于介质层陷阱电荷增长率,阈值电压漂移出现反弹现象,对于N型MOSFETs,此时的介质层陷阱电荷累积作用仍是大于界面陷阱电荷作用的,阈值电压仍为负向漂移;随着辐照剂量的继续累积,阈值电压将出现正向漂移,但此时器件已经损坏,不能再维持原本正常功能,所组成的电路甚至可能已经失效。

图6 在极大TID效应下阈值电压漂移的反弹现象
TID效应受温度的影响。398 K温度下陷阱电荷导致的阈值电压漂移比300 K严重,温度会影响电子空穴逃离本体复合的概率和陷阱态的形成速度,温度越高,逃逸的电子空穴越多,陷阱态建立速度越快,随时间累积带来的阈值电压漂移越明显。此外,界面被氢钝化的悬挂键密度影响界面陷阱电荷带来的阈值电压漂移结果如图7所示。悬挂键密度越大,随着时间累积的阈值电压漂移越明显,有效调节悬挂键密度可对介质层陷阱电荷导致的负向阈值电压漂移进行补偿。

图7 悬挂键密度对阈值电压漂移的影响
4 结束语
本文利用KMC方法模拟研究了铪基MOSFETs栅介质中陷阱诱导的器件性能退化和TID效应对阈值电压漂移的影响,包括缺陷的生长/复合、载流子的俘获/发射、载流子的隧穿跳跃以及辐照诱导陷阱电荷的形成。由结果可知,在辐照剂量小于1 krad时,TID诱导的陷阱电荷对阈值电压的影响小于本征缺陷和新生缺陷带来的影响;随着辐照剂量累积到1.4 Mrad,界面陷阱电荷影响逐渐增加,阈值电压漂移出现反弹现象。温度影响陷阱态的形成,温度越高,TID效应导致的阈值电压漂移越明显,且界面被氢钝化的悬挂键密度也会影响陷阱电荷的形成和作用。本文结果可为集成电路的设计、仿真、可靠性分析和抗辐加固等提供依据。

