偏压方式对金刚石薄膜生长的影响研究
黄 凯,王传新,徐远钊
(武汉工程大学 湖北省等离子体化学与新材料重点实验室,武汉 430073)
0 引言
金刚石作为自然界最坚硬的物质,具有优异的耐磨损性、化学稳定性,较高的热导率等理化性质。由于自然界中金刚石储量有限,金刚石加工难度大[1],使得用化学气相沉积方法制备的金刚石薄膜成为一种理想的表面材料,在切削工具、模具等领域得到了广泛应用[2]。
热丝化学气相沉积法(Hot Filament Chemical Vapor Deposition,HFCVD)是目前国内外产业化制备金刚石薄膜的主要方法之一[3],与其他制备方法相比,具有设备结构简单、操作方便、可大面积制备均匀的薄膜以及不限制衬底的形状等优点。在化学气相沉积中,金刚石薄膜的生长方式多为异质外延,由于晶格失配和热膨胀系数差异,这种生长方式在一定程度上抑制了薄膜在衬底上的沉积。偏压辅助沉积法作为薄膜制备过程中最常用的方法,可以显著提高反应粒子的活性,增强粒子对衬底的轰击效应,增加表面的形核密度,改善薄膜的形貌,提高薄膜的品质[4]。目前,最常用的两种偏压辅助法是直流偏压法和脉冲偏压法。胡东平等[5]探究了脉冲偏压特定参数对沉积在钼板上的金刚石薄膜的晶粒尺寸和形状的影响,发现施加脉冲偏压后生长的金刚石薄膜颗粒均匀细小且与基底结合力良好。Shen等[6]采用直流偏压辅助热丝法对单层金刚石晶粒的生长形态做了探究,发现适当的直流偏压有利于金刚石薄膜的生长。吴忠振等[7]对比了高脉冲偏压与直流偏压对磁控溅射CrN薄膜的影响,发现高脉冲偏压下制备的CrN薄膜在薄膜平整度和晶粒致密程度方面更优。鉴于两种辅助偏压方式在金刚石薄膜制备过程中的重要性,本文在前人试验的基础上着重探究直流偏压和脉冲偏压的大小对金刚石薄膜形貌和质量的影响,并从原理上对形貌转变的因素进行分析和讨论。
1 试验与薄膜性能表征
1.1 试验
采用自制的热丝化学气相沉积装置,在热丝与基片台之间增加一组偏压电源,通过偏压辅助的作用制备金刚石薄膜样品,如图1所示。

图1 热丝化学气相沉积装置示意图Fig.1 Schematic diagram of HFCVD device
用Φ0.5 mm的金属钽丝作为热丝,试验过程中保持热丝电压为23 V,热丝温度2 200℃左右;以氢气与甲烷作为反应气体,控制通入的气体流量比H2∶CH4=500∶10,气压2 kPa,生长时间3 h。衬底为单面抛光的P型单晶硅片,依次经过金刚石微粉溶液、无水乙醇、去离子水超声研磨清洗5 min,用氮气吹干后放置在基片台上,距离热丝5 mm。试验过程采用控制变量法,选定脉冲偏压频率20 kHz,占空比20%,分别改变两种偏压的大小。由于脉冲偏压具有断弧作用[5],试验过程中须适当调高脉冲偏压区间。具体工艺参数如表1所列。

表1 薄膜沉积参数Tab.1 Thin film deposition parameters
1.2 表征与测试
用扫描电镜(Gemini SEM300)测试金刚石薄膜样品的表面形貌,比较不同的直流偏压和脉冲偏压对金刚石薄膜表面形貌的影响;用Raman光谱(Thermo DXR Raman Microscope,波长532 nm )测试金刚石薄膜的质量;用等离子光谱仪(FX2000)测试不同反应体系各活性粒子的含量。
2 结果分析与讨论
2.1 偏压对金刚石薄膜形貌的影响
图2为不同电压下用直流偏压沉积的金刚石薄膜样品的电子显微照片,(a)~(d)均为明显的微米晶结构,晶粒尺寸随着偏压的增大呈先增大后减小的趋势。图2(a)晶粒分布较为离散,晶粒尺寸较小,晶界较多,薄膜质量较差;随着偏压增大到50 V,薄膜变得非常致密,晶粒取向主要为(110)(111),尺寸在2 μm左右,晶界处衍生了少许的孪晶,晶粒形状规整,薄膜质量较好,如图2(b)所示;随着偏压进一步增加,晶粒尺寸略有增加,晶面主要为(111)面,晶粒形状规整,大晶粒的棱边出现了一定程度的破损,小晶粒数量增多,如图2(c)所示;当偏压增大到90 V时,晶粒尺寸不再增大,(111)面更为显著,晶粒形状不规整,可以观察到三角晶粒的棱边处均出现刻蚀现象,同时因二次形核生出很多细小的晶粒,如图2(d)所示。

图2 不同的直流偏压辅助生长的薄膜表面形貌Fig.2 Surface topography of thin films grown with different DC bias
图3为不同脉冲偏压条件下沉积的金刚石薄膜的电子显微照片,从图3(a)~(d)中可以看到,脉冲偏压大小对薄膜的形貌以及晶粒尺寸取向具有很大的影响。

图3 不同的脉冲偏压辅助生长的薄膜的表面形貌Fig.3 Surface topography of thin films grown with different pulse bias
当施加的脉冲偏压较小时,薄膜中金刚石的晶粒分布较为平整,形状清晰,晶面取向以(100)(110)为主,含有少量的(111)面,晶粒尺寸较小,参差不齐,如图3(a)所示;随着脉冲偏压增大,晶粒分布更为致密紧凑,晶粒尺寸增大,晶粒的大小较均匀,如图3(b)所示;当脉冲偏压达到110 V时,晶粒尺寸最大,晶面取向以(111)面为主,晶粒的棱边处出现类似图2(c)(d)的刻蚀现象,如图3(c)所示;当偏压进一步增大到150 V时,薄膜表面棱边刻蚀现象更明显,平均晶粒尺寸减小,如图3(d)所示。
对比用两种偏压方式辅助制备的金刚石薄膜的SEM照片发现,金刚石晶粒尺寸都历经了由小到大直至破损的过程,造成这种现象的原因是当偏压较低时,给体系施加的能量较低,活性粒子的浓度较低,不利于高品质金刚石薄膜的生长;随着偏压升高,体系的能量达到最优值,活性粒子浓度较高,促进了薄膜生长;当偏压进一步增大时,体系能量和活性粒子浓度虽然较高,但是此时从热丝发射出的经高偏压加速的高能电子对衬底的轰击作用加剧,阻碍了晶粒的轴向长大。用两种偏压法在高偏压条件下制备金刚石时,都会因为热丝距离晶面较近[4],晶粒棱边处优先受到电子流的轰击[8]刻蚀,同时因活性粒子浓度高,伴随二次形核,晶粒平均尺寸骤减,薄膜表面粗糙度减小,晶面趋于平整。直流90 V,脉冲150 V时才出现表面晶粒棱边刻蚀现象,说明直流时持续的电子流轰击更易刻蚀棱边。脉冲为瞬时电压,每次加载时间很短,当偏压较低时电子流轰击累积量较小,难以产生刻蚀,只有单次轰击累积量达到一临界值时才会出现明显的刻蚀现象,也就是说,脉冲偏压辅助时需要更高的偏压才能产生表面晶粒棱边刻蚀。对比两组照片不难发现,采用脉冲偏压法制备的薄膜的晶粒尺寸整体较大,晶粒之间差别较小,薄膜均一性更好,可能的原因是:脉冲偏压瞬时峰值电压高,分解活性粒子的效率更高,因此薄膜生长速度更快、质量更好。
不同直流偏压下金刚石薄膜的Raman光谱如图4(a)所示。图中四个样品在1 336 cm-1附近均有一个尖锐的sp3金刚石相特征峰,说明薄膜中金刚石含量较高;1 500 cm-1附近均有一个圆滑的特征峰,是sp2石墨相特征峰。直流偏压30 V样品的Raman谱1 140 cm-1处有一个明显的特征峰,应该来源于金刚石晶界以及表面处的反式聚乙炔,通常这种峰的出现意味着薄膜中金刚石晶粒较小,趋于纳米晶[9],说明较低的直流偏压不利于高质量金刚石晶粒的生长。
用脉冲偏压制备的金刚石薄膜的Raman光谱如图4(b)所示。图中四个样品在1 334 cm-1附近均有一个尖锐的金刚石特征峰,在1 500 cm-1附近也有一个略微突起的石墨特征峰。值得关注的是,从SEM图中看到的直流偏压90 V和脉冲偏压150 V两种样品表面的金刚石均出现细化现象,部分晶粒尺寸甚至处于纳米级别,但是在Raman光谱图中却显示为非常好的微米晶[10],这一现象可能为金刚石晶粒的细化提供了新途径。

图4 不同偏压下生长的金刚石薄膜的Raman光谱图Fig.4 Raman spectra of diamond films grown at different DC bias and pulse bias
Raman光谱中金刚石特征峰的偏移程度反映了金刚石内应力的大小。天然金刚石的Raman光谱特征峰在1 333 cm-1处,而用直流偏压法与用脉冲偏压法制备的金刚石薄膜特征峰分别位于1 336 cm-1和1 334 cm-1附近处。对比Raman光谱可以发现,偏压大小对偏移程度无明显影响,两种偏压辅助制备的金刚石薄膜Raman光谱显示出的特征峰均往高波数漂移,表明薄膜内部均具有一定的压应力[11]。除了晶格匹配差异导致的本征压应力以及热膨胀系数差异导致的热残余应力外,部分压应力可能源于偏压下粒子的轰击,高能粒子的轰击会影响薄膜内部的微观组织,减小原子间的空洞、间隙,增加薄膜缺陷,从而增大了薄膜内部的压应力[12]。利用直流偏压辅助法制备的薄膜的Raman偏移程度整体大于脉冲偏压辅助法,造成这种现象的原因是直流偏压辅助法与脉冲偏压的工作机制不同:直流偏压不存在电压间歇期,当外加直流偏压施加在衬底与热丝之间时,带电粒子会持续地受到偏压的作用加速轰击衬底,不断地增大薄膜的缺陷程度,导致薄膜内部的压应力显著提升;而脉冲偏压法存在偏压作用的间歇期,在此期间,带电粒子对薄膜表面的轰击作用会得到一定的缓解,薄膜内部的压应力得到一定程度的释放。
金刚石相成分的相对强度ID与非金刚石相相对强度IG的比值ID/IG通常被用来衡量金刚石薄膜的品质。图5为两种偏压条件下不同偏压大小与金刚石薄膜品质的关系。

图5 不同偏压下生长金刚石薄膜的品质Fig.5 Quality of diamond films grown under different bias
从图5可以看出,两组金刚石薄膜的品质均随偏压的增大呈现先提升后降低的趋势,当直流偏压为50 V左右时,金刚石薄膜的品质最好,脉冲偏压在70 V附近时可以获得最高品质的金刚石薄膜,此时的金刚石峰强度最尖锐,如图4所示,说明附近的金刚石相最多,非金刚石相最少。对比Raman光谱图以及ID/IG比值可以看出,用脉冲偏压法制备出的金刚石薄膜的品质整体上优于用直流偏压法制备的金刚石薄膜。
为了进一步验证金刚石薄膜形貌转变的机制,借助等离子体光谱仪测试了薄膜沉积过程中衬底表面的各粒子强度,测试结果如图6所示。分析发现,该等离子体体系中主要存在Hα(656.30 nm)、Hβ(486.25 nm)、C2(563.10、516.08 nm)、H2(603.19 nm)四种粒子。Hα被认为是刻蚀石墨相的主要原子氢;Hβ是原子氢的另一种形式,常用Hα/Hβ比值来衡量等离子体的温度[13];C2粒子被认为是非金刚石相生长的前驱体[14],用C2/Hβ来表征薄膜中的非金刚石相成分[15]。由于测试选点对试验结果影响很大,只能采用相对强度来衡量活性粒子的浓度。
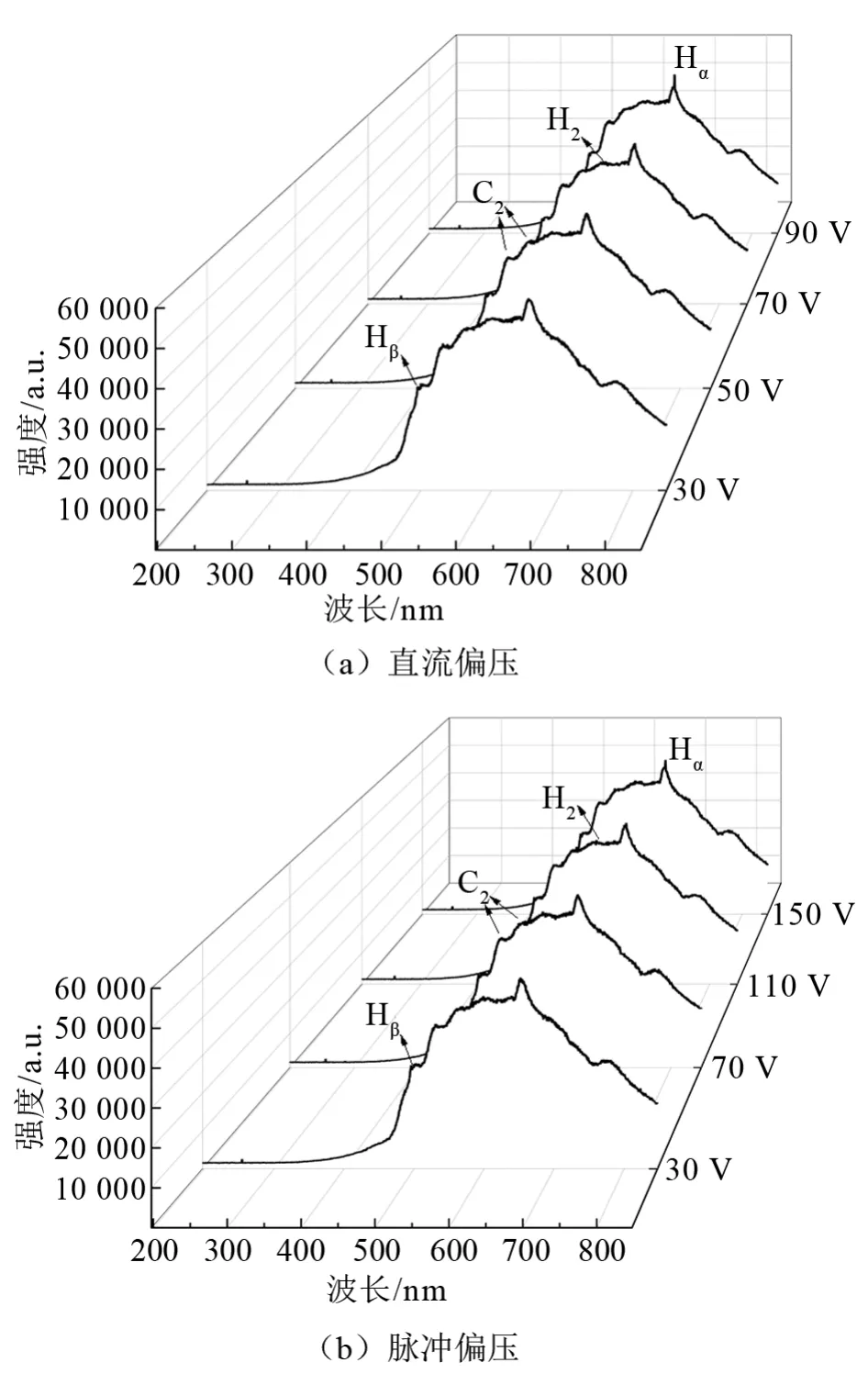
图6 不同偏压下薄膜沉积过程中的等离子体光谱分析图Fig.6 Plasma spectral analysis at different DC bias voltages and pulse bias
从图6可以看到,随着偏压增大,各种粒子强度均呈现增强趋势;当施加的直流偏压低于70 V,脉冲偏压低于110 V时,各种粒子强度均随着偏压的增加小幅度增强;当施加的直流偏压达到90 V,脉冲偏压达到150 V时,Hα粒子强度大幅度增强。对比两种偏压方式发现,随着偏压增大,Hα/Hβ相对强度增强,说明等离子体中电子的温度越来越高,能量越来越大,电子对衬底的轰击刻蚀作用越来越显著,对表面晶粒长大的抑制作用也越来越强。C2/Hβ相对强度呈现先增大后减小的趋势,且直流偏压法的相对强度整体上高于脉冲偏压法,这意味着用直流偏压法制备的金刚石薄膜中非金刚石相成分高于脉冲偏压法,这一点与Raman光谱的结果一致。同时,当施加的偏压较大时,体系中反应气体的分解能力增强,活性粒子浓度增大,促进了二次形核,细化了晶粒。
3 结论
利用热丝化学气相沉积装置研究了两种偏压对金刚石薄膜生长的影响。结果表明:(1)两种偏压方式下偏压的大小对薄膜的形貌均有很大影响,直流偏压达到90 V左右,脉冲偏压达到150 V左右时,薄膜表面棱边会出现电子流轰击刻蚀,同时伴随二次形核晶粒细化的现象;(2)相较直流偏压法,用脉冲偏压法制备的金刚石薄膜的晶粒较大、均匀性较好,薄膜的内应力较小;(3)高偏压下会出现薄膜晶粒细化现象,主要原因:一是高能量、高密度的电子流对金刚石表面的轰击刻蚀作用增强,使得晶面难以继续长大;二是活性粒子浓度增加导致了二次形核。

