多结级联垂直腔面发射激光器失效分析
刘 畅 肖 垚 刘 恒 邓国亮 苗 霈 王 俊 *
(1.四川大学 电子信息学院,四川 成都 610041;2.苏州长光华芯光电技术股份有限公司,江苏 苏州 215163)
1 引 言
垂直腔面发射激光器(Vertical cavity surface emitting laser,VCSEL)作为一种重要的半导体激光器,在光通信[1]、3D 人脸识别[2-3]、微型原子钟[4-5]等方面有着广泛的应用。而在未来主流的应用场景自动驾驶中,激光雷达是实现自动驾驶的关键传感元件[6],且在激光雷达测距系统中接收信号光强度越大,激光雷达测距精度越高,相对外部环境因素影响越小[7]。所以这对垂直腔面发射激光器的峰值功率以及电光转换效率提出了更高的要求。为了提高垂直腔面发射激光器输出光功率,1982 年,van der Ziel 和Tsang 提出了多结激光器概念[8]。多结垂直腔面发射激光器(Multi-junction VCSEL)具有电光转换效率高、输出光功率密度高、斜率效率高等优点。2021 年,长光华芯公司报道了效率达62% 的三结VCSEL[9]。但多结VCSEL 器件输出功率更高的特点也带来了器件产生热功率高的问题,这也势必对多结VCSEL 器件寿命造成严重影响;同时车载使用环境(更宽的温度及湿度工作范围)较普通消费电子类传感应用环境更为恶劣,工作功率更高、需要的寿命更长,这些都对多结VCSEL 器件可靠性提出了更高要求。目前多结VCSEL 器件失效模式在文献中尚未见报道。因此,通过加速老化来研究多结VCSEL 器件的失效模式对实现多结VCSEL 器件商业化具有重要的意义。对于单结VCSEL 器件来说,主要失效模式有DBR 攀爬位错、静电放电损伤(Electrostatic discharge,ESD)、电气过载(Electrical overstress,EOS)、外延缺陷[10]等。在氧化限制型VCSEL 中,氧化物边缘应力所导致的半导体裂隙为其主要失效模式之一[11],而与单结VCSEL 器件相比,多结VCSEL 器件同时具有多有源区和多层氧化结构。因此,多氧化层结构也会产生更多的应力累积,更易在高温高电流情况下形成失效。由于在实际生产中很难保证氧化孔径尺寸的均匀性,所以氧化孔径的形状或尺寸的细小差异以及结构上的缺陷将会造成不同器件之间最终的性能差异,例如激光器输出功率以及近场模式变化等。而这种器件性能差异会在激光器正常使用过程中加剧,最后导致器件失效以及不同器件之间的寿命差异。因此,当研究不同的光学性能或器件故障时,VCSEL 的详细表征是至关重要的,并且有必要采用相关技术来表征VCSEL 并识别不同结构层中器件之间的差异[12]。
本文通过老化寿命加速的方法,获得了相关的失效器件,并采用L-I-V测试、正反向V-I测试、光学及红外外观测试、近场光斑测试等多种表征手法分析了多结VCSEL 器件失效可能的起始原因,最终通过透射电子显微镜(TEM)确认了在氧化层附近已经存在位错,并推测多结VCSEL 器件失效起始点来自于氧化层边界处的应力累积。这对于继续优化VCSEL 内部结构及提升工艺控制能力,提高多结VCSEL 器件寿命及可靠性具有一定指导意义。
2 理论依据
VCSEL 器件失效曲线符合浴盆曲线,主要由三部分组成:早期失效期、随机失效期、损耗失效期[10]。由于垂直腔面发射激光器的寿命较长,一般采用老化加速来进行研究。老化加速模型主要有恒定应力、步进应力和序进应力三种[13],加速应力主要因素为电流应力与温度应力[14-15]两种。老化加速因子(FAF)推导公式[16]如下:

其中,Iacc为老化测试加速电流;Iuse为正常使用环境下驱动电流;n为经验推导“电流加速因子”,半导体器件通常为2~3[10],本文中取值为2;Ea为活化能,通常为实验中确定,本文中取值为0.7 eV[10];kB为Boltzmann 常数,等于8.617×10-5eV/K;Tj,use、Tj,acc分别为正常使用环境下器件结温与加速老化时器件结温。
由于公式(1)中需要使用器件结温,VCSEL的器件结温可以通过热阻计算得到,热阻计算公式[17]如下:

其中I为驱动电流,Ith为激光器阈值电流,Vj为PN 结偏压,Tj为结温,Tamb为外部环境温度,Rs为器件电阻,Pin为输入电功率,Popt为激光器输出光功率,Pdiss为热耗散功率。
由公式(2)可以看出,可以通过两种不同方式影响激光器内部温度,即改变外部环境温度或热耗散功率,从而导出光谱红移相同的数据集(ΔT,ΔP),而(ΔT,ΔP)可用于计算热阻:

3 实验方案
本文采用的是自主设计研发的GaAs 基940 nm 三结垂直腔面发射激光器,其结构如图1 所示,具有三层氧化层及有源区结构,氧化孔径大小为10 μm,器件封装形式采用COS(Chips on substrate,基板芯片)热沉封装,使用银浆作为焊料。实验过程中,采用TEC 半导体制冷器对老化器件进行控温,保证器件老化过程中的温度稳定性,控温精度±0.1 ℃。本文中老化加速条件为热沉温度为343 K,老化电流为12 mA 直流,当器件光功率下降至初始值的30%视为器件已失效。老化功率监控间隔为12 h。实验使用ILX lightwava LDC-3900 为驱动电源,功率采集使用热堆功率计(Coherent PM150),电压采集为KEITHLEY DMM6500 数字万用表。器件近场分布使用NIKON:50×物镜搭配CCD(Mightex:MCE-B013-U)拍摄。
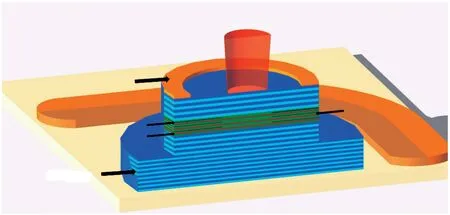
图1 三结级联VCSEL 结构示意图Fig.1 Three-junction cascaded VCSEL structure diagram
为计算实验过程中器件老化加速速度,我们测试了不同温度下器件的L-I-V曲线(具体情况如图2 所示)及相应温度条件下器件的光谱,光谱测试电流为5 mA 直流,并由此计算出了老化器件温漂系数为Δλ/ΔT=(0.0701 ±0.0002) nm/K 以及器件热阻与温度的关系:Rth=12.589Tamb-2482.3 K/W。

图2 (a)器件在不同温度下电压、功率与电流的关系;(b)器件温漂系数及热阻与温度的关系。Fig.2 (a)Relationship between voltage,power and current at different temperatures.(b)Temperature drift coefficient and relationship between thermal resistance and temperature.
由此,我们计算出在老化加速过程中,外部环境温度343 K 情况下,器件结温约在400 K;而对应于7 mA 电流,300 K 环境温度,内部结温324 K的正常使用情况下,老化加速因子约为104。而通常业界老化加速因子设置为50~200[10],相对来说,本文实验参数设计合理。
4 实验结果及讨论
在上述条件下,对失效器件进行分析,首先对VCSEL 器件老化前后在室温连续工作时的L-I-V曲线进行分析,其结果如图3 所示。结果显示,相比于老化前,器件在设定电流12 mA 下输出功率变小,降低了43.58 %;器件阈值变大,增大28.84%。阈值电流增加的原因是器件的内损耗增加,可能来源于内量子效率降低和非辐射复合过程中吸收的增加。光电转换效率变小,降低37.45%;斜率效率变小,降低33.18%;器件串联电阻基本保持不变。因此工作电压基本保持不变,但在开启电压区间位置显示出异常,因此,我们对器件测试了正反向V-I。图3(b)为使用数字源表(KEITHLEY 2400)对器件老化前后在-5~5 V 区间测试的V-I曲线结果。结果显示,器件在老化前后均未出现反向漏电流情况,但在老化后,器件开启电压下降,降低了1.43%,开启电压下降说明器件PN 结附近可能出现了缺陷。

图3 器件老化前后性能对比。(a)光功率及电压对比;(b)V-I 曲线对比。Fig.3 Comparison of device performance before and after aging.(a)Comparison of optical power and voltage.(b)Comparison of V-I curve。
随后,我们用光学手段对器件的外观及激光模式进行了研究。通过光学显微镜确认器件表面的情况,通过红外相机可以聚焦到器件内部,对器件内部进行成像以确认内部情况。因此,氧化孔径的大小通常通过红外相机成像进行确认。其中光学照片由可见光CCD(SZSS-2000,空间分辨率0.1 μm×0.1 μm)、红外照片由红外CCD(Mightex:MCE-B013-U,空间分辨率0.23 μm×0.23 μm)拍摄。拍摄的器件老化前后外观的光学及红外照片结果如图4 所示。图4(a)、(b)为老化前后的红外照片,从图中可知,老化实验前,器件氧化孔径边缘规则清晰,老化后,器件上下氧化边界处出现不规则暗斑。为排除两处暗斑是来源于器件表面的脏污,我们将光学镜头聚焦至器件SiN 表面,在光学照片中,未在该处位置发现表面脏污,证明红外图片中暗斑并非表面脏污成像,而是器件内部缺陷导致。
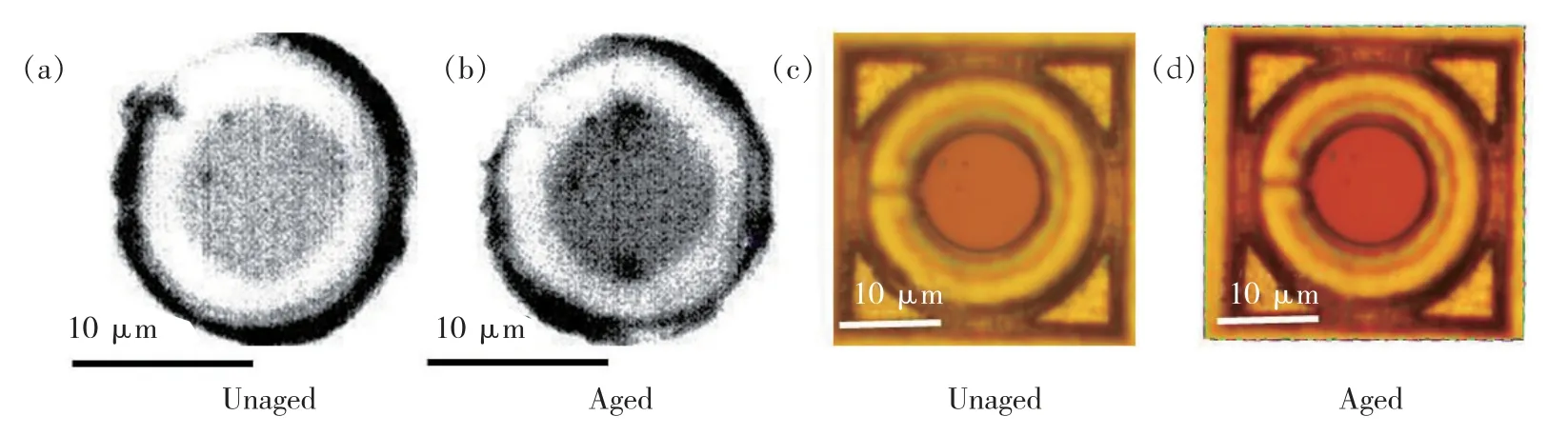
图4 器件老化前后光学及红外成像。(a)未老化时红外成像;(b)老化后红外成像;(c)未老化时光学照片;(d)老化后光学照片。Fig.4 Optical and infrared imaging before and after device aging.(a)Infrared imaging before aging.(b)Infrared imaging after aging.(c)Optical photos before aging.(d)Optical photos after aging.

表1 老化前后器件各项参数变化Tab.1 Changes of device parameters before and after aging
同时,我们对老化前后的近场光学进行了分析,实验测试了老化前后不同电流条件下的近场光斑。通常,可以通过阈值下的光斑来表征器件的氧化孔径大小。图5 为器件在老化前后不同电流下的近场分布情况,其中白色曲线为CCD 水平中心轴方向采样的光强分布。从图中可以明显看出,老化前后近场光斑存在着明显差异。首先是在阈值电流下时,老化后的近场光斑出现了两处明显的暗区,且暗区位置位于氧化孔径的边缘,并且上下对称地分布,其在近场光斑上分布的位置与红外外观图像中暗斑的位置相一致,而老化后的光学外观图显示器件对应位置表面无异常。因此,可以得出其老化后的器件内部区域出现了缺陷而影响了器件发光。且随着器件驱动电流逐渐加大,在上下暗斑之间出现了暗线缺陷(Dark-line defects,DLD)[17]。其次是在驱动电流大于阈值电流时、激光器输出激光、输出激光模式发生了很大改变。老化前,器件的激光模式随着电流的增加,逐渐由近高斯分布变为高阶模式,这主要是由于随着电流增加,横模分布受到空间烧孔、热透镜、模式竞争等效应的影响。而老化后的器件其激光模式分布由老化前中心对称的高阶模式分布变为轴对称高阶模式分布,这与阈值下近场光斑上下对称分布的暗斑有关,器件内部对称的缺陷破环了增益的径向对称性,从而使得激光模式变化。

图5 器件在老化前后不同电流下的近场分布情况Fig.5 Near field distribution of devices under different currents before and after aging
而对于激射波长的近场分布,同时受到上下DBR 的谐振反射的调制,因此其暗斑分布位置并不能反映实际缺陷位置。量子阱具有较宽的增益谱线,通常的GaAs 基DBR 高反射带宽在100 nm左右,因此,利用低反射带内的荧光波长的发光情况来表征实际量子阱的载流子分布及发光情况,这也是通常VCSEL 失效分析中常用的有源区分析方法[8]。我们通过使用860 nm 窄带通滤光片(半带宽10 nm,对通带外的波长提供大于30 dB的抑制)来观察器件不同电流下的近场分布。由于860 nm 位于940 nm VCSEL 器件上反射镜(PDBR)高反带外,此时反射率小于40%,因此我们可以消除由于940 nm 波段光线在器件内部来回反射造成的“横向传播”现象[17],进而可以精确定位器件失效位置。如图6 所示,相较于无滤光片情况,860 nm 带通滤光片下近场光强更弱,随着电流的增加,其发光强度增加,但同样也出现了两处明显的暗区,暗区位置位于氧化孔径的边缘且暗区范围更小。由于在氧化限制VCSEL 中,反射镜由低铝AlxGa1-xAs 和高铝AlxGa1-xAs 堆叠而成。通常低铝层的x=0.05,而高铝层的x=0.9,且反射镜厚度大,堆叠结构多,在DBR 靠近氧化孔径边缘处累积应力很高。同时由于本文研究的器件为三结级联VCSEL,具有三层氧化结构,所以在最上层氧化边界处应力累积最大,易在高温高电流情况下,产生缺陷,并形成位错网络。
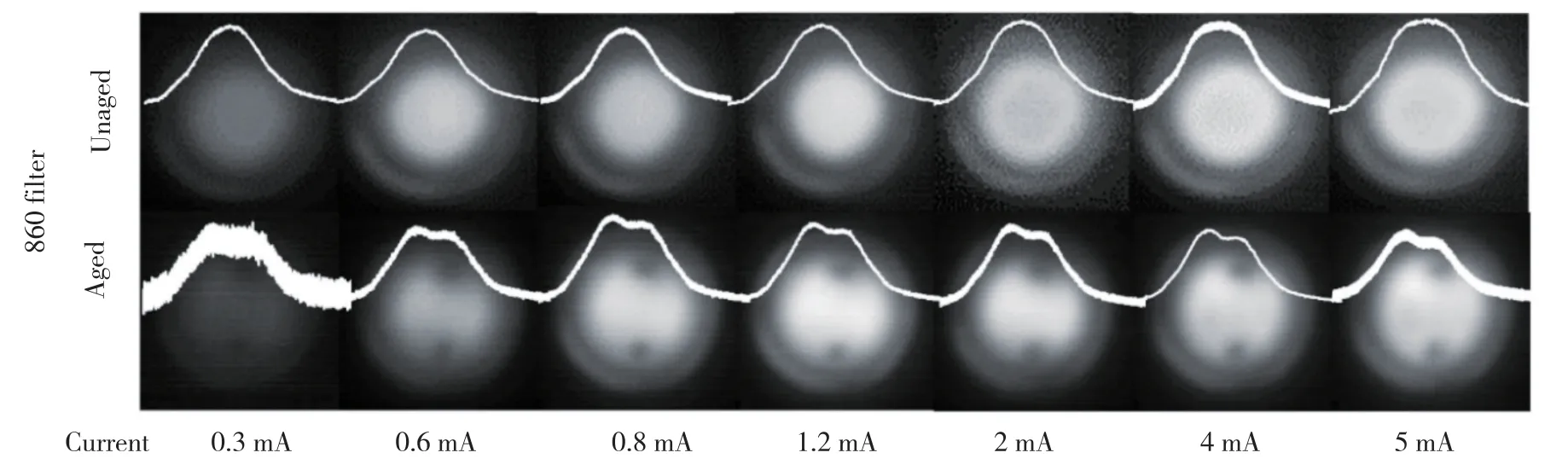
图6 器件在860 nm 带通滤光片下老化前后不同电流下的近场分布情况Fig.6 The near-field distribution of the device under different currents before and after aging under the 860 nm bandpass filter
因此,结合上述结果,我们认为,红外和近场光斑均显示缺陷出现在氧化层边缘,结合本文研究的器件为多氧化层的多结VCSEL 器件,可能产生缺陷的原因是由于氧化层边缘的应力累积产生缺陷裂痕,并在器件内部的高温梯度下,位错生长攀爬,进而产生较大范围的缺陷,最终造成功率下降,阈值上模式出现变化,器件失效。为了进一步研究并确认近场光斑及红外图像发现的暗点的来源,我们使用TEM 进行了微观结构分析。相对于SEM 来说,TEM 分辨率更高,更易观察到失效位错[18]。首先,根据前述的带通860 nm 滤光片的近场图像暗斑及红外图像暗点的结果,确定了TEM 制样的精确位置。我们使用聚焦离子束(Focused ion beam,FIB)进行竖切,对近场光学暗斑位置处进行截面制样,制样尺寸为长度10 μm、宽度20 μm、厚度150 nm,样品横切宽度覆盖近场中上下两个失效区。如图7(b)所示,图中黑框区域即为近场光学暗斑处所对应位置,使用FEI Talos F200X TEM 电镜并选择高角环形暗场扫描透射电子显微镜(HAADFSTEM)模式进行拍摄。其结果如图7 所示,其中图7(b)为样品全视图,图7(a)、(c)分别为左右氧化孔径边界位置处的放大图。从图7(a)中可以看出,在左方氧化孔径边界处上方P-DBR 存在沿水平方向位于AlGaAs/GaAs 界面处的位错痕,且该位错有生长攀爬迹象;而在图7(c)中位于右方氧化孔径边界处上方P-DBR 位于GaAs 层处同样有位错痕且能观察到其分裂延伸现象,这印证了红外暗斑和近场模式的变化是由该处的缺陷形成所导致的。

图7 失效位置TEM 截面图。(a)左侧氧化边界处放大图;(b)样品界面全视图;(c)右侧氧化边界处放大图。Fig.7 TEM cross-sectional view of failure location.(a)Enlarged image of the oxidation boundary on the left.(b)Full view of the sample interface .(c)Enlarged image of the oxidation boundary on the right.
5 结 论
本文通过多种表征手段研究了多结VCSEL器件失效原因。我们测量了实验器件热阻、确定老化实验加速速度并设计相关老化实验老化参数。通过老化实验可以看出,老化后器件阈值电流增加,输出光功率、斜率效率、电光转换效率及开启电压下降。再对比了老化前后器件的光学、红外以及近场光斑图片后,发现器件在氧化孔径边缘处存在缺陷,并且由于缺陷存在,激光模式分布由老化前的径向对称的高阶模式分布变为轴对称高阶模式分布。对失效位置制备TEM 样品并观测,我们发现位于左右氧化孔径边界上方P-DBR 处存在位错,验证了多结VCSEL 器件红外暗斑和近场模式的变化是由该处的缺陷形成所导致的。结合位错位置位于氧化孔径边界处上方,推测多结VCSEL 器件可能产生缺陷的原因是由于氧化层边缘的应力持续累积,形成缺陷,并在器件内部的高温梯度下,位错生长攀爬,进而产生较大范围的裂痕,最终造成器件失效。这对继续优化VCSEL 内部结构设计及提升工艺控制能力、提高多结VCSEL 器件寿命及可靠性具有一定指导意义。
本文专家审稿意见及作者回复内容的下载地址:http://cjl.lightpublishing.cn/thesisDetails#10.37188/CJL.20210396.

