固化温度对导电胶可靠性的影响研究
朱召贤,周悦,王涛,杨兵
(中国电子科技集团公司第五十八研究所,江苏 无锡 214035)
0 引言
陶瓷封装作为一种气密性封装,具有耐湿性好、机械强度高、散热效果优异和耐外部冲击力强等优点,在要求高密封性的场合具有不可替代的作用[1-3]。装片工艺是陶瓷封装的关键环节,目前大量使用的Pb/Sn金属合金焊料存在潜在的金属污染问题[4],已经逐渐地被环境友好、线分辨率高且加工操作简单的导电胶取代[5-7]。在陶封工艺过程中,由于装片键合后续的熔封工艺需要在300℃左右进行,传统的环氧树脂基导电胶在此温度下会发生分解[8],因此,目前陶瓷封装领域大量使用的是以耐高温的氰酸酯为基体的导电胶[9]。氰酸酯基导电胶在合金焊料封帽的温度范围内具有良好的热稳定性,能够满足气密性封装的工艺要求。
耐高温氰酸酯导电胶主要由氰酸酯基体、导电填料、固化剂和稀释剂组成。氰酸酯是一种极易吸湿的有机材料,与水汽反应的产物是CO2[10]。因此,为了防止导电胶中的基体未充分反应,导致与封装体内的水汽反应造成过大的内部压力,固化剂与氰酸酯的充分反应是提高封装可靠性的关键。如果固化不充分,极易造成粘结层中的孔洞存在,进而导致粘结强度和散热性能的恶化。因而,本文针对市售的一款成熟导电胶,采用5种不同的固化工艺,验证该款导电胶在不同温度下固化后的可靠性,为该款导电胶的工程化应用提供指导。
1 工艺流程
1.1 装片工艺
使用本单位的装片设备进行点胶和装片。为控制导电胶用量和点胶图形的一致性,在装片过程中使用压力-时间控制系统,通过该系统能够保证装片精度和装片工艺的稳定性,制备的样品除固化温度之外,其他各个参数均相同。本工艺中,控制导电胶的厚度为0.100 mm,封装结构示意图如图1所示。

图1 封装体结构横截面示意图
1.2 固化工艺曲线
本单位的陶封工艺中,熔封的温度最高可达340℃,考虑固化炉的实际温度误差并结合氰酸酯导电胶的固化条件,设定5种固化工艺曲线(如图2所示),最高固化温度分别为280、300、330、350和370℃,固化氛围为N2气氛,用于验证导电胶在不同温度下固化后的性能。
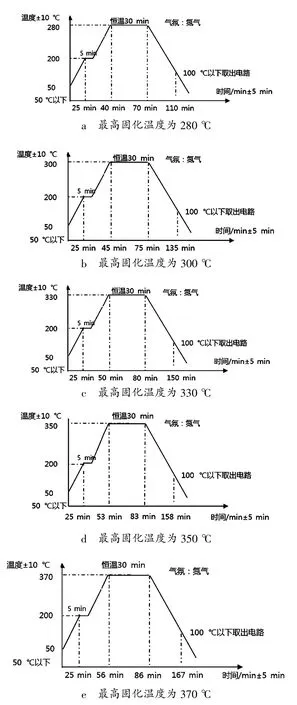
图2 固化工艺曲线
2 结果及分析
2.1 导电胶性能
耐高温导电胶由多种组分构成,除了作为粘结主体的氰酸酯之外,还包括银颗粒、固化剂和稀释剂等各种辅助成分。固化过程中一部分有机组分挥发,若挥发质量较大,极易在导电胶与芯片的界面处形成空洞。为了探究该款导电胶在高温下的热稳定性,图3给出了导电胶在氮气氛围中的热失重曲线图。可以看出,在升温过程中,导电胶的质量几乎不发生变化。该款导电胶在300℃左右才开始发生热分解,到400℃时,质量损失率仅为0.28%;当温度超过400℃时,导电胶的质量损失迅速地增加。以上结果表明该款导电胶在400℃以内具有优异的热稳定性,在本单位现有的熔封工艺中不会造成导电胶发生较大的质量损失而导致电路的封装失效。
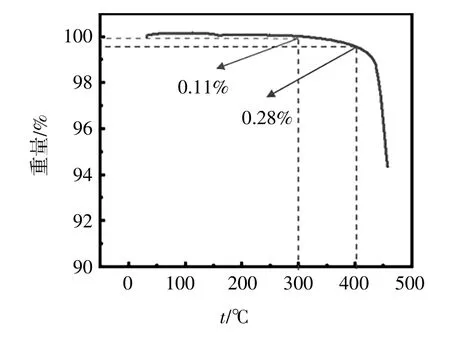
图3 导电胶的热失重曲线图
导电胶在不同固化温度下的红外光谱图如图4所示。在175℃固化之后,有明显的三唑环结构出现,说明在该温度下,导电胶开始发生固化。因而固化工艺的选择不能低于175℃。又考虑到后续熔封工艺的温度需在300℃左右时才能保证焊料充分熔化,因而将导电胶的最低固化温度定为280℃。

图4 不同固化温度下导电胶的红外光谱图
2.2 装片结果分析
固化温度由低到高时固化后电路的外观照片和X-RAY照片如图5所示。从图5中可以看出,5种固化工艺固化后芯片四周均出现小范围溢胶,即导电胶的铺展面积略大于芯片的面积,说明导电胶与芯片可以充分地接触;但是XRAY结果表明,在温度较低时(固化温度为280℃),芯片与导电胶之间出现了孔隙(孔隙率约为1%)。这是因为导电胶中的氰酸酯固化是一个热激活过程,需要大量的热量,若温度较低,不能满足氰酸酯完全固化所需要的热量,将会导致部分氰酸酯残留于电路中。该部分的氰酸酯在受热条件下会与导电胶中的水发生加成反应而产生氨基甲酸酯,而氨基甲酸酯在受热情况下会发生热分解生成二氧化碳气体,氰酸酯释放二氧化碳的反应议程式如下:
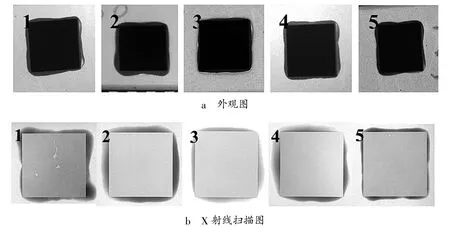
图5 固化后电路外观图及X射线扫描图(编号从1~5固化温度逐渐地升高)

这些小分子气体从导电胶体系溢出的过程中将会破坏固化的导电胶的致密结构,从而导致在粘结层中出现孔隙。此外,在导电胶的固化过程中,若未发生固化的氰酸酯的量过多,在后续封帽过程中导电胶将二次受热,生成二氧化碳,从而严重地影响封焊的质量。因此,对于氰酸酯类的耐高温导电胶,应选择较高的固化温度,避免固化不充分而带来的可靠性问题。
为了进一步地探究不同的固化温度对芯片粘结强度的影响,对固化之后的电路进行剪切试验。为了保证数据的准确性,在试验过程中,推头的侧面应该尽量地与芯片边缘保持平行,确保芯片与推头之间的面-面接触。为了增加数据的可靠性,在每种固化温度下测试的样品数目均为8个。不同固化温度下的剪切力测试数据如图6所示。从图6中可以看出,当固化温度较低,即固化温度为280、300℃时,芯片的平均粘接强度分别为18.30、18.01 kg,低于固化温度为350℃时的平均粘接强度。由此可见,当导电胶固化温度较低时,由于导电胶的不充分固化且芯片的界面间有少量的孔隙(固化温度为280℃),会导致在芯片剪切过程中加速导电胶与芯片之间的界面的剥离,降低粘结强度。

图6 不同的固化温度条件下芯片与基板表面的剪切力
将导电胶的固化温度升高至330℃,此时芯片平均粘结强度达到最大,为29.42 kg。这是因为在该温度下,导电胶中的氰酸酯完全固化,并且导电胶与芯片形成良好的接触面,空洞率降低。良好的接触面及稳固的树脂交联结构能在剪切过程中很好地抵抗外部应力,不易发生剪切失效。
为了进一步地探究高温对导电胶的影响,将固化温度提高至370℃。此时,芯片粘结强度骤然降至10.04 kg,造成粘结强度下降的主要原因可以分为两个方面:一方面是由于导电胶与陶瓷管壳的热膨胀系数不匹配,在较高的温度下,极易导致界面应力和界面分离现象,并且这种应力是不可逆的,当外部施加应力时,促使界面应力的释放,从而导致剪切强度的大幅降低;另一方面,温度较高时,导电胶发生分解产生水、二氧化碳等小分子,这些小分子与固化后的氰酸酯网络结构接触后会严重地扰乱固化后的导电胶的平衡状态,发生一系列复杂的化学反应,从而导致聚合物分子链的密度减小和力学性能降低。
剪切试验后样品的外观图如图7所示。当固化温度在280~350℃时,粘结的失效模式为芯片剪碎,如图7a所示;而当固化温度为370℃时,在外部剪切力的作用下,芯片从陶瓷管壳表面脱落,如图7b所示。两种失效模式的不同表明固化温度较高时,在外部应力的作用下,芯片与导电胶更易分离,导致电路的失效,而这种模式在高可靠的应用环境中是绝对不允许的。
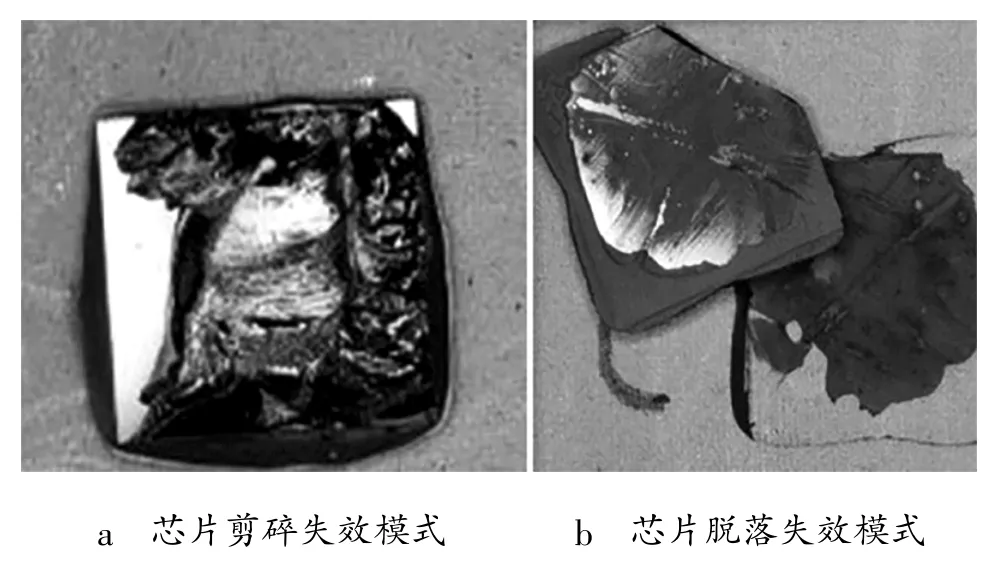
图7 两种芯片的剪切失效模式
采用扫描电子显微镜对剪切破坏的试样断面进行观察,得到的结果如图8所示,图8a-d分别是固化温度为300、330、350和370℃时(其中280℃时的剪切断裂面与300℃时的剪切断裂面基本无差异,故不单独考察)剪切断裂面的放大图。
固化温度较低时,即固化温度为300℃时,如图8a所示,该试样断裂处的导电胶呈明显的块状结构,说明导电胶在此温度下已发生一定程度的固化,但块状结构之间存在明显的间隙,表明导电胶的交联程度较低。此外,观察发现断面平整,表明导电胶固化后与陶瓷管壳表面结合强度较差,因此,导电胶造成在受到剪切力时,发生整体脱落,这与剪切测试的结果相吻合。
固化温度进一步升高后,达到330℃时,对剪切的断裂面进行分析,结果如图8b所示,导电胶的交联程度显著地提升,块状结构之间的间隙消失,结构更加紧密,且断裂处的断口错落不一,表明导电胶与陶瓷管壳的结合程度较高。紧密的结构和良好的结合程度使得芯片在受到剪切力作用时,具有较强的结构稳定性。
当固化温度为350℃时(如图8c所示),试样的断裂面处导电胶的形貌呈现致密的拉丝状,这表明在受到外部剪切作用力时,胶体表现出一定的延展性。一定的延展性能够在经受剪切力作用时避免刚性断裂,从而保持良好的粘接性能[11]。随着固化温度的进一步提高(如图8d所示),试样断面处的导电胶则呈现出块状颗粒形貌,且颗粒之间空隙较大,表明在较高的固化温度下氰酸酯网络结构遭到破坏,交联程度下降,使得原本致密化的固化状态变为疏松的孔隙结构,从而导致剪切强度下降,这与剪切强度测试的结果相吻合。

图8 不同固化温度时剪切界面处导电胶的SEM图
综合以上结果可知,当固化温度为330℃时,能够使得导电胶充分地固化且芯片与导电胶之间的界面结合力最强。为了进一步地评估该款导电胶在330℃条件下固化后的环境可靠性,随机选取若干个已封电路,参照GJB 548B进行相关验证试验,试验项目及结果如表1所示。

表1 相关环境可靠性试验及结果
从2表中可以看到,相关环境可靠性均能够通过验证,表明该款氰酸酯基的耐高温导电胶对封装体的性能无任何不良的影响,能够满足封装要求。
电路经过热冲击、温度循环、机械冲击和扫描振动后的X-RAY图及相应的孔隙率如图9所示。由于热冲击过程中温度转化速率过大,导致试样在测试过程中产生较大的热应力,且导电胶与芯片之间的热膨胀系数有差异,因此考核后会有孔隙产生,但是孔隙率较低,仅为1.38%,远低于标准要求(25%);电路通过温度循环、机械冲击和扫描振动考核后,孔隙率依然为0,表明该款导电胶在恶劣的环境中仍能保持优异的可靠性。

表2 相关环境可靠性试验后芯片与基板的粘接强度的平均值
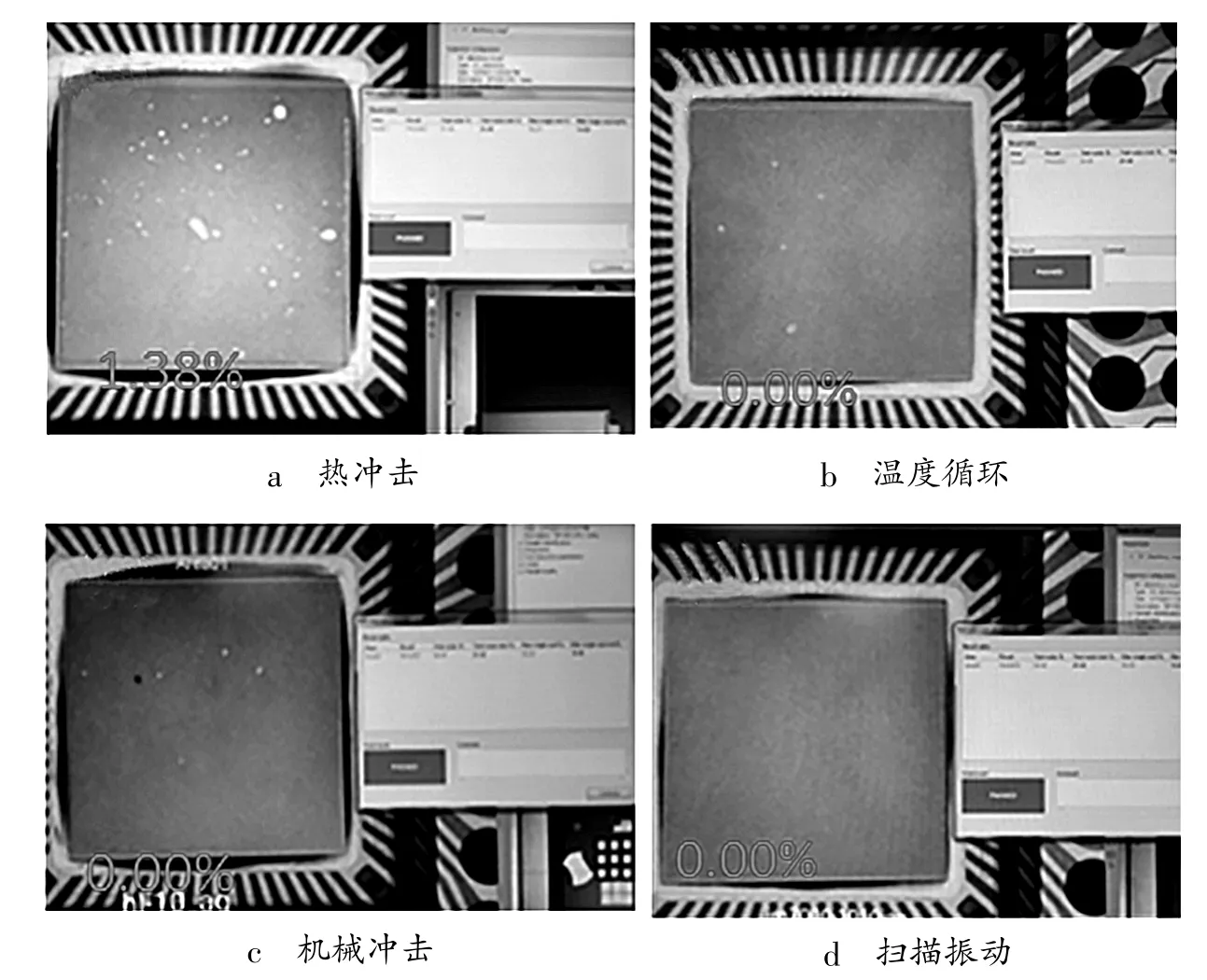
图9 相关环境可靠性试验后电路的X-RAY图及内部孔隙率
3 结束语
本文开展了氰酸酯基的耐高温导电胶在不同固化温度下的可靠性研究,结果表明:该款导电胶过高或过低的固化温度均会影响导电胶内部网络结构,从而降低封装后电路的可靠性;当固化温度为330℃时,导电胶能够充分地固化,在受到外部应力时,导电胶体随着芯片的位移而被拉伸,断裂面处的导电胶的形貌为致密的拉丝状,因而芯片与导电胶之间的粘附力较强。此外,对在330℃的温度下固化的电路进行相关环境可靠性测试均能通过相关验证,表明该款氰酸酯类的耐高温导电胶对封装体的性能无任何不良的影响,能够满足封装要求。

