基于高迁移率晶体管的氮化镓微机械谐振器
郭兴龙,朱友华,葛 梅,李 毅,邓洪海
(南通大学 信息科学技术学院,江苏 南通 226019)
20 世纪以来,集成电路(integrated circuit,IC)由于受到低品质因数无源元器件(如集成电感器、电容器和滤波器)的限制,这使得工程师只能以有限性能的IC 器件为基础或采用分立器件为单元开展电路设计。IC 技术通常需要根据数字或传统的模拟设计进行调整,所以器件的质量、成本和体积对片上系统(system on chip,SoC)有重大影响。因此,微机电系统(micro electro mechanical system,MEMS)[1-4]为传统非芯片实现射频(radio frequency,RF)子组件集成在芯片上创造了机会,并且为微机电设计师提供了新的设计工具,可以设计体积更轻、成本更低和更轻便的无线系统,进行更高水平的系统集成[5-13]。
谐振器是构建振荡器的最基本组件,而机械式MEMS 谐振器具有较高的频率选择性,其体积小、可靠性高、性能稳定,并且能够兼容标准制造工艺而显示出取代石英晶体谐振器的巨大潜力,所以对众多RF 收发机子组件,MEMS 谐振器是用于滤波或生成信号的装置。MEMS 谐振器组件可以通过提高品质因数和降低启动功率获得更高的性能,能够提供灵活的片上再重构的滤波性,还可以与电子装置集成[11-12]。
MEMS 谐振器沿静电制动谐振器和压电薄膜、体声波谐振器两个不同方向发展。可以利用压电薄膜生成体声波(BAW),并已成功制造出相关的高频率基准振荡器和滤波器[14-18]。然而,这种谐振器的谐振频率在很大程度上依赖薄膜厚度,在集成电路和系统中被认为是一个很难控制的参数。因为这种结构层上镀制出的膜层厚度通常是固定的。
氮化镓(GaN)具有优异的力学、热学、电学和光学特性,是继半导体材料硅之后的光电、射频设备和直流电源转换器常用的材料[19-20]。GaN 具有的压电材料高声速的特性可做为谐振器与高电子迁移晶体管(high electron mobility transition,HEMT)的共集成放大器[21-22]。GaN 能够在AlGaN/GaN 界面上由于自发极化和压电极化而形成具有较大电荷密度(1013cm-2)和较高的电子迁移率(1 000 cm2/(v·s))的二维电子气(two-dimensional electron gas,2DEG)层,其压电系数为e31=-0.33 C/m2,e33=0.65 C/m2,是制备HEMT 的理想材料,这些特性使GaN 成为MEMS谐振器的一种合适的材料[23]。GaN 属于宽禁带半导体材料,由此做成的传感器能够承受高电场和高温,是一种能够在恶劣环境中工作的器件[24-25]。在射频功率电子学中、氮化镓异质结构中具有的高电子迁移率的二维电子气体可以用于制造高频谐振传感器的压电器件[26]。此外,氮化镓具有压电效应的输运机制作用[27-29]能够将小信号放大后耦合到谐振器[30],可以利用氮化镓内部压阻效应制作有源器件晶体管。
本文结合氮化镓具有的半导体及压电性能把其谐振器集合到MMIC 工艺中,主要是使用AlGaN/GaN 界面和异质结构的压电特性能够将块体中产生的压电极化转换为放大电流这一特性,设计制作了一款GaN 微机械谐振器,此器件便于与微波电路集成,能够抑制器件自身产生的寄生干扰。此外,这可以用来减少输入电子器件的电容。具有较高的品质因数的氮化镓谐振器可以用于窄频带调制振荡器、固定频率的振荡器和一些无线传感器、声表面滤波器,并且能够和现有的IC 良好地兼容,因此,将来有望取代现有的石英晶体谐振器,并且能够显示出比石英晶体谐振器更高的可靠性。国内鲜有此类研究报道,国外一些研究单位对GaN MEMS 谐振器做了一定的研究[31-36],这些研究具有一定的借鉴意义。基于以上分析,本文研究设计和制作一种使用氮化镓的二维电子气的压电极化特性的谐振器,其工作频率为26.3 MHz。文章对器件的流片过程作了一定的说明,通过对器件进行测试,结果表明HEMT的栅极电压引起的沟道的2DEG 对谐振器的机电转换特性具有一定的影响,提高了其性能。
1 器件原理和设计
常用的ZnO、AlGaAs、AlN 和PbZrTiO3等压电材料主要用硅作为结构层,这些应用的一个主要挑战是有效的机电转换,尤其是在追求更高的共振频率和更高的灵敏度时,共振机械运动的电驱动和传感方案(包括静电、磁动和压电能量的转换)技术要求比较高。然而,随着器件尺寸和驱动面积的减小,静电和磁力耦合的效率降低,对小间隙尺寸的需求需要额外的技术努力,并且在非常高磁场强度的地方,器件需要复杂的工作装置。作为替代方案,可以通过使用压电耦合谐振器来增强微型器件中的耦合强度。
压电GaN 微机械谐振器通常由一个可释放的结构底层组成,该底层控制着器件的弹性特性。由一个薄的压电顶层提供驱动,压电顶层封闭在两个金属层之间,用作顶部和背面电极。AlGaN/GaN 异质结构由于结合了Ⅲ族氮化物的热释电和压电特性[37],因此该材料的结构品质和固有特性适合在小尺寸、以低固有损耗下实现高频谐振[38],而且2DEG具有良好的导电性为形成压电换能器奠定了基础,2DEG 对机械应力具有明确的敏感性,这为HEMT器件的设计形成奠定了基础。
本文设计的GaN 谐振器如图1 所示,器件制作在厚度为625 μm、晶向<111>高阻硅衬底上,其上为1.2 μm 的缓冲层,再上层为GaN,最上层为Al0.22Ga0.78N,厚度分别为0.8 μm 和20 nm,最后设计优化尺寸为70 μm×100 μm 的矩形板结构。HEMT 结构为栅极(G)、源极(S)和漏极(D)三端电极控制器件,肖特基接触构成栅极,欧姆接触构成源极和漏极。通过调节相对于源极的栅极电压,从而调控沟道中的二维电子气(2DEG)密度,实现了栅极电压和漏极电压对漏极电流(输出电流)的控制,并且栅极、源极和漏极3 个电极均制作在器件的同一侧表面,二维电子气所形成的电流在沟道中做水平流动。AlGaN/GaN HEMT 器件中的2DEG的密度可通过求解有外加栅极电压时的薛定愕方程和泊松方程得到。器件在近似耗尽情况下,即是在栅极下的肖特基结的耗尽区和AlGaN/GaN 异质结的耗尽区交叠时,AlGaN 区的耗尽层电荷分布通过求解泊松方程即可得到。当AlGaN 区的耗尽电荷等于阱中电荷时,沟道中的2DEG 面密度与栅极电压的关系可以用式(1)表达,

式中:ε(x)为AlGaN 的介电常数;d 为掺杂AlGaN的厚度和为非掺杂AlGaN 隔离层的厚度之和;Vgs为外加栅极电压;Vth是二维电子气完全耗尽时的栅极电压-阈值电压。AlGaN/GaN HEMT 器件能通过外加栅压控制沟道的2DEG 面密度,在异质结界面束缚了大量的电子,从而形成高浓度的2DEG,实现输出漏极电流随外加栅压和漏极电压的变化而变化。施加偏压的HEMT 器件能够加强压电材料极化强度,进而增强了压电薄膜和电极组成的微机械谐振器的剪切振动模式。
在图1 中,为了降低肖特基栅极的漏电流并便于形成电流调制作用的势垒,AlGaN/GaN HEMT 的栅极采用肖特基接触;源电极和漏电极均要求是欧姆接触电极,便于通态电阻通过良好的欧姆接触得以降低,从而能够产生较大输出电流,使得器件工作在良好的稳定性状态。因此,采用Ni/Au 黏附性较好的接触制做肖特基接触金属。为了降低源极和漏极之间的接触电阻,金属与半导体接触时可以形成非整流接触,采用多层金属欧姆接触Ti/Al/Ni/Au 制作了欧姆接触。
器件的谐振频率可由图2 中RLC 简单等效电路描述,电极与压电材料构成的静电容由式中C1表示,谐振器的频率响应由L 和C0决定,器件的损耗为R。由图2 能够得到串、并联两个谐振频率,RLC支路发生串联谐振,这个是极化向量与电场同相位时得到的,串联谐振频率为

图2 谐振器等效电路图Fig.2 Equivalent circuit diagram of resonator

电场与极化向量反相位,与C1产生并联谐振,谐振谐频率声波损耗最小,谐振频率为

器件的有效机电耦合系数为

HEMT 结构中压电薄膜的材料性能对有效机电耦合系数K 有一定的影响。压电薄膜的表面形貌会导致散射、电极损耗,从而影响器件品质因数。为了避免对器件品质因数产生影响,在器件制作过程中采用了无需加载功率的XeF2气体对硅基底进行各向同性刻蚀,可以避免对器件结构产生附件损伤,降低了器件的残余应力及粗糙度,避免杂质和缺陷造成的散射。
2 工艺制作
因为微机电系统没有标准的工艺库,所以制作每种MEMS 器件都有着不同的工艺步骤和方法。本文使用的AlGaN/GaN 异质结样品是通过MOCVD(金属-有机-化学-气相沉积)在<111>Si 衬底上生长的。外延层由一个GaN 缓冲层和20 nm Al0.22Ga0.78N(见图3(a))组成,器件的制造工艺流程如图3 所示。首先,利用ICP-RIE 在667 Pa 气压下使用Ar/BCl3/Cl2等离子体刻蚀200 nm 深的2DEG 压敏有源区(见图3(b))。为了保证精确的刻蚀深度,使用200 W 的刻蚀射频功率、50 W 平板功率。其次,通过对宽禁带半导体GaN 实施高掺杂工艺获得了较好的金属-半导体的欧姆接触,通过蒸发Ti/Al/Ni/Au(20/120/50/160 nm)4 层金属工艺形成良好的欧姆接触(见图3(c)),使用Au 可以防止金属氧化和降低栅电阻,同时,重新再结晶的Ni 和Pt 用于肖特基结构,继而在900 ℃持续30 s 快速热退火。再次,通过光刻、电子束蒸发Ni/Au(50/100 nm)多层膜及随后的剥离工艺技术形成肖特基接触及HEMT。采用干法蚀刻工艺形成GaN 微机械结构,谐振梁的形成是将通过PECVD 生长的厚度为300 nm 的SiO2作为刻蚀的掩膜层(选择刻蚀比大约为7∶1),通过光刻,采用较高的刻蚀功率(600 W)和极板功率(125 W)第二次ICP 干法快速刻蚀(约430 nm/min)光刻后的指定区域中的GaN 层(见图3(d))。最后,刻蚀体硅以形成器件的谐振梁,这一工序相对比较重要。采用无需加载功率的XeF2气体干法无损刻蚀<111>晶向的硅衬底。制作器件大部分的工艺与IC 工艺兼容,相对比较简单,无需再进行其他工艺研究,但增加了无损XeF2气体干法刻蚀工序,这样做是为了器件保护采取的一项措施。最后形成的悬空谐振梁如图3(e)所示,其物理尺寸为70 μm×100 μm,器件的光学照片实物图如图4 所示。
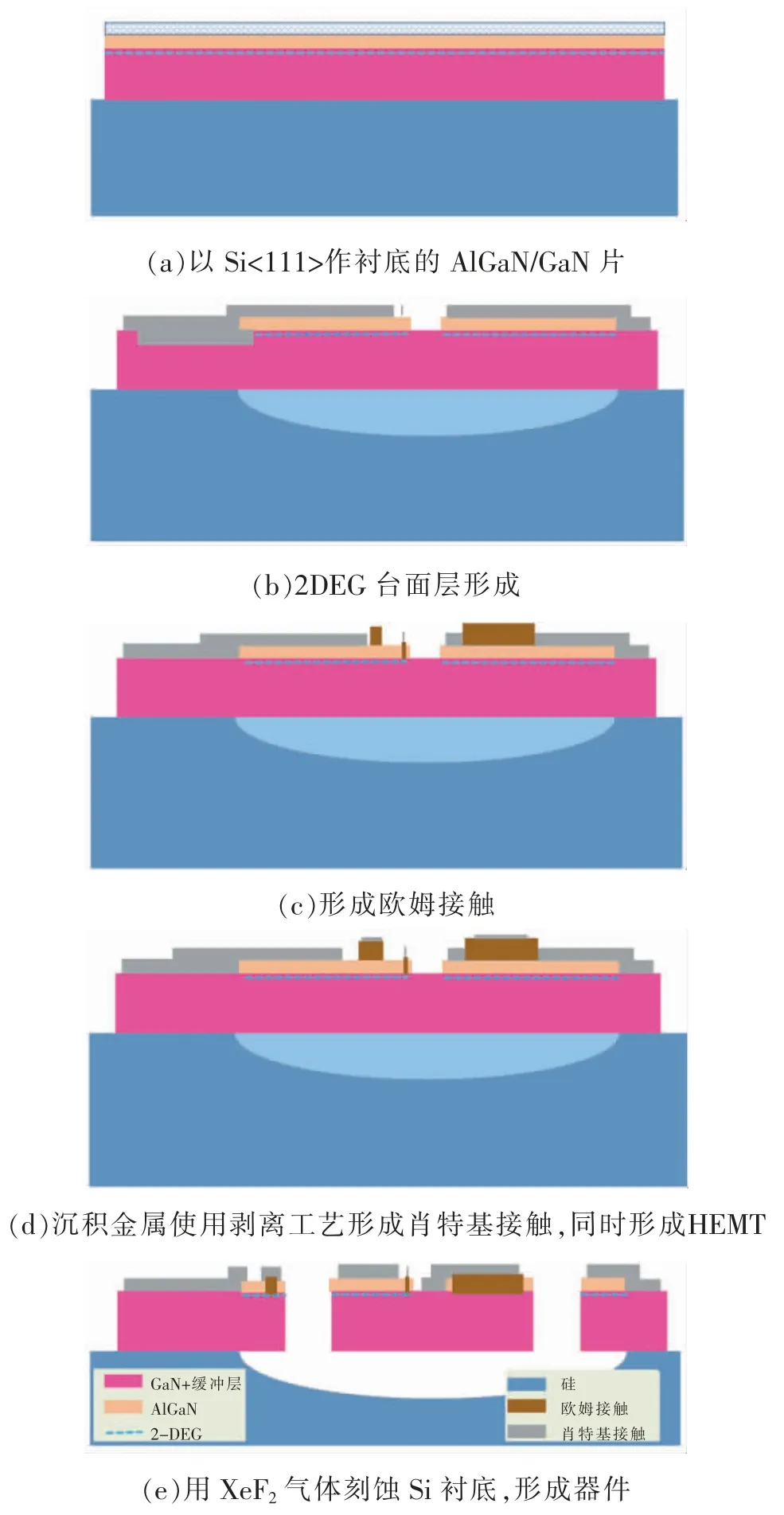
图3 谐振器的工艺Fig.3 Fabrication process

图4 谐振器的实物照片Fig.4 Physical photos of the resonator
3 器件的测试和分析
图5给出了HEMT 的模拟(见图5(a))和测试(见图5(b))I-V 特性图,从图上可以看出器件有良好的线性区和饱和区输出特性曲线,为防止肖特基接触在直流下弱化,采取负直流偏置控制驱动信号。数据曲线结果表明HEMT 器件工作的饱和区相对于模拟数据具有一定的偏移,因为模拟时器件被视为理想的状态,但是在测试时需加载探针及其偏压线,器件受到寄生电容、器件表面缺陷等影响,其性能受到一定的影响。

图5 HEMT 模拟和测试I-V 特性图Fig.5 I-V characteristic of HEMT
采用COMSOL 多物理场环境场对谐振器进行了有限元模拟仿真,仿真时设置谐振器的主体参数,赋予谐振体材料,对其进行了网格划分,使用的网格类型为四面体,最大元件尺寸为λ/10,其中λ是特定谐振器长度两倍的波长。采用负直流偏置控制驱动信号,另一个偏置电极加载在HEMT 的漏极,为了便于探针测试漏极触点引出到旁侧,使用网络分析仪记录传输参数。当f=26.41 MHz 时模拟谐振频率响应与f=26.30 MHz 的测试谐振频率响应基本吻合,但是测试时受到探针、偏压线、寄生电容等影响,响应曲线会出现一定的偏差,如图6 所示。基于HEMT 的谐振器的可调谐性来自顶部肖特基栅极上使用的直流偏置,该偏置控制HEMT 通道中的2DEG 密度和被视为应变传感器HEMT 的传输特性曲线。
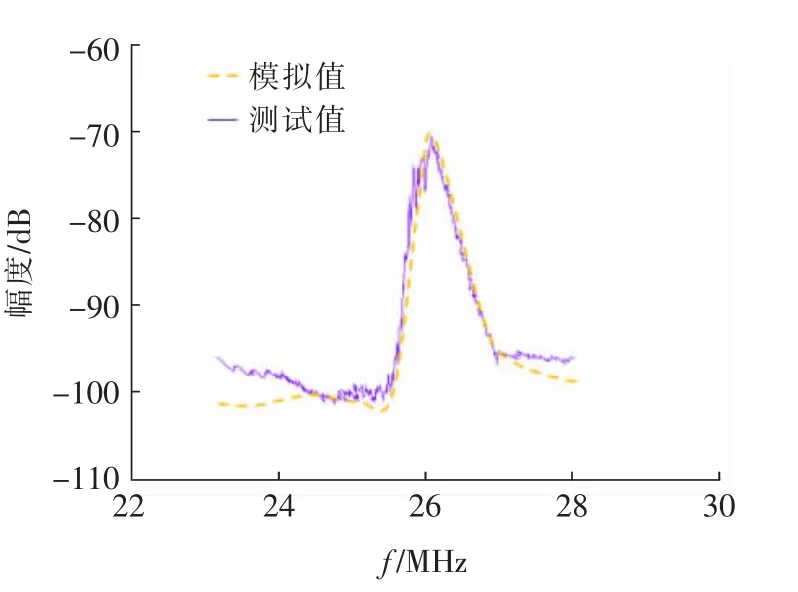
图6 谐振器的频率响应曲线Fig.6 Resonance frequency of resonator
谐振器电机械转换特性测试使用共面探针台(Janis Research ST-100)在1.3 Pa 真空条件下进行的,网络分析仪型号为Agilent E5061A。测量结果均使用终端阻抗50 Ω 获得,在测量设备之前,仪器进行了短、开通(SOT)校准。直流偏压(Vb)加载于肖特基接触栅极上,同时对谐振器施加射频信号,加载的电压至欧姆接触探测2DEG 层。为防止肖特基接触在直流下弱化,负直流偏置控制驱动信号,另一个偏置电极加载在HEMT 的漏极。器件的插入损耗、谐振频率和品质因数等不同的参数性能均由测试获得。测试时设定漏极电压为5 V,栅极电压分别为-1,-2,-3,-4 V,4 种不同偏压情况下2DEG 对换能器的转化的影响情况如图7(a)、(b)、(c)和(d)所示,同时测试出了谐振频点及S21,可以看出在施加偏压时谐振器的谐振频点在26.30 MHz 左右;振幅的变化显示了S21随着栅极电压(Vb从0~-4 V)的变化而发生改变,变化范围约为40 dB,观察到Vp处HEMT 反应减少,电子气产生从AlGaN 层扩散到非掺杂GaN 层,AlGaN 和GaN 之间的异质结中2DEG的浓度是通过栅极下的肖特基势垒来控制的,可以实现对电流的控制。迁移率较高的2DEG 会增加电极到电极的耦合,进一步改进了电流电极的布局,栅极电压可以改变势阱的深度和宽度,从而改变2DEG 的浓度增加谐振效果。并且随着偏压变化,2DEG 逐步耗尽,有助于谐振器输出电极的电荷吸收。品质因数由谐振频率f0(26.30 MHz)除以-3 dB带宽(10.039 kHz)得到,取几个样品测试品质因数,取其平均值为2 620。

图7 不同偏压下的谐振器的S21 变化响应Fig.7 Resonator S21 tunability of the at different bias voltages
4 结论
文章通过AlGaN/GaN 界面薄膜上二维电子气(2DEG)能够产生厚度剪切极化效应振动模式,从而实现增强器件振荡特性技术,设计制作了一种氮化镓谐振器。因为III 族氮化物是由Ⅲ族面(Al-,Ga-,In-)和N 面两个不同的物理和化学特性面组成的极化半导体,所以在AlGaN 和GaN 之间晶格结构的极化效应促进了电子浓度或空穴浓度。对于具有HEMT 结构的AlGaN/GaN 器件,2DEG 极化效应加剧了AlGaN 和GaN 之间的二维电子气密度。III 族氮化物有较大的压电(PE)系数,PE 感应的应变和自发极化对HEMT 器件结构有很大的影响。测试结果表明谐振频率工作在26.30 MHz,品质因数为2 620。文章给出了器件的平面和微机械工艺加工过程,最后得到了尺寸为70 μm×100 μm 谐振单元物理。文章的研究意义在于通过HEMT 结构内压电材料薄膜内正交应力(σx和σy)产生厚度剪切振动模式,实现增强器件振荡特性,增加了谐振器机电共振效果。同时说明使用栅极调节机制能够提供以非机械频率切换或调制谐振器输出方法。

