基于GaN 微米阵列结构的单芯片白光LED 有源区InGaN/GaN 多量子阱结构设计
王永嘉,杨 旭,2,李金钗,2*,黄 凯,2*,康俊勇
(1. 厦门大学物理学系,微纳光电子材料与器件教育部工程研究中心,福建省半导体材料及应用重点实验室,半导体光电材料及其高效转换器件协同创新中心,福建厦门 361005;2.厦门市未来显示技术研究院 嘉庚创新实验室,福建 厦门 361005)
1 引 言
Ⅲ族氮化物具有禁带宽度大、电子漂移饱和速度高、介电常数小、导热性能好、物理化学性质稳定等优点,特别是三元合金InGaN,通过调节合金中In 的组分,可实现禁带宽度从0.7~3.4 eV连续可调,对应的吸收光谱从紫外波段(365 nm)可以一直延伸到近红外波段(1 770 nm),覆盖整个可见光范围,成为新一代固态照明的优选材料[1-3]。目前,商用白光发光二极管(LED)普遍以蓝光LED 激发黄色荧光粉的技术方案为主,其制作工艺成熟且成本较低,但其光谱中缺失蓝绿光和深红光光谱,与自然白光光谱差异较大,导致显色指数不高,难以满足高品质照明的需求[4-5]。同时,降低了白光LED 的寿命和稳定性。因此,在追求高效率的基础上,开发具有高显色性的无荧光粉全光谱白光LED 成为了国际半导体照明发展的新趋势[6-7]。在c面上堆叠多波长量子阱或量子阱堆叠量子点是实现单芯片白光发射的直接途径[8],该方法存在开启电压增大、载流子注入不均匀以及长波长发光峰比例随电流增大而饱和等现象。core-shell 型纳米柱结构是实现单芯片白光的另一方法[9-10],该方法主要利用In 原子并入效率、InGaN 生长速率随纳米柱的尺寸、间距、高度等发生变化这一特点,从而获得不同组分、不同厚度的InGaN/GaN 量子阱有源区,但其外延生长动力学复杂且不同波段发光光谱比例难以调制。近年来,研究者们尝试采用选区外延(SAE)技术或刻蚀技术生长出金字塔形、条纹形、棱台形等具有多种晶面的GaN 微纳结构,为单芯片无荧光粉白光LED 提供了制备新途径[11]。例如,中科院半导体所研究团队采用纳米小球掩膜光刻法结合二次侧向外延(ELO)生长,获得有序六角棱台形纳米岛阵列,并结合量子点实现了显色指数从71.2~87.2 可调的单芯片白光LED[12];日本京都大学研究组采用条纹掩膜图案实现了{0001}极性面(c)和{1122}半极性面生长,制备出由460~480 nm 蓝光发光峰和570 nm 的黄绿发光峰混合而成的白光LED[13];南京大学研究团队采用交叉条纹掩膜图案,制备出具有{1122}、{2133}以及{1101}三种半极性面的微米阵列结构,并实现了涵盖400~650 nm 的宽光谱发射[14]。上述方法主要利用Ⅲ族氮化物材料在不同极性面上的生长速率和极化强度等差异,使得所生长的量子阱厚度和极化场强各不相同,从而获得双波长或者多波长的发射光谱。该技术方案的关键所在为如何有效调控各极性面的发光波长和发光面积,以实现全光谱白光。理论上,所生长的极性面种类越多,其混合发光的光谱波长涵盖范围越宽。然而,其外延生长动力学将变得复杂使得不同发光波段的光谱比例难以调制。为此,本文选取目前生长技术最为成熟的c面和采用SAE 技术最容易实现的{1011}和{1122}半极性面为研究对象,通过模拟仿真,首先设计并优化具有双波长堆叠的c面InGaN/GaN 多量子阱(MQWs)有源层结构,通过调节InGaN 阱层厚度和GaN 垒厚层厚度,实现双波长发光;进而考察在相同外延条件下生长的半极性面InGaN/GaN 堆叠量子阱LED 的发光特性。在此基础上,提出基于多波长堆叠InGaN/GaN 多量子阱结构的c面及{1011}和{1122}半极性面混合的单芯片白光LED设计方案。
2 c 面InGaN/GaN 堆叠量子阱结构优化设计
一般而言,将不同In 组分InGaN 量子阱堆叠起来即可实现多波长发光。然而,由于c面Ⅲ族氮化物具有强极化效应且氮化物LED 中电子和空穴非对称注入,往往使得LED 中有源层多量子阱结构中载流子分布不均匀[15-16]。因此,要通过堆叠量子阱实现多波长发光,其关键问题为如何使电子和空穴在有源层多量子阱结构中均匀分布。本文首先采用Crosslight Software Inc. 设计的APSYS(Advanced physical models of semiconductor devices)软件对双波长堆叠的InGaN/GaN MQWs LED 进行优化设计。
所构建的双波长堆叠InGaN/GaN MQWs LED模型如图1 所示。自下而上分别为:100 µm 厚的c面蓝宝石衬底,掺杂浓度为5×1018cm-3的3 µm厚n 型GaN,5 个周期的InGaN/GaN MQWs,18 nm厚p 型Al0.75Ga0.25N 电子阻挡层(EBL),掺杂浓度为1.2×1018cm-3的15 nm 厚p 型GaN。5 个周期的In-GaN/GaN MQWs 自下而上分别为2 个In0.2Ga0.8N蓝光量子阱和3 个In0.3Ga0.7N 绿光量子阱,如图1右侧所示。器件宽度为200 µm,相关参数设置符合商业化GaN 基LED 典型数值。在模拟计算中,温度设为300 K。俄歇复合系数设为1×1034cm6/s,Shockley-Read-Hall(SRH)复 合 寿 命 设 为100 ns,以上数据均来源于相关文献及实验数据[17-18]。此外,仿真中包含自发极化电荷模型和压电极化电荷模型,采用Fiorentini 等提出的方法计算了In-GaN/GaN 和AlGaN/GaN 界面极化电场引起的总内置电荷密度,不同晶面的极化电荷密度和有效质量由完整的6×6 k.p 模型重新设置[19]。
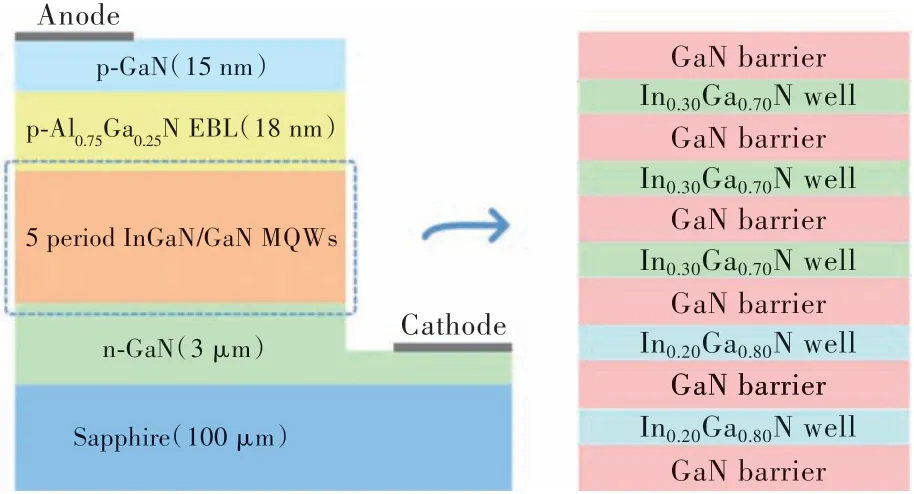
图1 双波长堆叠InGaN/GaN MQWs LED 模型结构Fig.1 Structure of dual-wavelength stacked InGaN/GaN MQWs LED
首先考察量子阱厚度对载流子分布的影响。图2(a)~(c)为固定垒层厚度为10 nm,量子阱厚度分别在1,2,3 nm 时的载流子分布图。其中,蓝色实线为电子浓度,红色实线为空穴浓度,左侧为靠近n 型侧,右侧为靠近p 型侧,将靠近n 型侧的量子阱命名为第一个量子阱(1st QW),依此排序,靠近p 型侧的量子阱命名为第五个量子阱(5th QW)。由图可见,在三种结构中,由于电子迁移率较大,电子浓度分布总体较为均匀;而空穴浓度分布则存在显著的差异,靠近p 型侧的绿光量子阱区中空穴浓度比靠近n 型侧的蓝光量子阱高了近2 个数量级。当量子阱厚度增加时,空穴浓度分布发生较大的变化,空穴浓度值整体随量子阱厚度增加而逐渐升高,并且,越靠近n 型侧的蓝光量子阱中的空穴浓度上升得越快。如图所示,当量子阱厚度从1 nm 增加至3 nm 时,1st QW 中空穴浓度增加了近3 个数量级,而5th QW 中仅增加1 个数量级。图2(d)~(f)为100 A/cm2注入下不同量子阱厚度LED 的辐射复合率分布图,从图中可以看出,1st QW 和2nd QW 中的辐射复合率随阱厚增大而逐渐上升,结合载流子分布图,量子阱厚度增加时,这2 个量子阱中空穴浓度逐渐上升,与电子浓度逐渐匹配,进而导致辐射复合率增加。这些结果表明,量子阱厚度增大,有利于空穴向n型层方向注入,从而使得载流子在有源区中分布得更为均匀,有望实现多波长发光。

图2 具有不同阱层厚度的双波长堆叠InGaN/GaN MQWs LED 载流子分布图((a)~(c))和辐射复合率分布图((d)~(f))Fig.2 Carrier distribution((a)-(c))and radiative recombination rate((d)-(f))of dual-wavelength stacked InGaN/GaN MQWs LED with different QW layer thicknesses
图3 为100 A/cm2电流密度注入下c面不同In-GaN 量子阱厚度LED 电致发光谱(EL)图。由图3可见,与前文预期一致,当量子阱厚度为1 nm 时,只呈现中心波长位于429 nm 的发光峰;随着量子阱厚度增大,载流子分布趋于均匀,发光光谱呈现双峰结构,分别为来自于蓝光量子阱的短波长次发光峰和来自于绿光量子阱的长波长主发光峰。值得一提的是,来自于绿光量子阱的主发光峰随着阱厚由1 nm 增大至3 nm 时,其中心波长由429 nm 显著红移至540 nm,红移量达111 nm 之多;而来自于蓝光量子阱的次发光峰随着阱厚由2 nm增大至3 nm 时,其中心波长红移量相对较小,约为22 nm。研究表明,在极化场作用下的基态量子能级跃迁能量与极化场强度、量子阱厚度等参数密切相关,如下式所示[20]:

图3 具有不同阱层厚度的双波长堆叠InGaN/GaN MQWs LED 电致发光光谱Fig.3 Electroluminescence spectra of dual-wavelength stacked InGaN/GaN MQWs LED with different QW layer thicknesses

其中Eg为InGaN 的禁带宽度,Fw和Lw分别为阱区的极化场和厚度,m*为电子或者空穴的有效质量。通过计算电场强度分布可知,上述绿光和蓝光量子阱中的平均极化场强分别约为2.3 MV/cm 和1.4 MV/cm。结合公式(1)计算可得,当绿光和蓝光量子阱厚度分别增加1 nm 时,其基态量子能级跃迁能量将分别减小0.23 eV 和0.14 eV,与上述波长红移量一致。由此说明,波长随阱厚变化可归因于极化场作用下的量子限制效应。
上述分析结果表明,当量子阱厚度增加至3 nm时,次峰积分强度与主峰积分强度之比可提高至18.2%,但依然无法满足单芯片白光LED 的要求。因此,我们进一步固定InGaN量子阱厚度为3 nm,考察垒层厚度对载流子分布乃至发光性质的影响。图4(a)~(d)为不同GaN垒层厚度LED在100 A/cm2注入下的载流子分布图。同样地,随着垒层厚度增加,电子浓度分布变化不大;但1st QW 和2nd QW 中的空穴浓度逐渐增大,而4th QW 和5th QW 中的空穴浓度随着垒厚增加而逐渐减小,也就是说整个有源区内的空穴浓度分布趋于均匀化。此外,不论是蓝光量子阱还是绿光量子阱区,其电子浓度和空穴浓度空间分离现象均随垒厚增大而略微增强,这一现象可归因于垒层增厚导致量子阱层中的极化电场增强,如图4(e)~(h)所示。而值得一提的是,随着垒层厚度增大,量子垒层中的极化电场反而逐渐减小,与文献报道一致[21]。由图4(e)~(h)可见,当垒层厚度由9 nm 增加至12 nm 时,绿光量子垒层中的极化电场强度降低了0.32~0.34 MV/cm,高于蓝光量子垒层中的极化电场强度的变化量(0.14~0.17 MV/cm)。研究表明,载流子输运不仅与载流子的迁移率有关,还与能带结构密切相关[22]。垒层中的极化电场强度降低意味着载流子从一个阱层传输至下一个阱层所需跨越的有效势垒将降低。为此,我们考察了相应的价带能带结构图,如图5所示,图中实线为价带带边(Valence band),虚线为准费米能级(Quasi-fermi level),价带带边与准费米能级的能量间距即为上文所述的有效势垒,图中由ΔEv表示。由图5 可见,垒层中极化场强降低使其价带带边弯曲程度显著减小,从而导致ΔEv显著减小。例如,当垒厚由9 nm 增加至12 nm 时,空穴跨越第五个量子垒所需克服的势垒ΔEv5由0.77 eV 大幅降低至0.53 eV。最终使得空穴更容易往靠近n型侧的量子阱传输。随着空穴浓度的增加,1st QW 和2nd QW 中 辐 射 复 合 率增 大;而4th QW 和5th QW 中辐射复合率则在空穴浓度降低和极化场强增大的双重作用下急剧减小,如图4(i)~(l)所示。

图4 具有不同垒层厚度的双波长堆叠InGaN/GaN MQWs LED 载流子分布图((a)~(d))、电场分布图((e)~(h))以及辐射复合率分布图((i)~(l))。Fig.4 Carrier distribution((a)-(d)),electric field distribution((e)-(h))and radiative recombination rate((i)-(l))of dualwavelength stacked InGaN/GaN MQWs LED with different QB layer thicknesses.
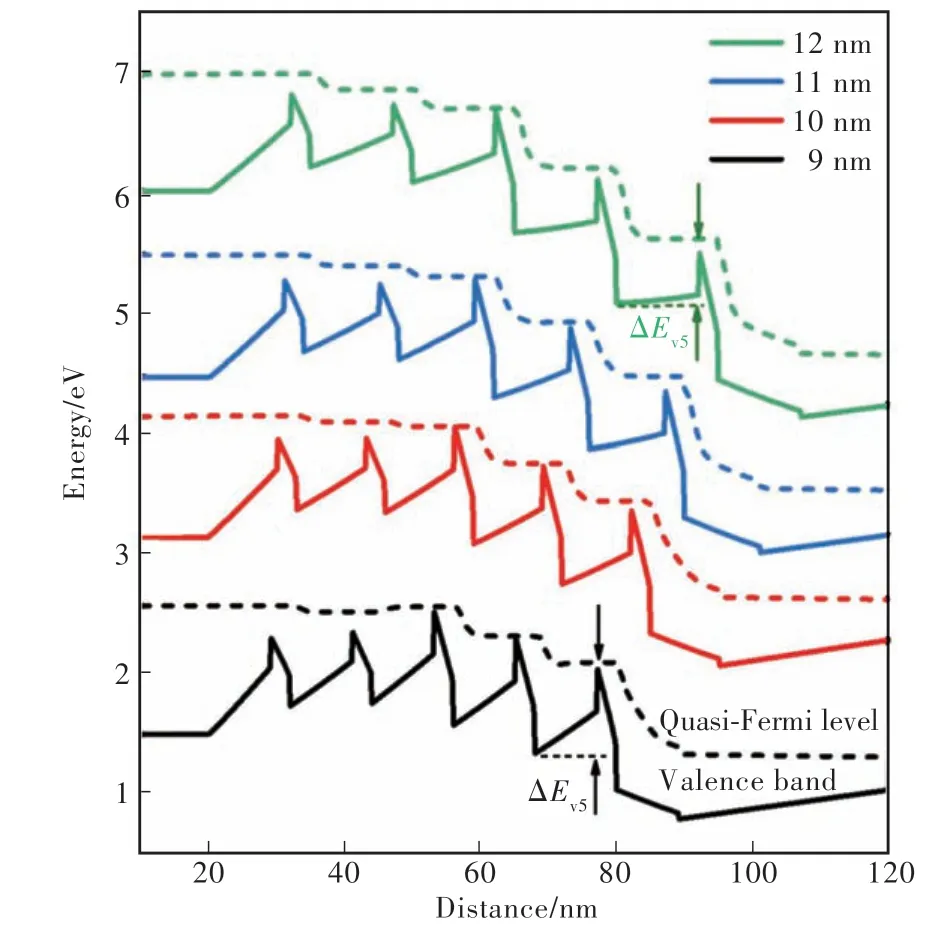
图5 具有不同垒层厚度的双波长堆叠InGaN/GaN MQWs LED 价带结构图Fig.5 Valence band diagram of dual-wavelength stacked InGaN/GaN MQWs LED with different QB layer thicknesses
进一步计算其电致发光谱发现,随着垒厚增大,来自于蓝光量子阱的短波长次发光峰强度逐渐增大,而来自于绿光量子阱的长波长主发光峰强度则逐渐减小,如图6 所示。当垒层厚度由9 nm 增加至11 nm 时,二者的积分强度比由8.3%逐渐增加至37.9%;而在垒层厚度为12 nm 时,短波长发光峰强度超过长波长的,积分强度比为121.6%。如前文所述,这一显著变化主要由4th QW 和5th QW 中空穴浓度降低和极化场强增大的双重作用所引起。特别是垒厚为12 nm 的结构,空穴浓度最高的3th QW 阱层中,其极化场强度相对于垒厚为9 nm 结构增强了约0.27 MV/cm,而垒厚为11 nm 结构中变化量仅约为0.08 MV/cm。此外,由于量子阱层中极化场强度随垒厚增加而增大,使得短波长和长波长发光峰均发生了红移,其波长分别由445 nm 红移至456 nm,由529 nm 红移至546 nm。

图6 具有不同垒层厚度的双波长堆叠InGaN/GaN MQWs LED 电致发光光谱Fig.6 Electroluminescence spectra ofdual-wavelength stacked InGaN/GaN MQWs LED with different QB layer thicknesses
综上所述,通过调节双波长堆叠的InGaN 多量子阱的阱层和垒层厚度,可调控载流子特别是空穴在量子阱有源区的分布,实现双波长发光峰比例调制。其中,当阱厚为3 nm、垒厚为11 nm时,各个量子阱的辐射复合率较为接近,短波长次峰与长波长主峰积分强度比为37.9%。因此,下文中我们将以该结构为基础进行单芯片白光LED的结构设计。
3 基于多波长堆叠InGaN/GaN 多量子阱结构的单芯片白光LED 设计
不同极性面的表面悬挂键密度差异导致其生长速率不同,表1 总结了不同半极性面与c面之间的夹角、生长速率以及极化电场强度[23]。从表1中可以看出,在相同外延条件下,在半极性或非极性面上外延的量子阱,其阱和垒厚度都将比c面上外延的薄,极化电场也较小。根据前文分析,更薄的阱垒结构和较低的极化电场都将使得发光波长蓝移。因此,需将c面量子阱In 组分调高至红、绿光波段,以便将其与半极性或非极性面的短波长发光混合实现白光发射。在下文的模拟设计中,c面多量子阱结构设置为由2 个In0.3Ga0.7N/GaN 绿光量子阱和3 个In0.4Ga0.6N/GaN 红光量子阱堆叠而成,其中阱层厚度均为3 nm,垒层厚度均为11 nm。进而根据表1 中各晶面的生长速率设置各晶面量子结构的阱垒厚度,以考察在相同生长条件下各晶面量子阱结构的发光特性。

表1 不同晶面与c 面夹角、生长速率、极化电场关系以及相同外延生长条件下的阱和垒厚度Tab.1 Angles,growth rate,polarization electric field,QW and QB thicknesses under the same epitaxial growth conditions of different semipolar planes and c-plane
图7(a)为相同外延条件下,不同晶面上的In-GaN/GaN 多量子阱结构LED 的光致发光光谱。从图中可见,c面呈现双波长发光,其中心波长分别位于534 nm 和671 nm;由载流子分布和辐射复合率分布(图7(b)~(c))可知,二者分别来源于In0.3Ga0.7N/GaN 量子阱和In0.4Ga0.6N/GaN 量子阱。而由于半极性面量子阱的阱垒厚度变薄,其空穴主要分布于In0.4Ga0.6N/GaN 量子阱中(图7(d)~(e)),使得半极性面LED 都基本只有一个发光峰。此外,如前文分析,在薄量子阱和低极化场作用下,发光波长发生蓝移。由图7(a)可见,在相同外延生长条件下,{1011}面上生长的量子阱发光波长最短,其中心波长位于445 nm 左右。
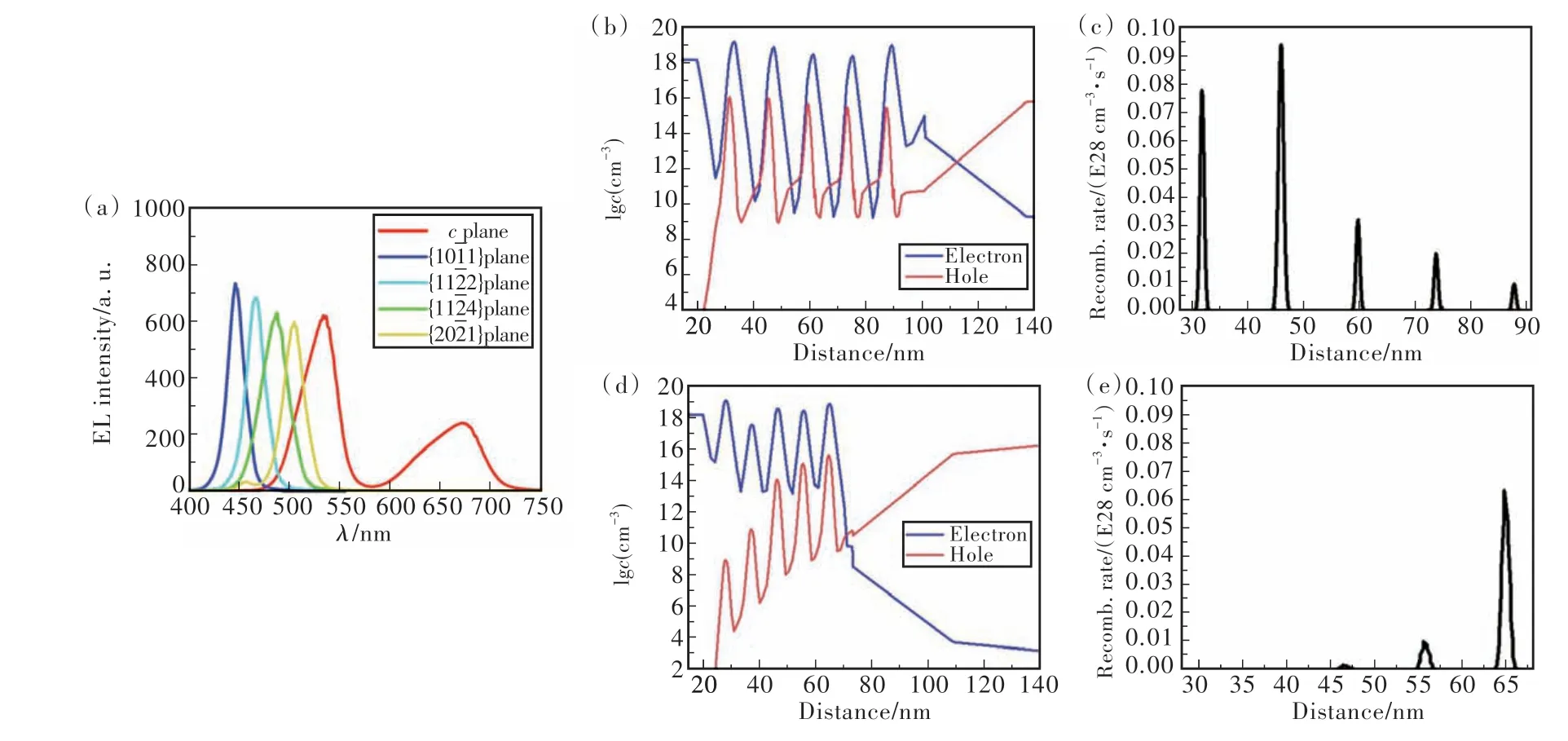
图7 (a)相同注入下各晶面发光光谱;(b)~(c)c 面LED 载流子及电场分布;(d)~(e)半极性面LED 载流子及电场分布。Fig.7 (a)Electroluminescence spectra of LED on different facets under the same injection.(b)-(c)Carrier and electric field distribution of LED on c-plane.(d)-(e)Carrier and electric field distribution of LED on semipolar plane.
上述结果表明,在相同条件下外延生长具有不同晶面的多波长堆叠InGaN 量子阱结构,其发光光谱可覆盖RGB 三色波段。若在外延生长时,通过掩膜图形调节所生长晶面的面积比例,即可混合形成白光。为验证其可行性,我们选取目前生长技术最为成熟的c面和采用SAE 技术最容易实现的{1011}和{1122}半极性面进行组合。此外,由于图7(a)所示光谱中依然缺少550 ~600 nm 黄光波段,我们进一步优化量子阱结构,将多量子阱结构设 置 为 由1 个In0.3Ga0.7N/GaN 量子阱、1 个In0.35Ga0.65N/GaN 量子阱以及3 个In0.4Ga0.6N/GaN 量子阱堆叠而成,其余结构参数不变。图8(a)~(b)显示了由{1011}和{1122}分别与c面按发光面积比为1∶1. 5 组合而成的EL 谱,光谱覆盖了大部分可见光波段,其中蓝光发光峰来自于半极性面量子阱,而位于530,600,680 nm 左右的发光峰则分别 来 自 于 组 分 为0. 3,0. 35,0. 4 的c面InGaN/GaN 量子阱。两个光谱在CIE 1931 色度图中的坐标分别为(0. 32, 0. 33)和(0. 32, 0. 36),色温均为6 000 K。研究表明,通过控制掩模图形、窗口尺寸以及外延条件,可控制半极性面与c面的面积比[24-25]。例如,采用条纹形掩膜图案,生长出底面为40 µm、高度为8.66 µm 的条纹型微米阵列结构,或采用圆孔型掩模图案,生长出底面为7.56 µm、高度为0.28 µm 的棱台型微米阵列结构,即可 获得{0001}∶{1011}或者{1122}面积比为1.5∶1 的单芯片白光LED,如图8(a)~(b)中插图所示。图8(c)显示了面积比由1∶1 提高至3∶1时,所混合而成的白光光谱在CIE 1931 色度图中的坐标。从图中可见,通过调节c面发光光谱在混合光谱中的比例,两种方案均可获得色温从9 000~4 500 K 可调的白光。进而比较其显色指数(CRI)变化趋势,如图8(d)所示,当面积比由1提高至3 时,二者的CRI 均先增大后减小,在面积比为1.5 左右时CRI 值最高。并且,值得一提的是,由{1122}与c面混合的白光光谱显色指数均远高于{1011}与c面混合的白光光谱,CRI 值最高达91.3。上述结果表明,通过SAE 技术生长出同时具有{1122}面和c面的微米阵列多波长堆叠In-GaN/GaN MQWs 结构,有望制备出显色指数高于90 的单芯片无荧光粉白光LED。本文的模拟仿真主要以采用SAE 技术最容易实现的{1011}和{1122}半极性面为例进行结构设计,在实际外延生长中,所生长的半极性面将会随着外延条件和掩膜图案的变化而改变,在确定可获得的晶面类型组合情况下,可进一步通过上述模拟设计方法相应地调整各晶面面积比,为实现高显色指数单芯片白光LED 设计提供指导。

图8 {1011}面(a)和{1122}面(b)分别与c 面按发光面积比为1∶1.5 的混合EL 谱;不同比例半极性面与c 面混合光谱的CIE 1931 色度图(c)和显色指数变化趋势(d)。(a)和(b)插图分别为实验设计条纹微米结构横截面图与棱台微米柱结构俯视图。Fig.8 Mixed EL spectra of{1011}plane(a),{1122}plane(b)and c plane with a ratio of 1∶1.5. CIE 1931 chromaticity diagram(c)and color rendering index(d)of different proportions of semipolar plane and c plane mixed illumination. The insets in(a)-(b)are the cross-sectional view of the experimental design of the fringe structure and the top view of the prismatic structure,respectively.
4 结 论
本文通过APSYS 模拟仿真,研究了不同阱、垒厚度对c面InGaN/GaN 双波长堆叠多量子阱LED 发光特性的影响。结果表明,量子阱和垒的厚度增大,有利于空穴向n 型层方向注入,从而使得载流子在有源区中分布得更为均匀。当阱厚为3 nm、垒厚为11 nm 时,可实现短波长次峰与长波长主峰积分强度比为37.9%的双波长发光。进而考察在相同外延条件下生长的半极性面In-GaN/GaN 堆叠量子阱LED 的发光特性,分析发现,在薄量子阱和低极化场作用下,空穴主要分布于靠近p 型侧的量子阱中,使其仅呈现单个发光峰,且发光波长发生蓝移。其中,{1011}面上生长的量子阱发光波长最短,其中心波长位于445 nm左右。在此基础上,提出基于多波长堆叠InGaN/GaN 多量 子 阱 结 构 的c面和{1011}或{1122}半 极 性面混合的单芯片白光LED 设计方案,通过调节c面发光光谱在混合光谱中的比例,可获得光谱覆盖大部分可见光波段、色温从4 500~9 000 K 可调、显色指数最高达91.3 的白光,为实现高显色指数的单芯片无荧光粉白光LED 提供了有效的设计方案。
本文专家审稿意见及作者回复内容的下载地址:http://cjl.lightpublishing.cn/thesisDetails#10.37188/CJL.20220115.

