SiGe/Si异质结PIN顶注入电光调制器的数值分析
冯露露,冯 松,胡祥建,王 迪,陈梦林
(西安工程大学 理学院,西安 710048)
随着全球通信技术的迅速发展,硅基电光调制器作为光互连系统的关键部件之一受到了广泛的关注[1]。由于硅中不存在直接电光效应,因此通过载流子浓度改变引起折射率和吸收系数变化的等离子体色散效应是硅基电光调制器经常采用的一种调制机理,基于等离子体色散效应的电光调制器具有调制速率高、传输损耗小等优点,已被证明可以广泛应用于光互连通信系统。
2004年Intel 报道了第一个基于等离子体色散效应的调制器[2],该调制器为金属氧化物半导体(Metal-Oxide-Semiconductor,MOS)电容结构,虽然最终实现带宽仅 1 GHz,但它的成功研制标志着硅基光电子学在光通信领域的开端,具有里程碑意义。目前最常见的调制方式主要有三种:PIN载流子注入式[3-4]、PN载流子耗尽式[5-6]和MOS电容式[7-8],2005 年,康奈尔大学报道了一种基于微环谐振腔的正向 PIN 二极管高速硅基电光调制器实现了速率为1.5Gbps 的光调制[9],2010年,日本纳米电子研究实验室的J.Fujikata等人采用脊型光波导结构制作出了速率为25 Gbps的MOS型硅基电光调制器[10]。2014年,新加坡微电子研究所也制作出了速率为50Gbps的硅基电光调制器[11];尽管反向偏置PN二极管的行波型全硅基调制器已经显示出了超过50Gbps的高调制速率,但是由于PN结的硅基调制器的等离子体色散效应和自由载流子吸收不够强,所以它们在低功耗方面存在问题。具有的调制效率仍然较低。PIN电光调制器以载流子注入的方式工作,施加正向偏压后,调制区的载流子浓度迅速增加,引起调制区的折射率下降,从而对传输光波进行调制。由于PIN电光调制器在较小的正向偏压下,载流子浓度变化较大,并且调制区的载流子分布较均匀,因此调制区的电荷变化总量较大,使得这种结构的电光调制器具有较高的调制效率。
为此,文中提出了基于Drude模型[12]的等离子体色散效应,通过SiGe/Si异质结的材料特性和改善载流子注入的特性,进一步增强了电光调制过程中的等离子体色散效应。利用数值方法对SiGe材料的等离子色散效应进行了分析,设计了一种SiGe/Si异质结PIN顶注入硅基电光调制器,分析了在1.55 μm近红外波长下SiGe/Si异质结PIN顶注入电光调制器的载流子注入特性,对其调制特性进行了数值研究。
1 器件原理与结构
电光调制里有两种常见的电光效应,分别是直接电光效应和间接电光效应。直接电光效应是在电信号的作用下,使得材料中的电荷位移发生极化,材料的介电常数影响其极化的强度,例如Pockels线性电光效应,Kerr非线性电光效应等都属于这种电光效应。间接电光效应是在电信号的作用下,改变材料的光吸收谱以实现折射率变化,例如Franz-Keldysh(F-K)效应,等离子色散效应等都属于这种电光效应。SiGe材料与Si材料类似,不具有Pockels线性电光效应,而且其 Kerr非线性电光效应也很弱,因此采用SiGe材料或Si材料制作的电光调制器,都是利用其间接电光效应进行电光调制。间接电光效应中的F-K效应也称电吸收效应,实质是电子在导带和价带间的场隧穿效应,改变了材料的吸收谱,借助外加电场改变了材料的折射率。F-K效应导致的折射率改变比较弱,外加电场为105 V·cm-1时,产生的折射率的变化仅为1.5×10-5。等离子色散效应是另外一种常见的间接电光效应,主要通过调制区载流子浓度的变化,改变其吸收系数,从而使得材料的折射率发生改变。当载流子浓度改变为1018cm-3时,所产生的折射率改变可达10-3,比起Kerr效应或F-K效应,其折射率的改变量高出了两个数量级[13]。因此,常见的SiGe材料或Si材料制作的电光调制器主要是通过等离子色散效应来完成电光调制。前期研究表明载流子注入浓度与SiGe中Ge含量的关系可知,载流子注入浓度随着Ge含量的增大而增大,当Ge含量超过0.2后,载流子注入浓度几乎不再增加[14-15]。
图1为SiGe/Si异质结PIN顶注入电光调制器的截面图,该结构基于SOI(绝缘体上硅)平台设计。平板波导层由Si材料组成,厚度为50 nm,脊型调制区由SiGe材料组成,宽度420 nm,高度170 nm,根据前期Ge含量的分析[13],Ge含量选取0.2。平板波导层的掺杂剂为磷,中间区域的掺杂浓度为1E15 cm-3,两端是掺杂浓度为1E20 cm-3的n++重掺杂区。脊型调制区的掺杂剂为磷,掺杂浓度为1E15 cm-3,顶注入区是掺杂浓度为1E20 cm-3的p++重掺杂区。n++重掺杂区与脊型调制区之间的距离是1 μm。该结构中掺杂浓度为1E15 cm-3的区域可以看作本征区(I区),它可以等效为一个P-I结和一个N-I结。p++重掺杂区连接正极,n++重掺杂区连接负极,二者之间形成偏置电压。
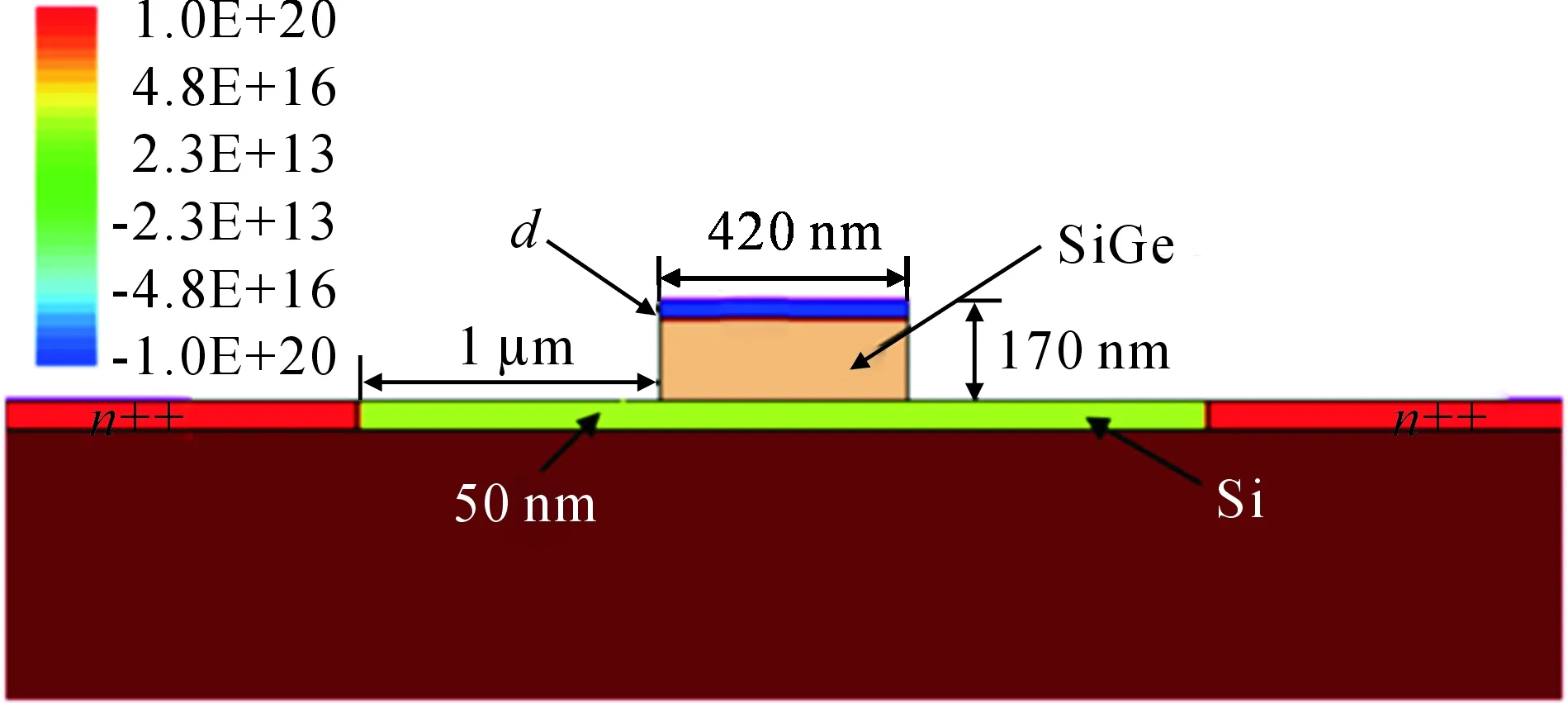
图1 SiGe/Si异质结PIN顶注入电光调制器的截面图
SiGe/Si异质结PIN顶注入电光调制结构器工作时,在器件有源区之间加载电信号,改变器件内部注入载流子浓度,引起调制区折射率的改变,从而使得调制区中传输的光波波长发生偏移,从而达到器件对光信号调制的目的。当偏置电压为零时,本征区内的载流子浓度很小,主要集中在P-I结和N-I结附近;当偏置电压为正时,本征区的载流子浓度增加,内建电场减小,导致扩散电流大于漂移电流,引起折射率下降。当偏压为负时,载流子被反向抽取,随着载流子浓度减小,本征区的内建电场增大,漂移电流占主导。SiGe/Si异质结PIN顶注入电光调制器工作时,器件处于正向偏置电压下,p++顶注入区向脊型调制区注入空穴,n++重掺杂区向脊型调制区注入电子,由于SiGe/Si异质结势垒高度小于Si同质结势垒高度[14],因此脊型调制区具有更大的载流子注入浓度。
2 调制器数值分析
2.1 等离子色散效应
根据Drude模型,忽略杂质离化的影响,一级近似后可得到折射率变化Δn、吸收系数变化Δα(单位为cm-1)与自由载流子浓度变化(单位为cm-3)的关系为
(1)
(2)

将相关物理量代入式(1)和式(2)可得,当λ0=1.55 μm时,
Δn=Δne+Δnh=-(1.2×10-23ΔNe+8.0×10-24ΔNh),
(3)
Δα=Δαe+Δαh=3.6×10-19ΔNe+5.1×10-19ΔNh,
(4)
从式(3)和式(4)中可以看出,SiGe材料的折射率变化Δn随着载流子浓度增大而减小,吸收系数变化Δα随着载流子浓度增大而增大。
文献[16]利用Kramers-Kronig关系和光吸收谱的实验数据,计算出了等离子体色散效应的近似公式[16],当λ0=1.55 μm时,
Δn=Δne+Δnh=-[8.8×10-22ΔNe+8.5×10-18(ΔNh)0.8],
(5)
Δα=Δαe+Δαh=8.5×10-18ΔNe+6.0×10-18ΔNh。
(6)
随着工艺水平的提升,式(5)和式(6)也根据最新的实验数据进行了修正[16],当λ0=1.55 μm时,
Δn=Δne+Δnh=-[5.4×10-22(ΔNe)1.011+1.53×10-18(ΔNh)0.838],
(7)
Δα=Δαe+Δαh=8.88×10-21(ΔNe)1.167+5.84×10-20(ΔNh)1.109。
(8)
由于SiGe材料是Si和Ge的合金,SiGe的折射率[17]可表示为
nSiGe=nSi+0.37x+0.22x2,
(9)
其中x为SiGe中Ge含量的大小。因此当λ0=1.55 μm时,文中SiGe的等离子体色散效应的近似公式为
ΔnSiGe=Δne+Δnh=-[5.27×10-22(ΔNe)1.011+
1.49×10-18(ΔNh)0.838],
(10)
ΔαSiGe=Δαe+Δαh=8.67×10-21(ΔNe)1.167+5.7×10-20(ΔNh)1.109。
(11)
从式(10)和式(11)中可以看出,空穴的吸收系数变化Δαh比电子的吸收系数变化Δαe小,但是空穴的折射率变化Δnh却比电子Δne大,因此,空穴是理想的载流子,调制器也通常采用空穴优化偏置结的设计,文中的顶注入区也采用了SiGe材料来加强偏置结的空穴注入。
2.2 器件参数分析
根据折射率变化Δn、吸收系数变化Δα的公式可知,顶注入区对调制器的载流子注入影响很大,因此针对顶注入区的厚度和掺杂浓度分别进行了数值分析。
图2是顶注入区厚度从10 nm变化到50 nm时偏置电压与载流子浓度的关系曲线,图中横坐标表示调制器的正向偏置电压,纵坐标表示调制区的载流子浓度。从图2中可以看出,当正向偏置电压小于0.6 V时,调制区的载流子浓度几乎处于本征状态;当正向偏置电压大于0.6 V时,调制区的载流子浓度随着正向偏置电压的增大而逐渐上升;当偏置电压一定时,不同顶注入区厚度下,调制区的载流子浓度也不相同,调制区的载流子浓度随着顶注入区厚度的增大而增大。
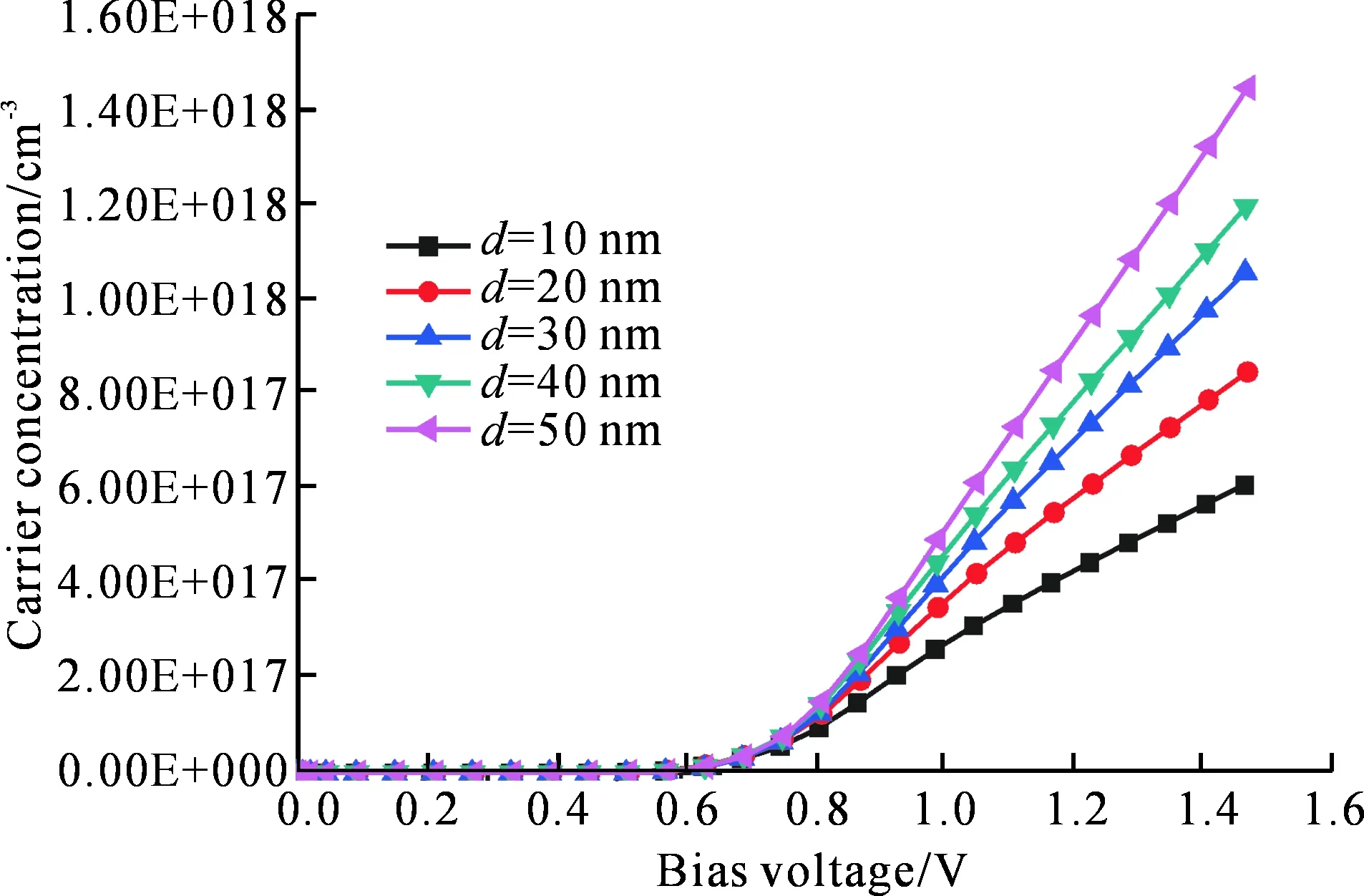
图2 不同顶注入区厚度下偏置电压与载流子浓度的关系
图3是顶注入区掺杂浓度从1E19 cm-3变化到1E20 cm-3时偏置电压与载流子浓度的关系曲线,图中横坐标表示调制器的正向偏置电压,纵坐标表示调制区的载流子浓度。从图3中可以看出,当正向偏置电压小于0.6 V时,调制区的载流子浓度几乎处于本征状态;当正向偏置电压大于0.6 V时,调制区的载流子浓度随着正向偏置电压的增大而逐渐上升;当偏置电压一定时,不同顶注入区掺杂浓度下,调制区的载流子浓度也不相同,调制区的载流子浓度随着顶注入区掺杂浓度的增大而增大;当顶注入区掺杂浓度大于3E19 cm-3后,调制区的载流子浓度上升变缓。

图3 不同顶注入区掺杂浓度下偏置电压与载流子浓度的关系
为了体现SiGe/Si异质结PIN顶注入电光调制器具有较高的载流子注入浓度,我们对SiGe/Si异质结调制器与硅基调制器进行了数值分析比较。
图4为SiGe/Si异质结调制器与硅基调制器的偏置电压与载流子浓度的关系曲线。

图4 SiGe/Si异质结调制器与硅基调制器的偏置电压与载流子浓度的关系
图4中横坐标表示调制器的正向偏置电压,纵坐标表示调制区的载流子浓度,调制器的顶注入区厚度为30 nm,掺杂浓度为1E20 cm-3。从图4中可以看出,当正向偏置电压大于0.6 V时,SiGe/Si异质结调制器的载流子浓度明显大于硅基调制器的载流子浓度,而且正向偏置电压越大,二者之间的载流子浓度差值越大。这是由于SiGe/Si异质结调制器中Si和SiGe之间存在能带偏移,载流子被限制在SiGe层中,因此SiGe层中的载流子浓度要比Si层中的载流子浓度大。因此,通过将载流子聚集到SiGe层中,可以进一步增强折射率和吸收系数的变化,使得SiGe/Si异质结调制器中的折射率和载流子吸收系数变化比硅基调制器更大,如图5所示。

图5 SiGe/Si异质结调制器与硅基调制器的偏置电压与折射率变化Δn、吸收系数变化Δα的关系
当顶注入区厚度为30nm,掺杂浓度为1E20 cm-3时,SiGe/Si异质结调制器与硅基调制器的偏置电压与折射率变化Δn、吸收系数变化Δα的关系曲线如图5所示,图中横坐标表示调制器的正向偏置电压,左侧纵坐标表示调制区的折射率变化Δn,右侧纵坐标表示调制区的吸收系数变化Δα。从图5中可以看出,当正向偏置电压大于0.6 V时,SiGe/Si异质结调制器中的折射率变化Δn和吸收系数变化Δα均比硅基调制器大,SiGe/Si异质结调制器具有更大的等离子体色散效应。在相同折射率变化Δn下,SiGe/Si异质结调制器所需的驱动电压比硅基电光调制器更小,在相同吸收系数变化Δα下,SiGe/Si异质结调制器所需的驱动电压同样也小于硅基电光调制器。
当顶注入区厚度为30 nm,掺杂浓度为1E20 cm-3时, SiGe/Si异质结调制器与硅基调制器的偏置电压与衰减的关系曲线如图6所示,图中横坐标表示调制器的正向偏置电压,纵坐标表示调制器的衰减。从图6中可以看出,随着正向偏置电压的升高,两种调制器的衰减也逐渐增大。在相同结构参数下,SiGe/Si异质结调制器的20 dB衰减所需的调制电压为0.99 V,硅基电光调制器所需的调制电压为1.24 V,由于调制器的调制效率与调制电压成反比,调制电压越低,其调制效率越高,因此SiGe/Si异质结调制器的调制效率更高,其调制效率约为硅基调制器的1.25倍。

图6 SiGe/Si异质结调制器与硅基调制器的偏置电压与衰减的关系
3 结 论
1) 在1.55 μm近红外波长下,建立了SiGe/Si异质结PIN顶注入电光调制器结构,分析了SiGe/Si异质结PIN顶注入电光调制器的载流子浓度变化与折射率、吸收系数和衰减的关系,优化了顶层注入区的厚度和掺杂浓度,提高了SiGe/Si异质结调制结构的载流子注入浓度,并与硅基调制器进行了对比研究。
2) SiGe/Si异质结PIN顶注入电光调制器有效增大了折射率变化和吸收系数变化,增强了等离子体色散效应,20 dB衰减所需的驱动电压从1.24 V降到0.99 V,SiGe/Si异质结PIN顶注入电光调制器的调制效率约为硅基调制器的1.25倍。通过SiGe/Si异质结PIN顶注入电光调制器的数值分析,从机理上SiGe/Si异质结具有提高调制区载流子注入效率的作用,有效提高调制区的载流子注入浓度,降低电光调制器的调制电压,增强调制效率,改善电光调制器的性能,SiGe/Si异质结PIN顶注入电光调制器是一种替代硅基电光调制器的理想器件。
3) SiGe/Si异质结的界面的质量直接决定着器件的特性,SiGe与Si 的失配度较大,改善晶格匹配需要依赖更好的异质结制备工艺。SiGe/Si异质结PIN顶注入电光调制器作为一种替代硅基电光调制器的理想器件,在优良的异质结制备工艺和器件加工工艺的基础上,以期实现集成化应用。

