PPF框架在半导体工业中的应用
李庆生
(铜陵三佳山田科技有限公司技术部,安徽 铜陵 244000)
1 引言
2003年1月27日,欧盟议会和欧盟理事会通过了2002/95/EC指令,即“在电子电气设备中限制使用某些有害物质指令”(The Restriction of the use of Certain Hazardous Substances in Electrical and Electronic Equipment),简称RoHS指令。基本内容是:从2006年7月1日起,在新投放市场的电子电气设备产品中,限制使用铅、汞、镉、六价铬、多溴联苯(PBB)和多溴二苯醚(PBDE)等六种有害物质。 RoHS指令发布以后,从2003年2月13日起成为欧盟范围内的正式法律; 2006年7月1日以后,欧盟市场上将正式禁止六类物质含量超标的产品进行销售。
PPF框架的开发是为了适应无铅化的工艺流程而开发的一种新型的封装用材料,主要目的是避免在电路打线和装配过程中使用含铅焊料。PPF制程免除了电镀/清除工序,为半导体制造商带来简化IC封装流程的优势,从而省去对大型设备的投资和缩短制造周期。此外,与镀纯Sn方法相比,用户的线路板装配工序可采用与锡/铅(SnPb)相同的回焊制程,并且不会有锡须的问题。
2 框架表面处理的发展过程
引线框架的发展经历了从简单到复杂,从低密度到高密度;同样,引线框架表面处理发展也经历了一个过程,如图1所示。

引线框架的表面处理质量如何影响到整个后道制程的生产,在对引线框架进行表面处理时需要考虑以下几个方面的问题:
(1)打线时的可焊性(金线键合时与框架表面是否能够牢固的结合);
(2)是否能够满足微细引脚间距的要求;
(3)是否能够和电路装配制程很好的兼容(260℃回流焊);
(4)是否能够满足封装工艺性要求;
(5)是否能够满足绿色环保要求。
3 PPF框架的结构和基本应用
3.1 纯锡电镀
为了实现无铅(LEAD FREE)制程的绿色封装,IC产品生产商们都在寻找用于替代锡铅合金的材料。最初人们使用镀纯锡来替代锡铅合金,但是纯锡容易生长出一种称之为“晶须”的东西,它是在一定环境条件下,在表面处理使用纯锡或含锡合金的电子组件焊脚上,经过一段时间表面会生长出像胡须一样的锡丝。它的生长速度相当缓慢,但具有很强的不确认性,所以对于焊脚间距小的电子部件,由于晶须的生长,可引发部品焊脚之间的短路导致部件永久性失效或间歇性失效。生成“晶须”的原因有很多,基本的说法是“晶须”的产生是由于锡与铜之间的化合或外部作用,如温度湿度的变化,或直接外力作用,引发内部应力,而长出锡胡须。目前降低晶须产生的可靠性风险的方法主要有以下几种:
(1)不要使用亮锡;
(2)用晶粒尺寸较大的灰锡可减缓“晶须”生长速度;
(3)使用较厚的灰锡镀层(最小8μm、10μm最佳);
(4)电镀后24h内退火(150℃/2h或170℃/1h),以减少Sn层内应力;
(5)电镀后24h内回流焊接,作用同退火。
下图2为“晶须”图片。
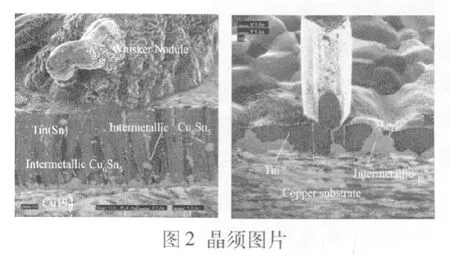
以上措施虽然可以降低“晶须”产生的可靠性风险,但是不能完全杜绝或控制“晶须”的产生,对于的引脚间距小于0.5mm的电路产品和对其可靠性要求高的场合下,纯锡电镀的表面处理方式是不适应的,比如说用于军品的集成电路以及空间技术产品等。必须找到其他更好的表面镀层来代替锡铅镀层。
3.2 NiPdAu镀层结构
为了适应无铅化进程(Pb-free),不少半导体公司正趋向选用镍/钯/金预镀(NiPdAu PPF)引脚焊料涂层,以简化生产制程。 但是这种方法需要考虑的是NiPdAu涂层上金粘结的质量、其引脚成形加工时如何避免过程中的损伤以及选择正确的原材料组合(晶片附着环氧树脂和封装复合材料),可在260℃下达到1级MSL (湿气灵敏度)。
NiPdAu合金预镀引脚框架(PPF)一般由铜基框架预镀上镍和钯加上薄金涂层构成。PPF制程免除了电镀/清除,为半导体制造商带来简化IC封装流程的优势,从而省去对大型设备的投资和缩短制造周期。 此外,与镀纯锡方法相比,用户的线路板装配工序可采用与锡/铅(SnPb)相同的回焊工艺,并且不会有锡须的问题。图3、图4所示的是NiPdAu涂层的结构以及在IC电路中的应用。
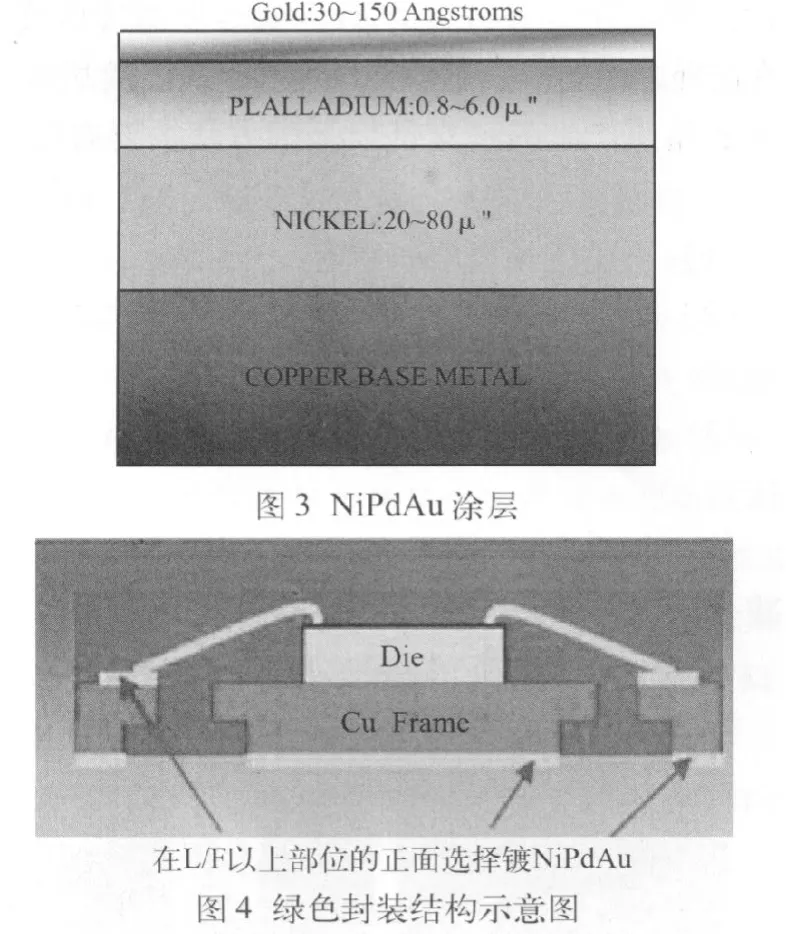
如图3、图4所示,附加的外部薄金涂层具有高热阻,不仅可以用作防止内部钯氧化的保护层,还可以在使用更高引脚粘合温度时阻止表面氧化。加上其在焊料中的高扩散比率以及较低的有机吸收倾向,能够提高焊接过程的分解速度,使其拉拔强度较其他钯结构材料高, 而使用此物质也就不会存在Cu-Sn金属化合物。相当于其他的表面处理方式,NiPdAu合金预镀引脚框架(PPF)具有以下的优点:
(1)避免了纯锡镀层容易引起“晶须”的缺陷;
(2)相对于NiPd镀层,由于减少了贵金属钯的用量,成本得到了控制;
(3)相对于PMF(POST-MOLD FINISH)流程,使用PPF框架简化了流程,节省了人力和相关设备投资;
(4)适应无铅化绿色封装;
(5)适应所有微细引脚间距产品的封装,如QFP/TQFP/SSOP/TSSOP/QFN/SOT/SOIC等。
图5、图6、图7显示的是NiPdAu合金预镀引脚框架(PPF)在16L QFN产品中的应用。
4 工艺难点和解决方法
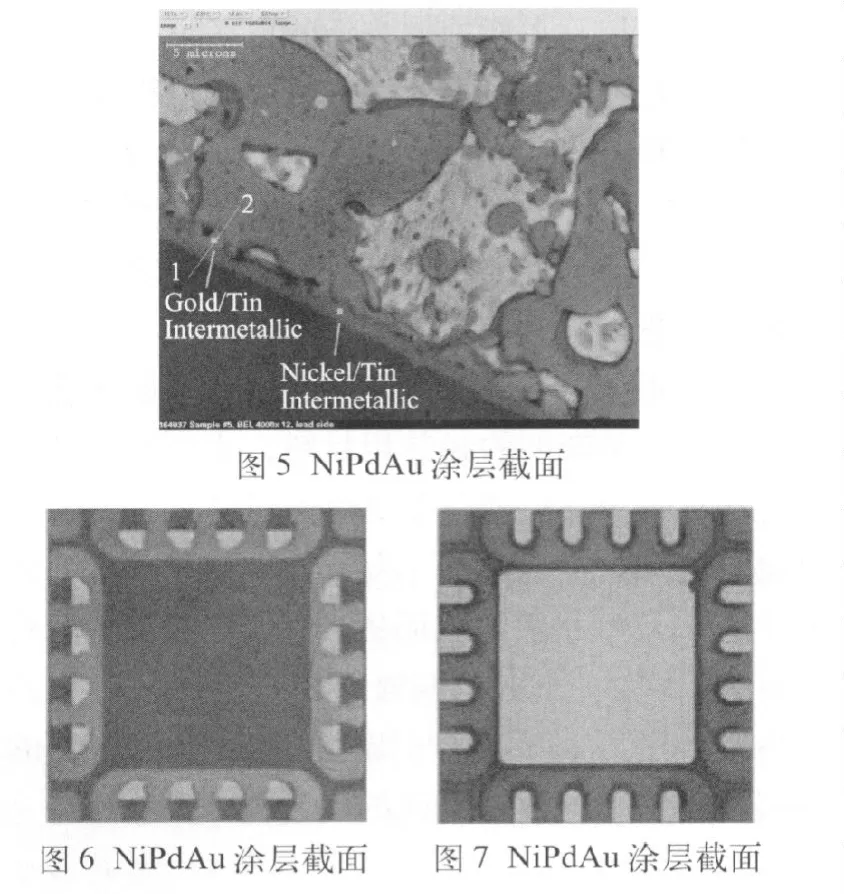
虽然NiPdAu镀层的PPF框架具有以上的优越性能,但是任何事物都有其不利的一面,NiPdAu镀层也有其工艺上的难点需要我们去克服,具体体现在以下四个方面:
(1)在升高到260℃峰值回流温度下达到1级MSL(潮湿敏感度)性能;
(2)打线时的引脚粘合性能;
(3)引脚弯曲成型时形状、尺寸和表面擦伤的控制;
(4)焊锡性。
由于本文篇幅的关系,我们将对上述中的第一点和第三点进行介绍,其中重点介绍引脚弯曲成型时形状、尺寸和表面擦伤的控制以及与其有关的成型刀具的处理要点。
4.1 高峰值回流温度下达到1级MSL性能的控制
260℃回流温度下的1级MSL性能由于NiPdAu镀层的熔点温度较高,因此需要提高焊料结点成形时的回流温度,并针对260℃峰值回流温度下的1级MSL性能进行评估。这是使用NiPdAu镀层PPF框架工艺中的难点,因为现今大多数材料组合都在这个温度水平下都出现失效。 一般来说,峰值回流温度每升高5℃~10℃,MSL性能就会降低一级。这是由于内部潮气气压的爆米花效应所造成,当封装暴露于更高温度时会带来一系列介面分层和内部裂纹问题。 钯基PPF的粘合强度比铜引脚框架低,更易于产生这种现象。针对这个问题我们所要做的是选择合适的环氧树脂和铸模复合材料,提高新型聚合物和框架的结合力,防止产品由于内应力或结合力不高等原因而出现分层现象。并对聚合物材料进行特性鉴定,以满足产品的特殊工艺性的要求。需要强调的是,选择新型材料时,一定要在封装后对其进行一系列严格的测试,来最终评定材料是否符合工艺要求。测试流程可以参照JEDEC相关的流程文件。
4.2 引脚弯曲成型时形状、尺寸和表面擦伤的控制
在对NiPdAu镀层的PPF框架进行引脚成型时,必须要注意解决好以下的几个问题,防止由于工艺失当而造成产品报废:
(1)产品的成型的尺寸,特别是和装配有关的尺寸,如外形尺寸、站脚高度、引脚成型角度以及C区长度尺寸(在gauge plane平面上)等;
(2)注意控制产品引脚的共面性;
(3)注意控制引脚第一弯脚区和第二弯脚区的R尺寸,防止出现弯脚裂纹;
(4)注意引脚在第二弯脚区的擦伤;
(5)控制产品的肩部不要和胶体(package)出现分层现象。
4.3 产品成型尺寸及形状的控制
从理论上讲,因为使用与现有铜材料相同的基底,应该不会对封装外形和适应性造成影响。 但是,根据实际的使用情况,由于镍的硬度原因,可能无法获得所需的侧翼和引脚角度,从而影响线路板安装过程中的引脚定位。 这就要求我们在设计成型工具时要充分考虑到成型尺寸的修正问题,在设计时就要考虑好修正方法和修正余量。在产品调试过程中要通过修正成型工具的相关尺寸来满足产品的尺寸和形状要求。如图8所示是我们在产品调试所需要控制的尺寸(以QFP产品为例)。

要控制产品“R”区的引脚不出现裂纹,最主要的是设计合适的成型“R”大小,R尺寸太大,产品的形状控制起来就比较困难,不容易得到满意的站脚高度和C区长度;但是如果R尺寸太小,就容易引起产品的镀层在“R”区出现皲裂现象。这归因于厚镍层、小弯曲半径及镍层的硬度比铜基体要大。通过我们的反复试验,得出的结论是NiPdAu镀层的PPF框架的成型R 尺寸不能小于1.5倍的引脚厚度尺寸。
在对NiPdAu镀层的PPF框架进行成型时,还有一个容易出现的问题是在引脚的肩部和产品的胶体部分出现分层现象,出现这种情况的原因是因为该框架和胶体的结合力比一般的框架要弱。在成型时,引脚弯曲的力量会传递到胶体,造成分层现象。我们这时要注意保护好肩部,就是要在成型时肩部一定要压紧。我们的经验是肩部压0.01mm就可以避免分层现象出现,又不会压伤引脚的镀层(具体的产品压紧量可能不一样,这要根据调试结果来最终确定)。
在成型过程中要控制成型工具对引脚擦伤,因为这会在制程中引起NiPdAu镀层材料严重脱落而露铜,并导致焊接不良。出现这种问题可以通过两种方法来解决:一种是成型时采用柔性夹弯成型方式,减少成型工具与引脚之间相对的移动,相对的移动越小产生的擦伤就越少;另外一个建议是使用带有DLC,类钻石涂层的成型工具,它是在工具上附着一层纤薄坚硬涂层,表面高度抛光。具有低摩擦系数且有自润滑作用,可更有效地防止焊料粘结,可以减少成形工具表面镀层的沉积,从而延长工具寿命,减少成型时对引脚表面的擦伤。通过这些措施可以保证引脚弯曲制程的稳定性。图9、图10、图11是柔性夹弯成型方式和经过表面DLC处理的成型刀具。


5 总结
随着RoHS指令逐渐发挥作用以及全球化的发展要求我们要积极适应外部的客观环境,PPF框架在半导体中的应用也会越来越普遍。同时对产品升级的需求以及对产品生产成本的控制,也驱使着我们去尝试应用一些新的技术和工艺手段。对PPF框架在半导体工业中的应用研究,可以帮助我们做好相应的技术贮备,来迎接外部环境的挑战,满足客户潜在的需求。


