SRAM型FPGA的静态与动态单粒子效应试验
王忠明,姚志斌,郭红霞,吕 敏
(1.清华大学 工程物理系,北京 100084;2.西北核技术研究所,陕西 西安 710024)
静态随机存取存储器(SRAM)型现场可编程门阵列(FPGA)具有很好的设计灵活性,是很多航天电子设备的备选方案,但大量文献和实际应用表明这类器件对空间中的单粒子效应非常敏感。Xilinx公司对典型的SRAM型FPGA器件进行了单粒子效应试验,给出了器件的单粒子特性[1-3],且对由单粒子引起的系统失效机理进行了分析[4],提出了针对这种效应的系统级加固方法[5-6]。
FPGA的单粒子效应主要是指发生在配置存储器和块存储器中的单粒子翻转。另外,触发器、全局控制寄存器和半闭锁结构中也有可能发生单粒子翻转,但发生的概率较前两者低几个数量级[7]。配置存储器中的数据控制着电路中各可配置逻辑模块的功能和连接关系,一旦发生单粒子翻转就有可能破坏电路结构,导致功能持续出错,直到器件被重新配置才能恢复。因此,这种翻转被认为是FPGA中最突出的单粒子效应。
对于FPGA,存储器的翻转截面只能用于描述器件本身对单粒子效应的敏感程度,若用来预估系统在空间轨道上的失效率则会导致结果过于保守。文献[8]将传统的翻转截面称为静态翻转截面,且提出用于描述系统功能失效频率的动态翻转截面的概念。文献[9]指出,静态截面与动态截面间只相差1个常数。FPGA的单粒子效应测试应根据试验目的不同决定采用静态测试还是动态测试。本文提出的FPGA辐射效应测试系统同时具备这两种测试能力[10-11]。
1 测试系统设计
静态测试主要是指对FPGA内部存储器翻转情况的监测,而动态测试是指对系统功能输出的监测。测试系统主体框架由上位计算机、测试板及2块辐照板组成。上位计算机与测试板间用50m的RS422协议进行通信,而测试板与2块辐照板则用60芯扁平电缆进行连接。
1.1 静态测试方案
静态测试是对FPGA的配置数据进行回读验证的过程[12]。辐照前,上位计算机将FPGA集成开发环境生成的配置文件、回读文件和掩码文件通过串口发送给下位DSP,再转存到Flash中。配置器件时,下位DSP将Flash中的配置文件通过SelectMAP接口写入FPGA中,实现程序的下载。在辐照状态时,下位DSP从回读文件中找到回读命令,按一定时序从SelectMAP接口中回读FPGA内部存储器的内容,在掩码文件的帮助下,比较原始配置数据与回读数据的异同,从而实现对单粒子翻转的监测。
1.2 动态测试方案
动态测试是指对系统功能的监测。本文采用1片与待测器件完全相同的参照器件,令其与待测器件同步运行,将二者的输出进行比较,一旦待测器件受到单粒子效应的干扰导致二者输出不同,则记为1次功能出错。这种错误一般会一直持续下去,因此,必须在出错后对器件进行自动重新配置,以保证下一次测试的有效性。
辐照时,下位DSP控制频率发生器,生成测试向量的输出时钟、2片FPGA的同步时钟及输出向量的比较时钟。当2片FPGA输出向量不同时,比较器会输出高电平,使下位DSP产生中断,并记录及回传此刻输入输出向量的值。
2 辐照试验
辐照试验在北京串列加速器(HI-13)及兰州重离子试验装置(HIREF)上进行。试验中的待测器件为Xilinx的 Virtex-XCV300,该器件采用0.22μm商用体硅工艺,规模约30万门,配置存储器约含1.7M位。静态测试中采用的离子LET范围为1.73~76MeV·cm2·mg-1(表1)。
在动态试验中设计了3个不同的测试电路。测试电路1是一简单的16位锁存器,用于系统调试和验证;测试电路2是1 024×16位的移位寄存器链,用于测试触发器翻转;测试电路3的资源利用较均衡,包含2个线性反馈移位寄存器、2个乘法累加器和2个FIFO,将相同模块的输出进行比较,结果进入一16位计数器。3个测试电路的资源占用情况列于表2。由于设计的资源占用率不高,系统功能出错的频率相对配置位翻转较低。受束流时间限制,动态试验仅在少数离子下进行。为避免系统功能出错过快,采用较低的注量率(100~1 000cm-2·s-1)进行试验,每次功能出错后自动对系统进行重新配置,试验流程如图1所示。

表1 历次FPGA单粒子效应试验情况Table 1 FPGA single-event effect experiment conditions

表2 3个测试设计电路的资源占用情况Table 2 Resource utilization of three benchmark circuit designs
3 试验数据分析
3.1 试验数据处理方法
单粒子试验的结果常用翻转截面来表示,它等于单粒子事件数与单位面积上入射的粒子注量之比,即:

其中:σ为翻转截面;N为单粒子事件数;F为单位面积上入射的粒子注量。

图1 FPGA单粒子动态测试的流程图Fig.1 Dynamic test flow of FPGA single-event experiment
在静态试验时,事件数等于内部存储器发生翻转的次数,而动态试验时,事件数为系统功能出错的次数。由此可得到静态翻转截面和动态翻转截面2个参数。在处理试验数据误差时,仅考虑核事件的随机涨落带来的不确定性,由正态分布假设可知N个计数的标准偏差为N1/2,截面数据为2个计数之商,利用误差合成公式可得到相应的标准偏差[13]:

在处理重离子单粒子试验数据时,往往对多个LET的翻转截面进行Weibull曲线拟合,以得到发生翻转的LET阈值、饱和截面等重要参数,拟合结果也可作为空间轨道翻转率预估程序的输入参数。Weibull曲线的函数形式为:

其中:σ(LET)为翻转截面;σsat为饱和截面;L0为LET阈值;W为尺度参数;s为形状参数。
在利用最小二乘法拟合的过程中,用前面求得的翻转截面的误差作为权重来平衡每个LET点对拟合结果的贡献。根据文献[14]中推荐的基本原则,令尺度参数W不超过100,将形状参数的初值设为1,饱和截面的初值设为最大LET处测得的截面,LET阈值设为试验中的最小LET。
3.2 静态试验结果
拟合出的静态翻转截面曲线如图2所示,饱和截面为9.60×10-8cm2,LET 阈值为1.72MeV·cm2·mg-1。上述结果与文献[13]中报道的Virtex的抗辐射加固版本XQVR300的试验结果差别不大。这说明采用Xilinx的抗辐射系列芯片不能彻底解决单粒子翻转的问题,对FPGA的加固还应在系统层面进行。
3.3 动态试验结果
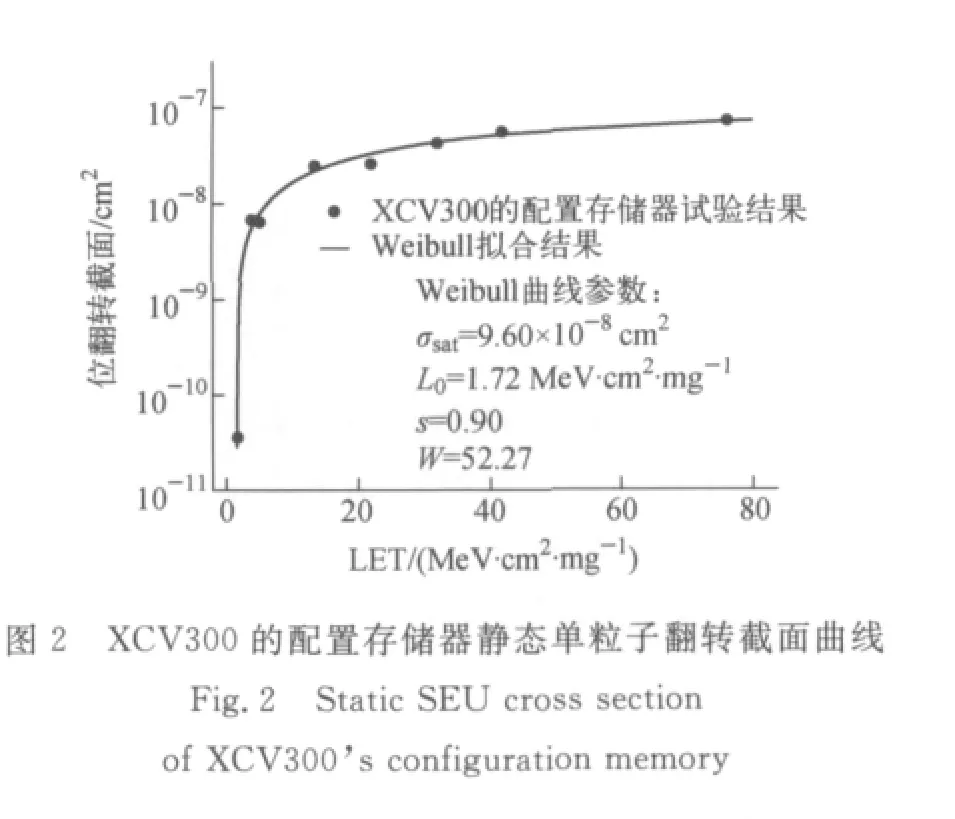
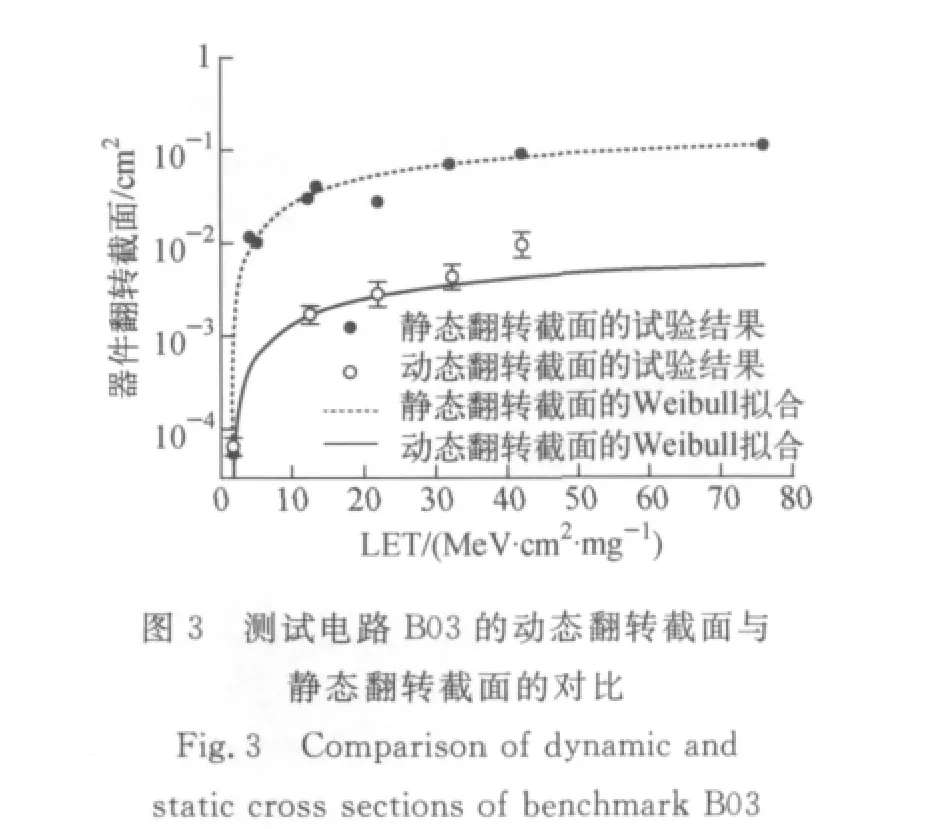
对3个测试电路的动态翻转截面进行了处理,其中,对资源占用较均衡的B03测试电路在多个LET下进行了动态试验(图3)。受束流时间限制,其他2个测试电路只在1个LET下进行了试验。从图3可看出,动态截面与静态截面之比基本是一常数(即表3中的比例因子),此常数的物理意义是指配置存储器中随机发生1次翻转可能导致系统功能失效的概率。由表3可知,对不同的配置电路,比例因子差别较大,一般情况下,资源占用率越高的电路动态截面越大。但从表2和3的对比可看出,比例因子不仅较资源占用率小得多,且二者也不是简单的线性关系。对系统设计而言,动态测试结果可直接用于系统功能失效率的预估,而静态测试结果主要反映器件本身的抗单粒子能力。

表3 用175MeV的Cl离子测得的3个配置电路的动态截面及其与静态截面之比Table 3 Dynamic and static cross sections of three benchmark designs using 175MeV Cl ion
4 结论
应用重离子加速器对Xilinx的Virtex系列FPGA进行了静态和动态单粒子效应试验。静态试验结果表明,该器件发生翻转的LET阈值很低,极易受到单粒子效应的干扰。对3个配置电路的动态功能测试结果表明,系统功能失效的频率与设计资源占用率直接相关,但二者不是简单的线性关系,不能直接用资源占用情况推算系统的空间失效率。
[1]FULLER E,CAFFREY M,BLAIN P,et al.Radiation test results of the Virtex FPGA and ZBT SRAM for space based reconfigurable computing[C]∥ Proceedings of Military and Aerospace Applications of Programmable Logic Devices(MAPLD).Laurel MD:NASA NEPP,1999.
[2]WIRTHLIN M,JOHNSON E,ROLLINS N,et al.The reliability of FPGA circuit designs in the presence of radiation induced configuration upsets[C]∥Proceedings of the 11th Annual IEEE Symposium on Field-Programmable Custom Computing Machines.[S.l.]:[s.n.],2003.
[3]CAFFREY M,GRAHAM P,JOHNSON E,et al.Single-event upsets in SRAM FPGAs[C]∥Proceedings of Military and Aerospace Applications of Programmable Logic Devices(MAPLD).Laurel MD:NASA NEPP,2002.
[4]GRAHAM P,CAFFREY M,ZIMMERMAN J,et al.Consequences and categories of SRAM FPGA configuration SEUs[C]∥Proceedings of Military and Aerospace Programmable Logic Devices International Conference(MAPLD).Washington D.C.:NASA NEPP,2003.
[5]CARMICHAEL C.Triple module redundancy design techniques for virtex FPGAs[R].San Jose,CA:Xilinx,2000.
[6]CARMICHAEL C.Correcting single-event upsets through virtex partial configuration[R].San Jose,CA:Xilinx,2000.
[7]FULLER E,CAFFREY M,SALAZAR A,et al.Radiation testing update,SEU mitigation,and availability analysis of the virtex FPGA for space reconfigurable computing[R].San Jose,CA:Xilinx,2000.
[8]MORGAN K,CAFFREY M,GRAHAM H,et al.SEU-induced persistent error propagation in FPGAs[J].IEEE Transactions on Nuclear Science,2005,52(6):2 438-2 445.
[9]VIOLANTE M,STERPONE L,CESCHIA M,et al.Simulation-based analysis of SEU effects in SRAM-based FPGAs[J].IEEE Transactions on Nuclear Science,2004,51(6):3 354-3 359.
[10]姚志斌,张凤祁,何宝平,等.静态随机访问存储器型现场可编程门阵列辐照效应测试系统研制[J].强激光与粒子束,2009,21(5):749-754.YAO Zhibin,ZHANG Fengqi,HE Baoping,et al.Development of the measurement system for radiation effect on SRAM-based FPGA[J].High Power Laser and Particle Beams,2009,21(5):749-754(in Chinese).
[11]姚志斌,范如玉,郭红霞,等.FPGA静态单粒子截面的获取与分类[J].强激光与粒子束,2011,23(3):812-816.YAO Zhibin,FAN Ruyu,GUO Hongxia,et al.Identification and classification of static singleevent upsets cross section of SRAM-based FPGAs[J].High Power Laser and Particle Beams,2011,23(3):812-816(in Chinese).
[12]Xilinx.Virtex FPGA series configuration and readback[R].San Jose,CA:Xilinx,2005.
[13]ALDERIGHI M,CANDELORI A,CASINI F,et al.SEU sensitivity of virtex configuration logic[J].IEEE Transactions on Nuclear Science,2005,52(6):2 462-2 467.
[14]PERTERSEN E L.Single-event data analysis[J].IEEE Transactions on Nuclear Science,2004,55(6):2 819-2 841.

