采用固相晶化和准分子激光晶化制备结晶硅薄膜的对比
王志雄,王 欣,李霞霞,黄飞武,张 霞
(上海工程技术大学材料工程学院,上海201620)
0 引 言
与非晶硅(α-Si)薄膜相比,结晶硅(nc-Si)薄膜具有更优异的光电性能,因此在薄膜晶体管、太阳能电池中都选用结晶硅薄膜。一般都是采用先制备非晶硅薄膜,然后再通过各种方法将其晶化的方法制备结晶硅薄膜。结晶硅薄膜晶化程度的提高以及大面积制备结晶硅薄膜时衬底温度的降低,使其成为新型显示器、绿色能源研究中的热门课题[1]。由于结晶硅薄膜的晶化程度是影响硅薄膜迁移率和薄膜晶体管器件稳定性、效率的关键因素,因此研究人员都在探究良好的晶化方法以制备出结晶率更高的结晶硅薄膜[2]。
目前国内外的结晶化技术主要包括固相晶化(SPC,Solid Phase Crystallization)、准分子激光晶化(ELA,Excimer Laser Annealing)、金属诱导晶化(MIC,Metal Induced Crystallization)和金属诱导横向晶化(MILC,Metal Induced Lateral Crystallization)等。SPC是在固态下进行的,薄膜具有均匀性好、杂质含量少等优点,但成膜速率太低(一般需要数小时),且不能达到理想的晶化效果,也不能实现器件单元的快速生产。ELA是使用激光将非晶硅薄膜迅速升至1 700℃的高温而熔化凝固后重新结晶,该技术相对于SPC具有晶粒内缺陷少、晶粒大、可靠性好等优点,具有快速、便捷的优点,但设备昂贵,对技术人员要求较高。MIC和MILC都是新型的结晶化方法,它们是先制备镍、铝、金、银等金属与非晶态硅的复合薄膜,然后对复合薄膜进行低温退火,在金属的诱导作用下使非晶态硅在低于500℃的条件下晶化而得到结晶硅薄膜。这两种方法的晶化温度低、所需时间短、薄膜晶粒大,制备出的多晶硅薄膜质量较好,但工艺复杂,工艺质量难以掌控。
基于SPC和ELA这两种晶化方法的广泛应用,有必要对其晶化后的薄膜结晶质量进行系统的对比分析,但此方面的研究报道还较少。为此,作者以工业玻璃为衬底,采用等离子体增强化学气相沉积(PECVD)技术制备了非晶硅薄膜,然后分别采用SPC和ELA方法对其进行晶化处理得到结晶硅薄膜,并对薄膜的结晶率、形貌和物相组成等进行了研究。
1 试样制备与试验方法
以工业玻璃为衬底,以纯度为99.999 9%的SiH4为反应气体,以纯度为99.999 9%的氩气作为稀释气体,采用等离子体化学气相沉积(PECVD)系统制备非晶硅薄膜[3]。沉积系统的本底真空度为1×10-4Pa,沉积温 度为400 ℃,沉积气压 为133Pa,SiH4流量为160cm3·min-1,氩气流量为5 000cm3·min-1。制备得到的非晶硅薄膜厚度为50nm。
采用SPC工艺制备结晶硅薄膜的步骤如下:先在20min内将非晶硅薄膜由室温升温到700℃,保温60min;然后在100min内缓慢降温至600℃,再在120min内降温至室温,获得结晶硅薄膜。工艺时间共计5h。
采用ELA工艺制备结晶硅薄膜的步骤如下:首先对激光功率、扫描时间、扫描次数等ELA工艺参数进行优化,然后采用200W的准分子激光器,在激光功率密度为390mJ·cm-2的条件下对玻璃衬底上的非晶硅薄膜进行激光照射。准分子激光波长为308nm,激光扫描的光斑尺寸为250mm×400μm,基板在每次激光脉冲过后向扫描方向的相反方向移动10μm,这样同一位置会受到重复照射40次。对于25cm×1cm的薄膜试样,总计扫描时间为16min。
采用InVia-Reflex型激光显微拉曼(Raman)光谱仪对结晶硅薄膜的结晶率进行定量分析,激光发射器为波长532nm的氦氖发射器,聚焦光斑直径为1μm,激光能量为50mW。测试中分别采用0.1%,0.5%,1%,5%,10%,50%,100%等7个不同梯度的激光能量强度进行分析。
采用Philips X射线衍射仪分析结晶硅薄膜的物相组成和结晶形态;采用JSM-6700F型场发射扫描电子显微镜观察薄膜的微观形貌。
2 试验结果与讨论
2.1 拉曼光谱
从图1中可以看出,与SPC工艺相比,采用ELA工艺制备的结晶硅薄膜具有更高的拉曼散射峰强度,晶化相含量更多。

图1 不同晶化方法制备结晶硅薄膜的拉曼光谱Fig.1 Raman spectra of silicon thin films crystallized by two methods
结晶率指薄膜中晶态硅的质量分数或体积分数,是评价结晶硅薄膜晶化效果的一项重要指标。对于硅材料,拉曼峰位位于480cm-1时,表明为非晶硅中Si-Si键的TO模;位于520cm-1时,表明为单晶硅中Si-Si键的TO模;位于510cm-1左右时,表明晶界为混合状态[4]。
2.2 结晶率
通过高斯拟合拉曼光谱分峰[5],然后根据分峰后的数据按式(1)计算结晶率。

式中:Xc为薄膜的结晶率;Ⅰ520为拉曼光谱中峰位位于520cm-1的峰面积;Ⅰ510为拉曼光谱中峰位位于510cm-1的峰面积;Ⅰ480为拉曼光谱中峰位位于480cm-1的峰面积。
从图2中可看出,采用SPC工艺制备的结晶硅薄膜的拉曼光谱各散射峰的强度在峰位位于517cm-1时达到最大,与标准单晶硅位于520cm-1处的峰强度接近,这表明此结晶硅薄膜具有较高的结晶率。图中虚线代表原始数据,实线是高斯分解后在520,510,480cm1三个位置对应的峰形。拉曼光谱经过高斯分解之后,根据式(1)可计算出SPC结晶硅薄膜的结晶率为70%。
从图2(b)中可看出,采用ELA工艺制备的结晶硅薄膜的拉曼散射峰的强度更高,峰位位于517cm-1附近。根据式(1)可计算得到其结晶率为90%,这与文献[6]的报道一致。
可见,与SPC工艺相比,采用ELA工艺晶化得到结晶硅薄膜的结晶率较高。这是因为ELA是采用308nm的短波激光照射,将非晶硅在1 700℃的高温下熔化,瞬间冷却后结晶为结晶硅,得到的结晶硅薄膜结构致密,具有较大的晶粒尺寸和规则的晶界分布,有利于载流子迁移和器件的稳定[7]。

图2 不同晶化工艺制备结晶硅薄膜的Raman光谱及高斯分解Fig.2 Raman spectra and Gauss analysis of crystalline silicon thin film prepared by SPC(a)and(b)ELA technologies
从图3中可看出,随着拉曼入射强度的增加,两种结晶硅薄膜的结晶率变化不大,但SPC结晶硅薄膜的拉曼散射强度略有所增大(入射强度增加至50%时因信号强度过大无法收集,所以未进行测试),ELA结晶硅薄膜的散射强度却随着拉曼入射强度的增大而大幅增大。所以结晶硅薄膜的结晶率与拉曼散射峰强度没有直接关系,这是因为结晶率由试样本身的特性决定,并且试样处于稳定的结晶状态[8]。

图3 不同工艺制备结晶硅薄膜的结晶率、拉曼散射强度与拉曼入射强度的关系Fig.3 Crystallization ratio and Raman scatter intensity independent of Raman incident intensity of crystalline silicon thin films prepared by SPC(a)and(b)ELA technologies
2.3 XRD谱
由图4可见,在2θ=23°附近,ELA结晶硅薄膜有明显拓宽的衍射峰位,这个峰位来源于非晶玻璃衬底,一般在30°以下拓宽的波包峰是来源于非晶态物质,显然此试样的波包峰来源于非晶玻璃和少量的非晶硅薄膜。
在2θ=28°处有很微弱的峰位,与标准谱对比后得知,该峰归属为Si(111)晶面。如此微弱的信号和衍射强度,一般是薄膜的结晶状态差或者薄膜本身比较薄造成的。实际上,ELA结晶硅薄膜作为薄膜晶体管电学器件的沟道层,确实做得比较薄,仅约为50nm,因此只有比较微弱的Si(111)结晶峰位。

图4 ELA工艺制备结晶硅薄膜的XRD谱Fig.4 XRD pattern of crystalline silicon thin film prepared by ELA technology
SPC结晶硅薄膜的结晶率较低,XRD谱信噪比过大,基本为非晶态的峰,在此未给出其XRD谱。
2.4 表面形貌
采用SPC工艺制备的结晶硅薄膜致密紧凑,晶粒尺寸比较均匀,形状规则,如图5所示,在较平坦的表面上再次堆积小晶粒,引起粒子成核模式变化和晶粒生长不同,导致薄膜表面在视觉上出现分层现象。因此,SPC晶化过程能够大幅促进硅原子键相互反应,易于发生团簇形核和长大,从而演变成非晶硅薄膜到结晶硅薄膜的晶化转变过程。同时也说明结晶硅薄膜具有比较良好的晶体质量。
采用ELA工艺制备的结晶硅薄膜由比较均匀的颗粒组成,表面平整,结构致密,无明显缺陷,如图6所示,显示出良好规则的晶界和晶粒分布,晶粒尺寸较大但并不完全一致,每个大晶粒内部还存在小晶粒,大晶粒和规则晶界对载流子的传输和器件的电学性能有利[9]。
综合以上可知,采用ELA工艺制备的结晶硅薄膜具有平整紧凑致密的显微结构,具有比较优异的表面质量[10]。

图5 SPC工艺制备结晶硅薄膜的表面SEM形貌Fig.5 Surface SEM morphology of crystalline silicon thin film prepared by SPC technology:(a)at low magnification and(b)at high magnification
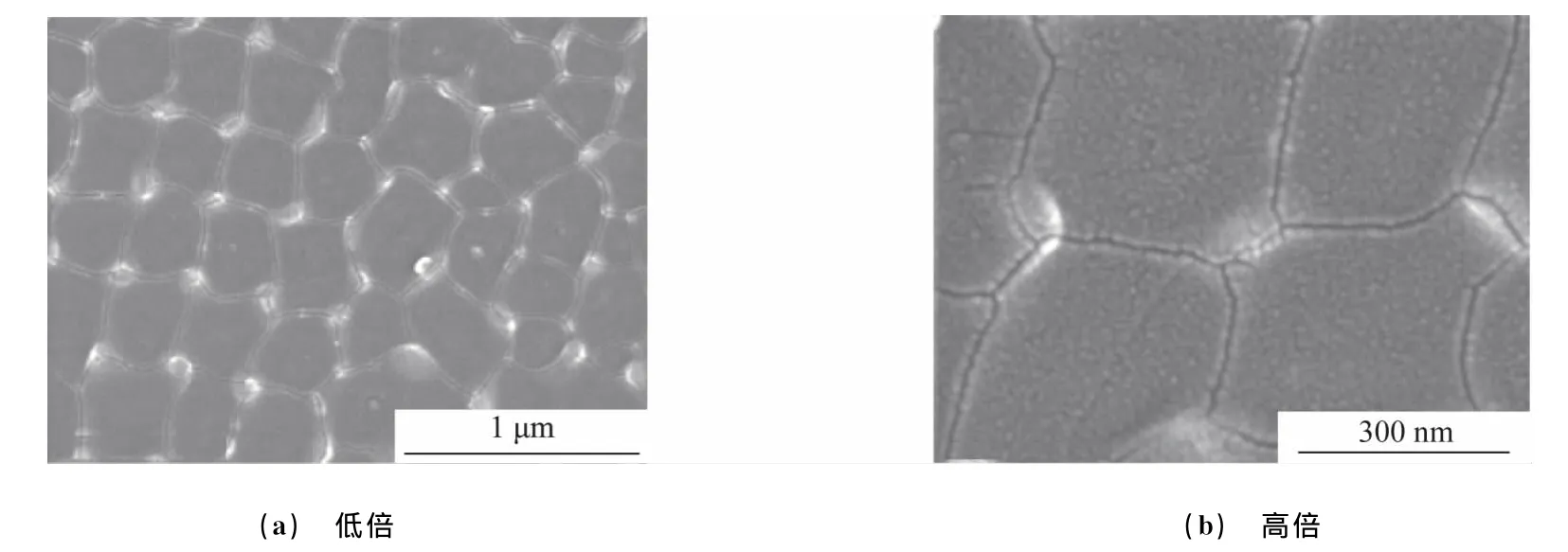
图6 ELA工艺制备结晶硅薄膜的表面SEM形貌Fig.6 Surface SEM morphology of crystalline silicon thin film prepared by ELA technology:(a)at low magnification and(b)at high magnification
3 结 论
(1)相对于SPC工艺而言,ELA工艺制备的结晶硅薄膜具有较大的晶粒尺寸和较规则的晶界,而且结晶率更高,可达90%,其XRD谱中具有微弱的Si(111)结晶峰位。(2)采用ELA工艺晶化制得的结晶硅薄膜,其拉曼散射峰强度均随着拉曼入射强度的增大而大幅增大,但它们的结晶率变化不大,说明结晶硅薄膜处于稳定状态。
(3)采用SPC工艺制备结晶硅薄膜的表面形貌为在较平坦的表面上再次堆积小晶粒,晶粒尺寸比较均匀;采用ELA工艺制备的结晶硅薄膜形成了大晶粒和良好的晶界分布,对载流子的传输和器件的电学性能有利。
[1]尹春健.YLF激光晶化多晶硅薄膜的研究[D].天津:南开大学,2012.
[2]张良艳.金属诱导多晶硅薄膜制备与研究[D].成都:电子科技大学,2010.
[3]高昕昕.大气压射频 Ar/SiH4/H2辉光放电数值模拟[D].大连:大连理工大学,2009.
[4]徐晓轩,林海波,武中臣,等.非晶硅薄膜的激光晶化及深度剖析拉曼光谱研究[J].发光学报,2003,24(4):426-430.
[5]刘国汉,丁毅,朱秀红,等.CVD法制备氢化微晶硅薄膜及其微结构研究[J].物理学报,2006,55(11):6147-6151.
[6]庞宏杰.非晶硅薄膜激光晶化组织结构研究[D].大连:大连理工大学,2007.
[7]LEE Y J,KWON J D,KIM D H,et al.Structural characterization of wavelength-dependent Raman scattering and laser-induced crystallization of silicon thin films[J].Thin Solid Films,2013,542:388-392.
[8]ELLERT C H,WACHTENDORF C,HEDLER A,et al.Influence of Raman crystallinity on the performance of micromorph thin film silicon solar cells[J].Solar Energy Materials&Solar Cells,2012,96:71-76.
[9]李英伟,林春芳,周晓,等.Na+掺杂ZnO薄膜的结构和电学性能[J].机械工程材料,2007,31(8):15-18.
[10]李雪飞,谢尚昇,何欢,等.Si(111)和Si(100)衬底上 AlN 薄膜的激光分子束外延生长特征[J].机械工程材料,2012,36(7):38-40.

