FC-PBGA644封装的热仿真模拟*
石 磊,黄金鑫,缪小勇,3,王洪辉(.南通富士通微电子有限公司,江苏 南通 226006;2.复旦大学信息科学与工程学院,上海 200433;3.武汉大学电子信息学院, 武汉 430072)
FC-PBGA644封装的热仿真模拟*
石 磊1,2,黄金鑫1,缪小勇1,3,王洪辉1
(1.南通富士通微电子有限公司,江苏 南通 226006;2.复旦大学信息科学与工程学院,上海 200433;
3.武汉大学电子信息学院, 武汉 430072)
摘 要:FC-PBGA(FilpChip-PBGA)倒装球栅格阵列封装相比BGA封装易于实现高密度封装,具有更好的电性能和热性能。利用有限元分析软件对封装产品进行建模仿真计算,添加各自的材料热导热系数、边界条件等,在产品设计研发阶段获得温度分布云图。通过计算其热阻,同时对此封装产品散热性能进行优化改进,得出基板尺寸的最优参数设计,可以通过添加散热盖改善其散热性能,提高产品可靠性。
关键词:FC-PBGA;仿真;可靠性;优化;散热
1 引言
BGA封装具有面积小、对端子间距要求不苛刻、便于实现高密度封装,具有良好的电学性能、散热性能(在芯片背面可加散热器)等优点。2002年开发的新型封装体FC-PBGA,发展速度很快,通过焊球等进行芯片倒装连接,易于实现高密度封装,利用焊球凸点将芯片与封装基板连接,把芯片正面朝下安装在基板上,使其成为高密度、高性能、多功能及高I/O的封装形式[1]。如图1所示,散热盖与芯片之间通过贴片胶连接起来,倒扣在上面,使其传热加快,减小热阻。
在芯片与基板之间,由焊点连接形成的间隙中填充一种环氧封装材料,称为底部填充料,主要为了降低芯片与基板由于热膨胀系数(CTE)不同引起的内应力,可以增加芯片的可靠性,降低焊球的应力,保护焊球凸点不受其他环境的影响[2]。
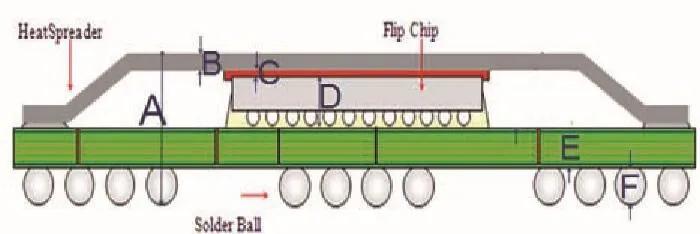
图1 带散热盖的FC-BGA封装示意图
2 仿真模型建立及计算
2.1模型的建立
根据FC-PBGA产品的结构图,通过ANSYS建立模型的三维图,如图2所示,分别由芯片、基板、焊球、PCB组成。其中芯片尺寸为8.6 mm×6.3 mm,基板尺寸为19 mm×19 mm,建模过程中将underfi ll与Bump等效为一层。基板采用四层板结构取代原先的两层基板,降低热阻,其总厚度为0.36 mm,分别由soldmask、core材、铜层、绝缘层组成,焊球尺寸为0.3 mm,球间距为0.65 mm,数量为644。PCB采用的是JEDEC51-7标准测试板,是四层板结构,如图3所示,尺寸为114.5 mm× 101.5 mm×1.6 mm。在模拟过程中也将PCB等效,实际生产的PCB板中的铜层经过刻蚀而形成无数导线,用来提供元器件直接的电路连接,根据实际情况,将PCB模型简化,用覆铜板进行模拟仿真[3~4]。
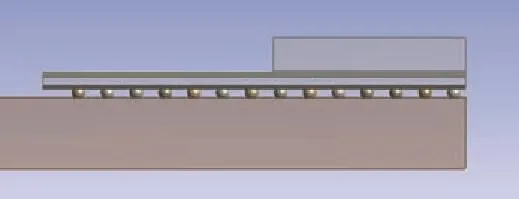
图2 三维模型

图3 四层PCB版的剖面图
2.2网格划分、边界条件
通过设定尺寸、材料、边界条件等参数,可以实现参数化仿真分析。本模型中,划分网格时所采用的网格大小不尽相同,结果产生了41 321个单元和131 450个节点。由于是对称模型,取其四分之一模型进行分析,芯片功耗设置为2 W,采用自然对流方式添加对流系数,设定的环境温度为25 ℃,所使用的材料参数如表1所示,其中die attach是指散热盖与芯片连接所用的材料,Underfi ll与Bump等效为一层。由文献可知[5],其等效导热系数可以用两种材料各自所占的体积比进行等效计算,得出其等效导热系数大约为12.2 W/m℃。

表1 各材料的导热系数
2.3计算结果
描述芯片稳态热特性主要有2个参数:芯片的最高结温以及热阻。通过ANSYS workbench分析的仿真计算结果云图所示,FC-PBGA无散热盖的最低、最高温度分别出现在PCB上以及芯片中央位置,数值分别为62.3℃、36.9℃,并且温度从中心扩散出去,最高温度在芯片的中心位置。对于微电子封装,通常用θja来描述其热特性,θja为芯片结点到环境的热阻,如式(1)所示:

其中Tj是芯片的最高温度,Ta为当前的环境温度,P为芯片功耗,本案例可计算出其热阻为12.7 ℃/W。
3 热仿真优化
为了提高模型的散热性能,对模型进行了优化设计。从添加散热盖、改变基板尺寸等减小热阻以达到所需要的功耗要求。利用仿真模拟软件,改变参数的数值,重新计算结果。
3.1散热盖对芯片结温的影响
通过对比有无添加散热盖,分析其对芯片结温的影响以及热阻的变化,散热盖倒扣在芯片上增加传热。由于添加散热盖,在同样的仿真计算条件下,如图4所示整体的最低、最高温度分别为36.7 ℃、55.9 ℃,可得其热阻为9.6 ℃/W。相比无散热盖的FC-PBGA同类产品,其热阻降低了24.4%。在其他条件不变的情况下,添加散热盖可以使产品的功耗得以提升,满足微电子封装功耗越来越大的要求。
3.2基板尺寸对芯片结温的影响
热阻是热量在物体内部传输时所遇到的阻力,影响热阻的因素有好几个方面,其中封装体的尺寸、基板尺寸、材料参数、空气流动速率等都是影响其散热的主要因素,下面就改变其基板分析芯片结温的变化。在有散热盖的情况下,其他条件不变,改变基板尺寸,通过仿真模拟观察芯片结温的变化,如表2所示。可以看出随着基板尺寸的不断减小,芯片结温在不断增大,热阻也不断增加,但是基板尺寸和经济成本也成比例关系,故在选择基板尺寸时要综合考虑热阻和成本的关系,选择最优尺寸。
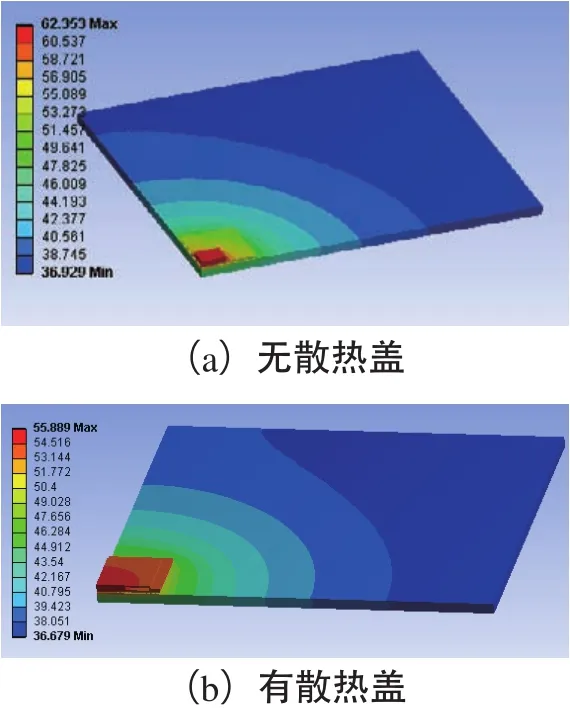
图4 散热盖对热阻的影响

表2 基板尺寸与芯片结温的关系
而后通过设定芯片的功耗不同,随着功耗的增加其芯片最高温度也呈线性增加(如图5所示),在环境温度为25 ℃、其他条件不变的情况下,功耗越大,其芯片结温越高,通过热阻计算公式(1)可以得出在功耗变化的情况下,热阻基本不变,由于芯片的工作温度一般不超过150 ℃[6],由此可以反推计算得出,无散热盖的FC-BGA器件工作的最大功耗为9.8 W,有散热盖的FC-BGA器件工作的最大功耗13 W,可知添加散热盖可以提高器件的最大功耗能力,加快散热。

图5 功耗与芯片结温的关系
4 结论
本文对FC-PBGA封装结构进行了有限元模拟仿真,主要研究了散热盖、基板厚度等对电路散热性能的影响,主要结论如下:(1)本次仿真所采用的模型对PCB、bump、underfi ll均进行了简化等效,仿真计算结果比较理想,最高温度集中在芯片中心部位,最低温度在PCB板上,从仿真云图上可以看出温度变化呈弧形扩散出去;(2)加散热盖可以提高散热性能,同等情况下大约改善24.4%;(3)改变基板的尺寸可以改变热阻,在综合散热和经济成本最优的情况下选择基板尺寸。
采用有限元分析方法,有助于封装产品的优化设计,通过有限元软件的模拟分析可以得出比较接近实际的结论,在前期设计阶段以及实际生产中有助于减少生产成本。
参考文献:
[1] SeungWook YOON, A Bahr, X Baraton,etc. 3D eWLB (embedded wafer level BGA) Technology for 3D-Packaging/3D-SiP (Systems-in-Package) Applications[C]. 11thElectronics Packaging Technology Conference, Beijing, 2009. 915-919.
[2] Fa-Xing CHE, Jing-En LUAN, Daniel YAP. Thermal cycling fatigue model development for FBGA assembly with Sn-Ag-based lead-free solder[C]. 33rdInternational Electronics Manufacturing Technology Conference, 2008.
[3] Esmailpour M. Do You Really Know the Thermal Conductivity of Your Boards[C]. 25thAnnual IEEE Semiconductor Thermal Measurement and Management Symposium, 2009. SEMI-THERM 2009, San Jose, CA: 55-64.
[4] 王金兰,仝良玉,刘培生,等. 一种多芯片封装(MCP)的热仿真设计[J]. 计算机工程与科学,2012,34(4):28-31.
[5] 陈则韶,钱军,叶一火. 复合材料等效导热系数的理论推算[J]. 中国科学技术大学学报,1992,22(4) :416-424.
[6] 章霖. 热循环载荷下BGA复合焊点疲劳寿命的研究[D].哈尔滨工业大学,2011.
Thermal Simulation of FC-PBGA644 Package
SHI Lei1, 2, HUANG Jinxin1, MIAO Xiaoyong1, 3, WANG Honghui1
(1. Nantong Fujistu Microelectronics Co., Ltd, Nantong 226006, China; 2. School of Information Science And Technology, Fudan University, Shanghai 200433, China; 3. School of Electronic Information of Wuhan University, Wuhan 430072, China)
Abstract:Flip chip-plastic ball grid array (FilpChip-PBGA), compared with the BGA (ball grid array) package is easy to realize high density package and better electrical and thermal properties. With fi nite element analysis software for modeling and simulation, their thermal conductivity, boundary conditions, and etc. are setted up. Then the temperature distribution can be gained in design phase, and the thermal resistance is calculated, at the same time, the packaging product is optimized to improve the heat dissipation performance. In conclusion, the optimal parameters of the substrate size is obtained, and its cooling performance can be improved by adding the radiator cover, so the reliability of products will be improved as well.
Keywords:FC-PBGA; simulation; reliability; optimization; heat dissipation
中图分类号:TN305.94
文献标识码:A
文章编号:1681-1070(2015)10-0001-03
收稿日期:2015-9-1
*基金项目:江苏省科技成果转化基金项目(SBA2015030442)
作者简介:
石 磊(1972—),男,复旦大学博士,江苏省第一期科技企业家,南通富士通微电子股份有限公司总经理,研究方向为微电子与固体电子技术。


