溶胶凝胶法制备以Al2O3为界面修饰层的铪铟锌氧薄膜晶体管
高娅娜, 许云龙, 张建华, 李喜峰*
(1. 上海大学 材料科学与工程学院, 上海 200072; 2. 上海大学 新型显示技术及应用集成教育部重点实验室, 上海 200072)
溶胶凝胶法制备以Al2O3为界面修饰层的铪铟锌氧薄膜晶体管
高娅娜1,2, 许云龙1,2, 张建华2, 李喜峰2*
(1. 上海大学 材料科学与工程学院, 上海 200072; 2. 上海大学 新型显示技术及应用集成教育部重点实验室, 上海 200072)
利用溶液法制备了以HfSiOx为绝缘层、HfInZnO为有源层、Al2O3为界面修饰层的TFT器件。HfSiOx薄膜经Al2O3薄膜修饰后,薄膜表面粗糙度从0.24 nm降低至0.16 nm。Al2O3薄膜与HfSiOx薄膜之间的界面接触良好,以Al2O3为界面修饰层的TFT器件整体性能得到提升,具体表现为:栅极电压正向和反向扫描过程中产生的阈值电压漂移显著减小,器件的阈值电压和亚阈值摆幅降低,迁移率与开关比增大。研究证明,溶液法制备Al2O3薄膜适合作为改善器件性能的界面修饰层。
溶液法; 薄膜晶体管; 界面修饰层Al2O3
1 引 言
非晶氧化物薄膜晶体管(TFT)由于具有良好的光学透过率、较高的场效应迁移率、大面积的均匀性等优点,在平板显示产业有很大的应用潜力[1-2]。目前广泛研究的金属氧化物半导体材料是InZnO(IZO)[3]、ZnSnO(ZTO)[4]、InGaZnO(IGZO)[1]、HfInZnO[5]等。目前,氧化物TFT制备大多需要高真空工艺,器件的制备成本较高。相比之下,溶液法在大气环境下即可进行,成本较低,同时它还可以精确地控制材料的比例,具有大面积均匀性等特点,成为制备薄膜器件的一种技术发展趋势[2-4]。
本研究采用HfO2和SiO2混合非晶铪硅(HfSiOx)材料为绝缘层。其中HfO2具有较高的介电常数,而SiO2具有较宽的禁带且价格低廉[6]。这种材料可以在一定程度上改善常用high-k绝缘层材料如HfO2、ZrO2、TiO2等存在的易结晶、界面性能差、漏电流大等缺点[7]。但是在研究过程中发现,将绝缘层进行高温退火后再旋涂有源层会引起较多的界面缺陷,使得器件性能劣化。增加界面修饰层是降低界面缺陷态的方法之一。界面修饰层常用于有机器件之中。Jang等[8]采用Y2O3对聚合物绝缘层表面进行修饰,提高了绝缘层的亲水性,增强了绝缘层和有源层间的结合,从而使TFT器件激活。Ding等[9]和Guo等[10]研究了ALD制备的Al2O3界面插入层对器件性能的影响,证实Al2O3薄膜有助于提高器件性能。但是,目前尚未有溶液法制备的Al2O3薄膜作为界面修饰层的报道。因此,本文引入了溶液法制备的界面修饰层Al2O3,通过对比有无界面修饰层时的器件性能来探讨影响溶液法制备TFT器件的界面态及器件性能的一些机制问题。
2 实 验
本文采用溶胶凝胶法制备TFT器件,以铪铟锌氧(HIZO)薄膜、HfSiOx复合材料和Al2O3分别作为器件的有源层、绝缘层和界面修饰层。
前驱体溶液的配制方法如下:将八水合氧氯化铪(HfCl2O·8H2O)和原硅酸(Si(OC2H5)4)以2∶1的量比溶解于乙二醇甲醚(2-MOE)中获得HfSiOx前驱体溶液。将氯化铪(HfCl4)、硝酸铟(In(NO3)3·xH2O)和二水合醋酸锌(Zn(CH3COO)2·2H2O))按0.3∶3∶2的量比溶解在2-MOE中配制HIZO前驱体溶液。将九水合硝酸铝(Al(NO3)3·9H2O))溶解在2-MOE中配制Al2O3前驱体溶液。所配制的溶液均老化2 d,形成匀质胶体。旋涂绝缘层和有源层薄膜,转速为3 000 r/min,时间为50 s。旋涂后,经 300 ℃退火处理坚固成膜,多次重复该工艺达到理想厚度。
所制备的HIZO TFT 为底栅底接触结构,如图1所示。基板为200 mm × 200 mm的Corning EXG 玻璃,以50 nm 厚的的透明ITO作为栅极。通过旋涂工艺制备厚度约为100 nm的HfSiOx绝缘层。在HfSiOx绝缘层进行500 ℃退火后,旋涂一层Al2O3作为界面修饰层,厚度约为15 nm。接着以50 nm厚的ITO作为源漏电极。最后,利用旋涂工艺制备约30 nm厚的有源层。所有层的图案化处理过程都采用传统光刻工艺,器件的沟道长度L均为10m。最终对器件进行400 ℃退火。

图1 HIZO TFTs结构示意图
采用原子力显微镜(AFM,Nanonavi SPI-400)分析薄膜的表面形貌,采用扫描电镜(SEM, Hatachi,S-4800)观察薄膜厚度和断面形貌,采用紫外分光光度计(Hatachi,H-3900)测量薄膜的透射率,采用 Agilent E4980A阻抗分析仪和Agilent 4155C精密半导体参数测量仪分别测量电容和TFT的电学性能。所有测试均在室温下进行。
3 结果与讨论
图2 给出了500 ℃退火的HfSiOx薄膜和增加界面修饰层Al2O3后的薄膜在300~800 nm波长范围内的透射率(包括玻璃基板)。薄膜在可见光范围内的平均透射率超过了80%,透光性良好,满足透明TFT器件的需求。界面修饰层引起的薄膜厚度增加导致了透过率曲线的轻微变化,但是这种变化几乎可以忽略 。
图3所示为500 ℃退火的HfSiOx薄膜和增加界面修饰层Al2O3后的薄膜的表面形貌图。从图中可以看出,HfSiOx薄膜的表面均方根粗糙度为0.24 nm。采用Al2O3作为界面修饰层后,表面粗糙度降至0.16 nm,表明Al2O3界面修饰层可以使薄膜表面变得更加光滑。光滑的绝缘层表面有利于形成绝缘层和有源层之间的良好接触,减少界面缺陷,从而提高TFT器件的性能[11-12]。
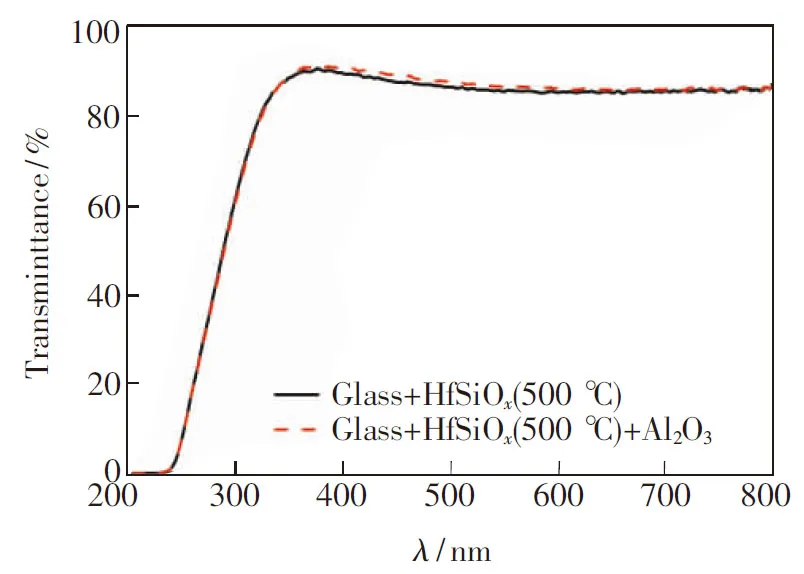
图2 HfSiOx和HfSiOx+Al2O3薄膜的透过率(包括玻璃基板)
Fig.2 Optical transmission spectra of HfSiOxand HfSiOx+Al2O3films (include the glasses)
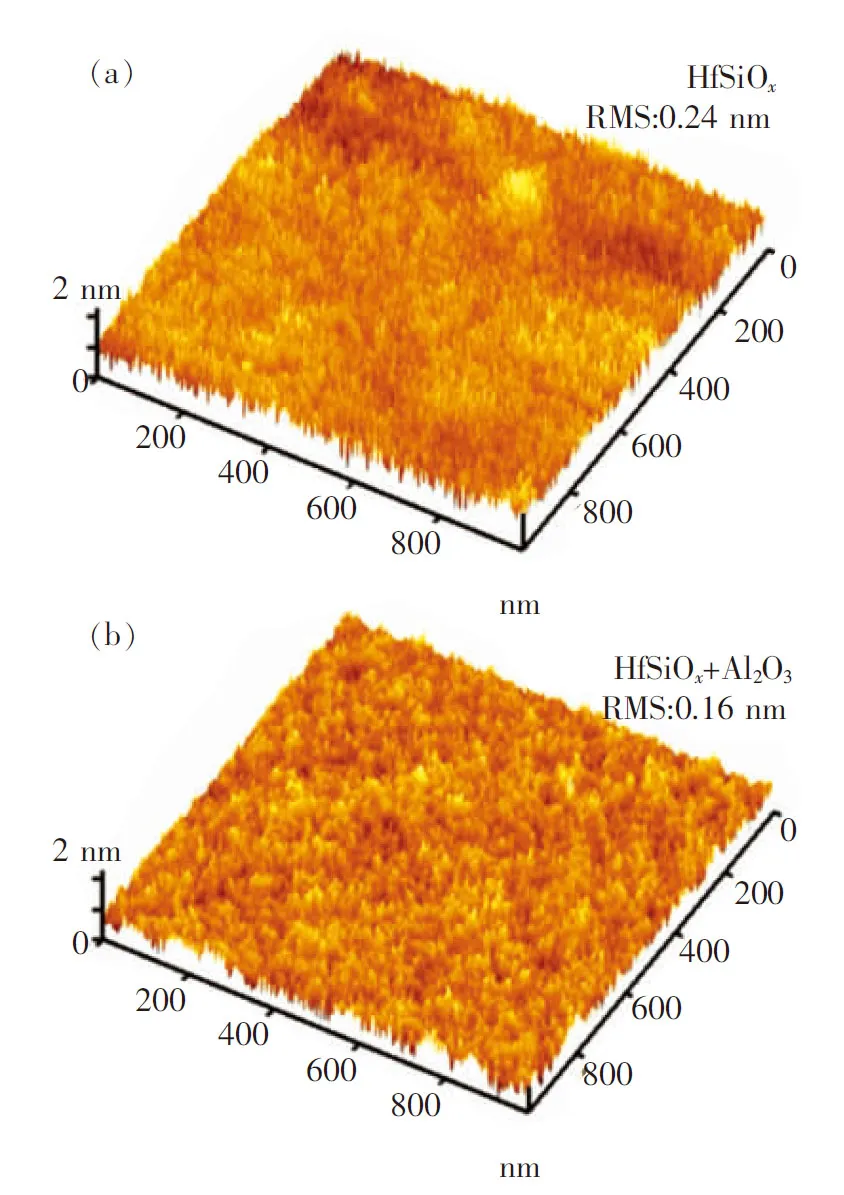
图3 500 ℃退火后的HfSiOx薄膜(a)和增加Al2O3界面修饰层后的HfSiOx薄膜(b)的接触式原子力显微镜图片
Fig.3 AFM images of HfSiOxfilm annealed at 500 ℃(a) and HfSiOxfilm modified by Al2O3film (b)
图4所示为增加界面修饰层Al2O3后的HfSiOx薄膜的扫描电子显微镜(SEM)截面图。为了更好地将HfSiOx和Al2O3层区分开来,根据两种材料的在氢氟(HF)酸中的刻蚀速率不同,在测量前对薄膜进行腐蚀处理(在稀的HF酸中浸泡5 s左右)。从测量图中可以看出,经过500 ℃处理的下层HfSiOx薄膜约为105 nm厚,而界面修饰层Al2O3厚度约为15 nm厚。同时HfSiOx和Al2O3膜层连续致密,没有裂纹和晶粒的存在,说明Al2O3和HfSiOx之间的界面结合性很好。
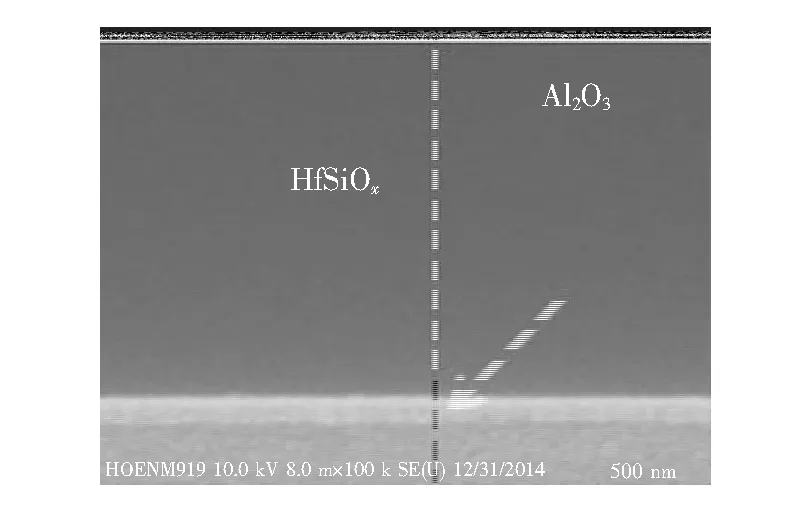
图4 增加界面修饰层Al2O3后的HfSiOx薄膜的扫描电子显微镜截面图
Fig.4 Cross sectional SEM image of HfSiOxfilm modified by Al2O3film
图5所示为HfSiOx和HfSiOx+Al2O3绝缘层的电容-电压曲线,从图中可以看出,增加界面修饰层Al2O3后,绝缘层单位电容有一定程度的下降,这可能与整体厚度的增加有关,但整体单位电容值随电压基本不变。这也在一定程度上说明,由于界面修饰层相对较薄,绝缘层的主要性能还是由HfSiOx材料决定,界面修饰层的加入不会引起绝缘层电容的显著下降及绝缘性能的恶化。
图6(a)所示为采用不同界面修饰层的HIZO TFT器件的转移特性曲线,其中源漏电压(Vd)为5 V。以IDS= 1 nA时的栅极电压定义为阈值电压,具体器件性能(正向扫描)参数见表1。从转移特性曲线中可以看出,通过增加Al2O3界面修饰层,器件迁移率、开关比、亚阈值摆幅都得到提升, 主要表现正向扫描情况下,器件迁移率从3.08 cm2/(V·s)增加至5.90 cm2/(V·s),亚阈值摆幅由0.66 V降低为0.42 V,开关比从9×105升高至6×106。尽管具体的原因还有待深入的分析,但是整体而言,Al2O3优良的表面性能有助于降低界面缺陷,从而使器件性能得到提升。界面缺陷及极化电荷的影响,一方面可以从亚阈值摆幅的变化中看出,另一方面也可以从回滞曲线中看出。如图6(a)中正反向扫描测试的转移特性曲线所示,在进行正向和反向扫描后,单纯HfSiOx为绝缘层的器件的转移特性曲线表现有明显的顺时针滞后现象(阈值电压差为-1.47 V),而以Al2O3为界面修饰层的器件存在有几乎可忽略的逆时针滞后现象(0.06 V)。

图5 HfSiOx薄膜和HfSiOx+Al2O3薄膜的电容-电压曲线
Fig.5 Capacitance-voltage plots of HfSiOxand HfSiOx+ Al2O3films
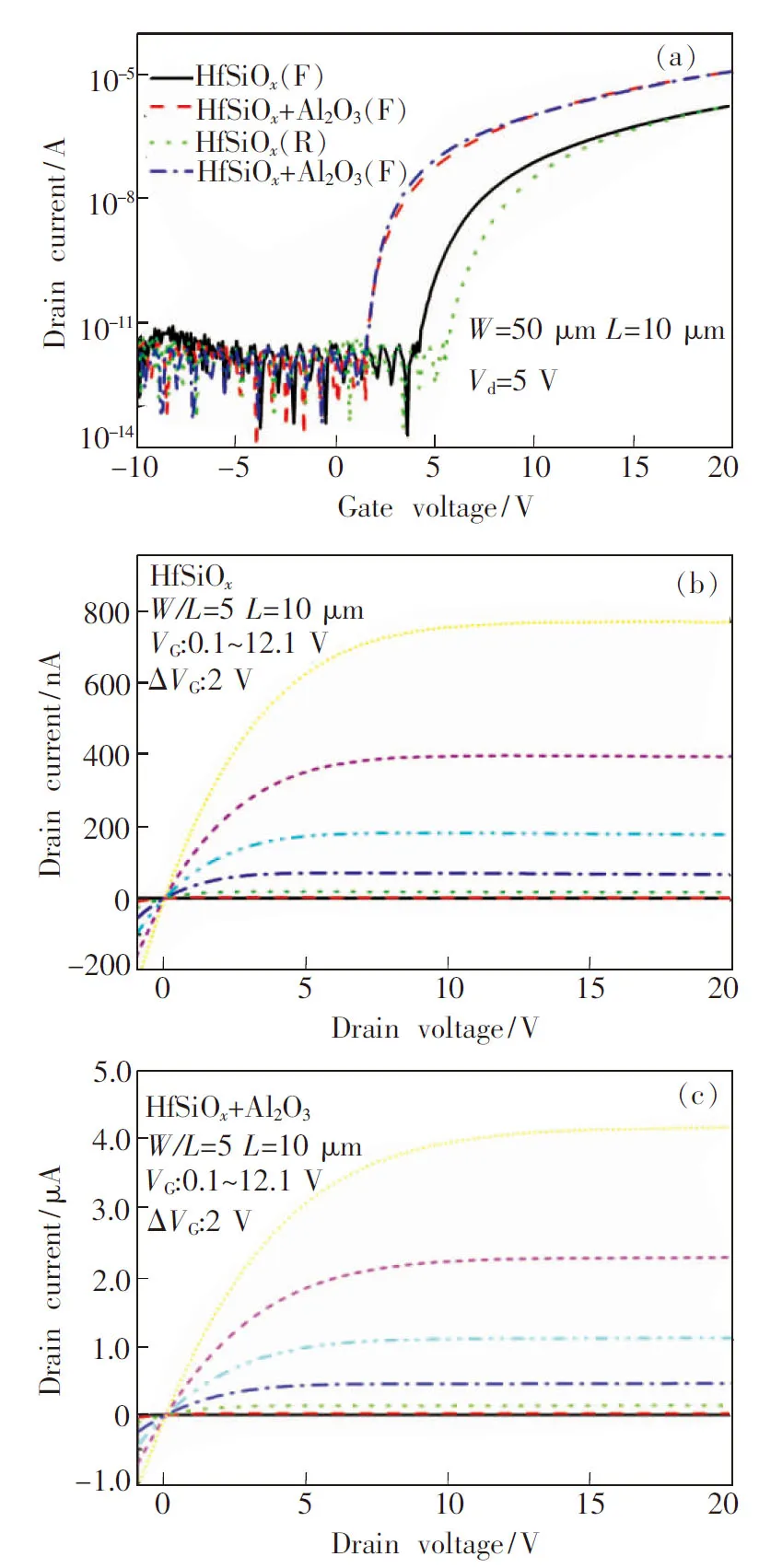
图6 (a)采用不同界面修饰层的TFT器件的转移特性曲线;(b)无界面修饰层的HIZO TFT的输出特性曲线;(c)采用Al2O3做界面修饰层的HIZO TFT的输出特性曲线。
Fig.6 (a) Transfer curves of HIZO TFTs with or without Al2O3modification layer. (b) Output curves of HIZO TFTs without Al2O3modification layer. (c) Output curves of HIZO TFTs with Al2O3modification layer.
表1 具有不同绝缘层的HIZO TFT器件性能参数对比
Tab.1 Parameters of HIZO TFTs with different dielectrics
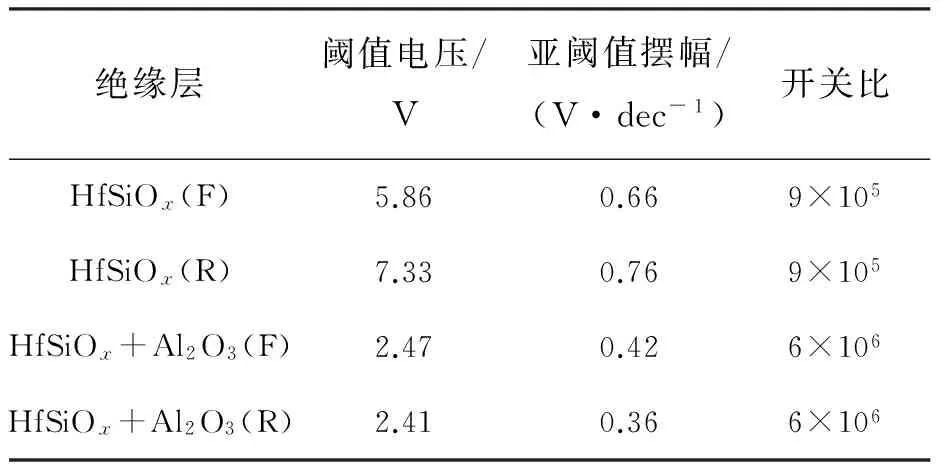
绝缘层阈值电压/V亚阈值摆幅/(V·dec-1)开关比HfSiOx(F)5.860.669×105HfSiOx(R)7.330.769×105HfSiOx+Al2O3(F)2.470.426×106HfSiOx+Al2O3(R)2.410.366×106
滞后的方向和幅度有以下几个决定因素[13]:(1)在沟道层与绝缘层之间的陷阱态;(2)绝缘层的缓慢极化;(3)可移动电荷;(4)栅极注入的电荷。绝缘层与沟道层之间界面缺陷会俘获栅极注入电子,在正向扫描时,产生电子被界面未占据态俘获;当反向扫描时,被俘获电子会持续到热脱阱。这样会引起顺时针滞后。反之,当界面俘获减少,引起可移动电子的累积,同时一些极化基团如羟基的存在会引起反向扫描过程中额外的电荷积累,这些则会导致逆时针滞后[14]。明显可以看出,增加Al2O3界面修饰层后,正向和反向扫描后引起的阈值电压差显著减小。这说明Al2O3薄膜和HIZO有源层之间的接触性能更好,Al2O3界面修饰层在提高器件性能上起到了显著作用。这可能有以下两方面原因:一是Al2O3薄膜中含有的少量羟基可以有效地抑制顺时针迟滞现象;二是通过较低温度制备绝缘层可以增加绝缘层和有源层之间的互扩散,减少由于绝缘层固化引起的界面缺陷以及器件性能退化。
图6(b)和(c)所示为以HfSiOx为绝缘层以及以Al2O3薄膜修饰的HfSiOx为绝缘层的TFT器件的输出特性曲线。从中可以看出,器件在正向偏压下正常开启,表现为n型增强模式。在Vd较低的情况下,IDS随Vd增加而线性增加,没有观察到电流阻塞现象,表明源漏电极和有源层HIZO之间存在良好的欧姆接触[15]。同时也可以看出,以Al2O3薄膜修饰的HfSiOx为绝缘层的TFT器件具有更高的饱和电流。考虑到电容电压测试结果中,两种绝缘层的电位电容变化不大,这种饱和电流增加的现象可以归因为Al2O3和绝缘层之间更好的界面特性[14]。
以上结果表明,界面修饰层可以很好地改善氧化物TFT器件的性能。
4 结 论
采用溶液法制备了以Al2O3为界面修饰层的氧化物TFT器件。Al2O3界面修饰层几乎不影响HfSiOx绝缘层薄膜的透过率,但可以改善HfSiOx薄膜的表面性能。加入Al2O3界面修饰层后,TFT器件的各项性能均得到一定程度的提高:在正向扫描情况下,器件迁移率从3.08 cm2/(V·s)增加至5.90 cm2/(V·s);亚阈值摆幅更小,由0.66 V降低为0.42 V;正向和反向扫描产生的阈值电压偏移得到了很好的抑制,由1.47 V降低为0.06 V。 实验结果表明,Al2O3界面修饰层可以降低绝缘层的表面缺陷,在一定程度上改善了TFT器件的性能。
[1] NOMURA K, OHTA H, TAKAGI A,etal.. Room-temperature fabrication of transparent flexible thin-film transistors using amorphous oxide semiconductors [J].Nature, 2004, 432(7016):488-492.
[2] 高娅娜,李喜峰,张建华. 溶胶凝胶法制备高性能锆铝氧化物作为绝缘层的薄膜晶体管 [J]. 物理学报, 2014, 63 (11):118502-1-6. GAO Y N, LI X F, ZHANG J H. Solution-processed high performance HIZO thin film transistor with AZO gate dielectric [J].ActaPhys.Sinica, 2014, 63(11):118502-1-6. (in Chinese)
[3] LI X F, LI Q, XIN E L,etal.. Sol-gel processed indium zinc oxide thin film and transparent thin-film transistors [J].J.Sol-GelSci.Technol., 2013, 65 (2):130-134.
[4] KIM Y J, OH S, YANG B S,etal.. Impact of the cation composition on the electrical performance of solution-processed zinc tin oxide thin-film transistors [J].ACSAppl.Mater.Interf., 2014, 6(16):14026-14036.
[5] LI X F, XIN E L, ZHANG J H. Effects of hf incorporation on indium zinc oxide thin-film transistors using solution process [J].Electron.Mater.Lett., 2015, 11(1):143-148.
[6] ROBERTSON J. High dielectric constant oxides [J].Eur.Phys.J.Appl.Phys., 2004, 28(3):265-291.
[7] FORTUNATO E, BARQUINHA P, MARTINS R. Oxide semiconductor thin-film transistors: a review of recent advances [J].Adv.Mater., 2012, 24(22):2945-2986.
[8] JANG K S, WEE D, KIMY H,etal.. Surface modification of a polyimide gate insulator with an yttrium oxide interlayer for aqueous-solution-processed ZnO thin-film transistors [J].Langmuir, 2013, 29(23):7143-7150.
[9] DING X, ZHANG J, ZHANG H,etal.. ZrO2insulator modified by a thin Al2O3film to enhance the performance of InGaZnO thin-film transistor [J].Microelectron.Reliab., 2014, 54(11):2401-2405.
[10] 郭永林,梁续旭,胡守成,等. Al2O3薄层修饰SiNx绝缘层的IGZO-TFTs器件的性能研究 [J]. 发光学报, 2015, 36(8):947-952. GUO Y L, LIANG X X, HU S C,etal.. Improvement of IGZO-TFTs performance with SiNxgate insulator modified by Al2O3film [J].Chin.J.Lumin., 2015, 36(8):947-952. (in Chinese)
[11] GAO Y N, LI X F, CHEN L L,etal.. High mobility solution-processed hafnium indium zinc oxide TFT with an Al-doped ZrO2gate dielectric [J].IEEEElectron.Dev.Lett., 2014, 35(5):554-556.
[12] ZHANG L, LI J, ZHANG X W,etal.. High performance ZnO-thin-film transistor with Ta2O5dielectrics fabricated at room temperature [J].Appl.Phys.Lett., 2009, 95(7):072112-1-3.
[13] YANG W, SONG K, JEONG Y,etal.. Solution-deposited Zr-doped AlOxgate dielectrics enabling high-performance flexible transparent thin film transistors [J].J.Mater.Chem. C, 2013, 1(27):4275-4282.
[14] PARK J H, YOO Y B, LEE KH,etal.. Low-temperature, high-performance solution-processed thin-film transistors with peroxo-zirconium oxide dielectric [J].ACSAppl.Mater.Interf., 2013, 5(2):410-417.
[15] 李喜峰,信恩龙,石继峰,等. 低温透明非晶IGZO薄膜晶体管的光照稳定性 [J]. 物理学报, 2013, 62(10):108503-1-5. LI X F, XIN E L, SHI J F,etal.. Stability of low temperature and transparent amorphous InGaZnO thin film transistor under illumination [J].ActaPhys.Sinica, 2013, 62(10):108503-1-5. (in Chinese)

高娅娜(1990-),女,河南濮阳人,硕士研究生,2013年于上海大学获得学士学位,主要从事氧化物薄膜晶体管的研究。
E-mail: gaoyana@shu.edu.cn

李喜峰(1978-),男,山西大同人,博士,研究员,2006年于复旦大学获得博士学位,主要从事薄膜晶体管及印刷电子器件的研究。
E-mail: lixifeng@shu.edu.cn
Solution Processed HfInZnO Thin Film Transistors with HfSiOxDielectrics Modified by Al2O3Films
GAO Ya-na1,2, XU Yun-long1,2, ZHANG Jian-hua2, LI Xi-feng2*
(1.SchoolofMaterialsScienceandEngineering,ShanghaiUniversity,Shanghai200072,China; 2.KeyLaboratoryofAdvancedDisplayandSystemApplicationsofMinistryofEducation,ShanghaiUniversity,Shanghai200072,China)*CorrespondingAuthor,E-mail:lixifeng@shu.edu.cn
Solution processed HfInZnO (HIZO) thin film transistors (TFTs) with HfSiOxdielectrics modified by Al2O3layer were fabricated. After the Al2O3layer was inserted, the optical transmittance of HfSiOxfilms was hardly changed and the surface root mean square (RMS) roughness was decreased from 0.24 to 0.16 nm. The excellent surface was benefited to improve the interface properties between dielectrics and semiconductors of HIZO TFTs. Furthermore, the characteristics of thin film transistors were improved. The threshold voltage shift between forward and reverse sweep was decreased obviously. Simultaneously, the threshold voltage and subthreshold voltage were decreased, and the on to off current ratios and mobility were increased. Above all, the experiment results indicate that Al2O3film is fit for using in TFTs as the interface modification layer to improve TFTs performance.
solution process; thin film transistors; modification layer Al2O3
∶1000-7032(2016)01-0050-06
2015-09-02;
2015-11-25
国家高技术研究发展计划(863)(2015AA033406); 广东省省级科技计划(2015B090915001); 上海科学技术委员会项目(13520500200)资助
TN321.5
A
10.3788/fgxb20163701.0050

