金属电阻率Cu/Cu2O半导体弥散复合薄膜的制备及其偏压效应
刘 阳,马 骥,唐 斌,蒋美萍,苏江滨,2,周 磊
(1. 常州大学 数理学院,江苏 常州 213164; 2. 厦门大学 物理系,福建 厦门 361005)
金属电阻率Cu/Cu2O半导体弥散复合薄膜的制备及其偏压效应
刘阳1,马骥1,唐斌1,蒋美萍1,苏江滨1,2,周磊1
(1. 常州大学 数理学院,江苏 常州 213164; 2. 厦门大学 物理系,福建 厦门 361005)
摘要:采用平衡直流磁控溅射技术,通过改变衬底偏压在玻璃衬底上制备了Cu/Cu2O弥散复合薄膜,并利用扫描电子显微镜、X射线衍射仪、四探针测试仪和紫外-可见分光光度计等进行表征与分析。研究发现,Cu/Cu2O弥散复合薄膜表现出金属和半导体双特性,其电阻率范围为(5.23~9.98)×10-5Ω·cm,禁带宽度范围为2.23~2.47 eV。同时,研究还发现衬底偏压对Cu/Cu2O弥散复合薄膜的形貌、结构、电学和光学性能都产生了较大的影响,特别是当衬底偏压为-100 V时薄膜样品的表面最为致密,结晶程度最好,电阻率最低,禁带宽度最窄。进一步地,对平衡磁控溅射过程的偏压效应进行了分析,并提出了两种区别于传统轰击和再溅射作用的新机制。
关键词:Cu/Cu2O;弥散复合薄膜;磁控溅射;衬底偏压;电阻率;禁带宽度
0引言
铜(Cu)是一种重要的过渡金属材料,属面心立方结构,其导电性能良好,电阻率为1.67×10-6Ω·cm。由于Cu具有比铝(Al)更低的电阻率和良好的抗电迁移性能[1],使Cu薄膜逐渐成为一种主流互连材料在集成电路和微电子领域有着广阔的应用前景。而氧化亚铜(Cu2O)为一价铜的氧化物,属赤铜矿结构,是一种直接带隙p型半导体材料,其电阻率为3×106Ω·cm,带隙宽度为2.17 eV。由于Cu2O具有优良的光电和化学特性,以及成本低廉、制备容易和无毒性等优点,使Cu2O薄膜成为一种具有广泛用途的材料,在太阳能电池[2]、光催化[3]、电极材料[4]、透明半导体[5]和抗菌材料[6]等领域均有潜在应用。由于Cu薄膜和Cu2O薄膜属于两种性质完全不同的材料,分别具有金属和半导体特性,如果把它们有机结合在一起,可能会具有不同于纯的Cu薄膜或者纯的Cu2O薄膜的特殊性质和相关应用。关于Cu薄膜和Cu2O薄膜的结合,主要有两种方式:一种是分层结构,一种是弥散复合结构。对于分层结构,文献中已经进行了一些研究,比如Switzer等[7]利用电沉积法制备了Cu/Cu2O多层薄膜,发现随着电沉积时所施加电流密度的变化,所得样品的电阻率可以在3.0×106~8.1×10-5Ω·cm范围内改变;Ghodselahi等[8]则利用Mie理论研究了Cu@Cu2O核-壳结构纳米颗粒的表面等离子体激元共振(SPR)特性,发现当Cu核直径超过2 nm时可见光波段会出现SPR吸收峰。对于弥散复合结构,人们在制备Cu2O薄膜时经常会发现,在某些特定条件如氧分压、pH值或者温度下得到的Cu2O产物中含有Cu组分[9-10]。然而,由于半导体薄膜的性质受杂质的影响非常严重[11-12],一般的文献在制备Cu2O薄膜时倾向于将含有Cu杂质相的样品视为不成功的例子而忽略或规避掉[9-10]。因此,在现有文献中尚未发现有人将Cu/Cu2O弥散复合薄膜作为一个独立的课题来进行系统、深入地研究。
鉴于此,本文采用平衡直流磁控溅射技术在玻璃衬底上成功制备了Cu/Cu2O弥散复合薄膜,并研究了衬底偏压对溅射产物形貌、结构、电学和光学性能的影响。研究结果表明,所制备的Cu/Cu2O弥散复合薄膜表现出金属和半导体双特性,并且衬底偏压对复合薄膜的形貌、结构、电学和光学性能都产生了较大的影响。进一步地,对平衡磁控溅射过程的偏压效应进行了分析,并提出了两种区别于传统轰击和再溅射作用的新机制。
1实验
本文制备实验是在高真空三靶磁控共溅射镀膜系统(JGP500A)中进行的,采用直流平衡磁控溅射镀膜方式,以干净的普通玻璃片为衬底,3英寸直径的高纯铜靶(99.99%)为靶材,衬底到靶材的距离约15 cm。先将腔室真空抽至5.0×10-4Pa,然后通入纯度为99.999%、流量为15 mL/min 的高纯氩气,腔室气压维持在0.1 Pa。区别于常规做法——通“氧气+氩气”混合气体、采用反应溅射来制备铜基氧化物薄膜[6,9],实验中只通氩气不通氧气,直接用氩离子来溅射铜靶,沉积Cu/Cu2O弥散复合薄膜。关于产物中的O成分,通过计算(Su J B等,未发表)和对比实验(直流100 W)发现主要来源于实验过程中腔体中残余的氧,而不是实验完成后样品暴露在空气中发生氧化的情况。沉积前,先在100 W的直流溅射功率下预溅射10 min以除去铜靶表面可能的氧化层,然后调节溅射功率为直流40 W,移开样品挡板沉积40 min,沉积速率约0.03 nm/s,薄膜厚度约72 nm。为了研究平衡磁控溅射时衬底的偏压效应,分别在0,-50,-100,-150和-200 V直流偏压下制备了样品。能量弥散X射线光谱分析(EDS)结果表明,样品中Cu和Cu2O组分的摩尔比例均约为10∶1。最后利用场发射扫描电子显微镜(FESEM,ZEISS SUPRA55),掠入射X射线衍射仪(GIXRD,RIGAKU D/max 2500PC),四探针测试仪(SDY-4)和紫外-可见分光光度计(SHIMADZU UV-2450)对样品作进一步表征与分析。
2结果与讨论
2.1微观形貌
图1为不同衬底偏压下制备得到的Cu/Cu2O弥散复合薄膜的FESEM照片。

图1不同衬底偏压Cu/Cu2O弥散复合薄膜的FESEM照片
Fig 1 FESEM images of Cu/Cu2O dispersive composite thin films at different substrate bias voltages
从图1中低放大倍数照片((a)、(c)、(e)、(g)、(i))可以看出,不同偏压下所有薄膜样品都表现出大面积、均匀和表面平整的特点。进一步地,从图1中高放大倍数照片((b)、(d)、(f)、(h)、(j))则显示了不同偏压下薄膜样品表面形貌的细节与区别。从高放大倍数照片可以看到,薄膜样品表面都呈现出“花菜”状的形貌,但是不同偏压下薄膜的疏密程度有所不同。当衬底偏压Vs=-0和-50 V时,薄膜表面都出现了许多纳米级的缝隙,薄膜显得很疏松;当衬底偏压Vs=-100 V时,薄膜表面的缝隙很少且很小,薄膜相对致密得多;而当衬底偏压Vs=-150和-200 V时,薄膜的致密程度相差不大,均比Vs=-100 V稍差,但明显优于Vs=0和-50 V。这就表明了薄膜表面的疏密程度与所施加的衬底偏压密切相关,随衬底偏压呈非线性变化关系。
2.2晶体结构
图2(a)中的GIXRD谱图显示了Cu/Cu2O弥散复合薄膜的微结构。从图2可以发现,不同偏压下制备得到的样品均表现为Cu+Cu2O混合相。其中,Cu2O相(JCPDS: 65-3288)的强度较弱,其晶向为(111);Cu相(JCPDS: 65-9743)的强度很强,主要晶向为(111),伴随有(200)和(220)晶向。而且,不同偏压下样品的结晶程度略有区别。图2(b)进一步给出了不同偏压下样品中Cu(111)和Cu2O(111)晶向的衍射峰强度。其中,对于Cu(111)晶向,当偏压从0 V增加到-100 V时,Cu(111)衍射峰强度随之增加,在Vs=-100 V时达到最大值;当偏压从-100 V增加到-200 V时,Cu(111)衍射峰强度随之下降。对于Cu2O(111)晶向,除了在Vs=-100 V时达到极小值,其它各个偏压下Cu2O(111)衍射峰强度的变化趋势与Cu(111)相同。图2(c)则根据谢乐公式给出了不同偏压下样品中Cu(111)和Cu2O(111)的晶粒尺寸。与图2(b)类似,在Vs=-100 V时,Cu(111)晶粒尺寸达到最大值而Cu2O(111)晶粒尺寸达到最小值,其它各个偏压下Cu(111)晶粒尺寸的变化趋势与Cu2O(111)相同。这可能是由于在Vs=-100 V时Cu(111)晶粒的迅速长大对Cu2O(111)晶粒的生长起到抑制作用。
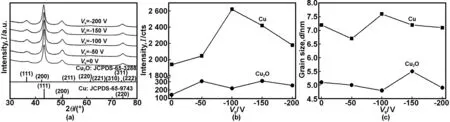
图2(a) Cu/Cu2O弥散复合薄膜的GIXRD谱图,(b) Cu(111)和Cu2O(111)衍射峰强度随衬底偏压Vs的变化关系图,(c) Cu(111)和Cu2O(111)晶粒尺寸随衬底偏压Vs的变化关系图
Fig 2 (a) GIXRD spectra of Cu/Cu2O dispersive composite thin films, (b) intensities of Cu(111) and Cu2O(111) diffraction peaks with the change of substrate bias voltage, (c) grain sizes of Cu(111) and Cu2O(111) with the change of substrate bias voltage
2.3电阻率
图3为Cu/Cu2O弥散复合薄膜的电阻率ρ随衬底偏压Vs的变化关系图。

图3Cu/Cu2O弥散复合薄膜的电阻率ρ随衬底偏压Vs的变化关系图
Fig 3 Resistivity of Cu/Cu2O dispersive composite thin films with the change of substrate bias voltage
从图3可以看出,薄膜电阻率随衬底偏压呈非线性变化关系。这可能是由于薄膜电阻率受包括薄膜表面疏密程度和结晶程度等多重因素的影响。更为重要的是,在不同衬底偏压下制备得到的薄膜样品的电阻率范围为(5.23~9.98)×10-5Ω·cm,属于常见金属或合金的电阻率范围(10-4~10-6Ω·cm)。这说明了本文所制备的Cu/Cu2O弥散复合薄膜具有很好的导电性能。此外,在-100 V衬底偏压时,薄膜样品的电阻率最低,为5.23×10-5Ω·cm。这可能是衬底偏压为-100 V时薄膜样品的表面最为致密(见图1),结晶程度最好(见图2)的缘故。
2.4禁带宽度
图4(a)给出了不同衬底偏压Cu/Cu2O弥散复合薄膜样品的(Ahv)2~hv曲线,并利用外推法获得了不同偏压下薄膜样品的禁带宽度值。发现,薄膜样品的禁带宽度范围为2.23~2.47 eV,这相对于纯Cu2O薄膜的禁带宽度值2.17 eV发生了不同程度的能隙宽化。能隙宽化的可能原因之一是Cu重掺杂导致Cu2O出现莫斯-布尔斯坦效应(Moss-Burstein effect)[13-14]。进一步地,图4(b)给出了薄膜样品的禁带宽度Eg随衬底偏压Vs的变化关系图。从图4可以看出,薄膜样品的禁带宽度随衬底偏压呈非线性变化的关系。分析比较禁带宽度和电阻率分别随衬底偏压的变化趋势(见图3和图4(b)),发现当衬底偏压低于-50 V即0 V≤|Vs|≤50 V时,禁带宽度随偏压的变化趋势与电阻率随偏压的变化趋势相反;而当衬底偏压高于-50即50 V≤|Vs| ≤200 V时,禁带宽度随偏压的变化趋势与电阻率随偏压的变化趋势相同。这从侧面说明了衬底偏压对Cu/Cu2O弥散复合薄膜的不同性质如电学和光学性质的作用机制并不完全相同,电阻率更多考虑的是表面粗糙度、晶界散射以及掺杂浓度等,而禁带宽度则主要考虑的是掺杂的影响。

图4不同衬底偏压Cu/Cu2O弥散复合薄膜的(Ahv)2-hv曲线, Cu/Cu2O弥散复合薄膜的禁带宽度Eg随衬底偏压Vs的变化关系图
Fig 4 (Ahv)2-hvcurves of Cu/Cu2O dispersive composite thin films at different substrate bias voltages, bandgap of Cu/Cu2O dispersive composite thin films with the change of substrate bias voltage
2.5偏压机制
通过上述分析,发现衬底施加负偏压后对产物的形貌、结构、电学和光学性能都产生了较大的影响。一般地,人们在研究衬底负偏压的作用时,更多的是考虑溅射氩离子在负偏压电场加速下对薄膜的轰击和再溅射作用[15]。然而,氩离子的轰击和再溅射作用更多出现在非平衡磁控溅射过程中,而本文使用的是平衡磁控溅射镀膜方式。相对于非平衡磁控溅射,平衡磁控溅射由于磁场线几乎完全被束缚在靶材附近,即使加上衬底偏压,氩离子主要活动范围还是集中在靶材附近,很少有氩离子能够运动到远处的衬底(本文靶材到衬底的距离为15 cm)并对正在沉积的薄膜进行轰击和再溅射[16-17]。另外,从图1的FESEM照片也可以看出,偏压较大时薄膜表面仍然保持得相对平整,并没有出现再溅射过程常见的表面粗糙化现象。这从侧面进一步说明了非平衡磁控溅射机制不适用于平衡磁控溅射过程。
针对本文的平衡磁控溅射情况,我们认为衬底负偏压的作用机制主要有两个。机制Ⅰ,在衬底负偏压电场的作用下,入射过来的Cu原子发生了“极化”,从而加速向衬底飞行运动。由于腔室气压很低,到达衬底前Cu原子具有较高的动能,它们将在衬底上进行一定的扩散与迁移。机制Ⅱ,在衬底负偏压电场的作用下,正在沉积的Cu/Cu2O薄膜(少部分Cu原子在衬底上被氧化成Cu2O分子)表面出现静电感应。由于微观尺度下的薄膜表面是凹凸不平的,根据尖端集电的原理,薄膜表面的电场可以看成是无数个颗粒(点电荷)电场的叠加,而且相邻点电荷电场之间由于极性相同而具有相互排斥性。当入射过来的Cu原子靠近某个颗粒时,会被这个颗粒的电场束缚住,并且在该电场的牵引下沉积到颗粒上的某个点,从而导致扩散和迁移难度增加。(1)当Vs=0和-50 V时,由于没有偏压作用或偏压作用较小,经过长距离的飞行以及与腔室中气体的碰撞,Cu原子到达衬底前的剩余动能较低,没有足够的能量保证在衬底上进行有效的扩散与迁移,导致最终薄膜表面疏松,结晶程度较差。在这个过程中,机制Ⅰ和机制Ⅱ没有贡献(Vs=0)或者贡献都比较弱(Vs=-50 V);(2) 随着衬底偏压的增加,当Vs=-100 V时,机制Ⅰ起主要作用,Cu原子在偏压电场的作用下加速沉积到衬底,由于具有了较高的动能,Cu原子将在衬底表面进行一定的扩散与迁移,薄膜表面变得致密,结晶程度提高;(3) 随着衬底偏压的进一步增加,当Vs=-150 V和-200 V时,机制Ⅱ起主要作用,加速过来的Cu原子进一步被衬底表面的电场所束缚,导致扩散和迁移难度增加,薄膜表面又变得疏松,结晶程度下降。
3结论
采用平衡直流磁控溅射技术在玻璃衬底上成功制备了Cu/Cu2O弥散复合薄膜, 并研究了衬底偏压对溅射产物形貌、结构、电学和光学性能的影响。研究发现,Cu/Cu2O弥散复合薄膜表现出金属和半导体双特性,其电阻率范围为(5.23~9.98)×10-5Ω·cm,禁带宽度范围为2.23~2.47 eV,因此在高迁移率晶体管、电极和太阳能电池等领域可能都具有潜在应用前景。同时,研究还发现衬底偏压对Cu/Cu2O弥散复合薄膜的形貌、结构、电学和光学性能都产生了较大的影响,特别是当衬底偏压为-100 V时薄膜样品的表面最为致密,结晶程度最好,电阻率最低,禁带宽度最窄。进一步地,对平衡磁控溅射过程的偏压效应进行了分析,并提出了两种区别于传统轰击和再溅射作用的新机制。
参考文献:
[1]Murarka S P. Multilevel interconnections for ULSI and GSI era [J]. Mater Sci Engineer R, 1997, 19: 87-151.
[2]Mittiga A, Salza E, Sarto F, et al. Heterojunction solar cell with 2% efficiency based on a Cu2O substrate [J]. Appl Phys Lett, 2006, 88: 163502.
[3]Zhang Y, Deng B, Zhang T, et al. Shape effects of Cu2O polyhedral microcrystals on photocatalytic activity [J]. J Phys Chem C, 2010, 114: 5073-5079.
[4]Tachibana Y, Muramoto R, Matsumoto H, et al. Photoelectrochemistry of p-type Cu2O semiconductor electrode in ionic liquid [J]. Res Chem Intermed, 2006, 32: 575-583.
[5]Robertson J, Peacoke P W, Towler M D, et al. Electronic structure of p-type conducting transparent oxides [J]. Thin Solid Films, 2002, 411: 96-100.
[6]Yang Jing’an, Zhang Junying, Li Chunzhi. Remarkable antibacterial properties of copper and its oxide thin films against E coli [J]. Journal of Functional Materials, 2012, 43: 398-404.
杨靖安,张俊英,李春芝. 铜及其氧化物薄膜对大肠杆菌的强抑制作用[J]. 功能材料,2012,43:398-404.
[7]Switzer J A, Hung C J, Huang L Y, et al. Potential oscillations during the electrochemical self-assembly of copper/cuprous oxide layered nanostructures [J]. J Mater Res, 1998, 13: 909-916.
[8]Ghodselahi T, Vesaghi M A, Shafiekhani A. Study of surface plasmon resonance of Cu@Cu2O core-shell nanoparticles by Mie theory [J]. J Phys D: Appl Phys, 2009, 42: 015308.
[9]Zhu H, Zhang J, Li C, et al. Cu2O thin films deposited by reactive direct current magnetron sputtering [J]. Thin Solid Films, 2009, 517: 5700-5704.
[10]Mahalingam T, Chitra J S P, Rajendran S, et al. Galvanostatic deposition and characterization of cuprous oxide thin films [J]. J Cryst Growth, 2000, 216: 304-310.
[11]Malerba C, Ricardo C L A, Dincau M, et al. Nitrogen doped Cu2O: a possible material for intermediate band solar cells [J]. Sol Energy Mater Sol Cells, 2012, 105: 192-195.
[12]Ishizuka S, Akimoto K. Control of the growth orientation and electrical properties of polycrystalline Cu2O thin films by group-IV elements doping [J]. Appl Phys Lett, 2004, 85: 4920-4922.
[13]Moss T S. The interpretation of the properties of indium antimonide [J]. Proc Phys Soc B, 1954, 67: 775-782.
[14]Burstein E. Anomalous optical absorption limit in InSb [J]. Phys Rev, 1954, 93: 632-633.
[15]Thièry F, Pauleau Y, Ortega L. Effects of the substrate bias voltage on the physical characteristics of copper films deposited by microwave plasma-assisted sputtering technique [J]. J Vac Sci Technol A, 2004: 22: 30-35.
[16]Su J B, Wang H H, Jiang M P, et al. Bias deposition of nanoporous Cu thin films [J]. Mater Lett, 2013, 102-103: 72-75.
[17]Su J B, Wang H H, Jiang M P, et al. Corrigendum to “Bias deposition of nanoporous Cu thin films”[J]. Mater Lett, 2014, 127: 12-12.
Fabrication of semiconducting Cu/Cu2O dispersive composite thin films with metallic resistivity and the bias voltage effect
LIU Yang1, MA Ji1, TANG Bin1, JIANG Meiping1, SU Jiangbin1,2, ZHOU Lei1
(1. School of Mathematics and Physics, Changzhou University, Changzhou 213164, China;2.Physics Department, Xiamen University, Xiamen 361005, China)
Abstract:Cu/Cu2O dispersive composite thin films were successfully fabricated on glass slides using direct current-balanced magnetron sputtering technology by changing the substrate bias voltage. Scanning electron microscope, X-ray diffractometer, four-point probe instrument and ultraviolet-visible spectrophotometer were applied for a detailed characterization. It was found that as-prepared composite thin films show an intriguing combination of metal and semiconductor characteristics with resistivity of (5.23-9.98) × 10-5Ω·cm and bandgap of 2.23-2.47 eV. It was also found that the substrate bias voltage influences the morphology, structure, electrical and optical properties greatly. Especially, when the substrate bias voltage was -100 V, as-prepared composite thin film presents a condensed morphology and a well-crystallized structure with the lowest resistivity and the narrowest bandgap. Further, the bias voltage effect during balanced magnetron sputtering deposition was studied and two new mechanisms which differentiate from the traditional bombardment and re-sputtering mechanisms were also proposed.
Key words:Cu/Cu2O; dispersive composite thin film; magnetron sputtering; substrate bias voltage; resistivity; bandgap
DOI:10.3969/j.issn.1001-9731.2016.03.038
文献标识码:A
中图分类号:O47;TB7
文章编号:1001-9731(2016)03-03205-05
作者简介:刘阳(1988-),男,安徽安庆人,硕士,师承蒋美萍教授,从事功能纳米氧化物研究。
基金项目:江苏省自然科学基金资助项目(BK20141169);江苏省高等学校大学生实践创新训练计划资助项目(201410292032Y);常州大学学生课外科技创新基金暨“挑战杯·卓越”计划资助项目(2014-07-A-21)
收到初稿日期:2015-04-02 收到修改稿日期:2015-09-20 通讯作者:苏江滨,E-mail: jbsu@cczu.edu.cn

