退火温度对非晶铟钨氧薄膜晶体管特性的影响
许 玲,吴 崎,董承远
(上海交通大学 电子工程系,上海 200240)
退火温度对非晶铟钨氧薄膜晶体管特性的影响
许玲,吴崎,董承远*
(上海交通大学 电子工程系,上海200240)
非晶铟钨氧(a-IWO)薄膜晶体管(TFT)具有高迁移率和高稳定性的优点,但其适合于实际生产的制备工艺条件尚有待摸索。本文研究了退火温度对a-IWO TFT电学特性影响的基本规律和内部机理。实验结果表明,随着退火温度的升高,a-IWO TFT的场效应迁移率也相应增加,这是由于高温退火下a-IWO薄膜中氧空位含量增多并进而导致载流子浓度增加的缘故。此外,a-IWO TFT的亚阈值摆幅和阈值电压在200 ℃下退火达到最佳,我们认为主要原因在于此时a-IWO薄膜的表面粗糙度最小并形成了最佳的前沟道界面状态。
非晶铟钨氧;薄膜晶体管;退火温度;氧空位;表面粗糙度
*Corresponding Author,E-mail:cydong@sjtu.edu.cn
1 引 言
自本世纪初以来,以非晶氧化物半导体(AOS)为有源层材料的薄膜晶体管(TFT)器件因为具有场效应迁移率大、亚阈值摆幅小和大面积均一性好等优点而逐渐被普遍认为将有可能取代非晶硅薄膜晶体管并成为下一代平板显示(FPD)的有源矩阵驱动电子器件[1-9]。其中,非晶铟镓锌氧(a-IGZO)最为研究人员所关注并已经成为AOS TFT有源层的主流材料[1-5]。然而,由于a-IGZO中采用ZnO和Ga2O3以促进非晶结构的形成和抑制载流子浓度,其场效应迁移率并不能达到很高,一般在10 cm2·V-1·s-1左右[6-9]。当前,平板显示的分辨率越来越高,使得a-IGZO TFT相对不高的场效应迁移率越来越难以满足相关技术需求。另一方面,a-IGZO TFT的稳定性也不是很理想,这也制约其在FPD中的进一步应用。因此,寻找迁移率更高同时稳定性更好的AOS材料变得越来越迫切。为此,科研人员展开了相关的研究和开发工作。其中,有研究表明非晶铟钨氧(a-IWO)具有非常好的电学特性[10]和稳定性[11],很有希望成为继a-IGZO之后的下一代非晶氧化物半导体材料。
目前已经有了一些关于a-IWO TFT的研究报道[10-11],但都局限于材料和器件机理方面的研究,关于a-IWO TFT制备工艺参数与器件特性之间的关系的研究还未见报道,而这些规律的掌握显然是其能够被实际应用的前提条件之一。例如,退火可以显著地改变TFT器件的电学特性,但是针对a-IWO TFT退火工艺基本规律的摸索到目前为止还几乎无人涉及。本文针对a-IWO TFT的退火温度对器件特性的影响开展研究,证明了将a-IWO TFT在200 ℃下退火1 h会获得最佳的器件电学特性,并通过微观表征和理论分析对上述结果给出了合理的解释。
2 实 验
2.1器件制备
本实验中制备的a-IWO TFT器件是倒置错排(Inverted staggered)结构(图1),沟道宽长比(W/L)为1 000 μm/275 μm。。采用的基板是n++型重掺杂的硅片(兼作栅电极),其上有一层300 nm厚的热氧化SiOx作为栅绝缘层。器件中的薄膜层都是利用金属掩膜遮挡磁控溅射沉积完成,有源层与源漏电极使用的靶材分别是IWO(In2O3∶WO3=97∶3,量比)和ITO (In2O3∶SnO2=9∶1,重量比)。由于IWO与ITO的载流子浓度都很高(即导电性较好),所以两层薄膜制备均采用直流(DC)磁控溅射,主要的成膜工艺条件如表1所示。a-IWO是一种新型的材料,所含的主要成分是In2O3与WO3,其中In2O3占主体,W掺杂可以起到降低载流子浓度和控制薄膜结晶状态的效果。目前采用的a-IWO薄膜中W的含量一般很少,由此导致薄膜的载流子浓度通常很高,所以在薄膜制备过程中需要尽量降低载流子浓度。与一般的AOS材料相类似,a-IWO的载流子主要来源于氧空位,因此为了降低载流子浓度必须减少氧空位的含量。一般而言,增加成膜过程中的氧流量,可以减少a-IWO薄膜中氧空位的产生。因此,在a-IWO的沉积时我们采用的气体流量比是:Ar∶O2=30∶5(cm3·min-1),即氧气流量比a-IGZO成膜时高得多。最后,将a-IWO TFT器件放置在退火炉中进行大气氛围下的退火处理,温度在160~240 ℃之间。
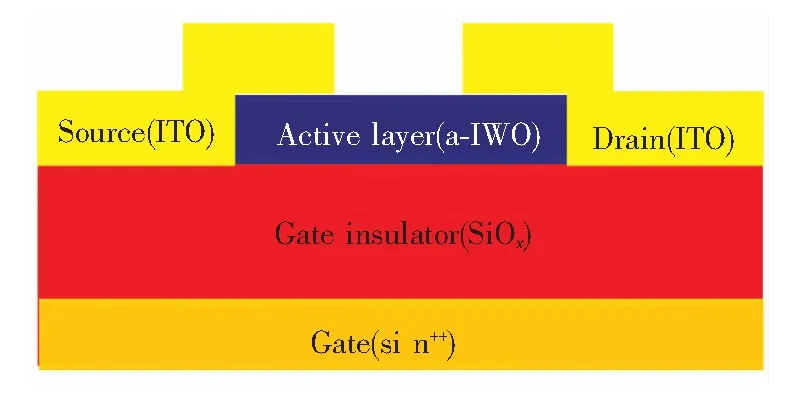
图1 本研究采用的a-IWO TFT器件断面结构
Fig.1Schematic cross section of a-IWO TFTs used in this study

表1 a-IWO与ITO制备工艺参数
2.2测试与分析
本研究采用Keithley 4200SCS半导体特性分析仪对TFT器件进行电学特性的测试。在测试转移特性曲线时设置漏极电压为10 V,栅极电压Vg选取的扫描范围是-20~40 V,其扫描间隔为0.25 V。利用D8 ADVANCE型X射线衍射仪(XRD)对a-IWO薄膜进行晶态结构的表征和分析。采用AXIS Ultra DLD型号的X射线光电子能谱仪(XPS)表征a-IWO薄膜内的元素成分和价键结构。最后为了定量分析a-IWO与栅绝缘层之间的界面状态,使用Nanonavi E-Sweep型号的原子力显微镜(AFM)观察和测量a-IWO薄膜表面的形貌和粗糙度。
3 结果与讨论
3.1a-IWO TFT电学特性
如前所述,a-IWO薄膜的主要成分是In2O3,而WO3主要起到调节载流子浓度和薄膜晶体结构的作用。因为高温退火可能会改变薄膜的非晶结构,所以对于a-IWO来说一般选择在较低温度下进行退火处理[11]。另一方面,a-IWO内的自由载流子主要来源于氧空位且浓度比较高,一般需要在含氧氛围下退火以达到填补氧空位的目的,因此将a-IWO在空气中进行退火处理是比较合适的。利用空气中的氧填补薄膜内的氧空位缺陷,不仅可以降低a-IWO薄膜的载流子浓度,还可以通过填补缺陷以达到改善界面态的效果。
本研究选择了如下几组退火温度在空气中对a-IWO TFT器件进行处理:160,180,200,220,240 ℃,退火时间均为1 h。实验测得的转移特性曲线如图2(a)所示,根据文献[12]中所述的方法提取了相关的器件特性参数,包括场效应迁移率μFE、亚阈值摆幅SS值、阈值电压Vth和开关电流比Ion/Ioff等。图2(b)、(c)和(d)分别对应场效应迁移率、亚阈值摆幅和阈值电压随着退火温度的变化规律。

图2 在不同退火温度下,a-IWO TFT的转移特性曲线(a)、场效应迁移率(b)、亚阈值摆幅(c)和阈值电压(d)。
Fig.2Dependence of the transfer curves (a),μFE(b),SS(c),and Vth(d) of a-IWO TFTs on the annealing temperatures,respectively.
从图2(a)中可以看出,在适当温度下退火可以明显改善a-IWO TFT的电学特性。但是,如果退火温度过高,例如当退火温度达到240 ℃时,器件已经无法表现出明显的转移特性,这说明a-IWO TFT的确不适合高温退火。如图2(b)所示,当退火温度由160 ℃逐渐增加至220 ℃时,a-IWO TFT的场效应迁移率也逐渐由7 cm2·V-1·s-1增加到12 cm2·V-1·s-1以上,而亚阈值摆幅和阈值电压则发生了比较复杂的变化。如图2(c)所示,随着退火温度的升高,SS值先降后升,在退火温度为200 ℃达到最小;同时,Vth则随着退火温度的升高而先增后减,在退火温度为200 ℃时达到最大值(图2(d))。
经过比较我们发现,200 ℃退火器件的亚阈值摆幅SS值和阈值电压Vth最佳,分别为0.6 V/decade和-3.5 V,其场效应迁移率也比较大(11.5 cm2·V-1·s-1)。虽然场效应迁移率较220 ℃退火时略小,但从图2(b)和(c)中可以发现,220 ℃退火器件的SS值与Vth都较差,因此经过综合比较,我们确定200 ℃为最佳的退火温度。
3.2a-IWO薄膜微观分析
至此,我们证明了a-IWO TFT的最佳退火温度是200 ℃,但为何在此条件下退火器件会呈现最佳电学特性尚不清楚。为此,我们采用XRD、XPS和AFM等测量设备对不同退火条件下a-IWO薄膜的微观结构进行了观察和分析。
首先我们利用XRD来表征不同退火温度下a-IWO薄膜的结晶状态。如图3所示,在160~240 ℃范围内退火时所有样品都没有明显的“结晶峰”出现,这说明在上述温度区间内退火的a-IWO薄膜会呈现比较理想的非晶状态。

图3 不同退火温度下a-IWO薄膜的XRD测试结果
Fig.3XRD patterns of a-IWO films under various annealing temperatures
接着,我们采用XPS对不同退火温度下的a-IWO薄膜的元素成分和价键状态进行了测量和分析。实验结果表明,我们制备的a-IWO薄膜中所含的W的摩尔分数为1.39%,与目标值1.18%相差不大。如前所述,a-IWO薄膜的自由载流子主要来源于氧空位,所以了解氧空位浓度随着退火温度的变化规律对理解a-IWO TFT器件特性变化的机理是非常有帮助的。具体实验结果如图4所示,其中图4(a)是未经退火处理的a-IWO薄膜的O1S图谱。图中横坐标代表光电子动能,纵坐标表示相对强度。图中黑色曲线代表薄膜的O1S的XPS谱图,该峰通常可由其他3个高斯分布的峰叠加拟合而成。图中红色曲线O1L表示低结合能峰,它是由a-IWO中的晶格氧O2-产生的;曲线O1M是处于中间的结合能,一般由氧空位的O2-离子产生(即形成氧空位时脱离晶格位置的O2-离子);曲线O1H是高结合能峰,通常是薄膜表面氧的峰位,如吸附的H2O、CO2等。
因为a-IWO薄膜中氧空位的数量直接影响着TFT器件有源层的自由载流子浓度,所以我们比较了不同退火温度下的样品中的氧空位浓度,如图4(b)所示。图中的纵坐标数值实际上是O1M峰的积分面积占O1S峰积分总面积的百分比。从图中可以看出a-IWO薄膜内氧空位的浓度一般都很高,这与霍尔效应测试证明的a-IWO薄膜一般具有较高载流子浓度的实验结果是相吻合的[13]。另一方面,经过退火处理的样品的氧空位含量一般比未退火的样品为低,这是因为在空气中退火处理时氧原子可进入a-IWO薄膜中并填补氧空位的缘故;在退火温度为160~220 ℃的区间,随着退火温度的升高氧空位的浓度也增加,这可能是因为在高温下退火的a-IWO中的氧原子更易于离开原来位置并形成新的氧空位。对于非晶氧化物半导体而言,其载流子迁移率通常与载流子浓度呈正比[1],因此a-IWO TFT的场效应迁移率也随着退火温度的升高而增加。至于未退火的器件,虽然其有源层中的氧空位(载流子)浓度较高,但因为薄膜和界面的缺陷态也非常高,所以并不能表现出好的转移特性。
尽管XPS的表征结果很清楚地解释了a-IWO TFT的场效应迁移率随退火温度的变化规律,但是还不能说明亚阈值摆幅和阈值电压的相关变化规律。一般而言,TFT器件的亚阈值摆幅和阈值电压主要取决于有源层和界面(特别是有源层/栅绝缘层界面)的缺陷态分布。就退火条件对a-IWO TFT器件特性的影响而言,我们推测前沟道(即有源层/栅绝缘层界面)的状态可能起到了至关重要的作用。另一方面,前沟道界面状态与有源层的表面粗糙度密切相关,所以对退火后的a-IWO薄膜表面进行粗糙度的分析是非常有必要的[14]。为此我们选取了未退火和160,200,240 ℃退火条件下的a-IWO薄膜做了AFM测试和分析,相关结果如图5所示。从图5(a)可以看出,200 ℃空气中退火的薄膜表面非常平整,其他3种样品的表面则相对比较粗糙。这一观察结论也为表面粗糙度的实际测量结果所证实。如图5(b)所示,未退火和160,200,240 ℃退火的a-IWO薄膜的粗糙度均方根值分别为0.494,0.433,0.249,0.464 nm。显然,200 ℃退火的薄膜表面粗糙度是最小的。事实上,a-IWO薄膜的表面粗糙度对前沟道(有源层/栅绝缘层)界面状态的影响至关重要。一般而言,较小的有源层表面粗糙度会形成较好的前沟道界面状态,进而带来较佳的TFT器件特性。其中SS值与前沟道界面态关系非常密切,当界面状态较好时,SS值会较小[15]。Vth则取决于更多因素,但因为本研究中制备的a-IWO TFT都是常开型(Normally-on)器件,所以较好的前沟道状态将导致绝对值较小的负栅极电压就能使沟道层中的固有电子耗尽,即获得更接近于0 V的阈值电压。至此,我们可以得出如下结论:因为200 ℃退火的a-IWO薄膜具有最小的表面粗糙度,所以形成的器件前沟道界面状态最好,从而获得了最佳的亚阈值摆幅和阈值电压。至于为何a-IWO薄膜在200 ℃下退火会获得最平整的表面目前还不清楚,相关研究还在进行中。我们推测可能与原子扩散和热应力有关。一般来说,随着退火温度的增加,原子扩散能力增强,而更充分的原子扩散可导致薄膜表面的原子排列更理想,即表面粗糙度更小;但是对于a-IWO薄膜而言,高于200 ℃退火可能会产生较大的热应力,从而使薄膜表面变得不平整。当然上述推测还有待进一步的实验验证。

图4(a)未退火a-IWO薄膜O1S峰的XPS图谱;(b)不同退火温度下a-IWO薄膜中的氧空位含量。
Fig.4(a) XPS O1Speak of the as-deposited a-IWO films.(b) Variation of the oxygen vacancy content in a-IWO films with the annealing temperatures.

图5不同退火温度下a-IWO薄膜的AFM分析测试结果。(a)表面形貌;(b)表面粗糙度。
Fig.5Surface morphology (a) and roughness (b) of the a-IWO films under various annealing temperatures measured by AFM
4 结 论
研究了在160~240 ℃区间内退火温度对a-IWO TFT器件电学特性的影响规律和相关物理机理。结果表明,随着退火温度的升高,场效应迁移率也随之增加;亚阈值摆幅和阈值电压则呈现比较复杂的变化规律,但在200 ℃下退火会达到最佳。XPS分析指出:随着退火温度的升高,a-IWO薄膜中的氧空位相应增加,并由此导致TFT器件场效应迁移率的增加。AFM测试则证明,在200 ℃下退火能获得最佳的亚阈值摆幅值和阈值电压的原因在于此时a-IWO薄膜的表面粗糙度最小,并由此而导致了最佳的前沟道界面状态。
[1]NOMURA K,OHTA H,TAKAGI A,et al..Room-temperature fabrication of transparent flexible thin-film transistors using amorphous oxide semiconductors [J].Nature,2004,432(7016):488-492.
[2]LEE G J,KIM J,KIM J H,et al..High performance,transparent a-IGZO TFTs on a flexible thin glass substrate [J].Semicond.Sci.Technol.,2014,29(3):035003.
[3]HSU H H,CHANG C Y,CHENG C H.A flexible IGZO thin-film transistor with stacked TiO2-based dielectrics fabricated at room temperature [J].IEEE Electron.Dev.Lett.,2013,34(6):768-770.
[4]MÜNZENRIEDER N,ZYSSET C,PETTI L,et al..Flexible double gate a-IGZO TFT fabricated on free standing polyimide foil [J].Solid State Electron.,2013,84:198-204.
[5]苟昌华,武明珠,郭永林,等.未退火InGaZnO作为缓冲层的InGaZnO薄膜晶体管性能研究 [J].液晶与显示,2015,30(4):602-607.
GOU C H,WU M Z,GUO Y L,et al..Effects of using InGaZnO without annealing as buffer layer on the performance of InGaZnO thin film transistors [J].Chin.J.Liq.Cryt.Disp.,2015,30(4):602-607.(in Chinese)
[6]LIU G X,LIU A,ZHU H H,et al..Low-temperature,nontoxic water-induced metal-oxide thin films and their application in thin-film transistors [J].Adv.Funct.Mater.,2015,25(17):2564-2572.
[7]DOMINGUEZ M A,FLORES F,LUNA A,et al..Impact of active layer thickness in thin-film transistors based on zinc oxide by ultrasonic spray pyrolysis [J].Solid State Electron.,2015,109:33-36.
[8]LI H U,JACKSON T N.Oxide semiconductor thin film transistors on thin solution-cast flexible substrates [J].IEEE Electr.Device Lett.,2015,36(1):35-37.
[9]LAN L F,XIONG N N,XIAO P,et al..Enhancement of bias and illumination stability in thin-film transistors by doping InZnO with wide-band-gap Ta2O5[J].Appl.Phys.Lett.,2013,102(24):242102.
[10]AIKAWA S,DARMAWAN P,YANAGISAWA K,et al..Thin-film transistors fabricated by low-temperature process based on Ga- and Zn-free amorphous oxide semiconductor [J].Appl.Phys.Lett.,2013,102(10):102101.
[11]KIZU T,AIKAWA S,MITOMA N,et al..Low-temperature processable amorphous In-W-O thin-film transistors with high mobility and stability [J].Appl.Phys.Lett.,2014,104(15):152103.
[12]SHI J F,DONG C Y,DAI W J,et al..The influence of RF power on the electrical properties of sputtered amorphous In-Ga-Zn-O thin films and devices [J].J.Semicond.,2013,34(8):084003.
[13]ABE Y,ISHIYAMA N,KUNO H,et al..Amorphous indium tungsten oxide films prepared by DC magnetron sputtering [J].J.Mater.Sci.,2005,40(7):1611-1614.
[14]FUH C S,SZE S M,LIU P T,et al..Role of environmental and annealing conditions on the passivation-free in-Ga-Zn-O TFT [J].Thin Solid Films,2011,520(5):1489-1494.
[15]RAJA J,JANG K,NGUYEN H H,et al..Enhancement of electrical stability of a-IGZO TFTs by improving the surface morphology and packing density of active channel [J].Curr.Appl.Phys.,2013,13(1):246-251.

许玲(1991- ),女,湖北孝感人,硕士研究生,2013年于北京交通大学获得学士学位,主要从事氧化物半导体薄膜晶体管的研究。
E-mail:xl_1130349168@sjtu.edu.com

董承远(1971-),男,辽宁沈阳人,博士,副教授,2003年于上海交通大学获得博士学位,主要从事薄膜电子器件与电路的研究。
E-mail:cydong@sjtu.edu.cn
Effect of Annealing Temperature on Performance of Amorphous InWO Thin Film Transistors
XU Ling,WU Qi,DONG Cheng-yuan*
(Department of Electronic Engineering,Shanghai Jiao Tong University,Shanghai 200240,China)
Amorphous indium tungsten oxide (a-IWO) thin film transistors (TFTs) show superior electrical performance and stable properties,but their industrial fabrication methods still need to be developed.In this study,the effect of annealing temperature on the electrical performance of a-IWO TFTs was investigated,where the related basic dependence and physical essence were involved.The experimental results indicate that the field-effect mobility of a-IWO TFTs increases gradually with the annealing temperature increasing,due to the more oxygen vacancies as well as the larger carrier concentration at higher annealing temperatures.Meanwhile,annealing at 200 ℃ led to the best subthreshold swing and threshold voltage of a-IWO TFTs,as is assumed to mainly result from the best front-channel interface caused by the smallest roughness of the a-IWO films annealed at 200 ℃.
amorphous indium tungsten oxide; thin film transistors; annealing temperature; oxygen vacancies; roughness
1000-7032(2016)04-0457-06
2015-12-21;
2016-01-18
国家自然科学基金面上项目(61474075); 国家自然科学基金重点项目(61136004)资助
TN321+.5
A
10.3788/fgxb20163704.0457

