衬底温度对共溅射法制备BaSi2薄膜的影响
杨子义, 刘 涛, 徐 虎
(1. 贵阳学院 电子与通信工程学院, 贵州 贵阳 550005;2. 贵州大学 新型光电子材料与技术研究所, 贵州 贵阳 550025)
衬底温度对共溅射法制备BaSi2薄膜的影响
杨子义1,2, 刘 涛1, 徐 虎2
(1. 贵阳学院 电子与通信工程学院, 贵州 贵阳 550005;2. 贵州大学 新型光电子材料与技术研究所, 贵州 贵阳 550025)
研究衬底温度对采用Ba靶和Si靶共溅射制备BaSi2薄膜的影响.采用X射线衍射仪和扫描电子显微镜对在不同衬底温度条件下制备的薄膜的微观结构组分和表面形貌进行表征与分析.结果表明,衬底温度在500 ℃以下时Ba和Si共沉积在Si(111)衬底上生成的为非晶,结合后续的真空退火生成BaSi2多晶薄膜.衬底温度是制备优质BaSi2薄膜的关键因素,衬底温度高于600 ℃时,共溅射法能够直接生成BaSi2薄膜.
共溅射法; BaSi2薄膜; 衬底温度; 晶体结构; 表面形貌
近年来,环境友好半导体硅化物在光电和热电方面的应用引起了广泛的关注[1].正交相BaSi2由自然界中含量丰富且较小毒性的元素构成,在室温和大气压下是一种稳定的P型半导体[2],其间接带宽为0.83~1.3 eV[3-5].通过Sr掺杂,BaSi2晶格中的Ba原子被Sr原子取代后间接带宽甚至能够达到1.4 eV[6],与太阳光谱匹配.在入射光能量为1.5 eV时正交相BaSi2的吸收系数超过了105cm-1[7],该值比晶体硅的吸收系数超过2个数量级.入射光能量在2~4.5 eV范围内,BaSi2的吸收系数比β-FeSi2大;入射光能量小于2 eV,两者吸收系数是大小相当的[3].在研发长波发光器件和太阳能电池方面,BaSi2是一种新型半导体材料.正交相BaSi2属正交晶系,其空间群为Pnma(No.62),晶格常数a=0.892 nm,b=0.675 nm,c=1.157 nm[8].正交相BaSi2在Si(111)衬底上比Si(001)衬底上生长得更好[9].在硅衬底上制备BaSi2薄膜比较困难,这是因为金属Ba容易被氧化,阻碍了Ba与硅衬底互相扩散反应生成Ba的硅化物.文献[10]利用垂直布里奇曼方法制备了块体的正交相BaSi2晶体.文献[11]采用反应沉积的方法,让Ba直接沉积到温度为600 ℃的Si(111)衬底上制备出了多晶的BaSi2薄膜,实验发现BaSi2有高度的择优取向性.文献[12]采用RDE的方法500 ℃时在硅衬底生成了20 nm的BaSi2薄膜,接着用MBE的方法600 ℃时在Si衬底上制备了[100]定向生长的BaSi2单晶薄膜,只观察到了BaSi2的(200)、(400)和(600)衍射峰[12].以上课题组已实现BaSi2单晶、多晶及块体、薄膜的制备.本文认为衬底温度是影响薄膜结晶的一个至关重要的因素,然而以上作者对结晶的原理及衬底温度的影响未做综合的讨论.文献[7]采用第一性原理将正交相BaSi2的电子结构和光学性质进行了计算,计算出带宽为1.086 eV,吸收系数的最高峰值为2.15×105cm-1.由Ba-Si二元体系的相图[13]可知,在BaSi2薄膜生长的过程中容易导致硅化物多相共生.本文采用共溅射法将Ba与Si沉积在Si(111)衬底上外延生长BaSi2薄膜,研究衬底温度对制备BaSi2薄膜的影响,同时对结晶的原理进行了理论分析.
1 实验
1.1薄膜的制备实验采用中国沈科仪研制的JGP560C VIII型带空气锁的超高真空多靶磁控溅射镀膜系统生长BaSi2薄膜.实验所用氩气纯度为99.999%,用于样品室和溅射室的高真空保护.溅射室的本底真空为2.0×10-5Pa,溅射气压约为7 Pa,氩气流量为20 SCCM.靶材采用北京有色金属研究总院的Ba靶和Si靶,Ba靶质量分数为99.5%,Si靶质量分数为99.999%.衬底为峨嵋半导体厂生产的单面抛光的p型Si(111)单晶片,大小为1.5 cm×1.5 cm,质量分数为99.999%,电阻率为8~13·cm.
Si(111)衬底用标准的半导体清洗工艺清洗后烘干.Ba靶和Si靶都是通过溅射剥离掉表面的氧化层.衬底温度分别保持为300、350、400、450和500 ℃,向硅衬底上共沉积Ba和Si的混合膜,Ba靶和Si靶的功率分别固定为90和100 W,沉积时间为10 min.之后将样品送入中国沈科仪研制的SGL80型卧式高真空退火炉退火,研究衬底温度对薄膜制备的影响.样品的详细溅射参数及退火参数如表1所示.

表 1 样品的制备参数
1.2薄膜的表征晶体结构的表征采用日本理学公司的D/MAX-2200型全自动X射线衍射仪,用于材料的物相的定性和定量分析及结构的表征.X射线源Cu Kα1的波长为0.154 06 nm,管压为40 kV,管流为30 mA,石墨单色器滤波,样品测试时设置的扫描步长为0.04°,测角仪为θ/2θ耦合.测角仪精度:0.000 1°.衍射角2θ的测角范围为0.5°~146°,薄膜的表面及剖面形貌的表征采用日立HITACHI S-3400N型扫描电子显微镜分析.
2 实验结果
2.1结构特性要说明的是,共溅射法沉积到硅衬底上的Ba和Si的混合膜未能在加温的衬底上直接扩散生成硅化物,呈现的是非晶.这说明衬底温度在300~500 ℃之间时共溅射的Ba和Si粒子反应活性不够.
将该组样品接着送入退火炉退火,温度800 ℃时间12 h,制得的样品,表征样品结构成分的X射线衍射图如图1所示.

图 1 退火后的XRD图
图1是不同衬底温度下制备的BaSi2多晶薄膜.从峰形图来看,300~500 ℃区间的衬底温度对制备BaSi2薄膜的影响并不大,峰型以及衍射峰的强度变化甚小.最明显的主峰为Si衬底的峰,衍射角2θ为28.65°处为Si(111)峰,衍射角2θ为59.322°处为Si(222)峰.可以看出,所有样品中BaSi2(020)衍射峰最强,沿着b轴垂直于衬底择优生长.也生成了其他一些衍射峰,说明生成了BaSi2多晶薄膜.经过比较,在衬底温度为500 ℃条件下制备的薄膜衍射峰最强.衬底温度在300~450 ℃,多晶薄膜的衍射峰相对较小,而且伴随有Ba5Si3相生成.当衬底温度提高到500 ℃时,Ba5Si3衍射峰消失.
可以确定,在衬底温度为500 ℃制备的多晶薄膜均为BaSi2相,BaSi2(020)衍射峰强度达到最大值.和以往的实验[14-15]相比较,Ba、Si共沉积制备薄膜的工艺增加了衬底加温,XRD图显示生成了较为单一的BaSi2相的多晶薄膜.合适的衬底温度能够有效提高溅射出来粒子在衬底表面的反应活性,从而有利于提高薄膜的结晶质量.如果能够使温度达到600 ℃,同时降低Ba、Si共沉积的速率,结晶效果会更好.
2.2薄膜的表面形貌不同衬底温度下沉积的Ba/Si薄膜经800 ℃、12 h退火后的表面形貌通过扫描电镜进行了表征,退火后的SEM图如图2所示.

(a) 衬底温度300 ℃

(b) 衬底温度350 ℃

(c) 衬底温度400 ℃

(d) 衬底温度450 ℃

(e) 衬底温度500 ℃
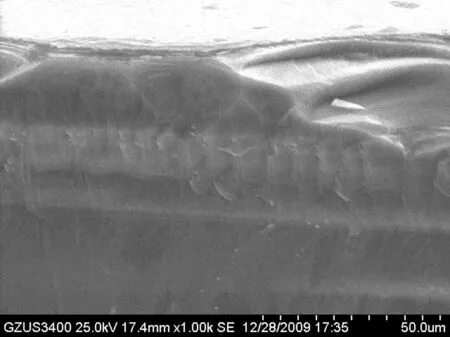
(f) 横截面图
由图2可以看出,这是一种岛状生长模式.如图2(a)衬底温度为300 ℃时,结晶效果不太理想.随着衬底温度增加到350 ℃后能看到明显的晶体颗粒,分布比较均匀,晶粒直径最大约100 nm.整体来看,衬底温度从350 ℃增加到500 ℃的过程中,较小的晶粒被合并,颗粒直径有所增大,薄膜也愈加均匀致密.这是因为衬底温度愈高愈有利于Ba原子与Si原子的扩散反应.薄膜在形核长大的过程中,需要吸纳合并扩散的单个原子核和小核.
图2(f)为样品退火处理后的横截面图,最下部分为Si(111)衬底,上部分为退火后形成的硅化物薄膜,膜厚约15 μm,中间是扩散层.
当溅射功率较高时,薄膜的沉积速率太快,沉积的膜结构中有很多孔隙, 膜层疏松,退火结晶后表面显得粗糙,薄膜均匀性和致密度较差.退火温度为800 ℃时样品结晶比较好,晶粒尺寸比较均匀,颗粒尺寸达到最大.
采用反应沉积外延(RDE)的方法加热衬底并减小Ba膜的沉积速率可以有效降低BaSi2薄膜的结晶温度,降低薄膜中的缺陷.
3 理论分析
文献[11]指出反应沉积外延的方法制备BaSi2薄膜对衬底温度的要求在600 ℃以上,本次试验的衬底温度为300~500 ℃不足以使Ba与Si原子扩散生成硅化物晶体薄膜,需要进一步借助退火炉退火生成了硅化物薄膜.为此,有必要讨论一下薄膜生长中基片温度与生长速率间的关系.在外延生长过程中,外延温度与沉积速率密切相关,二者的关系[16]为

(1)
其中,R为薄膜的沉积速率,Te为外延生长的最低温度,即外延温度,Q为外延生长的活化能,k为玻尔兹曼常数.由(1)式可知,薄膜的沉积速率越高,则外延温度越高.
沉积薄膜的晶体特性与衬底材料的选择和衬底温度有关.衬底温度低于薄膜的结晶温度则生成非晶薄膜,衬底温度高于结晶温度则生成多晶薄膜,通常衬底温度高于外延温度可使单晶薄膜生长于单晶的衬底上.此外,衬底温度低于薄膜的结晶温度时,可以经过后期的退火处理使非晶的薄膜生成多晶或单晶的薄膜.沉积条件和结晶情况的关系如表2所示.表2中Ts为衬底温度,Tc为结晶温度,Tepi为外延温度.

表 2 沉积条件和结晶性能
硅膜的外延温度为1 100 ℃至1 200 ℃[16],所以在室温或小于500 ℃的情况下沉积的Ba膜和Si膜均为非晶态,需要后续的退火才能够结晶生成多晶薄膜.在满足晶体生长的衬底温度情况下,低温能使薄膜表面更加光滑.
衬底加温时,BaSi2薄膜的外延温度与Ba、Si沉积速率有关,与沉积的Ba、Si混合膜厚无关.要在加热的硅衬底上直接生成BaSi2薄膜必须使衬底的温度达到外延温度以上.过低的衬底温度下生成的非晶可以通过退火处理生成BaSi2多晶薄膜.
4 结论
采用共溅射法结合真空退火的方法在Si(111)衬底上制备了BaSi2薄膜,衬底温度的高低直接影响着沉积原子的扩散能力及硅化物的形核过程.原子的扩散能力随着衬底温度的升高而增强.当衬底温度低于BaSi2结晶温度时生成的是非晶,后续退火可以生成BaSi2薄膜.
适当的提高衬底温度,达到600 ℃以上时,采用共溅射法将Ba与Si同时沉积在加热的Si衬底上可以直接生成BaSi2多晶薄膜[11].
适当的提高衬底温度并降低沉积的速率可以得到单晶结构的薄膜.
[1] BORISENKO V E. Semiconducting Silicides[M]. Berlin:Springer-Velag, 2000:185-186.
[2] IMAI M, HIRATA K, HIRANO T. Superconductivity of trigonal BaSi2[J]. Physica,1995,C245(1):12-14.
[3] IVANENKO L I, SHAPOSHNIKOV V L, FILONOV A B, et al. Electronic properties of semiconducting silicides:fundamentals and recent predictions[J]. Thin Solid Films,2004,461(1):141-147.
[4] NAKAMURA T, SUEMASU T, TAKAKURA K I, et al. Investigation of the energy band structure of orthorhombic BaSi2by optical and electrical measurements and theoretical calculations[J]. Appl Phys Lett,2002,81(6):1032-1034.
[5] EVERS J, WEISS A. Electrical properties of alkaline earth disilicides and digermanides[J]. Materials Research Bulletin,1974,9(5):549-554.
[6] MORITA K, KOBAYASHI M, SUEMASU T. Effects of Sr addition on crystallinity and optical absorption edges in ternary semiconducting silicide Ba1-xSrxSi2[J]. Thin Solid Films,2007,515(22):8216-8218.
[7] ZHAO F J, XIE Q, CHEN Q, et al. First-principles calculations on the electronic structure and optical properties of BaSi2[J]. Science in China:Physics,Mechanics Astronomy,2009,G52(4):580-586.
[8] JANZON K H, SCHFER H, WEISS A. Zur kenntnis der disilicide der erdalkalimetalle[J]. Zeitschrift Für Anorganische und Allgemeine Chemie,1970,372(1):87-99.
[9] MCKEE R A, WALKER F J, CONNER J R, et al. BaSi2and thin film alkaline earth silicides on silicon[J]. Appl Phys Lett,1993,63(20):2818-2820.
[10] KISHINO S, IIDA T, KUJI T, et al. Crystal growth of orthorhombic BaSi2by the vertical bridgman method[J]. Thin Solid Films,2004,461(1):90-93.
[11] INOMATA Y, NAKAMURA T, SUEMASU T, et al. Epitaxial growth of semiconducting BaSi2thin films on Si(111) substrates by reactive deposition epitaxy [J]. Japanese J Appl Phys,2004,A43(7):4155-4156.
[12] MORITA K, INOMATA Y, SUEMASU T. Optical and electrical properties of semiconducting BaSi2thin films on Si substrates grown by molecular beam epitaxy[J]. Thin Solid Films,2006,508(1):363-366.
[13] OKAMOTO H. Ba-Si(barium-silicon)[J]. J Phase Equilibria and Diffusion,2008,29(5):464.
[14] YANG Z Y, HAO Z T, XIE Q. Effects of annealing temperature on the structure and surface feature of BaSi2films grown on Si(111) substrates[J]. Physics Procedia,2011,11(1):118-121.
[15] YANG Z Y, HAO Z T, XIE Q. Effects of heat treatment on growth of BaSi2film on Si(111) substrates[J]. Materials Science Forum,2011,663(1):1273-1276.
[16] WASA K, KITABATAKE M, ADACHI H. Thin Film Materials Technology:Sputtering of Compund Materials[M]. Norwich:William Andrew,2004:50-52.
Effect of Substrate Temperature on Preparation ofBaSi2Film by Co-sputtering Method
YANG Ziyi1,2, LIU Tao1, XU Hu2
(1.SchoolofElectronic&CommunicationEngineering,GuiyangUniversity,Guiyang550005,Guizhou;2.InstituteofAdvancedOptoelectronicMaterialsandTechnology,GuizhouUniversity,Guiyang550025,Guizhou)
The effect of substrate temperature on preparation of BaSi2film by co-sputtering of Ba and Si targets is studied. The chemical composition and surface morphology of BaSi2film are characterized by X-ray diffraction (XRD) and scanning electron microscope(SEM), respectively. The results show that amorphous phase were observed on Si(111) substrates by co-sputtering of Ba and Si targets if substrate temperature is below 500 ℃. However, polycrystalline films of BaSi2are synthesized due to subsequent annealing in vacuo. Substrate temperature is a key factor to prepare BaSi2film. BaSi2film can be directly synthesized by co-sputtering method if substrate temperature is over 600 ℃.
co-sputtering method; BaSi2film; substrate temperature; crystal structure; surface topography
2016-04-19
国家自然科学基金(61264004)和贵州省科学技术基金(黔科合J字LKG[2013]07号40号)
杨子义(1977—),男,副教授,主要从事新型电子功能材料的研究,E-mail:yzygxl@126.com
TB34
A
1001-8395(2017)05-0675-05
10.3969/j.issn.1001-8395.2017.05.019
(编辑 陶志宁)

