65 nm互补金属氧化物半导体场效应和晶体管总剂量效应及损伤机制∗
马武英 姚志斌† 何宝平 王祖军 刘敏波刘静 盛江坤 董观涛 薛院院
1)(强脉冲辐射环境模拟与效应国家重点实验室,西安 710024)2)(西北核技术研究所,西安 710024)
(2017年11月28日收到;2018年2月7日收到修改稿)
对65 nm互补金属氧化物半导体工艺下不同尺寸的N型和P型金属氧化物半导体场效应晶体管(NMOSFET和PMOSFET)开展了不同偏置条件下电离总剂量辐照实验.结果表明:PMOSFET的电离辐射响应与器件结构和偏置条件均有很强的依赖性,而NMOSFET表现出较强的抗总剂量性能;在累积相同总剂量时,PMOSFET的辐照损伤远大于NMOSFET.结合理论分析和数值模拟给出了PMOSFET的辐射敏感位置及辐射损伤的物理机制.
1 引 言
航天器在空间天然辐射环境中的高可靠、长寿命的需求对系统中电子器件的性能要求很高,需要其具备高性能和强抗辐射能力[1−3].为了满足空间应用需求,新一代航天器等先进装备采用纳米器件已成为必然,而获得纳米器件在空间辐射环境中的响应规律及损伤物理机制是其空间应用的前提[2].
当集成电路进入到深亚微米领域时,金属氧化物半导体场效应晶体管(metal-oxide semiconductor fieldeffect transistor,MOSFET)的总剂量效应(total dose effect,TID)表现出一些新的特点[4−8]:栅氧化层越来越薄;由于栅氧化层本身的尺寸和隧穿电流的影响,栅氧化层对MOSFET辐照特性影响很小.氧化层积累辐照产生固定正电荷的能力与氧化层厚度密切相关,厚度越大,积累的固定正电荷越多,而浅槽隔离(shallow trench isolation,STI)氧化层的厚度比栅氧化层约高两个数量级,成为MOSFET在长时间辐照作用下受影响最严重的区域,STI退化直接影响N型金属氧化物半导体场效应晶体管(N-metal-oxide semiconductor field-effect transistor,NMOSFET)漏电流增大,阈值电压漂移;对于PMOSFET,STI氧化层中辐射感生缺陷并不会导致漏电流增大,但表面区域载流子浓度的增加会使得有效沟道变窄,表现为阈值电压的负漂.刘张李等[9]对0.18µm MOSFET总剂量效应进行了研究,指出STI氧化层是辐射敏感区域;Peng等[10]对0.13µm部分耗尽型(partially depleted,PD)硅基(silicon-on-insulator,SOI)NMOSFET的总剂量效应开展了研究,指出STI寄生晶体管的阈值电压决定了器件的抗辐射性能;Ding等[11]对65 nm P型金属氧化物半导体场效应晶体管(P-metal-oxide semiconductor fieldeffect transistor,PMOSFET)开展了总剂量效应研究,指出STI氧化层是造成其辐射损伤的敏感位置,但这一结论并不能解释我们看到的实验现象,即实验发现的NMOSFET抗总剂量性能优于PMOSFET.此外,对于65 nm工艺尺寸器件,沟道掺杂浓度的提高,致使STI层中感生缺陷对于器件辐射性能的影响越来越弱.轻掺杂漏(lightly doped drain,LDD)工艺是互补金属氧化物半导体(CMOS)集成电路进入亚微米后应用最广泛的技术,该技术很好地改善了沟道电场分布,避免了在器件漏端的强场效应,从而提高了器件的可靠性,而LDD区域上方侧墙氧化层中辐射感生产物对器件性能退化起着至关重要的作用[12,13].Gerardin等[14]研究了0.13µm尺寸MOSFET的质子辐射响应,定性地指出辐射在LDD区域上氧化层和栅氧化层中的感生缺陷是造成PMOSFET性能退化的主要因素.然而,针对65 nm MOSFET的LDD区是否是其辐射敏感位置以及其辐射损伤的物理机制并未引起关注.
本文选取65 nm CMOS工艺NMOSFET和PMOSFET为研究对象,开展了总剂量效应实验,并探索了其在不同偏置条件下的辐射响应.结合理论分析与数值仿真研究,获得了65 nm CMOS工艺NMOSFET和PMOSFET辐射响应的物理机制.
2 实验条件
辐照实验在西北核技术研究所60Co γ射线源上进行,实验样品是在65 nm CMOS工艺线上流片的不同宽长比的NMOSFET和PMOSFET.对样品采用两种偏置进行辐照,详细偏置信息如表1所列,其中W/L为器件的长宽比;Vg,Vs,Vd分别为栅极、源极和漏极电压.辐照剂量率为50 rad(Si)/s,分别在300 krad(Si),500 krad(Si)及1 Mrad(Si)时利用半导体参数测试仪对实验样品的转移特性曲线进行测量.
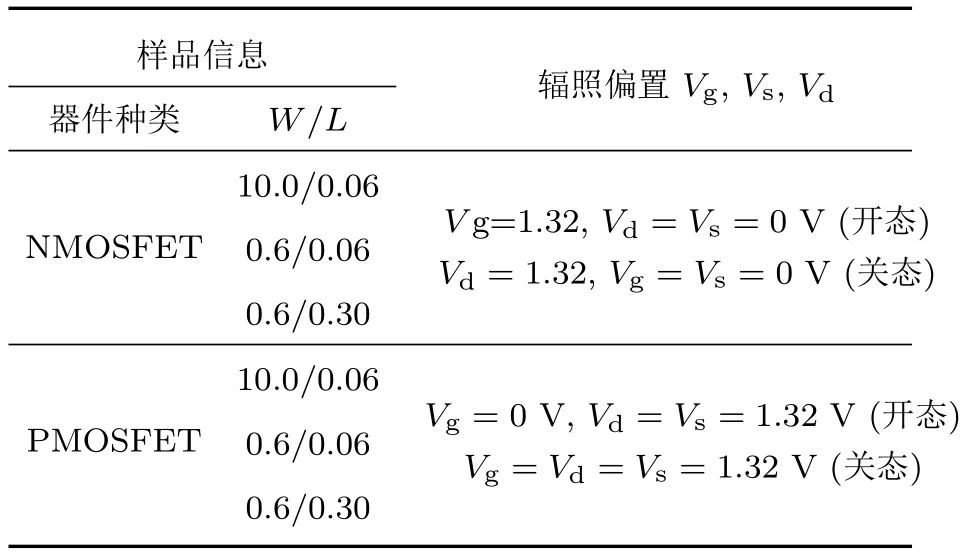
表1 样品信息及偏置条件Table1.Sample information and bias conditions.
3 实验结果
图1给出了NMOSFET在50 rad(Si)/s的剂量率辐照前后的转移特性曲线的变化趋势,累积总剂量为1 Mrad(Si).从图1中可以看出,NMOSFET在辐照前后的转移特性曲线没有明显变化.此外,在不同偏置条件下辐照时,NMOSFET的阈值电压变化量没有表现出明显的差异.
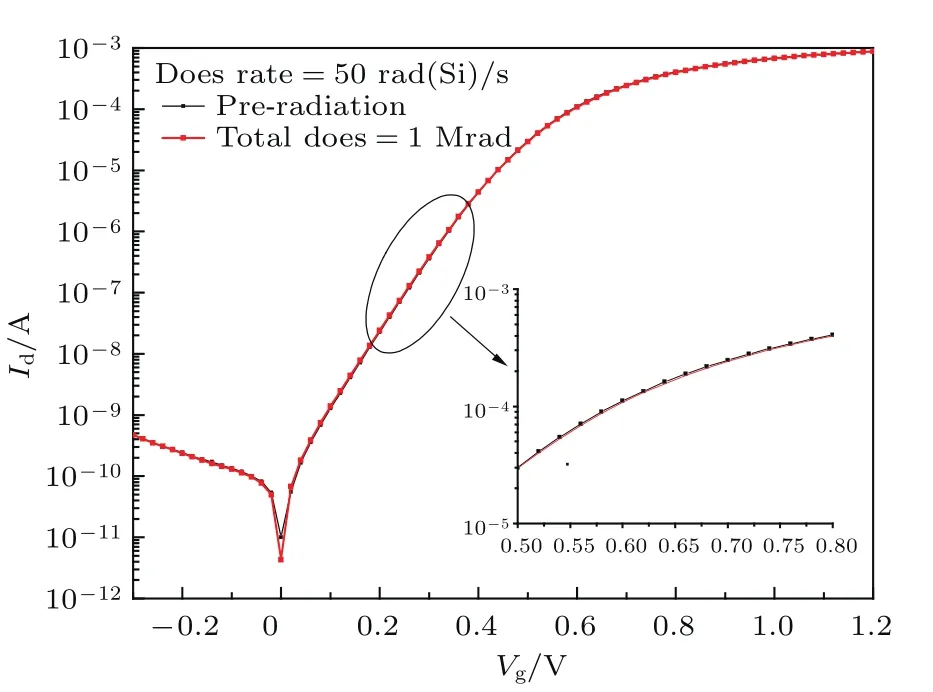
图1 NMOSFET辐照前后转移特性曲线变化趋势Fig.1.Id-Vgcharacteristics of NMOSFETs before and after exposure to a total dose of 1 Mrad(Si).
图2给出了PMOSFET辐照前后转移特性曲线的变化趋势.从图2中可以看出,PMOSFET在辐照后的阈值电压发生了明显漂移.表2给出了不同偏置条件下,不同工艺尺寸PMOSFET的阈值电压随总剂量变化的规律.从表2可以看出,不同偏置条件下,PMOSFET辐射响应存在差异,具体表现为开态辐照偏置的辐射损伤强于零偏.

图2 PMOSFET辐照前后转移特性曲线的变化趋势Fig.2.Id-Vgcharacteristics of PMOSFETs before and after exposure to a total dose of 1 Mrad(Si).

表2 不同偏置条件下,不同工艺PMOSFET阈值电压辐照前后的变化量Table2.Vthshifts for PMOSFET versus total does at Different channel length and radiation bias conditions.
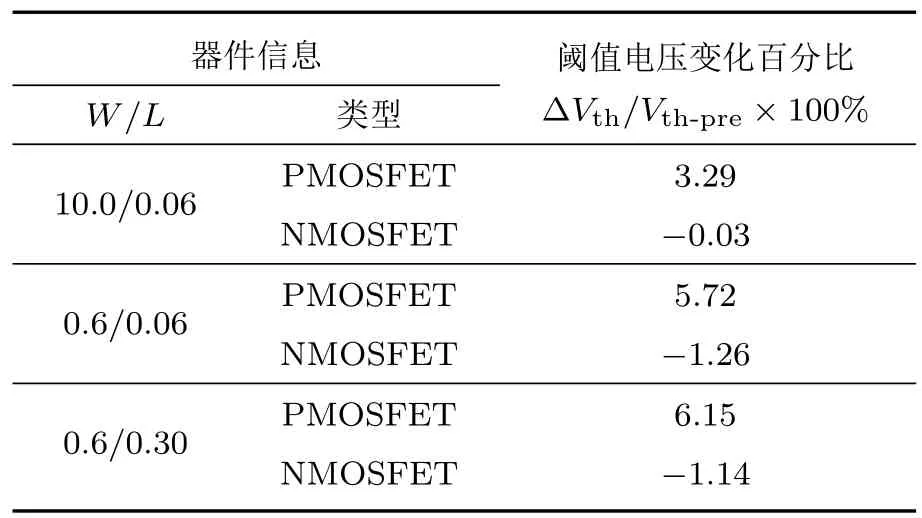
表3 NMOSFET与PMOSFET的辐射损伤程度比较(TID=1 Mrad(Si))Table3.Comparison of radiation damage in PMOSFET and NMOSFET(TID=1 Mrad(Si)).
4 讨 论
65 nm MOSFET总剂量的实验结果不同于深亚微米0.18µm MOSFET的实验结果,深亚微米MOSFET中STI区域为辐射敏感区域,NMOSFET辐照损伤强于PMOSFET,是辐射效应研究的热点[15].然而,从上述65 nm MOSFET实验结果中不难看出,PMOSFET的辐射损伤强于NMOSFET,NMOSFET的转移特性曲线在累积总剂量1 Mrad后,并未发生明显变化,PMOSFET应作为辐射效应研究的重点.因此,着重对65 nm NMOSFET和PMOSFET的辐射敏感性进行分析,并结合数值仿真定量给出PMOSFET辐射损伤潜在的物理机制;此外,定性分析PMOSFET在不同偏置条件下辐射损伤存在差异的原因.
4.1 PMOSFET及NMOSFET的辐射敏感性分析
表3中给出了不同工艺条件下,NMOSFET和PMOSFET在开态偏置状态下辐照至累积总剂量1 Mrad时阈值电压的变化百分比(∆Vth/Vth-pre×100%).从表3中可以看出,不同工艺条件下的PMOSFET,在总剂量辐照后其阈值电压均发生了一定程度的漂移,而NMOSFET并未发生明显变化.
以往的研究认为,由于尺寸很小,栅氧化层对纳米级MOSFET的辐照特性影响很小.累积辐照在氧化层中产生固定氧化物电荷的能力与氧化层的厚度密切相关,厚度越大,氧化物电荷量越多,STI氧化层的厚度比栅氧化层约高两个数量级,成为MOSFET在长时间辐照作用下受影响最严重的区域,STI退化直接影响NMOSFET漏电流增大,阈值电压漂移;对于PMOSFET,STI氧化层中辐射感生缺陷并不会导致漏电流增大,但表面区域载流子浓度的增加使得有效沟道变窄,表现为阈值电压的负漂.据此可推断,由于STI氧化层受电离辐射的影响,NMOSFET和PMOSFET均会受到STI退化影响而导致阈值电压漂移,且NMOSFET的辐射损伤将更为严重[6,15].但这一结论与我们的实验结果相矛盾.因此,随着器件尺寸减小,沟道掺杂浓度的提升,除了STI氧化层造成辐射损伤以外,对于65 nm MOSFET应存在其他的辐射敏感位置,才会造成PMOFET损伤更为严重.LDD上层氧化层中的辐射感生缺陷是否会成为65 nm MOSFET的辐射损伤敏感位置,将是我们分析的重点.对于纳米级MOSFET,LDD对阈值电压的影响为[16−18]

其中Vth0为未加LDD区时的阈值电压,Vds为源和漏极间的电压;φB=|EF−Ei|/q,EF是费米能级,Ei为本征费米能级.Vbi是LDD区域与衬底结上自建电势,其表达式为

其中NLDD和Nsub分别为LDD区及衬底区的掺杂浓度;ni为本征载流子浓度;Leff为沟道有效长度,近似估算为Leff=Lg−2δ·Xj(其Xj为LDD区结深,δ为经验参数,Lg为未增加LDD区域时的沟道长度);l为沟道特征长度.由此可见,MOSFET的阈值电压与LDD区的内建电势紧密相关.
电离辐射在LDD上方厚氧化层中感生到了正的氧化物陷阱电荷,相当于在LDD上方施加了一个正电压,若设该电压落在LDD与衬底结间上的电压为Vox,LDD,则对于NMOSFET和PMOSFET的LDD与衬底结的内建电势可分别表示为:

依据半导体器件物理[16,17],对于MOSFET,当表面反型时,LDD与衬底结的内建电势约为2ϕFP或2ϕFN(ϕFP,ϕFN分别为PMOSFET和NMOSFET衬底的费米势).因此,对于NMOSFET和PMOSFET,其LDD与衬底结附近为了达到反型,需要施加的表面势可分别用(5)式和(6)式表示:

从(5)式和(6)式中可以看出,对于NMOSFET,LDD区与衬底结附近表面反型所需要的电压减小,而在PMOSFET中,该区域反型所需的电压增大.
在辐射效应测试中,通过测量沟道电流来反推器件的阈值电压[14].假设在沟道中间的阈值电压为Vth0,LDD与衬底结附近表面反型的电压为Vth,LDD.在NMOSFET中,Vth,LDD
利用计算机辅助设计工具(technology computer aided design,TCAD)建立65 nm MOSFET 2维(2D)模型进行总剂量效应的数值模拟,所用的氧化物陷阱电荷与电场和剂量率的关系方程如(7)式和(8)式所示:

其中Gox为辐照在氧化层中引起的电荷产生率,g0为电子空穴对的产生率,D′为辐照剂量率,E0=Y0E1,E1=0.65 MV/cm,m=0.9,室温下Y0=0.05[19,20].
图3中给出了PMOSFET在辐照前后空穴浓度的梯度分布图.从图3可以明显看出:总剂量辐照后的界面处空穴浓度值(图3(b))低于未辐照时的仿真结果(图3(a)),这进一步验证了我们的理论分析结果,即LDD区上方氧化层中产生的氧化物电荷会改变PMOSFET沟道中空穴浓度.NMOSFET仿真结果如图4所示,辐照前后电子浓度梯度分布并未发生明显改变,仿真结果和理论较好地符合.
利用TCAD对NMOSFET和PMOSFET辐照前后的转移特性曲线进行仿真(图5),结果表明,PMOSFET在总剂量辐照后阈值电压发生漂移(图5(a)),而NMOSFET转移特性曲线未发生明显变化(图5(b)),仿真结果和实验数据在趋势上能很好地符合.仿真结果进一步证实了我们的理论分析,电离辐射在65 nm PMOSFET的LDD区域上方氧化层中感生的缺陷对其辐射响应起着决定性的作用,也是其辐射响应不同于NMOSFET的关键因素.
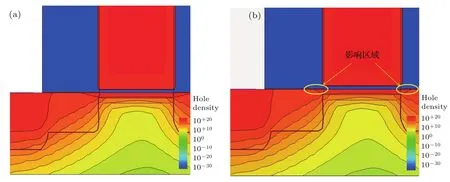
图3 PMOSFET辐照前后空穴浓度梯度截面 (a)辐照前;(b)辐照后Fig.3.Cross-section of PMOSFET indicating hole density affected by radiation-induced oxide trapped charge in LDD spacer:(a)Before radiation;(b)after radiation.

图4 NMOSFET辐照前后,电子浓度梯度截面 (a)辐照前;(b)辐照后Fig.4.Cross-section of NMOSFET indicating electron density affected by radiation-induced oxide trapped charge in LDD spacer:(a)Before radiation;(b)after radiation.

图5 MOSFET辐照前后,转移特性曲线的TCAD-2D仿真结果 (a)PMOSFET;(b)NMOSFET(TID=1 Mrad(Si))Fig.5.Id-Vgcharacteristics of MOSFETs with TCAD-2D simulation:(a)PMOSFET;(b)NMOSFET(TID=1 Mrad(Si)).
4.2 偏置条件对PMOSFET总剂量效应的影响
实验结果表明,PMOSFET在不同偏置条件下表现出不同的辐射响应(表2),在开态偏置条件下的辐射损伤强于零偏条件.其主要原因是电离辐射在氧化层中感生产物与电场有很强依赖关系[4],具体表现为:零偏情况下,氧化层电场接近为零,辐射电离所产物的初始电子-空穴对几乎完全复合,形成的自由电子及空穴很少,所以氧化物电荷和界面陷阱的形成很少,零偏置条件下的辐射响应很弱;对于开态偏置情况,在氧化层电场作用下,由于空穴和电子迁移率的差异,电离辐射产生的电子-空穴对直接复合概率大大降低,虽然栅的负压使电离所形成的空穴向远离Si/SiO2界面方向输运,但依然会在氧化层内被俘获,形成远离界面的正氧化物陷阱电荷,虽然其作用有可能弱于正栅压情况,但仍强于零偏辐照.
5 结 论
对65 nm工艺的NMOSFET和PMOSFET开展了不同偏置条件下的总剂量辐照实验,发现PMOSFET的辐射损伤强于NMOSFET,结合理论分析和数值仿真模拟,可以得出以下结论:电离辐射在LDD区域上方氧化层中产生的氧化物陷阱电荷是造成PMOSFET性能退化的主要因素;PMOSFET在不同偏置条件下表现出不同的辐射响应,主要是由于LDD上方氧化层中电场的影响,开态偏置下辐射损伤明显强于零偏条件.研究成果对65 nm MOS晶体管抗辐射加固设计具有重要参考价值.

