二维材料在电力电子器件中的散热应用
鲍 婕,宁仁霞,许 媛,徐文艺
(1.黄山学院机电工程学院,安徽黄山 245041;2.黄山学院半导体技术与微系统研究所,安徽黄山 245041;3.黄山宝霓二维新材科技有限公司,安徽黄山 245900)
电力电子应用市场需求的不断提高,推动了新型电力电子器件及相关半导体材料的研究和发展[1-2],从传统的晶闸管到智能功率模块,从硅基器件到碳化硅(SiC)和氮化镓(GaN)宽禁带器件。同时,器件的封装正朝着小体积和三维封装发展,电力电子器件的功率等级不断提高,而温度过高会导致器件电学性能、机械性能的下降[3-5],从而影响产品的寿命及可靠性,因此,电力电子器件封装结构的散热性能成为至关重要的问题。
根据功率大小和使用条件等差别,电力电子器件选取不同的散热方式,如风冷、热管、液冷、微通道冷却和喷射冷却,以及基于新材料的散热结构等[5-6]。近年来,二维材料的典型代表石墨烯由于强sp2键带来超高的热导率5300 W/(m·K),被提出可以作为一种有前景的散热材料[7]。很多文献中报道了各类石墨烯基薄膜、石墨烯纸、多层石墨烯/环氧聚合材料以及石墨烯薄片等,都可以用来做电子器件中的散热层[8-13]。具有类似结构特征的二维六方氮化硼(Two-Dimensional Hexagonal Boron Nitride,2D-hBN),作为导热却不导电的材料,面内热导率达390 W/(m·K)[14-15],其热膨胀系数是目前陶瓷材料中最小的,同样表现出在下一代电子器件散热中的应用前景[16-17]。然而围绕两种二维材料的散热应用研究大部分都集中在集成电路芯片及器件中,很少有电力电子器件结构中的相关报道。
本文着眼于大功率电力电子器件的发展需求,在现有封装结构的基础上,发挥石墨烯及2D-hBN物化性能和热传导性能等方面都与半导体器件良好匹配的优势,将两种二维材料作为高热导封装材料,应用到电力电子器件封装结构中,从横向和纵向同时减小热阻,提出新一代电力电子器件的热管理方案。
1 基于二维材料的封装结构及散热机理
以市场影响力举足轻重的绝缘栅双极型晶体管(Insulated Gate Bipolar Transistor, IGBT)为例, 高温下其传热速度明显比常温时低,容易因为热击穿而烧毁器件,同时,温度升高时IGBT器件中载流子迁移率下降,导致关断尾流时间长,饱和导通压降增大[18],功耗提高。当IGBT反复开通或关断时,热冲击作用下产生的失效或疲劳效应,严重影响其工作寿命和可靠性,其中绑定引线、绑定点以及焊料层是IGBT封装结构中最脆弱的部分[19],如图1所示。针对失效机理及原因分析,改进散热技术,使IGBT模块产生的热量及时传递到外部空间,可以避免或延缓失效现象的出现。
1.1 封装结构
本文提出了基于二维材料的新型IGBT器件封装结构,如图2所示,IGBT芯片的发射极和快速恢复二极管(Fast Recovery Diode,FRD)芯片的阳极表面应用化学气相沉积(Chemical Vapor Deposition,CVD)方法生长的高热导率石墨烯薄膜作为散热辅助层,将热点的热量在横向迅速散开,降低芯片局部热点的最高温度,改变芯片热量从基板向外传输的路径角度,加快散热速度。
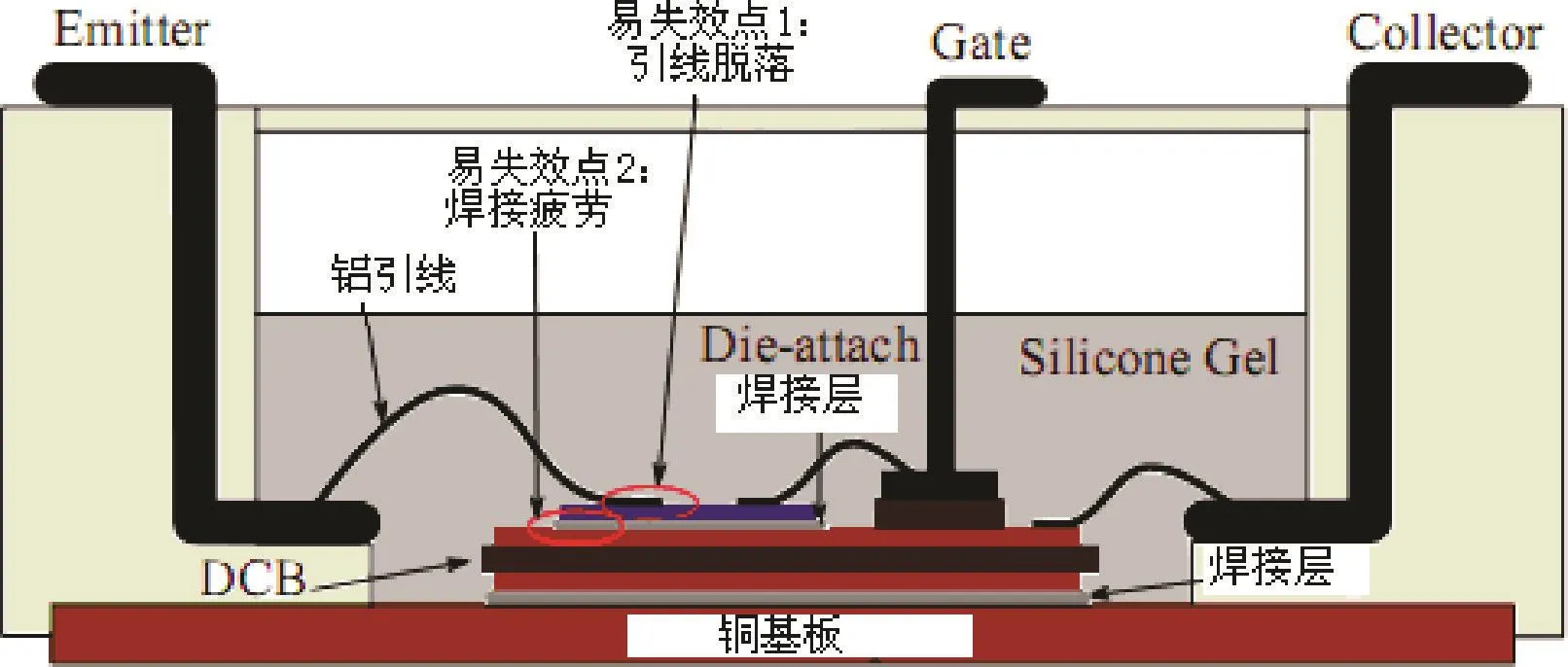
图1 IGBT模块失效位置剖面图[19]Fig.1 Failure position profile of IGBT module[19]

图2 基于二维材料的IGBT封装结构示意图Fig.2 Schematic diagram of IGBT packaging structure based on two-dimensional materials
同时,采用液相剥离法制备2D-hBN,借助其比表面积大、导热系数高的优势,将其填充到封装树脂中,使导热颗粒之间通过2D-hBN的表面搭载作用形成更为良好的热传导网络,从而减小封装整体的纵向热阻,提升IGBT器件的散热性能。
1.2 散热机理
在IGBT器件的传统封装结构中,芯片上局部热点的热量主要通过自上而下传输到覆铜陶瓷基板(Direct Bonding Copper,DBC),再到外基板,进而通过热沉散发到环境中,热传导路径如图3(a)所示,另外热量从芯片向上通过封装树脂及外壳散发到环境中是次要热传导路径,由于封装树脂的导热系数较低,次要路径的热传导速度较慢,热量大部分从主要路径传出。本文提出的基于二维材料的IGBT器件封装结构,热传导路径如图3(b)所示,转移到芯片表面的石墨烯薄膜由于其横向热导率远远高于硅材料,局部热点的热量会沿着石墨烯薄膜的表面迅速横向传开,使热量从单点聚集形式变化为平面分布,从而改变热传导路径的传热角度,大大提高热量散发的速度。
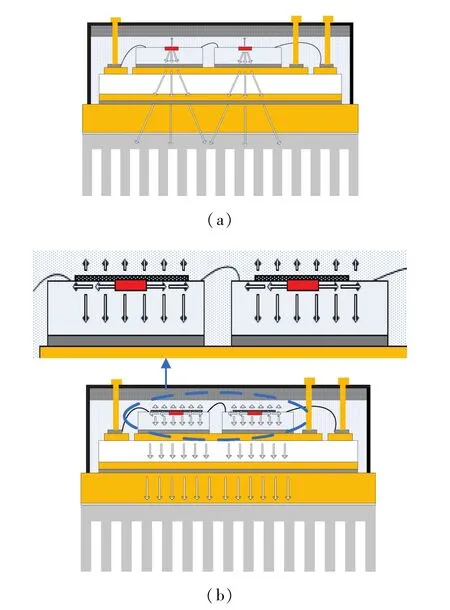
图3 不同封装结构的热传导路径对比:(a)传统封装结构的热传导路径示意图;(b)基于二维材料的封装结构热传导路径示意图Fig.3 Thermal conduction paths comparison of different packaging structures:(a)traditional packaging structure;(b)packaging structure based on two-dimensional materials
封装结构中封装树脂里的导热颗粒是否能形成“导热网链”是提升复合材料导热性能的关键。传统封装树脂中导热颗粒含量少时虽然分散均匀,但颗粒表面被基体包裹,彼此没有接触,如图4(a)所示,对整体导热贡献不大;含量过大会导致复合材料力学性能下降。2D-hBN的比表面积大,将导热颗粒负载于二维表面,借助其横向导热系数高的优势,在未接触的导热颗粒之间作为热传导的桥梁,在复合基体中构建热传导网络,如图4(b)所示,从而有效提高封装树脂的导热系数,使得热传导次要路径也在散热过程中充分发挥作用。在石墨烯薄膜的共同作用下,从封装结构的横向和纵向同时减小热阻,交叉散热,大大提高了IGBT器件整体的热传导性能。
2 封装方案及二维材料工艺过程
IGBT器件的封装工艺包括DBC基板上涂覆焊料、IGBT/FRD芯片贴装、DBC/母线组装、焊接、清洗、引线键合、树脂注塑、固化封装等。本文提出的基于二维材料的IGBT器件封装工艺流程如图5所示,在现有封装工艺的基础上增加石墨烯薄膜转移及2D-hBN制备、复合的相关步骤。

图4 封装树脂的微观结构示意图:(a)传统封装树脂的微观结构示意图;(b)2D-hBN基封装树脂的微观结构示意图Fig.4 Microstructure diagram of encapsulated resin:(a)traditional encapsulated resin;(b)2D-hBN based encapsulated resin

图5 基于二维材料的IGBT器件封装工艺流程图Fig.5 Process flow chart of IGBT devices packaging based on two-dimensional materials
2.1 石墨烯薄膜的制备及转移
采用CVD法在25 μm厚的铜箔上生长单层石墨烯,样品(南京先丰纳米材料公司提供)的微观表征如图6所示,从透射电镜(Transmission Electron Microscopy,TEM)可以看到石墨烯样品为单原子层,拉曼光谱中G峰和2D峰的强度比约为0.25,2D峰的半高全宽约29 cm-1,这些都符合单层石墨烯的特征。
铜箔上的单层石墨烯转移到目标芯片时要求得到干净、连续、无褶皱的薄膜,本文采用气泡分离法,相比于基底刻蚀法,前者工艺步骤简单,转移过程引入杂质少,而且铜箔可以回收再利用,节约成本。气泡分离过程参见图7,具体步骤包括:旋涂聚合物支撑层、粘贴辅助框架、电解液中构建电流回路、电解反应将铜箔剥离、薄膜清洗、转移到目标芯片、切除框架、去除聚合物支撑层、清洗吹干。
2.2 2D-hBN的制备及导热颗粒的改性
考虑与后续导热颗粒改性工艺的兼容,本文选用液相剥离法制备2D-hBN,将平均粒径1 μm的hBN粉末(Sigma-Aldrich提供)在一定配比的乙醇/水溶液中通过强超声(FR-1025)作用进行剥离,离心处理后得到2D-hBN分散液,其微观表征参见图8,从TEM照片中可以看到2D-hBN呈现出很好的分散性,直径范围在数百纳米到微米之间;X衍射图中在(002)面出现峰型尖锐且强度较大的衍射峰,其2θ角是26.62°,峰值集中且峰形很窄说明纯度很高,产物的结晶度很好。
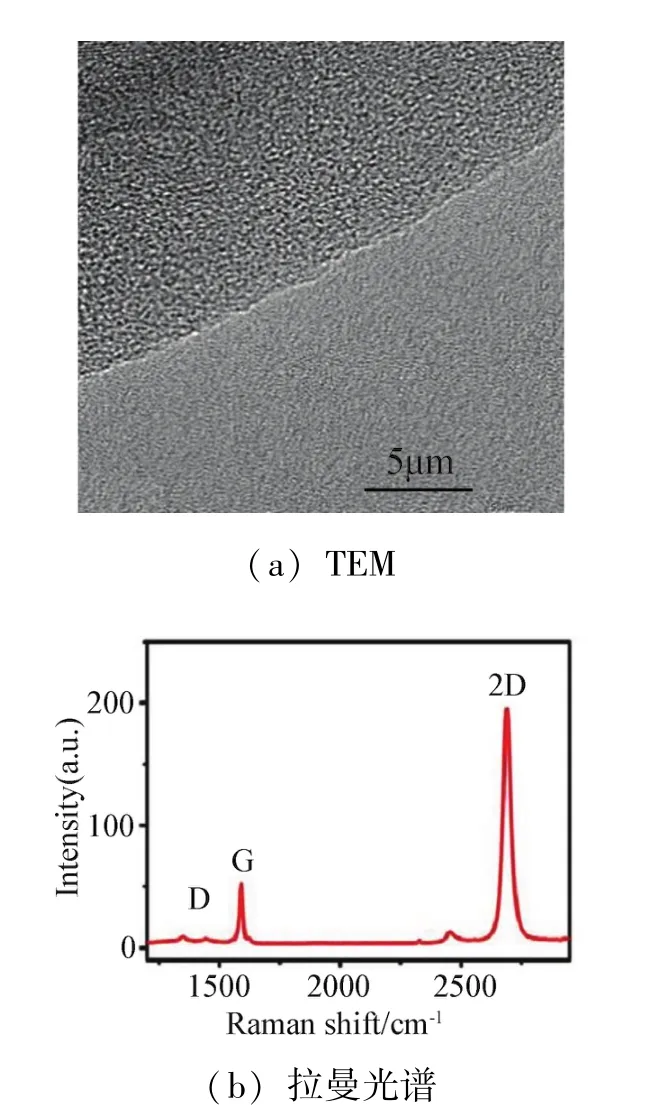
图6 单层石墨烯的微观表征Fig.6 Microscopic characterization of graphene

图7 气泡分离过程实物图Fig.7 Bubble separation process photo
本文以纳米hBN作为导热颗粒填充到环氧树脂基体中制备封装树脂,将2D-hBN通过弱超声作用分散在纳米hBN颗粒表面,形成复合导热颗粒,微观结构如图9所示。SEM照片中显示大部分为片状纳米hBN,且方向多为平行,其中包含少量直径较大的2D-hBN;TEM照片中可以进一步看到其分布状态,大薄膜套着小薄膜,将各个颗粒连成一片,利于 “导热网链”的形成。

图8 液相剥离2D-hBN的微观表征Fig.8 Microscopic characterization of 2D-hBN prepared by liquid phase method
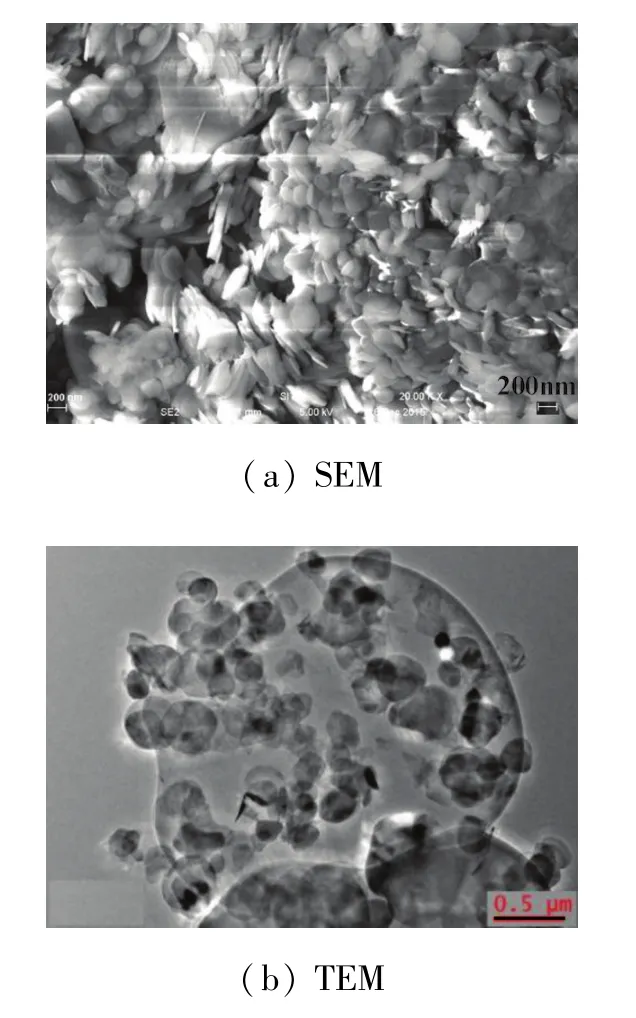
图9 复合导热颗粒的微观表征Fig.9 Microscopic characterization of composite thermal conductive particles
3 结论
虽然石墨烯及二维六方氮化硼材料具有优异的热传导特性,实验室中也进行了大量的实验研究,但是针对电力电子器件封装结构中的散热应用仍然没有形成行业认可的共性方案,散热效果与材料的制备方法、目标基体的特性、转移与应用技术方案等因素都有着密切的关系,这个领域的研究工作还有很长的路要走。针对本文提出的基于二维材料的电力电子器件封装结构,继续进行工艺优化及机理分析,从而寻求一套成熟可靠、可行性强的新一代电力电子器件的热管理技术。

