高垂直度和低沉积的MEMS陀螺梳齿结构释放工艺*
梁德春,庄海涵,李新坤,刘福民
(北京航天控制仪器研究所·北京·100039)
0 引 言
硅基材料的刻蚀包括各向同性刻蚀和各向异性刻蚀。对于具有高深宽比特点的硅结构各向异性加工,普遍采用干法刻蚀技术,该技术可很好地应用于MEMS器件的加工工艺中。由Bosch公司开发的深硅刻蚀工艺(Bosch工艺),可将钝化和刻蚀交替进行,很好地实现高深宽比结构的刻蚀,因而得到了广泛的研究。M. A. Blauw等人[1]研究了Bosch工艺中钝化和刻蚀的平衡问题;Catherine B. Labelle等人[2]经研究发现,深硅刻蚀过程中钝化聚合物的沉积速率、成分与钝化气体的气压、衬底温度和功率等工艺参数有关;张旭[3-4]等人研究了深硅刻蚀过程中的footing效应、Lag效应、侧壁光滑度和垂直度等形貌问题。
战术导弹用MEMS陀螺仪,对结构垂直度有明确的要求[5]。陀螺芯片的硅结构底部是具有支撑作用的锚点,以在结构层底部形成漏空的区域。在结构释放过程中,钝化聚合物除了会附着在硅结构的侧壁,还会沉积于硅结构下的支撑层表面。由于硅结构下方无法被等离子体刻蚀,聚合物会不断地沉积。聚合物的存在影响电极的绝缘特性,作为多余物会对器件的可靠性带来一定的风险。为了减小硅结构释放工艺对器件性能的影响,在保证结构刻蚀垂直度的基础上,有必要减少刻蚀过程中的聚合物沉积。但到目前为止,没有对聚合物和形貌两个因素同时进行研究的报道。
1 原理和试验

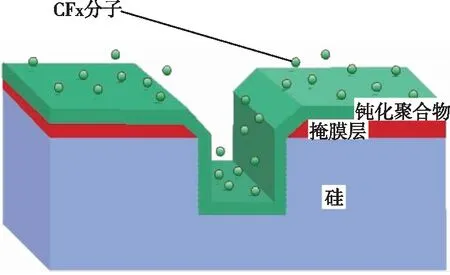
(a)

(b)图1 Bosch工艺的钝化过程(a)和刻蚀过程(b)示意图Fig.1 The scheme of Bosch process for deposition (a) and etching(b)
用于硅结构干法刻蚀试验的样品是经过阳极键合工艺的4英寸(直径为100mm)硅-玻璃结构,玻璃的上表面沉积金,是支撑层和电极引出层。需要刻蚀的硅结构层的厚度为60μm,硅结构层底部锚点的高度为10μm,图2是刻蚀结构的横截面实物图。区域A是刻蚀间隙为3μm的梳齿结构,区域B和C是刻蚀间隙尺寸分别为100μm和200μm的刻蚀区。

图2 硅-玻璃结构MEMS陀螺的截面图Fig.2 The cross-section structure of SOG MEMS gyroscopes
在刻蚀过程中,由于Lag效应的存在,大间隙的结构(区域B和C)优先于小间隙的结构(区域A)完成刻蚀[6]。在大间隙结构刻穿后,钝化聚合物透过硅结构层底部的漏空区域在玻璃电极表面不断附着。利用物镜为10倍、目镜为20倍的显微镜观察电极表面钝化聚合物的形貌;利用台阶仪测量钝化聚合物的沉积厚度,台阶仪的扫描速率为50μm/s,测量精度为1nm,测量的基准点为暴露在刻蚀区域、无聚合物沉积的金表面,测量并记录钝化产物的最大厚度值;利用扫描电子显微镜对钝化产物的成分进行定性分析,并对刻蚀结构的垂直度进行测量。
通过优化钝化气体C4F8的流量、卡盘温度、刻蚀气体SF6的流量和钝化气体C4F8的压力,可减少钝化聚合物的沉积,改进结构垂直度。
2 结果和分析
2.1 钝化产物的成分确认
利用刻蚀机对硅结构层厚度为60μm的硅-玻璃结构进行释放。在结构释放后,将硅结构层剥离掉,与硅结构对应的电极表面明显增加了一层物质。利用SEM-EDS方法对电极表面物质的成分进行定性分析,表1为成分测试结果。测试点的成分包括了元素碳、氟和金,3种元素的质量百分比分别为24.10%、17.35%、58.55%,原子数百分比分别为62.38%、28.38%和9.24%。其中,元素金是玻璃电极表面溅射的金属材料,元素碳和氟是钝化过程产生的聚合物,碳、氟两种元素的比例为2.2∶1。

表1 钝化过程中钝化产物的成分Tab.1 The composition of deposition polymer during passivation process
2.2 降低钝化聚合物
在硅结构刻蚀过程中,保持刻蚀/钝化时间、射频源功率不变,分别调节工艺参数C4F8气体流量、卡盘温度、SF6气体流量和C4F8气体压力。在硅刻蚀后剥离掉硅结构层,并利用台阶仪对电极表面的钝化聚合物厚度进行测试,测试结果如图3(a)~(d)所示。

(a)

(b)

(c)

(d)图3 钝化聚合物厚度随C4F8气体流量(a)、卡盘温度(b)、 SF6气体流量(c)和C4F8气体压力(d)的变化Fig.3 The thickness of deposition polymer as the influence of C4F8 flow (a), platen temperature (b), SF6 flow (c) and C4F8 pressure (d)
如图3(a)所示,改变气体C4F8的流量由360cm3/min降低至180cm3/min,钝化聚合物的厚度将由1200nm降低至980nm;如图3(b)所示,将卡盘温度由-10℃升高至30℃,钝化聚合物的厚度将由1200nm降低至270nm;保持C4F8的流量和衬底温度分别为180cm3/min和30℃不变,调节SF6气体流量和C4F8气体压力,钝化聚合物的厚度将降低至100nm以下,如图3(c)和图3(d)所示。可见,气体C4F8的流量和卡盘温度是影响钝化聚合物厚度的主要因素,调节SF6气体流量和C4F8气体压力对降低聚合物厚度的作用不明显。
根据测试结果,气体C4F8和SF6的流量对钝化聚合物厚度的影响不同。钝化过程为各向同性的工艺过程,气体C4F8的流量越小,通过扩散沉积在硅结构层底部的钝化聚合物越少;刻蚀过程为各向异性的工艺过程,离子气体的垂直方向性好,而扩散能力差。因此,在SF6气体流量增加时,刻蚀离子对硅结构底部聚合物的去除能力没有明显改变。
工艺过程中的衬底温度由制冷机chiller进行控制。当衬底温度由-10℃升高至20℃时,钝化聚合物厚度的变化不明显。当温度升高至30℃时,金属表面的钝化聚合物厚度明显减少,这是由于随着温度的升高,钝化聚合物(CF2)n的脱附率明显增大所致。
根据Catherine B. Labelle等人的分析,升高C4F8气体压力,沉积速率将降低。如图3(d)所示,钝化聚合物厚度随C4F8气体压力的变化无明显改变,这可能与气压设置范围有关。腔室气体压力的大小影响等离子体密度,在等离子体密度饱和的情况下,调节气体压力对钝化聚合物的多少影响很小。
当刻蚀完成后,将硅结构剥离掉并利用显微镜观察电极的表面形貌,如图4所示。当衬底温度为-10℃、C4F8气体流量为360cm3/min时,电极表面钝化聚合物明显(图4(a));减少C4F8气体流量至50%或提高工艺衬底温度至30℃,电极表面聚合物颜色变浅(图4(b)~(c));同时降低C4F8气体流量并提高工艺衬底温度,电极表面颜色均匀,无明显的聚合物(图4(d))。可见,降低C4F8气体流量并提高工艺衬底温度可以减少聚合物,满足使用要求。

(a)衬底温度为-10℃,C4F8气体流量为360cm3/min

(b)衬底温度为-10℃,C4F8气体流量为180cm3/min

(c)衬底温度为30℃,C4F8气体流量为360cm3/min

(d)衬底温度为30℃,C4F8气体流量为180cm3/min图4 电极表面显微镜形貌Fig.4 Themicroscope morphology of electrode surface
2.3 提高结构垂直度
高垂直度硅结构的加工是刻蚀工艺和钝化工艺达到动态平衡的过程。影响垂直度的因素包括刻蚀/钝化周期、极板功率、气体流量和腔室压力等工艺参数[7]。结合2.2节中可降低聚合物的工艺参数的调整,对刻蚀后的硅结构垂直度进行测量,图5(a)~图5(d)是梳齿结构的横截面SEM结果。当衬底温度为-10℃、C4F8气体流量为360cm3/min时,硅结构垂直度为89.9°;降低C4F8气体流量至180cm3/min时,硅结构垂直度为92.2°,由于保护气体C4F8的流量过低,硅结构出现各向同性刻蚀,结构边缘出现削角现象[8],硅结构上宽下窄;当衬底温度升高至30℃时,硅结构垂直度为89.1°,卡盘温度升高,硅结构上部的刻蚀能力大于结构底部的刻蚀能力,硅结构上窄下宽;同时提高衬底温度至30℃并降低C4F8气体流量至180cm3/min时,刻蚀结构的垂直度为90.0°,达到结构刻蚀的理想状态。

(a)衬底温度为-10℃,C4F8气体流量为360cm3/min

(b)衬底温度为-10℃,C4F8气体流量为180cm3/min

(c)衬底温度为30℃,C4F8气体流量为360cm3/min

(d)衬底温度为30℃,C4F8气体流量为180cm3/min图5 梳齿结构的横截面SEM图Fig.5 The SEM picture of cross section for comb-shaped structure
3 结 论
本文优化了刻蚀过程的工艺参数,包括钝化气体C4F8的流量、衬底温度、气体SF6的流量和钝化气体C4F8的压力。利用台阶仪和扫描电子显微镜对玻璃电极表面的钝化产物厚度和硅刻蚀结构的垂直度进行了测量。影响玻璃电极表面钝化聚合物厚度的主要工艺参数是气体C4F8的流量和衬底温度。结合对刻蚀气体SF6流量的调节,获得了玻璃表面钝化产物层厚度小于100nm、垂直度为90.0°的硅刻蚀结构,避免了加工过程中引入的多余物,满足了使用要求。

