铁电负电容场效应晶体管器件的研究
李 珍,翟亚红
(电子科技大学 电子薄膜与集成器件国家重点实验室,四川 成都 610054)
0 引言
随着微电子芯片集成度的不断提高,晶体管功耗成为限制其发展的主要因素。降低器件的亚阈值摆幅(SS)是减小功耗的主要途径之一。因玻尔兹曼热力学限制,在温度T=300 K时,传统金属氧化物场效应晶体管(MOSFET)的SS极限值为60 mV/dec。2008年,Salahuddin和Datta提出了用铁电材料来置换传统栅介质的概念,此后有许多学者的研究表明,采用铁电负电容结构的负电容场效应晶体管(NCFET)可以突破60 mV/dec的热力学限制[1-4]。对于一个新型器件的研究,模型的建立是关键环节。Girish Pahwa等[5]基于金属/铁电/金属/介质层/硅(MFMIS)结构的NCFET结合标准的BSIM6的本征金属氧化物场效应晶体管(MOSFET)的模型推导出了NCFET的模型; Hyunjae Lee等[6]通过半解析的方式推导出了NCFET的电流-电压模型。
本文基于MuhammadA.Alam等的NCFET模型,对模型进行了修正,其模型中直接将晶体管栅源电容和栅漏电容简化为栅氧化层和源漏的重叠电容。但是栅源电容和栅漏电容还包括与偏压有关的栅氧化层电容与耗尽层电容相串联的部分电容。二者的电容大小是会随着栅源电压和栅漏电压变化。在短沟道器件中,栅源电容和栅漏电容不可忽略,因此,本文在建立短沟道NCFET器件模型时,对其进行了修正,基于修正后的模型,仿真分析了铁电层厚度、等效栅氧化层厚度及不同类型的铁电材料等参数对晶体管器件性能的影响。
1 器件模型及原理
1.1 铁电材料的负电容效应
铁电材料的自由能U为
U=αP2+βP4+γP6-EP
(1)
式中:α、β和γ为铁电材料的各向异性参数;E为铁电材料内部的电场强度;P为极化强度。
描述铁电材料性质的Landau-Khalatnikov (LK)方程为
(2)
式中:ρ为极化阻尼参数,与材料有关;t为时间。
在准静态下,结合式(1)、(2)可得铁电材料两端的电压VFE为
VFE=2αtFEP+4βtFEP3+6γtFEP5
(3)
式中tFE为铁电材料的厚度。
在铁电材料中,电场较小时,电容上的电荷量Q和P近似相等,可得铁电电容CFE的表达式为
(4)
正电容材料的α、β和γ均为正,而铁电材料中α<0,β可能为正也可能为负,γ≥0。因此,不同于正电容材料的抛物线形状的能带图,与正电容材料的U-P能带图(其为开口向上的抛物线结构)不同,铁电材料的U-P能带图为双势阱结构(见图1),其有2个能量最小值,即稳定态A和B,且为正电容区域,当外加电压V=0时,系统处于稳定态,当V大于矫顽电压Vc时,A不再为能量最小值,会沿着曲线向B移动,在此过程中,会经过负电容区域(NC),由图可知NC并非稳定态。但已有研究[7]表明,通过串联正电容,使串联系统对外部呈现正电容状态,可以起到稳定CFE的作用。在NCFET中,本征MOSFET的总电容可以起到串联的正电容作用。
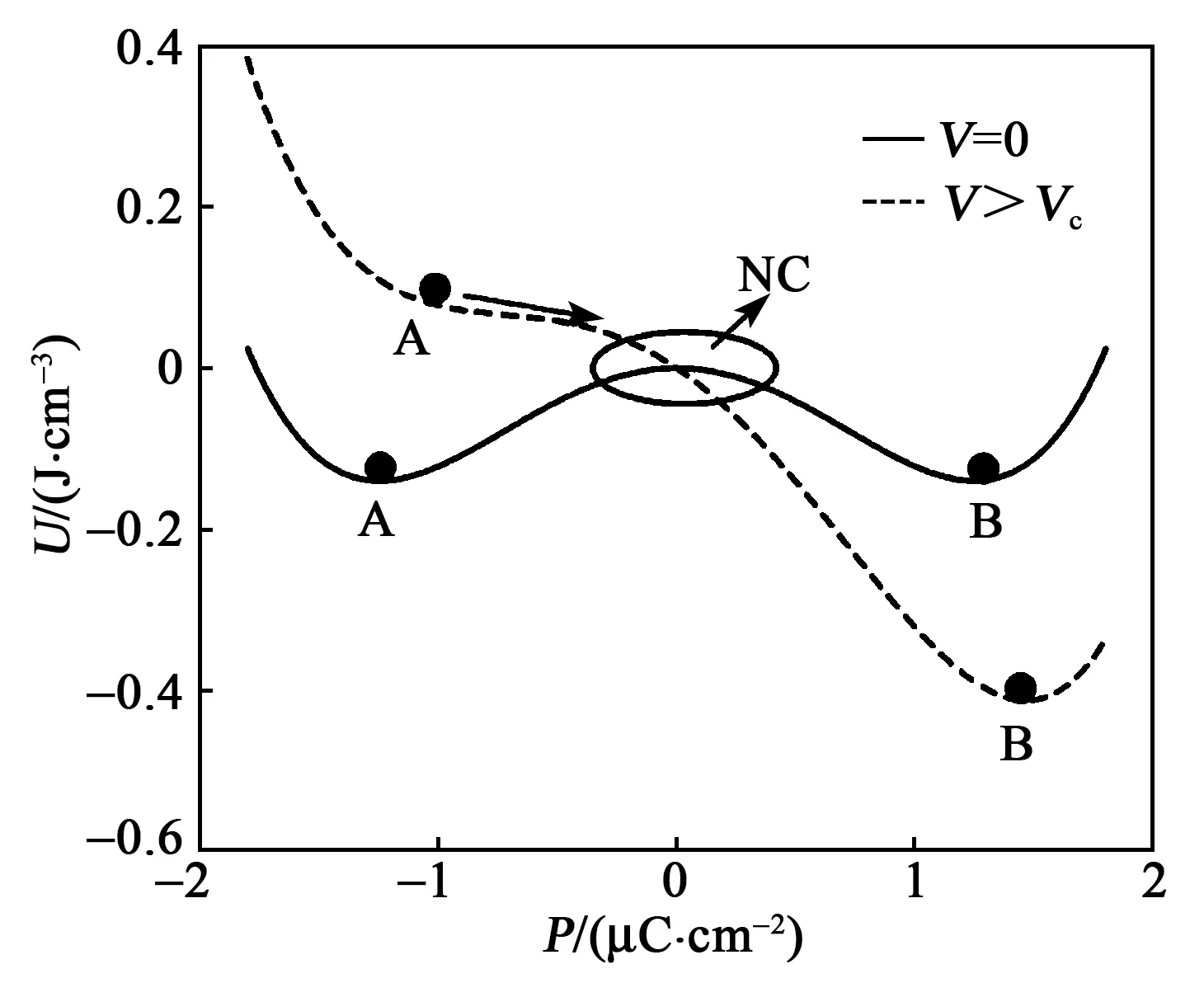
图1 铁电材料U-P能带图
1.2 NCFET器件模型
NCFET的等效结构模型如图2所示。器件的结构为在本征MOSFET的栅氧化层上添加金属层/铁电层/金属层(M/FE/M)。金属层相当于提供了一个等势面[8],结构可等效为铁电电容串联本征MOSFET。其中金属层为氮化钛(TiN),铁电层材料为锆钛酸铅(PbZrTiO3,PZT)压电陶瓷或钽酸铋锶(SrBi2Ta2O9,SBT)或钛酸钡(BaTiO3,BTO)。其等效电容模型如图3所示。图中,VGMOS为本征栅极电压,ΦS为半导体的表面势,VGNC为外部栅极电压,VDS为漏源电压,COX为栅氧化层单位电容,CGS为栅源电容,CGD为栅漏电容,CS为半导体电容。其中CGS和CGD由与偏压有关以及与偏压无关的两个部分组成,与偏压无关的栅极是和源漏区直接交叠的氧化层电容,与偏压有关的栅电容是栅氧化层电容与耗尽层电容相串联的部分。

图2 NCFET器件结构模型

图3 NCFET等效电容模型
根据MEYER模型[9]可知,CGS和CGD均是偏压的函数。通过电容分压关系可得VGMOS与VGNC及VFE的关系:
VGMOS=VGNC-VFE=VGNC-tFE(2αQ+
4βQ3+6γQ5)
(5)
由式(5)可看出,当铁电电容稳定在负电容区域时,VFE<0,因此,VGMOS>VGNC,铁电电容相当于起到了一个电压放大的作用。
2 结果及讨论
2.1 铁电层厚度
为了研究不同厚度的铁电层对NCFET性能的影响,对比了tFE分别为0、150 nm、260 nm、330 nm、400 nm和500 nm的NCFET。器件的具体参数如表1所示。图4为采用不同tFE的铁电层器件的VGNC-ID(ID为漏极电流)关系。由图可知,与本征MOSFET相比,NCFET的ID更大,且随着tFE的增加,ID增加。表2为tFE不同时NCFET的SS。由表可知,SS随着tFE的增加而减小。

表1 器件具体参数

图4 采用不同tFE时铁电层器件的VGNC-ID关系

表2 tFE不同时NCFET的SS
将CFE和CMOS串联起来定义NCFET的总电容为CT,并且只有CT为正时,总的系统才处于稳定状态[10]。铁电材料具有负电容效应使CFE为负,由此使得CT>CMOS,由于串联电容上的电荷量相等,因此VGNC (6) 由式(6)可知,AV可用来衡量电压放大的效果。 由于电压放大效应使得栅极电压相同时,与本征MOSFET相比,NCFET具有更大的ID。器件的SS[11]为 (7) 式中:CG为总的栅电容;q为电子电荷量;k为玻尔兹曼常数;CINT为本征MOSFET的总电容。此时栅极电容是CFE串联COX,当CFE 在其他参数不变的情况下,对比了等效栅氧化层厚(EOT)分别为0.75 nm、1.00 nm、1.50 nm和4.50 nm的NCFET。其中添加的铁电层是厚330 nm的PZT。图5为采用不同EOT器件的VGNC-ID关系。由图可知,随着EOT减薄,ID增加,这是因为EOT减小会使COX增加,进而本征MOSFET单位电容CMOS增加,增加后的CMOS和|CFE|更接近,电压放大效应明显,从而使SS减小(见表3)。 图5 采用不同EOT器件的VGNC-ID关系 表3 不同等效栅氧化层厚度NCFET的COX、CMOS及SS 为了研究不同铁电材料对NCFET器件性能的影响,对比了3种不同铁电材料(PZT、SBT和BTO)的NCFET。材料的各向异性参数[8]如表4所示,其中tFE为330 nm时, 等效栅氧化层厚度为1 nm。 表4 铁电材料的各向异性参数 图6为采用不同铁电材料的器件的VGNC-ID关系。由图可知,添加了SBT的NCFET的ID最大,其次是PZT及BaTiO3。结合式(4)及表3可知,CFE主要由铁电材料的α决定,|α|越大,|CFE|越小,与CMOS越接近,电压放大效应就越好,SS就越小(见表5)。图7为采用不同铁电材料的NCFET的电容耦合关系。由图可知,当CMOS=4.932 9×10-6F/cm2时,添加了SBT的铁电层的NCFET的|CFE|和CMOS在一定电压范围内很接近。 图6 采用不同铁电材料器件的VGNC-ID关系 表5 不同铁电材料NCFET的SS 图7 采用不同铁电材料的NCFET的电容耦合关系 本文基于Landau-Khalatnikov理论和器件的短沟效应,建立了NCFET的器件模型,结果表明,在系统稳定即CT为正,CFE为负的前提下,|CFE|和CMOS的耦合程度越好,AV就越大,NCFET的SS就会远小于60 mV/dec。 另外,基于此模型,我们对NCFET器件性能进行了仿真研究,得到了亚阈值摆幅为33.9176 mV/dec的短沟道NCFET的器件结构和参数。同时,对比分析了各种器件参数对短沟道NCFET器件性能的影响,仿真结果表明: 1) 铁电层厚度增加,NCFET亚阈值摆幅减小。 2) 等效氧化层厚度减小,NCFET亚阈值摆幅减小。 3) 对比了铁电材料分别为PZT、SBT和BTO的NCFET的器件性能,由于SBT的|x|最大,而铁电电容CFE主要是由各向异性参数α决定的,添加了SBT的铁电层的NCFET,其铁电电容CFE和本征MOSFET电容CMOS耦合度更高,其亚阈值摆幅就更小。2.2 等效栅氧化层厚度


2.3 铁电材料种类




3 结论

