基于硅通孔工艺的宽带毫米波传输设计
金来福 林蒙 桂勇锋

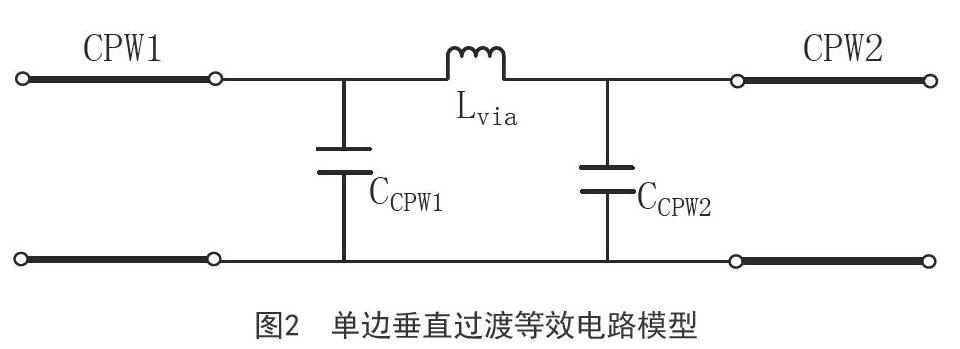

摘 要 硅通孔技术是当前在微波毫米波三维集成微系统领域的重点研究方向之一, 本文基于现有的硅通孔工艺技术开展宽带毫米波垂直传输结构的设计,运用三维电磁场仿真软件对该垂直过渡结构进行了建模, 并作优化设计与仿真计算, 运用高径深比通孔填铜工艺和多层键合工艺完成样品研制。借助于去嵌入校准方法完成在片测试,结果表明该设计性能良好,具有很好带宽和平坦的幅度响应,实现了基于硅通孔垂直互联的低损耗传输。
关键词 硅通孔(TSV);宽带垂直过渡;三维集成
引言
宽带高频低损耗互连是微波毫米波系统技术发展的基础,以三维微波、毫米波集成电路为主要内容之一的系统级集成(系统级封装) 技术已成为研究热点, 在三维结构内更加倾向于有源器件与无源电路的系统级混合集成, 而三维集成电路需要研究的关键问题之一是垂直互连传输技术。
相比于传统的多层基板应用,硅转接板技术因为采用半导体工艺而具有更高的精度优势[1]。TSV通孔技术由于其能够有效地缩短互连长度、提高互连性能而应用于各类低频电子线路,该项技术极大地提高了数字集成电路的集成度,同时在微波毫米波领域,TSV垂直通孔能够实现信号的垂直传输,是微波电路三维集成的关键技术[2]。在多芯片电路中的信号完整性与电磁兼容问题引起了广泛关注[3]。
本文采用硅转接板中硅通孔工艺技术研制了一种工作于毫米波段的宽带垂直过渡,运用三维电磁仿真分析软件对该过渡进行了优化设计。
1硅通孔(TSV)传输结构设计
微波毫米波系统中使用到的垂直过渡主要有电磁耦合[4]与直接耦合[5],均能实现宽带和低插损特性。本文采用了类同轴结构直接耦合的垂直过渡形式,设计了一种基于硅通孔工艺的宽带毫米波垂直过渡传输结构,传输线采用的共面波导(Coplanar Waveguide,CPW)传输。在该结构中,硅通孔是通过半导体后道工艺制作的铜填充实心硅通孔;射频信号传输线和信号TSV过孔的四周在硅基板上表面都布满地,上表面地与下表面的地平面在信号传输线两侧通过TSV阵列形式互连。此过渡是正面共面波导到背面共面波导的垂直通孔过渡的对称形式,如图1所示。
在硅通孔工艺的垂直互连设计中,传输线在互连过渡时一般会产生突变,不连续性会引起寄生效应。通过对图2所示的过渡等效电路模型可知,垂直互连通孔引入了通孔寄生电感Lvia,电容CCPW1和CCPW2分别是由共面波导与地造成的寄生电容。为了消除或尽量抑制这些寄生效应,需要在实际建模时对传输线尺寸在各过渡段对尺寸优化分析。同时为了防止信号的辐射和泄露,引导电磁场信号传输,在垂直信号通孔周围和共面波导线侧边分别引入了金属屏蔽通孔,以连通短接带状线上下金属地板,同时有效抑制由于不连续性激发的寄生平行板模式。
根据以上的过渡结构和传输原理分析,开展进行宽带毫米波垂直互联传输设计。硅转接板工艺中采用30um×200um高径深完全填充的TSV型生胚材料,硅转接板相对介电常数为11.9,建立模型如图3所示。50欧姆共面波导线的线宽设计为100μm,信号线与两侧的地间距均为100μm。
信号过孔的端部采用容性补偿设计,抵消垂直互连金属过孔串联的电感效应,在正反面微带线两侧的接地通孔,可以有效抑制寄生模式,消除谐振,提高截止频率,改良电路传输性能。
2结束语
本文设计了一种基于硅通孔工艺的宽带毫米波垂直过渡, 给出了设计、工艺制作和测试结果。通过基于硅通孔的互连设计和传输性能的测试分析,基于半导体后道的TSV实心填铜工艺制作的传输结构能具有较好的垂直传输性能,在毫米波频段内,单个TSV 垂直过孔插入损耗S21≤0.055dB,可以满足微系统集成要求。
参考文献
[1] Souriau J C,Sillon N,Brun J,et al. System-on-Wafer:2-D and 3-D Technologies for Heterogeneous Systems[J]. IEEE Transactions on Components Packaging & Manufacturing Technology, 2011, 1(6):813-824.
[2] Zhu L Wu K.Ultrabroad-band vertical transition for multilayer integrated circuits[J].IEEE Microwave and Guided Wave Letters,1999,11(9):453-455.
[3] Zhu H R,Sun Y F,Huang Z X,et al. A Compact EBG Structure with Etching Spiral Slots for Ultra-Wideband Simultaneous Switching Noise Mitigation in Mixed Signal Systems[J]. IEEE Transactions on Components, Packaging,and Manufacturing Technology,2019,8(9):1559-1567.
[4] Lee J H,Kidera N,Dejean G,et al. A V-band front-end with 3-D integrated cavity filters/duplexers and antenna in LTCC technologies[J]. IEEE Transactions on Microwave Theory & Techniques,2006,54(7):2925-2936.
[5] Henick, Katherine J, Yook, JongGwan, Robertson, Stephen V,等. W-Band Micromachined Vertical Interconnection for Three-Dimensional Microwave ICs[C].European Microwave Conference. IEEE,2007:402-406.
作者簡介
金来福(1989-),男,安徽桐城人;学历:研究生,职称:工程师,现就职单位:中国电子科技集团公司第三十八研究所,研究方向:微波毫米波电路。

