某微波收发组件脉冲接收下增益降低失效分析
吴小虎 宋军 魏守明

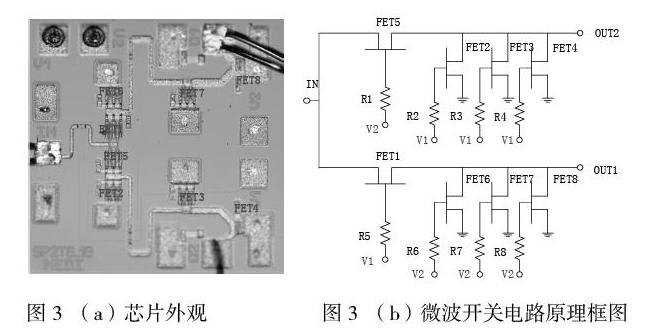
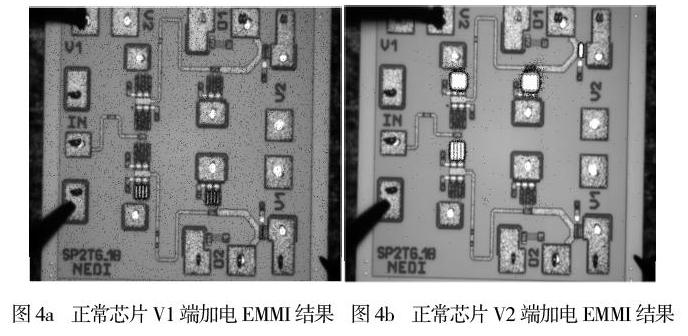
【摘 要】微波收发组件作为有源相控阵天线的核心部件,主要功能包括微波信号的接收、发射和幅度与相位控制。随着武器装备小型化、高集成度化和高可靠的发展需要,在微波收发组件性能保持不变的情况下需进一步提高可靠性。在高集成度微波收发组件实现过程中发生了部分失效现象,暴露了一些可靠性问题,制约了武器装备的发展。本文对某波收发组件脉冲接收下增益降低的故障展开了失效分析。通过EMMI等先进的失效分析手段定位该组件收发开关芯片体电阻出现异常。针对该问题产生的原因,提出增加芯片级筛选测试项目和组件级脉冲接收测试筛选项目,为提高组件的可靠性提供指导。
【关键词】微波收发组件;脉冲接收;失效分析
1 前言
有源相控阵雷达因其能满足雷达的探测距离、数据更新率、多目标跟踪及测量精度等众多需求,是近年来发展迅速的雷达技术[1]。有源相控阵雷达中“有源”指的是可以辐射功率和接收目标回波的微波收发组件,每一个微波收发组件内包括独立的发射支路、接收支路、公共支路和控制电路[2]。发射支路的主要作用是将来自激励源的信号进行放大、滤波等处理,通过天线饱和输出射频信号,并保持输出信号幅度、相位有相当好的一致性,发射支路的主要性能指标包括饱和输出功率峰值、通道间发射峰值功率一致性等。接收支路的主要作用是将天线接收到得微弱空间辐射信号进行低噪声放大,经过移相、衰减等控制,将接收到得数据返回波控系统,接收支路的主要性能指标包括噪声系数、接收总增益、接收带内增益平坦度等。公共支路包括移相器、收发开关和环形器等,公共支路为微波收发组件收、发公共部分。控制电路包括波束控制电路、过温保护电路等,主要实现对组件内发射支路、接收支路和公共支路工作状态的控制。控制电路设计时主要考虑的性能指标包括运算速度、体积和功耗等,目前趋向于高集成度和专用集成电路。
微波收发组件接收支路中有源器件主要由限幅器、低噪声放大器、衰减器、开关和移相器组成。本文阐述了开关芯片由于体电阻异常导致脉冲接收测试条件下增益降低的失效机理,提出了芯片添加在片测试筛选项目和组件增加脉冲接收测试筛选项目措施。
2工作原理
本文中涉及的微波收发组件单纯的接收支路主要由限幅器、低噪声放大器和衰减器构成,但是,在接收工作时,公共支路的环形器、收发开关、移相器和部分控制电路也参与其中。因此,其接收工作原理框图如图1所示。从图1中可以看出,专用集成电路主要功能为将组件外部提供的串联数据信号T_R、CLK、SEL、DATA和DARY转换为并联控制信号V1-V11、S1-S11、SW1和SW2,V1-V11控制移相器,S1-S11控制衰减器,SW1和SW2控制微波开关芯片。
专用集成电路逻辑功能图如下图2所示。从图2可以看出,T_R信号面经过驱动器输出互补的差分信号SW1、SW2,SW1和SW2控制微波开关。
3 失效分析
某编号该型号组件在整机调试时,发现T_R信号在频率12GHz、43%占空比及脉宽10us接收测试情况下,增益与正常通道相比,小5dB左右。由故障现象可知,组件接收测试结果与T_R信号相关。通过图1和图2的原理图可知,T_R信号经专用集成电路转换后控制开关芯片。
利用示波器测量专用集成电路SW1和SW2输出,输出波形正常,判断微波开关芯片发生失效。
组件中使用的微波开关芯片是一款双路开关芯片,该芯片采用MESFET工艺,共包括8个MESFET,简称为FET1~8,芯片外观及电路原理框图如下图3所示。FET1~8作为信号路由开关,属于栅控芯片,切换信号传输路径。芯片中的所有栅极电均有串联电阻,串联电阻通过GaAs体电阻实现[3],在芯片表面看不到该电阻,在图3(a)芯片外观图中对体电阻走线进行了标注,在图3(b)芯片电路原理框图中体电阻标注为R1~R8。
显微镜下检查微波开关芯片,芯片外观正常。为进一步明确故障组件内开关是否失效,对被分析芯片和正常芯片进行了EMMI测试。在半导体中有两种载流子,自由电子和空穴,自由电子和空穴复合时会发射光子[4],EMMI通过高灵敏度摄像头,可以将被分析样件和正常样件表面发光情况拍摄下来,然后将两者进行比对,找出发光强度不同的位置,可以精确定位芯片故障点[5]。
对于正常芯片:V1端口加电时,FET2和FET3发光,其余位置不发光,如下图4a所示;V2端口加电时,FET5、FET6、FET7和FET8发光,其余位置不发光,如下图4b所示。
故障芯片V1端口加电时,与正常件相比,除FET2和FET3发光外,在芯片中间区域存在一处发光点,如图5红色圆圈内所示,将该发光点与图3芯片外观图和电路原理图比对,判断发光位置为体电阻R4。造成这种发光现象差别的原因为,对于正常件,体电阻局部分压较小,体电阻无热电子效应,观测不到发光点,对于故障件,体电阻局部异常增高,体电阻局部分压增大,热电子效应增强,观测到发光点。故障芯片V2端口加电时,与正常件相比,FET5、FET6、FET7和 FET8均发光。
对R4电阻异常导致FET开关速度变慢进行理论分析,该芯片FET结构如下图6所示。
栅源寄生电容为Cgs,与此次发生失效的R4体电阻串联,构成RC电路,FET开关上升沿和下降沿由RC电路时间常数τ决定,用公式1表征。
τ=R*C (公式1)
式中R為R4体电阻的阻值,C为栅源寄生电容Cgs的容值。对于该失效件,R4异常增大,单独测量R4阻值由原来1K欧姆增大至1M欧姆,时间常数增大,开关开启速度变缓。在脉冲接收测试条件下,对于每一个脉内,FET不能及时响应,开关工作状态异常,接收增益降低。
选取同类型的开关电路并实际测试外部串联电阻的方式增加R数值,得到不同电阻的延时效果,实际测试结果见表1。理论推算R电阻要增大到50M,与FET寄生电容共同作用,可能产生接近1毫秒延时。
该电阻是砷化镓电阻,是在具有一定阻值的晶圆上,使用光刻工艺限定图形区域,然后通过注入工艺将限定图形以外的区域电学隔离,隔离区域为高阻。若这些工艺步骤中存在缺陷,是有可能使得体电阻变成高阻的,可能的缺陷包括:
(1)GaAs材料缺陷。GaAs材料缺陷所在的位置,其方阻值与晶圆其它部分的方阻会有显著差异,若此缺陷恰好位于电阻图形上,阻值就会出现异常。常见的GaAs材料缺陷多数都是在光学显微镜或扫描电镜下可见的,工艺上控制的典型缺陷密度为≤50个/cm2(>0.8um2的缺陷)。除此之外,GaAs材料缺陷还包括沟道内部缺陷,此类缺陷在光学显微镜或扫描电镜下看不见,鉴于这么多年来此类缺陷遇到的概率不高,因此判定GaAs材料缺陷的可能性虽然存在,但概率不高。
(2)可被去除的灰尘或颗粒落到晶圆上。若在半导体电阻加工过程中,有一颗灰尘或颗粒落到电阻图形上,会造成此处光刻胶偏薄,后续注入工艺中就会使此处被部分隔离,形成高阻,在去胶工艺中颗粒又被去除,因此目检看不到缺陷。高阻态的半导体电阻在加电时存在较高的电场强度,产生热电子,在电场驱动下与半导体材料中的空穴复合,产生光子,从而被EMMI探测到。EMMI所观测到的点状发光点,与工艺中常见的圆形、椭圆形点状颗粒是很类似的。故障件是由此类缺陷造成的可能性较大。
4 采取的措施
造成该问题的主原因是芯片个别制造缺陷在之后的筛选过程中未被剔除,在芯片制造和组件级筛选采取措施如下。
4.1芯片添加在片测试筛选项
添加芯片直流在片测试的测试项,筛选出控制端串联电阻明显偏大的异常件,施加Vgs偏置电压,采集各通道的Igs,当Igs超过0.4V,可以看到Igs-Vgs的斜率有明显的变化。当Vgs达1V时,正常通道与故障通道的Igs相差超过两个数量级,如图7所示。
4.2 组件增加脉冲接收测试筛选项目
该组件在之前仅进行连续波接收测试,针对该故障,增加脉冲接收测试。测试条件:测试频率12GHz,占空比43%,脉宽10μs,示波器设置为单触发状态,打开射频信号及T-R脉冲信号,组件开机后观测接收信号的完整脉冲检波图形。
5 结束语
针对某收发组件在脉冲接收条件下接收增益下降的问题,经定位,问题原因是组件内微波收发开关芯片工艺制造过程中个别缺陷造成体电阻异常增大。针对该问题,本文提出的芯片添加在片测试筛选项目和组件增加脉冲接收测试筛选项目措施有效,可以避免同类问题的再次发生。
参考文献:
[1]陈忠先.相控阵雷达的发展与前景[J].现代电子,1995,52(3):1-6
[2]胡明春,周志鹏,严伟.相控阵雷达收发组件技术[M].北京:国防工业出版社,2010:6-16
[3]高学邦,杜红彦,王小旭,赵静.半导体情报[J],2000,37(1):62-65.
[4]Paul Scherz. Practical Electronics for Inventors,Second Edition[M],2009:388-391
[5]丁鷙敏,吴照玺,段超.微光显微镜(EMMI)在器件失效分析中的应用[J].电子显微学报,2019,38(2):156-158
作者简介:
吴小虎,男,1986年生,安徽省六安市霍邱县人,2012年毕业于电子科技大学,硕士研究生学历,从事研发项目管理和研发体系建设工作。

