原子层沉积薄膜的表征方法进展
田 旭,王新炜
(北京大学深圳研究生院新材料学院,广东深圳518055)
随着科技不断发展,在电子、能源、催化、生物、医学等越来越多的应用领域中需要可控制备高质量的纳米薄膜.常用的纳米薄膜制备方法可分为气相、液相和固相三类,其中气相法包括物理气相沉积(PVD)[1]、化学气相沉积(CVD)[2]和原子层沉积(ALD)[3].原子层沉积主要基于前驱体分子的自限性表面化学反应,通过循环交替通入前驱体,使薄膜以原子层的形式逐层生长.这种特殊的薄膜生长方式使得ALD技术在精准控制纳米薄膜厚度及在复杂三维表面上实现保形沉积等方面具有显著优势[3-4].因此,ALD技术在微电子、纳米等前沿科技领域具有越来越多的应用[5-13].
1 ALD原理
在常见的ALD过程中,两种前驱体循环交替地通入反应器内,与基底表面依次发生自限性的表面化 学 反 应,从 而 使 薄 膜 逐 层 生 长[3-4,14].以 常 见 的ALD工艺制备氧化铝(Al2O3)薄膜为例[15],该工艺使用三甲基铝(TMA)作为铝前驱体、H2O作为氧前驱体,单个沉积循环包括以下步骤:通入TMA前驱体,使TMA与基底表面发生自限性化学吸附反应;通入惰性气体吹扫,去除表面化学反应副产物(甲烷)及过量的TMA;通入H2O,H2O与表面吸附的TMA发生自限性化学吸附反应;通入惰性气体吹扫,去除表面化学反应副产物(甲烷)及过量的H2O.重复上述循环,直至完成所设定的薄膜沉积周期数.图1为ALD制备Al2O3薄膜的反应步骤示意图[15].

图1 ALD制备Al2O3薄膜的反应步骤示意图[15]Fig.1 Schematic diagram of the reaction steps of the ALD of Al2O3 films[15]
对于ALD薄膜生长而言,每周期薄膜沉积的厚度增量(GPC)是其关键参数之一[16].鉴于ALD技术的自限制薄膜生长特点,在理想情况下每周期的膜厚增量应为一恒值.因此,通过测量膜厚与周期数之间的关系,可验证薄膜的GPC是否为一常数.同时,薄膜的成分、杂质、结晶性、形貌等物性对于ALD薄膜的应用也至关重要.而一般ALD过程中都或多或少存在一些非理想的因素,例如:所涉及的表面化学反应并非完全自限,导致类似于化学气相CVD的薄膜沉积,从而影响了薄膜的保形性和均匀性[17-18];前驱体分子配体在基底表面发生裂解,裂解产生的碳、氮等元素残留于薄膜内而形成杂质[19-20].因此,对ALD薄膜物性进行细致的表征是十分有必要的.
2 ALD薄膜的表征
2.1 ALD薄膜厚度的表征
ALD薄膜的厚度通常为几纳米到几十纳米,因此需要精度较高的厚度测量方法.同时,ALD制得的薄膜通常相对致密且表面平整(均方根粗糙度通常小于1 nm),因此比较合适的测量方法主要包括椭圆偏振光谱(SE)、X射线反射谱(XRR)、石英晶体微天平(QCM)、表面轮廓仪等.
2.1.1 椭圆偏振光谱(SE)
SE测量薄膜厚度的基本原理是利用偏振光在薄膜上下表面发生反射后的相干信号叠加,通过模型拟合获得薄膜厚度.对于一般的介电和半导体ALD薄膜而言(厚度<20 nm),厚度的拟合受薄膜光学参数的影响较小,因此薄膜厚度的测量精度较高(可达0.1 nm).对于金属等导电薄膜来说,受薄膜光学参数及粗糙度的干扰较大,厚度测量通常不准确[21].此外,对于ALD而言,SE技术的另一优势是可用于原位监测ALD过程中的薄膜厚度增长,实验设备如图2所示[22].

图2 设备示意图[22]Fig.2 Schematic illustration of the setup[22]
图3 为原位SE法测量ALD氮化锆薄膜的实验结果.ALD氮化锆薄膜于150℃温度下沉积在硅片表面,通过原位SE测量薄膜沉积前后的椭偏参数Ψ(相对振幅衰减)和Δ(相位移动差)(图3(a)中实线和虚线分别表示镀膜前后的椭偏参数),以及连续10个沉积周期的Δ动态变化(图3(b)),再通过模型拟合,得到每周期薄膜厚度的增量为0.103 nm[22].

图3 原位SE方法测量ALD氮化锆薄膜的实验结果[22](a)薄膜沉积前后的椭偏参数(Ψ,Δ);(b)连续10个沉积周期的Δ动态变化Fig.3 Experimental results of in situ SE measurement of ALD zirconium nitride films[22](a)SE paramteres(Ψ,Δ)before and after the film deposition;(b)dynamic change ofΔduring continuous 10 cycles of ALD
2.1.2 X射线反射谱(XRR)
XRR测量薄膜厚度的原理是基于X射线在薄膜上下表面发生反射后的相干信号叠加,通过模型拟合获得薄膜厚度[23].XRR较为适用的厚度范围通常在几纳米到几十纳米之间,且要求薄膜的表面和界面较为平整(均方根粗糙度小于2 nm)[24].一般的ALD薄膜都能符合上述要求,可以通过XRR准确测量薄膜厚度(测量精度达0.1 nm).图4为在Si/SiO2衬底上ALD生长了100个周期的氧化钇薄膜的XRR测量曲线[25].X射线在薄膜表面和界面发生多次反射干涉后,形成了所测总反射强度的振荡,振荡周期与薄膜厚度成反比,因此可根据振荡周期得到薄膜厚度为7.7 nm.

图4 ALD氧化钇薄膜的X射线反射率曲线[25]Fig.4 X-ray reflectivity(XRR)curve of an ALD Y2O3film[25]
2.1.3 石英晶体微天平(QCM)
QCM主要用于实时监测ALD沉积过程中的薄膜质量变化,再根据薄膜密度计算得到薄膜厚度.QCM是基于石英晶体片的压电效应构建的高精度振荡器,晶体片上纳克量级的微小质量变化即可引起谐振频率发生明显变化,因而具有高精度的质量分辨率,理论上可测量对应薄膜厚度在0.01 nm量级的变化.但是由于石英晶片谐振频率受温度影响较大,一般需要特殊切面或者使用GaPO4等温度系数较小的晶体才能获得较好的实际测量精度[26].此外,薄膜厚度的折算还依赖于薄膜密度和晶振片表面的粗糙度,因此通常需要使用其他方法进行比对校准.图5为利用QCM实时监测ALD沉积碳化钴薄膜过程的质量变化图[27].由于该过程使用了离子体辅助,会对QCM信号采集造成一定的本底干扰,因此镀膜过程中的真实薄膜质量变化可通过扣除本底信号得到(图5(b)~图5(c)).图5(b)中的P1值对应的是一个ALD沉积周期的谐振频率变化,换算成薄膜厚度的增量约为0.066 nm.此外,通过QCM曲线还能得到ALD半周期内的薄膜质量变化(图5(b)中的P2和P3值),据此可用以判断ALD过程中的表面化学反应机制.

图5 QCM监测ALD沉积碳化钴过程中的薄膜质量变化[27](a)所采集的原始QCM质量增量曲线;(b)扣除本底信号后的QCM质量增量曲线;(c)每周期对应的薄膜质量增量P1及P2/P1和P3/P1比值变化图Fig.5 Film mass change monitored by QCM during ALD of cobalt carbide[27](a)acquired trace of QCM mass gain;(b)background subtracted trace of QCM mass gain;(c)per-cycle changes of film mass P1 and ratios of P2/P1 and P3/P1
2.1.4 表面轮廓仪
表面轮廓仪测量薄膜厚度,先将衬底表面的部分薄膜划去,再在划痕处测量薄膜边缘与衬底形成的台阶高度,从而得到薄膜厚度.尽管轮廓仪自身测量台阶高度的精度可达纳米级,但是在划痕台阶构建过程中容易引入误差(如损伤衬底等),因此在实际中较少使用.Z.Guo等人[28]采用表面轮廓仪测量沉积在Si/SiO2衬底表面的金属铜薄膜厚度,由于ALD铜薄膜与SiO2表面的附着力较弱,即使使用较轻的力(避免衬底损伤)也能产生较为完整的划痕,因此针对这类薄膜得到的厚度值较为准确.
2.2 ALD薄膜成分的表征
ALD薄膜成分的表征方法主要包括卢瑟福背散射谱(RBS)、X射线荧光光谱(XRF)、能量色散X射线谱(EDS)和X射线光电子能谱(XPS)等.根据ALD薄膜通常相对较薄的特点,一般推荐使用RBS或XRF测量薄膜中的元素比例,使用EDS表征薄膜中各元素的空间分布,使用XPS分析各元素的化学价态.
2.2.1 卢瑟福背散射谱(RBS)
RBS是一种精确测量薄膜元素成分的方法,该方法通过高能He离子束照射样品,收集背散射离子的信号,获取样品组分含量的定量信息.但是由于ALD薄膜通常较薄,因此只有原子序数大于基底元素的信号才能被很好地测量分析.如需测量ALD氧化物薄膜中的含氧量,一般需要将薄膜沉积在玻璃碳基底上[29].如果沉积在硅片上,则氧峰会被硅的背底信号掩盖,难以用于定量分析.此外,RBS在区分近邻重元素方面,也存在一定的局限性[30].图6为使用RBS方法测量约8.5 nm厚的ALD硫化镍(NiSx)薄膜的实验图谱和拟合图谱,由此可得到NiSx薄膜中Ni和S原子的总面密度,从而计算得到薄膜中的Ni/S原子比[31].

图6 ALD NiSx薄膜的RBS图谱及拟合结果[31]Fig.6 Experimental and simulated RBS spectra of an ALD NiSx film[31]
此外,通过结合前述的薄膜厚度测量,还可获得ALD薄膜的密度信息.基于RBS方法研究了沉积温度对所得ALD NiSx薄膜中
Ni/S原子比和薄膜密度的影响,结果如图7所示.

图7 ALD NiSx薄膜中Ni/S原子比及薄膜密度随沉积温度的变化曲线[31]Fig.7 Temperature dependence of the Ni/S atomic ratio and film density of the ALD NiSx films[31]
2.2.2 X射线荧光光谱(XRF)
XRF也是一种相对精确的薄膜成分定量测量方法,可与RBS互补使用.XRF的工作原理是通过X射线照射样品,使其元素的内层轨道电子发生受激跃迁,受激电子在退激发过程中向外辐射X荧光,通过收集荧光信号,分析薄膜中的元素组分[32-33].由于ALD薄膜通常较薄,传统XRF测量中的基体效应可忽略不计,因此所得定量测量结果较为准确,但是该方法对轻元素的灵敏度较低,尤其对原子序数小于钠的元素测量较为困难.Y.Shao等人[34]在研究分析ALD硫化铁(FeSx)薄膜的过程中,使用了XRF方法测量了FeSx薄膜中的Fe/S原子比,并将结果与RBS结果对照(图8),获得了很好的一致性.
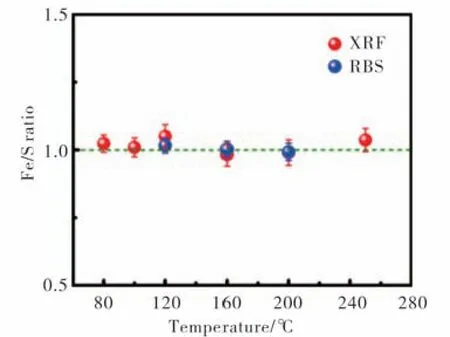
图8 XRF和RBS方法测量ALD FeSx薄膜Fe/S原子比的结果对照[34]Fig.8 Comparison of the XRF and RBS results for the Fe/S ratios of ALD FeSx films[34]
2.2.3 能量色散X射线谱(EDS)
EDS也可用于分析ALD薄膜的成分,其通常与SEM和TEM等组合使用,通过电子束激发薄膜中的元素产生特征X射线,以此分析薄膜材料的组分.与RBS和XRF等方法相比,EDS基于电子束,可用于材料的微区成分分析并得到元素的空间分布,但是相对而言,其定量分析的误差略大.Y.Shao等人[34]使 用EDS方 法分 析 了 包覆 在Al2O3粉末颗粒上的ALD FeSx薄膜成分(图9).通过结合SEM和EDS表征方法,可以看到ALD制备的FeSx薄膜能均匀地覆盖在Al2O3颗粒粉末上,体现了ALD技术在保形包覆方面的优势.
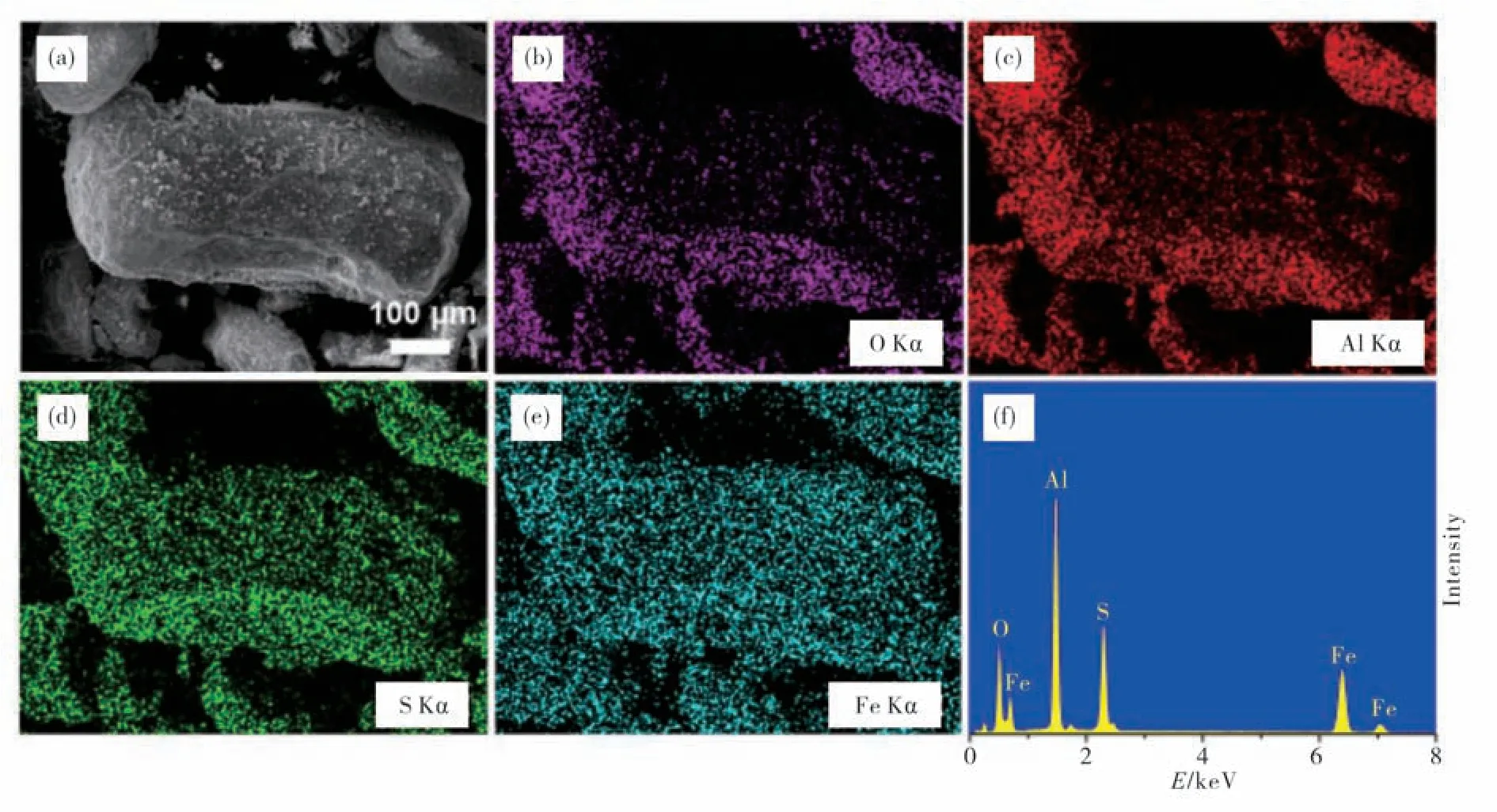
图9 包覆了ALD FeSx薄膜的Al2O3粉末颗粒的SEM图像及元素的EDS分布图和EDS谱[34](a)SEM图;(b)O;(c)Al;(d)S;(e)Fe;(f)EDS谱Fig.9 SEM image of ALD FeSx coated Al2O3 powder,the associated EDS elemental distributions and EDS spectrum[34](a)SEM image;(b)O;(c)Al;(d)S;(e)Fe;(f)EDS spectrum
2.2.4 X射线光电子能谱(XPS)
XPS主要基于X射线与材料作用产生的光电子来分析薄膜的成分及各元素化学价态,但是由于光电子的逃逸深度较浅,XPS仅能用于分析材料的表面特性.Q.Guo等人[35]利用XPS,分析了ALD碳化镍(Ni3Cx)薄膜的元素组成及化学态(图10).通过分析Ni和C的谱峰面积,可计算得到薄膜的元素组成约为Ni3C0.7;通过分析Ni和C的峰位和峰形,可以判断所得材料为碳化物;通过分析N和O谱峰强度发现仅略高于噪声水平,表明所得Ni3Cx薄膜纯度较高.此外,XPS还可应用于原位表征研究ALD过程的薄膜生长机制.R.Zhao等人[36-38]利用原位XPS技术,深入研究了硫化镍等ALD薄膜生长过程中的机理机制问题,发现了诸如表面酸碱络合物生成机制、反应团聚机制等一系列新的ALD机制.

图10 ALD Ni3Cx薄膜的XPS谱图[35](a)全谱;(b)Ni 2p;(c)C 1s;(d)N 1s;(e)O 1s高分辨谱Fig.10 XPS spectra of ALD Ni3Cx films[35](a)survey and high-resolution;(b)Ni 2p;(c)C 1s;(d)N 1s;(e)O 1s spectra
2.3 ALD薄膜晶型及形貌表征
ALD薄膜晶型的表征方法主要有X射线衍射(XRD)、拉曼光谱和透射电子显微镜(TEM),薄膜表面形貌的表征方法主要有原子力显微镜(AFM)和扫描电子显微镜(SEM).
2.3.1 X射线衍射(XRD)和拉曼光谱
XRD和拉曼光谱都是常用的晶型表征方法.XRD方法基于X射线在晶体中发生的衍射现象,可用于表征多晶薄膜和单晶外延薄膜,但是如果薄膜过薄或者晶粒尺寸过小,会导致XRD谱峰过弱过宽,难以准确得到晶体结构.拉曼光谱法则基于测量材料的特征振动谱,判断所得薄膜的晶体结构,相对而言,拉曼光谱对于ALD薄膜材料的微结构变化更为敏感.Z.Guo等人[39]利用XRD和拉曼光谱,表征了ALD沉积的硒化铁(FeSe2)、硒化钴(CoSe2)和硒化镍(NiSe2)薄膜的晶相结构(图11).结果表明:ALD FeSe2和CoSe2薄膜的晶相结构均为正交晶系的白铁矿型结构,而ALD NiSe2薄膜的晶相结构为立方晶系的黄铁矿型结构,此外薄膜的晶粒尺寸可通过Scherrer方程从衍射峰的宽度估算;通过比对相应的块体材料结构的拉曼谱,可以进一步确认薄膜的晶体结构,此外所得的拉曼光谱没有观测到晶态硒和非晶硒的特征峰,据此可以判断这些ALD薄膜中无单质硒杂质.

图11 ALD FeSe2,CoSe2和NiSe2薄膜的图谱[39](a)XRD谱图;(b)拉曼光谱图Fig.11 Spectra of ALD FeSe2,CoSe2 and NiSe2 films[39](a)XRD;(b)Raman spectra
2.3.2 透射电子显微镜(TEM)
TEM可用于分析ALD薄膜的微区晶相结构.Li H.等人使用TEM得到ALD NiSx薄膜(厚约10 nm)的微区形貌图和电子衍射图(图12)[31].结果表明,ALD NiSx薄膜呈现出了一定的结晶性,再通过测量衍射环半径的大小及对比数据库,可确定所得ALD NiSx薄膜的晶体结构属于正交godlevskite结构Ni9S8.
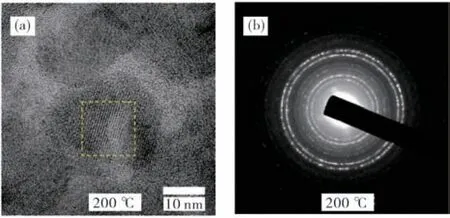
图12 ALD NiSx薄膜的TEM图像及相应的电子衍射图[31](a)TEM;(b)电子衍射Fig.12 TEM image and the corresponding electron diffraction pattern of ALD NiSx film[31](a)TEM;(b)electron diffraction
2.3.3 AFM和SEM
AFM和SEM主要应用于表征ALD薄膜的表面形貌.AFM是利用针尖与薄膜表面原子间的排斥力获得样品表面的三维形貌图,从而得到薄膜表面粗糙度等信息.但是AFM成像范围相对较小、测试速度慢,成像质量受探头影响较大.SEM是通过电子枪向样品表面发射电子,采集样品表面逸出的二次电子进行成像,从而获得样品表面形貌图像.SEM成像范围较大、测试速度快,但是无法直接测量薄膜表面均方根粗糙度值.通过AFM和SEM分别观测ALD NiSx薄膜的表面形貌(图13)[31],结果表明:NiSx薄膜厚度约为10 nm,AFM测得的表面均方根粗糙度为1.81 nm;AFM和SEM的图像均显示该薄膜具有颗粒状的表面形貌,说明薄膜具有多晶结构.此外,通过SEM观测在三维复杂结构上沉积ALD薄膜的覆盖情况发现,ALD NiSx薄膜沉积在深宽比为10∶1的沟槽结构上,ALD薄膜在沟槽结构内侧均有沉积且厚度均一,表明ALD薄膜具有良好的保形性特点.

图13 ALD NiSx薄膜的表面形貌[31](a)AFM;(b)SEM;(c)横断面SEM图Fig.13 Surface morphology of ALD NiSx film[31](a)AFM;(b)SEM;(c)cross-sectional SEM image
2.4 ALD薄膜的其他表征
除了上述涉及的薄膜基本物性表征外,通常还需针对ALD薄膜的具体应用场景进行针对性的性能表征.ALD薄膜的应用十分广泛,受限于篇幅,以下仅选取了几个典型例子进行简单讨论.
ALD技术广泛应用于催化领域,通过在亚纳米尺度上对催化剂的成分、结构、尺寸和分布进行精准调控,构建新型高效的纳米催化剂.Liu等人[40]在研究基于ALD技术的单原子Pt催化剂的过程中,通过核磁共振技术表征了Pt原子所处的化学环境,为构建高效催化剂提供重要的微观结构信息.ALD薄膜也广泛应用于电催化领域,包括制备高效电解水制氢、制氧催化剂等[41-47].针对这一应用场景,需要对所得ALD薄膜进行各种电化学性质表征,包括循环伏安法、电化学阻抗法等.此外,对于ALD制备的金属薄膜,通常需要测量薄膜的电导率等性质[28].
3 结语与展望
综述了常见的ALD薄膜表征方法,主要从薄膜厚度、成分、结晶性、形貌等方面进行了介绍.通常通过SE,XRR和QCM等方法测量薄膜的厚度,以此检测薄膜的生长特性.通过RBS,XRF,EDS和XPS等方法,表征薄膜的成分组成、元素化学价态及杂质类型和含量.通过XRD,TEM和拉曼光谱等方法表征薄膜的晶型,而通过AFM和SEM观测薄膜的表面形貌.根据ALD薄膜的具体应用场景,进行针对性的性能表征.
随着表征技术的不断发展,原位表征技术将起着越来越重要的作用.目前已有不少原位技术应用于表征ALD薄膜生长的过程,除了前述的SE,QCM和XPS方 法 以 外,还 有QMS[48],FTIR[49],STM[50]和UPS[51]等方法,以及基于同步辐射光源的GISAXS[52],XRF[52],AP-XPS[53]和XANES[54]等方法.这些原位表征技术通过监测ALD过程中薄膜的厚度、形貌、化学价态、电子结构等关键特性的演变,还能更好地认识理解ALD过程的机理机制,以此制备可控性更好、性能更优的ALD薄膜,从而促进ALD技术的应用发展.因此,发展更好的原位表征手段对于未来ALD技术的发展和应用具有重要的意义.

