SiC MOSFET单粒子效应研究现状
刘翠翠郭 刚李治明张付强陈启明韩金华杨新宇
1(中国原子能科学研究院北京102413)
2(国防科技工业抗辐照应用技术创新中心北京102413)
3(兰州大学兰州730000)
随着核能与空间技术的不断进步,越来越多的半导体器件和设备工作在各类辐射环境中。为了满足电力电子、人工智能、军事安全等领域日益增长的需求,半导体器件在朝着更小特征尺寸、更低功耗、更高效率发展的同时,其抗辐照特性也需要进一步加强[1]。在核作业与自然空间辐照环境中存在大量的高能粒子,如质子、中子、电子、重离子等[2],会导致半导体器件产生单粒子效应(Single Event Effect,SEE)、总剂量效应(Total Ionizing Dose,TID)以及位移损伤效应(Displacement Damage Dose,DDD)等[3-5],对其正常工作产生了严重威胁。随着使用需求的提高,传统的Si基功率器件工作频率、耐压阈值、抗辐照能力,逐渐逼近其物理性能极限,以碳化硅(SiC)、氮化镓(GaN)为代表的第三代宽带隙半导体材料及器件凭借优异的性能脱颖而出[6]。
如图1所示,SiC的绝缘击穿场强约为Si的10倍,热导率约为Si的3倍,禁带宽度约为Si的3倍,载流子饱和漂移速度约为Si的2倍[7-9];与同为第三代半导体的GaN相比,SiC在热导率、击穿电场等方面也具有突出优势,特别适合制备1 kV以上的高功率器件。金属氧化物半导体场效应晶体管(Metal Oxide Semiconductor Field Effect Transistor,MOSFET)是一种常见的功率器件,已广泛应用于各类数字和模拟电路中。其中,与传统Si基MOSFET及GaN高电子迁移率晶体管(High Electron Mobility Transistor,HEMT)等相比,SiC MOSFET具有工作电压更高、正向导通电阻更低、开关速度更快、驱动电路更简单等突出优势[10-11],在新一代航天器动力系统中具有较强竞争力。

图1 常用半导体材料主要物理特性对比Fig.1 Comparison of main physical property of commonsemiconductor materials
目前,在空间堆、宇航器、反应堆、箭/弹等核能或航天极端辐射环境中,高压大功率器件的应用场景非常广阔[12-15]。然而,当前关于SiC MOSFET辐射效应的研究结果表明,其SEE敏感性及复杂性与理论预期不符,严重影响了该类器件的辐射应用价值。因此,为了进一步提升SiC MOSFET性能,研究SiC MOSFET SEE退化规律、效应机制以及新型的抗辐照加固技术,是保障未来各类辐射任务顺利达成的必由之路。
1 研究背景
常见的辐射环境包括空间辐射、空中辐射以及人为辐射等。其中,空间辐射环境主要由太阳宇宙射线、银河宇宙射线以及地球俘获带组成,其起源和相关粒子成分如图2所示。太阳宇宙射线对近地空间影响最为强烈,其中存在质子、重离子、中子和电子等多种成分;银河宇宙射线绝大部分是质子和α粒子,主要特点是高能量、低通量、各向异性很小;而在地球俘获带中则主要包含质子(内带)和电子(外带),在空间辐射环境中,粒子种类繁多,能量可跨越0~10 GeV,对各类电子元器件的正常服役产生了极大威胁。在以反应堆为主的人为辐射环境中,还存在能量更高、注量更大的粒子[16-17],或可对应用其中的电子元器件产生更为致命的损伤。

图2 复杂的空间辐射环境Fig.2 Complex space radiation environment
一般来说,依据电子元器件所受辐射损伤的机理和性能退化规律,辐射效应可分为SEE、TID以及DDD。其中,SEE是指当单个高能粒子入射到半导体器件后,由于电离能量沉积的作用,在器件敏感区中诱发大量电子空穴对,在电子空穴对被电场收集后形成脉冲电流,从而导致器件工作状态发生改变的一种现象。
根据效应损伤是否可逆,SEE又可分为单粒子翻转(Single Event Upset,SEU)、单粒子瞬态(Single Event Transient,SET)、单粒子功能中断(Single Event Function Interruption,SEFT)等非致命性软错误,以及单粒子闩锁(Single Event Latchup,SEL)、单粒子栅穿(Single Event Gate Rupture,SEGR)、单粒子烧毁(Single Event Burnout,SEB)等致命性硬错误[18]。根据2013年IEEE核与空间辐射效应会议(Nuclear and Space Radiation Effects Conference,NSREC)相关统计结果,由辐射效应所引起的航天器在轨故障数占总故障数的45%,在这其中,由SEE引起的故障占86%,TID和DDD分别仅占8%和6%[19-20]。由此可见,SEE是航天器正常作业的主要威胁因素。
商用SiC MOSFET诞生在21世纪初期,并凭借其突出优势在功率器件领域占据越来越大的市场份额。经过20余年的发展至今,SiC MOSFET工作电压可达数千伏,被认为是Si绝缘栅双极型晶体管(Insulated Gate Bipolar Transistor,IGBT)的强势替代产品,在电源和驱动系统领域的前景被广泛看好。然而,虽然SiC中形成缺陷的电离能和阈值能(原子键强度)均远超Si,在理论上具有更强的抗辐射能力,但由于其材料制备技术及器件设计、工艺尚不成熟等问题,SiC MOSFET对高能粒子仍非常敏感,很容易产生SEB和SEGR等效应[21-23],严重影响其辐射应用的可靠性。如今,我们不仅面临SiC MOSFET SEE效应机理不清晰的问题,也亟需开发针对SiC MOSFET的新型抗辐射加固技术。
因此,本文从实际应用需求出发,梳理并归纳总结了国内外多家研究单位关于SiC MOSFET SEE机理、加固技术及评估方法等多方面的研究成果,希望为日后SiC MOSFET SEE的研究工作提供有益参考。
2 国外研究现状分析
国外关于SiC MOSFET的研究起步较早,目前也已经形成了从材料生长、器件设计、制备工艺到封装成型等完整技术体系。与此同时,由于欧美日等国家的加速器发展较早,其模拟辐照实验技术也相对成熟,而且伴随其较早开展的空间探测技术,故在多年前便开展了SiC MOSFET辐射效应的相关研究。经过多年积累,在SiC MOSFET SEE效应机理和加固技术等方面也取得了诸多的研究成果。
Si基MOSFET的SEGR和SEB现象在1986年首次被发现并报道。以N型MOSFET举例,当时认为器件的SEB始于强电流触发外延层的雪崩。当带电粒子作用于高偏压工作状态下的器件后,导致其内部的寄生双极晶体管(Bipolar Junction Transistor,BJT)被激发导通,在外延/衬底界面处电场增加。这一电场削弱了碰撞电离的作用;反之,由于高电子密度导致带隙变窄,电流可通过带间隧穿来维持。同时,局部温度的升高将导致Si发生熔化,并产生一个导电性较好的电流路径,使得漏极-源极电压突然下降,即二次击穿[24-25],最终导致器件发生SEB。
1995年,Titus等[26]研究发现,MOSFET的栅氧化层厚度、入射离子线性能量转移(Linear Energy Transfer,LET)值、入射角度、温度、沟道电导率以及元胞几何形状等多种因素都会影响VD MOSFET的SEGR阈值。他们结合实验测试结果,总结了SEGR发生时,其栅-源阈值电压VGS与源-漏电压VDS、栅氧化层厚度Tox、离子LET以及入射角度θ等变量之间的经验公式(1):

对Si基MOSFET的SEB演化的理解也有助于探索理解SiC MOSFET的SEB机制,关于SiC MOSFET SEE的研究最早见于2014年。研究表明:相比于其他类型的SEE,在SiC MOSFET中更容易产生SEGR和SEB这两种效应,这是因为这两种效应的发生与器件被粒子辐照后所产生的潜损伤有关[27]。由辐射后栅极应力(Post-Irradiation Gate Stress,PIGS)的测试结果发现,潜损伤使SiC MOSFET在低于阈值电压的10%时即发生退化,在宏观电性能上表现为栅极漏电流IGSS升高,且器件退化程度与相对偏置正相关,偏压越高,其退化程度越大[28],图3展示了SiC MOSFET发生SEE过程。因此,目前国际上针对SiC MOSFET抗辐射加固技术的研究也更着重于解决SEB和SEGR这两个问题。

图3 SiC MOSFET辐照前后的重离子效应与施加电压的关系。失效是指IGSS>1 mA,BVDSS<<额定电压Fig.3 Heavy-ion effects as a function of relative applied voltage for SiC MOSFET,as measured during and after irradiation.Failed refers to IGSS>1 mA,BVDSS< 2014年,Mizuta等[29]基 于 商 用SiC MOSFET(Cree公司,型号CMF10120D)开展了70 MeV质子及N、Ne、Ar、Kr、Xe等多种重离子的辐照实验,并利用高能粒子诱导电荷光谱(Energetic Particle-Induced Charge Spectroscopy,EPICS)等在线监测了器件的电荷累积状态以及漏电流的变化。在远低于额定电压时,漏电流变化行为与SiC SBD类似;而随偏置电压升高,引发SEB的粒子注量下降,反应截面逐渐增加(图4)。分析发现,器件的漏-栅漏电流IDG通路涉及漏极颈,类似一个结型场效应晶体管(Junction Field-Effect Transistor,JFET)区域,而漏-源漏电流IDS通路涉及的是体漏极p-n结。 图4 重离子辐照过程中器件失效率与粒子注量的关系Fig.4 Cumulative failure rate as a function of particle fluence during heavy ion irradiation 2015年,Lauenstein等[30]研 究 了 商 用SiC MOSFET对Ag和Xe离子的SEE响应。结果显示:几乎所有器件都在低于其额定电压60%时发生了SEE,在低于额定电压10%时便可能发生永久性损伤。然而,即使SiC MOSFET的温度稳定性相比Si基MOSFET要更好,但其抗SEE辐射能力仍旧较差,因而难以满足空间应用需求。 同年,Shoji等[31]研究了中子辐照SiC MOSFET SEB诱发机理(图5)。扫描电子显微镜下可直观地看到器件发生SEB后,粒子入射局部的材料性质发生了变化。与软件模拟结果相结合,可以认为SiC MOSFET SEB的诱发因素和诱发过程非常复杂:当高能离子入射后,在器件内部会出现峰值电场转移以及在n-/n+结处因碰撞电离导致的载流子激增等多种变化,最终由于多种因素综合作用导致了SEB的发生,但对这些因素在诱发SEB时的贡献程度以及各种因素触发的先后顺序并未做出清晰论述。 图5 扫描电子显微镜下SiC功率MOSFET SEB示意图(a),SiC功率MOSFET重离子入射后电场变化仿真示意图(b)Fig.5 Diagram of SEB in SiC MOSFET under scanning electron microscope(a),simulation diagram of electric field variation after heavy ion incident in SiC MOSFET(b) 2018年,Akturk等[32]研 究 了 中 子 诱 发SiC MOSFET SEB的物理机制。实验研究的结果表明:中子的敲除作用会在器件内产生缺陷及二次粒子,进而诱发载流子碰撞电离,对于SiC MOSFET的SEB退化起决定性作用,并认为抑制器件内部碰撞电离以及降低器件关断状态下电场强度是两种能够提高SiC MOSFET抗SEB能力的技术途径。 同年,Witulski等[33]选用1 200 V SiC MOSFET(Wolfspeed公司,型号C2M0080120D)开展了重离子辐照SEE实验。他们采用不同LET值重离子辐照后的结果如图6所示,器件SEB阈值电压会随入射离子LET值的增加而显著降低,而且,当LET值大于10 MeV·cm2·mg-1时,器件的SEB阈值电压几乎恒定为额定电压的一半,该研究结果与他人研究结 果 比 较 统 一[25,29-30]。利 用 计 算 机 辅 助 设 计(Technology Computer Aided Design,TCAD)软件模拟SEB退化过程的结果表明,SEB损伤阈值与粒子入射位置密切相关,而引起电性能退化的整个过程主要与寄生BJT的开启机制有关。 图6 1 200 V SiC MOSFET SEB阈值电压与离子束LET的关系Fig.6 Relationship between SEB bias threshold voltages for 1 200 V SiC MOSFET and the LET values of ion beams with comparison of 3D TCAD SEB simulations to measured data by different researchers 2018年,Ikpe等[27]选取了来自4个不同制造商、阈值电压为900~3 300 V不等的8款SiC MOSFET开展了重离子LET值对SEB响应的影响研究,结果如图7所示。当LET值及偏压均较低时,器件未发生任何退化,但当源-漏偏压VSD增加到一定值后便会瞬间引发SEB;而且,当LET略微大于10 MeV·cm2·mg-1(SiC)后,利用PIGS几乎测试到所有器件都发生了IGSS的增加。研究结果表明:当LET大于一定值后,随源-漏偏压的增大,器件均经历了非永久性退化、栅极潜在损伤、漏-栅极漏电流IDG主导退化、源-漏极漏电流IDS主导退化以及最终的SEE这一系列过程。但与前人结论不同的是,Ikpe认为寄生BJT并没有参与到SiC MOSFET SEB诱发机制中。因为相比Si基MOSFET,SiC MOSFET需要更高的电压才能开启寄生BJT,这也符合文献[27,34]中关于寄生BJT在SiC MOSFET SEB产生过程中所起作用较小的结论。 图7 MOSFET对不同离子束响应的柱图Fig.7 Column plot of MOSFET responses to different ion beams 2019年,Martinella等[35]研究了重离子辐照SiC MOSFET的电流传输机制,并提出了重离子辐照SiC MOSFET退化的电流输运模型。实验结果显示:当源-漏偏压VDS较低时,重离子辐照导致的漏电流路径是从漏到栅极;当源-漏偏压VDS较高时,漏电流路径是从漏到源极(图8),与Lauenstein团队实验结果[27]一致。同时,他们还测到高LET值Xe离子引发SiC MOSFET的漏电流比Fe离子引发的高2~3个数量级。 图8 在辐照过程中栅极和漏极泄漏电流随注量的变化规律Fig.8 The variation of gate and drain leakage current with injection amount during irradiation 2020年,该团队[36]又采用焦点为500 nm的重离子微束研究了SiC垂直双扩散金属氧化物半导体场效应晶体管(Vertical Double-Diffused Metal Oxide Semiconductor Field Effect Transistor,VDMOSFET)的漏电敏感区及退化机制,并绘制出可解释SiC VDMOSFET SEB退化的曲线(图9)。相比于文献[27]的研究结果,该研究发现SiC VDMOSFET漏电流退化遵循一定的空间周期性,且漏电流主要贡献区会随源-漏偏置升高逐渐从栅氧层下的JFET区转移到pn结区,这与文献[27,34]中的论述对应,即当源-漏偏置升高后主导的漏电流从漏-栅电流IDG转化为漏-源电流IDS。 图9 重离子辐照过程中SiC MOSFET SEB过程与漏-源电压VDS的关系Fig.9 The SEB processing for SiC power MOSFET as a function of the drain-source bias VDS during the heavy ion irradiation 同年,Ball等[37]针对二极管和MOSFET类似的SEB特性,重新研究了寄生BJT在引发SEB机制中的作用,并采用三维数值模拟的方法,对具有相同外延层结构的SiC MOSFET和二极管的临界击穿电场进行了分析。该模拟结果同文献[31]一样否定了寄生BJT在SiC MOSFET SEB中的关键作用,显示出当离子入射后电场的重新分布,并在外延/衬底界面,即pn结处出现峰值。同时,碰撞诱导电流脉冲发生在几十皮秒的尺度内,在如此短时间内不会因二极管和MOSFET结构不同而产生不同的结果。由于离子诱导的高局域态能量脉冲作用,外延/衬底界面处较大的电场也显著增强了碰撞电离,这些共性导致重离子辐照MOSFET和二极管出现了比较一致的SEB退化现象。 截至目前,国外对于束流条件,如粒子种类、LET值、束流注量以及偏压等因素对SiC MOSFET SEE影响的研究较多,而关于器件工作温度影响的研究虽然开展较早,但仅有少量可参考文献,研究数据相对较少。从1996年开始,Mouret等[38]就研究了温度对功率MOSFET SEB和SEGR的影响,在研究中主要是验证了高温可提高SEGR阈值电压、降低功率SEGR敏感度。2011年,Morand等[39]基于质子加速器和脉冲激光模拟辐照技术,研究了功率MOSFET的SEB温度敏感性(图10),实验结果证明,功率MOSFET高温下SEE敏感度降低,表现为SEB截面的减小和安全工作区的增大。 图10 不同能量的质子横截面与温度的关系Fig.10 Relationship between proton cross sections of different energies and temperature 对于不同入射倾角的仿真结果显示漏电流与入射倾角θ之间并非简单的1/cosθ的关系。2018年,Lauenstein等[28]还 观 测 了SiC MOSFET经1 137 MeV高能重离子Xe不同入射角度辐照之后的漏电流变化。他们发现漏-源电流IDS、漏-栅电流IDG均随粒子注量的变化而改变(图11),在垂直入射和45°倾斜角度情况下IDS的变化几乎无差别,而IDG则满足角度的余弦关系。 图11 不同入射角度下,SiC MOSFET IDS(a)及IDG(b)随1 137 MeV Xe离子注量的变化Fig.11 Change in IDS(a)and IDG(b)leakage current as a function of 1 137 MeV xenon fluence at different angles 对比不同类型粒子辐照SiC MOSFET单粒子效应的研究结果可以发现,几乎全部肯定了粒子入射之后导致的电场漂移和载流子碰撞电离对诱发SEB的贡献,与Si基MOSFET的SEB机制中BJT的作用存在明显不同。但是,由于不同粒子的电离作用及非电离作用的不同,不同粒子对SiC MOSFET单粒子效应之间的等效关系还需要更多研究。 国内SiC MOSFET商业应用起步较晚,因而关于其SEE的研究数据也相对匮乏。当今时代的中国,随着电动汽车、高铁、核电站等领域的快速发展,成为了全球最大的SiC功率器件市场。与此同时,我国核能与航天事业快速发展,但SiC MOSFET SEE敏感度较高的问题却极大限制了其辐射应用,进而制约了未来深空探测的发展。因此,开展SiC MOSFET SEE物理机制及抗辐射加固技术的深入研究迫在眉睫。 早在2004年,中国原子能科学研究院开展了Si基MOSFET在不同VDS和VGS条件下的SEB研究[40]。在单一重离子辐照实验研究的基础上,也对16O、35Cl、79Br离子及高剥离态127I离子的SEB截面进行了测试,并得到了SEB截面随LET值的变化曲线。结果表明:对35Cl、79Br离子,只有在较高VDS下才会发生SEB;而因为高剥离态127I具有足够高的能量和LET值,即使在VDS较低时127I也可引起较高的SEB截面。此外,随着Si基功率器件工艺、结构的不断完善,其应用场景不断具体化。Si基MOSFET在600 V以下功率应用中占据主导地位,但是高于该电压的状态一般采用IGBT结构,然而Si IGBT对SEL非常敏感,空间应用价值很低。目前,国内多所高校和研究院所根据Si基功率器件的应用需求也开展了诸多器件辐射效应及抗辐照技术的研究工作。关于Si功率器件单粒子效应机制及异同性也较清晰,Si功率二极管的SEB更多受离子诱导产生的峰值电场导致的碰撞电离影响,而Si基MOSFET的SEB则更多受寄生BJT的影响[41]。 截至目前,对Si基MOSFET SEE的研究已较为全面,也形成了从地面模拟辐照技术、分析测试方法、抗辐照加固技术以及性能评估标准等全方位的技术体系。但Si基功率器件逐渐达到其性能极限,未来可能无法满足更高的性能要求;与此同时,SiC功率器件凭借多项优异的性能异军突起,有望应用于新一代航天器的电推进系统中。为了早日实现SiC MOSFET的国产替代,我国多家科研单位在21世纪初及时开展了SiC MOSFET技术及应用的相关研究,其中包括西北核技术研究院、中国原子能科学研究院、中国航天科技集团、中国电子科技集团以及电子科技大学等科研院所和高校。 2016年,中国电子科技集团公司第十三研究所王 敬 轩 等[42]研 究 了Br、I、Au重 离 子 辐 照SiC MOSFET后诱发SEB和SEGR的物理机制。根据表1的实验结果可见,相比于SEB,SiC MOSFET更容易发生SEGR,而且其损伤阈值会随重离子LET值增大而降低。最后,他们结合器件SEE退化特征认为改进器件结构或更换高K栅介质可以提高其抗辐射能力。 表1 SiC MOSFET器件Br、I、Au单粒子辐照结果Table 1 Single event experiments results of SiC MOSFET according to Br,I,Au ions 2017年,空军工程大学刘忠永等[43]利用TCAD软件,对基于4H-SiC和6H-SiC材料的两种VDMOSFET SEB敏感性进行了模拟分析。结果如图12所示,4H-SiC基VDMOSFET的SEB阈值电压相比于6H-SiC基VDMOSFET的SEB阈值电压更高,表示其抗SEB能力更强。在随后的研究中他们还发现[44],更换高H栅介质HfO2对SEGR有加固作用,而增加沟道参杂浓度可提高器件抗SEB能力。 图12 4H-SiC(a)及6H-SiC(b)VDMOSFET SEB前后的漏极电流Fig.12 Drain currents of 4H-SiC(a)and 6H-SiC(b)VDMOSFET before and after SEB 2019年,北京工业大学Zhou等[45]借助TCAD对SiC MOSFET与Si基MOSFET的SEB敏感性进行了仿真,并比较了二者在不同LET值下的安全工作区。两种器件重离子辐照下漏电流随时间的演化过程如图13所示。总体来说,SiC MOSFET的SEB阈值电压高于Si基MOSFET。最后,他们认为增加缓冲层可以在一定程度上提高SiC MOSFET抗辐照能力。但真正应用这种加固技术,还需要同时权衡正向导通电阻和栅氧层峰值电场强度两个因素,才能保证器件的综合能力。 图13 Si和SiC MOSFET在不同条件下随时间的漏极电流密度特性Fig.13 Drain current density characteristics vs.time for Si and SiC MOSFET under different conditions 2019年,中国空间技术研究院于庆奎等[46]研究了SiC MOSFET及二极管在重离子辐照条件下的SEE退化机制。由表2所示的统计结果显示,SiC MOSFET及二极管器件在重离子辐照条件下的SEB敏感性类似,均在较低工作电压条件下即发生SEB。深入分析了SiC功率器件SEB退化规律,他们认为导致SiC功率器件SEE敏感的主要原因不是器件类型而是SiC材料,主要是重离子在SiC器件中引起了材料物理结构上的损伤,导致SiC功率器件SEB敏感性较高。 表2 SiC器件经重离子辐照后的测试结果Table 2 The result of leakage current increase induced heavy ions for SiC devices 2020年,杭州电子科技大学林茂等[47]研究了MOSFET结构对其单粒子效应的影响。传统MOSFET的沟道与器件表面平行,称为平面栅VDMOSFET;新研制MOSFET的沟道与器件表面垂直,称为沟槽栅金属氧化物半导体场效应晶体管(U Metal Oxide Semiconductor Field Effect Transistor,UMOSFET)。这种设计在减小了器件尺寸、增大了单位面积电流密度的同时,还消除了器件内部的JFET区、降低了导通电阻。通过模拟发现,沟槽栅UMOSFET不仅拥有优异的电学特性,还拥有更突出的抗辐照特性。文献[47]基于UMOSFET研制出带有N岛缓冲层的SiC NITG-MOSFET,与SiC UMOSFET性能的对比结果如图14所示。可以清晰看到,新型器件经过LET为0.1 pC·μm-1粒子辐照后,SEB阈值电压提升显著。在不影响电学性能的同时,SiC NITG-MOSFET在衬底/外延层处的电场明显降低,其碰撞电离特性也显著提升。通过该仿真还发现,依据重离子入射导致的温度变化来表征SEB,比依据器件源-漏电流ISD的改变量表征更为准确。 图14 功率4H-SiC UMOSFET(a)及NITG-MOSFET(b)的SEB仿真结果Fig.14 The simulation results of SEB of 4H-SiC UMOSFET(a)and NITG-MOSFET(b) 2021年,湘潭大学张鸿等[48]基于蒙特卡罗方法对重离子在SiC中输运过程以及能量损失进行了系统的模拟分析,结果显示:重离子在SiC中造成的总能量损失主要是电离能量损失,这部分能量主要导致大量电子空穴对的产生,且电荷沉积峰值位于离子径迹中心,也随入射深度的增加而减小;而少部分的非电离能量损失则主要导致了SiC材料内晶格原子的移位,产生晶体材料的损伤,在材料中构建了电离通道的同时也影响了材料的热传导能力。再结合锎源、重离子辐照及TCAD模拟等多种方法,从理论上解释了SiC MOSFET的SEB诱发过程[49]:偏置电压会对器件内部电场产生强烈影响,局部区域的高压大电场作用导致了大电流的产生,进而引起过热,最终则由于非电离能量损失以及电离能量损失的共同作用导致器件发生烧毁。 目前,国内针对SiC MOSFET SEE的研究和报道仍旧是以基于TCAD、Geant4等软件的模拟计算为主[50];基于加速器、放射源等开展的辐照实验研究较少,主要是受限于加速器模拟辐照技术相关配套设施的建设;常见的模拟辐照研究工作,也主要集中于SiC MOSFET及功率二极管单粒子效应的重离子辐照实验。而天基等实际工作环境下的辐照实验目前仍面临实验成本过高、实验机会难得、实验周期过长等问题,尚不能作为常规研究手段。虽然实验室加速器辐照、辐射源辐照等地面模拟辐照方法已经逐渐能产生多种类型、多种能量的高能粒子,但其与真实辐照环境仍存在(诸如粒子能谱、粒子峰值能量、粒子类型等)多个方面的区别;而激光模拟、软件模拟等手段,许多参数都与真实环境存在差别[51-52]。目前已经形成的辐照效应等效模型只关注于效应或结果的部分方面,但等效关系不仅需在作用结果中进行等效,还应该体现在作用类型上。故地面加速器辐照实验虽然机时稀缺、等效模型也不完美,但仍是当前研究SiC MOSFET SEE机理机制及抗辐照性能评估最可行可靠、最贴近现实的研究手段。随着综合技术的发展,一些数值模拟方法及物理模型逐渐被建立并完善。借助这些模型,可逐渐修正地面加速器模拟辐照环境与真实辐照环境之间在时间尺度、能量尺度、空间尺度等方面的差异,建立出可信度较高的等效关系[16-17,53-55]。 首先,世界上仍没有针对SEB及SEBR有效的错误率预估方法,这主要是因为针对SiC MOSFET SEE机理研究的最劣辐照实验条件没有统一的技术标准:关于入射粒子种类、入射角度、粒子注量、工作温度等因素的评估条件也尚无可靠统一的研究结果。因此,为了加快SiC MOSFET SEE机理及加固评估等方面的研究步伐,建立广泛且统一的SiC MOSFET性能评估技术体系,目前的首要任务是完善配套的加速器地面模拟辐照试验技术。 然后,由于SiC MOSFET整体的抗辐照性能受到材料类型、材料质量、器件结构、流片和封装工艺等过程中多种因素的影响,因此开展SiC MOSFET SEE性能退化的研究十分困难,也产生诸多亟待揭示的物理现象。例如,辐照诱发各类损伤的微观演变过程、辐照微损伤对器件长期应用可靠性的危害、微损伤引起的各类宏观电学性能参数的退化、以及电学参数随时间、偏压、温度等工作条件的具体演化过程等,这些是SiC MOSFET SEE机制研究中必须解决的问题,对于SiC MOSFET性能评估也具有重要的意义。 同时,关于SiC MOSFET抗辐照加固的研究较少,也缺乏有针对性的加固技术。传统针对Si基MOSFET抗SEB和SEGR的加固技术大多以调整栅氧化层厚度和介质材料,或扩展P+源区优化寄生BJT的参数等为主,这些方法可以降低Si器件的寄生晶体管效应[47];或者也可以通过改善N区缓冲层以降低衬底/外延结处的电场强度和碰撞电离[56]。但是,调整栅氧化层厚度和介质材料也对氧化层材料的耐压性能提出更高的要求,而对寄生BJT参数的优化则通常以牺牲器件电学性能为代价。这也导致应用此类技术制备的抗辐照加固Si基MOSFET性能通常落后于同期普通商用器件约两代左右,因此也无法很好满足核能与航天任务中对器件高压、高速等性能的要求,且这些技术对于SiC基功率器件的有效性也有待验证。 最后,关于SiC电路或系统级器件的研究也需要提上日程。基于Si基功率MOSFET的降压变换器、探测器等性能突出,但其工作状态又受辐照剂量、沟道类型、栅极电压、工作频率等因素影响严重[57-58]。未来,SiC MOSFET凭借多项物理性能的突出优势,极有可能在诸多场合替代传统Si基器件。但由于各种SiC功率器件应用场景不同,目前针对SiC基功率二极管及MOSFET等分立器件的单粒子效应研究居多。而由于应用相对较窄,针对IGBT、GTO等类型SiC功率器件和SiC电路或系统级器件单粒子效应的研究则相对较少。研究表明,随着半导体工艺技术、材料类型、集成度等不断发展,器件的单粒子效应敏感性和机理都在随之改变。随着半导体器件和集成电路的发展,未来SiC辐射环境应用也一定会随之增加。因此,对于SiC电路或系统辐射效应的研究也具有非常重要的意义。 面对核能和空间飞行技术的飞速发展,各国都高度关注SiC功率器件的发展。无论在民用或军用领域,我国都拥有全球最大的SiC功率器件的应用市场,所以SiC功率器件高度依赖进口、国产替代严重不足已经成了必须面对的问题。同时,随着SiC MOSFET在辐射环境下的应用需求不断增加,其应用前景被广泛看好。但因为SEB、SEGR等问题严重影响了SiC MOSFET的可靠性,甚至会对单个分立器件,乃至整个电子系统产生致命威胁,使得SiC MOSFET真正广泛应用于核能与太空探索领域仍任重而道远。 作为新生于21世纪第三代半导体功率器件,SiC在理论上具备非常好的抗辐射能力,而实际上却并非如此。而且,目前国内外关于SiC MOSFET SEE机理及相应抗辐照加固技术等研究尚不充分,使其尚不能在辐射环境下实现规模化应用。因此,为保障我国核和空间事业的持续发展,亟需针对新型SiC MOSFET开展以下研究工作:1)新型SiC MOSFET加速器地面模拟辐照试验技术;2)SiC MOSFET SEE退化规律及物理机制;3)针对新型SiC MOSFET的抗辐照加固技术。以上研究内容前后承接、息息相关,其顺利实施不但能为我国核工业和空间事业的顺利进行保驾护航,也将大大推进我国SiC MOSFET等功率器件的国产替代进程。 作者贡献声明刘翠翠提出编写思路,并负责论文起草、修改的主要工作;郭刚负责审核、把关论文的科学性、严谨性;李治明负责搜集参考文献,以及起草、修改论文的部分内容;张付强负责搜集参考文献,指导论文编写;陈启明负责指导论文编写;韩金华负责参考文献中部分数据的分析;杨新宇负责搜集参考文献。


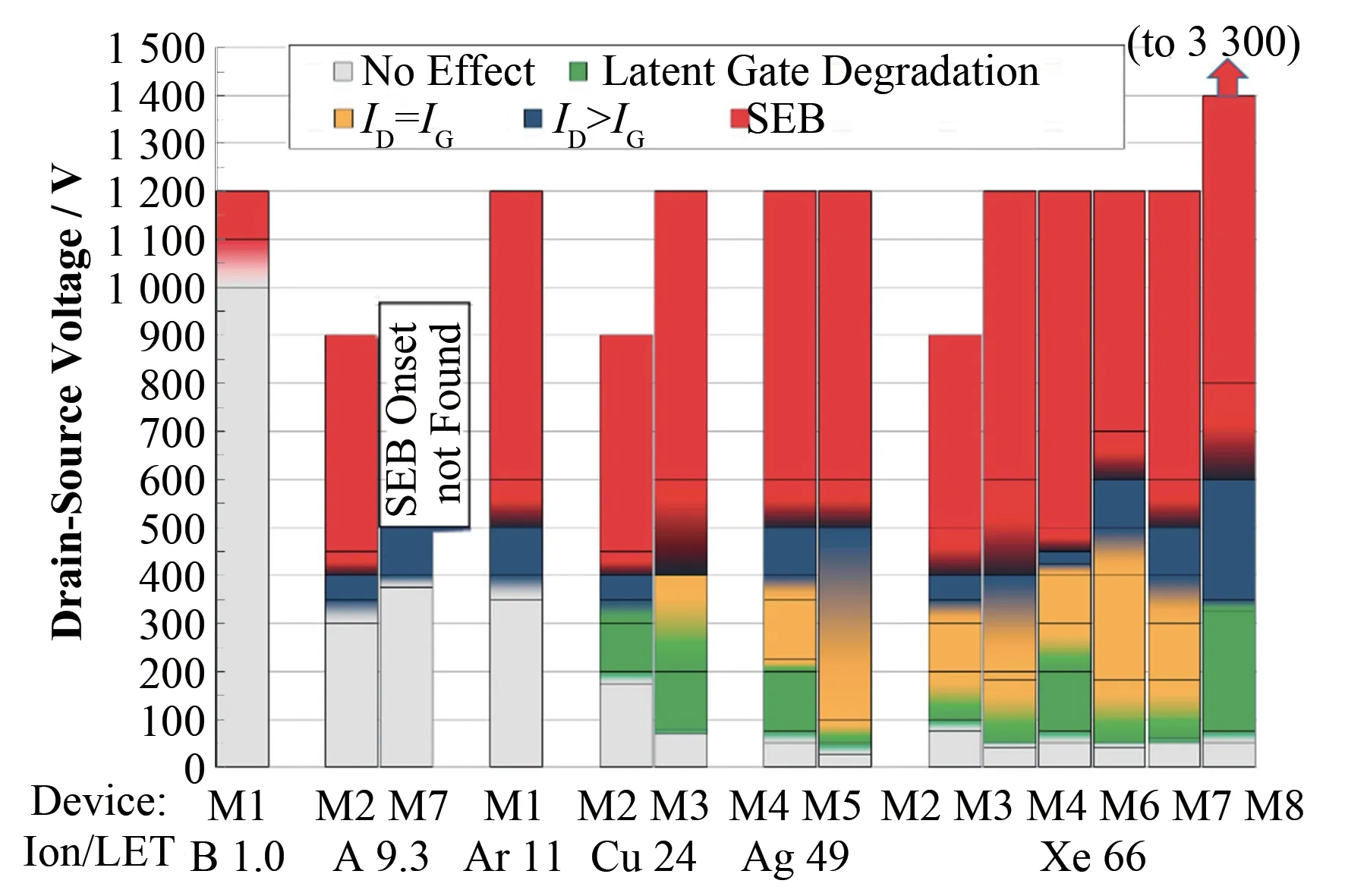




3 国内研究现状分析


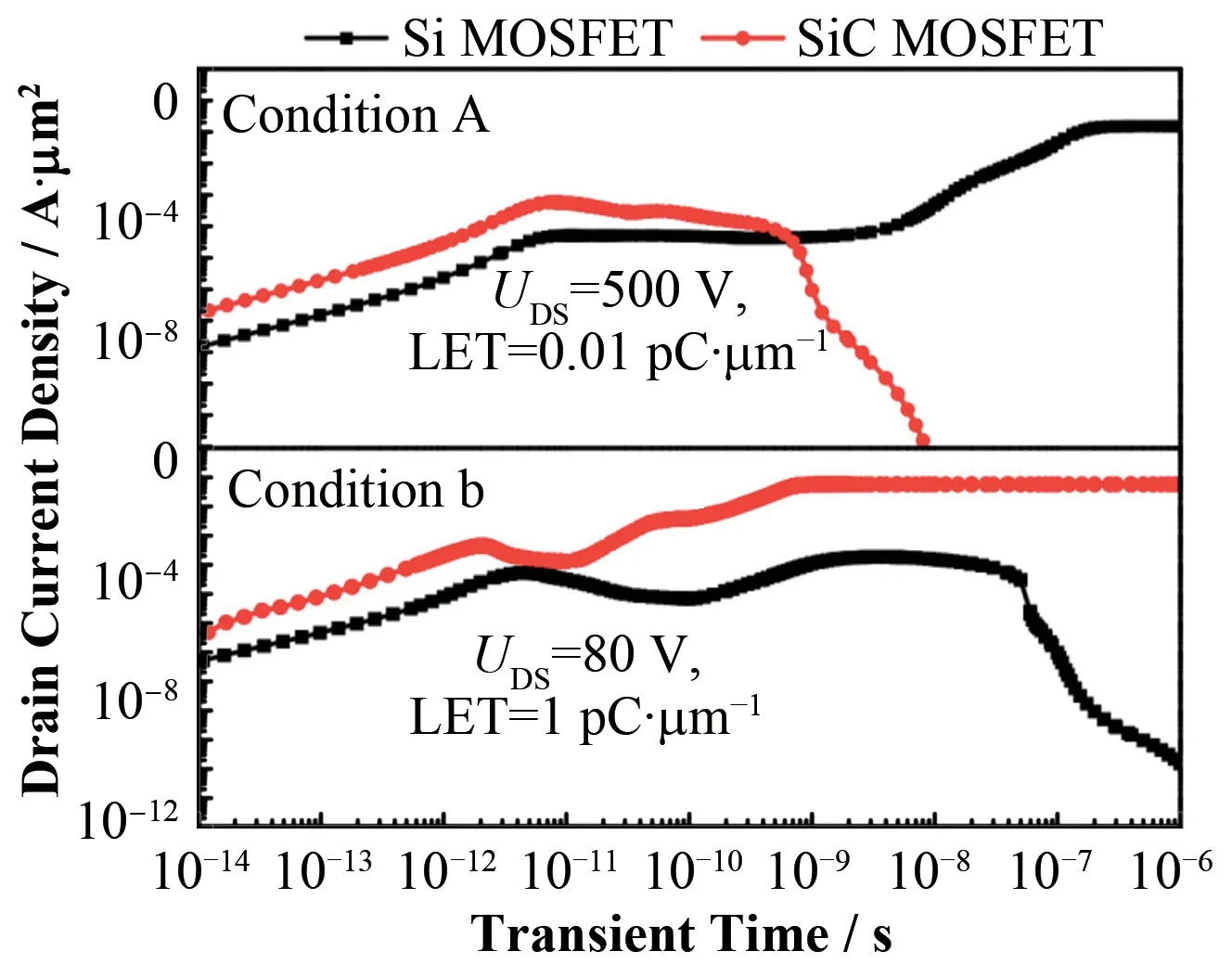


4 SiC MOSFET SEE加固及性能评估现存问题
5 结语

