SiC 功率器件辐照诱生缺陷实验研究进展*
杨治美,高 旭,李 芸,黄铭敏,马 瑶,龚 敏
(1.四川大学物理学院微电子技术四川省重点实验室,成都 610064;2.四川大学辐射物理及技术教育部重点实验室,成都 610064)
1 引言
SiC 半导体产业的发展一直是我国的“卡脖子”工程,最近几年在国家项目扶持下,SiC 半导体产业迅猛发展。为了促进SiC 功率器件在各种复杂极端环境下的应用,人们对SiC 功率器件的研究主要集中在3 个方面:一是新型SiC 器件结构设计和优化的研究[1-5],如2021 年中国科学院微电子研究所提出4H-SiC 沟槽金氧半场效晶体管与台面侧壁肖特基二极管(Trench Metal-Oxide-Semiconductor Field-Effect Transistor Integrated with Mesa-Sidewall Schottky Barrier Diode,TMS-SBD)集成的结构可大大降低导通损耗和关断损耗;二是SiC 器件工艺制造和可靠性的研究[6-7];三是SiC 器件应用开发研究等[8-17],如深井探测、车辆控制系统和发电厂、超导、太阳能电推进系统(Solar Electric Propulsion System Technology,SEP)[18]和航天应用。在这些研究中,深井探测应用环境温度高于400 K,而超导和航天应用运行的环境温度往往又低于100 K[7],这些极端环境的条件要求电力设备能够在较大的温度范围内可靠稳定地运行,同时由于航空航天应用的特殊性(工作温度宽、系统集成度高、元件更换困难),半导体器件中的缺陷问题对电力电子器件的可靠性影响重大,所以缺陷对功率器件的电气特性评价和分析是非常重要的。
缺陷是半导体中普遍存在的,可能是外来原子(杂质原子)或晶体中的缺陷,也可能是在晶体生长和器件制备过程中有意引入的。有意掺入的杂质原子形成的浅能级杂质可以改变半导体导电类型和导电性能;而深能级缺陷则形成复合中心,可以降低器件寿命,这对改善器件的频率和开关等性能极为有利。辐照技术能够可控地引入点缺陷,如空位和间隙,从而提高制备器件的光学和电学输运性能[19]。国内SiC 材料最早开始离子注入硼和磷,以及电子辐照等都是在6H-SiC(Eg=3.0 eV)材料中开展的[20]。随着半导体制造技术的提升,由于4H-SiC 具有更宽的禁带宽度(Eg=3.23 eV)、更高的电子迁移率(1141 cm2·V-1·s-1)等独特的优势,目前4H-SiC 器件相关研究已成为主流。在宽禁带半导体SiC 器件中,辐照诱生缺陷会强烈地影响器件的电学性能,限制器件的应用,如载流子-寿命限制的缺陷。因此,对宽禁带半导体材料和器件而言,如何表征和评估器件制造过程和辐照诱生缺陷中心对其应用是非常关键的。
功率器件界面特性对其性能影响至关重要,解决金属-SiC 界面缺陷问题也是提高SiC 器件抗辐照性能的关键,但辐照诱生的缺陷包括SiC 体内缺陷,金属与SiC 界面的缺陷,SiC/SiO2界面,以及辐照诱生原子迁徙后在金属层中形成新的SiC 晶体等相关缺陷,这些缺陷的化学特性尚未完全达成共识,特别是导带边缘附近大量界面态的影响,SiC 器件场效应迁移率仅约为30 cm2·V-1·s-1,比其体材料迁移率低约2 个数量级,这极大地限制了SiC 器件的性能。SiC/SiO2界面态密度(1012~1013cm-2·eV-1)比Si/SiO2(1010cm-2·eV-1)高2 个数量级以上[21],这些缺陷态可能的起源较多:如SiC 的本征缺陷(C=C),界面附近或SiO2中的过量碳团簇,或SiO2体相陷阱(O 空位)。2021 年剑桥大学的ZHANG 等率先从理论上揭示[21],SiC 中Si 的选择性氧化会导致碳沉淀,并在SiO2中形成碳团簇,从而解释了高界面态密度的成因,缺陷能级靠近SiC 的导带底,因此降低了载流子的迁移率。可以看出界面碳团簇可能是SiC 器件载流子迁移率降低的重要原因,本课题组在快重离子辐照的实验中,通过深能级瞬态谱(Deep Level Transient Spectroscopy,DLTS) 和 微 区Raman 不同的测试技术手段都观测到大量碳团簇现象的存在[22-23]。
在SiC 材料和器件的辐射效应实验和理论研究中[24-26],重离子辐照主要集中在单粒子效应(Single Event Effect,SEE)方面的研究[24-25],SEE 是一种低注量(小于107ion/cm2)和低注量率的单粒子事件辐射失效机制。根据辐照能量、辐照注量、入射角、离子种类和辐照过程中偏置电压等的不同,损伤可能导致缓慢退化或灾难性失效,从而导致热失控事件。SEE 事件主要通过泄漏电流来反映,众所周知泄漏电流受缺陷的影响,但目前的SEE 文章中,使用DLTS 表征辐照诱生缺陷的研究尚未见报道。高注量离子束诱导的SiC外 延 层 再 结 晶 (Ion-Beam-Induced Epitaxial Crystallisation,IBIEC)效应已有报道[22,26-27],这主要是由于重离子辐照导致Si—C 键断裂,同时离子的碰撞导致焦耳热的产生[28],可以导致损伤、辐照诱生缺陷和晶体结构部分恢复,因此,利用分子动力学(Molecular Dynamics,MD)模拟重离子辐照温度效应也有所报道。过去的研究表明:纳米晶AlN 和GaN 在重离子辐照后形成非晶态,具有很强的抗辐照性能。快速重离子(Swift Heavy Ions,SHI)辐照对晶体结构和缺陷/界面陷阱,特别是深能级缺陷[22,29]都会产生影响。其中,在N 型4H-SiC 中施主(0/+)和受主(-/0)能级的Z1和Z2缺陷占主导地位,与碳空位(Carbon Vacancy,VC)缺陷有关,该缺陷具有较强的热稳定性,热退火温度高达1700 ℃。相关研究表明:SiC 材料本身具有较好的抗辐照特性,但SiC PN 结、SBD 和MOSFET 器件的电学参数不同程度地都会受到不同辐照(类型/ 注量/能量等)的影响,其中SBD 器件是最简单、最基础、最成熟的器件结构。金属-半导体界面的质量直接影响SBD 器件的可靠性,辐照对SiC SBD 器件耗尽区附近的影响对整个器件电学输运性质的影响非常大,一些新型功率器件的结构已将SBD 结构融入其中,辐照对局部器件产生影响,将有可能导致整个器件的电学参数发生较大变化。由于半导体的辐射效应与半导体材料中原始杂质缺陷的分布、器件的掺杂工艺条件等诸多因素息息相关,而文献报导的结果并不完全相同,目前对辐射损伤机制的理论解释也尚未完善,还有很多问题亟需解决,因此本文着重介绍了SiC SBD 功率器件辐照发展历程和辐照损伤机理,综述轻离(粒)子和重离子对SiC 功率器件辐照效应实验的研究进展,以及不同温度辐照对诱生缺陷形成机理的异同,并对它们的发展前景做出了展望。
2 SiC 功率器件诱生缺陷简介
2.1 SiC 功率器件辐照效应研究发展历程
功率器件辐照效应研究发展历程如图1 所示,6H-SiC 单晶片在1990 年实现商品化,1991 年加拿大的BARRY 等[30]便利用电子束辐照6H-SiC 发光二极管进行损伤研究,因此SiC 辐射效应研究基本上与SiC 材料和器件是同步发展的。早期SiC 工艺中,掺杂工艺困难,常用离子注入或辐照诱生缺陷结合退火工艺来实现掺杂,因此SiC 辐照效应的研究主要集中在材料辐照效应方面;2001 年以后,随着微电子工艺制造水平的提升,SiC 器件良率提高,且材料的辐射效应研究已解决相当多的问题,因此业界开始大力发展SiC 器件的辐射效应研究,并占主导地位。目前SiC 新器件结构不断涌现,因此新器件的辐照效应也引起了不少学者的关注。

图1 功率器件辐照效应发展历程
2.2 辐照损伤机理
辐射源一般包括轻离(粒)子(如电子、质子、中子、γ 射线)和重离子,不同的辐照源在材料/器件中产生的损伤是不相同的,且损伤程度不但与射线的能量、剂量关系密切,而且与器件的结构、偏置状态、温度等条件关系也很密切,因此辐射效应研究是一个相当复杂的问题。
在半导体材料/器件的辐照效应中,通常以电离损伤和位移损伤为主,电离损伤是指高能粒子辐射在半导体材料上的时候,使得基体材料中的原子发生电离,即激发出非平衡的电子-空穴对。电离效应是在材料中引入可以自由移动的电荷,存在电场时就能形成附加电流,从而导致器件出现电离损伤退化效应。电离效应包括总剂量电离损伤和SEE。位移损伤是入射粒子能量足够大时,通过碰撞等过程与基体原子发生相互作用,最终使得基体材料的原子离开原本所处的晶格位置,从而形成空位-填隙原子对类的缺陷。被移位的原子可能与其他原子多次碰撞,产生移位链。位移损伤产生缺陷会在禁带中引入附加能级,从而影响少数载流子寿命,降低多数载流子浓度和迁移率。一般电离损伤所需要的能量比位移损伤小,体效应器件以位移损伤为主,表面效应器件以总剂量损伤为主,集成电路还会出现剂量率和单粒子效应。
3 国内外SiC 功率器件辐照效应研究现状
3.1 轻离(粒)子对SiC 功率器件的辐照效应
早在20 世纪90 年代初期,MCLEAN 等[5]就报道了 6H-SiC N 沟结型场效应晶体管(Junction Field-Effect Transistor,JFET)的中子辐照效应,实验结果表明,经过1×1015/cm2中子辐照后,器件特性仅有轻微的退化;高温工作时,器件特性的退化幅度比常温下小。2004 年有研究者发现63 MeV 质子辐照会导致4H-SiC SBD 的串联电阻增加,虽然正向电流变化很小,但反向漏电流和反向电压会发生明显的改变[6]。2006 年,HARRIS 等[7]报道了商用整流管4H-SiC SBD的高能质子辐射特性,经过2.5×1014/cm2的203 MeV质子辐照后,器件的肖特基势垒高度基本没有变化。2011 年张林等[31]研究了γ 射线、高能电子和中子的Ti/4H-SiC SBD 抗辐射特性,发现电子和中子辐照会造成器件串联电阻增加。2016 年OMOTOSO 等[32]开展了α 辐照4H-SiC SBD 诱生缺陷对电学特性影响的研究,研究结果表明:辐照导致理想因子从1.12 增加到1.15,肖特基势垒高度从0.93 eV 增加到2.96 eV,串联电阻从12 Ω 增加到48 Ω,辐照诱生缺陷导致复合电流增加。2018 年李豪杰[33]开展了高温湿氧工艺4HSiC MOS 电容与SBD 的质子辐照效应研究,辐照后串联电阻增大,理想因子n增大,势垒高度ΦB降低,且场板结构比传统结构SBD 的下降量更大。2021 年刘超铭等[34]采用1 MeV 电子辐照4H-SiC SBD,测试结果表明,随着辐照电子注量的增加,正向特性逐渐退化,串联电阻逐渐增加,反向漏电流增加,高剂量时反向漏电流减小。这些参数的变化对极端环境下运行的功率开关系统存在潜在的危害。目前很多课题组已报道轻离(粒)子的辐照对SiC 器件会有影响,譬如电子、质子、快中子、α 粒子等辐照SiC 都会导致材料或者表面的损伤。
诸多学者开展了宽禁带半导体SiC 材料和器件辐照的研究,主要考虑各种辐照对半导体材料或器件性能的影响,以及高温退火对辐照诱生缺陷的影响[35-36]。辐照对器件电容无明显影响[36],串联电阻(Series Resistance,Rs)明显增加[9,31-32],反向漏电流(Reverse Leakage Current,IS)有增[11,34]有减[36]或不变[37]。这些相关参数的变化表明:辐照后,在半导体材料的禁带中产生新的深能级缺陷俘获了自由载流子,从而减小空间电荷区的浓度,最终导致半导体器件体电阻增加、载流子寿命和迁移率的变化。尽管这些辐照种类不同,但是在SiC 材料中诱生出相似的缺陷,这对极端环境下运行的电源系统存在潜在的危害。
3.2 重离子辐照对SiC SBD 功率器件缺陷的影响
银河宇宙射线是来自于太阳系以外宇宙射线的总称,整体特点是高能量低通量,组成部分为:质子占比85%,α 粒子占比14%,重离子只占比1%。目前关于重离子辐照的研究相对较少,但重离子能量高,辐照损伤较大,譬如重离子辐照和高偏置电压下对SBD产生的损伤会导致瞬间击穿,从而导致漏电流增大[10]。
对SiC 辐照诱生缺陷的研究主要有光致发光光谱(Photoluminescence,PL)、正电子湮灭光谱(Positron Annihilation Spectroscopy,PAS)、DLTS、热刺激电容(Thermally Stimulated Capacitance,TSCAP)、热刺激电流(Thermally Stimulated Current,TSC)和电子顺磁共振(Electron Paramagnetic Resonance,EPR)等技术,目前DLTS 是半导体器件中最通用的测试技术。DLTS是一种非常有用和灵敏的半导体材料和器件深能级缺陷的表征技术,它可以获得深能级缺陷相关的重要参数(如缺陷能级相对于导带底EC/价带顶EV的位置ET,缺陷浓度NT,捕获截面σ,峰值位置P)。2017 年本课题组采用1985 MeV Bi 离子辐照4H-SiC SBD 器件[22],辐照前后的DLTS 曲线如图2 和图3 所示(其中TW为脉冲信号的周期,TP为脉冲信号的宽度,UR为反偏电压,UP为脉冲电压),首先可以看出Bi 离子辐照诱 生 新 的 缺 陷ET1、Z1/2、ET2、EH3、EH6/EH7和EN2产生,缺陷对应的基本参数和原因见表1,TiSi指Ti 取代Si,h 和k 是位置。其次这些缺陷会随辐照注量的变化发生显著变化:如ET1缺陷的强度随着辐照注量的增大而减弱,甚至在注量超过1×1010ion/cm2时完全消失;Z1/2[VC(=/0)]和ET2类似,它们都在辐照注量为1×109ion/cm2的器件中峰强度增大,1×1010ion/cm2的器件中强度减弱,而注量1×1011ion/cm2的样品中则几乎完全消失,但是Z1/2在辐照后峰宽增大,这应该是辐照引入了相邻Z1/2很近的新缺陷,但是这些新缺陷在注量超过1×1010ion/cm2时开始恢复;而EH3在辐照前并不存在,辐照后引入了强度较弱的宽峰,而宽峰表明它们可能是多个电容信号叠加而成。重离子辐照诱生缺陷的恢复主要是由于重离子入射到SiC 材料中时与晶格原子相互作用,通过非弹性碰撞,将能量转移到径迹周围,引起局部产生高热效应,即“热峰模型”,从而使径迹周围的晶体熔融并再结晶,发生局域相变,热的累积效应最终形成永久性物理损伤——潜径迹。因此随着辐照注量的增加,SiC 晶体重构,深能级缺陷在一定程度上被恢复。深能级缺陷的产生会导致4H-SiC SBD 器件反向漏电流的增加[22],在此不再详细赘述。

表1 Bi 离子辐照后器件深能级的相关参数及产生原因[22,32]

图2 Bi 离子辐照前后的DLTS 曲线(40~800 K)

图3 Bi 离子辐照前后的DLTS 曲线(300~600 K)
快重离子辐照前后4H-SiC SBD 器件中金属电极参数变化如表2 所示,可以看出金属电极的参数变化不大,但从元素分析数据中可以明显观察到重离子辐照后Si 和C 往金属层中迁徙,这是首次在SiC 器件中观察到的现象[29]。这主要是由于高能快重离子辐照过程中,Si—C 键断裂后,Si 和C 扩散经Ti 层进入W 金属层电极中,金属电极和金属-半导体界面的变化对M-S 界面势垒高度的影响非常重大,这是在过去的实验和模拟计算研究中被忽略的问题。

表2 辐照前后金属层厚度的变化[29]
过去对重离子辐照功率4H-SiC SBD 器件的影响研究中,重点关注快重离子辐照对有源区(肖特基结的金属与半导体接触的界面区域)电学特性、关键参数、结构和元素等的影响,目前的研究以室温下辐照为主,且轻离子(粒子)辐照研究居多,而低温重离子辐照研究相对较少。
为了避免重离子辐照过程中高热效应带来的影响,2021 年在低温(77 K)和室温(300 K)条件下采用能量相对较低的6 MeV Au 离子辐照4H-SiC SBD 器件,结果分别如图4 和图5 所示,研究发现:低温辐照诱生缺陷的峰位不变,且Z1/2峰的强度随辐照注量的增加而增强,5×1015ion/cm2的DLTS 强度最大;而300 K时重离子辐照诱生的Z1/2缺陷则表现出峰位随辐照注量的增加而右移,峰值最高出现在1×1014ion/cm2时。这说明低温辐照和室温辐照影响有较大差异,低温辐照时以位移效应为主,而室温辐照时以电离效应为主。对于化合物半导体,位移效应比电离效应重要,带电重离子与晶格原子发生碰撞,使得原子移出原来的晶格位置,形成替位原子、间隙原子和空位等,这些诱生缺陷可以和材料杂质复合或与其他空位结合形成更复杂的损伤缺陷。因此低温辐照诱生缺陷对复合电流和反向漏电流的影响远高于室温辐照,同时辐照诱生深能级缺陷对载流子的寿命有较大的影响,而载流子寿命对功率器件的开关速度/功耗等都有非常大的影响。在航空航天环境中运行的电子设备有40%的失效率,而在这些失效中,电离环境所导致的失效占比高达34%,说明空间粒子辐射所造成的退化乃至失效对于应用于空天环境中的设备、半导体器件而言是必须考虑的。因此从深能级缺陷浓度、缺陷类型、峰位移动等情况都反映出低温重离子辐照诱生缺陷高于室温重离子辐照诱生缺陷,同时辐照过程中重离子辐照产生的热有利于晶体结构的恢复,从而对重离子辐照诱生的缺陷具有一定的恢复作用。结合目前的研究,采用能量相对较低的重离子辐照方法,利用表面金属电极的阻挡作用,重离子仅能穿入终端区而无法进入有源区,进一步说明重离子辐照对器件终端区域的影响,对器件的性能也会带来非常大的影响。因此重离子辐照功率器件的研究中还有很多问题亟待解决。

图4 77 K 下6 MeV Au 离子辐照后的DLTS 曲线
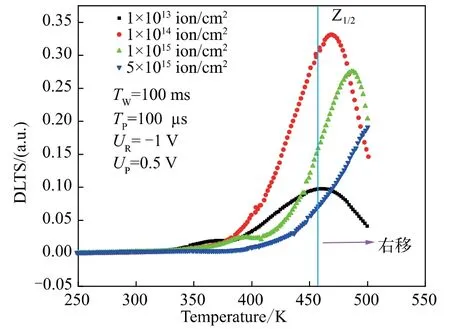
图5 300 K 下6 MeV Au 离子辐照后的DLTS 曲线
SiC 晶体结构中Si 或C 第二近邻和第三近邻有不同的配位结构,导致了不等价(Inequivalent)位置的产生,如k 和h 位。对4H-SiC 而言,有h 位和k 位,但6H-SiC 有k1、k2和h 位,同时不同晶格结构SiC 材料晶格常数和禁带宽度等材料参数差异较大,因此引入的深能级缺陷也略有不同,一些6H-SiC 和4H-SiC 中缺陷对比如表3 所示。Ih和D 为两种少数载流子陷阱。可以看出:不同晶体结构和辐照种类(轻/重离子)可在SiC 材料中辐照诱生出相似的深能级缺陷,辐照诱生的深能级缺陷往往并不是单一的;同时,对于高能或者穿透性强的辐照会影响整个外延层,甚至衬底也会受到严重的影响。因此对SiC 深能级缺陷的研究是一个迫切的任务,器件的制备过程中在器件内部引入本征的深能级缺陷中心,而辐照诱生缺陷也会在器件内部引入各种类型的缺陷中心,目前对SiC 中缺陷的认识还未形成共识。
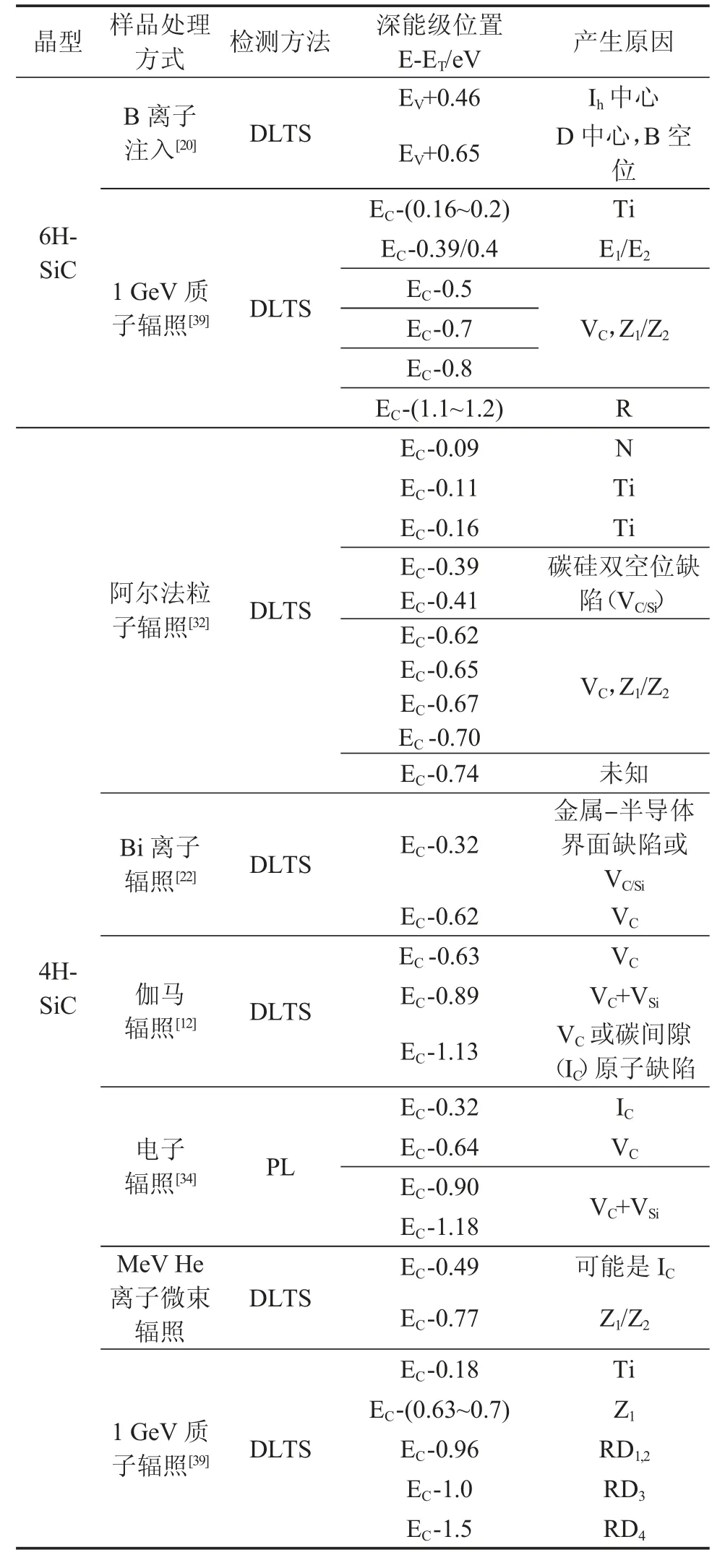
表3 6H-SiC 和4H-SiC 中缺陷比较
国内外有多个机构对SiC 功率器件的辐照效应做了深入的研究,并取得了一系列成果。由上述研究现状可以看出,理论上宽禁带SiC 半导体材料具有良好的抗辐照特性,但是实际上任何辐照都会对SiC 器件的性能产生一定影响。目前对SiC SBD 辐照效应的研究还存在以下问题有待深入探究:(1)实验研究主要集中在室温辐照损伤对器件性能的影响,而对器件性能退化机制的研究还不够深入,同时低温辐照的研究相对匮乏;(2)辐照实验一般采用零偏置,对加不同偏置电压时辐照效应的研究还比较缺乏;(3)辐照源相对比较单一,对多种辐照源的综合影响还有待进一步开展相关研究工作;(4)轻/重离子辐照可以诱生出相似的深能级缺陷,且是多个复合中心叠加在一起;(5)辐照诱生缺陷会导致4H-SiC SBD 器件反向漏电流的增加,但目前对SiC SBD 中缺陷认识还未形成共识。
对SBD 器件辐照效应的研究重点关注有源区辐照损伤,以及有源区辐照损伤对器件直流关键参数的影响,目前本课题组最新的研究成果表明:SiC 功率器件终端的PN 结、MOS 和终端区域的中性区受重离子辐照影响后,其对器件的整体性能影响非常大,但目前在对这些问题的研究中并未见相关详细的报道,因此重离子辐照功率器件的研究中还有很多问题亟待解决。结合目前的研究,采用能量相对较低的重离子辐照的方法,利用表面金属电极的阻挡作用(重离子仅能穿入终端区而无法进入有源区),可以进一步深入地研究重离子辐照对功率器件终端区域的影响,从而全面剖析重离子辐照对功率器件影响的关键因素。
3.3 辐照对新型SiC 功率器件的影响
目前对功率4H-SiC SBD 器件辐照效应的研究,重点关注快重离子辐照对有源区(肖特基结的金属与半导体接触的界面区域)电学特性、关键参数、结构和元素等的影响,取得了较好的研究成果,但是随着技术的发展,SiC 新器件结构不断涌现(见图6)[17],在对1.2 kV SiC 商用垂直扩散-金属-氧化物-半导体器件(Common Vertical Diffusion Metal-Oxide-Semiconductor,C-VDMOS)、 商 用 超 结 VDMOS(Common Super Junction VDMOS,C-SJ VDMOS)和单缓冲层超结VDMOS (Single Buffer Layer Super Junction VDMOS,SBL-SJ VDMOS)的SEB 对比模拟研究工作中,SiC 功率器件终端的PN结、MOS 和终端区域的中性区受重离子辐照影响后对器件的整体性能影响非常大,但并未见对这些问题的相关研究的报道,因此对SiC 器件的辐照效应研究必然会面临一些新的挑战。
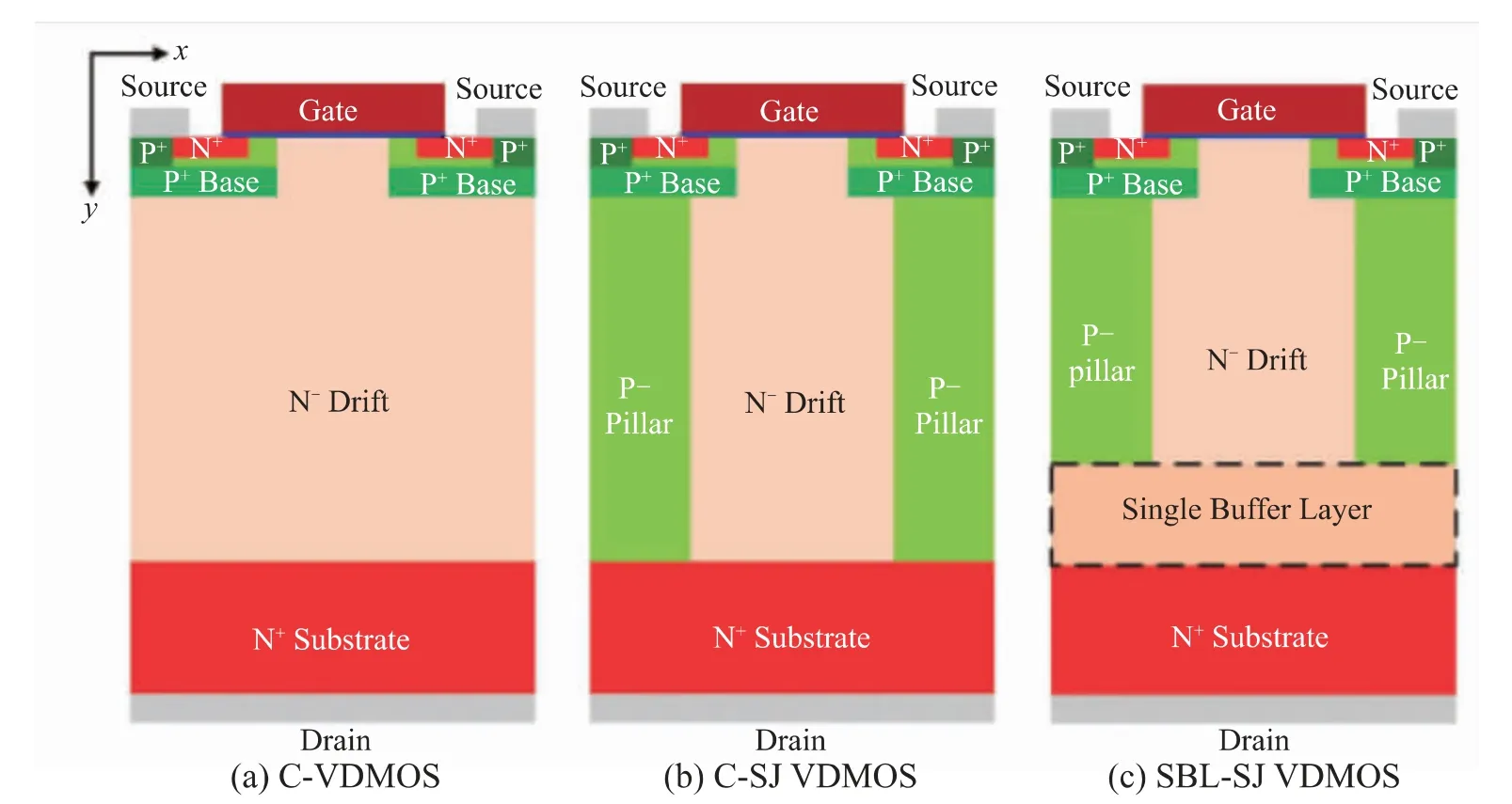
图6 SiC 新器件结构[17]
4 结论
随着科技的迅速发展,越来越多高性能商用的新型半导体电子设备被广泛应用于人造地球卫星和宇宙飞船等的控制系统中,构成这些设备的器件不可避免会受到各种各样的辐射,SiC 器件工作在不同的辐照环境中,辐照会在SiC 器件内部诱生各种缺陷,进而影响器件的性能,因此有效表征SiC 器件辐照诱生缺陷对SiC 器件在辐照环境下的应用具有重要的理论意义和实用价值。本文综述了近年来SiC 功率器件辐照效应的研究进展,包括SiC 功率器件辐照发展历程和辐照效应机理、轻/重离子辐照对SiC SBD 功率器件诱生缺陷影响的研究进展,以及辐照对新型SiC 功率器件的影响。目前的模拟仿真研究中一般只考虑单一的深能级参数对电学参数的影响和缺陷在外延层中、温度、隧穿和碰撞电离对反向击穿特性的影响。辐照过程中原子迁徙的现象,原子迁徙后对器件性能的影响和辐照诱生多个深能级缺陷与电学参数的关系等,重离子辐照导致再结晶效应,辐照损伤恢复是发生在样品表面还是在晶体与非晶界面等一系列问题,目前都无法通过计算机模拟来完成,还需要开展大量的实验工作来提供相关数据。全面剖析重离子辐照对功率器件影响的关键因素,可以进一步深化和完善重离子辐照对功率器件影响的研究,其研究结果具有重要的科学意义和工程应用价值。

